Transistores de efeito de campo ferroelétricos baseados em padrões de faixa de micron-largas dominadas por nanotubo de carbono de parede única com camada de controle de defeito de HfO2
Resumo
Transistores de efeito de campo ferroelétrico (FeFETs) com nanotubo de carbono de parede única (SWCNT) com faixa de micron-largura dominada e padronizada como canal, (Bi, Nd) 4 Ti 3 O 12 filmes como isolantes e HfO 2 filmes como camada de controle de defeito foram revelados e fabricados. Os SWCNT-FeFETs preparados possuem excelentes propriedades, como grande condutância de canal, alta relação de corrente liga / desliga, alta mobilidade da portadora de canal, excelente desempenho de resistência à fadiga e retenção de dados. Apesar de sua espessura equivalente de capacitância fina, o isolador de porta com HfO 2 camada de controle de defeito mostra uma baixa densidade de corrente de fuga de 3,1 × 10 −9 A / cm 2 a uma tensão de porta de - 3 V.
Histórico
O transistor de efeito de campo ferroelétrico (FeFET) é um candidato promissor para dispositivos de memória não volátil e circuitos integrados devido à sua alta velocidade, estrutura de dispositivo único, baixo consumo de energia e operação de leitura não destrutiva [1,2,3]. (Bi, Nd) 4 Ti 3 O 12 (BNT) é uma película fina ferroelétrica sem chumbo com propriedades químicas estáveis e desempenho de resistência à fadiga. Assim, o FeFET usando BNT como dielétrico de porta teria menor tensão de limiar, grande condutância de canal e assim por diante. Nanotubos de carbono (CNTs) têm sido amplamente aplicados em FeFET por sua alta condutividade e grande mobilidade de portadores [4,5,6,7]. É bem conhecido que não existem ligações pendentes na superfície dos CNTs ideais, o que leva a uma pequena reação de interface entre o filme ferroelétrico e os CNTs [8, 9]. No entanto, é muito difícil atingir o crescimento de CNT único entre os eletrodos de fonte e dreno no experimento. Além disso, a relação de corrente liga / desliga da rede de nanofios de CNT FeFET é geralmente baixa por causa da mistura de nanotubos metálicos na rede de CNT [7, 10]. Song et al. propôs o uso de uma faixa de micron-largura de CNT multiwalled como material de canal de FeFET para resolver os problemas mencionados acima, mas o desempenho de resistência à fadiga e retenção de características físicas de CNT FeFET não está claro [9]. Comparado ao CNT de paredes múltiplas (MWCNT), o CNT de parede única (SWCNT) é uma única folha de grafeno perfeitamente envolvida formada em um tubo cilíndrico [11]. Além disso, existem alguns defeitos (como impurezas de íons, lacunas de oxigênio e deslocamentos) que são difíceis de controlar durante a fabricação de filme fino ferroelétrico [12,13,14]. A difusão desses defeitos pode afetar a relação de corrente liga / desliga, desempenho de resistência à fadiga e retenção de dados [15, 16]. Portanto, implantamos HfO 2 camada em SWCNT-FeFET, que é usado para bloquear a difusão de defeitos pontuais e pode ser usado como uma camada tampão para aliviar o desajuste entre BNT e Si e, portanto, para reduzir a densidade de deslocamento no filme BNT. Ele pode controlar os defeitos no SWCNT-FeFET e, em seguida, melhorar significativamente a relação de corrente liga / desliga, características de fadiga e retenção de dados.
Neste estudo, fabricamos SWCNTs de rede padronizada de faixa de largura de mícron regular e alinhada como camada de canal, filmes BNT como isolante e HfO 2 filmes como camada de controle de defeito para fabricar FeFET tipo bottom-gate e espera-se obter uma boa relação de corrente liga / desliga, características de fadiga e retenção de dados. A estrutura de SWCNT-FeFET e seu procedimento de preparação são mostrados na Fig. 1a, b. Além disso, também fabricamos MWCNT-FeFET para comparação.
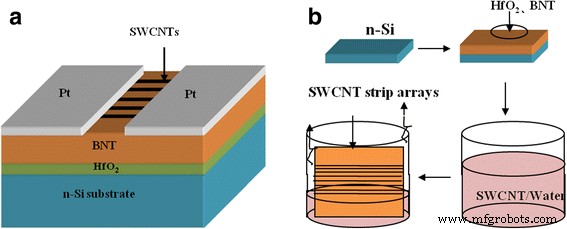
a O diagrama de estrutura do SWCNT-FeFET padronizado de faixa. b Fluxograma do padrão de faixa SWCNT / BNT / HfO 2 -FeFET fabricação
Métodos
Nos dispositivos FeFET, o SWCNT micron-wide stripe padronizado é usado como canal, o filme fino BNT é usado como dielétrico de porta, HfO 2 filmes são usados como camada de controle de defeito, e o Si tipo n fortemente dopado é usado como substrato e eletrodo de porta traseira de FeFET simultaneamente. A resistividade do Si tipo n é 0,0015 Ω cm. O HfO 2 foi depositado no substrato de Si por deposição de laser pulsado (PLD) usando um excimer laser KrF com comprimento de onda de 248 nm, e sua espessura é de cerca de 20 nm. O filme de BNT foi depositado no substrato de Si pelo PLD conforme descrito no trabalho anterior [17], e sua espessura é de cerca de 300 nm. O SWCNT com descarga de arco puro foi adquirido do Instituto de Química Orgânica de Chengdu (Academia Chinesa de Ciências); o comprimento e o diâmetro são 10-30 μm e 0,8-1,1 nm, respectivamente. Sua pureza é de 85%, o que significa que SWCNT é dominado. Os SWCNTs foram fabricados usando automontagem induzida por evaporação. A concentração de SWCNT / dispersão de água foi de 100 mg / L, a taxa de evaporação variou em um intervalo de 9–21 μL / min e a temperatura foi de 80 ° C. Ao controlar a temperatura de evaporação do solvente, um padrão de faixa bem definido foi formado na interface sólido-líquido-vapor no BNT / HfO 2 Substrato / Si. Em seguida, eletrodos de fonte / dreno de Pt foram depositados nos SWCNTs / BNT por pulverização catódica por feixe de íons usando uma placa de máscara. A área total da placa de máscara de metal é 1 cm 2 , e as áreas de origem e drenagem são ambas 4,5 mm 2 . O comprimento do canal ( L ) e largura ( W ) de FeFET são 200 e 1500 μm, respectivamente. O SWCNT-FeFET fabricado seguido por um pós recozimento a 500 ° C por 2 h para melhorar o contato entre os eletrodos de fonte / dreno e os SWCNTs. Conforme relatado, a rede CNT contém nanotubos metálicos e semicondutores. A rede CNT foi processada aplicando uma grande tensão de porta. Os nanotubos SWCNT metálicos foram quase ablacionados e os nanotubos SWCNT semicondutores foram mantidos pela corrente de carga [18]. Para comparar, SWCNT / SiO 2 -FET foram fabricados pelo mesmo método e condições; MWCNTs / BNT-FET também foi fabricado pelo método descrito no trabalho anterior [9]. As características do FeFET foram medidas usando um analisador de parâmetros Keithley 4200. Os loops de histerese e polarizações de FeFET foram medidos usando um analisador ferroelétrico RT Precision Workstation.
Resultados e discussão
A Figura 2 mostra imagens SEM típicas das faixas SWCNTs padronizadas. Os SWCNTs regulares e alinhados com padrões de faixa de largura de mícron são exibidos na Fig. 2a. As listras protuberantes e claras são listras SWCNT, nas quais os SWCNTs são densamente compactados, conforme exibido na imagem ampliada de uma listra na Fig. 2b. As listras afundadas e cinza correspondem ao BNT / HfO descoberto 2 / Si substrato nos espaços entre as faixas SWCNT de largura mícron. A concentração da solução do precursor SWCNT aumenta com a evaporação, e a largura das faixas graduadas aumenta ligeiramente com o declínio do nível do líquido SWCNT / água. O BNT / HfO 2 filmes e filmes BNT no substrato de Si são mostrados na Fig. 2c, d. Pode ser visto que a superfície do BNT / HfO 2 o filme é composto por diversos grãos cristalinos e poros, o que indica uma rugosidade maior que a dos filmes BNT. A Figura 2e mostra o P - V loops de histerese de BNT e BNT / HfO 2 filmes, respectivamente. As polarizações dos loops de histerese do BNT / HfO 2 os filmes são maiores do que os filmes BNT na mesma voltagem. Mesmo que HfO 2 camada compartilhada parte da voltagem de BNT / HfO 2 filmes, o filme BNT ainda mostra melhor valor de polarização do que o BNT cultivado em substrato de Si. É porque os filmes BNT cresceram no HfO 2 camada tem menor concentração de defeito de difusão do que os filmes BNT crescidos no substrato de Si diretamente.

a Micrografia SEM da faixa SWCNT padronizada no SWCNT / BNT / HfO 2 -FeFET. b A estrutura de grade de SWCNTs. c Imagem SEM da superfície para BNT / HfO 2 filme. d Imagem SEM da superfície para filme BNT. e Loops de histerese de BNT e BNT / HfO 2 filmes
A Figura 3 mostra as características de saída ( I DS -V DS ) curvas de SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET. SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET mostram o típico p características do transistor de canal e correntes fonte-dreno saturadas em baixa tensão fonte-dreno. A duração do canal ( L ) é 200 μm. Por causa do padrão de faixa SWCNT de largura mícron, a corrente “ligada” e a condutância do canal de SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET alcançam 3,8 × 10 −2 A, 3,6 × 10 −2 A e 9,5 × 10 −3 S, 9 × 10 −3 S em V GS =- 4 V e V DS =4 V. No entanto, SWCNT / BNT / HfO 2 -FeFET mostra correntes de estado desligado mais baixas do que SWCNT / BNT-FeFET, e SWCNT / BNT-FeFET mostra grave fenômeno de corrente de fuga em V GS =0 V . Isso ocorre porque o HfO 2 camada bloqueia efetivamente a difusão de defeitos.

Curvas de características de saída de SWCNT / BNT / HfO 2 -FeFET (letf) e SWCNT / BNT-FeFET (direita)
As características de transferência ( I D - V G ) do SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET com L =200 μm e V DS =0,6 V são exibidos na Fig. 4. A tensão de limiar ( V th ) de SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET são V th =0,2 V e V th =0,8 V por um ajuste linear do ( I D ) 1/2 vs V GS curva do transistor operando na região de saturação. A mobilidade do canal ( μ sat ) é calculado com base no ( I DS ) 1/2 vs V GS curva, bem como a expressão da região de saturação para um transistor de efeito de campo [19],
$$ {I} _ {\ mathrm {DS}} =\ left (\ frac {\ varepsilon_0 {\ varepsilon} _r {\ mu} _ {\ mathrm {sat}} W} {t _ {\ mathrm {ins}} 2L} \ right) {\ left ({V} _ {\ mathrm {GS}} \ hbox {-} {V} _ {\ mathrm {th}} \ right)} ^ 2 para \ kern0.5em {V_ { \ mathrm {DS}}} ^ {{} ^ 3} {V} _ {\ mathrm {GS}} \ hbox {-} {V} _ {\ mathrm {th}}, $$
onde ε r é a permissividade relativa e t ins é a espessura do BNT. Uma constante dielétrica relativa ( ε r ) do filme BNT é 350, que é medido a 1 MHz pelo analisador de parâmetro HP4156. O μ sat de SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET são 395 e 300 cm 2 / V s. A Figura 5 mostra o I DS - V GS curvas de transferência logarítmica do SWCNT / BNT / HfO fabricado 2 -FeFET, SWCNT / BNT-FeFET e SWCNT / SiO 2 / HfO 2 -FET em modo de varredura dupla. A varredura da tensão da porta foi realizada em uma V DS de 0,6 V e no V GS varia de - 7 a 4 V, - 6 a 3 V, e - 4 a 1 V. O I DS relação liga / desliga de SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e SWCNT / SiO 2 / HfO 2 -FET são 2 × 10 5 , 2 × 10 4 e 2,3 × 10 2 no V GS variam de - 7 a 4 V. O I DS relações on / off de SWCNT / BNT / HfO 2 -FeFET são maiores do que MWCNT / BNT-FeFET [9] e SWCNT / BNT-FeFET. É porque o HfO 2 A camada de controle de defeitos foi implantada em SWCNT-FeFET, que bloqueia efetivamente a difusão dos defeitos. Para eu DS - V GS características, obtivemos um loop de histerese no sentido horário devido à reversão da polarização ferroelétrica do filme BNT, a largura da janela de memória (MW) obtida de SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET são cerca de 4,2 e 4,1 V, que é maior do que o CNT / PZT-FeFET (1,1 V) com a rede CNT como camada de canal [20]. O MW maior indica um bom acoplamento dielétrico neste sistema FeFET. Na Fig. 4c, podemos ver a largura da janela obtida de SWCNT / SiO 2 / HfO 2 -FET é cerca de 1 V, que é causado principalmente por densidades de defeito de SWCNT [21]. Esses resultados sugerem que a histerese da janela de memória (4,2 V) do FeFET ferroelétrico é causada tanto pela polarização do BNT quanto pelas densidades dos defeitos SWCNT.
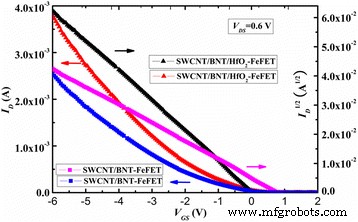
A curva de características de transferência linear e ajustada I DS 1/2 - V G curva em V DS =0,6 V para a faixa padronizada de SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET

Curvas de transferência logarítmica de faixa padronizada a SWCNT / BNT / HfO 2 -FeFET, b SWCNT / BNT-FeFET e c SWCNT / SiO 2 / HfO 2 -FET em V DS =0,6 V . As setas indicam um loop de histerese no sentido anti-horário, e as linhas sólidas exibem a largura da janela de memória
A Figura 6a mostra as características de fuga de corrente-tensão do BNT / HfO 2 e filme BNT. Como pode ser visto, as correntes de fuga são 1,2 × 10 −9 A e 1,5 × 10 −8 A para BNT / HfO 2 e filme BNT, respectivamente, quando a voltagem atinge até - 3 V. As características de corrente-voltagem de fuga do BNT / HfO 2 e filme BNT foram estudados para comparação, ajustando o I - V dados. As características da corrente de fuga de um contato Schottky foram representadas por Ln ( J ) = b ( V + V bi * ) 1/4 [9, 22, 23], e os gráficos correspondentes para BNT / HfO 2 e filmes BNT na faixa de tensão de 0 a 3,8 V são mostrados na Fig. 6b. As tensões integradas V bi * e declive b na fórmula pode ser obtido ajustando o experimento I-V dados. As densidades de carga espacial calculadas N eff , que consistia em centros de aprisionamento profundo e vagas de oxigênio [22], são cerca de 2.132 × 10 17 cm −3 e 1,438 × 10 19 cm −3 para BNT / HfO 2 e filme BNT, respectivamente. É indicado que os filmes de BNT depositados sobre substrato de Si são semicondutores do tipo n de acordo com a fórmula de altura de barreira de interface [24]. Isso é consistente com o efeito do HfO 2 na redução da corrente de saída de I D - V G curva na Fig. 4a, b, porque o BNT tipo n gera elétron aumenta a corrente de saída na tensão negativa. A condução do filme BNT mostra mecanismo controlado por bulk, o que implica ainda que o BNT tipo n é induzido principalmente por defeitos condutores ou impurezas [9, 22].
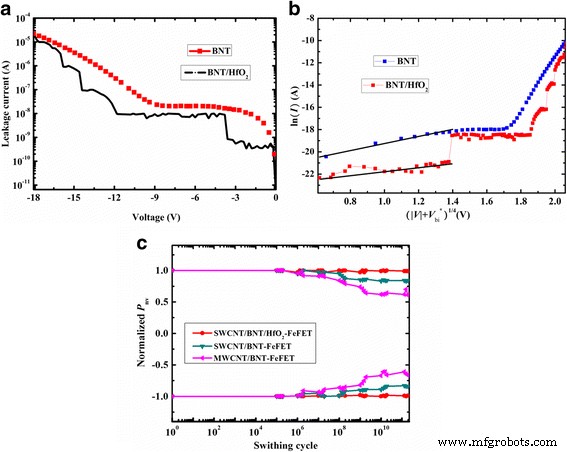
a Características de corrente-tensão de fuga do BNT / HfO 2 e filme BNT. b A curva de ajuste das características de corrente-tensão de fuga do BNT / HfO 2 e filme BNT. c Desempenho de resistência à fadiga do SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e MWCNT / BNT-FeFET
A Figura 6c mostra o desempenho de resistência à fadiga para o SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e MWCNT / BNT-FeFET com pulso bipolar de 100 KHz no V GS variam de - 7 a 4 V. O desempenho de resistência à fadiga do FeFET é exibido na perda de polarização comutável com ciclos de comutação repetidos. O valor da polarização não volátil ( P nv ) é obtido pela equação P nv = P r * - P r ^ e então, normalizado com P nv / P r0 * [25], onde P r * é duas vezes a polarização remanescente de FeFET, P r ^ é a perda de polarização após o próximo pulso, e P r0 * é a polarização remanescente duas vezes inicial do FeFET. A perda parcial do P normalizado nv após 10 11 ciclos de comutação de leitura / gravação são observados para o FeFET, que são aproximadamente 3, 10 e 25% para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e MWCNT / BNT-FeFET, respectivamente. Quando o BNT cresce diretamente no eletrodo inferior de Si, o desempenho de fadiga do SWCNT / BNT-FeFET é muito ruim por causa da difusão entre o substrato de BNT e Si através do contorno do grão [12,13,14]. Esses resultados sugerem que o HfO 2 A camada bloqueia efetivamente a difusão do substrato de Si e reduz as impurezas de íons, o que resulta em excelente desempenho de resistência à fadiga.
Para avaliar a confiabilidade do dispositivo de FeFET em relação à aplicação NVRAM, examinamos a retenção de dados. A Figura 7 mostra as curvas de retenção de corrente fonte-dreno para o SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e MWCNT / BNT-FeFET em temperatura ambiente. O pulso de tensão de V GS =- 4 V e V GS =1 V em V DS =1 V é aplicado ao eletrodo da porta e da fonte-dreno, mudando a tensão do FeFET para o estado desligado ou ligado, respectivamente. As relações de corrente de estado ligado / desligado medidas são quase 3 × 10 4 , 7 × 10 3 e 6 × 10 2 para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e MWCNT / BNT-FeFET após 10 6 s, respectivamente. Não há perda significativa na relação de corrente no estado ligado / desligado (3,2%) após um tempo de retenção de 1 × 10 6 s para SWCNT / BNT / HfO 2 -FeFET. Extrapolando as curvas para 10 8 s para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e MWCNT / BNT-FeFET, as relações de corrente no estado ligado / desligado são quase 1,9 × 10 4 , 3 × 10 3 e 2 × 10 2 , respectivamente. A proporção de estado ligado / desligado de SWCNT / BNT / HfO 2 -FeFET ainda é alto o suficiente para a função de memórias, demonstrando uma propriedade de retenção desejável do presente dispositivo de memória. A retenção é influenciada pela corrente de fuga da porta [26, 27]. O longo tempo de retenção indica HfO 2 a camada de controle de defeitos pode reduzir efetivamente a corrente no estado desligado e a corrente de fuga da porta, o que estabiliza a relação da corrente ligada / desligada. Além disso, também fizemos uma comparação entre FETs baseados em ferroelétricos e diferentes CNT na Tabela 1, sugerindo que o SWCNT / BNT / HfO fabricado 2 -FeFET neste estudo pode fornecer alta relação de corrente on / off, excelente desempenho de resistência à fadiga e retenção de dados.
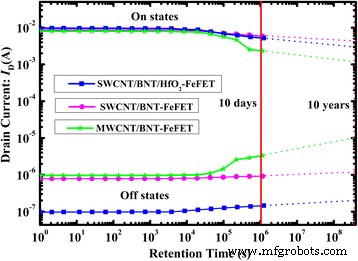
Características de retenção do SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET e MWCNT / BNT-FeFET à temperatura ambiente
Para entender melhor como os defeitos influenciam as características físicas do dispositivo, o P - E loops de histerese e I DS - V GS curva para o SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET foram simulados considerando carga assimétrica causada por defeitos usando nossos modelos anteriores [12, 28]. Uma carga assimétrica causada por defeitos é considerada para simular o P - E loops de histerese e I DS - V GS curva de BNT, e uma carga simétrica é considerada para simular aquela de BNT / HfO 2 . Os resultados da simulação são mostrados nas Fig. 8a, b, que são semelhantes aos resultados experimentais das Figs. 2e e 5a, b, respectivamente. Os resultados da simulação indicam HfO 2 camada efetivamente reduz as cargas assimétricas de filmes ferroelétricos causadas por defeitos, o que aumenta ainda mais a corrente de estado desligado. Portanto, pode ser demonstrado que os defeitos da película fina ferroelétrica foram efetivamente controlados por HfO 2 camada de controle de defeitos.
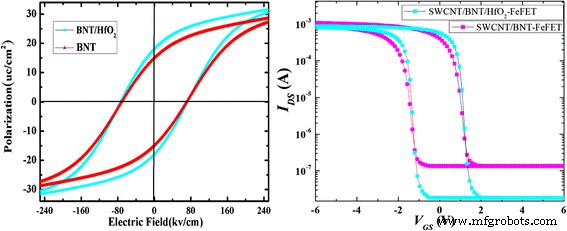
Simulação de a P - E loops de histerese de BNT e BNT / HfO 2 filmes e b eu DS - V GS curva para o SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET
Conclusões
Em resumo, o efeito de HfO 2 materiais como camada de controle de defeito na relação de corrente liga / desliga, desempenho de resistência à fadiga e retenção de dados dos SWCNT / BNT-FeFETs foram investigados, nos quais os defeitos da película fina ferroelétrica são controlados por HfO 2 como a camada de controle de defeitos. Devido à fina camada de controle de defeitos de HfO 2 , o SWCNT / BNT / HfO fabricado 2 -FeFET mostra uma corrente de fuga baixa de 1,2 × 10 −9 A quando a tensão atinge - 3 V, uma grande relação de corrente liga / desliga de 2 × 10 5 , um V th de 0,2 V, e um μ de 395 cm 2 / V s. Além disso, o SWCNT / BNT / HfO 2 -FeFET mostrou excelente desempenho de resistência à fadiga e boa retenção de dados que são atribuídos ao HfO fino 2 camada de controle de defeitos. A histerese faz um loop P - E e eu DS - V GS curva para o SWCNT / BNT / HfO 2 -FeFET e SWCNT / BNT-FeFET foram simulados para entender como os defeitos influenciam as características físicas do dispositivo. Os resultados da simulação demonstraram ainda que a carga assimétrica pode ser reduzida em SWCNT / BNT / HfO 2 -FeFET por HfO 2 para controlar os defeitos.
Abreviações
- BNT:
-
(Bi, Nd) 4 Ti 3 O 12
- FeFETs:
-
Transistores de efeito de campo ferroelétricos
- MWCNT:
-
Multiwalled CNT
- PLD:
-
Deposição de laser pulsado
- SWCNT:
-
Nanotubo de carbono de parede simples
Nanomateriais
- Artigos recentes detalham a escalabilidade do nanotubo de carbono, avanços de integração
- Fio de nanotubo de carbono, músculo e folhas transparentes
- Controle de Polarização Terahertz Completo com Largura de Banda Ampliada via Metasurfaces Dielétricos
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Transistores de efeito de campo Nanoflake SnSe multicamadas com contatos óhmicos de baixa resistência
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- Dieletroforese de aquecimento aprimorado para filme nanotubo de carbono de parede única alinhado de densidade ultra-alta
- Nanoesferas de carbono monodispersas com estrutura porosa hierárquica como material de eletrodo para supercapacitor
- Projetando Materiais Nanotubos de Carbono Simples e Compostos por Caracterização Porosimétrica
- Uma investigação em uma célula solar de silício cristalino com camada de silício preta na parte traseira



