Desenvolvimento de um espelho absorvedor de pontos quânticos de 1550 nm InAs / GaAs com uma estrutura de cobertura de superrede de curto período para aplicações de laser de fibra de femtosegundo
Resumo
Pontos quânticos III – V InAs / GaAs (QDs) de baixa dimensão foram aplicados com sucesso a espelhos absorvedores saturáveis de semicondutores (SESAMs) trabalhando em uma faixa de comprimento de onda de 900–1310 nm para aplicações de laser pulsado ultrarrápido, beneficiando-se de sua ampla largura de banda, flexibilidade de comprimento de onda, e fluência de baixa saturação. No entanto, é muito desafiador obter um QD-SESAM de alto desempenho trabalhando na faixa de comprimento de onda mais longa em torno de 1550 nm devido ao grande obstáculo ao crescimento de epitaxia das estruturas QD. Neste trabalho, pela primeira vez, é revelado que, o sistema InAs / GaAs QD projetado para a faixa de emissão de luz de 1550 nm, o processo de relaxação de portador muito fraco das camadas de capeamento (CLs) para QDs é o principal responsável pela baixo desempenho de emissão, de acordo com o qual desenvolvemos uma superrede de curto período (Em 0,20 Ga 0,80 Como / Em 0,30 Ga 0,70 As) 5 como o CL para os QDs e percebeu emissão ~ 10 vezes mais forte em 1550 nm em comparação com o CL InGaAs convencional. Com base na estrutura QD desenvolvida, QD-SESAMs de alto desempenho foram alcançados com sucesso, exibindo uma intensidade de saturação muito pequena de 13,7 MW / cm 2 e uma grande profundidade de modulação não linear de 1,6%, simultaneamente, o que permite a construção de lasers de fibra travada em modo femtossegundo de 1550 nm com excelente estabilidade de trabalho a longo prazo.
Introdução
Os lasers pulsados de femtossegundos com bloqueio de modo de 1550 nm têm amplas aplicações em comunicação óptica, ótica ultrarrápida e ótica não linear devido à sua alta potência de pico, baixo efeito térmico e alta energia de pulso [1,2,3,4,5] . O absorvedor saturável (SA) com ampla largura de banda óptica, tempo de resposta rápido e propriedades de baixa perda são o componente óptico crítico para tais lasers pulsados ultracurtos [6,7,8,9]. Além disso, o alto limite de dano do SA é altamente desejável para a operação estável a longo prazo de um laser de modo bloqueado [10,11,12,13]. Recentemente, materiais bidimensionais (2D), como grafeno, isoladores topológicos, fósforo negro e dichalcogenetos de metal de transição têm atraído muita atenção para sua aplicação como SAs para lasers pulsados de femtossegundo bloqueado em modo [14,15,16,17,18, 19,20,21]. No entanto, seu baixo limiar de danos e baixa estabilidade de trabalho têm dificultado severamente suas amplas aplicações [22, 23]. Os SESAMs baseados em poço quântico (QW) são considerados candidatos comerciais para lasers ultracurtos de modo bloqueado devido à sua alta repetibilidade e excelente estabilidade de operação, mas as larguras de banda de operação estreitas e a profundidade de modulação pequena ainda são as grandes barreiras para a realização do ultracurto de femtossegundo pulsos [24].
Recentemente, caracterizado com largura de banda de operação de placa e rápido tempo de recuperação de portadora [25,26,27,28,29,30,31], pontos quânticos de InAs auto-montados (QDs) crescidos através do modo Stranski-Krastanow surgiram como uma excelente escolha para SESAMs para construir lasers pulsados com bloqueio de modo. Para atingir o comprimento de onda de trabalho em torno de 1550 nm, geralmente são empregados os QWs InGaAsP baseados em InP. Os intervalos de banda de InGaAs QDs baseados em GaAs podem ser geralmente projetados para cobrir a faixa espectral de 980 a 1310 nm, e um comprimento de onda maior além de 1310 nm requer um conteúdo de índio muito maior nas camadas de cobertura QD (CLs). Ligas Quaternárias InGaAsSb (InGaNAs) e InGaAs CLs muito altos em% (> 30%) foram empregadas para projetar o bandgap QD em direção ao comprimento de onda longo de 1550 nm [32, 33]. No entanto, os CLs da liga quaternária complicam significativamente o processo de crescimento epitaxial, e o alto teor de In nos CLs InGaAs degrada a qualidade cristalina e óptica dos QDs, o que introduz mais centros de recombinação não radiativa. A emissão de 1550 nm foi obtida com InAs / GaAs QDs crescidos em substratos metamórficos, mas a baixa confiabilidade e repetibilidade permanecem como problemas graves para tal técnica [34]. Em nosso trabalho anterior, os QDs de InAs / GaAs assimétricos trabalhando em 1550 nm foram fabricados, pelo qual um oscilador de vidro dopado com Er de modo bloqueado foi obtido com largura de pulso de 2 ps [24]. E, recentemente, um QD-SESAM de 1550 nm com estrutura InAs / GaAs capeada por InGaAs foi fabricada, com a qual um laser de fibra dopada com érbio (EDF) Q-comutado passivamente de comprimento de onda duplo foi obtido [35]. No entanto, os desempenhos dos lasers obtidos foram limitados devido à pequena profundidade de modulação de 0,4% desses QD-SESAMs. Portanto, é altamente desejável explorar novas técnicas para otimizar as estruturas QD de InAs / GaAs de 1550 nm com o objetivo de aumentar a profundidade de modulação de tais QD-SESAMs.
Neste trabalho, desenvolvemos diferentes estruturas de QD de InAs / GaAs projetadas para SESAMs trabalhando em uma faixa de 1550 nm, com CLs de liga InGaAs e CLs de superrede de curto período (SSL) de InGaAs, respectivamente, e investigamos exaustivamente suas propriedades ópticas. A caracterização da espectroscopia de fotoluminescência (PL) revela emissão de luz muito fraca em temperatura ambiente (RT) no comprimento de onda em torno de 1550 nm, que não pode ser observada na temperatura inferior a 250 K. Este fenômeno está em notável contraste com o conhecido dependente da temperatura comportamentos dos sistemas QD, ou seja, a intensidade do PL é mais forte em temperaturas mais baixas, que fica muito fraca ou mesmo não observável no RT devido à excitação térmica dos portadores confinados nos QDs. Os fenômenos anormais observados nos QDs de InAs / GaAs de 1550 nm podem ser atribuídos ao processo de relaxamento de portadora fraca de CL para QDs, que pode ser reduzido significativamente pelo crescimento de um CL SSL para os QDs. As estruturas SSL fornecem modos de fônons abundantes de grandes densidades vibracionais de estados, que efetivamente aumentam o relaxamento da portadora dos CLs para os QDs. Portanto, uma emissão de 1550 nm 10 vezes mais forte do que os QDs não protegidos por SSL é observada. A dinâmica da portadora superior nos QDs de 1550 nm confere aos QD-SESAMs um desempenho de absorção altamente saturável, manifestado como uma intensidade de saturação muito pequena de 13,7 MW / cm 2 e uma maior profundidade de modulação não linear de 1,6% que é 4 vezes o valor relatado em [24, 35]. Beneficiando-nos do alto desempenho do QD-SESAM com SSL CLs, construímos com sucesso um laser EDF e alcançamos o lasing de modo estável em 1556 nm, com duração de pulso de 920 fs.
Métodos
Crescimento do MBE dos InAs / GaAs QDs
Três estruturas InAs / GaAs QD foram cultivadas com a técnica de epitaxia de feixe molecular (MBE). Todas as amostras contêm três períodos de camadas de pontos, cada uma das quais é montada automaticamente a partir de 2,9 monocamadas (MLs) InAs. Como mostrado na Fig. 1, nas amostras 1 e 2, os InAs QDs foram cultivados em GaAs e um In de 1 nm 0,18 Ga 0,82 Como camada tampão (BL), respectivamente, e todas cobertas com um In 0,33 de 6 nm de espessura Ga 0,67 Como camada. Para a amostra 3, os 2,9 MLs InAs QDs também foram cultivados em uma espessura de 1 nm In 0,18 Ga 0,82 Como BL, mas limitado por um SSL de 10 nm de espessura consistindo em 5 períodos de In 0,20 Ga 0,80 Como (1 nm) e em 0,30 Ga 0,70 Como camadas (1 nm). A temperatura e a taxa de crescimento dos InAs QDs foram 510 ° C e 0,01 ML / s, respectivamente. Os QD-SESAMs foram fabricados pelo crescimento de uma estrutura de camada de pontos em um Refletor Bragg Distribuído (DBR) inferior que contém 31 pares de GaAs não dopados (115 nm) e Al 0,98 Ga 0,02 Como camadas (134 nm). As temperaturas de crescimento para GaAs e InGaAs foram 565 e 530 ° C, respectivamente.
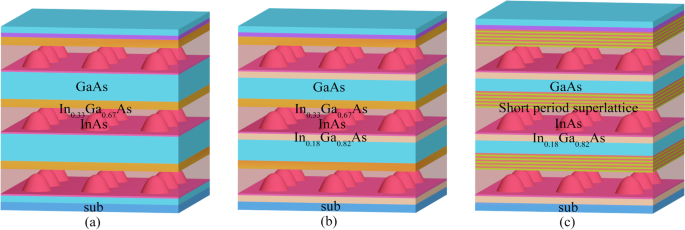
Diagramas esquemáticos de estruturas QD. Diagramas esquemáticos de três estruturas de teste de a amostra 1, b amostra 2 e c amostra 3, respectivamente
Métodos de caracterização
As medições de PL foram realizadas na faixa de temperatura variada de 11 a 300 K com um laser de estado sólido de 532 nm. As estruturas de cristalografia dessas amostras QD foram caracterizadas com difração de raios-X de alta resolução usando a linha de emissão Cu Kα. As morfologias das estruturas QD foram examinadas com a técnica de microscópio de força atômica (AFM) em condições ambientais sob um modo sem contato em uma dimensão nanoscópica TM Sistema 3100 SPM AFM. Imagens de microscopia eletrônica de transmissão (TEM) foram obtidas em um microscópio 200 KeV JEOL-2010.
Resultados e discussão
As Fig. 2a, b e c apresentam os espectros de PL dependentes da temperatura das amostras 1, 2 e 3, respectivamente, adquiridos nas temperaturas que variam de 11 a 300 K com a potência de excitação de 200 mW. Ele revela dois picos PL característicos, um pico estreito localizado na região do comprimento de onda curto e um pico largo no comprimento de onda longo. O pico estreito posicionado a cerca de 1170 nm a 11 K e cerca de 1280 nm a 300 K origina-se da luminescência dos CLs, enquanto o pico largo a cerca de 1550 nm a 300 K é atribuído à emissão QD. Conforme mostrado na Fig. 2a, nas temperaturas mais baixas, apenas a emissão de CL pode ser observada, e a emissão em torno de 1550 nm dos InAs QDs começa a aparecer quando a temperatura aumenta até 250 K e fica gradualmente mais forte com o aumento da temperatura . O comportamento semelhante também é observado com a amostra 2, conforme mostrado na Fig. 2b. Geralmente, para estruturas QD de InAs / GaAs projetadas para emissão de comprimento de onda mais curto (por exemplo, 1300 nm), a emissão de QDs domina os espectros PL em baixas temperaturas, e a emissão de CLs ou camadas umectantes dificilmente pode ser observada. Isso ocorre por causa dos níveis de energia mais baixos das estruturas QD e do escape térmico reduzido de portadores dos QDs em baixas temperaturas [36]. Com o aumento da temperatura, a intensidade de emissão de QDs diminui gradualmente devido ao aumento do escape térmico de portadores de QDs. Em notável contraste com os QDs de InAs / GaAs projetados para aplicações de 1310 nm, nossas amostras para 1550 nm exibem comportamentos de emissão de luz dependentes da temperatura completamente opostos, indicando dinâmica de portadora distinta neste novo sistema QD. Conforme representado na Fig. 2e, o bandgap dos QDs é muito mais estreito do que o dos CLs e os níveis de energia mais baixos para elétrons e buracos estão todos na estrutura QD e, portanto, espera-se que os portadores fotogerados possam preferencialmente residir nos QDs depois de relaxar suas energias excessivas. No entanto, o resultado de PL observado é que a emissão de CL domina a PL e a emissão de QD é invisível na temperatura inferior a 250 K, o que revela que, em baixas temperaturas, os portadores fotogerados estão predominantemente confinados nos CLs ao invés de os QDs. Este fato pode ser explicado pelos efeitos de bloqueio da relaxação de portadora severa de que há poucos fônons participando do processo de espalhamento de portadora, resultando na baixa eficiência de relaxamento das portadoras dos CLs para os QDs. Com o aumento da temperatura, mais populações de fônons são termicamente excitadas e a interação dos fônons com as portadoras fotogeradas é gradualmente aumentada, levando a mais portadoras espalhadas dos CLs para os QDs. A intensidade PL mais forte da emissão QD em 1550 nm aparecendo em RT indica que o processo de relaxamento de energia dos portadores de CLs para QDs domina o processo de escape térmico de QDs para CLs.

Caracterização de materiais e diagrama esquemático de bandas. Espectros PL medidos em 11-300 K de a amostra 1, b amostra 2 e c amostra 3, respectivamente. d Varreduras ω / 2θ de alta resolução mostrando o pico do substrato GaAs (008) e o padrão de difração CL para as amostras 1, 2 e 3, respectivamente. Diagrama esquemático de banda para e amostra 2 e f amostra 3, respectivamente
As caracterizações de PL das amostras 1 e 2 revelam que, no sistema InAs / GaAs QD projetado para aplicações de 1550 nm, existe uma característica de relaxamento de portadora ineficiente e maior densidade de fônons favorece o relaxamento de portadora até QDs. Essencialmente, o processo de relaxação da portadora fraca está enraizado nas estruturas de banda eletrônica determinadas pelo CL. Os materiais QD nos quais seus deslocamentos de banda são muito maiores do que as energias do fônon óptico longitudinal (LO) dos CLs e as portadoras nos CLs têm que relaxar para os níveis de QD por meio da emissão de vários fônons em vez de apenas um. O processo de relaxação de portadora fraca não pode ser eliminado nos QDs de InAs / GaAs para 1550 nm por causa do deslocamento de banda muito maior na estrutura de banda CL e QD, mas podemos modificar o processo de espalhamento de múltiplos fônons ajustando as estruturas de banda eletrônica, bem como as estruturas da banda de fônons. Para atingir este objetivo de aumentar o relaxamento da portadora nos QDs de 1550 nm, empregamos um (Em 0,20 Ga 0,80 Como / Em 0,30 Ga 0,70 As) 5 Estrutura SSL como os CLs para substituir os CLs InGaAs. Espera-se que os SSL CLs forneçam mais modos vibracionais de fônons e densidades de fônons muito maiores devido aos efeitos de dobramento da zona de Brillouin no SSL [37]. Como mostrado na Fig. 1c, a amostra 3 foi cultivada com a mesma estrutura da amostra 2, exceto o uso de cinco períodos de 10 nm de espessura em 0,20 Ga 0,80 Como / Em 0,30 Ga 0,70 Tão SSLs quanto CLs. A Figura 2d mostra os padrões de XRD obtidos para as amostras 1, 2 e 3. Todas as amostras exibem um pico forte em 66,1 °, que pode ser atribuído à difração dos (008) planos de GaAs cúbicos. Picos de satélite claros resultantes da espessura de 6 nm em 0,33 Ga 0,67 Como a estrutura CL é observada em cerca de 64,0 ° para as amostras 1 e 2. Uma inspeção adicional revela que em 0,20 Ga 0,80 Como / Em 0,30 Ga 0,70 Como SSL na amostra 3 exibe um pico de satélite em cerca de 64,4 ° e a mudança para graus maiores em relação ao de In 0,33 Ga 0,67 Como CLs sugere uma diminuição do conteúdo médio de In [38, 39]. Para entender o efeito de SSL CLs nas propriedades ópticas dos InAs / GaAs QDs, espectros de PL de dependência de temperatura para a amostra 3 também são medidos como mostrado na Fig. 2c. Semelhante às amostras 1 e 2, nenhuma emissão óbvia de PL em 1550 nm dos InAs / GaAs QDs pode ser observada em temperaturas abaixo de 200 K e a emissão torna-se gradualmente intensa com o aumento das temperaturas mais altas. É importante notar que o pico de emissão QD em 1550 nm na amostra 3 emerge a uma temperatura muito mais baixa de 200 K (cerca de 250 K para as amostras 1 e 2). Sua intensidade relativa com respeito à emissão de CL no RT é muito maior do que as amostras 1 e 2, e sua intensidade PL é cerca de 10 vezes mais forte do que a amostra 2. Esses resultados indicam que os CLs SSL aumentam muito o relaxamento da portadora dos CLs para o QDs, resultando em recombinação radiativa muito melhorada nos QDs. A razão responsável pelo relaxamento aprimorado da portadora dos CLs para os QDs está nos CLs SSL de alta qualidade com o conteúdo de índio reduzido. Isso efetivamente modula os comportamentos de relaxamento da portadora e melhora a captura de portadoras pelos QDs.
Para obter mais informações sobre o processo de espalhamento de portadoras facilitado por multi-fônons, as estruturas de banda do sistema InAs / GaAs QD com diferentes tipos de CLs são comparadas. Para fins de simplicidade, a diferença de energia entre os bandgaps CL e QD pode ser estimada como a diferença em suas energias de pico de PL. Como mostrado na Fig. 2e e f, as diferenças de bandgap na amostra 2 e 3 entre os QDs CL e InAs em 300 K são determinadas como 143 e 114 meV, respectivamente, de acordo com as medições de PL. Com a suposição de que os deslocamentos de banda são de aproximadamente 60% das diferenças energéticas entre as bandas de condução de CL e QDs [40], os elétrons devem relaxar 86 e 68 meV para a amostra 2 e amostra 3, respectivamente, para serem espalhados a partir dos níveis de energia do capeamento das camadas para os níveis de energia mais baixos dos QDs do InAs. As energias dos fônons dos modos LO e acústico longitudinal (LA) nas ligas InGaAs são 34 e 9 meV [40, 41]. Para o processo de espalhamento de múltiplos fônons, a combinação de 2 fônons LO na amostra 3 pode cumprir o espalhamento de um elétron dos CLs para QDs enquanto 2 fônons LO mais 1 fônons LO ou 2 LA são necessários para a amostra 2. Foi demonstrado que A taxa de relaxamento de elétrons é severamente reduzida quando mais modos de fônons estão envolvidos em um processo de espalhamento de múltiplos fônons [42,43,44,45]. Portanto, a taxa de relaxamento de elétrons na amostra 3 é maior do que na amostra 2, o que explica a intensidade PL muito aumentada dos QDs na amostra 3. Na verdade, o conteúdo de In diminuído nos CLs SSL e o efeito de gargalo de fônon enfraquecido no o processo de relaxamento do portador são as principais razões para a intensidade aumentada de PL dos QDs na amostra 3.
Para verificar ainda mais o efeito de relaxamento de portador aprimorado causado pelos CLs SSL, espectros de PL dependentes de energia de excitação foram adquiridos a 300 K. Como mostrado na Fig. 3a, b e c, a intensidade de PL do CL (Pico 1) e InAs Os picos de QD (pico 2) aumentam gradualmente com o aumento da potência de excitação, e nenhuma mudança óbvia das posições de pico pode ser observada. Observa-se claramente que a intensidade do Pico 1 é muito mais forte do que a do Pico 2 nas amostras 1 e 2, conforme mostrado na Fig. 3a e b na maior potência de excitação, enquanto a amostra 3 exibe uma emissão QD muito mais forte em todas as excitações medidas faixa de potência. As razões de intensidade PL do Pico 2 e Pico 1 dessas amostras em função da potência de excitação foram resumidas na Fig. 3d. Na potência de excitação de 2.000 mW, as razões de intensidade PL do Pico 2 e Pico 1 são de 0,21 e 0,29 correspondendo à amostra 1 e 2, respectivamente, como mostrado na Fig. 3d. Isso indica que muitos portadores se recombinam em InGaAs CL e o relaxamento do portador da camada de cobertura para os QDs de InAs é severamente prejudicado devido à taxa de relaxamento do portador ineficiente. Em comparação com a amostra 1, a razão de intensidade da camada de Pico 2 para Pico 1 na amostra 2 pode ser atribuída à densidade de pontos mais alta alcançada por mais centros de nucleação causados pelo In 0,18 Ga 0,82 Como camada de buffer [24]. A intensidade do Pico 2 na amostra 3 é cerca de 2,1 vezes mais forte do que a do Pico 1 na potência de excitação de 2.000 mW, indicando uma eficiência de relaxamento de portadora muito melhorada nos QDs de InAs com limite de SSL. Além disso, verificou-se que, embora o conteúdo médio de In seja de cerca de 25% na camada de cobertura SSL, que é menor do que 33% nos CLs das amostras 1 e 2, o comprimento de onda de emissão do pico 1 (em ~ 1337 nm) na amostra 3 é ligeiramente mais longo do que (em ~ 1310 nm) para as amostras 1 e 2. Acreditamos que a principal razão para os resultados é o efeito de confinamento quântico reduzido na camada SSL muito mais espessa (10 nm) em comparação com a camada de 6 nm Camada de cobertura InGaAs.

Medições de PL dependentes de energia. Espectros PL dependentes de energia da temperatura ambiente medidos em 20–2000 mW de a amostra 1, b amostra 2 e c amostra 3, respectivamente. d Rádio de intensidade de Pico 2 / Pico 1 versus potência de bombeamento nas amostras 1, 2 e 3, respectivamente.
Com base nas boas propriedades ópticas obtidas nos QDs de InAs / GaAs protegidos por SSL, demonstramos ainda sua aplicação como um QD-SESAM para geração de pulso de femtossegundo. O QD-SESAM de InAs / GaAs coberto por SSL de 1550 nm consiste em uma camada de QDs de InAs / GaAs protegidos por SSL como a camada de absorção e um espelho DBR inferior feito de 31 períodos de GaAs não dopados (115 nm) e Al 0,98 Ga 0,02 Como camadas (134 nm). A estrutura detalhada do QD-SESAM é ilustrada pela imagem TEM em corte transversal, conforme mostrado na Fig. 4. A densidade de pontos média dos QDs na camada de absorção é estimada em 4,4 × 10 10 cm -2 , e a altura média e o tamanho lateral do ponto são 7,5 e 40 nm, respectivamente, como visto na imagem AFM na Fig. 4. O SESAM é caracterizado com uma configuração típica de detector duplo balanceado [46] e uma intensidade de saturação de 13,7 MW / cm 2 e uma profundidade de modulação não linear de 1,6% são alcançadas. Conforme ilustrado na Fig. 4, com o QD-SESAM inserido na cavidade do laser EDF, construímos um laser de modo bloqueado passivamente. Com uma fibra monomodo padrão de 23,75 m e um EDF de 0,75 m como meio de ganho, a cavidade obtida tem 24,5 m de comprimento. Um diodo laser semicondutor DFB (LD) que emite a 980 nm serve como fonte de bomba, e um multiplexador de divisão de comprimento de onda (WDM) de 980/1550 nm é usado para acoplar a energia da bomba na cavidade do laser de fibra. Um isolador independente de polarização (PI-ISO) e um controlador de polarização (PC) são usados para garantir a transmissão unilateral da luz e otimizar o estado de bloqueio de modo na cavidade, respectivamente. A porta 1 de um circulador óptico de 1550 nm (CIR) está conectada ao PC, a porta 2 está conectada ao QD-SESAM e a porta 3 deste CIR está conectada ao acoplador de saída 10/90 (OC) (saída de 10% e 90% de entrada).
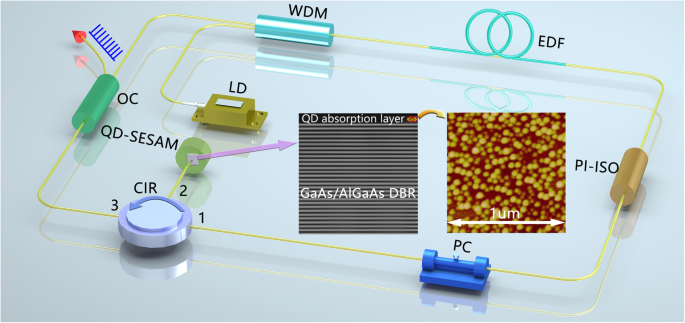
Configuração experimental de laser de fibra de modo bloqueado com QD-SESAM de 1550 nm. Detalhe:imagem TEM em seção transversal do QD-SESAM e 1 × 1 μm 2 Imagem AFM dos QDs de 1550 nm
O comportamento de bloqueio de modo pode ser alcançado quando a potência da bomba é superior a 50 mW. Conforme mostrado na Fig. 5a, a potência de saída deste laser de modo bloqueado aumenta linearmente com o aumento da potência da bomba e a eficiência do declive é de cerca de 4,82% determinada pelo tratamento de encaixe linear. Conforme apresentado na Fig. 5b, o espectro típico do soliton convencional com uma largura de banda de 3 dB de 3,2 nm foi observado. O comprimento de onda central é 1556 nm. O espectro de RF com taxa de repetição de 8,16 MHz é mostrado na Fig. 5c, correspondendo ao comprimento da cavidade de 24,5 m. A relação sinal-ruído é de cerca de 51 dB, indicando o grande potencial para atingir uma operação de bloqueio de modo estável com os QD-SESAMs de limitação de SSL. As medições de bloqueio de modo estável de longo tempo foram operadas com a potência da bomba limite de 50 mW, e mais de 1 semana de operação contínua estável foi alcançada. A Fig. 5d é o traço de autocorrelação equipado com um perfil de ajuste Gaussiano, que ilustra a duração real do pulso de aproximadamente 920 fs. Para comparação, com o QD-SESAM baseado na estrutura como na amostra 2 exibindo uma intensidade de saturação de 15,7 MW / cm 2 e uma profundidade de modulação não linear de 0,4%, e o laser de modo bloqueado gera pulsos de 2,7 ps de largura [47]. A duração de pulso muito reduzida alcançada com QDs protegidos por SSL baseados em QD-SESAM pode ser atribuída à profundidade de modulação aumentada, e acreditamos que a eficiência aprimorada de relaxamento de portadora induzida por camadas de cobertura SSL é responsável pela diminuição da intensidade de saturação. Além disso, cinco outros QD-SESAMs protegidos por SSL foram selecionados para construir os lasers de fibra de modo bloqueado, e todos os lasers de modo bloqueado exibiram estabilidade de longo prazo, pela qual a alta repetibilidade e confiabilidade dos SESAMs são demonstradas.

Características do modo bloqueado do laser de fibra desenvolvido. a Potência de saída versus potência da bomba. b Espectros ópticos de saída. c Espectro de RF do laser de fibra de modo bloqueado. d Traço de autocorrelação
Conclusões
Em conclusão, InAs / GaAs QDs projetados para aplicações de 1550 nm foram crescidos pela técnica MBE com camadas de liga InGaAs e SSL, respectivamente, como camadas de cobertura para QDs. Com a caracterização da espectroscopia PL dependente da temperatura e da potência, é revelado que o deslocamento da banda de condução das estruturas CL e QD é modificado de 86 meV para 68 meV alterando o In 0,33 Ga 0,67 Como liga CL a a (em 0,20 Ga 0,80 Como / Em 0,30 Ga 0,70 As) 5 SSL CL, e espalhamento de portadora envolvida por múltiplos fônons mais eficiente é, portanto, alcançado, o que leva a mais portadoras se recombinando radiativamente na estrutura QD e a emissão resultante significativamente melhorada em 1550 nm. O QD-SESAM desenvolvido com os QDs InAs / GaAs protegidos por SSL exibe uma intensidade de saturação muito melhorada de 13,7 MW / cm 2 e uma profundidade de modulação não linear de 1,6%, e uma duração de pulso de 920 fs é alcançada em um laser de fibra de modo bloqueado operando em 1556 nm construído com o QD-SESAM. O QD-SESAM desenvolvido com o design SSL como o CLs para QDs abrirá um novo caminho para lasers ultrarrápidos de alto desempenho.
Disponibilidade de dados e materiais
Os conjuntos de dados gerados e / ou analisados durante o presente estudo estão totalmente disponíveis sem restrição do autor correspondente, mediante solicitação razoável.
Abreviações
- 2D:
-
Bidimensional
- AFM:
-
Microscópio de força atômica
- BL:
-
Camada tampão
- CIR:
-
Circulador
- CLs:
-
Camadas de cobertura
- DBR:
-
Refletor Bragg Distribuído
- EDF:
-
Fibra dopada com érbio
- LA:
-
Acústica longitudinal
- LD:
-
Diodo laser
- LO:
-
Óptica longitudinal
- MBE:
-
Epitaxia de feixe molecular
- MLs:
-
Monocamadas
- OC:
-
Acoplador de saída
- PC:
-
Controlador de polarização
- PI-ISO:
-
Isolador independente de polarização
- PL:
-
Fotoluminescência
- QDs:
-
Pontos quânticos
- QW:
-
Bem quântico
- RT:
-
Temperatura
- SA:
-
Absorvedor saturável
- SESAMs:
-
Espelhos absorvedores saturáveis de semicondutores
- SSL:
-
Superrede de curto período
- TEM:
-
Microscopia eletrônica de transmissão
- WDM:
-
Multiplexador de divisão de comprimento de onda
Nanomateriais
- Emissão multicolor da estrutura ultravioleta de nanopiramida quasicristal fotônica baseada em GaN com InxGa1 semipolar − xN / GaN vários poços quânticos
- Fonte de fóton único brilhante a 1,3 μm com base no ponto quântico InAs Bilayer no micropilar
- Detectando Exciton Espacialmente Localizada em Superredes de Pontos Quânticos Auto-Organizados InAs / InGaAs:Uma Forma de Melhorar a Eficiência Fotovoltaica
- Efeitos bipolares na fotovoltagem de heteroestruturas de pontos quânticos de InAs / InGaAs / GaAs metamórficos:soluções de caracterização e design para dispositivos sensíveis à luz
- Controle eletroquímico reversível sobre luminescência fotoexcitada do filme de pontos quânticos do núcleo / casca / ZnS
- Desempenho fotovoltaico de uma célula solar nanofio / ponto quântico híbrido de nanoestrutura
- Eliminação do tamanho bimodal em pontos quânticos InAs / GaAs para preparação de lasers de pontos quânticos de 1,3 μm
- Estimulação de cisteína revestida com CdSe / ZnS Quantum Dot Luminescência por meso-Tetrakis (p-sulfonato-fenil) Porfirina
- Diodos emissores de luz ultravioleta baseados em AlGaN quase isentos de eficiência com uma camada de bloqueio de elétrons tipo p de superrede especificamente projetada para alta eficiência de dopag…
- Síntese e propriedades de pontos quânticos de CdTe com liga de Mn com emissão de azul solúvel em água



