Comportamentos de programação dependentes da polaridade da voltagem da memória amorfa do transistor de filme fino In – Ga – Zn – O com um trapping de carga de ZnO depositado na camada atômica Camada
Resumo
As memórias amorfas de transistor de filme fino (TFT) In-Ga-Zn-O (a-IGZO) estão atraindo muitos interesses para futuras aplicações de sistema em painel; no entanto, eles geralmente exibem uma baixa eficiência de apagamento. Neste artigo, investigamos os comportamentos de programação dependentes da polaridade da voltagem de uma memória TFT a-IGZO com uma camada de captura de carga de ZnO depositada na camada atômica (CTL). Os dispositivos pristine demonstram características eletricamente programáveis não apenas sob polarização de porta positiva, mas também sob polarização de porta negativa. Em particular, o último pode gerar uma eficiência de programação muito maior do que o primeiro. Ao aplicar um pulso de polarização de porta de +13 V / 1 μs, o dispositivo mostra uma mudança de tensão de limiar (ΔV th ) de 2 V; e o ΔV th é tão grande quanto −6,5 V para um pulso de polarização de porta de −13 V / 1 μs. No caso de programação de 12 V / 1 ms (P) e apagamento de −12 V / 10 μs (E), uma janela de memória tão grande quanto 7,2 V pode ser alcançada em 10 3 de ciclos P / E. Comparando os ZnO CTLs recozidos em O 2 ou N 2 com o as-depositado, conclui-se que a vacância de oxigênio (V O Os defeitos relacionados a) dominam as características de programação bipolar dos dispositivos de memória TFT. Para programar na tensão de porta positiva, os elétrons são injetados do canal IGZO na camada de ZnO e preferencialmente presos em níveis profundos de vacância de oxigênio ionizado individualmente (V O + ) e vacância de oxigênio duplamente ionizado (V O 2+ ) Com relação à programação na tensão de porta negativa, os elétrons são facilmente retirados das vacâncias de oxigênio neutro por causa de doadores rasos e túneis de volta ao canal. Isso, portanto, leva a um apagamento altamente eficiente pela formação de vacâncias de oxigênio ionizado adicionais com cargas positivas.
Histórico
Um transistor de filme fino (TFT) baseado em óxido de índio-gálio-zinco amorfo (a-IGZO) foi extensivamente estudado para a aplicação em sistemas eletrônicos transparentes e flexíveis [1,2,3,4,5,6,7 , 8,9,10,11,12]. Isso é atribuído a algumas propriedades específicas dos filmes a-IGZO, como boa uniformidade, baixa temperatura de processamento, transparência à luz visível e alta mobilidade de elétrons [13]. Além disso, memórias não voláteis a-IGZO TFT também foram propostas, e sua capacidade de armazenamento de dados não voláteis expande o escopo de utilização do dispositivo a-IGZO TFT. Como uma arquitetura típica de dispositivos de memória não volátil, uma memória TFT a-IGZO com portas flutuantes tem sido intensamente investigada nos últimos anos. Até agora, vários materiais foram explorados como uma porta flutuante (ou seja, meio de armazenamento de carga), como dielétricos [14, 15], nanocristais de metal [16, 17] e materiais semicondutores [18,19,20,21] . Como a-IGZO é um semicondutor natural do tipo n, e a inversão de orifícios dificilmente é realizada em um a-IGZO TFT sob uma polarização de porta negativa, portanto, as memórias a-IGZO TFT geralmente têm uma eficiência de apagamento pobre. Em outras palavras, a maioria das memórias TFT a-IGZO não podem ser apagadas eletricamente através da injeção do orifício do canal [14,15,16]. No entanto, Zhang et al. [21] fabricaram uma memória TFT usando a-IGZO como a camada de captura de carga (CTL) e a camada de canal, que exibia características eletricamente programáveis e apagáveis, bem como boa retenção de dados. Enquanto isso, Yun et al. também investigou as características das memórias a-IGZO TFT com diferentes IGZO CTL composicionais, revelando uma janela de memória decrescente com o aumento de O 2 pressão parcial (P O2 ) durante a deposição por pulverização catódica do CTL [18]. Além disso, Bak et al. relataram o desempenho das memórias TFT a-IGZO com vários CTLs de ZnO de condutividade e inferiram que a natureza eletrônica otimizada da estrutura de bandgap para o CTL ZnO poderia ser um dos fatores mais importantes para realizar memórias TFT de óxido altamente funcionais [20]. Embora as memórias a-IGZO TFT baseadas em CTL de semicondutor de óxido acima mencionadas exibam velocidades de programação / apagamento elétricas superiores, as características de programação bipolar dos dispositivos mencionados acima não foram relatadas, e os processos de captura correspondentes de diferentes cargas no CTL de semicondutor de óxido não são claro ainda, especialmente para a captura de cargas positivas.
Neste trabalho, uma memória TFT a-IGZO programável bipolar foi fabricada usando um filme de ZnO depositado em camada atômica como um CTL. Ao comparar as características de programação bipolar dos dispositivos de memória TFT com as depositadas, O 2 - ou N 2 - CTLs ZnO recozidos, os processos de captura de diferentes cargas na camada de ZnO foram discutidos. É revelado que os defeitos relacionados à vacância de oxigênio dominam as características de programação bipolar dos dispositivos de memória TFT a-IGZO.
Métodos
As bolachas de Si tipo P (100) com resistividade de 0,001–0,005 Ω cm foram limpas usando o processo de limpeza RCA padrão e usadas como porta traseira do dispositivo. Então, 35 nm Al 2 O 3 e filmes de ZnO de 20 nm foram depositados sucessivamente por deposição de camada atômica (ALD) a 250 ° C e 200 ° C, que serviram como camada de bloqueio e CTL da memória TFT, respectivamente. Vale ressaltar que o filme de ZnO tem uma rugosidade quadrática média (RMS) de 0,553 nm. Posteriormente, fotolitografia e corrosão úmida foram realizadas para definir o CTL de ZnO. Depois disso, um Al 2 de 8 nm O 3 a camada de tunelamento foi desenvolvida por ALD. Os precursores do dietilzinco (DEZ) / H 2 O e TMA / H 2 O foram usados para o crescimento de ZnO e Al 2 O 3 filmes, respectivamente. Depois disso, um filme de a-IGZO de 40 nm foi depositado por pulverização catódica de magnetron de radiofrequência como uma camada de canal em temperatura ambiente usando um InGaZnO 4 alvo. O canal ativo com largura (W) / comprimento (L) de 100/10 μm foi então definido por fotolitografia e ataque ácido com HCl diluído. Os contatos da fonte e do dreno de Ti / Au (30 nm / 70 nm) foram formados por evaporação de feixe eletrônico seguido por um processo de lift-off. Finalmente, todos os dispositivos fabricados foram recozidos a 250 ° C em O 2 por 5 min para melhorar seu desempenho. As caracterizações elétricas foram realizadas em analisador de parâmetros semicondutores (Agilent B1500A) em temperatura ambiente. A tensão limite (V th ) é definido como a tensão da porta na qual a corrente de dreno é igual a W / L × 10 −9 A. A concentração de portadores dos filmes de ZnO foi extraída das medições do efeito Hall (Ecopia HMS-3000) à temperatura ambiente.
Resultados e discussão
A Figura 1 mostra os diagramas esquemáticos do dispositivo de memória TFT a-IGZO fabricado sob programação de polarização positiva e negativa, respectivamente. Durante a programação elétrica, um pulso elétrico é aplicado na porta traseira e os eletrodos da fonte e do dreno são aterrados. A Figura 2 mostra as características de programação dos dispositivos de memória pristine sob diferentes condições. Para o dispositivo de memória primitiva, ele exibe uma relação de corrente liga / desliga ( I em / eu desligado ) de 1,5 × 10 7 , mobilidade de efeito de campo de 7,1 cm 2 V −1 s −1 , e uma oscilação subliminar (SS) de 0,67 V / dec. Em termos de programação de 80 ms em diferentes vieses positivos, o I d - V g curva se move gradualmente na direção de uma tendência positiva como uma função da tensão de programação, por exemplo, o V th resultante mudança em relação ao dispositivo original (ΔV th ) aumenta de 1,3 para 4,8 V com o aumento da tensão de programação de 8 para 13 V, exibindo saturação de programação em 12 V, conforme mostrado na Fig. 2a. Um ΔV th tão significativo sugere que elétrons consideráveis do canal a-IGZO tipo n são injetados no CTL ZnO. Além disso, quando a tensão de programação é fixada em 13 V, o ΔV th aumenta lentamente de 2 para 3,1 V com prolongamento do tempo de programação de 1 μs a 30 ms, conforme mostrado na Fig. 2c. Curiosamente, quando o dispositivo de memória primitiva é programado em uma polarização de porta negativa, o V th exibe uma mudança notável em direção a uma polarização negativa, mostrada na Fig. 2b. Para tempo de programação constante de 80 ms, o ΔV th aumenta de −5,2 para −7,4 V com o aumento da polarização de programação de −8 para −13 V. Mesmo se o dispositivo de memória original for programado em -13 V para 1 μs, ele também pode demonstrar um ΔV th tão grande quanto -6,5 V, mostrado na Fig. 2d. Isso significa que um grande número de elétrons são retirados do CTL, resultando, portanto, no restante de uma abundância de cargas positivas.
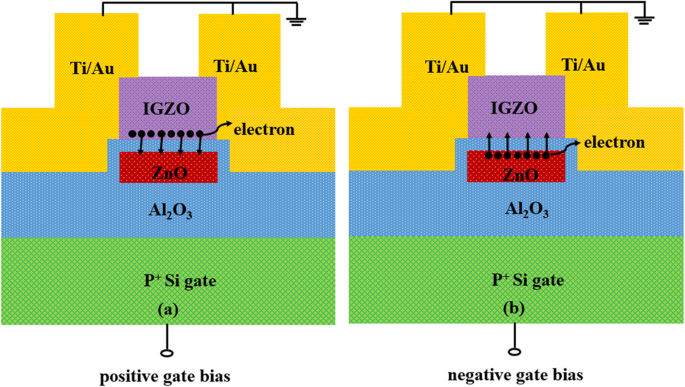
Os diagramas esquemáticos de seção transversal do dispositivo de memória TFT a-IGZO programado sob uma polarização de porta positiva ( a ) e uma polarização de porta negativa ( b ), respectivamente.
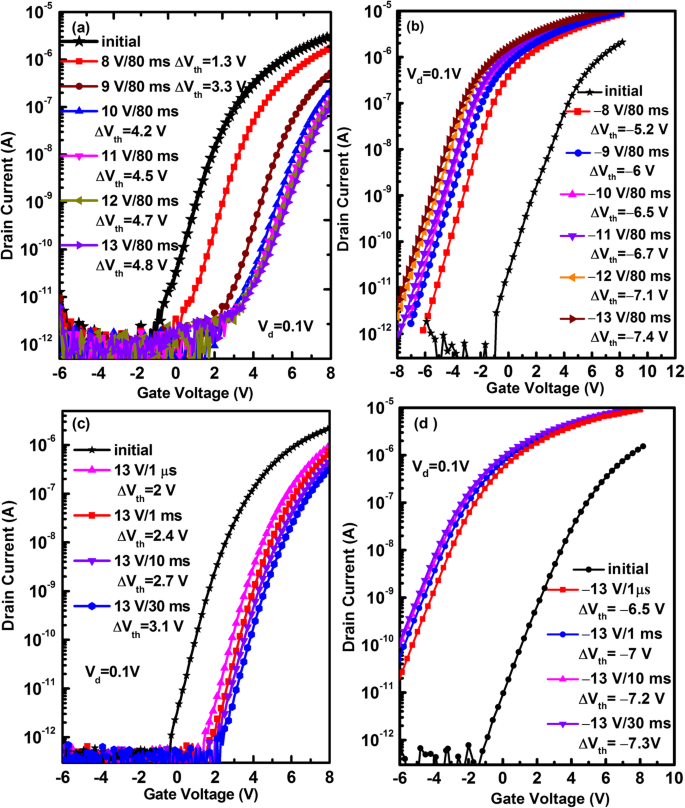
As curvas de transferência do dispositivo de memória TFT a-IGZO e aquelas programadas a em vários enviesamentos de portão positivo por um tempo constante de 80 ms, b em várias polarizações de porta negativa por um tempo constante de 80 ms, c a 13 V para vários tempos de programação e d a -13 V para vários tempos de programação. Todas as curvas de transferência de cada figura foram medidas no mesmo dispositivo, e todas as operações de programação foram realizadas em sequência.
Para entender o efeito de captura de carga da camada de ZnO, a-IGZO TFTs sem ZnO CTL também são fabricados como dispositivos de controle para comparação. A Figura 3 mostra as características de transferência dos dispositivos de controle ao serem programados sob diferentes polarizações positivas e negativas, respectivamente. Verificou-se que o dispositivo não exibe um ΔV th discernível independentemente da polaridade e amplitude da tensão de programação. Isso indica que o supracitado distinto ΔV th para os dispositivos de memória deve ser atribuído ao ZnO CTL. Por outro lado, observa-se que IGZO é um semicondutor natural do tipo n, portanto, elétrons no canal IGZO podem ser facilmente injetados no CTL ZnO sob uma polarização de porta positiva (por exemplo, . , +9 V). Porém, quando um viés de programação negativo é aplicado ao eletrodo de porta do dispositivo, o canal a-IGZO tende a se esgotar, e a condução do orifício dificilmente é alcançada [15]. Nesse caso, o dispositivo não pode ser programado por meio de injeção de orifício do canal e, portanto, a possibilidade única de programação elétrica deve ser realizada por destravamento de elétrons intrínsecos no CTL ZnO prístino. Na verdade, nossos resultados experimentais indicam que o dispositivo pode ser facilmente programado sob polarização de porta negativa, ver Fig. 2d. A Figura 4 mostra as características de resistência da memória em função dos ciclos de programação / apagamento (P / E). O dispositivo exibe uma janela de memória de 3,7 V por 10 3 de ciclos P / E no caso de programação de 11 V / 1 ms e apagamento de −9 V / 10 μs. Além disso, uma janela de memória tão grande quanto 7,2 V pode ser alcançada em 10 3 de ciclos P / E em relação à programação de 12 V / 1 ms e apagamento de −12 V / 10 μs. A Tabela 1 compara as características de programação e apagamento de várias memórias TFT a-IGZO [14, 22, 23]. Comparado a outros dispositivos, nosso dispositivo exibe uma eficiência de apagamento muito maior, mesmo sob uma polarização mais baixa (−12 V) e um tempo muito mais curto (10 μs), apesar da não superioridade notável na eficiência de programação.
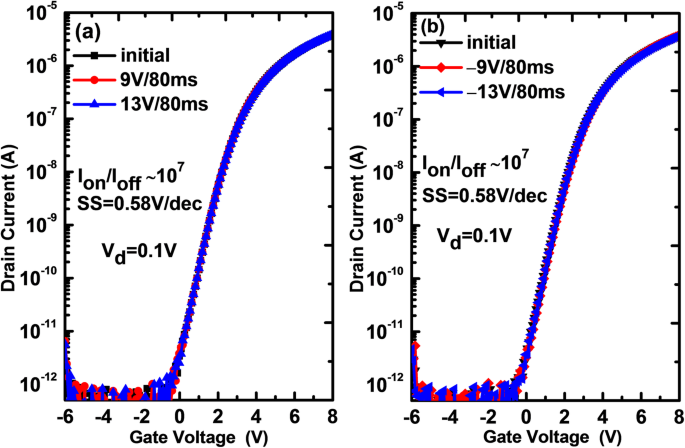
As curvas de transferência do dispositivo a-IGZO TFT e aquelas programadas a em polarizações de porta positiva diferentes por um tempo constante de 80 ms e b em polarizações de porta negativa diferentes por um tempo constante de 80 ms
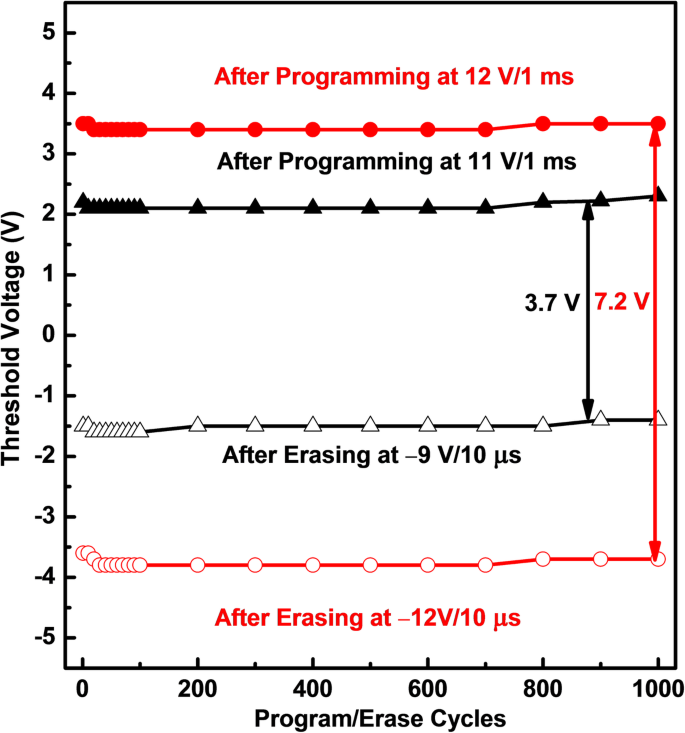
As características de resistência do dispositivo de memória TFT a-IGZO em função dos ciclos P / E
Para esclarecer a origem dos elétrons retirados do CTL ZnO prístino, vários CTLs ZnO processados são comparados nos dispositivos de memória TFT a-IGZO. A Figura 5 mostra a dependência da tensão de programação de △ V th para os dispositivos com diferentes ZnO CTLs. Observa-se que, para os dispositivos de memória com o as-depositado e N 2 - CTLs ZnO recozidos, o ΔV th resultante exibe uma tendência de aumento semelhante com o aumento da tensão de programação, apesar das polaridades de tensão. No entanto, para o dispositivo de memória com o O 2 - recozido ZnO CTL, o valor absoluto de ΔV th mostra uma diminuição significativa sob a mesma condição de programação, por exemplo, o valor absoluto de ΔV th diminui em 2 e 3 V, respectivamente, no caso de pulsos de programação de 13 V / 80 ms e −12 V / 1 μs. Além disso, comportamentos de programação saturados são observados para o O 2 - ZnO CTL recozido no caso de enviesamentos de porta positivos e negativos. Isso deve ser atribuído a armadilhas limitadas no CTL. Em uma palavra, o pós-recozimento em O 2 a 250 ° C reduz o número de centros de captura no filme de ZnO, levando a uma diminuição na capacidade de captura de carga.

As mudanças de tensão de limiar dos dispositivos de memória TFT a-IGZO com diferentes camadas de captura de carga ZnO processadas como uma função de a tensão de programação positiva para tempo de programação constante de 80 ms e b tensão de programação negativa para tempo de programação constante de 1 μs. Para cada condição, cinco dispositivos foram medidos.
Para investigar a influência do pós-recozimento nas propriedades do filme de ZnO, os filmes de ZnO como depositado e processado são caracterizados por medições de efeito Hall e XPS. Conforme mostrado na Fig. 6, o filme de ZnO recozido em N 2 a 250 ° C mostra uma concentração de portador de 4,4 × 10 19 cm −3 , que é muito próximo disso (4,5 × 10 19 cm −3 ) do filme ZnO depositado; no entanto, o filme ZnO recozido em O 2 a 250 ° C exibe uma diminuição notável na concentração de transportador, que é igual a 1,8 × 10 18 cm −3 . É relatado que os doadores intrínsecos em filmes semicondutores de ZnO do tipo n são vacâncias de oxigênio [24]. Kwon et al. também relataram que a razão atômica O / Zn no filme ALD ZnO diminuiu gradualmente de 0,90 para 0,78 com o aumento da temperatura de deposição de 70 para 130 ° C [25]. Isso revela a existência de vacâncias de oxigênio nos filmes ALD ZnO. Portanto, o O 2 - a redução induzida pelo recozimento na concentração do portador (elétron) deve estar relacionada à redução das vacâncias de oxigênio no filme de ZnO. Além disso, os espectros O1s XPS de alta resolução do filme ZnO depositado e aqueles recozidos em N 2 ou O 2 são analisados, como mostrado na Fig. 7. Os três picos deconvoluídos são centralizados em 530,0, 531,6 e 532,4 eV, correspondendo a O 2− íons ligados com Zn 2+ (O1), vacâncias de oxigênio (O2) e elemento de oxigênio adsorvido quimicamente (–OH, etc.) (O3), respectivamente [26]. Comparado com o filme ZnO depositado, o pós-recozimento em O 2 gera uma diminuição de 2,1% no percentual relativo de O2. No entanto, para o filme ZnO recozido em N 2 , a porcentagem relativa de O2 é quase inalterada. Esses resultados indicam que o O 2 o recozimento pode passivar as vacâncias de oxigênio no filme ZnO, mas o N 2 o recozimento não pode fazer. Isso confirma ainda mais a correlação entre as vacâncias de oxigênio e a concentração de portadores.

As concentrações de portadores do filme de ZnO conforme depositado e aqueles recozidos sob diferentes condições.
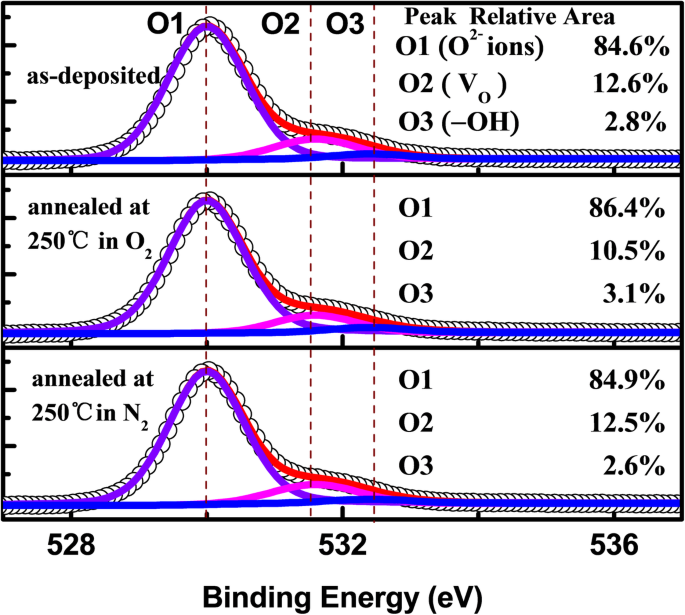
Espectros O1s XPS de alta resolução do filme ZnO conforme depositado e aqueles recozidos a 250 ° C em O 2 e N 2 , respectivamente. O1 e O2 correspondem a O 2− íons ligados com Zn 2+ e vagas de oxigênio, respectivamente. O3 é atribuído ao elemento de oxigênio adsorvido quimicamente (–OH, etc.). Para remover acidentalmente contaminantes da superfície, todas as amostras foram gravadas com bombardeio de íons de Ar in situ
Com base nos resultados experimentais mencionados, pode-se concluir que as características de programação dos dispositivos de memória primitiva são dominadas pela concentração de defeitos relacionados à vacância de oxigênio no CTL ZnO. Em outras palavras, as lacunas de oxigênio no filme ZnO servem principalmente como centros de captura para a captura de cargas positivas e negativas. É relatado que os defeitos relacionados à vacância de oxigênio em ZnO incluem vacância de oxigênio neutro (V O ), vacância de oxigênio ionizado isoladamente (V O + ), e vacância de oxigênio duplamente ionizado (V O 2+ ), cujos níveis de energia estão localizados em 0,02–0,04, 0,3–0,45 e 0,61 eV, respectivamente, abaixo da banda de condução mínima de ZnO [27, 28]. Uma vez que o filme de ZnO depositado mostra uma alta concentração de elétrons em nosso caso, a concentração de vacâncias de oxigênio neutro servindo como doadores superficiais deve ser muito maior do que a de vacâncias de oxigênio ionizado (V O + e V O 2+ ) Em termos de programação em uma polarização de porta positiva, os elétrons na camada de acumulação do canal a-IGZO são injetados na camada de ZnO pelo mecanismo de tunelamento de Fowler-Nordheim (FN), que é demonstrado por um ΔV th
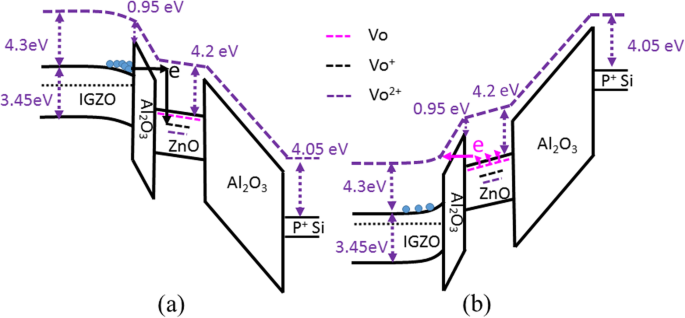
Diagramas de banda de energia dos dispositivos de memória TFT a-IGZO programados em a um viés de portão positivo e b uma polarização de porta negativa, respectivamente. V o , V o + , e V o 2+ denotam vacância de oxigênio neutro, vacância de oxigênio unicamente ionizado e vacância de oxigênio duplamente ionizado, respectivamente
Conclusões
Em resumo, fabricamos uma memória TFT a-IGZO programável bipolar com um CTL ZnO depositado na camada atômica. Em comparação com a programação sob uma polarização de porta positiva, a programação sob uma polarização de porta negativa pode gerar uma eficiência muito maior. Isso ocorre porque diferentes defeitos de vacância de oxigênio entram em vigor durante a programação dependente da polaridade da tensão. Ou seja, defeitos profundos de V O + e V O 2+ desempenham um papel fundamental para o aprisionamento de elétrons durante a programação de polarização positiva e defeitos superficiais de V O principalmente doar elétrons durante a programação de polarização negativa, resultando na geração de vagas de oxigênio carregadas positivamente.
Disponibilidade de dados e materiais
Os conjuntos de dados que apoiam as conclusões deste manuscrito estão incluídos no manuscrito.
Abreviações
- a-IGZO:
-
Óxido de índio-gálio-zinco amorfo
- ALD:
-
Deposição de camada atômica
- CTL:
-
Camada de trapping de carga
- TFT:
-
Transistor de filme fino
- XPS:
-
espectroscopia de fotoelétrons de raios-X
Nanomateriais
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Células solares de perovskita invertida altamente eficientes com camada de transporte de elétrons CdSe QDs / LiF
- Uma investigação em uma célula solar de silício cristalino com camada de silício preta na parte traseira
- Melhoria do desempenho do dispositivo a-IGZO TFT usando um processo de interface limpa por meio de nanocamadas Etch-Stopper
- Resistência de contato reduzida entre metal e n-Ge por inserção de ZnO com tratamento de plasma de argônio
- Efeito da bicamada CeO2 − x / ZnO e ZnO / CeO2 − x heteroestruturas e polaridade de eletroformação nas propriedades de comutação da memória não volátil
- Investigação da banda de energia em ZnO / β-Ga2O3 depositado na camada atômica (\ (\ overline {2} 01 \)) Heterojunções
- Transistor de semicondutor de óxido metálico difundido duplo e lateral de resistência ultrabaixa específica com porta dupla aprimorada e camada P-enterrada parcial
- Python - Programação de extensão com C



