Efeitos bipolares na fotovoltagem de heteroestruturas de pontos quânticos de InAs / InGaAs / GaAs metamórficos:soluções de caracterização e design para dispositivos sensíveis à luz
Resumo
O efeito bipolar do substrato GaAs e das camadas próximas na fotovoltagem de estruturas verticais InAs / InGaAs metamórficas em comparação com estruturas pseudomórficas (convencionais) de pontos quânticos InAs / GaAs (QD) foram estudados. Ambas as estruturas metamórficas e pseudomórficas foram crescidas por epitaxia de feixe molecular, usando contatos de fundo em qualquer n + -buffers ou o substrato GaAs. As características relacionadas a QDs, camadas de umedecimento e tampões foram identificados nos espectros fotoelétricos de ambas as estruturas de contato com o tampão, enquanto os espectros de amostras em contato com o substrato mostraram o início adicional atribuído aos centros de defeito EL2. As amostras em contato com o substrato demonstraram fotovoltagem bipolar; sugeriu-se que isso ocorresse como resultado da competição entre os componentes relacionados aos QDs e suas camadas de revestimento com os defeitos relacionados ao substrato e a camada mais profunda crescida. Nenhum efeito de substrato direto foi encontrado nos espectros das estruturas de contato com o tampão. No entanto, uma influência negativa notável do n + Camada tampão -GaAs no sinal de fotovoltagem e fotocondutividade foi observada na estrutura InAs / InGaAs. Analisando os resultados obtidos e os cálculos realizados, fomos capazes de fornecer insights sobre o projeto de estruturas QD metamórficas, que podem ser úteis para o desenvolvimento de novos dispositivos fotônicos eficientes.
Histórico
Nas últimas duas décadas, materiais compósitos contendo nanoestruturas semicondutoras encontraram grande uso em aplicações fotônicas devido à sensibilidade à luz, facilidade e baixo custo de fabricação, sintonia espectral e emissão altamente eficiente com vida curta [1,2,3,4,5 ] Em (Ga) As heteroestruturas de ponto quântico (QD) são uma classe importante de nanoestruturas sensíveis ao infravermelho, que tem sido amplamente empregada em vários dispositivos fotônicos, como lasers [2, 6], fontes de fóton único [7, 8], fotodetectores [9,10,11,12,13] e células solares [14,15,16]. Numerosas investigações foram dedicadas a melhorar as propriedades fotoelétricas de tais dispositivos sensíveis à luz. Por exemplo, a faixa de fotossensibilidade pode ser estendida através da excitação por meio de bandgap intermediário [17, 18] ou geração múltipla de excitons [19, 20], de modo que as eficiências de conversão de energia de células solares baseadas em QD podem exceder, em teoria, os limites de uma única células solares de banda larga [21]. Os métodos de balanceamento de deformações [22] e técnica de gerenciamento de desajuste [23], bem como o recozimento térmico [24] são utilizados para reduzir deformações nessas estruturas, operando a faixa de trabalho [25], bem como aumentando a fotorresposta devido ao supressão de defeitos relacionados à deformação [26] que podem atuar como centros de recombinação.
Um método eficiente para a redução da deformação é baseado no crescimento de um buffer metamórfico (MB) InGaAs em vez do GaAs convencional. Como resultado, as estruturas de QD de InAs / InGaAs atraíram muito interesse na última década [27,28,29]. Ao aumentar os QDs no MB InGaAs, pode-se observar diferenças essenciais no processo de formação e nas propriedades ópticas de QD em comparação com as convencionais na matriz de GaAs [25, 30,31,32,33]. Por exemplo, a camada de confinamento InGaAs reduz a incompatibilidade de rede entre QDs e buffer e, portanto, as cepas em QDs. Como resultado, o bandgap de InAs é reduzido e um aumento significativo no comprimento de onda de emissão é observado [34]. A aplicação do MB como um material de confinamento permite deslocar seu valor para a janela de telecomunicações em 1,3 e 1,55 μm [28, 29, 35, 36].
Da mesma forma, tem havido tentativas esperançosas de aplicar as propriedades fotoelétricas das estruturas metamórficas InAs QD no projeto de dispositivos sensíveis à luz como fotodetectores infravermelhos metamórficos [11,12,13] e células solares [37,38,39]. Alguns estudos foram realizados para desenvolver projetos de estruturas [25, 31,32,33] e outros para melhorar as propriedades fotoelétricas [39, 40]. As investigações estão acontecendo para reduzir as deformações nas heteroestruturas [34, 41], pois isso leva a uma melhoria substancial na densidade da fotocorrente e na resposta espectral das células solares [39, 40], bem como na eficiência de fotoemissão de tais estruturas [ 29, 32, 42].
O desenvolvimento de dispositivos sensíveis à luz requer um estudo aprofundado das propriedades fotoelétricas. Os estudos de fotovoltagem (PV) ou fotocondutividade (PC) são uma ferramenta ideal para a determinação da fotorresposta em função da energia luminosa, transições entre níveis, transporte de portadores e faixa de operação do dispositivo [10, 43, 44]. No entanto, apesar de alguns estudos das propriedades fotoelétricas de estruturas com QDs de InAs metamórficos terem sido realizados nos últimos anos [37,38,39, 43], aspectos completos do mecanismo de fotorresposta ainda permanecem obscuros, assim como a influência do MB nas propriedades das nanoestruturas. Em particular, os efeitos do substrato GaAs e interfaces relacionadas nos espectros fotoelétricos de estruturas QD de InAs / InGaAs / GaAs não foram explorados em detalhes. Embora esforços significativos sejam dedicados para evitar a influência do substrato, a fotorresposta é afetada tanto pelo substrato quanto pelas camadas próximas crescidas por epitaxia de feixe molecular (MBE). Assim, enquanto a geometria de contato aplicada é para reter as camadas inferiores e substrato eletricamente inativo, um efeito negativo notável deles em PV e fotocorrente foi detectado por nós em uma investigação anterior [43]. Muito recentemente, comparamos as propriedades fotoelétricas do metamórfico InAs / In 0,15 Ga 0,85 Como estrutura de QD com aqueles de um QD de InAs / GaAs padrão e descobriu que a fotocorrente de InAs / In metamórfico 0,15 Ga 0,85 As heteroestruturas não foram afetadas por níveis relacionados a defeitos nas proximidades de QD [45]. Além disso, concluiu-se que dispositivos fotônicos eficientes em 1,3 μm podem ser desenvolvidos com nanoestruturas semelhantes como um material ativo.
Neste trabalho, continuamos o estudo das propriedades fotoelétricas das heteroestruturas com InAs QDs embutidos no In 0,15 metamórfico Ga 0,85 Como ou buffers de GaAs convencionais, com foco no efeito do substrato de GaAs e camadas de MBE próximas. A fim de alcançar uma compreensão clara do papel do substrato e das camadas tampão, consideramos as estruturas com contatos de fundo no (i) In 0,15 Ga 0,85 Como camada tampão ou (ii) o substrato GaAs inferior (ver Fig. 1). Assim, dependendo da seleção do contato inferior, a corrente fluiu através de (i) apenas os QDs e camadas de buffer e (ii) a estrutura completa incluindo os substratos e suas interfaces com as camadas MBE. A análise dos resultados e cálculos nos permitiu fornecer uma visão sobre o melhor projeto para sensores de luz em estruturas QD metamórficas.
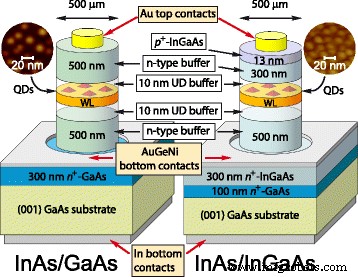
(Color online) esquemas do metamórfico InAs / In 0,15 Ga 0,85 Como / si -GaAs (direita) e InAs / GaAs / si -GaAs (esquerda) Amostras QD investigadas; Imagens AFM das estruturas sem cobertura são mostradas
Métodos
As estruturas foram preparadas por MBE em (001) semi-isolante ( si ) Substratos de GaAs. Os substratos eram n -tipo, com valores de 3 × 10 7 cm −3 concentração de portador residual, espessura de 500 μm e uma resistividade de 2 × 10 7 Ω × cm. As estruturas metamórficas InAs / InGaAs QD consistem em (i) 100 nm n + Camada tampão -GaAs crescida a 600 ° C, (ii) 300 nm de espessura n + -Em 0,15 Ga 0,85 Como MB com n =5 × 10 18 cm −3 cultivado a 490 ° C, (iii) 500 nm de espessura n -Em 0,15 Ga 0,85 Como MB com n =3 × 10 16 cm −3 cultivado a 490 ° C, (iv) 3,0 monocamadas (MLs) de QDs de InAs auto-montados incorporados em um In de 20 nm não dopado 0,15 Ga 0,85 Conforme a camada cresceu a 460 ° C, (v) 300 nm n -Em 0,15 Ga 0,85 Como camada de cobertura superior com n =3 × 10 16 cm −3 cultivado a 490 ° C, e (vi) 13-nm p + -dopado em 0,15 Ga 0,85 Como tampa com p =2 × 10 18 cm −3 cultivado a 490 ° C (Fig. 1). A taxa de crescimento foi de 1,0 ML / s, exceto para os QDs que cresceram com uma taxa de crescimento de 0,15 ML / s. As camadas não dopadas são necessárias para separar QDs de n -dopadas regiões e, portanto, para reduzir a influência de centros de recombinação não radiativa, maximizando a eficiência de emissão de luz QD [30, 46]. As estruturas padrão InAs / GaAs QD consistem em (i) 300 nm n + Camada de buffer -GaAs com n =5 × 10 18 cm −3 cultivado a 600 ° C, (ii) 500 nm de espessura n -GaAs MB com n =3 × 10 16 cm −3 cultivado a 600 ° C, (iii) 3,0 MLs de InAs QDs incorporados em uma camada de GaAs não dopada de 20 nm cultivada a 460 ° C, e (iv) 500 nm n -GaAs camada de cobertura superior com n =3 × 10 16 cm −3 cultivado a 600 ° C. A taxa de crescimento foi de 1,0 ML / s, exceto para os QDs que cresceram com uma taxa de crescimento de 0,15 ML / s.
As imagens de microscopia de força atômica (AFM) das estruturas sem cobertura são mostradas na Fig. 1. Pela análise de dados AFM em estruturas semelhantes, os valores mais frequentes de tamanhos de QD foram estimados em 20 nm (diâmetro) e 4,9 nm (altura) para metamórficos QDs e 21 nm (diâmetro) e 5,0 nm (altura) para QDs padrão [30, 31, 45].
Para medições fotoelétricas, mesas circulares de 500 μm de espessura foram gravadas nas estruturas até o buffer inferior n + camadas; Os contatos de topo retificadores com um diâmetro de 400 μm e uma espessura de 70 nm foram então evaporados no topo das mesas. Para obter contatos ôhmicos na parte inferior n + -NgaAs e n + Camadas de buffer -GaAs, respectivamente, Au 0,83 Ge 0,12 Ni 0,05 liga foi depositada a 400 ° C por 1 min em atmosfera de nitrogênio. Contatos ôhmicos de índio espesso foram feitos no fundo de substratos em outras peças das mesmas amostras, a fim de ter medições também com a corrente fluindo através do buffer de GaAs e si Substrato -GaAs. A ohmicidade dos contatos foi verificada pelo I - V medições, contatando a um pedaço de substrato; as características de corrente-tensão foram consideradas lineares (dados não mostrados).
Seguindo a abordagem proposta na Ref. [47] e usado em outros trabalhos [48, 49], o fino p + Camada -INGaAs entre o contato Au e o n - Camada de ingaAs foi utilizada para aumentar a altura da barreira Schottky, uma vez que a estrutura obtida pela simples deposição de um metal sobre n -InGaAs exibiu uma altura de barreira Schottky relativamente baixa. Conseqüentemente, a deposição de fina p + A camada deINGaAs aumenta a altura da barreira Schottky para ser semelhante à do contato Au-GaAs, mantendo a semelhança do perfil da barreira para as estruturas metamórficas e InAs / GaAs.
Para projeto de estrutura e contato, bem como compreensão do perfil de energia para ambas as estruturas compostas pelo In 0,15 Ga 0,85 As ou GaAs MBs, In (Ga) As QDs, undoped cap layer e contatos Au / AuGeNi, os cálculos foram realizados usando o software Tibercad [50]. Perfis de banda foram modelados na aproximação deriva-difusão, levando em consideração condições de deformação, densidades de armadilhas relacionadas a defeitos na região de interface InGaAs / GaAs, camadas de depleção próximas a contatos e alturas de barreira Schottky apropriadas. Para o cálculo dos perfis de banda QD metamórfica, os tamanhos dos dados de AFM foram considerados e os efeitos de deformação foram incluídos, seguindo uma abordagem já validada nas Refs. [42, 51]. O cálculo dos níveis quânticos de QD está fora do escopo deste artigo, e a modelagem de QD foi realizada anteriormente na Ref. [45]. Neste trabalho, entretanto, calculamos perfis de banda de toda a heteroestrutura incluindo o substrato.
Fotocorrente vertical e espectros de PV foram medidos na faixa de 0,6 a 1,8 eV usando geometria de excitação de incidência normal em temperatura ambiente (RT) (300 K) e a mesma intensidade de fonte de luz (1,5 mW / cm 2 ) A fotocorrente foi medida usando um amplificador de corrente e técnica de corrente contínua [10, 43,44,45], com 1 V bias. A corrente foi medida como uma queda de sinal de tensão através de uma resistência de carga em série de 100 kΩ (veja a inserção na Fig. 5). A fotoluminescência (PL) excitada a 532 nm foi medida a 300 K. Algumas informações sobre estruturas e métodos são descritos em mais detalhes na Ref. [45].
Resultados e discussão
A. Caracterização fotoelétrica
Os espectros PV de InAs / In 0,15 Ga 0,85 As amostras de As e InAs / GaAs são apresentadas na Fig. 2. Contato apenas com as camadas MBE, espessas n -NgaAs, ou n Buffers -GaAs, as características dos espectros foram descritas em outro lugar [45]. O limite do espectro do InAs / In 0,15 Ga 0,85 Como em 0,88 eV está relacionado à absorção do estado fundamental no conjunto QD, que corresponde ao início da banda QD no espectro PL no RT medido anteriormente [45] (Fig. 2a). O espectro de emissão QD metamórfico mostra uma banda larga a 0,94 eV que está na faixa de telecomunicações de 1,3 μm (0,95 eV), enquanto o QD PL demonstra uma boa eficiência, como foi observado em artigos anteriores [30, 45, 46, 52]. A banda larga do espectro PV atingiu o pico em 1,24 eV e com borda em 1,11 eV é devido à geração da portadora no In 0,15 Ga 0,85 Como MB e camada de umedecimento (WL) incluindo o caminho através dos níveis rasos. Deve ser adicionado que o In 0,15 Ga 0,85 Como o bandgap calculado para a camada desenvolvida por MBE é de 1,225 eV [53], e o PL WL é observado em 1,2 eV [45]. Além disso, uma queda acentuada significativa acima de 1,36 eV é observada sendo causada provavelmente por um efeito indireto da camada tampão de GaAs dopada pesada localizada fora da região de contato intermediário que foi mencionada na Ref. [43]. A camada tampão é preenchida por vários níveis rasos e não uniformidades de banda originadas de defeitos de crescimento de MBE e centros de dopagem que desviam para o vermelho a absorção entre bandas de GaAs [33, 46, 54, 55]. Para a nanoestrutura InAs / GaAs de contato com tampão convencional, o início em 1,05 eV do espectro PV na Fig. 2b se origina do estado fundamental QD, conforme confirmado pelo espectro PL, enquanto a etapa acentuada em 1,3 eV pode estar relacionada ao transições no WL [56]. A característica após 1,39 eV está obviamente relacionada à absorção da camada tampão superior de GaAs dopado. Um mecanismo para este efeito será discutido em detalhes abaixo.

(Cor online) espectros fotovoltaicos de temperatura ambiente de a metamórfico InAs / In 0,15 Ga 0,85 As e b Estruturas de QD de InAs / GaAs; PV foi medido em contato com apenas camadas MBE [45] (curvas pretas) e através do semi-isolante si Substrato -GaAs (azul). Os espectros de PV medidos através do si -GaAs substrato são invertidos por sinal de tensão abaixo de 1,68 e 1,44 eV, respectivamente, para a e b . As partes de baixa energia das curvas são fornecidas nas inserções; as bandas QD PL medidas antes de [45] para ambas as estruturas são apresentadas para o posicionamento de energia do estado fundamental QD (vermelho)
Como mencionado acima, a queda acentuada do sinal PV acima de 1,36 eV no InAs / In 0,15 Ga 0,85 Como a estrutura está relacionada a n + -GaAs camada inferior cobrindo o substrato. Para limpar os efeitos das camadas abaixo do contato AuGeNi inferior na fotorresposta, estudamos as propriedades fotoelétricas das estruturas usando um contato de índio na parte de trás do substrato. Ao contrário da geometria de contato Au e AuGeNi anterior que permite o PV unipolar, o sinal bipolar foi observado para as estruturas em contato com o topo da amostra e substrato de volta (Fig. 2). É necessário notar que o sinal de PV muda ao longo do eixo de energia do fóton, e na Fig. 2, os espectros de ambas as amostras são invertidos pelo sinal de tensão abaixo de 1,68 e 1,44 eV para o InAs / In 0,15 Ga 0,85 Estruturas QD de As e InAs / GaAs, respectivamente. Aqui, PV é considerado positivo quando, como no caso do contato com as camadas MBE, o potencial positivo é aplicado ao contato Au superior, enquanto o potencial negativo é aplicado ao contato inferior.
Todas as transições ópticas mencionadas acima contribuem para o sinal PV das estruturas na geometria de contato substrato-topo. No entanto, ao medir PV através do substrato, o início do sinal para as estruturas metamórficas e convencionais ocorre em cerca de 0,72 eV. O início em 0,72 eV é atribuído à transição do centro de defeito EL2 localizado em si Substrato -GaAs e interfaces relacionadas perto de 0,75 eV abaixo da banda de condução GaAs [57], levando em consideração a possibilidade de transição através dos níveis rasos de defeitos [46, 54, 55]. Os aspectos relacionados à sua localização, bem como o redshift do início do EL2 PC foram discutidos em detalhes em outro lugar [10, 45]. Como nenhum sinal sob as bandas relacionadas ao QD foi observado nos espectros das amostras contatadas com os buffers InGaAs ou GaAs (Fig. 2), concluímos que o substrato e as interfaces relacionadas não têm influência substancial nas propriedades das heteroestruturas cultivadas em MBE .
Para entender a aparência do sinal PV em nossas amostras, deve-se olhar a Fig. 3, onde mostramos os perfis de banda calculados ao longo da direção de crescimento. A explicação detalhada da origem do PV entre os contatos Au e AuGeNi é fornecida no artigo anterior [45]. Resumindo, os elétrons excitados pela luz (buracos) derivam predominantemente em direção ao substrato (superfície), dando um potencial positivo no contato Au e um negativo no contato AuGeNi.

(Cor online) perfil de banda calculado no InAs / In metamórfico 0,15 Ga 0,85 Estruturas As (para cima) e InAs / GaAs (para baixo) pseudomórficas, para explicar o mecanismo de PV. A curvatura da banda das camadas mais profundas abaixo do contato AuGeNi é indicada em cinza. As transições ópticas observadas nos espectros PV são indicadas por setas verticais; setas em negrito mostram direções de deriva dos portadores de carga opticamente excitados sob o campo interno (criação PV); E F é a energia de Fermi. Os cálculos foram realizados usando o software Tibercad [50]
Explicando o PV bipolar das estruturas com o si eletricamente ativo Substratos -GaAs, pode-se considerar suas estruturas de banda calculadas na Fig. 3. Como antes, os portadores gerados nas camadas superiores, bem como nos QDs e WL, podem dar “+” no topo e “-” no substrato. O nível de Fermi no substrato semi-isolante está localizado muito mais baixo do que no n -camadas MBE dopadas. Portanto, a banda dobrando perto do n + A interface -GaAs / substrato é oposta àquela no resto da estrutura desenvolvida por MBE (consulte a Fig. 3). Conseqüentemente, a excitação no n + Camada -GaAs e substrato (acima de 1,36 eV) fornece um sinal PV oposto ao dos QDs, WL e buffers. O mesmo se aplica à excitação de defeitos EL2 (acima de 0,72 eV) do substrato GaAs e, especialmente, defeitos semelhantes a EL2 em n + Região tensionada -GaAs / GaAs [46, 57]. Contribuição do substrato e n + -GaAs para o sinal PV total é essencialmente mais forte do que aquele das camadas superiores de MBE, e o sinal negativo de PV é geralmente observado em energias de excitação mais baixas, enquanto o impacto das camadas InGaAs e nanoestruturas aparece como vales nas respectivas curvas espectrais na Fig 2. Isto é claramente visto comparando as bandas espectrais QDs, WL e tampão nas curvas PV das estruturas contatadas com tampões MBE com os vales nos espectros das amostras em contato com o topo do substrato. Para as energias mais altas, no entanto, a excitação é absorvida mais perto da superfície da amostra, não atingindo as camadas mais profundas do MBE e o substrato, que é a principal fonte de sinal negativo. Conseqüentemente, o sinal PV torna-se positivo com energias maiores. Portanto, a presença de si eletricamente ativos -substrato leva à competição entre os componentes espectrais relacionados às camadas superiores crescidas por MBE e os defeitos relacionados ao substrato e o n + Absorção de -GaAs.
Caso contrário, uma característica semelhante acima de 1,35 eV foi observada por meio de espectroscopia PV de superfície em um estudo detalhado recente de p - InAs / GaAs QD e InAs / InGaAs dot-in-well estruturas dopadas com base em si Substratos -GaAs [58]. A queda drástica da amplitude da PV foi explicada, ao contrário do nosso caso, por diferentes portadores de carga gerados abaixo e acima de 1,35 eV. No entanto, tendo em conta a diferença drástica nas estruturas referidas e presentes, bem como as especificidades dos métodos aplicados, seguimos a nossa interpretação dos próprios resultados.
Com base no conceito de curvatura de banda abaixo do contato AuGeNi, pode-se explicar a queda acentuada do sinal de PV na estrutura metamórfica InAs / InGaAs de contato com tampão acima de 1,36 eV observada na Fig. 2a. Esta característica espectral é devido ao efeito do substrato e MBE mais profundo n + Camada -GaAs. De fato, os elétrons gerados lá se movem sob o campo intrínseco para o contato AuGeNi evocando um campo elétrico adicional lá, com isso uma barreira devido à curvatura da banda na heterojunção InGaAs / GaAs é obviamente muito baixa para ser um obstáculo essencial para os portadores de carga. Isso alinha a curvatura da banda nas camadas superiores, que contribuem diretamente para o PV, e, portanto, reduz o fornecimento dos portadores fotoexcitados acima do n + Camada -GaAs e, consequentemente, o sinal PV total.
Uma pequena característica perto de 1,39 eV é observada na Fig. 2b no espectro da amostra pseudomórfica em contato com os buffers MBE, embora uma queda drástica do sinal como na estrutura metamórfica deva ser esperada acima de 1,36 eV, levando em consideração uma curvatura de banda semelhante perto de n + Interface -GaAs / substrato. Esse recurso não é um atributo apenas do substrato e n + -dopado GaAs; tais transições foram detectadas em estruturas QD In (Ga) As / GaAs baseadas em p GaAs dopado [58] e não dopado [10, 55]. Essas transições ocorrem obviamente também nas camadas GaAs superiores de nossa estrutura pseudomórfica, compensando principalmente o efeito negativo das camadas próximas ao substrato no sinal de PV. Como resultado, apenas a influência desprezível da camada próxima ao substrato pode ser observada na curva preta para a amostra InAs / GaAs na Fig. 2b, em vez da queda na curva da metamórfica originada das camadas mais profundas de GaAs, apesar de um bipolar semelhante efeito observado com a participação direta do substrato na formação do PV.
A razão para o pequeno recurso após 1,39 eV no espectro da amostra InAs / GaAs contatada com os buffers MBE pode ser diferente da discutida acima para a amostra InAs / InGaAs metamórficos. Em nossa opinião, é devido à ligeira queda de sinal causada pela borda de absorção do buffer GaAs de 500 nm de espessura crescido em MBE superior sombreando os QDs e WL, que são contribuintes mais eficientes para PV nessas energias de fótons. De fato, elétrons e lacunas gerados em QDs e WL são transportados para lados diferentes e evitam a recombinação, ao contrário da geração de volume, onde a recombinação é muito mais provável. Esta é a principal razão para a detecção eficaz de fototransportadores vindos de uma única camada de QDs e WL. Fótons de energias mais altas são absorvidos banda a banda próximo à superfície n Camada tampão -GaAs e elétrons escapam para o volume da amostra longe dos buracos, levando ao aumento acentuado de PV acima de 1,4 eV. A exatidão da razão sugerida para o recurso de 1,36 eV na estrutura InAs / GaAs de contato com tampão, em vez daquela assumida para metamórfica, é confirmada por estudos de células solares com base em estruturas InAs / GaAs com os contatos de fundo no n + Substratos -GaAs [18, 24, 59], isto é, com uma banda monótona curvando-se por toda a amostra de contato a contato. Seus espectros PV revelam o mesmo recurso sem uma barreira relacionada à interface da camada MBE para o substrato. Além disso, um mergulho estreito foi observado na mesma faixa espectral nos espectros de PC de estruturas InGaAs / GaAs com geometria de contato lateral e sem campo intrínseco [10, 55].
Os espectros de PC das estruturas obtidas na polarização de 1 V direcionadas como o campo intrínseco nas camadas superiores das estruturas (“-” no topo e “+” no contato inferior) são apresentados na Fig. 4. Os espectros de PC para as estruturas contatadas com as camadas MBE são muito semelhantes às PV na Fig. 2. Os componentes dos buffers QDs, WLs, InGaAs ou GaAs, bem como n + Camada -GaAs são observadas nas mesmas energias. No que diz respeito às estruturas com o contato do fundo no s i Substrato -GaAs, os espectros de PC têm limites próximos a 0,72 eV relacionados à absorção do centro de defeito EL2.
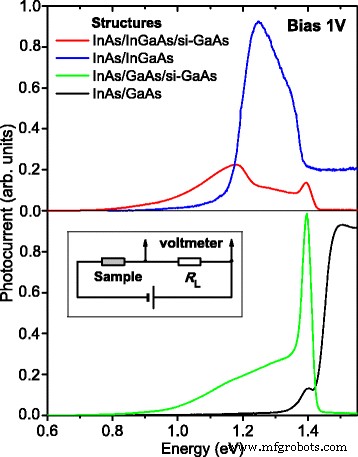
(Cor online) espectros de fotocorrente de temperatura ambiente do InAs / In metamórfico 0,15 Ga 0,85 Como / si -GaAs e InAs / GaAs / si convencionais Estruturas -GaAs QD. Detalhe:esquema elétrico de conexão da amostra para medições de PC
As características dos espectros de PC para as estruturas em contato com as camadas MBE apresentadas na Fig. 4 correspondem principalmente àquelas nos espectros de PV na Fig. 2 considerados acima. No que diz respeito às estruturas com o contato do fundo no s i Substrato -GaAs com o componente central EL2, há uma competição entre o sinal de absorção nas camadas MBE e os níveis relacionados a EL2, como discutido acima. No entanto, as formas das curvas permitem concluir que nenhum portador de carga excitado dentro das camadas acima n + -GaAs participa do PC; isto é particularmente relevante para o espectro de estrutura QD metamórfica. Obviamente, os elétrons não atingem o fundo por causa da barreira de alto potencial (ver Fig. 3) induzida por si -substrato. O substrato tem resistência muito alta e a principal queda de polarização aplicada ocorre nele, portanto, não ocorre redução da barreira.
Assim, pode-se notar que o PV e a fotocorrente são afetados negativamente pelo n relacionado ao substrato + Camada -GaAs:a absorção acima de 1,36 eV causa uma redução drástica do sinal. A principal causa da barreira abaixo do contato AuGeNi é o si Substrato -GaAs com um posicionamento bastante baixo ao nível de Fermi resultando na curvatura da banda oposta à do topo da estrutura. Este é o único efeito do substrato observado no PV em tal geometria de contato, e se manifesta mesmo em uma camada intermediária bastante espessa (400 nm) entre o contato do fundo e o substrato.
B. Soluções de projeto de camada intermediária de substrato-heteroestrutura
Do ponto de vista prático, pode-se concluir que tal projeto de estrutura InAs / InGaAs com si -Substrato GaAs não é útil na engenharia de dispositivo sensível à luz vertical, especialmente junto com um n relativamente fino + - buffer dopado, mesmo quando a configuração do contato elimina o fluxo de corrente através do substrato. A área de carga espacial formada no n + A região de interface -GaAs / substrato obriga os portadores de carga excitados aqui a se moverem opostamente aos excitados na estrutura metamórfica, como nas Figs. 3 e 5a, gerando assim um sinal de PV oposto e reduzindo a eficiência quântica total da amostra.
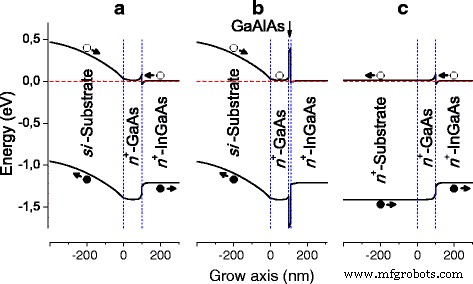
(Cor online) perfis de banda calculados próximos a In 0,15 Ga 0,85 As interfaces As / GaAs da estrutura metamórfica crescidas em um si -substrato com o n + Espessura da camada -GaAs de a 100 nm (amostra presente), b 100 nm e um Ga 0,3 fino de 10 nm Al 0,7 Como camada de barreira, e c estrutura como a atual, mas cresceu em um n + -substrato dopado semelhante a 100 nm de espessura n + Camada -GaAs acima. Os cálculos foram realizados usando o software Tibercad [50]
Portanto, para dispositivos baseados na absorção de luz, um projeto de estrutura diferente deve ser considerado. Acreditamos que tal melhoria deve ser sugerida porque muitos grupos de pesquisa consideram si Substrato -GaAs como base para o novo p - n -tipo fotodetectores infravermelhos QD [11,12,13] e células solares [15].
Espessamento simples do n + O buffer -GaAs sob estrutura metamórfica parece não ser uma ideia muito boa. Embora tal buffer possa absorver mais quanta de excitação acima de 1,37 eV e sombrear a interface e o substrato abaixo, sua espessura deve ser muito alta, porque 800 nm de material InGaAs de bandgap mais estreito acima é insuficiente para suprimir completamente os efeitos bipolares negativos. Além disso, mesmo um n muito espesso + O buffer -GaAs não pode excluir o efeito negativo dos centros semelhantes a EL2 que estão localizados principalmente no substrato e perto de sua interface com a camada MBE. No entanto, como os portadores de carga têm um caminho livre médio limitado, o espessamento do n + A camada -GaAs pode enfraquecer o campo negativo induzido no contato AuGeNi acima.
Uma melhoria melhor poderia ser fornecida pelo crescimento de uma fina camada de barreira para os elétrons provenientes do substrato, como é mostrado na Fig. 5b. Para cálculos, um Ga não dopado fino de 10 nm 0,3 Al 0,7 Como camada de barreira foi escolhida. Tal barreira poderia confinar fortemente os elétrons excitados no substrato dentro do n + Camada -GaAs. Camadas de alta ôhmica semelhantes crescidas por materiais de largura de banda larga como InAlAs, GaAlAs e AlAs têm sido usadas em estruturas de laser para evitar o vazamento do portador de carga da região ativa do dispositivo optoeletrônico [60]. No entanto, para o caso de GaAs-In 0,15 Ga 0,85 Como dispositivo baseado, Ga 0.3 Al 0,7 As best matches due to the wide bandgap and small lattice mismatch between the epitaxial layer. Decreasing the carrier-induced field on the AuGeNi contact, it can suppress the negative effect of the substrate region on the photoresponse, especially in combination with increase in the n + -InGaAs layer thickness.
Yet, a more optimal design of the vertical structures seems to be in use of a monotonous gradient of doping, including an n + -doped GaAs substrate as it is proposed in Refs [14, 39, 40]. This design is the most efficient and at the same time simplest. If the substrate is doped similar to the capping n + -layer or heavier, this causes the band bending depicted in Fig. 5c. Furthermore, an essential advantage of such a substrate could manifest itself in solar cell design. A low-resistive substrate allows for utilization of the configuration with the “–” contact on the sample bottom [24, 38,39,40, 59], non-shadowing the MBE structure from the sunlight.
Conclusões
We have shown that photoelectrical characterization evidences a critical influence of the deep levels on the photoelectrical properties of vertical metamorphic InAs/In0.15 Ga0.85 As and pseudomorphic (conventional) InAs/GaAs QD structures in the case of electrically active si -GaAs substrate. Both nanostructures manifest a bipolar PV caused by a competition of the components originated from the oppositely sloped band profiles near the GaAs substrate and bottom MBE n + -GaAs layer on one side and the rest of MBE-grown structure on the other side. An alternative contact configuration, which allows to avoid the current flow through the bottom layers, demonstrates the unipolar PV. The last configuration together with thick buffers on substrate strongly suppresses the influence of the photoactive deep levels originated from interfaces with the si -GaAs substrate on photoelectric properties of the nanostructures. However, a notable negative indirect effect of the substrate on the photovoltage and photocurrent signal from the InAs/InGaAs structure is observed when the excitation is absorbed in the substrate and near-substrate n + -GaAs MBE layer. Analyzing the obtained results and the performed calculations, we have been able to provide insights on the design of metamorphic QD structures, which can be useful for the development of novel efficient photonic devices.
Abreviações
- AFM:
-
Força atômica microscópica
- MB:
-
Metamorphic buffer
- MBE:
-
Molecular beam epitaxy
- ML:
-
Monolayer
- PC:
-
Photoconductivity
- PL:
-
Fotoluminescência
- PV:
-
Photovoltage
- QD:
-
Quantum dot
- R L :
-
Load resistance
- si :
-
Semi-insulating
- WL:
-
Wetting layer
Nanomateriais
- Projeto e Desenvolvimento de Dispositivos 5G:Faixas de Desempenho 5G
- S, N Co-dopado de grafeno Quantum Dot / TiO2 Compósitos para geração eficiente de hidrogênio fotocatalítico
- Engenharia de processo de revestimento por imersão e otimização de desempenho para dispositivos eletrocrômicos de três estados
- Fonte de fóton único brilhante a 1,3 μm com base no ponto quântico InAs Bilayer no micropilar
- Detectando Exciton Espacialmente Localizada em Superredes de Pontos Quânticos Auto-Organizados InAs / InGaAs:Uma Forma de Melhorar a Eficiência Fotovoltaica
- Um Projeto Eficiente e Eficaz de Nanofios InP para Captação Máxima de Energia Solar
- Avaliação de estruturas de grafeno / WO3 e grafeno / CeO x como eletrodos para aplicações de supercapacitor
- Eliminação do tamanho bimodal em pontos quânticos InAs / GaAs para preparação de lasers de pontos quânticos de 1,3 μm
- Diretrizes para Projeto de RF e Microondas
- Retrocessos e soluções no projeto de PCB de RF



