Detectando Exciton Espacialmente Localizada em Superredes de Pontos Quânticos Auto-Organizados InAs / InGaAs:Uma Forma de Melhorar a Eficiência Fotovoltaica
Resumo
Este artigo relata investigações experimentais e teóricas das propriedades atípicas de fotoluminescência dependente da temperatura de pontos quânticos de InAs multi-empilhados em estreita proximidade com o alívio de tensão InGaAs subjacente ao poço quântico. A heteroestrutura InAs / InGaAs / GaAs QD foi cultivada por epitaxia de feixe molecular de fonte sólida (SS-MBE) e investigada por fotoluminescência (PL), elipsometria espectroscópica (SE) e fotoluminescência resolvida no tempo de picossegundos. Picos de emissão dupla distintos são observados nos espectros PL da amostra. A partir das medições de PL dependentes de energia de excitação e dependentes de temperatura, esses picos de emissão estão associados à transição do estado fundamental de InAs QDs com duas populações de tamanhos diferentes. As medidas de luminescência foram realizadas em função da temperatura na faixa de 10–300 K pela técnica PL. O PL de baixa temperatura apresentou uma emissão anormal que apareceu no lado da baixa energia e é atribuída à recombinação através dos níveis profundos. A energia de pico do PL apresenta um comportamento anômalo em decorrência do processo de competição entre portadores localizados e deslocalizados. Propomos o modelo de conjunto de estados localizados para explicar os comportamentos usuais de fotoluminescência. O estudo quantitativo mostra que os estados contínuos dos poços quânticos atuam como um canal de trânsito para a redistribuição de portadores termicamente ativados. Determinamos a profundidade de localização e seu efeito na aplicação da heteroestrutura investigada para células fotovoltaicas. O modelo fornece uma visão geral para uma possível melhoria das propriedades de SCs de QDs de InAs / InGaAs / GaAs com base nos cálculos teóricos.
Histórico
Pontos quânticos automontados (QDs) têm sido amplamente investigados para possíveis aplicações em optoeletrônica devido à natureza do confinamento de portadores tridimensionais e à densidade de estados do tipo δ. Recentemente, estruturas QD foram propostas para realizar as células solares de banda intermediária (IBSCs), que introduzem fotocarreadores extras através da absorção de banda de valência-IB e IB-condução [1]. Os IBSCs baseados em GaAs com QDs que possuem banda de energia menor que GaAs formam estruturas em tandem que são capazes de absorver fótons em energias menores que a lacuna de energia de GaAs, resultando em maior eficiência de conversão de energia [2]. A formação da banda intermediária QD precisa de uma estrutura de múltiplas camadas compactada de QDs de alta densidade [3, 4]. No entanto, a qualidade do cristal de InAs QDs degrada à medida que o número da camada QD aumenta e o espaçamento da camada diminui devido ao acúmulo de deformação compressiva interna. A tensão excessiva irá induzir deslocamentos e defeitos que sobem dos QDs em direção à superfície. Portanto, o desempenho de um QD SC InAs / GaAs também se degrada conforme o número de camadas QD aumenta [5]. Para superar esses problemas, uma técnica de crescimento de compensação de deformação foi demonstrada com GaAsN, GaAsP e camada tampão de GaP para sistemas de materiais InAs / GaAs [6,7,8]. Outra técnica para superar esses problemas é cobrir a camada de QDs de InAs / GaAs com uma camada reduzida de deformação InGaAs fina. Em comparação com os QDs de InAs / GaAs, esta camada causa um desvio para o vermelho na foto-resposta devido à presença de uma pequena incompatibilidade de rede entre InAs e InGaAs. O estudo de fotoluminescência dependente da temperatura fornece informações úteis sobre o SC multi-stacked InAs / GaAs QDs, que é de considerável interesse prático e teórico. Classicamente, o gap de banda de um material semicondutor reduz monotonicamente com o aumento da temperatura. Materiais especiais, como InAs / GaAs QDs, mostraram uma anomalia no PL em baixas temperaturas devido a mecanismos de transferência de portadores termicamente ativados dentro do conjunto dos pontos quânticos. No entanto, essas anormalidades desaparecem progressivamente após processos de mistura pós-crescimento nas heteroestruturas InAs / InGaAs / GaAs QD, conforme mostrado por Ilahi et al. [9]. Heteroestruturas semelhantes às do presente estudo foram investigadas quanto à sua eficiência em aplicações fotovoltaicas por Sayari et al. [10]. Muitos modelos foram propostos nas últimas décadas, como o Passler, o Vina e o Varshni. A fim de produzir dispositivos confiáveis, o comportamento da temperatura desse tipo de heteroestruturas InAs / InGaAs / GaAs QD deve ser bem compreendido e isso é feito através do uso do modelo de melhor ajuste. Utilizamos aqui o modelo clássico de Passler corrigido para o coeficiente de redistribuição térmica, a fim de melhor compreender a dependência observada em forma de S da temperatura do gap excitônico. Nosso estudo dá origem a uma imagem precisa e autoconsistente para a localização e transferência de portadores em uma heteroestrutura QD de InAs / InGaAs / GaAs, que é um material energético de extrema importância tecnológica para a fabricação de dispositivos fotovoltaicos de alta eficiência.
Detalhes Experimentais
A Figura 1 ilustra um diagrama esquemático da heteroestrutura InAs / InGaAs / GaAs QD investigada em nosso estudo. A heteroestrutura consiste em cinco pilhas de InAs / In 0,11 Ga 0,89 Camadas QD de As / GaAs imprensadas por uma camada de GaAs intrínseca de 80 nm. As camadas epitaxiais cresceram em epiready n + Substrato -GaAs (100) usando epitaxia de feixe molecular de fonte sólida (SS-MBE) com sistema Riber MBE 32P. Após a dessorção de óxido, um n + de 250 nm -dopado GaAs buffer com uma densidade de dopagem de 2 × 10 18 cm −3 foi cultivado a 520 ° C seguido por uma camada de base de GaAs dopada com n de 1000 nm com uma densidade de dopagem de 10 17 cm −3 . A temperatura do substrato é então baixada e estabilizada a 500 ° C para a deposição da região intrínseca. Como mostrado na Fig. 1, as camadas repetidas consistem em 2,5 monocamadas (ML) de cobertura InAs, 5 nm de espessura In 0,11 Ga 0,89 As e GaAs de 33 nm de espessura. A formação dos QDs foi controlada in situ monitorando o padrão de difração de elétrons de alta energia (RHEED). O objetivo da espessura de 5 nm em 0,11 Ga 0,89 Como é para redshift os espectros de emissão e absorção, enquanto o GaAs de 33 nm de espessura atua como uma camada espaçadora. As taxas de crescimento para InAs, em 0,11 Ga 0,89 As camadas de As e GaAs foram de 0,08 ML / s, 0,78 ML / s e 0,7 ML / s, respectivamente, medidas por oscilações de ponto especular RHEED. No final, uma camada emissora de GaAs dopada com p de 500 nm (2 × 10 17 cm −3 ) seguido por um GaAs de 100 nm p + -camada de contato dopada (5 × 10 18 cm −3 ) foram cultivadas no topo da heteroestrutura. Silício (Si) e berílio (Be) foram usados como dopantes do tipo n e p, respectivamente. Durante o crescimento, a temperatura foi calibrada por um pirômetro.
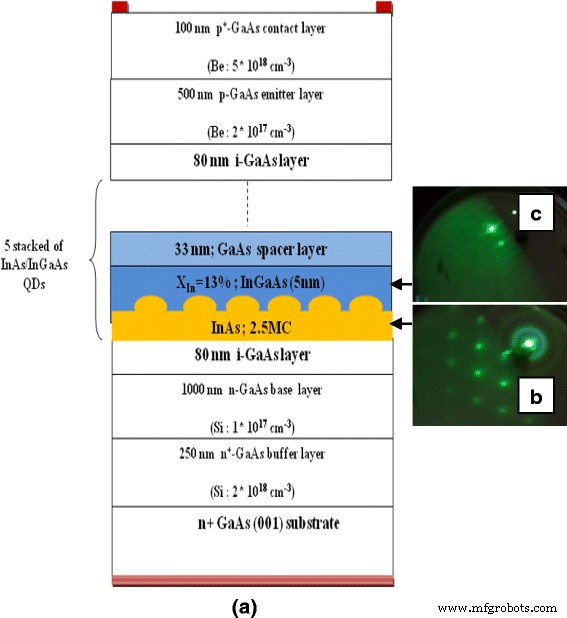
a Estrutura esquemática da camada do InAs / InGaAs QDs SC de cinco camadas crescidas em (001) n + Substrato -GaAs. b RHEED padronizado após crescimento de 2,5 ML de InAs (crescimento tridimensional). c RHEED padronizado durante o crescimento de InGaAs 5 nm (crescimento bidimensional) [10]
A elipsometria espectroscópica (SE) foi realizada em temperatura ambiente entre 1 e 6 eV, usando um J.A. Elipsômetro espectroscópico de ângulo variável Woollam (VASE) M-2000. As medidas SE foram realizadas em ângulos de incidência variando de 45 ° a 60 °. Em medições PL, um íon argônio (Ar + ) laser com comprimento de onda de 514,5 nm foi usado como uma fonte de excitação para gerar pares de elétron-buraco. A luz luminescente das amostras foi dispersa por um espectrômetro de alta resolução e detectada por um fotodetector Ge termeletricamente resfriado com um amplificador embutido. Para as medições de PL dependentes da potência de excitação e dependentes da temperatura, as amostras foram montadas em um criostato de hélio de ciclo fechado com temperatura controlada. Os espectros de PL foram obtidos na faixa de potência de saída nominal de 1,5–350 mW e na faixa de temperatura de 11–300 K. As medições de PL resolvidas no tempo foram realizadas em uma temperatura variável (10–240 K), hélio de ciclo fechado criostato. A linha de 514 nm foi usada como comprimento de onda de excitação, a partir de um laser de pulso de picossegundo de safira bloqueado em modo a uma taxa de repetição de 80 MHz com uma largura de pulso de 1,2 ps.
Resultados e discussões
A Figura 2 mostra as partes reais (a) e imaginárias (b) medidas da função dielétrica da heteroestrutura InAs / InGaAs / GaAs QD a 300 K para a faixa de energia de 1-6 eV. As partes reais e imaginárias seguem padrões diferentes. A variação da função dielétrica com a energia do fóton indica que algumas interações entre fótons e elétrons nos filmes são produzidas na faixa de energia de 1–6 eV. As duas principais características espectrais são E 1 e E 2 estruturas de ponto crítico (CP) em ~ 3 e ~ 4,5 eV, respectivamente [11, 12]. Para determinar quantitativamente a posição da energia das diferentes transições entre bandas, tomamos o cruzamento zero do espectro da segunda derivada da parte imaginária da função pseudodielétrica. As diferentes energias de transição obtidas estão resumidas na Tabela 1.
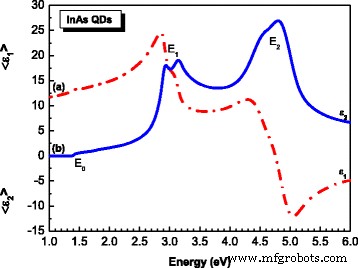
Real ( ϵ 1 ) ( linha vermelha tracejada ) e imaginário ( ϵ 2 ) ( linha azul contínua ) partes das funções dielétricas da heteroestrutura InAs / InGaAs QD obtidas a partir de medições SE [10]
A Figura 3 mostra o espectro derivado da segunda energia da parte imaginária da função pseudodielétrica mostrada na Fig. 2. Os dois picos em 2,9 e 3,1 eV correspondem, respectivamente, ao E 1 e E 1 + Δ 1 , transições entre bandas em GaAs. No entanto, os dois picos próximos posicionados em cerca de 4,4 e 4,7 eV são causados pelas transições de CP E 0 ’E E 2 , respectivamente, nas camadas InAs QD [12]. Notamos que a contribuição do E 1 + Δ 1 Energia do CP (2,74 eV) [12] do InAs para o E 1 um (2,91 eV) [11] de GaAs não pode ser excluído devido à pequena diferença entre os dois valores de energia. Em baixa energia, o gap de GaAs é claramente distinguível no ε espectro em cerca de 1,4 eV. Além disso, o segundo espectro de derivada de energia (Fig. 3) mostra uma transição entre bandas em 1,75 eV que corresponde ao E 0 + Δ 0 Energia CP de GaAs [11]. Sabe-se que ε 2 é um medidor e uma medida da qualidade do material; o valor mais alto implica a interface mais abrupta [13]. De acordo com a literatura, ε 2 valores da ordem de 25, sendo o valor mais elevado 26,8 no nosso caso, obtido na região do E 2 gap próximo a 4,7 eV, indica a alta qualidade dos materiais formando a heteroestrutura InAs / InGaAs / GaAs QD crescida por SS-MBE.
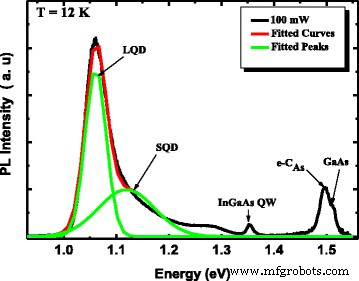
Espectro da segunda derivada da parte imaginária ( ϵ 2 ) da função dielétrica em função da energia do fóton para a heteroestrutura InAs / InGaAs QD. As energias de transição decorrentes das camadas InAs QD e camadas GaAs são indicadas [10]
A Figura 4 mostra o espectro PL da região ativa na heteroestrutura InAs / InGaAs / GaAs QD com uma potência de excitação de 100 mW em baixa temperatura (12 K). Obviamente, o espectro apresenta uma forma assimétrica localizada no lado de alta energia e que pode ser deconvoluída em duas sub-bandas por ajuste gaussiano [14]. Considerando a dependência dos potenciais de confinamento quântico no tamanho do ponto, o pico mais intenso localizado em 1,06 eV é atribuído à emissão dos estados fundamentais de QDs maiores (LQDs), enquanto o pico de energia mais alto em 1,11 eV refere-se à emissão de os estados fundamentais de QDs menores (SQDs) [15]. Assim, em potência de excitação muito baixa e baixa temperatura, deduzimos que a forma assimétrica é devida à luminescência originada de uma distribuição bimodal de tamanho de pontos [16]. Além disso, os picos originados da camada do poço quântico InGaAs, a recombinação entre elétrons na banda de condução de GaAs e buracos no nível do aceitador de carbono (e-C As ) [17] e o gap de GaAs são vistos em torno de 1,35, 1,49 e 1,51 eV, respectivamente. Para confirmar essa atribuição à forma assimétrica, realizamos medições de PL em diferentes potências do laser variando de 10 a 100 mW. Também realizamos medições de AFM em uma estrutura sem cobertura semelhante à investigada. A partir da Fig. 5, é claro que a heteroestrutura tem uma forma PL independente de potência. Além do espectro de excitação mais alto, a intensidade de PL e a largura da linha do pico de PL de alta energia da heteroestrutura não são significativamente alterados. Além disso, a separação de energia entre os dois picos PL (Fig. 5) é de cerca de 50 meV. Como esperado, a imagem AFM demonstra que os QDs na quinta camada possuem uma distribuição de tamanho bimodal com uma densidade de QDs inteira de 7 × 10 10 cm ^ (- 2). Assumindo que os picos laterais de baixa energia da heteroestrutura correspondem ao estado fundamental de grandes QDs (LQDs), podemos dizer que os picos de alta energia em alta potência parecem ser o resultado dos estados fundamentais de QDs relativamente pequenos (SQD )
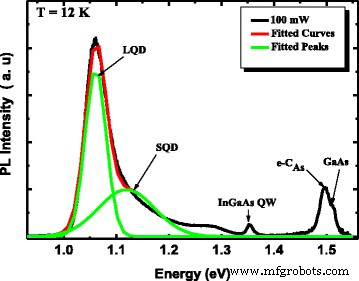
Espectro de PL medido em baixa temperatura (12 K) a partir da heteroestrutura QD de InAs / InGaAs empilhados de cinco camadas. Uma análise de formato de linha de espectros prova que o sinal QD PL é uma convolução de dois picos em forma de Gauss, conforme mostrado por linhas sólidas

Espectros de PL normalizados dependentes da potência de excitação da heteroestrutura QD de InAs / InGaAs medido a 12 K
Para obter uma visão dos mecanismos de recombinação de PL, medições de PL dependentes da temperatura são realizadas na heteroestrutura de 10 a 300 K e representadas na Fig. 6. A Figura 7 mostra a posição de energia de PL do pico principal associado à emissão de LQDs. Este pico mostra uma dependência anormal da temperatura entre 10 e 100 K em comparação com outras ligas ternárias III-V, como GaAlAs convencionais [18]. Nesta faixa de temperatura (região (i)), um desvio para o vermelho de cerca de 12 meV é observado. Esta mudança é devido à recombinação de excitons via estados localizados dentro do conjunto dos LQDs não homogeneamente distribuídos. À medida que a temperatura aumenta dentro desta faixa de temperaturas, os portadores são termicamente ativados e transferidos dos QDs menores para os maiores dentro do conjunto, onde eles eventualmente se recombinam radiativamente. Isso torna os fenômenos observados susceptíveis de se originar da dispersão de tamanho de ponto grande em nossa estrutura (ver inserção AFM). A temperatura característica na qual os dois processos de recombinação (portadores localizados e deslocalizados) participam igualmente no sinal PL é denotada como T loc / deloc . Então, entre 100 e 120 K (região (ii)), o pico de energia aumenta. Isso se deve à fuga de portadores dos estados mais rasos para os mais elevados. A temperatura característica é denotada como T escape . Mesmo em altas temperaturas (região (iii)), os excitons são totalmente deslocalizados e uma recombinação banda a banda é recuperada.

Espectros de PL dependentes de temperatura da heteroestrutura QD de InAs / InGaAs medidos a uma potência de excitação de 100 mW

Energias de pico LQD PL da heteroestrutura investigada InAs / InGaAs QD medida em várias temperaturas
Para melhor compreensão do processo de recombinação em QDs multi-empilhados InAs / InGaAs / GaAs, estudamos o PL resolvido no tempo usando a técnica de fotocontagem correlacionada com o tempo. Foi previsto teoricamente que o tempo de vida do decaimento do exciton dos QDs é sensível à temperatura [19]. Medições experimentais mostraram que os tempos de vida são de fato uma constante de temperatura abaixo de uma temperatura crítica [20]. Markus et al. [21] relatou uma vida útil constante de cerca de 950 ps em uma ampla faixa de temperatura dentro do erro experimental.
A Figura 8a apresenta o espectro de decaimento PL, entre 17 e 240 K para uma energia de detecção fixada em 1,06 eV e uma energia de excitação ( λ exc =514 nm). Esses espectros são bem ajustados teoricamente por uma função monoexponencial, com um tempo de decaimento de ~ 1000 ps em temperatura mais baixa. Este tempo de decaimento lento, em comparação com filmes finos de semicondutores III-V [22], é uma assinatura da presença de estados localizados [23], e a recombinação dos portadores no pico de LQD deve ser puramente radiativa. De fato, em baixa temperatura, os elétrons e buracos foto-gerados, antes de se recombinarem, levam tempo para formar excitons e relaxar sua energia para ser capturada pelos estados localizados rasos. Esses fenômenos levam a um tempo de decaimento lento. O efeito da temperatura no tempo de decaimento do PL foi estudado e mostra a presença de dois regimes diferentes, conforme representado na Fig. 8b [24]. Observamos que o tempo de decaimento associado à menor energia da banda PL (LQDs (1,06 eV)) é quase constante (1000 ps) até 140 K, e então diminui com o aumento da temperatura.

a Tempo de decaimento do pico LQDs versus a temperatura da amostra para uma excitação de comprimento de onda de 514 nm. b Intensidade de decaimento de fotoluminescência típica versus a temperatura do pico LQD medida em um comprimento de onda de excitação de 514 nm
Abordagem teórica
A fim de compreender a dependência anômala da temperatura do PL, a posição do pico do PL foi investigada usando o modelo LSE desenvolvido por Li et al. [25, 26]. Na verdade, este modelo quantitativo fornece uma explicação satisfatória para as características espectrais anômalas da luminescência de estado localizado previamente observada em vários materiais III-V, como B (In) GaAs / GaAs [27, 28] à base de boro ligas e InGaAs / GaAs MQWs [29, 30]. O modelo assumiu que o estado localizado tem uma distribuição de energia do tipo gaussiana para densidade de estados dada por:
$$ \ rho (E) ={\ rho} _o {e} ^ {- {\ left (\ frac {E- {E} _ {\ mathrm {ch}}} {2 {\ sigma} ^ 2} \ direita)} ^ 2} $$ (1)
Onde σ e E ch são o parâmetro de alargamento para a distribuição dos estados localizados (profundidade de localização) e o nível de barreira que os portadores devem superar para transferir, respectivamente. Em estado quase estacionário, a dinâmica dos excitons localizados pode ser descrita pelas seguintes equações de taxa:
$$ \ frac {dN \ left (E, T \ right)} {dt} =G (E) + \ frac {\ gamma_c N \ hbox {'} \ left (E, T \ right) \ rho (E) } {\ Lambda} - \ frac {N \ left (E, T \ right)} {\ tau _ {\ mathrm {tr}}} {e} ^ {\ frac {E- {E} _a} {K_B T} } - \ frac {N \ left (E, T \ right)} {\ tau _ {\ mathrm {r}}} =0 $$ (2)
Os parâmetros τ r , τ tr , γ c , K B , Λ e N 'representam, respectivamente, o tempo de recombinação do portador (tempo de vida radiativo), o tempo de transferência do portador (tempo de vida não radiativo), coeficiente de recaptura, constante de Boltzmann, número total de estados localizados e o número total de portadores que são termicamente ativados longe do estados localizados. G ( E ) representa a taxa de geração da portadora. A quantidade \ (\ frac {\ gamma_c N \ hbox {'} \ left (E, T \ right) \ rho (E)} {\ Lambda} \) é o número de portadoras recapturadas pelos estados localizados por unidade Tempo. O terceiro termo à direita fornece a taxa de escape térmico dos portadores localizados. O último representa a taxa de despovoamento de portadores devido à recombinação radiativa. A densidade da população de portadores de portadores localizados é proporcional à função de distribuição e densidade de estados de portadores localizados. Na verdade, a solução da Eq. (2) pode ser descrito pela Eq. (3).
$$ N \ left (E, T \ right) =\ frac {\ rho_o {e} ^ {- {\ left (\ frac {E- {E} _0} {2 {\ sigma} ^ 2} \ right) } ^ 2}} {\ left [\ frac {\ tau _ {\ mathrm {tr}}} {\ tau _ {\ mathrm {r}}} + exp \ left (\ frac {\ left (E- {E} _ {\ mathrm {ch}} \ right)} {K _ {\ mathrm {B}} T} \ right) \ right]} $$ (3)
onde E 0 é a energia central. Matematicamente, a dependência da temperatura da posição do pico devido à redistribuição térmica da portadora dentro dos estados localizados determinados a partir de \ (\ frac {\ parcial N \ left (E, T \ right)} {\ partial t} =0 \) é dada por :
$$ E (T) ={E} _0- x (T) {K} _B T $$ (4)
Onde x ( T ) é a solução numérica da Eq não linear. (5):
$$ x {e} ^ x =\ left [{\ left (\ frac {\ sigma} {K_b T} \ right)} ^ 2- x \ right] \ left (\ frac {\ tau _ {\ mathrm {r }}} {\ tau _ {\ mathrm {tr}}} \ right) exp \ left [\ frac {\ left ({E} _0- {E} _ {\ mathrm {ch}} \ right)} {K_ { \ mathrm {B}} T} \ right] $$ (5)
A Equação 5 tem apenas uma solução para \ (0
Sabe-se que o band gap de um material semicondutor idealizado é geralmente descrito pela fórmula empírica de Passler [32]. Levada em consideração a correção devido ao coeficiente de redistribuição térmica, a variação da posição do pico de luminescência usando o modelo LSE descrito pela Eq. (7):
$$ E (T) ={E} _0- \ frac {\ alpha \ theta} {2} \ left [\ sqrt [P] {1+ \ left (\ frac {2 T} {\ theta} \ right) } \ kern0.5em -1 \ right] - x (T) {K} _B T $$ (7)
onde θ é um parâmetro de temperatura característico que se esperava ser comparável com a temperatura de Debye θ D . Para T >> θ , vemos que α representa apenas o limite da magnitude da primeira derivada, \ ({\ frac {dEg (T)} {dT}} _ {T \ to \ infty} \). O expoente “p” está relacionado à forma da função espectral elétron-fônon [33]. O modelo fornece um bom ajuste para a evolução experimental, o que é confirmado pela Fig. 9. Os parâmetros de ajuste estão resumidos na Tabela 2.

Evolução da fotoluminescência dependente da temperatura do pico LQD ( quadrados pretos sólidos ) ajustado usando a lei de Passler empírica ( linha sólida azul ) e a verdade da relação de Passler modificada com o modelo LSE ( linha sólida vermelha )
A energia de pico de PL depende fortemente da redistribuição térmica representada na Fig. 10. Esta última indica um rápido aumento na faixa de temperatura criogênica. O máximo de redistribuição térmica corresponde ao máximo de redshift na evolução de energia (~ 50–100 K). Na região de alta temperatura de PL, a redistribuição térmica diminui exponencialmente e tende ao cancelamento a partir de 150 K inicia o processo de deslocalização e retorno às transições banda a banda. Além disso, podemos observar isso quando as curvas clássica e modificada são sobrepostas (Fig. 9). O expoente “p” indica que a contribuição dos fônons acústicos longitudinais (LA) é mais significativa do que a contribuição da óptica longitudinal (LO ) fonons. Essa contribuição parece ser dominante na região de alta temperatura de PL onde a emissão é assistida por fônons. O processo de distribuição bimodal abre um canal de acoplamento entre QDs que é representado por elétrons deslocalizados e estados de lacunas separados por uma energia E ch . A origem deste canal de acoplamento ainda é assunto de controvérsia [34,35,36]. No entanto, o canal de acoplamento pode ser visto como os estados intermediários existentes entre os estados bidimensionais WL e zero-dimensional QD [37]. Assim, pode-se imaginar que as portadoras nos estados QD podem ser mais facilmente excitadas termicamente para o canal de acoplamento do que WL devido à menor energia de ativação necessária, e então transferidas para seus QDs vizinhos dentro de uma distância finita. Parece o nível Fermi-Dirac na distribuição Fermi-Dirac. Esta energia E ch é menor que a energia de ativação E a extraído do diagrama de Arrhenius (Fig. 11). A razão pela qual E a é maior pode ser explicado pelo fato de que os portadores precisam de maior energia para atingir a camada de umedecimento (WL), como mostrado esquematicamente na Fig. 12. Além disso, a magnitude da diferença Δ E = E ch - E 0 desempenha um papel mais significativo na determinação da dependência anormal da temperatura da luminescência de portadores localizados. Devemos observar que os dois casos, E ch - E 0 > 0 e E ch - E 0 <0, existe de um ponto de vista físico, mas geralmente é atribuído como energia de ativação térmica “positiva”. Em nosso caso, isso implica que E ch está 4 meV abaixo de E 0 em que portadores localizados são termicamente ativados para estados (ou locais no espaço real) com energias mais altas. Ele diminui em comparação com uma única camada InAs QD com In 0,15 Ga 0,85 Como camada subjacente redutora de tensão [10]. A profundidade de flutuação potencial atribuída por σ é o resultado da falta de homogeneidade da distribuição de tamanho dos QDs. A profundidade potencial encontrada é de 19 meV. Ele diminui aumentando o número de pilhas de InAs / In 0,11 Ga 0,89 As / GaAs QDs. Como resultado, podemos deduzir que a diminuição da profundidade potencial aumenta a eficiência da estrutura em comparação a uma camada de QDs de InAs / InGaAs / GaAs estudada por Ilahi et al. e Helmi et al. [10, 36].

Redistribuição térmica dependente da temperatura determinada numericamente. As temperaturas características ( T loc / deloc e T escape ) são indicados em relação ao processo de localização-deslocalização
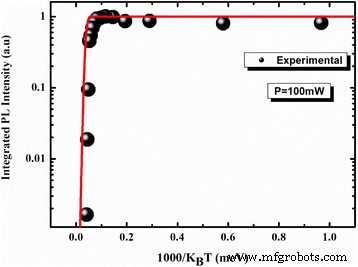
Ajuste de Arrhenius da amostra investigada. A intensidade integrada normalizada ( círculos pretos ) é equipado com três energias de ativação ( linha contínua vermelha )
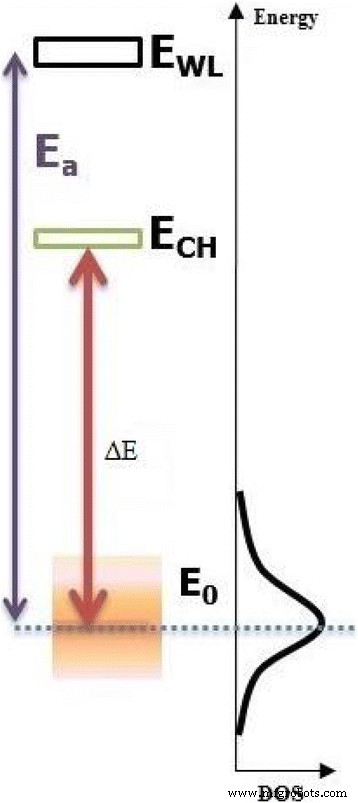
Esquema da distribuição QD de estados localizados de elétron / buraco (exciton) ( WL camada de umedecimento, CH canal de transferência da operadora)
Conclusão
Em conclusão, fabricamos com sucesso SC baseado em GaAs com uma pilha múltipla de QDs de InAs, cobrindo uma camada de InGaAs nos QDs e inserindo camadas espaçadoras de GaAs. As duas principais características espectrais observadas nos espectros da função dielétrica da heteroestrutura InAs / InGaAs / GaAs QD em 3 e 4,5 eV são atribuídos ao E 1 e E 2 Estruturas de CP de GaAs e InAs, respectivamente. O espectro PL dos InAs QDs na matriz de GaAs é intenso e apresenta uma forma assimétrica, o que indica o crescimento de uma estrutura InAs QD multi-empilhada de alta qualidade. A contribuição de QDs maiores e relativamente menores para o espectro PL também é demonstrada. As medições de luminescência foram modeladas e reinterpretadas com sucesso usando o modelo LSE desenvolvido. O estudo teórico interpretou quantitativamente os espectros dependentes da temperatura observados e lançou luz sobre os complicados mecanismos de emissão espontânea em QDs de InAs / InGaAs / GaAs empilhados, com base nos parâmetros de ajuste. Este estudo sugere uma forma de melhorar a eficiência de estruturas QD de InAs / GaAs para seu uso em aplicações fotovoltaicas. Esses resultados ajudam a melhorar o entendimento da dinâmica de portadores dependente da temperatura em QDs de engenharia de deformações, a fim de melhorar a eficiência da estrutura investigada. Na sequência deste trabalho, estudaremos o efeito da orientação, bem como o aumento no número de InAs / GaAs QDs da estrutura multi-stack na profundidade de localização.
Nanomateriais
- Usando ângulos para melhorar o futuro da eletrônica
- Detectando o magnetismo do núcleo de um átomo único
- Componentes de plástico:pavimentando o caminho para a eficiência automotiva
- Fonte de fóton único brilhante a 1,3 μm com base no ponto quântico InAs Bilayer no micropilar
- Efeitos bipolares na fotovoltagem de heteroestruturas de pontos quânticos de InAs / InGaAs / GaAs metamórficos:soluções de caracterização e design para dispositivos sensíveis à luz
- Controle eletroquímico reversível sobre luminescência fotoexcitada do filme de pontos quânticos do núcleo / casca / ZnS
- Desempenho fotovoltaico de uma célula solar nanofio / ponto quântico híbrido de nanoestrutura
- Eliminação do tamanho bimodal em pontos quânticos InAs / GaAs para preparação de lasers de pontos quânticos de 1,3 μm
- O aquecimento global reduzirá a eficiência das células solares
- Fresamento CNC de 5 eixos liderando o caminho para uma usinagem de maior eficiência



