Mudança de estrutura de GaN entre Nanowall Network, Nanocolumn e Compact Film Grown on Si (111) por MBE
Resumo
Mudança de estrutura da rede de nanopartículas de GaN, nanocoluna e filme compacto foram obtidos com sucesso em Si (111) por epitaxia de feixe molecular assistido por plasma (MBE). Como é esperado, o crescimento das nanocolunas de GaN foi observado em condições ricas em N em Si puro, e o crescimento mudou para filme compacto quando o fluxo de Ga foi melhorado. Curiosamente, se uma pré-deposição de alumínio (Al) por 40 s foi realizada antes do crescimento de GaN, GaN cresce na forma de rede de nanowall. Os resultados mostram que o Al pré-depositado sai na forma de gotículas com diâmetro e altura típicos de ~ 80 e ~ 6,7 nm, respectivamente. Um modelo de crescimento para a rede nanowall é proposto e o mecanismo de crescimento é discutido. GaN cresce na área sem gotículas de Al, enquanto o crescimento acima das gotículas de Al é prejudicado, resultando na formação de uma rede de nanowall de GaN contínua que remove os obstáculos da fabricação de nano-dispositivos.
Histórico
Como semicondutores diretos de banda larga, GaN e compostos relacionados obtiveram grande sucesso em diodos emissores de luz [1,2,3], diodos de laser [4] e transistores de alta mobilidade de elétrons [5, 6]. A heteroepitaxia do filme de GaN em safira, carboneto de silício ou silício de cristal único, entretanto, induz uma alta densidade de deslocamento. Acredita-se que suas nanoestruturas tenham desempenho superior devido à relação entre área de superfície e volume livre de deslocamento, livre de deformação e grande [7, 8]. Pesquisas em nanocolunas e nanofios de GaN têm sido realizadas intensamente [9,10,11,12]. A nucleação nanocolunar de GaN ocorre espontaneamente pelo mecanismo de crescimento de Volmer-Weber [13], enquanto a condição rica em nitrogênio (rica em N) evita que os locais de nucleação se aglutinem. Muita atenção tem sido dada à fabricação de um dispositivo elétrico nos nanofios de GaN ou nas nanocolunas. Os nanofios de GaN foram mecanicamente dispersos em SiO 2 Substrato / Si e contatos ôhmicos formados em dois lados de um nanofio individual aleatoriamente [14]. Em outro caso [15], um lado do nanofio foi fixado a um estágio conectado ao eletrodo negativo enquanto o outro lado foi alinhado ao eletrodo positivo por meio de microscópio eletrônico de varredura (MEV), formando um dispositivo elétrico para pesquisas científicas.
Alternativamente, uma nanoestrutura especial, ou seja, a rede de nanowall de GaN, que é eletricamente condutora no plano, é promissora, uma vez que nenhum processo complexo é necessário para a fabricação de nano-dispositivos. Em 2007, o crescimento da rede de nanopartículas de GaN foi obtido pelo grupo de Kishino usando a camada de Ti padronizada por litografia de feixe de elétrons como uma máscara [16]. Vários anos atrás, o crescimento da rede de nanowall de GaN sem qualquer litografia foi obtido com sucesso em substratos de safira e silício [17,18,19]. A intensidade de emissão da borda da banda da rede de nanoparques de GaN é semelhante às nanocolunas de GaN e a luminescência amarela não é óbvia, indicando a alta qualidade da rede de nanopartes de GaN. Diferente da nanoestrutura separada, como as nanocolunas, a rede nanowall é eletricamente condutora no plano [18, 20, 21] que poderia ser fabricada em um nano-dispositivo tão fácil quanto o filme [22]. Portanto, o obstáculo da fabricação do dispositivo nas nanocolunas separadas pode ser removido pela condução elétrica no plano da rede de nanoparedes. É crucial estudar o mecanismo de crescimento da rede nanowall. A formação espontânea induzida por deslocamento da rede de nano-paredes é considerada como o mecanismo de crescimento da rede de nano-paredes de GaN em c nua. - safira plana [23]. Uma vez que a formação induzida por deslocamento da rede de nano-paredes é de baixo controle, o crescimento da rede de nano-paredes em substrato de Si (111) com camada tampão de Al [18] foi realizado. O mecanismo de crescimento do nanowall em Si (111) é significativamente diferente daquele em substrato de safira nua; no entanto, nenhuma pesquisa é realizada, embora o mecanismo de crescimento em Si (111) seja a chave para o crescimento da rede nanowall.
Neste trabalho, o crescimento de GaN em várias estruturas, incluindo a rede de nano-paredes, as nanocolunas e o filme compacto são sistematicamente estudados. Várias estruturas de GaN mencionadas acima foram cultivadas em Si (111) usando epitaxia de feixe molecular assistido por plasma (MBE). Os resultados mostram que a mudança de estrutura do crescimento de GaN pode ser alcançada ajustando a razão Ga / N e adicionando as gotas de Al pré-depositadas. A morfologia e fotoluminescência da rede de nanowall de GaN foram medidas por microscopia eletrônica de varredura de emissão de campo (FESEM) e analisador de espectro de fotoluminescência com laser He-Cd (325 nm, 200 mW) como fonte de excitação. Microscópio de força atômica (AFM) foi utilizado para a caracterização da camada de Al pré-depositada. O mecanismo de crescimento da rede de nanopartículas de GaN em Si (111) com gotículas de Al metálico é proposto.
Experimental
Estruturas de GaN foram cultivadas em substratos de Si (111) pelo sistema Riber 32 MBE equipado com um N 2 Fonte de plasma RF (Veeco, RFS-N / TH). A pressão da câmara de crescimento foi bombeada para 3,0 × 10 - 10 Torr antes do crescimento. O N 2 gás, Ga e Al com pureza de 99,9999% foram usados neste experimento. Substrato de Si (111) (sem dopagem, um lado polido para crescimento, 380 ± 20 μm, fornecido pela Sigma-Aldrich) com resistividade> 5000 Ω cm foi limpo pelo processo RCA padrão, seguido por imersão em HF:H 2 O =1:50 por alguns segundos para remover a camada de óxido de silício na superfície do substrato de Si, bem como formar uma superfície terminada em hidrogênio.
Para o crescimento das nanocolunas de GaN, as venezianas do N 2 plasma e a fonte de Ga foram abertos simultaneamente e o Si puro (111) foi aquecido a 973 K. A potência e a pressão do N 2 fonte de plasma usada em todas as amostras neste trabalho foram fixadas em 400 W e 4,2 × 10 - 5 Torr, respectivamente. Antes do crescimento da rede de nanoparedes de GaN, as gotículas de Al com diâmetro de cerca de 80 nm foram depositadas no Si puro (111) aquecido a 973 K. A fonte de Al foi mantida a 1323 K. A pré-deposição das gotículas de Al resultou em uma diferente nucleação e crescimento de GaN, levando ao crescimento da rede de nanowall. O fluxo de Ga para o crescimento da rede de nano-paredes foi o mesmo com as nanocolunas ( φ Ga =1,2 × 10 - 7 Torr a 1169 K). Para o crescimento do filme de GaN, o fluxo de Ga foi aumentado para 5,3 × 10 - 7 Torr enquanto o fluxo de N foi mantido constante.
Resultados e discussão
Quando as venezianas de N 2 plasma e Ga foram abertos simultaneamente, GaN (S 1 ) cresceu na forma de nanocolunas no Si nu (111), como mostrado na Fig. 1a. O fluxo de Ga era 1,2 × 10 - 7 Torr e o substrato Si (111) foram mantidos a 973 K conforme mostrado na Tabela 1. Observa-se que o diâmetro das nanocolunas de GaN varia de 52 a 125 nm com comprimento de ~ 460 nm. A densidade das nanocolunas contadas da imagem SEM é de aproximadamente 10 7 mm - 2 . Obviamente, a maioria das nanocolunas observadas na Fig. 1b não são perpendiculares ao substrato, mas inclinam-se com um ângulo de ~ 30 °. A superfície superior das nanocolunas é lisa, em conformidade com o relatório de Bertness [9]. Acredita-se que as nanocolunas se nuclearam espontaneamente e então se propagam porque o coeficiente de aderência no (0 0 01) c - o plano é mais alto do que no {110 0} m -avião. O comprimento de difusão L do átomo de Ga absorvido (Ga ab ) é essencial para o crescimento das nanocolunas. Conforme descrito na Eq. (1), o comprimento de difusão L depende da distância média de salto a , o Ga ab energia de dessorção Q des , e a energia de ativação para um salto de difusão de superfície Q d [13] .
$$ L =\ sqrt {2} a \ \ exp \ left (\ frac {Q _ {\ mathrm {d} \ mathrm {es}} - {Q} _ {\ mathrm {d}}} {2 kT} \ direita) $$ (1)
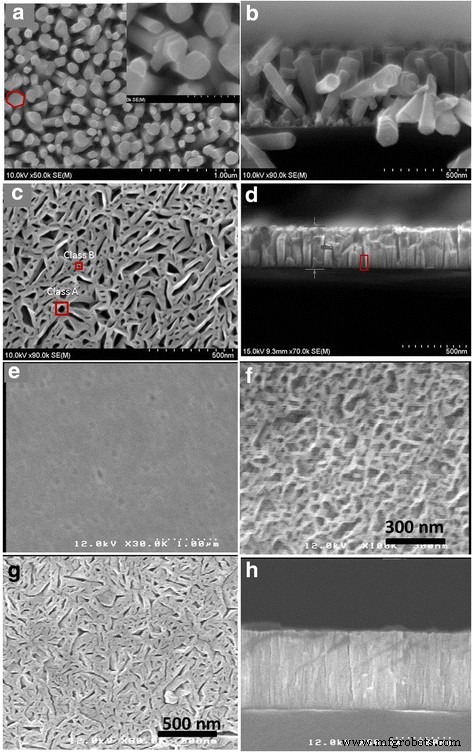
Imagens FESEM de amostras cultivadas em diferentes condições. a , b Correspondendo às nanocolunas GaN (amostra S 1 ) c , d Correspondente à rede nanowall de GaN (amostra S 2 ), e Correspondente ao filme compacto (amostra S 3 ), f Correspondente à rede nanowall de GaN (amostra S 4 ) no estágio inicial de crescimento. g , h Correspondente à rede de nanowall de GaN crescida a uma temperatura inferior de 900 K (amostra S 5 )
Uma vez que as paredes laterais da nanocoluna atomicamente planas fornecem poucos locais de adsorção, assume-se que o Ga ab comprimento de difusão L no m - o plano das paredes laterais é muito mais alto do que no c -plano, resultando no crescimento vertical de GaN para nanocolunas. Se essa suposição fosse verdadeira, a forte anisotropia da taxa de crescimento seria alterada quando a razão Ga / N fosse melhorada. Na verdade, o GaN (S 3 ) a estrutura mudou da nanocoluna para o filme compacto (Fig. 1e) quando o fluxo de Ga foi aumentado para 5,3 × 10 - 7 Torr. Portanto, o crescimento de GaN na forma de nanocoluna ou filme compacto pode ser controlado ajustando a razão Ш / V.
Embora as nanocolunas de GaN exibam um desempenho superior do que o filme, a fabricação do dispositivo elétrico é de grande dificuldade porque a nanocoluna separada precisa de alinhamento antes da fabricação do contato elétrico. Uma nanoestrutura eletricamente condutora no plano, portanto, é preferida. Para o crescimento da amostra S 2 , a pré-deposição de Al metálico foi realizada na câmara de crescimento MBE por 40 s. Então, o N 2 plasma e a fonte de Ga foram abertos simultaneamente. O fluxo de Ga para o S 2 o crescimento está resumido na Tabela 1, o mesmo com o de S 1 . A Figura 1c mostra a imagem FESEM de vista superior da amostra S 2. É bastante interessante que o GaN cresça na forma de rede nanowall no Al / Si (111). Os nanowalls com diâmetro de 50 ~ 100 nm se sobrepõem e se entrelaçam, formando uma rede contínua no plano, ou seja, a rede nanowall. Duas classes de orifícios são observáveis, denominadas classe A e classe B. Os diâmetros dos orifícios da classe A e da classe B são tipicamente, 50 ~ 100 e 10 ~ 49 nm, respectivamente. A característica contínua no plano torna a rede do nanowall no painel eletricamente condutora [18], removendo os obstáculos da fabricação do nanodispositivo até certo ponto. A superfície superior dos nanowalls é relativamente plana, diferente da matriz de GaN facetada relatada na Ref. [13]. É observável que os orifícios mostrados na imagem de vista superior se estendem para perto do substrato, conforme indicado pelo retângulo na Fig. 1d.
Alguém pode se perguntar como os furos mencionados acima são gerados. Crescemos uma amostra S 5 a uma temperatura de crescimento inferior de 900 K. Os outros parâmetros de crescimento são os mesmos com a amostra S 2 , como mostrado na Tabela 1. Da Fig. 1g, observamos que a amostra S 5 também cresceu na forma de rede nanowall com orifícios menores. A Figura 1h é a imagem em corte transversal de S 5 , mostrando uma camada mais compacta do que S 2. A fim de ver o crescimento inicial da rede nanowall de GaN, aumentamos outra amostra S 4 em pouco tempo com a pré-deposição de Al. Todos os parâmetros de crescimento de S 4 são iguais aos da amostra S 2 exceto para o tempo de crescimento (20 vs 120 min). A espessura de S 4 é de cerca de 50 nm e sua imagem de vista superior é mostrada na Fig. 1f. Observa-se que buracos foram formados neste estágio e o GaN como vestido é uma rede contínua no plano, ao invés de nanofios ou ilhas de GaN. Do estudo das amostras S 1 , S 2 , S 4 e S 5 , é claro que a pré-deposição da camada de Al muda o comportamento de crescimento de GaN no início, da nanocoluna para a rede de nanopasse contínua no plano.
Observe que todas as condições de crescimento de S 2 exceto que a pré-deposição de Al é a mesma de S 1 . Então, podemos nos perguntar qual é a estrutura do Al pré-depositado e como isso afeta o crescimento subsequente do GaN. Para encontrar essas respostas, a pré-deposição de Al por 40 s no Si puro (111) é investigada por FESEM e AFM. A Figura 2a mostra a imagem da vista superior do Al pré-depositado. Verificou-se que o Al no substrato de Si existe na forma de gotículas (pontos brancos) diferente de filme. As gotículas de Al metálico com densidade de ~ 4 × 10 7 mm - 2 distribuir relativo uniformemente sem acúmulo significativo. Recentemente, as gotículas de Al foram cultivadas com sucesso usando MBE por Li et al. para melhorar a qualidade do GaN conforme crescido, bem como reduzir o estresse [24]. Para estudar mais a morfologia das gotículas de Al, AFM foi utilizado para medir suas imagens tridimensionais e parâmetros relacionados, como mostrado na Fig. 2b, c. As gotas são esféricas como mostrado na Fig. 2b, de acordo com o resultado SEM. A altura e o diâmetro da gota de Al medidos são 6,7 e 80 nm, respectivamente. Poppitz et al. [25] investigaram o crescimento da rede de nanowall de GaN em 6H-SiC (0001) por MBE assistido por feixe de ferro. Seus resultados mostram que as condições de crescimento extremamente ricas em N, em combinação com a alta temperatura do substrato e a irradiação energética de íons N durante o crescimento, são as principais razões para a formação da rede de nano-paredes em 6H-SiC nua (0001). Como pioneiro, Kesaria et al. [17] investigaram a rede de nanowall de GaN em substrato de safira nua usando PA-MBE. Em sua pesquisa, é considerado que os nanowalls de GaN nucleados na borda e os deslocamentos do parafuso e crescem sob atmosfera rica em N.
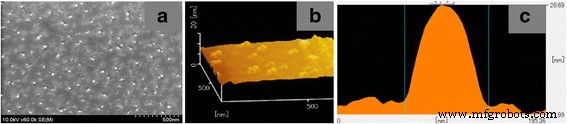
FESEM ( a ) e AFM ( b ) imagens do Al pré-depositado no substrato de Si. c Um parâmetro de medição de uma gota de Al por AFM
Em nosso caso, o mecanismo de crescimento da rede de nanoparques de GaN deve ser diferente, uma vez que os nanoparques crescem com a exigência da pré-deposição de Al metálico. É claro que, até onde sabemos, todas as redes de nanowall de GaN, incluindo em nosso experimento, são cultivadas sob a atmosfera rica em N. Rico em N é necessário para reduzir a coalescência dos nanowalls. Agora, vamos nos concentrar no papel das gotículas de Al na formação da rede nanowall. Semelhante às gotículas de Au atuando como um catalisador [26], se as gotículas de Al atuassem como um catalisador, o GaN deveria crescer para as nanocolunas, em vez da rede de nano-paredes. O papel das gotículas de Al, portanto, não é um catalisador em nosso estudo. A temperatura de fusão do metal Al é de 933 K, enquanto a temperatura do substrato é mantida em 973 K durante o crescimento. No início do crescimento de GaN, portanto, as gotículas de Al são gotículas líquidas. De acordo com relatório anterior, no caso de GaN em Si (111) com gotas de Ga [13], as gotas de Ga atuam como reservatórios que fornecem átomos de Ga para sua vizinhança próxima. As próprias gotículas de Ga, no entanto, impedem o crescimento de GaN nelas, uma vez que os locais de gotículas de Ga originais são círculos ocos. Em nosso caso, o diâmetro das gotículas de Al é ~ 80 nm, semelhante ao tamanho dos buracos de classe A na Fig. 1a. Portanto, as gotículas de Al podem impedir o crescimento de GaN sobre elas, levando à formação dos buracos de classe A observados na rede de nanopartículas de GaN. Devido à mesma razão Ш / V das amostras S 1 e S 2 , o comprimento de difusão Ga L em Si para o crescimento da rede nanowall espera-se que seja o mesmo que para as nanocolunas. O tamanho típico do substrato de Si nu (a área sem gotículas de Al) é de ~ 80 nm, dentro do valor do diâmetro da nanocoluna na Fig. 1a. Em outras palavras, o comprimento de difusão de Ga L cobre o tamanho do substrato de Si nu, resultando no crescimento contínuo de GaN na área sem as gotículas de Al, ou seja, rede de nanowall de GaN.
Com base na análise acima, um modelo de crescimento da rede de nanopartículas de GaN é proposto e mostrado na Fig. 3. GaN nucleados no substrato de Si nu, conforme ilustrado na Fig. 3a. Desde o Ga ab comprimento de difusão L cobre o substrato de Si descoberto, GaN cresce em todo o substrato de Si descoberto, enquanto o crescimento de GaN acima das gotículas de Al é impedido (Fig. 3b). Além disso, sob condição rica em N, o GaN tende a crescer verticalmente, conforme mostrado na Fig. 3c. Como o substrato de Si puro é uma rede contínua no plano, o crescimento de GaN acima também é uma rede contínua chamada rede nanowall, conforme ilustrado na Figura 3d. Esta suposição é confirmada pela imagem de vista superior da amostra S 4 na Fig. 1f. Devido à condição de N-rico para a amostra S 2 crescimento, o crescimento lateral é limitado que os buracos são capazes de reservar no crescimento subsequente. Observe que tanto as gotículas de Al quanto a condição rica em N são essenciais para o crescimento da rede de nanopartículas de GaN.
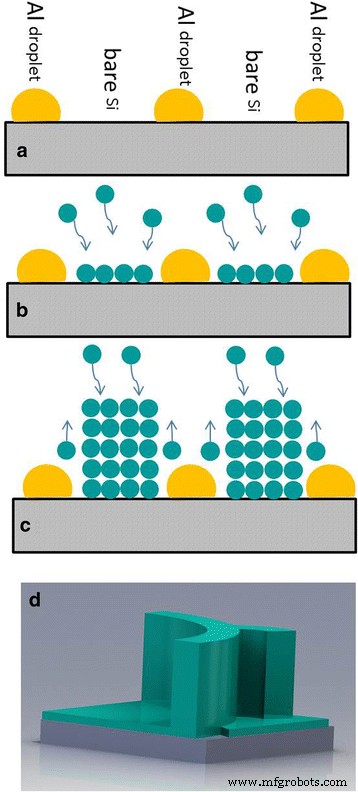
Modelos de crescimento da rede de nanowall de GaN. a As gotículas de Al pré-depositadas no substrato de Si. b Nucleação da rede de nanowall de GaN no Si nu. c Ilustração em corte transversal da rede nanowall de GaN crescida verticalmente na condição rica em N. d Incline a ilustração da rede nanowall de GaN
A difração de raios X foi utilizada para a caracterização da estrutura cristalina da rede de nanopartículas de GaN, conforme mostrado na Fig. 4. Dois picos de difração de GaN (002) e GaN (004) são observados juntamente com o pico de Si (111) do Substrato de Si. O resultado revela que a rede de nanopartículas de GaN é hexagonal e se orienta altamente ao longo de C eixo. Além do padrão de XRD, a curva oscilante ω-scan do GaN (002) também foi medida como mostrado na inserção da Fig. 4. A largura total na metade do máximo é 52,2 arcmin, semelhante ao relatório anterior cultivado na safira substrato [27]. As propriedades elétricas também foram medidas usando o sistema de medição Van der Pauw Hall (HL5500PC, Nanometrics) a 293 K. A condutividade elétrica, a mobilidade Hall e a concentração de elétrons da rede de nanowall de GaN são 10,2 S / cm, 31 cm 2 / Vs e 2.1 × 10 18 cm - 3 , respectivamente. Quanto ao filme GaN, a condutividade elétrica aumenta para 666,7 S / cm devido à maior concentração de elétrons de 2,2 × 10 20 cm - 3 . A alta concentração de portadores no filme é provavelmente atribuída à alta concentração de defeitos intrínsecos gerada pela razão Ga / N não otimizada. Quanto à mobilidade do hall do filme, o valor é 18,7 cm 2 / Vs.

Padrão de difração de raios-X da rede nanowall de GaN (S 2 ) A inserção é a curva oscilante ω-scan da amostra S 2
A Figura 5 mostra os espectros de fotoluminescência da rede de nanopartículas de GaN com um laser He-Cd como fonte de excitação. De acordo com o relatório de Kesaria et al. [17], a comparação direta de catodoluminescência entre filme GaN, rede de nano-parede e nanocoluna cultivada em substrato de safira nua foi realizada. Seus resultados mostram que a emissão da borda da banda da rede de nano-painel é ligeiramente maior do que a da nanocoluna e muito maior do que a do filme. Uma ampla emissão de defeito centrada em 520 a 620 é observável para a rede de nano-parede, enquanto nenhuma emissão de defeito pode ser observada para a nanocoluna. Na Fig. 5, uma forte emissão de borda de banda centrada em 363,7 nm é observada com a largura total na metade do máximo de 14,1 nm. Bem de acordo com o relatório de Kesaria et al. [17], na faixa de 520 a 620 nm, uma ampla emissão verde-amarela atribuída a defeitos pontuais [28] é detectável, mas muito fraca, indicando alta qualidade do nanowall de GaN rede. Portanto, a luminescência da rede de nanoparques de GaN crescida no substrato de safira nua e no substrato de Si com as gotículas de Al é quase a mesma, embora o mecanismo de crescimento seja diferente.

Espectros de fotoluminescência (PL) da rede de nanopartículas de GaN medidos à temperatura ambiente
Conclusões
Neste trabalho, a mudança de estrutura do crescimento de GaN entre a nanocoluna, a rede de nanoparede e o filme compacto foi alcançada com sucesso em substrato de Si (111) usando MBE. As nanocolunas de GaN foram cultivadas no substrato de Si nu sob condição rica em N, enquanto o filme compacto foi cultivado com um fluxo de Ga melhorado. Ao adicionar uma camada de Al pré-depositada, o crescimento de GaN muda das nanocolunas para a rede de nanopasse contínua no plano. A camada de Al pré-depositada existe na forma de gotículas com altura e diâmetro típicos de 6,7 e 80 nm, respectivamente. O mecanismo de crescimento da rede nanowall é abordado. GaN cresce continuamente no substrato de Si exposto, enquanto o crescimento de GaN nas gotículas de Al é impedido, resultando na formação da rede de nanopartículas. Ambas as gotículas de Al e a condição rica em N são essenciais para o crescimento da rede de nanoparedes.
Nanomateriais
- Operadores C# Bitwise e Bit Shift
- C Estrutura e Função
- Equipe de Química e Indústria 4.0
- 5G e GaN:a mudança de LDMOS para GaN
- 5G e GaN:inovações futuras
- IoT e blockchain - Uma mudança de paradigma
- Diferença entre Estrutura e União
- Revelando a estrutura atômica e eletrônica das nanofibras de carbono de copo empilhado
- Estrutura e propriedades eletrônicas da nanoargila caulinita dopada com metal de transição
- Análise de refletância infravermelha de camadas epitaxiais de GaN dopado tipo n cultivadas em safira



