Um Memristor multinível baseado em filme fino HfO2 Al-Dopado
Resumo
A memória não volátil (NVM) desempenhará um papel muito importante nas tecnologias digitais de próxima geração, incluindo a Internet das coisas. Os memristores de óxido metálico, especialmente baseados em HfO 2 , têm sido favorecidos por muitos pesquisadores por causa de sua estrutura simples, alta integração, velocidade de operação rápida, baixo consumo de energia e alta compatibilidade com tecnologias CMOS avançadas (óxido metálico complementar). Neste artigo, uma resistência estável de 20 níveis declara HfO dopado com Al 2 com base em memristor é apresentado. A duração dos ciclos, o tempo de retenção de dados e a taxa de resistência são maiores que 10 3 ,> 10 4 s e> 10, respectivamente.
Histórico
Embora o fenômeno de resistência negativa tenha sido descoberto inicialmente por Hickmott em um Al / Al 2 O 3 / Au structure em 1962 [1], e Chua propôs o conceito de memristor em 1971 [2]. Não foi até que Strukov et al prepararam o TiO 2 baseado em memristor em 2008 [3] que as pessoas começaram a prestar atenção ao estudo sobre memristor. Atualmente, os pesquisadores prepararam memristores com mais de dezenas de materiais resistivos ativos, incluindo múltiplos óxidos complexos [4, 5], óxidos de metal como ZnO [6], TiO x [7], TaO x [8], e materiais bidimensionais [9, 10]. HfO 2 tem sido usado como dielétricos de porta de alto k em dispositivos CMOS devido à sua alta confiabilidade, velocidade de operação rápida e baixo consumo de energia [11, 12]. Também é preferido pelos pesquisadores como um material memristivo [13,14,15].
Memristor multinível pode ser amplamente usado como armazenamento de dados [16,17,18], cálculo lógico [19], dispositivo sináptico eletrônico [20,21,22,23] e assim por diante. Wang Y. [16] e Gao B. et al. [24] preparou memristores multinível dopando HfO 2 com Cu e Gd, respectivamente, mas eles só podem criar estado de armazenamento de 4 níveis, o que é difícil de atender às demandas dos aplicativos. Portanto, o estudo sobre HfO 2 Memristors multinível é de grande significado.
Métodos
Ti / Al:HfO 2 / Pt dispositivo foi fabricado como mostrado na Fig. 1a. A área da célula ativa foi definida pelo eletrodo superior de Ti (TE) de formato quadrado. Uma camada adesiva de Ti de 20 nm foi depositada por sputtering de corrente contínua (DC) em um substrato de silício, em seguida, um filme de Pt de 100 nm foi depositado como um eletrodo de fundo (BE). O HfO dopado com Al 20 nm 2 camada funcional foi depositada pelo reator de deposição de camada atômica (ALD) (R-150, Picosun, Espoo, Finlândia) a 300 ° C com MeCp 2 HfMe (OMe) (denotado como HfD-04) como o precursor Hf, e H 2 O como fonte de oxigênio [25]. Os precursores foram transportados por N 2 de alta pureza (> 99,999%) na câmara do reator. Filmes dopados com Al foram obtidos depositando um ciclo de Al 2 O 3 a cada 8 ciclos de HfO 2 com o trimetilalumínio (TMA) como fonte de Al e H 2 O como fonte de oxigênio. A concentração atômica de Al de 6,2% é detectada por espectroscopia de fotoelétrons de raios-X (XPS, Axis Ultra DLD, Kratos Analytical, Manchester, UK) em um sistema Theta 300 XPS da Thermo Fisher. Um filme de Ti de 50 nm como TE e Pt de 100 nm como camada de cobertura foram depositados por pulverização catódica DC. Os dispositivos são obtidos padronizando o TE por litografia óptica e processo de decolagem. A Figura 1b é a micrografia óptica dos dispositivos. Preparamos dispositivos com diferentes áreas que variam de 5 μm × 5 μm a 500 μm × 500 μm.
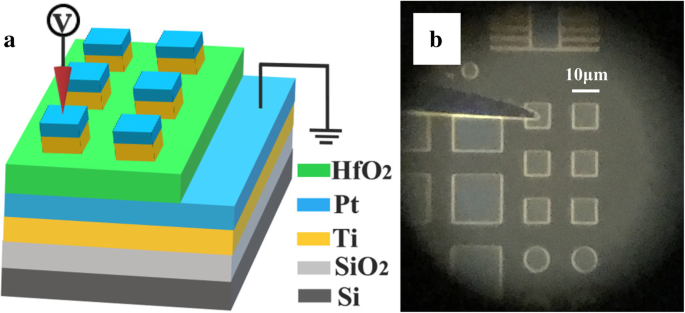
A estrutura dos dispositivos. a Modelo 3D dos memristores. b Microscopia ótica dos dispositivos
Resultados e discussão
A Figura 2 mostra o XPS de dispositivos dopados e não dopados com Al. Em comparação com os espectrogramas de dispositivos não dopados, os dispositivos dopados com Al mostram um pico distinto de 74,1 eV de Al 2p na Fig. 2a, e a energia de ligação de Hf 4f tem um certo aumento na Fig. 2b. A proporção de Hf 4f 5/2 para Hf 4f 7/2 também aumentou para os dispositivos dopados. É consistente com os outros relatórios [14, 26, 27]. Os átomos de Al se ligam à estrutura de HfO2 para formar Hf-Al-O, o que resulta nas ligações Hf-O mais fracas e mais facilmente quebráveis.

O XPS de dispositivos dopados com Al e não dopados. a Al 2p e b Hf 4f são comparados
Para todas as medições elétricas, o Ti TE foi polarizado enquanto o Pt BE estava aterrado. Varreduras CC foram realizadas usando um analisador de parâmetros B1500A (Santa Clara, CA, EUA) com uma unidade de fonte / medição, e medições elétricas de pulso com um gerador de forma de onda / unidade de medição rápida também são usadas. Todos os dispositivos apresentam estado de alta resistência (HRS) antes de um necessário processo de conformação elétrica. A Figura 3a mostra a característica de formação dos dispositivos dopados e não dopados com Al de 10 μm × 10 μm. A conformidade atual durante a formação é necessária para proteger os dispositivos de serem danificados. A resistência inicial e a tensão de formação do dispositivo não dopado são maiores. A oscilação na região de baixa tensão do dispositivo não dopado ocorre porque a corrente é inferior ao limite de medição do instrumento. O processo de reinicialização após a etapa de formação é motivado pela aplicação de uma tensão negativa, conforme mostrado na Fig. 3a, e então o primeiro processo definido é motivado. À medida que a amplitude da tensão de reinicialização aumenta, a corrente de ambos os dispositivos aumenta até um máximo maior do que a corrente limitada de formação e, em seguida, diminui. As correntes HRS de ambos os dispositivos são várias ordens maiores do que no estado inicial na mesma tensão. Isso sugere que ainda há filamento condutor que não pode ser fundido completamente após a reinicialização. As curvas I – V de ajuste / reinicialização típicas na Fig. 3b mostram que a tipologia desses dois dispositivos é o modo de operação bipolar [28]. A relação de comutação e a tensão de ajuste / reset do dispositivo dopado com Al são menores do que as do dispositivo não dopado, mas seu processo de transformação do estado de resistência é mais suave, adequado como um dispositivo de armazenamento de vários valores.
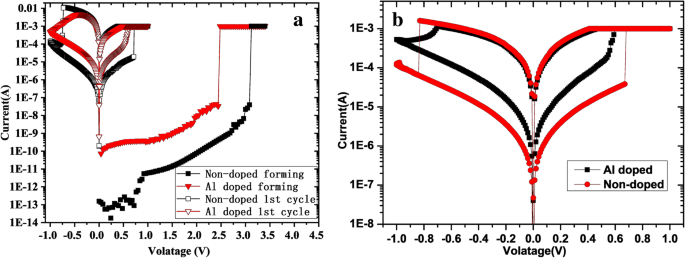
As características I / V dos dispositivos. a O processo de formação e primeiro ciclo. b O processo típico de configuração / reinicialização
Para esclarecer os mecanismos de chaveamento dos dispositivos, as curvas I – V são traçadas em dupla escala logarítmica na Fig. 4. Para ambos os tipos de dispositivos, a curva de baixa resistência exibe um comportamento óhmico linear, o que indica a formação de filamentos condutores em HfO 2 filmes durante sua configuração [29, 30]. No entanto, as curvas de alta resistência são bastante diferentes entre esses dois tipos de dispositivos. Para o dispositivo dopado, é composto por três regiões:a região ôhmica (I∝V), a região da lei de criança (I∝V 2 ), e a região de aumento de corrente íngreme, que está de acordo com a característica I – V típica de corrente limitada de carga espacial controlada por armadilha (SCLC) [31, 32]. A curva de alta resistência do dispositivo não dopado é composta por duas regiões:a condução ôhmica (I∝V) na região de baixa tensão e o ajuste linear do lnI-V 1/2 na região de alta tensão (inserção da Fig. 4), confirmando o mecanismo de emissão de Schottky [15, 33].
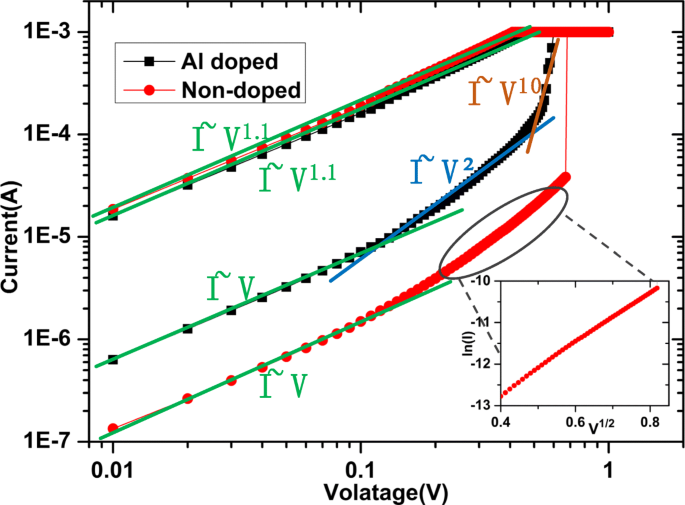
O ajuste da curva do processo SET nas coordenadas logarítmicas duplas
De acordo com as características acima, os mecanismos microscópicos dos memristores são resumidos a seguir. Para dispositivos não dopados, conforme a voltagem positiva aplicada ao eletrodo de titânio aumenta, mais e mais íons de oxigênio são gerados no HfO 2 e movem-se em direção ao eletrodo de titânio [34], produzindo óxido de titânio [35]. Ao mesmo tempo, as vacâncias de oxigênio se acumulam na interface entre o eletrodo de platina e o HfO 2 , formando filamentos condutores gradualmente [36]. Portanto, a corrente aumenta gradualmente com a tensão. Os dispositivos passam para o estado de baixa resistência (LRS) quando os filamentos condutores de vacâncias de oxigênio conectam o TE e o BE. Enquanto o eletrodo de titânio é aplicado com uma voltagem negativa, os íons de oxigênio se combinam com as vacâncias de oxigênio no HfO 2 / Interface Pt [37], que leva à menor concentração de vacância de oxigênio e à maior barreira de Schottky. Quando a tensão de reinicialização é atingida, o filamento condutor é rompido e o dispositivo é alterado para HRS.
Para dispositivos dopados com Al, os átomos de Al se ligam à estrutura do HfO2 para formar o Hf-Al-O, resultando em ligações Hf-O mais fracas e facilmente quebráveis. A energia de formação da vacância de oxigênio é reduzida. Portanto, os dispositivos de dopagem apresentam menor resistência e menor tensão de transição. Em filmes não dopados, as lacunas de oxigênio tendem a se acumular ao longo dos limites dos grãos [38, 39]. Como resultado, os filamentos condutores são poucos e grossos. A resistência dos dispositivos varia muito com a condução e quebra dos filamentos condutores. Nos filmes dopados, as lacunas de oxigênio são facilmente formadas perto dos átomos de impureza [35, 40, 41]. A distribuição uniforme de uma grande quantidade de impurezas no filme fino faz com que os filamentos condutores sejam formados por vacâncias de oxigênio mais controláveis. Portanto, é mais fácil atingir vários valores de resistência.
Os dispositivos podem ser configurados para diferentes estados de resistência estável, alterando a conformidade atual do processo configurado. Vinte estados de resistência estáveis são obtidos ajustando a conformidade de corrente formando 0,5 mA a 10 mA com uma etapa de 0,5 mA na Fig. 5a. Como os estados de resistência definidos pela varredura DC, o consumo de energia é grande e a operação é complicada. Por outro lado, os valores de resistência são facilmente travados no LRS quando uma grande conformidade de corrente é usada. Este método também não é capaz de ajustar o HRS. Estados de resistência de vinte níveis alcançados pela alteração da amplitude da tensão de ajuste e reset do pulso. Para evitar a possibilidade de ultrapassagem de corrente e falha de ajuste / reset, a amplitude da tensão é limitada entre 1 V ~ 1,9 V para SET e -1 V ~ - 1,9 V para reset. Pode-se ver no diagrama de caixa (Fig. 5b) que a faixa de tensão permitida é dividida em 20 valores e o rendimento do dispositivo está excedendo em muito o nível 3 σ (99,73%). Este é um requisito comum na produção. A desvantagem deste método é que os dispositivos não podem ser definidos diretamente de um HRS (LRS) para outro HRS (LRS), mas precisam redefinir (definir) para LRS (HRS) primeiro e, em seguida, definir para o HRS alvo (LRS) . Isso aumenta a complexidade e o consumo de energia da operação.

O armazenamento de vários valores dos dispositivos. a Transforme os estados de resistência definindo as correntes de conformidade. b 20 estados de resistência estável obtidos pela configuração da amplitude da tensão de pulso. A largura e o intervalo do pulso são de 500 μs
Uma abordagem melhor é mostrada na Fig. 6. A condutância do dispositivo é incrementalmente aumentada ou diminuída por pulsos consecutivos. A duração e o intervalo do pulso são de 10 μs. A condutância é medida por um pulso de leitura de 0,1 V após cada pulso de ajuste / reinicialização. Conforme visto na Fig. 6, o número de pulsos necessários para definir / redefinir os dispositivos em diferentes níveis depende da tensão aplicada. As diferentes estátuas resistentes com 20 níveis são obtidas através de set e reset selecionando 0,5 V como tensão SET e - 0,7 V como tensão de reset respectivamente (Fig. 7). O dispositivo é redefinido para um HRS por 10 - 0,9 V pulsos consecutivos todas as vezes antes de definir para o status alvo ou definido para um LRS por 10 pulsos consecutivos de 0,8 V antes do ajuste. Considerando o mesmo estado presente no processo de set e reset, são obtidos 35 estados diferentes na sua totalidade. O desvio do número de pulso necessário para os dois estados de resistência adjacentes de set (reset) excede o nível 3 σ. A desvantagem é que se os valores de resistência dos dispositivos mudarem muito, o número de pulsos necessário será grande e a velocidade de operação será lenta.
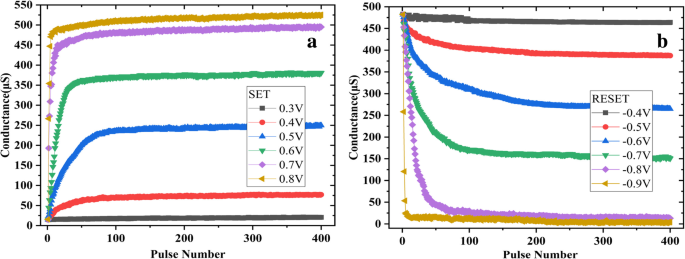
A resistência ajustada por pulsos consecutivos. a Definir processo e b processo de reinicialização

Número de pulso necessário para definir ( a ) ou redefinir ( b ) os dispositivos em 20 níveis diferentes
Para testar a retenção de dados dos dispositivos, 20 dispositivos são ajustados / resetados para uma série de diferentes valores de resistência, e mantidos em uma mesa de aquecimento a 85 ° C [42]. Os valores de resistência foram medidos com tensão de 0,1 V a cada 100 s. Pode ser visto na Fig. 8a que a resistência dos dispositivos se mantém estável após 10 4 s. Para testar a confiabilidade do ciclo do dispositivo, repetimos a operação de ajuste e reinicialização com um pulso de ajuste de 1,8 V / 500 µs e um pulso de reinicialização de - 1,8 V / 500 µs. Após 10 3 ciclos, a relação de comutação do dispositivo ainda é maior do que 10 na Fig. 8b.
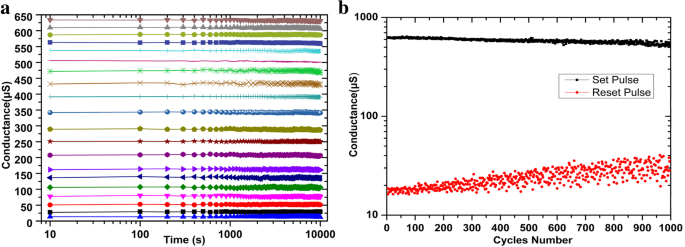
Os testes de confiabilidade dos dispositivos. a Características de retenção de dados após definir / redefinir as operações de pulso. b Curvas de resistência de ciclos para operações de ajuste / redefinição de pulso
Conclusões
O HfO dopado com Al proposto 2 memristor mostra um desempenho de ajuste / redefinição gradual e estável. Ao ajustar a curva de processo de conjunto dos dispositivos dopados e não dopados com Al, verifica-se que, no HRS, o dispositivo não dopado segue o mecanismo de emissão de Schottky, enquanto o dispositivo dopado com Al segue o mecanismo condutor do SCLC. O mecanismo físico microscópico de mudança de resistência também é discutido. Além disso, o armazenamento de vários valores do dispositivo foi confirmado alterando a corrente de complacência, ajustando a amplitude de tensão de pulso definida / redefinida e usando os pulsos curtos consecutivos. Finalmente, testamos a confiabilidade dos dispositivos para provar que eles têm uma retenção de dados de mais de 10 4 s (85 ° C) e uma relação de comutação maior que 10 após 10 3 ciclos.
Disponibilidade de dados e materiais
Todos os dados gerados ou analisados durante este estudo estão incluídos neste artigo publicado.
Abreviações
- ALD:
-
Deposição de camada atômica
- BE:
-
Eletrodo inferior
- CMOS:
-
Óxido de metal complementar de silício
- HfD-04:
-
MeCp 2 HfMe (OMe) Hf
- HRS:
-
Estado de alta resistência
- LRS:
-
Estado de baixa resistência
- NVM:
-
Memória não volátil
- SCLC:
-
Corrente limitada por carga espacial
- TE:
-
Eletrodo superior
- TMA:
-
Trimetilalumínio
- XPS:
-
espectroscopia de fotoelétrons de raios-X
Nanomateriais
- Autenticação de dispositivo baseada em X.509 no Eclipse Hono
- Nano grafema, memória transparente flexível à base de silício
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Fabricação de fossos em nanoescala com alto rendimento em filme fino de polímero usando litografia de aragem dinâmica baseada em ponta de AFM
- Preparação e Características Termoelétricas de ITO / PtRh:Termopar de Filme Fino PtRh
- Sensor de deformação ultrassensível baseado em filme piezoelétrico de poli (fluoreto de vinilideno) flexível
- Desempenho energético aprimorado com base na integração com os nanolaminados de Al / PTFE
- Projeto do sensor acústico de membrana basilar coclear biônica para seletividade de frequência com base em nanogerador triboelétrico de filme
- Ambarella, Lumentum e ON Semiconductor colaboram na detecção 3D baseada em processamento de IA para dispositivos AIoT de última geração
- Revestimento de película fina de nitreto de titânio e nióbio



