Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
Resumo
A polarização da superfície de nitreto de gálio de face Ga (GaN) (2 nm) / AlGaN (22 nm) / canal de GaN (150 nm) / tampão / Si com Al 2 O 3 camada de cobertura é investigada por espectroscopia de fotoelétrons de raios-X com resolução de ângulo (ARXPS). Verificou-se que a banda de energia varia de flexão para cima a flexão para baixo na região de interface, que se acredita estar correspondendo à variação de polarização. Uma camada interfacial é formada entre o GaN superior e Al 2 O 3 devido à ocorrência de quebra da ligação Ga – N e formação da ligação Ga – O durante Al 2 O 3 deposição via deposição da camada atômica (ALD). Acredita-se que esta camada interfacial elimine a polarização de GaN, reduzindo assim as cargas negativas induzidas pela polarização. Além disso, esta camada interfacial desempenha um papel fundamental para a introdução de cargas positivas que conduzem a banda de energia para baixo. Finalmente, um N 2 o recozimento a 400 ° C é observado para aumentar o crescimento da camada interfacial, aumentando assim a densidade de cargas positivas.
Histórico
O nitreto de gálio (GaN) é considerado um dos materiais semicondutores mais atraentes em muitos campos, desde indústrias de LED a indústrias de eletrônicos de energia [1, 2]. A popularidade se deve a uma série de vantagens em relação ao silício:alto campo elétrico de decomposição, alta mobilidade de elétrons e excelente estabilidade térmica [3, 4]. O transistor de alta mobilidade de elétrons GaN (HEMT) é amplamente estudado para aplicações de alta potência e alta frequência [1, 5, 6]. No HEMT, se a porta Schottky for adotada, esta interface de porta traz grandes estados de interface que exacerbam a grande corrente de fuga e o baixo campo de quebra [7]. Um isolador induzido como a camada de passivação superficial e dielétrico de porta poderia ajudar a mitigar os problemas acima [8,9,10].
Al 2 O 3 é preferido para tal aplicação de isolador devido ao seu grande gap, alta constante dielétrica e energia livre de Gibbs mais negativa em comparação com Ga 2 O 3 , então acredita-se que Al 2 O 3 poderia passivar os estados de superfície e melhorar o campo elétrico de colapso [5]. No entanto, uma camada interfacial é formada inevitavelmente no GaN / Al 2 O 3 interface após a deposição do Al 2 O 3 [11, 12]. Acredita-se que esta camada interfacial esteja correlacionada com a confiabilidade da tensão de limiar e propriedade do gás de elétron bidimensional (2DEG) e desempenha um papel fundamental no controle da curvatura da banda [2, 13,14,15,16].
Embora a camada interfacial tenha sido estudada por vários grupos de pesquisa, o papel desempenhado pela camada interfacial não foi explorado em profundidade [12, 17]. Portanto, neste trabalho, utilizamos a espectroscopia de fotoelétrons de raios X com resolução angular (ARXPS) para detectar as mudanças graduais da curvatura da banda e obter a estrutura atômica da camada interfacial [11]. Espessuras diferentes de Al 2 O 3 são depositados em amostras de GaN por deposição de camada atômica (ALD). ALD tira proveito de uma tecnologia de deposição camada por camada de baixa temperatura, que limita a reação térmica entre GaN e Al 2 O 3 . Assim, ALD é favorecido pelas indústrias para depositar dielétricos de alto k devido a sua alta conformabilidade e uniformidade, precisão no controle de espessura, alta qualidade de filme e baixa densidade de defeito [4]. Isso permite um Al 2 suave e de baixo defeito O 3 Interface / GaN. Depois de Al 2 O 3 deposição, uma amostra de recozimento pós-deposição (PDA) de 400 ° C também é preparada para intensificar a reação da camada interfacial, aumentando a formação da camada interfacial. Com base nos resultados do ARXPS, foi descoberto que a banda está se curvando para cima inicialmente do substrato de GaN para a interface próxima devido às cargas negativas induzidas pela polarização. No entanto, como um aumento no ângulo de detecção θ , a banda se curva para baixo gradualmente devido à formação de cargas positivas [5, 11,12,13].
Métodos
O wafer GaN / AlGaN / GaN-on-Si (111) Ga-face foi adquirido de uma empresa comercial (Enkris.com). A estrutura wurtzita epitaxial compreende uma camada de GaN de 2 nm no topo de uma camada de AlGaN de 22 nm, e as duas camadas epitaxiais são cultivadas em uma camada de i-GaN de 150 nm. Uma camada de buffer serve como uma camada de transição conectando a epilayer de GaN e o substrato de Si. Três amostras, S1, S2 e S3, são preparadas. Todas as amostras foram reduzidas primeiro por 5 min em acetona, seguido por imersão em álcool isopropílico e um enxágue em água corrente desionizada (DI). O óxido nativo foi então removido por ataque químico por imersão em uma solução diluída de HCl (HCl:H 2 O =1:10) por ~ 1 min, seguido por um enxágue em água DI. O Al 2 O 3 são depositados por ALD em cima de GaN, com trimetil alumínio (TMA) e H 2 O como precursor metálico e oxidante, respectivamente. O Al 2 O 3 a espessura é de 1 nm para a amostra S1 e 3 nm para as amostras S2 e S3. A espessura é medida pelo elipsômetro. Além disso, S3 foi submetido a PDA em N 2 a 400 ° C durante 5 min.
As medições ARXPS foram realizadas em um sistema Thermo Fisher Scientific Theta Probe equipado com uma fonte de raios-X monocromática e microfocalizada de Al Kα (1486,6 eV) e um analisador hemisférico de energia eletrônica. A calibração da energia de ligação (BE) foi realizada usando amostras padrão de Ni, Au, Ag e Cu puro, definindo a borda de Ni Fermi, Au 4 f 2/7 , Ag 3 d 5/2 e Cu 2 p 3/2 picos em 0,00 ± 0,02, 83,98 ± 0,02, 368,26 ± 0,02 e 932,67 ± 0,02 eV, respectivamente. O FWHM de um dado espectro de componente foi permitido variar dentro de uma faixa estreita apenas (± 0,1 eV). O menor número de espectros de componentes foi usado para obter valores residuais aceitavelmente baixos [11]. Os espectros XPS foram registrados em diferentes ângulos de detecção ( θ ), variando de 27,5 ° a 72,5 ° em relação à amostra normal em paralelo sem inclinar a amostra. Para remover um possível deslocamento de BE induzido por carga positiva, os espectros XPS obtidos foram referenciados ao C 1 s pico em 285,0 eV. A análise quantitativa, incluindo a determinação da relação elemento / ligação, foi obtida usando fatores de sensibilidade relativa e algoritmos embutidos no software Avantage [11].
Resultados e discussão
O Ga 3 d espectros de nível de núcleo para S1-S3 em diferentes ângulos de detecção de fotoelétrons são representados na Fig. 1a-c, respectivamente. Para S1, cada Ga 3 d espectro pode ser ajustado com dois picos, correspondendo às ligações Ga – N e Ga – O. As ligações Ga – O são devido à formação de óxido como resultado da exposição ao oxigenante no ALD, e o oxigenante penetrou no Al fino inicial 2 O 3 camada [3]. Para S2 e S3, três picos podem ser identificados, notados como Ga – N, Ga – O e O 2 s , respectivamente. O 2 s o pico é atribuído às ligações Ga – O e Al – O, e se torna óbvio quando o ângulo de detecção está se tornando maior. Como este artigo não está focado neste pico, não será discutido mais adiante. A Figura 2 apresenta o BE dos picos de Ga – N em função de θ para S1 – S3. Uma diminuição de 0,2-eV é obtida de θ =27,5 ° a 72,5 ° para S1. Sugere uma curvatura da banda para cima, o que está de acordo com as publicações [3, 11]. Para S2, o BE apresenta uma diminuição de 0,1 eV, indicando uma leve curvatura da banda para cima perto da interface em comparação com S1 ou uma banda de energia plana sem curvatura da banda em consideração ao erro experimental. Porém, para S3, há um aumento de 0,2 eV no BE, o que está em contraste com as amostras S1 e S2, aconselhando uma curvatura de banda para baixo. A Figura 3 registra o Al 2 p espectros para todas as amostras, e não há alteração nos BEs. Além disso, o pico é notado como a ligação Al – O e, conseqüentemente, a camada AlGaN tem influência desprezível na variação de Ga – N BE. A Tabela 1 resume os BEs de Ga 3 d e Al 2 p em diferentes ângulos de detecção para todas as amostras, com o erro de ± 0,1 eV.

O XPS Ga 3 d espectros de nível de núcleo para a S1, b S2 e c S3

O BE do pico do espectro Ga – N em função do ângulo de detecção θ (em relação ao normal) para S2. A barra de erro é ± 0,1 eV

O XPS Al 2 p espectros de nível de núcleo para a S1, b S2 e c S3, e o pico indica a ligação Al – O. Além disso, não há variação significativa de BE
As razões do pico de Ga – O para Ga – N para todas as amostras são fornecidas na Tabela 2. A razão é de cerca de 0,2 para as amostras S1 e S2, o que é consistente com os resultados anteriores [3]. No entanto, após o tratamento com PDA, a proporção aumenta para ~ 0,3 e denota um aumento do GaO x camada interfacial. Além disso, a razão Ga / N também é dada na Tabela 2. A razão é calculada comparando as intensidades integradas do Ga 3 d e N 1 s picos com fatores de sensibilidade atômica [18]. Para as amostras S1 e S2, a razão em torno de 1,7 sugere uma camada interfacial rica em Ga. No entanto, após o N 2 recozimento, a proporção diminui para ~ 1,0. Além disso, a profundidade de amostragem também é fornecida na Tabela 2 para cada ângulo. Por causa da atenuação exponencial de fotoelétrons, 63 e 95% dos elétrons detectados se originam de uma distância de 1λ (ou seja, λ representa o caminho livre médio inelástico do elétron (IMFP)) e 3λ, respectivamente, da superfície. Portanto, a profundidade de amostragem XPS é definida como 3λ nanômetros abaixo da superfície da amostra. Em nosso caso, Al 2 O 3 é a camada de cobertura e o λ de Ga 3 d fotoelétrons em Al 2 O 3 é estimado em ~ 3,4 nm. Para uma estimativa aproximada, a profundidade de amostragem em ângulos diferentes é dada como 3λcos θ . No entanto, a profundidade de amostragem Ga – N BE real deve considerar a espessura de Al 2 O 3 , então a profundidade de amostragem é estimada em 3λcos θ menos o limite Al 2 O 3 grossura. Porque o GaO x camada está no topo da heteroestrutura de GaN, o sinal desta camada é incluído para cada ângulo de detecção. Porém, com o aumento do ângulo de detecção, a intensidade do sinal da ligação Ga – N diminui, resultando no aumento da razão Ga – O / Ga – N. Comparando S2 a S3, o aumento da razão Ga – O / Ga – N e a diminuição da razão Ga / N sugerem que a camada rica em Ga foi oxidada para formar GaO x .
Para ilustrar os dados experimentais apresentados aqui, um modelo é esquematicamente proposto na Fig. 4. O nível de energia de Fermi do substrato GaN / AlGaN / GaN é calibrado como 0 eV durante a medição XPS [19]. São fornecidos o máximo da banda de condução (CBM), máximo da banda de valência (VBM) e o nível do núcleo. O BE é a diferença de energia entre o nível do núcleo e o nível de Fermi. Na deposição ALD, O do oxigenante pode substituir N na ligação Ga – N para oxidar o GaN e os átomos de N circundantes podem formar N 2 moléculas [20], o que leva à formação da camada rica em Ga e óxido de gálio (GaO x ) camada interfacial [11, 18]. Isso é apoiado pela razão Ga / N que é maior que 1 na Tabela 2. Esta razão indica a mudança da estequiometria de GaN, e o efeito de polarização espontânea intrínseca de GaN deve desaparecer [21,22,23]. Como resultado, a camada rica em Ga, como o GaN-to-GaO x camada de transição, elimina as cargas negativas induzidas pela polarização e resulta em uma banda de condução plana [11], como mostrado na Fig. 4.
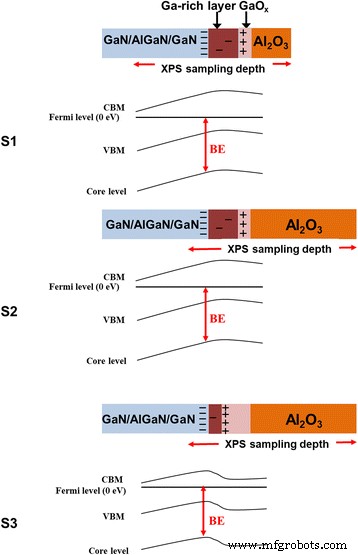
Na região da interface, O substituindo N na ligação Ga – N resulta em uma camada rica em Ga e um GaO x camada. A camada rica em Ga atua como GaN para GaO x camada de transição. A formação Ga – O elimina a polarização de GaN e atua como cargas positivas. Como resultado, a banda de condução se curva gradualmente de cima para baixo e o BE varia em conformidade
Além disso, no processo de recozimento, a superfície rica em Ga é oxidada para formar um GaO mais espesso x camada. Como a oxidação é uma reação cineticamente limitada e restrita a cerca de duas monocamadas de superfície, o volume não será fortemente perturbado [24]. Portanto, o sinal de ligação Ga-N é principalmente do volume subjacente não oxidado, resultando na razão estequiométrica Ga / N de 1 para S3. O GaO x foi relatado que a camada traz cargas positivas que podem ser cargas fixas interfaciais com estados de energia entre os mínimos da banda de condução do óxido nativo e GaN, o que dobraria a banda para baixo [4, 11, 13, 14]. Portanto, a banda de condução da camada rica em Ga começa a diminuir na região próxima ao GaO x camada. Um GaO mais espesso x espera-se que traga uma maior densidade de cargas positivas. Com relação à constante BE de Ga – O e Al – O em S3, indica que a carga positiva deve se localizar na interface da camada rica em Ga / GaO x camada. As cargas positivas e as cargas negativas induzidas por polarização constroem um campo elétrico interno que modificou a curvatura da banda da curvatura para cima para a curvatura da banda para baixo, mostrada na Fig. 4. Por causa da curvatura da banda para baixo, o BE aumenta com o aumento do ângulo de detecção .
O GaO x camada interfacial traz cargas positivas que aumentam a altura da barreira da interface ɸ b . ɸ b é definido como a diferença de energia entre o nível de Fermi e o mínimo da banda de condução na superfície ou interface [25]. Como resultado, após o A 2 O 3 deposição, a mobilidade do 2DEG é aumentada e a densidade eletrônica do 2DEG é diminuída [16, 25, 26].
Com o aumento do Al 2 O 3 espessura, o sinal XPS reflete mais na região de interface entre o Al limitado 2 O 3 e GaN / AlGaN / GaN, que é validado pela profundidade de amostragem XPS mostrada na Tabela 2. Isso explica que apenas parte do perfil de flexão da banda pode ser detectado para S2 [27]. Como resultado, a variação de BE é de 0,1 eV, menor que 0,2 eV de S1. Para S3, com uma camada interfacial mais espessa, a densidade de cargas positivas é aumentada, resultando em uma curvatura de banda para baixo.
Conclusões
Em resumo, a polarização da interface de Al 2 O 3 -capped GaN / AlGaN / GaN é investigado pelo ARXPS. A polarização intrínseca de GaN é eliminada por causa de uma camada rica em Ga e um GaO x formação de camadas. Além disso, as ligações Ga – O do GaO x camada trazem cargas fixas interfaciais positivas. Devido a esta variação de polarização, a banda varia desde a curvatura para cima até a curvatura para baixo na região de interface.
Nanomateriais
- 5G e GaN:inovações futuras
- Impacto dos estados da superfície e da fração da toupeira de alumínio no potencial da superfície e 2DEG em HEMTs AlGaN / GaN
- Análise de refletância infravermelha de camadas epitaxiais de GaN dopado tipo n cultivadas em safira
- Células endoteliais de segmentação com nanopartículas de GaN / Fe multifuncionais
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Camadas ótimas de dopagem de silício de barreiras quânticas na sequência de crescimento, formando potencial de confinamento suave de oito períodos em 0,2Ga0,8N / GaN poços quânticos de azul LED…
- Uma investigação em uma célula solar de silício cristalino com camada de silício preta na parte traseira
- Compreendendo o mecanismo de crescimento de camadas epitaxiais de GaN em grafite esfoliado mecanicamente
- Recombinação controlada por tensão em poços quânticos múltiplos de InGaN / GaN em substratos de silício
- Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN



