Propriedades ópticas e eletrônicas de fotodiodos N + / P de silício hiperdopado com enxofre induzido por laser de femtosegundo
Resumo
A fotorresposta no infravermelho próximo (NIR) mediada por impurezas em silício é de grande interesse para fotovoltaicos e fotodetectores. Neste artigo, fabricamos uma série de n + / p fotodetectores com silício hiperdopado preparado por implantação de íons e laser pulsado de femtossegundo. Esses dispositivos mostraram um notável aprimoramento na absorção e fotorresposta em comprimentos de onda NIR. O dispositivo fabricado com dose de implantação de 10 14 íons / cm 2 exibiu o melhor desempenho. O método proposto oferece uma abordagem para a fabricação de fotodetectores à base de silício de banda larga de baixo custo.
Histórico
Os dispositivos tradicionais à base de silício não podiam mostrar a fotorresposta NIR desejável devido à limitação do bandgap óptico (1,12 eV) do silício [1], e muitas tentativas foram feitas para aumentar a absortância do material de silício, especialmente em comprimentos de onda NIR [2,3, 4,5,6,7,8,9]. A descoberta do silício supersaturado com calcogênio fabricado por irradiação a laser em SF 6 A atmosfera demonstrou uma abordagem para aumentar a absorção de sub-bandgap [10, 11]. Nesse processo, o material pode ser dopado além do limite de solubilidade [12]. Além disso, o efeito de captura de luz causado pela estrutura única do cone pontiagudo na superfície de silício também aumenta a eficiência de absorção da luz [13]. Neste artigo, fabricamos silício hiperdopado preparado por implantação de íons e laser pulsado de femtossegundo. A medição Hall foi realizada para medir as propriedades elétricas do silício hiperdopado. Fotodetectores baseados em n + A junção / p demonstrou alto desempenho na absorção de NIR e na fotorresposta.
Métodos
Bolachas de silício tipo p polido de um lado [100] (300 μm) com resistividade 8–12 Ω cm foram implantadas com íons 1,2 keV 32 S + a uma profundidade de aproximadamente 40 nm à temperatura ambiente. As doses de implantação foram 1 × 10 14 , 1 × 10 15 e 1 × 10 16 íons / cm 2 . A fusão a laser pulsada (PLM) foi realizada por um trem de 1 kHz de 100 fs, pulsos de laser de femtossegundos de 800 nm com uma fluência de 0,5 J / cm 2 . Em seguida, o ponto de laser de 200 μm de diâmetro é focado no silício e em áreas quadradas padronizadas de até 10 mm × 10 mm. O recozimento térmico rápido (RTA) foi implementado a 600 ° C por 30 min em um N 2 atmosfera.
Determinamos a absorção ( A ) das amostras medindo a refletância ( R ) e transmitância ( T ) usando um espectrofotômetro UV-Vis-NIR (UV3600, Shimadzu, Tóquio, Japão) equipado com um detector de esfera integrante [3]. A absorção foi calculada por A =1- R - T . A concentração e a mobilidade dos portadores foram medidas pelo sistema de medição do Efeito Hall em temperatura ambiente (via técnica de van der Pauw) [14]. Para investigar se a impureza / banda intermediária (IB) formada por impurezas de enxofre no silício aumenta a fotorresposta sub-bandgap, empregamos um método de espectroscopia de fotocorrente com transformada de Fourier, conforme descrito na Ref. [15, 16], onde a fonte de luz FTIR globar picada é focada na amostra e a fotocorrente gerada é então demodulada por um amplificador lock-in externo e finalmente realimentada de volta para a porta externa do FTIR.
Resultados e discussão
A Figura 1 mostra a absortância de amostras de silício implantadas em diferentes doses. As amostras processadas com PLM mostraram a maior absortância nos comprimentos de onda visível e NIR, enquanto as amostras implantadas mostraram a menor absortância. No entanto, o processo de recozimento reduz a absorção na região NIR dos espectros. A alta absortância Vis-NIR do silício microestruturado é atribuída às seguintes razões:banda de impureza induzida por hiperdopagem e efeito de captura de luz gerado pela superfície microestruturada. Conforme ilustrado na Fig. 1d, uma banda de impureza induzida por dopantes é formada em silício, que é responsável pela absorção de sub-bandgap [17]. Consequentemente, o silício hiperdopado mostra alta absortância na faixa de NIR. Enquanto isso, o derretimento a laser reconstrói a superfície do silício e produz uma matriz de cones que leva à reflexão e absorção múltiplas [13], conforme mostrado na Fig. 1e, f. O recozimento processado evidentemente reduz a absortância na faixa de comprimentos de onda do NIR, que é causada principalmente pelos dois aspectos:(1) aniquilar as nanoestruturas na superfície do silício, diminuindo o efeito de captura de luz [18]; e (2) resultam no rearranjo da ligação dentro da matriz de silício, que inativam opticamente as impurezas de enxofre [11].
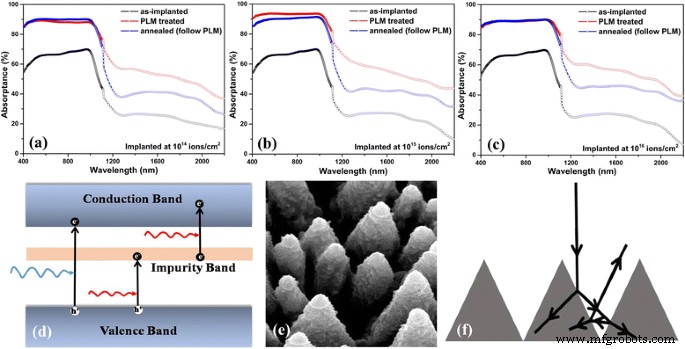
a - c Dependência da absortância em diferentes processos de fabricação com várias doses de implantação. d A banda de impureza localizada dentro do bandgap de Si facilita a geração de portadores que participam da absorção de fótons de menor energia. e Micrografia eletrônica de varredura de pontas de silício. f Ilustração do caminho óptico na superfície microestruturada
Por causa da estrutura de superfície semelhante criada pelos mesmos parâmetros de laser, a intensidade de absorção na faixa NIR depende principalmente dos níveis de impureza do dopante [19]. No passado, ilustramos os possíveis níveis de energia relacionados a S correspondentes às características espectrais de fotoresposta [20]. Ele mostrou que o grande aumento observado na região NIR resultou de forma dependente do nível de energia relacionado ao S (~ 614 meV), o que aumentou muito a absortância sub-bandgap. Antes do processo de recozimento, a absorção não tem nenhuma mudança dramática em relação à dose de dopagem, conforme mostrado na Fig. 2a. O silício microestruturado com 10 16 e 10 15 íon / cm 2 dose de implantação mostra absortância semelhante, e a amostra implantada em 10 14 íons / cm 2 mostra diminuição imperceptível. Consideramos que a menor absortância para amostras recozidas na faixa NIR pode ser atribuída aos dois aspectos. M. A. Sheehy et al. [21] propuseram que a diminuição da absorção abaixo do bandgap após o processo de recozimento é atribuída à difusão dos grãos cristalinos para os limites dos grãos dos dopantes supersaturados e defeitos. Esses defeitos incluem vagas, títulos pendentes e títulos flutuantes. Uma vez que os defeitos se difundam para os contornos dos grãos, eles não contribuiriam mais para as bandas de impureza no Si, reduzindo assim a absorção da radiação abaixo do bandgap. Além disso, a literatura [22] relatou que nenhuma redistribuição notável de S ocorreu até que a temperatura de recozimento atingiu 650 ° C. Durante este processo, o S parece complexo com clusters defeituosos, o que significa que os átomos de S irão combinar uns com os outros na superfície do wafer de Si. Este fenômeno leva a uma redução da concentração de dopagem ativa.

a Dependência da absortância em diferentes doses de implantação de íons. Todas as amostras foram microestruturadas por PLM. b Propriedades eletrônicas do silício de referência e do silício microestruturado para diferentes doses de implantação de íons antes do recozimento e uma após o recozimento
A densidade de portadores e a mobilidade do silício microestruturado com diferentes doses de implantação de íons são mostradas na Fig. 2b. É evidente que a densidade da folha aumenta com a dose de implantação de íons e a mobilidade diminui com o aumento da dose de implantação de íons. De acordo com o efeito de recombinação Shockley-Read-Hall (SRH), em um semicondutor bandgap indireto como Si e Ge, o tempo de vida do portador diminui com o aumento da concentração de dopante [23, 24]. A diminuição da mobilidade leva a um aumento da probabilidade de recombinação, portanto, a diminuição da mobilidade resulta em uma diminuição no tempo de vida do elétron e a diminuição na mobilidade com o aumento da dose de dopagem é consistente com o efeito de recombinação SRH. Após o recozimento, a densidade do suporte da folha diminui drasticamente devido ao efeito de difusão térmica, conforme discutido anteriormente.
A Figura 3 mostra a fotorresposta com diferentes doses de dopagem, e a inserção mostra o diagrama do fotodetector n + / p. A fotorresposta na faixa NIR indica o aparecimento de banda mediada por impurezas. O pico proeminente em aproximadamente 960 nm corresponde à geração de pares elétron-buraco no substrato de silício, que são separados pelo potencial embutido de n + / p junção e coletados nos contatos de Al superior e inferior. Este fenômeno é bem conhecido como teoria da heterojunção em dispositivos de Si [25].
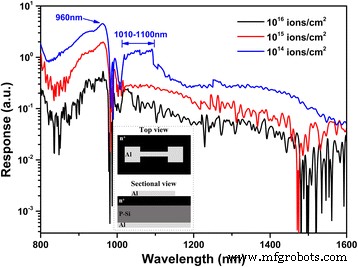
Fotorresposta de detectores n + / p com diferentes doses de implantação de íons. A inserção mostra a vista superior e a vista em corte do dispositivo. Cinza claro mostra os padrões de contato interdigitado na superfície microestruturada e todo contato permanente na parte traseira
A fotorresposta observada em NIR é atribuída aos níveis de impureza de enxofre no silício hiperdopado. Tais níveis de impureza facilitam a absorção de bandgap abaixo como mencionado acima. A luz NIR absorvida é convertida em pares elétron-buraco, resultando no aumento da fotorresposta na faixa NIR (1100 ~ 1600 nm) [20]. O dispositivo com dose de implantação de 10 14 íons / cm 2 mostra a fotorresposta mais alta na faixa de comprimento de onda de 1010–1100 nm. O pico largo foi investigado devido a níveis profundos de enxofre no silício processado a laser de femtosegundo [20, 26]. Além disso, descobrimos que o dispositivo com 10 14 íons / cm 2 mostrou maior fotorresposta do que aquelas com 10 15 e 10 16 íons / cm 2 . E a medição Hall indicou que a amostra implantada em 10 14 íons / cm 2 tinha uma concentração em massa de 10 19 íons / cm 3 . Conforme demonstrado pelo efeito de recombinação SRH, o tempo de vida do portador depende da concentração de dopante no silício. E. Mazur concluiu que a amostra com 10 19 íons / cm 3 era esperado que a concentração de dopante mostrasse uma vida útil mais longa do portador do que 10 20 e 10 21 íons / cm 3 [23]. Nossos resultados de medição Hall, amostra implantada em 10 14 íons / cm 2 mostra a maior mobilidade, estão de acordo com a conclusão. Com base nessa teoria, embora uma amostra com maior dose de dopagem apresente maior absortância, ainda existe um equilíbrio entre a absorção óptica e a mobilidade do portador. Conforme apresentado na Fig. 3, o dispositivo com 10 14 íons / cm 2 é mais provável que mostre a fotorresposta mais alta, o que é consistente com a conclusão relatada na Ref. [23].
Conclusões
Medimos a resposta de fotodetectores baseados em silício microestruturado com diferentes doses de implantação de íons. A incorporação de impurezas leva a um aumento notável na absorção e fotorresposta em comprimentos de onda NIR. E dispositivo implantado em 10 14 íons / cm 2 exibe a maior fotorresposta. PLM combinado com implantação iônica demonstra uma técnica considerável para a fabricação de detectores NIR. Esta técnica pode oferecer uma abordagem viável para fabricar fotodetectores baseados em silício de banda larga de baixo custo.
Nanomateriais
- Estrutura e propriedades eletrônicas da nanoargila caulinita dopada com metal de transição
- Modulação das propriedades de anisotropia eletrônica e óptica de ML-GaS por campo elétrico vertical
- Síntese fácil e propriedades ópticas de pequenos nanocristais de selênio e nanorods
- Estados eletrônicos do nanocristal dopado com oxigênio e emissão visível em silício negro preparado por ns-Laser
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Propriedades ópticas estruturais e de infravermelho próximo visível de TiO2 dopado com Cr para pigmentos frios coloridos
- Preparação e propriedades ópticas de filmes GeBi usando o método de epitaxia de feixe molecular
- Sondando as propriedades estruturais, eletrônicas e magnéticas dos aglomerados Ag n V (n =1–12)
- Propriedades de PCB automotivo e considerações de design



