Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN
Resumo
As propriedades interfaciais e elétricas da camada atômica de AlN depositada em n-GaN com diferentes espessuras de AlN foram investigadas. De acordo com a capacitância-tensão ( C - V ) características, a amostra com um AlN de 7,4 nm de espessura apresentou as maiores densidades de interface e armadilha de óxido. Quando a espessura de AlN era de 0,7 nm, os espectros de espectroscopia de fotoelétrons de raios-X (XPS) mostraram o pico dominante associado às ligações Al-O, junto com nenhum pico claro de AlN. A quantidade de átomos de oxigênio remanescentes perto da superfície de GaN diminuiu para o AlN mais espesso. No entanto, muitos átomos de oxigênio estavam presentes em toda a camada de AlN, fornecendo os defeitos relacionados ao oxigênio, que eventualmente aumentaram a densidade do estado da interface. O modelo de não homogeneidade de barreira com emissão termiônica (TE) foi apropriado para explicar a corrente de polarização direta para a amostra com AlN de 7,4 nm de espessura, o que não era adequado para a amostra com AlN de 0,7 nm. As correntes de fuga reversas para ambas as amostras com AlN de 0,7 e 7,4 nm de espessura foram melhor explicadas usando Fowler – Nordheim (FN) em vez de emissões de Poole – Frenkel.
Histórico
Por causa do grande intervalo de banda, alta velocidade de saturação de elétrons e alto campo de degradação, os materiais de nitreto III são de grande interesse não apenas para dispositivos optoeletrônicos, como diodos emissores de luz azul (LEDs), diodos laser (LDs) e detectores de UV, mas também para dispositivos eletrônicos, como transistores de alta mobilidade de elétrons (HEMTs) e dispositivos de potência [1,2,3,4]. A realização de dispositivos baseados em GaN de alto desempenho requer uma interface de metal / GaN com uma densidade de estado de interface mínima, que pode atuar como armadilhas de elétrons ou limitar para modular as alturas de barreira de acordo com a função de trabalho em metal fixando o nível de Fermi [5, 6]. Para outras técnicas de melhoria de dispositivo baseadas em GaN, alguns métodos, como supercrescimento de coalescência de nanocolunas de GaN, não polar m -plano GaN, modelo de nanoimpressão GaN e nanobastões de GaN de face semipolar também foram demonstrados [7,8,9,10,11]. Dentre os semicondutores compostos de nitreto III, o nitreto de alumínio (AlN) pode ser aplicado em detectores de UV, emissores e detectores de comprimento de onda curto, devido ao seu alto bandgap (∼ 6,2 eV), alta condutividade térmica, alta resistência elétrica, bem como baixa expansão em altas temperaturas [12, 13]. Além disso, o AlN pode ser depositado em um processo compatível com semicondutor de óxido metálico complementar (CMOS) por deposição de camada atômica (ALD) (~ 300 ° C), o que é uma grande vantagem. Filmes de AlN crescidos em ALD policristalino e amorfo podem ser usados como camada dielétrica para dispositivos microeletrônicos [14]. Apesar do progresso das técnicas de crescimento de AlN, o AlN crescido com ALD ainda revela propriedade não estequiométrica que contém uma grande quantidade de impurezas relacionadas ao oxigênio [15]. A quantidade de átomos de oxigênio no AlN pode afetar fortemente as propriedades elétricas e ópticas do AlN [16].
Alto- k óxidos dielétricos como Al 2 O 3 e HfO 2 têm sido empregados como uma camada de passivação em transistores de alta mobilidade de elétrons AlGaN / GaN (HEMTs) [17, 18]. Mas a formação de ligações Ga – O no Al 2 O 3 / A interface (Al) GaN é conhecida por produzir alta densidade de estados de interface profundos (e lentos) [19]. Como um material de passivação alternativo com baixos estados de interface, o AlN tem sido considerado para dispositivos baseados em GaN devido à sua menor incompatibilidade de rede com GaN [20, 21]. Além disso, a modulação de propriedades elétricas, como alturas de barreira em contatos de metal / semicondutor (MS) pela inserção de uma camada de óxido muito fina, foi relatada em GaN [22, 23]. Aumento da altura da barreira em Pt / HfO 2 / GaN metal-isolador-semicondutor (MIS) diodos com 5 nm de espessura HfO 2 camada foi relatada [22]. A inserção de uma camada de MgO de 3 nm em uma interface Fe / GaN foi encontrada para reduzir a altura efetiva da barreira para 0,4 eV [23]. Ainda agora, no entanto, há um número limitado de artigos relatando as propriedades de contato projetadas com AlN crescido em ALD em GaN. Neste trabalho, depositamos camadas de AlN sobre n-GaN por ALD com diferentes espessuras e investigamos as propriedades da interface AlN / n-GaN.
Métodos
Materiais e fabricação de dispositivos
Epitaxi de fase de vapor de hidreto (HVPE) crescido, sem dopagem, c -plane (0001) bulk GaN (espessura 300 μm, concentração de portador 5 × 10 14 cm −3 , densidade de deslocamento de rosca 1,5 × 10 7 cm −2 ) adquirido da Lumilog foi usado neste trabalho. Depois de cortar o wafer em pequenos pedaços, alguns deles foram carregados em uma câmara ALD após o processo de limpeza em um HCl:H 2 Solução O (1:1). Em seguida, a temperatura foi elevada para 350 ° C para depositar a camada de AlN. Filmes finos de AlN foram depositados por sistema ALD térmico (fabricante:CN-1 na Coréia; modelo:Atomic Classic) usando trimetilalumínio (TMA) e NH 3 como precursores. Três camadas espessas de AlN diferentes (0,7, 1,5 e 7,4 nm) foram preparadas variando o número de ciclos de ALD. As espessuras do filme de AlN foram medidas usando um elipsômetro FS-1 de múltiplos comprimentos de onda (fabricante:Film Sense nos EUA; modelo:FS-1). Para examinar as características elétricas dos filmes, diodos MIS foram fabricados com um eletrodo de Pt Schottky (diâmetro 500 μm, espessura de 50 nm) e um contato posterior de Al (espessura de 100 nm). Como referência, diodos Schottky Pt / n-GaN (isto é, sem camada de AlN) também foram fabricados.
Caracterização
Tensão-corrente dependente da temperatura ( I - V - T ) as medições foram realizadas com um analisador de parâmetro de semicondutor HP 4155B após a colocação de amostras em um mandril quente conectado a um controlador de temperatura e tensão de capacitância ( C - V ) as medições foram realizadas usando um medidor HP 4284A LCR. As medições de espectroscopia de fotoelétrons de raios-X (XPS) foram realizadas usando um Al Κα monocromático Fonte de raios-X para observar o mecanismo de formação na interface AlN / GaN.
Resultados e discussão
A Figura 1a-c mostra as imagens de microscopia eletrônica de transmissão de varredura em corte transversal (STEM) ao redor da camada de AlN. As espessuras estimadas das camadas de AlN foram semelhantes aos valores do elipsômetro. A tensão-densidade de corrente semilogarítmica típica ( J - V ) curvas são mostradas na Fig. 2a. Em comparação com a amostra sem AlN (isto é, amostra de referência), os valores de corrente aumentaram para a amostra com AlN de 0,7 nm de espessura e diminuíram para as amostras com AlN de 1,5 e 7,4 nm. Usando o modelo de emissão termiônica (TE) [24], o transporte de corrente de polarização direta de um diodo Schottky foi analisado para obter a altura da barreira e o fator de idealidade. As alturas das barreiras foram calculadas em 0,77 (± 0,03), 0,61 (± 0,01), 0,83 (± 0,05) e 1,00 (± 0,08) eV para as amostras com 0-, 0,7-, 1,5- e 7,4-nm- AlN espesso, respectivamente. Os fatores de idealidade encontrados foram 1,63 (± 0,18), 4,19 (± 0,16), 1,83 (± 0,33) e 1,57 (± 0,03) para as amostras com 0-, 0,7-, 1,5- e 7,4 nm de espessura AlN, respectivamente. Com um AlN de 0,7 nm de espessura, a altura da barreira diminuiu e o fator de idealidade aumentou. Com camadas mais espessas de AlN, o fator de idealidade foi semelhante, mas a altura da barreira aumentou em comparação com a amostra de referência. É visto na Fig. 2c que com o aumento da espessura de AlN, a altura da barreira diminuiu primeiro e, em seguida, aumentou devido à resistência de tunelamento induzida pela camada espessa de AlN. Isso indica que cerca de 0,7 nm é um ponto de viragem para a altura da barreira em termos de espessura de AlN.
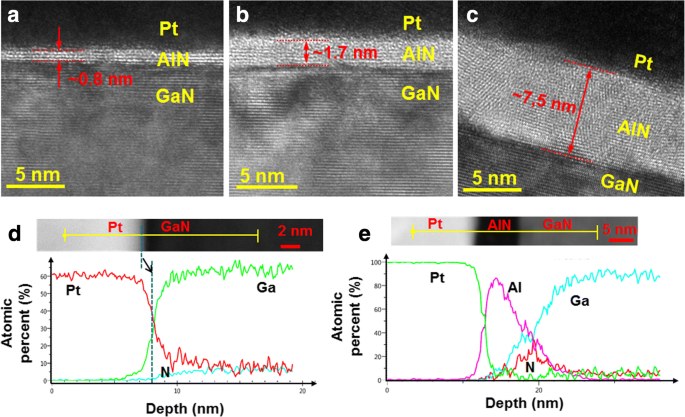
Imagens de microscopia eletrônica de transmissão de varredura transversal (STEM) com a 0,7-, b 1.5-, e c AlN de 7,4 nm de espessura. d , e Perfis atômicos de porcentagem vs. profundidade obtidos a partir de varreduras de linha de espectroscopia de raios-X dispersiva (EDS) para as amostras com AlN de 0 e 7,4 nm de espessura, respectivamente

a Corrente-tensão semilogarítmica típica ( I - V ) características. b Gráficos de fator de idealidade e altura de barreira. c Alturas de barreira e fatores de idealidade em função da espessura de AlN
A Figura 3 mostra o C - V curvas medidas em várias frequências. Quando as espessuras de AlN são 0 e 0,7 nm, a inversão nos valores de capacitância foi observada abaixo de 10 kHz. Em vez de inversão, depleção profunda é normalmente observada para materiais de bandgap largo como GaN devido à baixa taxa de geração de portadores minoritários (buracos) [25, 26]. Como mostrado na Fig. 3c, d, tal inversão não foi observada para camadas mais espessas de AlN. Aqui, deve-se notar que na junção Au / GaN, nenhuma inversão foi observada em baixas frequências. Usando espectroscopia transiente de nível profundo (DLTS), Auret et al. observaram defeitos induzidos por feixe de elétrons em junções Schottky Pt / n-GaN [27]. Aqui, realizamos medições de espectroscopia de energia dispersiva de raios-X (EDS) e os perfis de profundidade para as amostras com AlN de 0 e 7,4 nm de espessura são mostrados na Fig. 1d, e, respectivamente. É claramente visto na Fig. 1d que os átomos de Pt se difundiram na camada de GaN, enquanto a difusão dos átomos de Pt na camada de GaN foi suprimida efetivamente por causa da camada de AlN. Portanto, seria possível sugerir que defeitos induzidos pela deposição de Pt próximos à superfície de GaN produziram a capacitância de inversão em baixas frequências e a formação desses defeitos foi suprimida com uma camada de AlN relativamente espessa (> 1,5 nm).
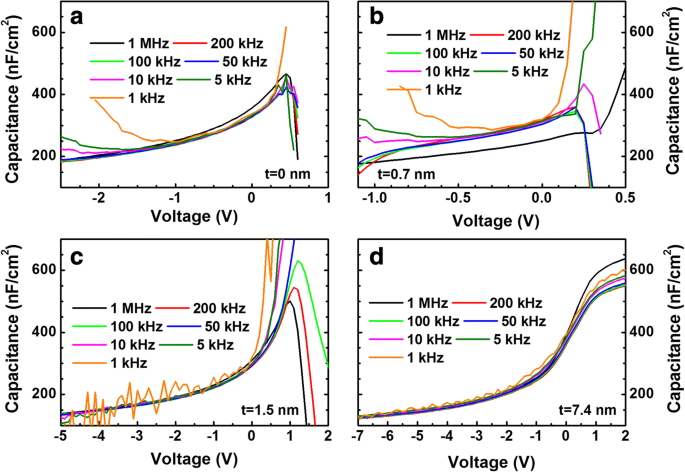
Capacitância-tensão ( C - V ) dados medidos em várias frequências para as amostras com a 0-, b 0,7-, c 1,5-, e d AlN de 7,4 nm de espessura
Exceto a amostra com um AlN de 7,4 de espessura, todas as outras amostras mostraram o pico anômalo no C - V curva com o aumento da tensão de polarização, que foram associados com a distribuição de armadilhas profundas no gap, a resistência em série e os estados de interface [28, 29]. A dispersão de frequência na região de acumulação está associada à formação de uma camada não homogênea na interface. A capacitância dessa camada atua em série com a capacitância do óxido causando a dispersão no acúmulo [30]. A dispersão no esgotamento é devido à presença de estados de interface respondendo à frequência aplicada. Se as constantes de tempo dos estados da interface são comparáveis à frequência do sinal pequeno, os estados da interface fazem uma contribuição para a capacitância total de forma que a capacitância limite aumenta com a diminuição da frequência [31].
A Figura 4 mostra a condutância-tensão ( G / ω - V ) curvas medidas em várias frequências. Sob polarizações direta e reversa suficientemente altas, os defeitos ativados poderiam se comunicar com os estados de interface vizinhos de forma mais eficaz em baixas frequências e, portanto, aumentariam a condutância. Aproximadamente na faixa de - 1 e 0 V, todas as amostras apresentaram aumento na condutância com o aumento da freqüência. Este comportamento tornou-se mais proeminente para a amostra com um AlN de 7,4 nm de espessura. O aumento da condutância com o aumento da frequência foi associado com os centros de recombinação promovendo corrente de recombinação na região de depleção e os estados de interface fornecendo corrente de carga e descarga ou processo de condução de salto ocorrendo em alta frequência [32]. Os resultados, portanto, indicam que os estados de interface com várias constantes de tempo estão presentes para todas as amostras, e a presença de tais defeitos é mais significativa para a amostra com um AlN de 7,4 nm de espessura.
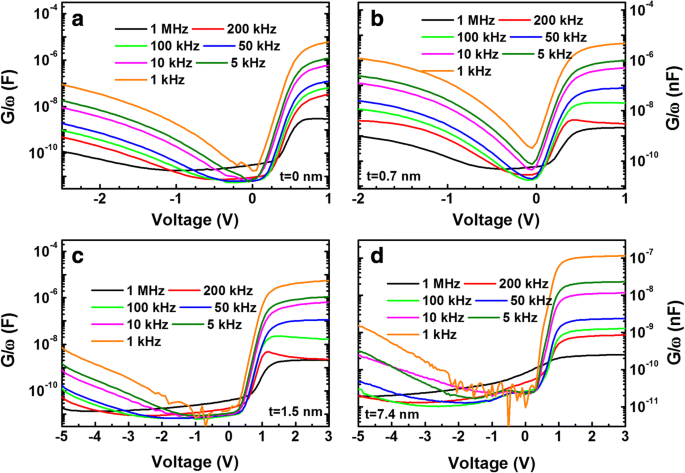
Tensão de condutância ( G / ω - V ) dados medidos em várias frequências para as amostras com a 0-, b 0,7-, c 1,5-, e d AlN de 7,4 nm de espessura
Conforme mostrado na Fig. 5a, uma estimativa da densidade do estado da interface ( D it ) foi feito aplicando o método Terman ao experimental C – V curvas medidas a 1 MHz [33]. O D obtido it vs. E C - E t (localização do estado da interface) é apresentado na Fig. 5b. Aqui, não analisamos o C – V curva da amostra com um AlN de 0,7 nm de espessura porque a amostra estava vazando e a capacitância de óxido exata ( C OX ) não foi bem definido. A amostra com AlN de 7,4 nm de espessura apresentou a maior densidade de estado de interface, especialmente para E C - E t > 0,4 eV. Além disso, a interface média e a densidade da armadilha de óxido ( Q T ) ao longo do intervalo de banda GaN ( E g ) foram calculados analisando C - V gráficos de histerese, usando a mudança de tensão de banda plana (Δ V FB ) por meio da equação Q T =( C OX Δ V FB ) / qE g [34]. A pequena mudança de tensão de banda plana e a pequena janela de histerese indicam uma baixa densidade de trap. A inserção na Fig. 4b mostra C - V gráficos de histerese. As densidades de carga presas foram calculadas em 4,2 × 10 9 , 9,3 × 10 9 e 3,6 × 10 11 cm −2 eV −1 para as amostras com AlN de 0, 1,5 e 7,4 nm de espessura, respectivamente. A histerese pode se originar das armadilhas de interface de AlN / GaN e das armadilhas de borda (ou massa) na camada de AlN. Como o método Terman, a camada de AlN de 7,4 nm de espessura revelou a interface mais alta e densidade de armadilha de óxido. Portanto, é possível sugerir nesta amostra que as armadilhas de borda na camada AlN, bem como as armadilhas de interface contribuíram significativamente para a mudança em C - V parcelas.
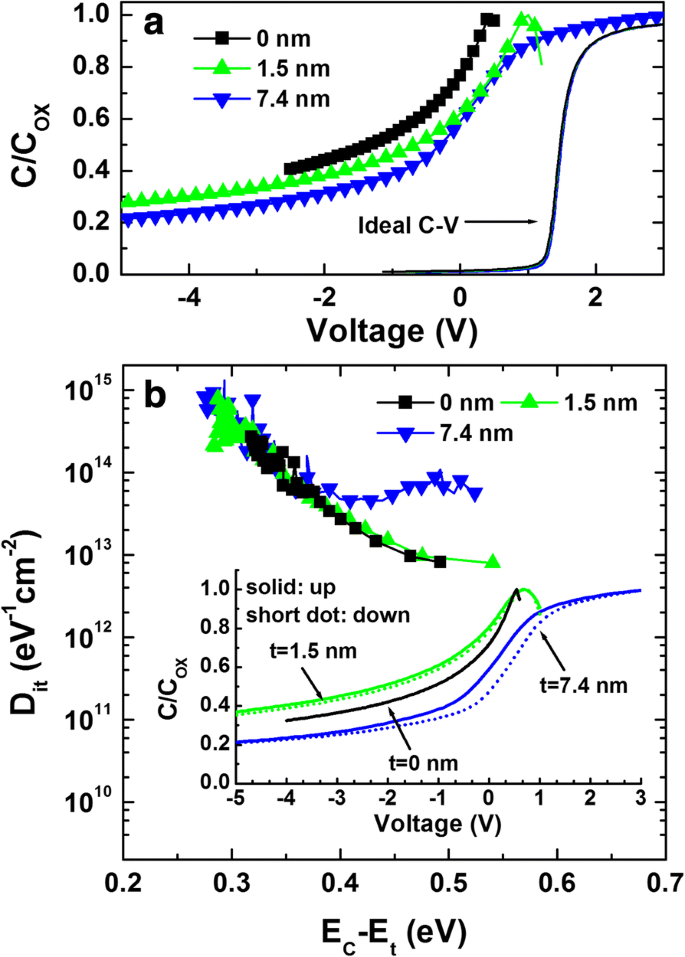
a Comparação de capacitância-tensão experimental ( C - V ) dados medidos a 1 MHz e C– V ideal dados e b densidade de estado da interface ( D it ) distribuições determinadas pela aplicação do método Terman para as amostras com camada de AlN de 0, 1,5 e 7,4 nm de espessura. A inserção em b mostra o C - V gráficos de histerese medidos em 1 MHz
A composição química na interface AlN / GaN foi investigada usando medições de XPS para duas amostras com AlN de 0,7 e 7,4 nm de espessura. Aqui, o tratamento de corrosão catódica foi realizado na amostra com um AlN de 7,4 nm de espessura porque a espessura do AlN era muito espessa para obter a informação exata perto da interface AlN / InP. Bare GaN também foi escaneado de superfície como referência. A Figura 6a mostra os perfis de profundidade XPS para cada elemento obtido da amostra com um AlN de 7,4 nm de espessura. A difusão de átomos de Ga na camada de AlN foi vista claramente. Uma grande quantidade de átomos de oxigênio foi encontrada na camada de AlN. No entanto, os átomos de O e Al não foram bem observados perto da interface AlN / GaN. A maior quantidade de oxigênio próximo à superfície do AlN, em comparação com a interface AlN / GaN, indica que uma parte significativa dele resultou da oxidação atmosférica, não do próprio processo de deposição de ALD. Em seguida, selecionamos os espectros XPS escaneados estreitos em uma profundidade de corrosão (a espessura do AlN remanescente foi de cerca de 1,5–2,0 nm) e os comparamos com os dados de outras amostras. A Figura 6b mostra o Ga 2 p 3/2 espectros de nível de núcleo. Os picos em ~ 1118,0 eV e ~ 1119,2 eV para o GaN vazio e a amostra com AlN de 0,7 nm de espessura estão associados com GaN e Ga 2 O 3 , respectivamente [35, 36]. O pico em ~ 1117,4 eV para a amostra com um AlN de 7,4 nm de espessura é devido ao Ga ligado ao AlN [37]. No entanto, não podemos descartar a possibilidade de que possa ser de Ga 2 O pico (~ 1117,3 eV) [38].

a Perfis de profundidade XPS para cada elemento obtido da amostra com um AlN de 7,4 nm de espessura. Espectros de nível de núcleo XPS de b Ga 3 p 3/2, c O 1 s , e d Al 2 p para as amostras com AlN de 0, 1,5 e 7,4 nm de espessura
Conforme mostrado na Fig. 6c, os picos em ~ 530,2 e ~ 531,9 eV são atribuídos ao O e Ga quimisorvido 2 O 3 , respectivamente [39]. Além disso, o pico em ~ 532,8 eV está associado ao Al – OH [40]. No entanto, nenhum pico peculiar foi observado para a amostra com um AlN de 7,4 nm de espessura na profundidade selecionada. Da mesma forma, nenhum pico foi observado nas profundidades de corrosão mais profundas (não mostrado). Quando a espessura do AlN é fina (0,7 nm), os átomos de oxigênio adsorvidos quimicamente foram removidos, mas os átomos de Al se ligaram ao OH. Com o aumento da espessura do AlN, muito pouca quantidade de átomos de oxigênio estavam presentes perto da região da superfície de GaN, indicando o efeito de limpeza. No entanto, uma grande quantidade de átomos de oxigênio estavam presentes na região de AlN crescida, desde cargas de óxido. O 1 s espectros de nível de núcleo nas profundidades de corrosão onde a quantidade de átomos de Ga são desprezíveis (cerca de 0 ~ 3 nm da superfície de AlN na Fig. 6a) foram encontrados para exibir o pico dominante em ~ 531,8 eV, associado com Al 2 O 3 [41]. Isso significa que alguma parte da camada AlN é composta de Al 2 O 3 . Como mostrado na Fig. 6d, o pico relacionado com AlN não é bem observado para a amostra com AlN de 0,7 nm de espessura. Em vez disso, dois picos são observados em ~ 74,1 e ~ 75,6 eV, associados com AlO x e Al – OH, respectivamente [42]. Esses picos relacionados à ligação Al – O, como AlO x e Al – OH podem atuar como defeitos. O pico em ~ 73,6 eV para a amostra com um AlN de 7,4 nm de espessura está associado ao AlN [43].
As propriedades de transporte de corrente para as amostras com AlN de 0,7 e 7,4 nm de espessura foram investigadas posteriormente usando corrente-tensão dependente da temperatura ( I - V - T ) Medidas. Conforme mostrado na Fig. 7, tanto a corrente de polarização direta quanto a reversa aumentaram em um grau semelhante para a amostra com espessura de 0,7 nm. Para a amostra com um AlN de 7,4 nm de espessura, no entanto, as correntes de fuga reversas eram mais dependentes da temperatura do que as correntes diretas. Sob polarização reversa, a temperatura mais elevada poderia causar um buraco na emissão térmica dos níveis profundos para a banda de valência do AlN e, assim, introduzir outro suprimento de elétrons [44]. De acordo com o modelo de barreira não homogênea [24], a altura da barreira efetiva dependente da temperatura ( φ B ) está relacionado com uma altura média da barreira de polarização zero (\ ({\ overline {\ varphi}} _ B \)) e um desvio padrão ( σ 0 ) como \ ({\ varphi} _B ={\ overline {\ varphi}} _ B-q {\ sigma_0} ^ 2/2 kT \). O σ 0 os valores foram obtidos como 0,147 e 0,204 V para as amostras com 0,7 e 7,4 nm de AlN de espessura, respectivamente. Usando esses valores, os gráficos modificados de Richardson de ln ( I 0 / T 2 ) - q 2 σ 0 2 / 2 k 2 T 2 vs. 1 / kT foram obtidos, mostrado na Fig. 8a. As interceptações na ordenada produziram as constantes de Richardson de A ** como 397,3 e 27,1 A cm −2 K −2 para as amostras com AlN de 0,7 e 7,4 nm de espessura, respectivamente. O valor para a amostra com um AlN de 7,4 nm de espessura é semelhante ao valor teórico de 26,4 A cm −2 K −2 para n-GaN, indicando que a não homogeneidade da barreira com o modelo TE pode explicar o transporte de corrente. No entanto, para a amostra com um AlN de 0,7 nm de espessura, o valor é muito alto em comparação com o valor teórico, indicando que o modelo TE, mesmo incluindo a não homogeneidade da barreira, não pode explicar o transporte de corrente. A Figura 8b mostra os valores de nkT como uma função de kT . A linha reta com inclinações de 1,15 combina bem com os dados experimentais para a amostra com um AlN de 7,4 nm de espessura usando o modelo TE. Para a amostra com um AlN de 0,7 nm de espessura, no entanto, o declive foi de 5,11. Esse grande desvio da unidade pode surgir dos estados de interface, camada isolante e corrente de tunelamento.
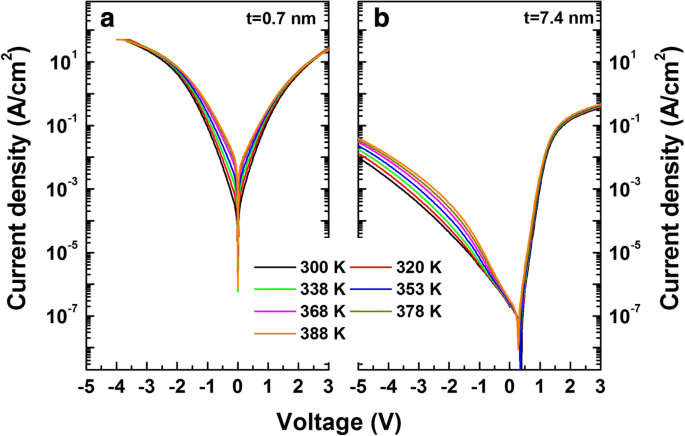
Densidade de corrente dependente da temperatura - voltagem ( J - V ) características para as amostras com a 0.7- e b AlN de 7,4 nm de espessura
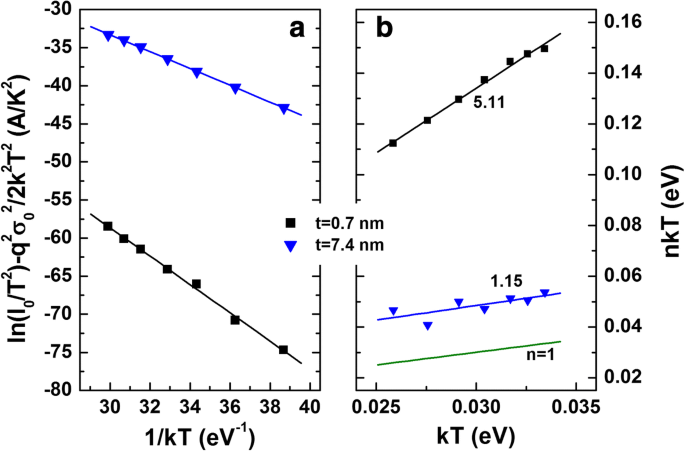
a Parcelas de Richardson modificadas e b nkT vs. kT gráficos com os ajustes lineares aos dados experimentais. Em b , a linha com uma inclinação de 1 ( n =1) também foi incluído como uma referência
A densidade de corrente de dispersão reversa foi analisada usando o modelo de tunelamento Fowler – Nordheim (FN), fornecido por [45].
$$ J =\ alpha {E} ^ 2 \ exp \ left (- \ beta / E \ right) $$ (1)
onde α =1,54 × 10 −6 / m ∗ Φ B e β =6,83 × 10 −7 ( m ∗ ) 1/2 (Φ B ) 3/2 ; m * ( m * =0,30 para AlN [46]) é a massa efetiva do elétron no isolador e Φ B é a altura da barreira de tunelamento. A Figura 9a, b mostra que a emissão de FN foi observada para as amostras com AlN de 0,7 e 7,4 nm de espessura, quando as tensões de polarização são maiores que - 0,9 V e - 3 V, respectivamente. A tensão mais alta para a amostra com um AlN de 7,4 nm de espessura se deve ao fato de que o AlN mais espesso precisa de uma tensão de tunelamento mais alta. A partir da inclinação mostrada na Fig. 9, as alturas das barreiras de tunelamento foram determinadas para cada temperatura, que são apresentadas no detalhe da Fig. 9b. À temperatura ambiente, as alturas de barreira para as amostras com AlN de 0,7 e 7,4 nm de espessura foram calculadas em cerca de 1,67 e 0,78 eV, respectivamente. Esses valores são menores do que o deslocamento da banda de condução relatado de 2,58 eV na interface AlN / GaN [47]. A baixa qualidade da interface perto da interface AlN / GaN pode produzir esses valores mais baixos. A altura de barreira mais baixa para a amostra com um AlN de 7,4 nm de espessura também pode ser associada à alta interface e densidade da armadilha de óxido perto da interface AlN / GaN e defeitos relacionados ao oxigênio na camada de AlN. Como resultado, o tunelamento assistido por armadilha ocorreu mais facilmente e aumentou a corrente de fuga reversa.
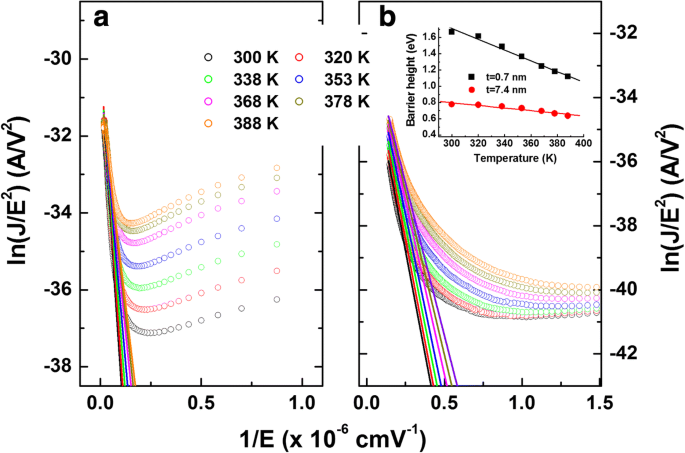
Parcelas de túneis de Fowler-Nordheim (FN) de ln ( J / E 2 ) vs. 1 / E com o ajuste linear aos dados experimentais para as amostras com a 0.7- e b AlN de 7,4 nm de espessura. A inserção em b apresenta as alturas de barreira calculadas em função da temperatura
O modelo de emissão de Poole-Frenkel (PF) também foi aplicado à corrente de fuga reversa, fornecida por [48].
$$ \ ln \ left (J / E \ right) =m (T) {E} ^ {1/2} + b (T) \ Big) $$ (2)
com
$$ m (T) =\ frac {q} {kT} \ sqrt {\ frac {q} {{\ pi \ varejpsilon} _0 {\ varejpsilon} _ {\ mathrm {AlN}}}}, b (T) =- \ frac {q {\ varphi} _t} {kT} + \ ln C $$ (3)
onde ϕ t é a altura da barreira de emissão de elétrons dos estados da armadilha, ε AlN é a permissividade dielétrica relativa do isolador de porta em alta frequência ( ε AlN 4,77 [49]), ε 0 é a permissividade do espaço livre, e C é uma constante. A validade do ajuste de emissão de PF foi verificada verificando a dependência do coeficiente linear m da temperatura ( T ) obtido a partir do ajuste linear das parcelas PF ln ( J / E ) em função de E 1/2 [50], que é mostrado na Fig. 10. Do m ( T ) valores obtidos a partir do ajuste linear a esses gráficos (inserção na Fig. 10a), ε AlN foi encontrado para ser 64,9 e 959,0 para as amostras com 0,7 e 7,4 nm de AlN de espessura, respectivamente. Os valores obtidos são muito elevados em relação ao valor teórico de 4,77, o que aponta que a emissão de FP não pode explicar o transporte de corrente corretamente para ambas as amostras. Conseqüentemente, o tunelamento FN é o mecanismo de transporte mais apropriado na corrente de fuga reversa.
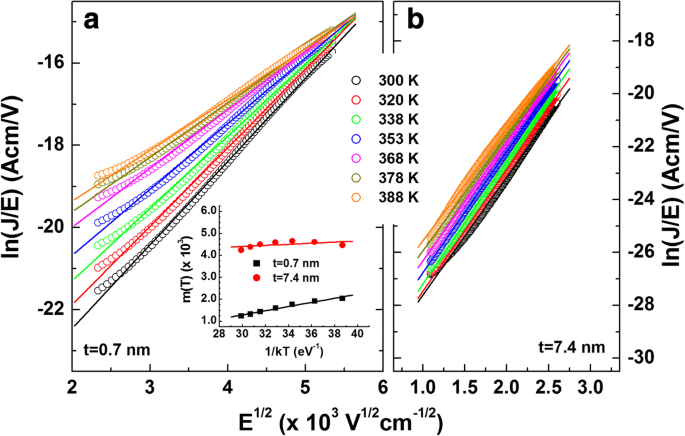
Gráficos de emissão Poole-Frenkel (PF) de ln ( J / E ) vs. E 1/2 / com o ajuste linear aos dados experimentais para a amostra com a 0.7- e b AlN de 7,4 nm de espessura. A inserção em a apresenta o m calculado ( T ) valores vs. temperatura
Mesmo que a Eq. (1) não contém dependência da temperatura, as alturas de barreira obtidas diminuíram com o aumento da temperatura. As inclinações foram obtidas como - 6,67 meV / K e - 1,62 meV / K para as amostras com 0,7 e 7,4 nm de AlN de espessura, respectivamente. Foi relatado na estrutura SiO2 / 4H-SiC que o tunelamento FN possui uma dependência da temperatura com uma inclinação de - 7,6 meV / K [51]. Os elétrons ejetados do eletrodo de Pt seguiram a distribuição de Fermi-Dirac [52] e, portanto, a corrente de fuga reversa pelo tunelamento também poderia aumentar com a temperatura. Nesse caso, o aumento com a temperatura seria maior para uma camada mais fina de AlN.
Enquanto isso, foi relatado que os mecanismos de transporte de corrente em alto campo elétrico não podem ser explicados apenas pelo tunelamento FN [53, 54]. Mesmo incluindo as mudanças nas cargas no óxido e no nível de Fermi do substrato, e a distribuição de energia do elétron no SiO 2 Interface / SiC com temperatura, a corrente de fuga reversa em SiO 2 / 4H-SiC não foi explicado de forma satisfatória [53]. Foi proposto que a emissão de PF termicamente ativada de elétrons aprisionados a partir das armadilhas de elétrons interfaciais contribui significativamente para o aumento da corrente de fuga [54]. Portanto, reduzir tais defeitos em AlN durante o processo ALD é crucial no desempenho do dispositivo baseado em AlN / GaN, especialmente durante a operação de alta temperatura.
Como pode ser visto no gráfico da altura da barreira vs. espessura de AlN na Fig. 2c, Li et al. observaram comportamento semelhante em contatos de metal / n-Ge com Y 2 O 3 camadas [55]. Eles atribuíram a redução na altura da barreira à supressão do instável GeO x o crescimento e a passivação de ligações pendentes na superfície Ge. Karpov et al. inserido Si 3 N 4 camada em contatos Ni / n-GaN e descobriu que a altura da barreira diminuiu de 0,78 para 0,27-0,30 eV com um Si 3 N 4 camada. Os resultados foram explicados pela formação de dipolo no Si 3 N 4 Interface / GaN [56]. Além disso, Zheng et al. investigou a resistência de contato vs. Al 2 O 3 espessura na estrutura Al / n-SiC e descobriram que o dipolo de interface começou a se formar na espessura de 1,98 nm [57]. Acima dessa espessura, a resistência de contato diminuiu primeiro devido ao efeito dipolo e, em seguida, aumentou devido ao aumento da resistência de tunelamento. De acordo com os dados de XPS na Fig. 6, a formação da camada de AlN não é clara para a amostra com um AlN de 0,7 nm de espessura. Portanto, a redução da altura da barreira com um AlN de 0,7 nm de espessura é mais provavelmente devido ao efeito de passivação, em vez da formação de dipolo de interface.
O processo de corrosão a seco, como a corrosão por plasma de acoplamento indutivo (ICP), é amplamente utilizado em dispositivos baseados em GaN devido à estabilidade química do GaN [58], embora a corrosão química úmida intensificada por ultravioleta tenha sido demonstrada [59]. No entanto, o processo de corrosão a seco pode induzir danos na superfície de GaN, aumentando a corrente de fuga e degradando o comportamento de retificação. O tratamento pós-corrosão usando recozimento térmico e solução de KOH após o ataque iônico reativo (RIE) foi encontrado para remover efetivamente o dano superficial em GaN [60]. Considerando os resultados até agora, sugerimos que a deposição de AlN (maior que 1 nm) pode ser aplicada para reduzir o dano na superfície de GaN gravada, o que deve aumentar a qualidade da interface e as características de retificação ainda mais.
Conclusões
Nós investigamos as propriedades interfaciais e elétricas da camada atômica de AlN depositada em n-GaN com diferentes espessuras de AlN. De acordo com a capacitância-tensão ( C - V ) características, a amostra com um AlN de 7,4 nm de espessura apresentou a maior interface e densidade de armadilha de óxido. De acordo com as medições de espectroscopia de fotoelétrons de raios-X (XPS), a amostra com um AlN de 0,7 nm de espessura revelou um pico dominante relacionado com ligações Al – O, sem nenhum pico claro associado com AlN. Os átomos de oxigênio restantes perto da superfície de GaN foram encontrados para ser muito pequenos para a amostra com um AlN de 7,4 nm de espessura. Por outro lado, muitos átomos de oxigênio foram encontrados na camada de AlN, o que forneceu os defeitos relacionados ao oxigênio na camada de AlN. As análises na corrente de fuga reversa revelaram que a emissão de Fowler – Nordheim (FN) em vez de Poole – Frenkel (PF) foi mais apropriada para explicar o transporte de corrente para as amostras com AlN de 0,7 e 7,4 nm de espessura.
Abreviações
- ALD:
-
Deposição de camada atômica
- AlN:
-
Nitreto de alumínio
- C - V :
-
Capacitância-tensão
- FN:
-
Fowler – Nordheim
- J - V :
-
Densidade de corrente - tensão
- PF:
-
Poole – Frenkel
- TE:
-
Emissão termionica
- XPS:
-
espectroscopia de fotoelétrons de raios-X
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Dependência da toxicidade das nanopartículas em suas propriedades físicas e químicas



