FETs de canal U de porta retangular de alto desempenho com distância de apenas 2 nm entre os contatos de origem e drenagem
Resumo
Um novo FET de canal U de porta retangular de alto desempenho (RGUC FET) para distância integrada extrema entre contatos de fonte e dreno é proposto neste artigo. O RGUC FET representa características subliminares quase ideais até que a distância entre os contatos fonte / dreno (S / D) seja reduzida para 2 nm. Diferente dos outros FETs recuados ou baseados em canal em forma de U, os contatos de porta não precisam ser formados na região recuada, mas apenas em uma camada de espaçador para o isolamento entre as duas partes verticais em ambos os lados do canal U. Suas vantagens estruturais permitem a aplicação na fabricação de circuitos integrados com maior integração para extrema distância integrada entre os contatos fonte e dreno. As propriedades elétricas do RGUC FET foram escrupulosamente investigadas estudando a influência dos parâmetros de projeto, incluindo a distância horizontal entre os contatos S / D, a altura de extensão da região S / D e a espessura e o material da camada de óxido de porta. As propriedades elétricas do RGUC FET são verificadas por simulação quântica. Comparado com os outros FETs multiportas de canal não planejador, o novo FET RGUC é adequado para maior integração.
Introdução
Como um dos dispositivos mais promissores usados em circuitos integrados (IC) em nanoescala, o transistor de efeito de campo sem junção (JL FET) que apresenta características elétricas notáveis em comparação aos FETs semicondutores de óxido metálico (MOS) convencionais baseados em junção, além de sua simplicidade de fabricação, tem sido profundamente estudada nos últimos anos [1,2,3,4]. Enquanto o aumento da tensão da porta forma a região de acumulação no canal, resultando em maior na corrente [5], a introdução do FET de porta múltipla (MG) reforçou a controlabilidade da corrente fonte-dreno da tensão da porta, resultando para propriedades de sublimiar muito melhores do dispositivo. Os FETs de portas múltiplas sem junção (JL MG) também têm sido amplamente estudados há anos [6,7,8]. Embora o MOSFET de portão de canal vertical em toda a volta mostre um I quase ideal - V desempenho com um raio de apenas vários nanômetros, o canal vertical dele faz com que a fonte e o dreno de contato não pudessem ser fabricados na mesma camada, o que torna o layout dos ICs incompatível com a tecnologia do planejador. Além disso, como a fabricação de semicondutores foi forçada a reduzir o comprimento do canal para menos de 10 nm, os MG FETs enfrentam o efeito de canal curto novamente [9,10,11]. A fim de superar o efeito do canal curto, os MOSFETs de canal recesso se tornaram um tema quente nos últimos anos [12,13,14,15,16]. O trabalho de modelagem e simulação de MOSFETs de canal recesso também é realizado de forma abrangente [17,18,19,20]. Um MOSFET de canal recuado possui partes do canal vertical planejador sob os contatos da fonte e do dreno e uma parte do canal plano horizontal. Na verdade, prolongou o comprimento efetivo do canal em comparação com os MOSFETs convencionais apenas com o canal plano horizontal. Para o dispositivo com a mesma distância entre os contatos da fonte e do dreno, ele pode ser mais imune ao efeito de canal curto em comparação com os MOSFETs convencionais com canal plano; no entanto, os dados experimentais mostram que a oscilação de subliminar de MOSFETs com canal de recesso não pode realizar uma oscilação de subliminar ideal com comprimento de canal efetivo inferior a 100 nm. Isso ocorre porque, embora o comprimento do canal seja prolongado, a controlabilidade da porta não é reforçada como MG FETs. Deve-se notar que é melhor definir um novo parâmetro geométrico chave relacionado à descrição da integração, ao invés do comprimento do canal. A distância entre os contatos da fonte e do dreno é mais realista e eficaz porque o objetivo final do design do dispositivo em nanoescala é a realização do melhor desempenho em uma determinada área de chip limitada, e o tamanho real do dispositivo está relacionado à largura do canal e a distância entre os contatos da fonte e do dreno. A fim de combinar as vantagens de ambos os MG FETs e MOSFETs de canal recesso, em nosso trabalho anterior, propomos FETs de porta em forma de sela com um canal em forma de U [21,22,23], que promove a controlabilidade da porta para a horizontal canal parte do canal rebaixado de um tipo de porta única plana para um tipo de porta tripla 3-D. Depois disso, atualizamos este recurso de porta tripla 3-D formado não apenas na parte do canal horizontal, mas também em ambas as partes do canal vertical. Este dispositivo é denominado como FETs de canal U de porta H, e o canal recesso é correspondentemente atualizado para um canal de tubo em forma de U 3-D também [24]. Como mencionado acima, o objetivo final do projeto do dispositivo em nanoescala é a realização do melhor desempenho em uma determinada área de chip limitada por meio da otimização. Para realizar um dispositivo otimizado de alto desempenho, tanto a estrutura do portão quanto a estrutura do canal correspondente devem ser bem consideradas e projetadas. Além disso, a complexidade de fabricação deve ser considerada também. Os dispositivos mencionados acima, como o dispositivo de canal recuado, os FETs de sela propostos anteriormente e os FETs HGUC têm um terreno comum, uma estrutura em sanduíche de óxido de porta / porta / óxido de porta deve ser bem formada na pequena região de recesso. Esta característica estrutural limita sua promoção adicional de integração. Parece que uma boa maneira de promover a integração é simplificar o recurso estrutural na região rebaixada e manter a capacidade de controle da porta para a parte do canal vertical e parte do canal horizontal do canal em forma de U ao mesmo tempo. A fim de realizar essas características e funções do dispositivo, neste artigo, propusemos um novo FET de canal U de porta retangular (RGUC FET) para uma distância integrada extrema entre os contatos de fonte e dreno. Possui um canal em forma de U que pode prolongar o comprimento do canal de efeito sem aumentar a distância entre os contatos da fonte e do dreno. Em comparação com os outros FETs de canal em forma de U, o FET RGUC tem uma estrutura interna mais simples na região rebaixada do canal em forma de U; depois disso, pode realizar uma fabricação mais simples na parte interna da região rebaixada e uma distância menor entre os contatos da fonte e do dreno (maior integração). A estrutura proposta tem melhor controlabilidade da porta e menor corrente de fuga reversa acompanhada de maior I LIGADO / eu DESLIGADO Razão. A distância entre o contato da fonte e o contato do dreno pode ser reduzida para menos de 2 nm. Todas as propriedades elétricas são analisadas por simulações quânticas.
Métodos
A Figura 1a apresenta a vista esquemática 3D do RGUC FET e as Fig. 1b a d são perfis do dispositivo cortado através dos planos A, B, C e D mostrados na Fig. 1a. W é a largura do corpo do silício, t b é a espessura do corpo do silício, h em é a altura interna do espaçador na região rebaixada, h ex é a altura da fonte de extensão / região de drenagem, t boi é a espessura do óxido de porta em torno do corpo de silício, e t sp é a espessura do espaçador da camada isolante depositada na região rebaixada do canal em forma de U que é igual à distância entre o contato da fonte e o contato do dreno.
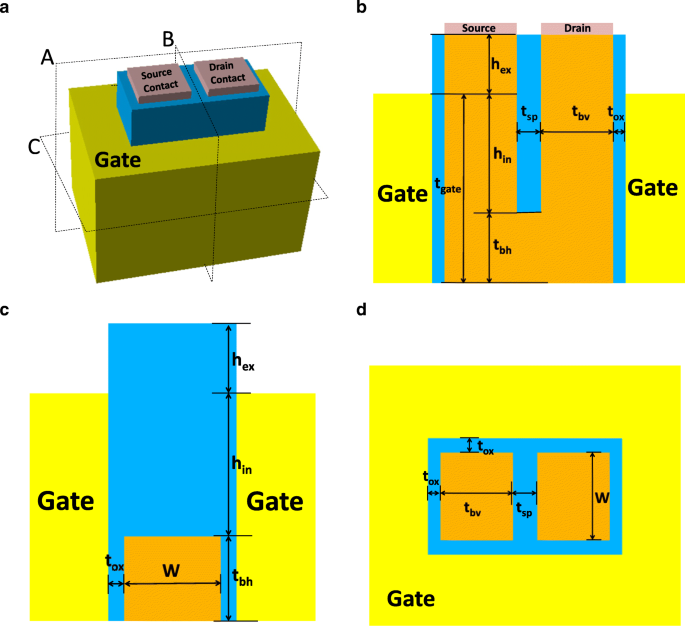
a Vista esquemática 3D do RGUC FET. b Perfis do dispositivo cortados através do plano A de a . c Perfis do dispositivo cortados através do plano B de a . d Perfis do dispositivo cortam o plano C de a
Como a espessura do corpo de silício é inferior a 6 nm, simulações quânticas são introduzidas neste artigo, em vez de simulações clássicas para obter resultados de simulação mais precisos. Todas as simulações são realizadas usando o TCAD de simulação de dispositivo SILVACO Atlas 3D, usando o modelo de mobilidade dependente da concentração, modelo Shockley-Read-Hall dependente da concentração, modelo de recombinação Auger, modelo de estreitamento de bandgap, modelo de tunelamento banda a banda padrão e Modelo de potencial quântico de Bohm [25]. Os parâmetros de simulação estão listados na Tabela 1. As duas partes verticais do corpo são na verdade cubos com quatro lados, as superfícies superiores dos quais são cobertas com a região de origem ou dreno e a superfície inferior são ambas conectadas à parte horizontal do corpo. Os lados triplos externos das partes verticais do corpo são circundados pelo óxido da porta e pelo contato da porta retangular, e o outro lado interno é conectado ao espaçador interno na região rebaixada. Os quatro lados do corpo horizontal são todos circundados pelo óxido da porta e pelo contato da porta retangular. É conjecturável que a porta retangular tem uma forte capacidade de controle de efeito de campo para o corpo horizontal e as duas partes verticais devido às características da estrutura mencionadas acima. E, o espaçador interno na verdade prolongou a distância do caminho mais curto entre os contatos da fonte e do dreno no silício, o que poderia eliminar o efeito de canal curto que não pode ser evitado para dispositivos multiportas com recursos de canal planar. Em comparação com outros dispositivos de canal 3-D [21,22,23,24], a estrutura proposta não precisa da formação de porta na região rebaixada, o que reduz em grande parte a complexidade da estrutura interna da região rebaixada.
Resultados e discussões
O modelo de potencial quântico de Bohm (BQP) calcula um termo de energia potencial dependente da posição usando uma equação auxiliar derivada da interpretação de Bohm da mecânica quântica. Este modelo é derivado da física pura e permite que o modelo aproxime o comportamento quântico de diferentes classes de dispositivos, bem como uma variedade de materiais. Os efeitos do confinamento quântico no desempenho do dispositivo, incluindo I - V características, serão então calculados com uma boa aproximação. Estudos anteriores mostram que a corrente de fuga da porta é desprezível para casos de espessura de óxido maior que 0,5 nm [7, 26].
A Figura 2a mostra as comparações da tensão porta-fonte da corrente dreno-fonte ( I DS - V GS ) características do RGUC FET com diferentes h em s em escalas logarítmicas e lineares. A Figura 2b mostra as comparações de oscilações de sublimiar (SS) e I LIGADO / eu DESLIGADO proporção do RGUC FET com diferentes h em s. Com o aumento de h em , o caminho vertical de todo o canal da fonte ao dreno é continuamente aumentado, então o comprimento efetivo do canal mais curto aumenta gradualmente e o efeito do canal curto gradualmente enfraquece e é finalmente eliminado. O SS pode atingir um valor quase ideal de 65 mV / dec para h em atinge 10 nm. O eu LIGADO / eu DESLIGADO a proporção também aumenta cerca de 35 vezes para h em aumenta de 2 para 10 nm devido ao SS continuamente diminuído. O prolongado h em faz com que a distância do caminho mais curto da fonte ao dreno aumente de 6 para 22 nm, que é igual a 2 h em + t sp e é equivalente ao comprimento efetivo do canal da estrutura proposta. A Figura 2c e d mostram uma distribuição de concentração de elétrons 2-D no corpo de silício no estado desligado para o dispositivo com 2 nm e 10 nm h em , respectivamente. Para o caso de 2 nm, a maior concentração de elétrons na região horizontal do corpo é cerca de 10 12 cm −3 e a distância entre o contato fonte / dreno e a região horizontal do corpo é muito curta. Daí em diante, o viés de fonte / dreno afeta seriamente a distribuição de elétrons na região horizontal do corpo; a solução é prolongar o canal vertical que mantém a fonte / dreno longe da região horizontal do corpo. Para o caso de 10 nm, na Fig. 2d, podemos ver que a maior concentração de elétrons na região horizontal do corpo diminuiu para 10 9 cm −3 , e torna uma região totalmente esgotada mais ideal para o estado desligado, o que traz um nível muito mais baixo de corrente de fuga.

a As comparações do eu DS - V GS características do RGUC FET com diferentes h em s em escalas logarítmicas e lineares. b As comparações de oscilações de sublimiar (SS) e I LIGADO / eu DESLIGADO proporção do RGUC FET com diferentes h em s. c Distribuição da concentração de elétrons 2-D no corpo de silício no estado desligado para o dispositivo com h de 2 nm em . d Distribuição da concentração de elétrons 2-D no corpo de silício no estado desligado para o dispositivo com 10 nm h em
A Figura 3a mostra as comparações do I DS - V GS características do RGUC FET com diferentes t sp s em escalas logarítmicas e lineares. A Figura 3b mostra as comparações de oscilações de sublimiar (SS) e I LIGADO / eu DESLIGADO proporção do RGUC FET com diferentes t sp s. Com a diminuição de t sp , a distância entre os contatos da fonte e do dreno também diminui continuamente. A corrente de fuga é induzida principalmente pela corrente de tunelamento banda a banda. A probabilidade de tunelamento é proporcional à curvatura da banda que pode ser equivalente à intensidade do campo elétrico em um determinado ponto. A corrente total de tunelamento é a soma da corrente de tunelamento gerada em cada ponto da região do corpo.
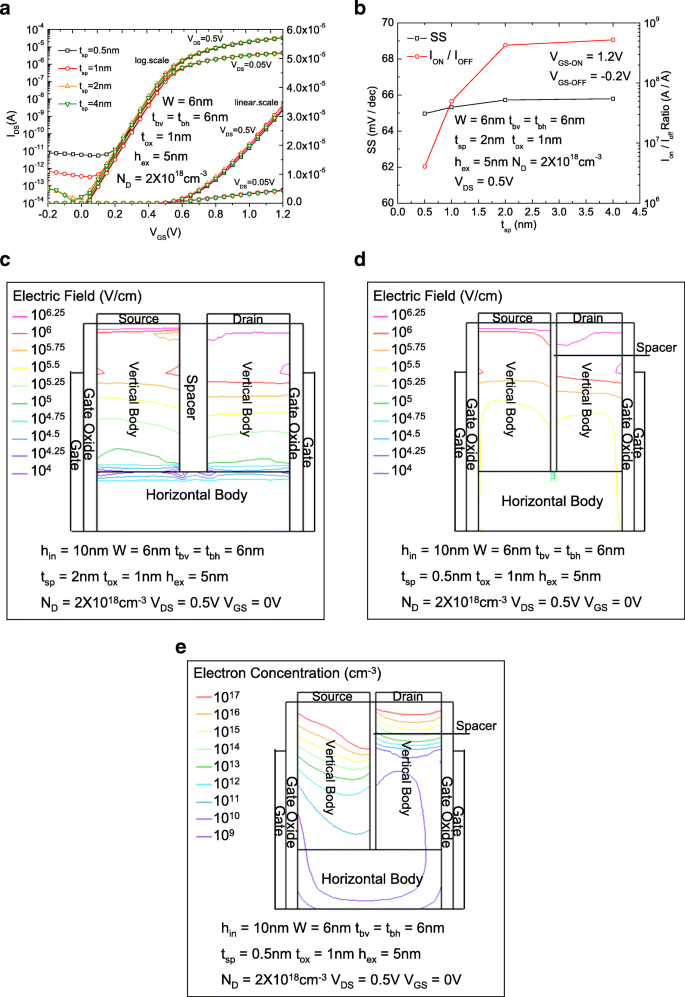
a As comparações do eu DS - V GS características do RGUC FET com diferentes t sp s em escalas logarítmicas e lineares. b As comparações de oscilações de sublimiar (SS) e I LIGADO / I DESLIGADO proporção do RGUC FET com diferentes t sp s. c Distribuição de campo elétrico 2-D no corpo de silício no estado desligado para o dispositivo com 2 nm t sp . d Distribuição de campo elétrico 2-D no corpo de silício no estado desligado para o dispositivo com 0,5 nm t sp . e Distribuição da concentração de elétrons 2-D no corpo de silício no estado desligado para o dispositivo com 0,5 nm t sp
A Figura 3c e a Fig. 2d mostram uma distribuição de campo elétrico 2-D no corpo de silício no estado desligado para o dispositivo com 2 nm e 0,5 nm t sp , respectivamente. Para uma espessura de espaçador maior ou uma tensão de fonte de drenagem menor ( V DS ) polarização, a intensidade do campo elétrico na interface entre o espaçador na região rebaixada não é forte o suficiente para produzir uma grande quantidade de corrente de fuga. A intensidade do campo elétrico mais forte aparece perto da interface entre o óxido da porta e a parte vertical do corpo, que é decidida por V GD . No entanto, se a distância fonte-dreno for diminuída para menos de 1 nm (menos do que a espessura do óxido de porta), a intensidade de campo mais forte aparece perto da interface entre o espaçador na região rebaixada e as duas partes verticais do corpo. Pode-se ver que quando t sp é menor que 1 nm, para um V maior DS (0,5 V por exemplo), a corrente de fuga é quase independente com a polarização da porta e principalmente decidida pelo V DS . O SS é quase independente com t sp e mantém um valor quase ideal de 65 mV / dec para um h em =10 nm caso até t sp é inferior a 2 nm. O eu LIGADO / eu DESLIGADO proporção mantém 10 8 até t sp =2 nm e está seriamente degradado por t sp menos de 2 nm devido ao aumento da corrente de fuga induzido pelo forte campo elétrico aparece perto da interface entre o espaçador na região rebaixada e as duas partes verticais do corpo. A intensidade do campo elétrico do corpo de silício na região do corpo é amplamente aumentada para o t de 0,5 nm sp caso. A Figura 3e mostra a distribuição da concentração de elétrons 2-D no corpo de silício no estado desligado para o dispositivo com 0,5 nm t sp . Em comparação com a Fig. 2d, é claramente visto que a concentração de elétrons na região horizontal do corpo é aumentada de 10 9 a 10 10 cm −3 . Além disso, a dimensão da espessura do espaçador de 0,5 nm é muito próxima de uma camada de uma única molécula, o que pode causar danos à propriedade de isolamento da camada espaçadora em algum grau. Devido ao motivo mencionado acima, o t sp é sugerido ser 2 nm para design de alta integração e baixo vazamento e baixo consumo de energia.
A Figura 4 mostra o I DS - V DS do RGUC FET proposto com estrutura otimizada sob diferentes.
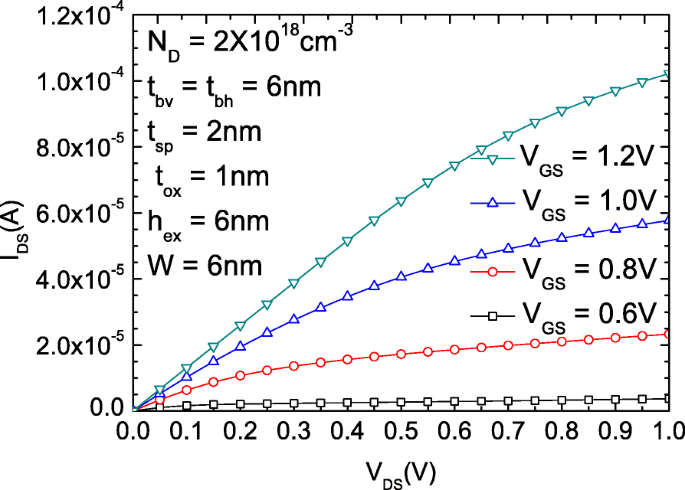
eu DS - V DS característica do RGUC FET proposto com parâmetros de dispositivo otimizados
V GS valores, o SS dos quais é cerca de 63 mV / dez, e o I ON / eu OFF é 10 9 ~ 10 10 . A corrente saturada aumenta conforme V GS aumenta.
Conclusões
Um novo RGUC FET com alta integração e alto desempenho é proposto neste artigo, que apresenta oscilações de sublimiar baixos e I superiores LIGADO / eu DESLIGADO Razão. A distância entre os contatos fonte / dreno (S / D) pode ser reduzida para 2 nm, com características quase ideais, como SS, corrente de fuga reversa e I LIGADO / eu DESLIGADO Razão. Todas as propriedades elétricas são simuladas com modelos quânticos para garantir resultados mais precisos.
Abreviações
- BQP:
-
Potencial quântico Bohm
- FET:
-
Transistor de efeito de campo
- h ex :
-
Altura da extensão do espaçador entre a região S / D
- h em :
-
Altura interna do espaçador na região rebaixada
- I DESLIGADO :
-
Sem corrente
- I LIGADO :
-
Na atual
- JL:
-
Sem junção
- MOS:
-
Semicondutor de óxido de metal
- N D :
-
Concentração de doping
- RGUC:
-
Canal U de portão retangular
- S / D:
-
Fonte / dreno
- SS:
-
Balanço de sublimiar
- t bh :
-
Espessura horizontal do corpo
- t bv :
-
Espessura vertical do corpo
- t portão :
-
Comprimento vertical do portão
- t boi :
-
Espessura da camada de óxido de porta
- t sp :
-
Espessura do espaçador entre a região S / D
- V DS :
-
Tensão da fonte de drenagem
- V GS :
-
Tensão da fonte de porta
- W:
-
Largura do corpo
Nanomateriais
- Diferença entre estrutura e classe:explicada com exemplo de C++
- Diferença entre while e do-while:explicado com exemplos
- Nanomaterial inteligente e nanocompósito com atividades agroquímicas avançadas
- Transistores de efeito de campo Nanoflake SnSe multicamadas com contatos óhmicos de baixa resistência
- Síntese fácil de nanofios de prata com diferentes proporções de aspecto e usados como eletrodos transparentes flexíveis de alto desempenho
- Eletrodo de porta de prata impresso a jato de tinta curado por UV com baixa resistividade elétrica
- Resistência de contato reduzida entre metal e n-Ge por inserção de ZnO com tratamento de plasma de argônio
- Channel Plasmon Nanowire Lasers com cavidades em V-Groove
- Materiais de interface térmica assistida por grafeno com um nível de contato de interface satisfeito entre a matriz e os enchimentos
- Material catódico de alto desempenho de FeF3 · 0,33H2O modificado com nanotubos de carbono e grafeno para baterias de íon-lítio



