Evolução estrutural da interface HfO2 / Si dependente da temperatura e seu mecanismo
Resumo
Neste trabalho, óxido de háfnio (HfO 2 ) filmes finos são depositados em substratos de Si tipo p por deposição de camada atômica de plasma remoto em Si tipo p a 250 ° C, seguido por um recozimento térmico rápido em nitrogênio. Efeito da temperatura pós-recozimento na cristalização de HfO 2 filmes e HfO 2 As interfaces / Si são investigadas. A cristalização do HfO 2 filmes e HfO 2 A interface / Si é estudada por microscopia eletrônica de transmissão de emissão de campo, espectroscopia de fotoelétrons de raios-X, difração de raios-X e microscopia de força atômica. Os resultados experimentais mostram que durante o recozimento, o oxigênio difunde-se do HfO 2 para interface Si. Para temperatura de recozimento abaixo de 400 ° C, o HfO 2 filme e camada interfacial são amorfos, e a última consiste em HfO 2 e dióxido de silício (SiO 2 ) Na temperatura de recozimento de 450-550 ° C, o HfO 2 o filme torna-se policristalino multifásico e um SiO cristalino 2 é encontrado na interface. Finalmente, na temperatura de recozimento além de 550 ° C, o HfO 2 o filme é dominado por policristalino de fase única e a camada interfacial é completamente transformada em SiO cristalino 2 .
Introdução
Óxido de háfnio (HfO 2 ) a película fina é um material interessante para uma variedade de aplicações. Pode ser usado em revestimento óptico multicamadas [1], revestimento protetor [2], dielétrico de porta [3], camada de passivação [4,5,6], e assim por diante devido às suas excelentes propriedades, como alta densidade, alta refração índice, gap largo e estabilidade térmica relativamente alta. Muitos métodos foram usados para preparar HfO 2 filme fino, como evaporação de feixe de elétrons [7], deposição de solução química [8], pulverização catódica reativa [9], deposição de vapor químico orgânico de metal [10], epitaxia de feixe molecular [11] e deposição de camada atômica (ALD). ALD é um método promissor para a obtenção de filmes finos com controle de espessura de alta precisão e uniformidade de alta precisão. O pós-recozimento tem influências significativas em ALD HfO 2 filmes [12,13,14,15]. De acordo com a pesquisa, HfO 2 filmes finos podem cristalizar para uma temperatura de recozimento superior a 500 ° C [16,17,18]. A estrutura cristalina do HfO 2 afeta fortemente as propriedades ópticas e elétricas. Por exemplo, a mudança estrutural de HfO 2 de fase cristalina amorfa a monoclínica pode levar a mudanças no índice de refração de 1,7 a 2,09, gap óptico de 5,75 a 6,13 eV e constante dielétrica de 24,5 a 14,49 [19, 20]. Para ALD HfO 2 depositado em substratos de silício, uma camada de óxido é geralmente observada em HfO 2 Interface / Si [21, 22]. A presença desta camada interfacial é relatada para diminuir a constante dielétrica [22]. Além disso, Kopani et al. [23] apresentou as propriedades estruturais de 5 nm HfO 2 filmes após oxidação com ácido nítrico de substratos de Si dopados com n. Eles descobriram que a alta temperatura de recozimento aumenta a taxa de crescimento dos núcleos cristalinos. No entanto, suas propriedades de cristalização, particularmente HfO 2 / interface substrato foram estudados escassamente. Portanto, a temperatura de recozimento afeta as propriedades de cristalização do HfO 2 filmes finos preparados por ALD valeram a pena para uma investigação mais aprofundada.
Neste trabalho, o HfO 2 filmes finos foram fabricados por uma deposição de camada atômica de plasma remoto (RP-ALD) em substratos de silício tipo p. O pós-recozimento foi realizado por um sistema de recozimento térmico rápido (RTA) em diferentes temperaturas. As mudanças estruturais e propriedades de cristalização do HfO 2 filmes finos por RTA foram caracterizados por microscopia de força atômica (AFM), difração de raios-X incidente rasante (GIXRD), espectroscopia de fotoelétrons de raios-X (XPS) e microscopia eletrônica de transmissão de alta resolução (HR-TEM). O HfO 2 dependente da temperatura A evolução estrutural da interface / Si e seu mecanismo também são investigados.
Método
Foram utilizadas bolachas de Czochralski Si, polidas de dois lados (100) e orientadas tipo p, de 2 polegadas e 250 μm, com resistividade de 30 Ω cm. Antes da deposição, as pastilhas de Si foram limpas por um método padrão da Radio Corporation of America, seguido por imersão em solução diluída de ácido fluorídrico (5%) por 2 min para remover possíveis óxidos perdidos sem enxágue final com água. Após a limpeza, todas as bolachas foram secas com nitrogênio puro (N 2 ) de gás e montado no suporte de substrato. Aproximadamente 15 nm HfO 2 (168 ciclos ALD) filmes finos foram depositados em pastilhas de Si por RP-ALD (Picosun R-200, Finlândia) usando tetraquis (etilmetilamino) háfnio (TEMAH) e oxigênio (O 2 ) em pulso alternado com N 2 purga da câmara de reação entre os pulsos. O TEMAH e O 2 o plasma foi pulsado no reator na seguinte sequência:TEMAH pulso 1,6 s; N 2 purga 10 s; O 2 pulso de plasma 10 s e N 2 purga 12 s. Depois de depositar o HfO 2 filmes finos, o recozimento térmico rápido foi realizado em N 2 ambiente por 10 min. As temperaturas de recozimento variaram de 400 a 600 ° C para investigar o efeito na cristalização do HfO 2 filmes finos e HfO 2 Interface / Si. A Tabela 1 lista as condições típicas de RPALD e pós-recozimento.
As medições de AFM foram realizadas no modo de toque para investigar a morfologia da superfície do HfO 2 filmes finos. As imagens AFM mostradas neste trabalho são varreduras de 2 μm × 2 μm com resolução de 256 pontos × 256 linhas. A estrutura do HfO 2 os filmes foram caracterizados por medidas de difração de raios X incidentes rasantes (GIXRD, Rigaku TTRAXIII, Japão) com um tubo de raios X de foco fino longo de Cu. Raios-X com comprimento de onda de 0,154 nm foram produzidos em uma tensão de operação de 50 kV e uma corrente de 300 mA. Um ângulo de incidência de 0,5 ° foi selecionado para obter padrões de difração ao longo de 2 θ faixa de 20–60 °. A espectroscopia de fotoelétrons de raios-X (XPS, Thermo Fisher K-alpha) também foi realizada usando radiação monocromática de raios-X Al Kα (hν =1486,6 eV). Para a análise de XPS, um ponto de 100 μm de diâmetro foi usado e os fotoelétrons foram coletados em um ângulo de decolagem de 45 °. As seções transversais do HfO 2 filmes finos foram preparados por uma técnica de lift-out de feixe de íons focado em um sistema Hitachi NX2OOO. As imagens transversais do HfO 2 filmes finos foram examinados por uma microscopia eletrônica de transmissão de alta resolução de emissão de campo (HR-TEM, JEM-2100F, EUA).
Resultados e discussão
A Figura 1 mostra as imagens AFM para o HfO 2 filmes recozidos em diferentes temperaturas. Os valores da raiz quadrada média (RMS) e da rugosidade superficial média (Ra) são mostrados para indicar a rugosidade da superfície. O valor RMS é de 0,44 nm para o filme conforme depositado. Aumenta ligeiramente para 0,47 nm quando a temperatura de recozimento sobe para 500 ° C. Aumentar ainda mais a temperatura de recozimento para 600 ° C leva a um aumento significativo na rugosidade da superfície com um RMS aumentando para 0,69 nm. A mesma tendência é observada em valores de Ra. O aumento da rugosidade da superfície para as películas recozidas pode inferir uma mudança estrutural.
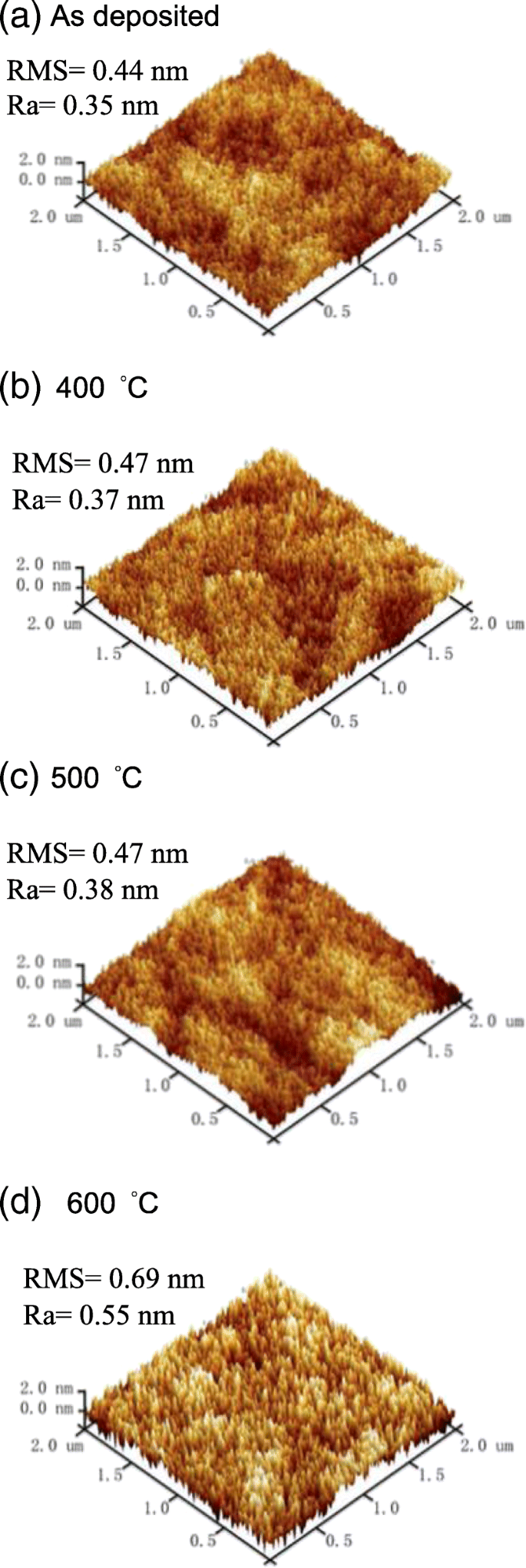
Imagens AFM de a depositado, b 400 ° C recozido, c 500 ° C recozido e d HfO recozido a 600 ° C 2 filmes
A Figura 2 mostra os espectros GIXRD dependentes da temperatura de vários HfO 2 filmes finos. O HfO depositado 2 os filmes são amorfos e permanecem amorfos após o recozimento a 400 e 450 ° C. Em uma temperatura de recozimento superior a 500 ° C, aparecem picos de difração, indicando a formação de HfO cristalino 2 . Os picos em 1 / d =0,319 e 0,354 Å −1 correspondem aos planos - 111 e 111 da fase monoclínica (ICDD PDF # 34-0104, grupo espacial P21 / c), respectivamente. O pico em 1 / d =0,340 Å −1 corresponde ao plano (111) da fase ortorrômbica (ICDD PDF # 21-0904, grupo espacial Pbcm). Outros picos próximos a 1 / d =0,380 ~ 0,395 são os planos 200, 020 e 002 da monoclínica e o plano 020 das fases ortorrômbicas. Os resultados também revelam que a fase monoclínica diminui e as fases ortorrômbicas aumentam com a temperatura de recozimento. O HfO ortorrômbico 2 domina a estrutura cristalina em temperaturas de recozimento mais altas. No entanto, os picos de difração de HfO ortorrômbico 2 foram observados em um 1 / d inferior (um espaçamento d menor) em comparação com o ICDD PDF # 21-0904. Além disso, o deslocamento de 1 / d =0,340 Å −1 em direção a um valor mais alto indica que o espaçamento d diminui com a temperatura de recozimento.
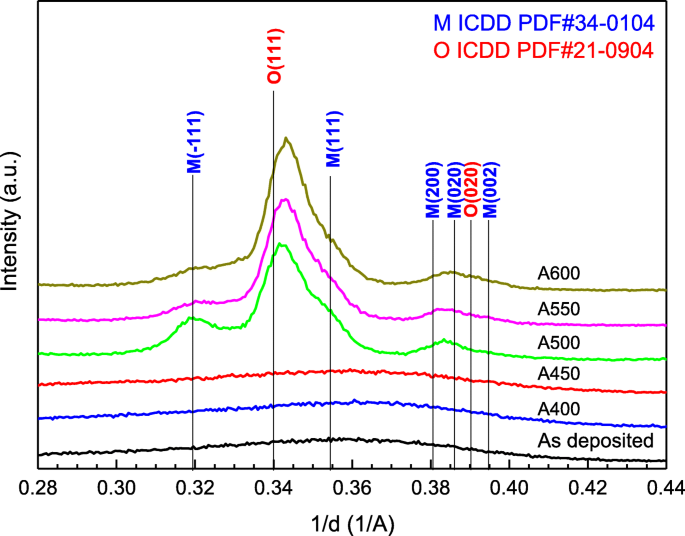
Espectros GIXRD de HfO 2 filmes finos recozidos em diferentes temperaturas
As concentrações de Hf e O no HfO 2 os filmes foram medidos usando XPS de perfil de profundidade. A Figura 3 mostra a proporção de composição O / Hf do HfO como depositado e pós-recozido 2 filmes. A razão O / Hf diminui de 1,60 para 1,29 com a temperatura de recozimento. Devido ao uso de N 2 durante o recozimento, o HfO 2 torna-se deficiente em oxigênio com a temperatura. O HfO deficiente em oxigênio 2 o filme também resulta em um espaçamento d menor, conforme mencionado anteriormente.

Razão atômica de oxigênio para háfnio para HfO 2 filmes finos recozidos em diferentes temperaturas
A Figura 4a, b, c, d, e e f mostram as imagens HR-TEM em seção transversal de alta resolução de 400 ° C-, 450 ° C-, 500 ° C-, 550 ° C-, e HfO recozido a 600 ° C 2 filmes finos em substratos de Si, respectivamente. Pode ser visto que o HfO 2 camada e substrato de Si são claramente exibidos nessas imagens. Além disso, uma camada fina com espessura de 1-2 nm entre HfO 2 e o substrato de Si pode ser o SiO 2 filme. Conforme mostrado na Fig. 4a, não há nenhum arranjo de rede óbvio no HfO conforme depositado 2 filme, indicando que este filme é amorfo. Após o recozimento a 400 ° C, embora a maioria das regiões de HfO 2 filme ainda são amorfos, podemos observar que uma fração de arranjos de rede com os valores de espaçamento d de 2,82 e 3,12 Å são formados neste filme. Esses dois valores de espaçamento d são indexados ao HfO monoclínico 2 (111) e HfO monoclínico 2 (- 111) planos, respectivamente, e o filme recozido a 400 ° C mostra a estrutura nanocristalina. Com o aumento da temperatura de recozimento de 400 para 600 ° C, a qualidade do cristal de HfO 2 filme é gradualmente aprimorado. Quando o HfO 2 o filme é recozido a 500–550 ° C, os principais arranjos de rede consistindo em HfO monoclínico 2 (- 111), HfO monoclínico 2 (200), e HfO ortorrômbico 2 (111) podem ser identificados. No entanto, aumentando ainda mais a temperatura de recozimento para 600 ° C, a estrutura de rede do HfO ortorrômbico 2 (111) ainda existe no filme, e os outros dois arranjos de rede desaparecem gradualmente. Por outro lado, os valores de espaçamento d do HfO ortorrômbico 2 (111) planos para HfO recozido a 500 ° C, 550 ° C e 600 ° C 2 os filmes são determinados como 2,93, 2,90 e 2,88 Å, respectivamente. Isso concorda bem com o resultado de XRD de que o HfO ortorrômbico 2 (111) o pico de difração muda para a direção do ângulo alto com o aumento da temperatura de recozimento de 500 a 600 ° C. O resultado revela que o conteúdo de oxigênio do HfO 2 o filme reduz gradualmente à medida que a temperatura de recozimento aumenta. O outro fenômeno interessante pode ser encontrado nas mudanças da estrutura do cristal e espessura do SiO 2 camada. No estado como depositado, o SiO 2 camada é amorfa. Mesmo se a amostra for recozida a 400 ° C, a energia térmica não é alta o suficiente para transformar a estrutura de SiO 2 camada de amorfo a cristalino. No entanto, ao aumentar a temperatura de recozimento de 450 para 600 ° C, o SiO cristalino 2 camada (com o SiO cúbico 2 (220) estrutura) é formada e sua espessura aumenta de 1,0 para 1,6 nm. Pode-se observar que o SiO amorfo 2 camada se transforma completamente em SiO cúbico 2 estrutura após o recozimento da amostra a 600 ° C. Com um incremento da temperatura de recozimento de 550 a 600 ° C, o valor do espaçamento d de SiO cúbico 2 (220) aumenta de 2,48 para 2,56 Å. Isso significa que o conteúdo de oxigênio de SiO 2 camada aumenta com o aumento da temperatura de recozimento. Pode ser razoavelmente especulado que a adição de conteúdo de oxigênio no SiO 2 camada é atribuída à difusão de átomos de oxigênio provenientes do HfO 2 filme. Além disso, a espessura total diminui para a temperatura de recozimento de 550 e 600 ° C e pode estar relacionada ao aumento da densidade do filme causado pela cristalização e remoção de hidrogênio.
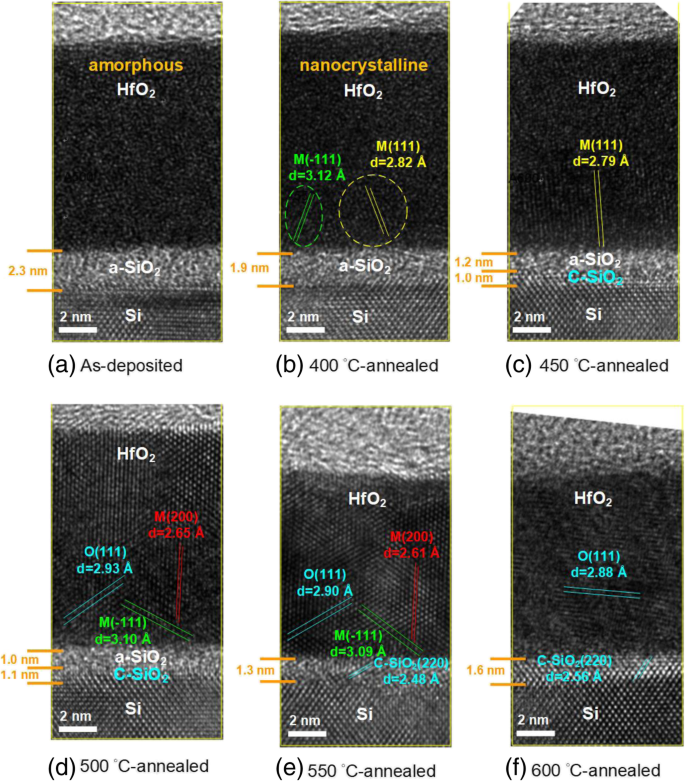
Imagens transversais do TEM de a depositado, b 400 ° C recozido, c 450 ° C recozido, d 500 ° C recozido, e 550 ° C recozido e f HfO recozido a 600 ° C 2 /Si
Com base nos resultados acima, a Fig. 5 ilustra os mecanismos do HfO 2 filmes com diferentes temperaturas de recozimento. Considerando que a temperatura de recozimento é menor que 400 ° C (Fig. 5a), o filme é amorfo, onde os átomos de Hf e O estão dispostos aleatoriamente. A camada interfacial entre HfO 2 e c-Si wafer é um óxido misto que consiste em a-SiO 2 e a-HfO 2 . A uma temperatura de recozimento de 450–550 ° C (Fig. 5b), o HfO 2 o filme recebe energia térmica levando a uma mudança estrutural de amorfo para policristalino com fases monoclínica e ortorrômbica. A orientação cristalina e o espaçamento d são indicados de acordo com os resultados HR-TEM e GIXRD. Um SiO cristalino 2 camada é formada. Vários trabalhos relataram uma camada de óxido de silício ordenada na interface de a-SiO 2 e (100) c-Si, mas o mecanismo e a estrutura em escala atômica permaneceram controversos. A oxidação térmica do silício pode ser considerada como operações de inserção sequencial de átomos de oxigênio em ligações Si-Si, e isso induz um grande acúmulo de deformações compressivas nas regiões oxidadas e pode possivelmente causar uma transformação estrutural em óxido ordenado no SiO 2 Interface / c-Si [24]. Também foi relatado que a fase cristalina contendo oxigênio poderia ser formada sob condições de alta supersaturação de oxigênio de Si [25] ou baixa densidade de defeito de interface [26]. A partir das imagens XPS e TEM neste trabalho, o HfO 2 camada é deficiente em oxigênio. As quantidades significativas de oxigênio se difundem do HfO 2 em direção ao substrato de silício, e isso pode levar à supersaturação de oxigênio na interface c-Si e formação de SiO cristalino 2 . Nesta faixa de temperatura, o SiO cristalino 2 a espessura da camada aumentaria, mas o a-HfO 2 + A-SiO 2 a espessura da camada mista diminui com o aumento da temperatura de recozimento. Em uma temperatura de recozimento superior a 550 ° C (Fig. 5c), o HfO 2 A estrutura é dominada por monofásica policristalina ortorrômbica (111). A camada interfacial é inteiramente governada por SiO cristalino 2 . O espaçamento d diminui para HfO ortorrômbico 2 camada e aumenta para c-SiO 2 . Embora o recozimento de HfO 2 é necessário para alcançar alta passivação do wafer de Si e constante dielétrica, em altas temperaturas, a cristalização resultante do HfO 2 e o SiO interfacial 2 pode reduzir as propriedades do filme. A temperatura de recozimento de 500 ° C é encontrada para obter a melhor constante dielétrica de 17,2. Aumentar ainda mais a temperatura de recozimento leva a uma redução na constante dielétrica, possivelmente devido à mudança na fase cristalina. Tomida et al. relatou que a constante dielétrica de HfO 2 diminui quando a estrutura se transforma de policristalina em monoclínica de fase única [27]. A melhor passivação de HfO 2 / Si também pode ser obtido na temperatura de recozimento de 500 ° C, pois temperaturas mais altas podem levar a um c-SiO completo 2 camada interfacial e desidrogenação na interface.
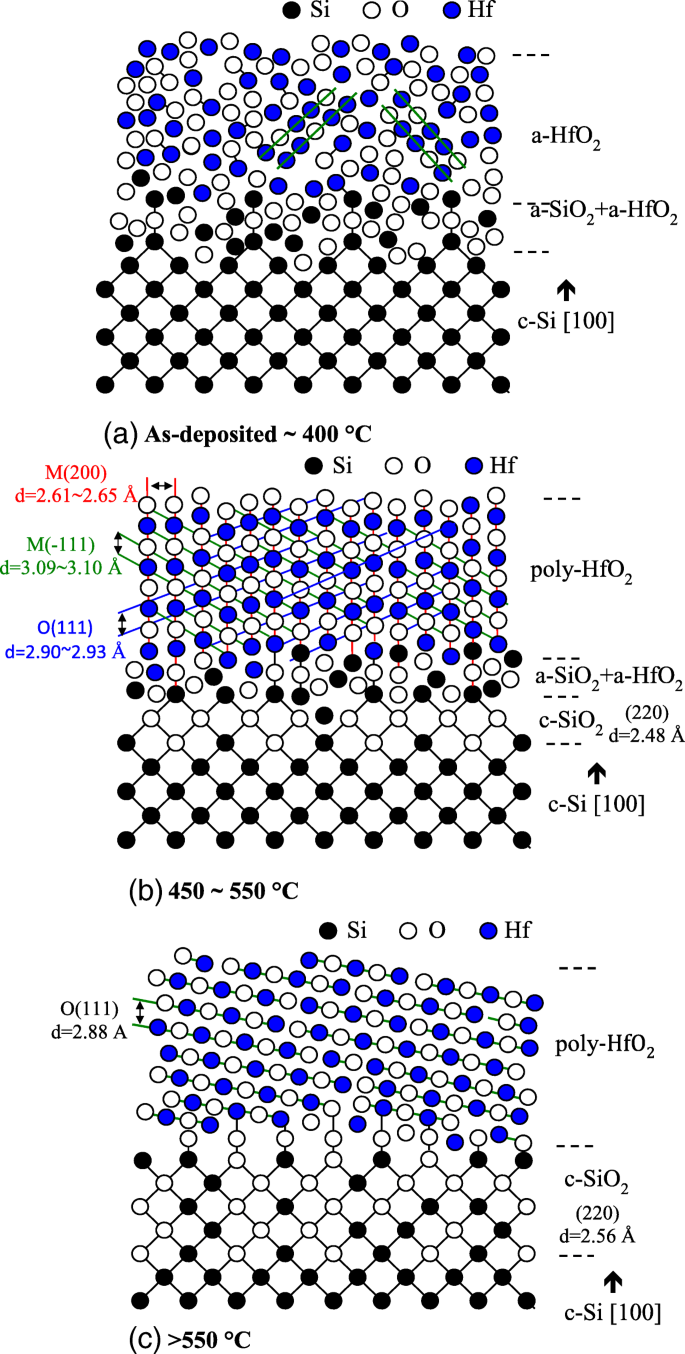
Diagramas do mecanismo de cristalização de HfO 2 filmes e camada interfacial nas faixas de temperatura a como depositado a 400 ° C, b 450 a 550 ° C e c além de 550 ° C. O valor de espaçamento d e orientação cristalina também são indicados
Conclusão
HfO 2 os filmes são preparados usando RP-ALD e o efeito da temperatura de recozimento na estrutura cristalina do HfO 2 foi investigado. Para HfO depositado 2 e que recozido abaixo de 400 ° C, o HfO 2 e a camada interfacial é amorfa. Com o aumento da temperatura de recozimento, o espaçamento d do ortorrômbico reduz, enquanto o do c-SiO 2 camada interfacial aumenta, indicando a difusão de oxigênio do HfO 2 para interface Si. Temperatura de recozimento superior a 550 ° C mostra um HfO 2 camada com fase única ortorrômbica policristalina, e a camada interfacial se transforma completamente em c-SiO 2 . Embora o recozimento seja necessário para HfO 2 em muitas aplicações, como a obtenção de alta passivação de pastilhas de Si e alta constante dielétrica, a cristalização pode ser prejudicial às propriedades do filme. A temperatura de recozimento de 500 ° C pode ter a melhor qualidade de passivação de wafer de Si e constante dielétrica.
Abreviações
- AFM:
-
Força atômica microscópica
- a-HfO 2 :
-
Óxido de háfnio amorfo
- ALD:
-
Deposição de camada atômica
- a-SiO 2 :
-
Dióxido de silício amorfo
- c-SiO 2 :
-
Dióxido de silício cristalino
- GIXRD:
-
Difração de raios-X incidente em pastejo
- HfO 2 :
-
Óxido de háfnio
- HR-TEM:
-
Microscopia eletrônica de transmissão de alta resolução
- N 2 :
-
Azoto
- O 2 :
-
Oxigênio
- RMS:
-
Raiz quadrada média
- RP-ALD:
-
Deposição de camada atômica de plasma remoto
- RTA:
-
Recozimento térmico rápido
- TEMAH:
-
Tetraquis (etilmetilamino) háfnio
- XPS:
-
espectroscopia de fotoelétrons de raios-X
Nanomateriais
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Preparação de nanoesferas poliméricas impressas com íons de paládio (II) e sua remoção de paládio (II) da solução aquosa
- Mecanismo de condução e resistência aprimorada em RRAM baseado em HfO2 com tratamento de nitridação
- Fabricação de filmes finos SrGe2 em substratos Ge (100), (110) e (111)
- Sondando as propriedades estruturais, eletrônicas e magnéticas dos aglomerados Ag n V (n =1–12)
- Fabricação de nanofibras helicoidais CA / TPU e sua análise de mecanismo
- Caracterização de ressonância magnética e de micro-ondas dependente da espessura de filmes FeCoBSi padronizados de listras combinadas
- Uma simulação teórica das respostas à radiação da superrede de Si, Ge e Si / Ge para irradiação de baixa energia
- Propriedades de síntese controlada e adsorção seletiva de nanofolhas Pr2CuO4:uma discussão sobre o mecanismo



