Mecanismo de condução e resistência aprimorada em RRAM baseado em HfO2 com tratamento de nitridação
Resumo
Uma tecnologia de tratamento de nitretação com uma fonte de nitrogênio complexo de ureia / amônia melhorou a propriedade de comutação resistiva em HfO 2 com base em memória de acesso aleatório resistiva (RRAM). O tratamento de nitretação produziu um dispositivo confiável e de alto desempenho que resulta em resistência superior (mais de 10 9 ciclos) e um efeito de auto-conformidade. Assim, o mecanismo de condução atual mudou devido ao defeito de passivação por átomos de nitrogênio no HfO 2 filme fino. Em um estado de alta resistência (HRS), ele foi transferido para a emissão Schottky de Poole-Frenkel em HfO 2 RRAM baseado em No estado de baixa resistência (LRS), o mecanismo de condução atual foi a corrente de carga espacial limitada (SCLC) após o tratamento de nitretação, o que sugere que os átomos de nitrogênio formam aglomerados de vacância Hf-N-Ox (V o + ) que limitam o movimento do elétron através da camada de comutação.
Histórico
Recentemente, memória de acesso aleatório por resistência (RRAM) composta por uma camada isolante ensanduichada por dois eletrodos tem sido amplamente estudada como uma candidata promissora para memória não volátil de próxima geração devido às suas propriedades superiores, como estrutura simples, baixo consumo de energia, operação em alta velocidade (<300 ps) e leitura não destrutiva [1-9]. Embora a maioria dos dispositivos RRAM tenha muitas propriedades superiores à memória não volátil, a alta corrente de operação da RRAM e a degradação do desempenho são os principais problemas da memória não volátil em termos de aplicação de produtos eletrônicos portáteis.
O Pt / HfO 2 / A estrutura TiN pode fornecer um caminho de condução que induz um comportamento de chaveamento resistivo [10-19]. No entanto, os defeitos do HfO amorfo 2 aumentará o número de caminhos de vazamento, levando ao consumo de energia e degradação do aquecimento joule. Neste trabalho, a camada de comutação resistiva de HfO 2 foi tratado por uma solução com uma fonte de nitrogênio complexo de ureia / amônia como o tratamento de nitretação para aumentar suas propriedades de comutação elétrica.
Métodos
O TiN / Ti / SiO padronizado 2 O substrato / Si foi fabricado com um processo padrão de deposição e corrosão, após o qual orifícios de passagem podem ser formados (inserção da Fig. 1a). Então, um HfO 2 de 23 nm de espessura filme fino foi depositado em orifícios no substrato por pulverização catódica RF magnetron usando um HfO 2 puro alvo. A potência de pulverização catódica foi fixada em potência de RF de 150 W e realizada em ambiente de argônio (Ar =30 sccm) com pressão de trabalho de 4 mtorr à temperatura ambiente. O HfO 2 / TiN dispositivo semiacabado foi colocado na câmara reativa e imerso na solução com uma fonte de nitrogênio complexo de ureia / amônia para tratamento de nitretação. Durante o tratamento de nitretação, a solução foi aquecida a 160 ° C na câmara de aço inoxidável do sistema por 30 min. Em seguida, o eletrodo superior de Pt com 110 nm de espessura foi depositado por pulverização catódica de magnetron DC no HfO 2 filme fino para formar dispositivos elétricos com Pt / HfO 2 / Estruturas sanduíche TiN. Finalmente, todas as características elétricas foram medidas pelo analisador de parâmetros de semicondutores Agilent B1500. A polarização de varredura de DC e pulso foi aplicada ao eletrodo inferior (TiN), enquanto o eletrodo superior (Pt) foi aterrado durante as medições elétricas. Além disso, a espectroscopia de infravermelho com transformada de Fourier (FTIR) foi medida por um espectrômetro Bruker VERTEX 70v na região do infravermelho médio.

a As curvas de formação atuais de HfO 2 dispositivos RRAM baseados em b Comparação de ciclos de varredura DC em uma corrente de complacência de 5 mA entre o tratamento inicial e após o tratamento de nitretação de HfO 2 RRAM baseado em c Ciclos de varredura DC sem conformidade de corrente externa do HfO 2 dispositivo após o tratamento de nitretação. d Tempo de retenção do HfO 2 dispositivos RRAM baseados em 85 ° C com e sem corrente de conformidade após o tratamento de nitretação
Resultados e discussão
Um processo de eletroformação é necessário para ativar todos os dispositivos RRAM usando uma polarização DC com uma corrente de conformidade de 10 μA, como mostrado na Fig. 1a. Após o processo de formação, as propriedades da tensão-corrente elétrica (I-V) do HfO 2 com base em RRAM foram comparados no início e após o tratamento de nitretação. No LRS, a corrente foi obviamente reduzida em comparação com o HfO 2 não tratado filme fino, como mostrado na Fig. 1b. A redução atual pode ser atribuída aos defeitos passivados pelo NH 3 molécula na solução de tratamento. Descobrimos que a distribuição de HRS é muito mais estável após o tratamento de nitretação, como no detalhe da Fig. 1b. Os estados de resistência são extraídos com uma tensão de leitura de 0,1 V durante os 100 ciclos de varredura com operação DC (inserção da Fig. 1b). A relação de resistência liga / desliga foi ligeiramente reduzida após o tratamento de nitretação. Curiosamente, uma propriedade de comutação resistiva de auto-conformidade foi observada nestes HfO 2 com base em dispositivos RRAM após o tratamento, conforme mostrado na Fig. 1c. Depois de mais de 10 3 ciclos de varredura, foi observada uma característica autoprotetora repetível do dispositivo sem quebras severas. O tempo de retenção foi avaliado a 85 ° C e permaneceu estável mesmo após 10 4 s em HRS e LRS.
Para avaliar ainda mais o desempenho do dispositivo, os testes de resistência de HfO 2 com base em RRAM foram realizados para o tratamento inicial e após o tratamento de nitretação, como mostrado na Fig. 2. No dispositivo não tratado após 10 6 ciclos de varredura, a razão HRS / LRS degrada significativamente de 100:1 a 5:1, como mostrado na Fig. 2a. Após o tratamento de nitretação, no entanto, mesmo depois de mais de 10 9 ciclos de varredura, o dispositivo exibiu uma razão HRS / LRS estável, como na Fig. 2b. Esses resultados indicam que o processo de nitretação aumentou o HfO 2 RRAM baseado em desempenho com recursos de comutação e confiabilidade superiores. Para investigar melhor esses resultados, a análise de FTIR foi usada para observar as alterações químicas do HfO 2 filme fino, como mostrado na Fig. 3. Um pico nítido em 1589 e 1311 cm −1 apareceu após o tratamento de nitretação, correspondendo ao pico de vibração de alongamento simétrico e assimétrico de uma ligação N-O [20]. Além disso, a intensidade de pico das ligações N – H em 1471 cm −1 [21] aumentou devido ao processo de nitretação pela fonte de nitrogênio do complexo ureia / amônia (detalhe da Fig. 3). Portanto, podemos inferir a formação de compostos contendo nitrogênio após o tratamento de nitretação.
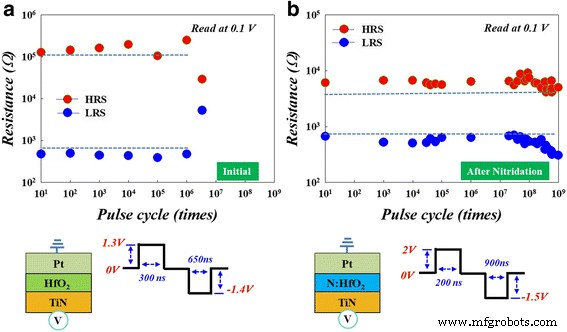
Comparação de tempos de resistência em HfO 2 RRAM baseado em: a inicial e b após o tratamento de nitretação. Os diagramas inferiores são as estruturas de dispositivo correspondentes e as condições de pulso de resistência

A comparação dos espectros de FTIR de HfO 2 filmes finos entre o tratamento inicial e após a nitretação
A fim de esclarecer o mecanismo de chaveamento resistivo, analisamos o mecanismo de condução de corrente do HfO 2 filme fino com e sem o tratamento de nitretação, mostrado nas Fig. 4a e d. Para o HfO não tratado 2 filme fino, os elétrons foram transferidos através dos defeitos, de forma que o mecanismo de condução da corrente foi dominado pela condução de Poole-Frenkel de acordo com a relação linear entre ln (I / V) e a raiz quadrada da tensão aplicada (V 1 / 2 ) no HRS, conforme mostrado na Fig. 4b [22].
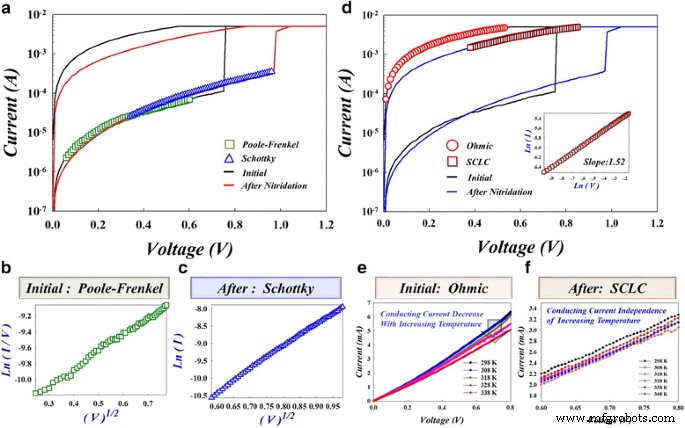
a Análise do mecanismo de condução atual de HRS a partir de curvas I-V em HfO 2 com base em RRAM entre o inicial e após o tratamento de nitretação. b O mecanismo de condução de corrente de Poole-Frenkel de HRS em HfO 2 RRAM baseado em c O mecanismo de condução de corrente de emissão Schottky de HRS em HfO 2 à base de RRAM após o tratamento de nitretação. d Análise do mecanismo de condução atual de LRS que se transforma em SCLC a partir da condução ôhmica após o tratamento de nitretação em HfO 2 RRAM baseado em a figura inserida mostra o resultado do ajuste atual do SCLC. e O mecanismo de condução ôhmica de LRS em HfO 2 baseado em RRAM que é característico na correlação negativa atual com a temperatura. f O mecanismo SCLC de LRS em HfO 2 com base em RRAM que é independente da temperatura após o tratamento de nitretação
Em contraste, HfO 2 RRAM baseado em exibiu o mecanismo de emissão Schottky de acordo com a relação linear entre ln (I / T 2 ) e a raiz quadrada da tensão aplicada (V 1/2 ) de HRS, como mostrado na Fig. 4c [23, 24]. Isso se deve à diminuição dos defeitos e das ligações pendentes, pois as ligações tornam-se passivadas por átomos de nitrogênio após o tratamento de nitretação. Além disso, também analisamos o mecanismo de condução atual com e sem tratamento no LRS em HfO 2 RRAM baseado em No LRS, o mecanismo de transporte do portador do HfO não tratado 2 RRAM com base foi dominado pela condução ôhmica, onde a corrente diminui com o aumento da temperatura, como mostrado na Fig. 4e. Após o tratamento de nitretação, o mecanismo de condução de corrente é transferido para a corrente limitada de carga espacial (SCLC) com uma inclinação de 1,52. A curva I-V não é relativa à temperatura, com uma relação linear entre ln (I) e o quadrado da tensão aplicada V 2 no LRS, conforme mostrado na Fig. 4f [25].
Propusemos um modelo para explicar as características do mecanismo de condução da corrente, e é mostrado na Fig. 5. Assim, existem dois dipolos compensados associados aos átomos de N e O e um átomo de Hf (ou seja, a sequência O – Hf – O é substituído por O – Hf – N – O) após dopar átomos de N em HfO 2 filme fino. Como a negatividade do elétron do nitrogênio é menor do que o oxigênio, o dipolo da ligação Hf – N é menor do que a ligação Hf – O, que cria uma região de constante dielétrica mais baixa. Quando uma polarização positiva é aplicada durante o processo SET, uma série de vacâncias Hf-N-Ox são formadas devido à sua constante dielétrica inferior, formando então clusters de vacância (Vo + ) O caminho condutor normalmente se forma junto com os clusters de vacância Hf – N – Ox (Vo + ) à medida que os átomos de nitrogênio capturam íons de oxigênio em torno dos aglomerados, como mostrado na Fig. 5b. A presença desses aglomerados de vacância Hf – N – Ox isolantes (Vo + ) resulta na redução da corrente e no efeito de auto-conformidade encontrado em HfO 2 RRAM baseado em

Um esquema da migração de íons de oxigênio através do processo definido em HfO 2 RRAM baseado em a inicial e b após o tratamento de nitretação, que forma aglomerados de vacância Hf – N – Ox (V o + )
Conclusões
Em resumo, uma propriedade de comutação resistiva de auto-conformidade foi observada em um Pt / HfO 2 / Dispositivo TiN RRAM após o tratamento de nitretação. Os tempos de resistência alcançaram 10 9 ciclos e um tempo de retenção de mais de 10 4 s foi alcançado a 85 ° C. Devido à menor negatividade de elétrons do átomo de nitrogênio quando comparado ao átomo de oxigênio, o dipolo da ligação Hf – N é menor do que o da ligação Hf – O, o que cria uma região de constante dielétrica mais baixa. Durante o processo SET, os clusters de vacância Hf – N – Ox (Vo + ) formam o caminho condutor. Os clusters de vacância isolantes Hf – N – Ox (Vo + ) protegem o dispositivo de avarias graves e executam uma propriedade de conformidade automática.
Abreviações
- FTIR:
-
Espectroscopia infravermelha com transformada de Fourier
- HRS:
-
Estado de alta resistência
- LRS:
-
Estado de baixa resistência
- RRAM:
-
Memória de acesso aleatório resistiva
- SCLC:
-
Corrente limitada de carga espacial
Nanomateriais
- Manteiga e Margarina
- Entrevista com um especialista:Spencer Wright de pencerw.com e nTopology
- Ganhando tração com Markforged:Moldagem e fundição de rodas impressas em 3D
- Materiais:Espuma EPP com propriedades de superfície aprimoradas e comportamento de enchimento otimizado
- Nanomaterial inteligente e nanocompósito com atividades agroquímicas avançadas
- Modelo de retenção de TaO / HfO x e TaO / AlO x RRAM com características de chave auto-retificadora
- Nanopartículas de albumina carregadas de resveratrol com circulação sanguínea prolongada e biocompatibilidade aprimorada para terapia de tumor pancreático direcionada altamente eficaz
- Eficácia antitumoral aprimorada e farmacocinética de Bufalin via lipossomas PEGuilados
- Toxicidade de nanopartículas de CoFe2O4 revestidas com PEG com efeito de tratamento da curcumina
- Resistência de contato reduzida entre metal e n-Ge por inserção de ZnO com tratamento de plasma de argônio



