Transistores de filme fino a-InGaZnO de alto desempenho com orçamento térmico extremamente baixo usando um dielétrico Al2O3 rico em hidrogênio
Resumo
As características elétricas de transistores de filme fino (TFTs) amorfos In-Ga-Zn-O (a-IGZO) são comparadas usando O 2 deposição de camada atômica intensificada por plasma Al 2 O 3 dielétricos em diferentes temperaturas. TFTs a-IGZO de alto desempenho são demonstrados com sucesso com um Al 2 O 3 dielétrico depositado em temperatura ambiente, que exibe uma alta mobilidade de efeito de campo de 19,5 cm 2 V - 1 s - 1 , uma pequena oscilação de sublimiar de 160 mV / dec, uma baixa tensão de limiar de 0,1 V, uma grande relação de corrente liga / desliga de 4,5 × 10 8 e estabilidades de polarização de porta negativa e positiva superiores. Isso é atribuído ao Al 2 rico em hidrogênio O 3 dielétrico depositado à temperatura ambiente em comparação com temperaturas de deposição mais altas, assim, passivando eficientemente os estados interfaciais de a-IGZO / Al 2 O 3 e as vacâncias de oxigênio e melhorando a condutividade do canal a-IGZO gerando elétrons adicionais por causa do dopagem de hidrogênio aprimorada durante a pulverização catódica de IGZO. Esse orçamento térmico extremamente baixo para TFTs a-IGZO de alto desempenho é muito atraente para aplicações eletrônicas flexíveis.
Histórico
Transistores de filme fino (TFTs) amorfos baseados em In-Ga-Zn-O (a-IGZO) têm atraído muita atenção na última década devido à sua alta mobilidade, boa uniformidade, alta transparência de luz visível e baixa temperatura de processo [1, 2,3]. Esses méritos o tornam um candidato promissor para a aplicação de eletrônicos de última geração, como display transparente, dispositivos flexíveis ou eletrônicos vestíveis. Em particular, para as aplicações de eletrônicos flexíveis, os TFTs são geralmente fabricados em substratos de polímero termicamente estáveis. Assim, é necessário reduzir o orçamento térmico da fabricação do a-IGZO TFT. Para este propósito, muitos pesquisadores têm se concentrado em a-IGZO TFTs com isoladores de porta fabricados em temperatura ambiente, como sputtering [4,5,6], processo de solução [7,8,9], evaporação de feixe eletrônico [10] e anodização [11]. No entanto, esses filmes dielétricos muitas vezes sofrem de alta densidade de armadilhas e forte espalhamento interfacial dielétrico / a-IGZO, resultando assim em mobilidade limitada de efeito de campo, uma grande oscilação de sublimiar e uma pequena razão de corrente liga / desliga [4,5,6 , 7,8,9,10,11].
Por outro lado, a deposição de camada atômica (ALD) é uma técnica promissora, que pode fornecer filmes de alta qualidade, controle preciso da espessura do filme, boa uniformidade em uma grande área e baixa temperatura de processo [12,13,14]. Zheng et al. [15] relatou que o a-IGZO TFT com ALD SiO 2 dielétrico exibiu excelente desempenho elétrico sem a necessidade de pós-recozimento. No entanto, uma alta temperatura de substrato de 250 ° C é necessária para o ALD de SiO 2 filmes [15], que é mais alto do que as temperaturas de transição vítrea da maioria dos substratos plásticos flexíveis. Curiosamente, é relatado que ALD de Al 2 O 3 os filmes podem ser realizados mesmo em temperatura ambiente (RT) [16, 17]; enquanto isso, o Al 2 O 3 o filme depositado em RT contém uma grande quantidade de impurezas de hidrogênio (H) [17]. No entanto, até onde sabemos, o supramencionado Al 2 rico em H O 3 o filme nunca foi utilizado como isolante de porta em a-IGZO TFT. Portanto, é desejável explorar o a-IGZO TFT com um RT ALD Al 2 O 3 isolador de porta.
Nesta carta, a-IGZO TFT de alto desempenho foi fabricado com sucesso com um Al 2 depositado à temperatura ambiente O 3 dielétrico de porta. Comparando as características dos a-IGZO TFTs com vários Al 2 O 3 isoladores de porta depositados em diferentes temperaturas, o mecanismo subjacente foi abordado.
Métodos
Wafers de silício tipo p altamente dopados (<0,0015 Ω cm) foram limpos por processos RCA padrão e serviram como eletrodos de porta. Al 2 de quarenta nanômetros O 3 os filmes foram depositados em um sistema comercial ALD (Picsun Ltd.) usando trimetilalumínio (TMA) e O 2 plasma como precursor e reagente, respectivamente. Um ciclo de crescimento consistiu em pulso de TMA de 0,1 s, 10 s N 2 purga, 8 s O 2 pulso de plasma e 10 s N 2 purga. O TMA foi mantido a 18 ° C para uma pressão de vapor e dose estáveis, e o O 2 a taxa de fluxo de gás foi fixada em 150 sccm com uma potência do gerador de plasma de 2500 W. Subseqüentemente, filmes de a-IGZO de 40 nm foram depositados por pulverização catódica RF usando um alvo de cerâmica IGZO com uma razão atômica de In:Ga:Zn:O =1 :1:1:4. Durante a pulverização catódica, pressão de trabalho e Ar e O 2 as taxas de fluxo de gás foram fixadas em 0,88 Pa e 48 e 2 sccm, respectivamente. A região ativa foi formada por fotolitografia e corrosão úmida. Em seguida, eletrodos fonte / dreno de bicamadas 30 nm Ti / 70 nm Au foram preparados por evaporação por feixe de elétrons e método lift-off. Nenhum outro processo de recozimento foi aplicado a esses dispositivos.
As propriedades elétricas dos a-IGZO TFTs foram caracterizadas usando um analisador de dispositivo semicondutor (Agilent Tech B1500A) em uma caixa escura em temperatura ambiente. As estabilidades do dispositivo foram medidas sob tensões de polarização de porta positiva e negativa, respectivamente. Os perfis de profundidade dos elementos e composição química foram medidos por espectrometria de massa de íons secundários (SIMS) e espectroscopia de fotoelétrons de raios-X (XPS), respectivamente.
Resultados e discussão
A Figura 1a compara as constantes dielétricas do Al 2 O 3 filmes depositados em diferentes temperaturas em função da frequência (ou seja, de 10 Hz a 10 5 Hz). Conforme a temperatura de deposição aumenta de 100 para 150 ° C, o filme mostra uma diminuição gradual da constante dielétrica. Uma tendência semelhante também foi relatada em literaturas anteriores para a mudança da temperatura de deposição de RT para 150 ° C [18, 19]. Isso ocorre porque o RT Al 2 O 3 filme contém a maior concentração de hidrogênio (H) na forma de grupos OH. Assim, a constante dielétrica correspondente é aumentada devido à rotação de mais grupos OH em um campo elétrico [20]. Em termos de frequência de medição de 10 Hz, as constantes dielétricas extraídas para o RT, 100 ° C e 150 ° C Al 2 O 3 os filmes são iguais a 8,6, 7,9 e 7,4, respectivamente, que são usados para a extração da mobilidade de efeito de campo ( μ FE ) e densidade de armadilha interfacial ( D it ) do dispositivo TFT fabricado. A Figura 1b mostra as características da corrente de fuga de diferentes Al 2 O 3 filmes. Verifica-se que o RT Al 2 O 3 o filme exibe uma pequena densidade de corrente de fuga de 2,38 × 10 - 8 A / cm 2 a 2 MV / cm e um campo elétrico de ruptura de 5,3 MV / cm. Além disso, o campo elétrico de ruptura aumenta gradualmente com o aumento da temperatura de deposição de 100 a 150 ° C.
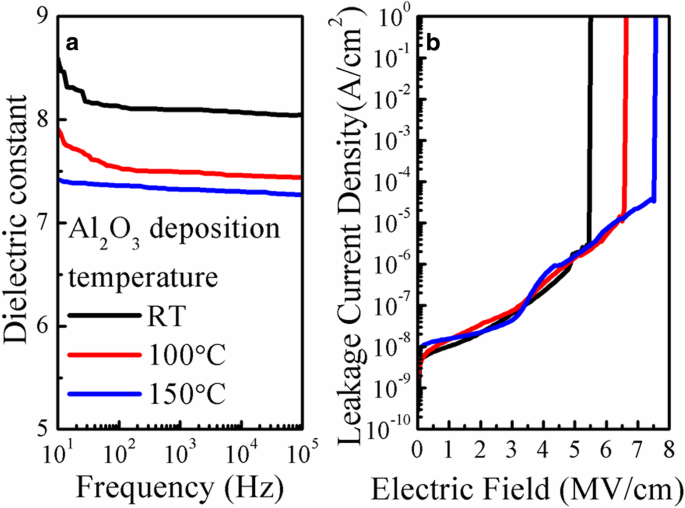
Propriedades elétricas de Al 2 O 3 filmes depositados em diferentes temperaturas. a Constante dielétrica versus frequência. b Densidade de corrente de fuga versus campo elétrico
A Figura 2 mostra as curvas de transferência típicas dos a-IGZO TFTs com diferentes Al 2 O 3 isoladores de portão. O RT Al 2 O 3 TFT exibe o melhor desempenho, como alto μ FE de 19,5 cm 2 V - 1 s - 1 , uma pequena oscilação de sublimiar (SS) de 160 mV / dec, uma pequena tensão de limiar ( V T ) de 0,1 V, e uma grande relação de corrente liga / desliga ( I ligado / desligado ) de 4,5 × 10 8 . No entanto, os TFTs a-IGZO com Al 2 O 3 isoladores de porta depositados a 100 e 150 ° C mostram um desempenho muito pior, ou seja, correntes ativas reduzidas (10 - 7 e 3 × 10 - 9 A) e SS degradado. O D it na interface de Al 2 O 3 / a-IGZO pode ser calculado com base na seguinte equação [21]:
$$ {D} _ {\ mathrm {it}} =\ left (\ frac {\ mathrm {SS} \ times \ lg e} {kT / q} -1 \ right) \ frac {C_ {ox}} { q ^ 2} $$ (1)
onde e , k , T e q representam o número de Euler, constante de Boltzmann, temperatura absoluta e carga eletrônica unitária, respectivamente. C boi é a capacitância dielétrica da porta por unidade de área. Para o RT Al 2 O 3 TFT, o D it é igual a 1,1 × 10 12 eV - 1 cm - 2 , que é mais de uma ou duas vezes menor do que aqueles para os TFTs com o Al 2 O 3 isoladores de porta depositados a 100 e 150 ° C.

Curvas de transferência dos TFTs a-IGZO com ALD Al 2 O 3 isoladores de porta depositados em diferentes temperaturas, juntamente com os parâmetros do dispositivo extraído
As estabilidades de polarização da porta dos dispositivos foram medidas posteriormente aplicando tensões negativas e positivas. A Figura 3 mostra o V T deslocamento em função do tempo de estresse de polarização para diferentes TFTs. Em termos de estresse de polarização de porta negativa (NGBS), o RT Al 2 O 3 TFT exibe um V insignificante T deslocamento de - 0,04 V após ser submetido a tensão em - 10 V por 40 min. No entanto, Al 2 de alta temperatura O 3 isoladores de porta geram V maiores T muda especialmente para 150 ° C. Uma estabilidade NGBS tão alta para RT Al 2 O 3 deve ser atribuído a uma baixa concentração de vacâncias de oxigênio ( V O ) no canal a-IGZO [22]. Com relação ao estresse de polarização de porta positiva (PGBS), o RT Al 2 O 3 TFT mostra um V T deslocamento de 1,47 V, que é muito menor do que aqueles (8,8 V e 12,1 V) para o Al 100 e 150 ° C 2 O 3 TFTs. Além disso, foi investigada a influência do tempo de armazenamento no desempenho do dispositivo, conforme mostrado na Fig. 4. Embora nenhuma camada de passivação seja coberta no canal traseiro, o dispositivo ainda mantém um excelente desempenho após ser mantido em um gabinete (20% UR) durante 60 dias a 30 ° C; entretanto, nenhuma variação significativa em μ FE e SS são observados. Isso indica o RT Al 2 O 3 TFTs sem qualquer camada de passivação têm boa estabilidade dependente do tempo de armazenamento no ambiente atual.

V T deslocamento como uma função do tempo de estresse de polarização sob NGBS =- 10 V e PGBS =10 V para os TFTs com Al 2 O 3 isoladores depositados em diferentes temperaturas

Estabilidade dependente do tempo de RT Al 2 O 3 TFT após ser mantido em um gabinete (20% UR) a 30 ° C. a Curvas de transferência. b Mobilidade e oscilação de sublimiar
A Tabela 1 compara o desempenho de nosso RT Al 2 O 3 TFT com outros relatórios. Verificou-se que nosso dispositivo exibe um V próximo de zero T , SS menor e I maior ligado / desligado no caso de mobilidade comparável [4, 23]. Apesar de usar um Ta 2 O 5 isolador de porta pode obter maior mobilidade de 61,5 cm 2 V - 1 s - 1 , ambos SS e I ligado / desligado deteriorar-se notavelmente [10]. Em uma palavra, nosso RT Al 2 O 3 TFT possui um desempenho abrangente superior em comparação com 100 e 150 ° C Al 2 O 3 TFTs. Uma vez que todas as etapas de processamento são idênticas, exceto a etapa de deposição de Al 2 O 3 , tais diferenças significativas no desempenho elétrico devem se originar do Al 2 O 3 isoladores de portão.
Para entender o mecanismo subjacente, os perfis de profundidade dos elementos no a-IGZO / Al 2 O 3 os filmes empilhados foram analisados pelo SMIS. A Figura 5a mostra a dependência da concentração de H na profundidade nas pilhas de IGZO / Al 2 O 3 , onde o Al 2 O 3 os filmes foram depositados em temperatura ambiente e 150 ° C, respectivamente. Para comparação, um filme IGZO depositado em um substrato de Si nu também foi analisado. O filme IGZO depositado em Si puro contém uma concentração de H de ~ 3 × 10 21 cm - 3 , que se origina do gás residual no sistema de pulverização catódica e H 2 absorvido / H 2 Moléculas de O na superfície de Si. Ambos os filmes IGZO depositados no Al 2 O 3 os filmes contêm concentrações de H mais altas do que no substrato de Si puro. Isso indica que as concentrações aumentadas de H devem vir da liberação de impurezas de H no Al 2 subjacente O 3 filmes durante a pulverização catódica de IGZO. Além disso, é observado que a concentração de H no filme IGZO no topo do RT Al 2 O 3 o filme é mais alto do que aquele de 150 ° C na região da interface próxima, o que pode fornecer passivação mais eficiente dos estados interfaciais. Isso, portanto, melhora a estabilidade SS e PGBS do RT Al 2 O 3 TFT reduzindo o aprisionamento interfacial de portadores. Além disso, os espectros O 1s XPS dos filmes a-IGZO perto da interface de IGZO / Al 2 O 3 foram analisados, como mostrado na Fig. 5b. Os picos ajustados estão localizados em 530,2 ± 0,1 eV, 530,9 ± 0,1 eV e 531,6 ± 0,1 eV, correspondendo a O 2− íons ligados com metal (O1), V O (O2) e grupos OH (O3), respectivamente [13, 24]. A porcentagem de O2 é de 26,3% na camada a-IGZO sobre o Si puro; no entanto, diminui para 12,3% e 6,8% para 150 ° C e RT Al 2 O 3 filmes subjacentes, respectivamente. Isso indica que mais V O no canal IGZO pode ser efetivamente passivado por impurezas H adicionais originadas do Al 2 subjacente O 3 filmes, especialmente para o RT Al 2 O 3 filme com uma concentração de H mais alta. É relatado que quando V O e H ambos estão presentes no filme a-IGZO, eles podem se combinar para formar um estado estável no qual H está preso em V O ( V O H), e o V resultante O H é um doador de nível superficial [25,26,27]. Assim, o doping H melhorado no canal IGZO no topo do RT Al 2 O 3 melhora a condutividade do canal, fornecendo elétrons adicionais. Além disso, o pequeno V T mudança sob o NGBS para o RT Al 2 O 3 O TFT também pode ser atribuído à passivação H efetiva de V O [28]. Conforme relatado na literatura, a instabilidade do TFT sob NGBS se origina da ionização do neutro V O ( V O → V O 2+ + 2e - ) [17, 29]. Além disso, a porcentagem O3 do filme a-IGZO no RT Al 2 O 3 é 6,9%, que é maior do que aqueles no 150 ° C Al 2 O 3 (5,3%) e o Si puro (4,6%), respectivamente. O grupo OH pode se originar da reação O 2− + H → OH - + E - durante a deposição de filmes IGZO [30]. Assim, o doping H aprimorado no canal IGZO no topo do RT Al 2 O 3 o filme gera mais grupos OH e também contribui para melhorar a condutividade do canal.

a Perfis SIMS de concentração de hidrogênio em Al 2 O 3 depositado a RT e 150 ° C. b Espectros O1s XPS de alta resolução do canal IGZO depositado em RT Al 2 O 3 , 150 ° C Al 2 O 3 , e Si nua
Conclusões
Um TFT a-IGZO de alto desempenho foi fabricado com sucesso sob o orçamento térmico extremamente baixo de RT usando um Al rico em H 2 O 3 dielétrico de porta preparado por O 2 ALD intensificado por plasma. Isso é atribuído ao fato de que o Al 2 O 3 o dielétrico depositado em RT contém mais impurezas de hidrogênio do que aqueles depositados em temperaturas mais altas. Assim, as impurezas H liberadas durante a pulverização catódica de IGZO geraram mais elétrons e passivaram eficientemente os estados interfaciais de a-IGZO / Al 2 O 3 e o V O no canal a-IGZO.
Abreviações
- a-IGZO:
-
Amorfo In-Ga-Zn-O
- ALD:
-
Deposição de camada atômica
- D it :
-
Densidade de armadilha interfacial
- H:
-
Hidrogênio
- I ligado / desligado :
-
Relação de corrente liga / desliga
- NGBS:
-
Tensão de polarização de portão negativo
- PGBS:
-
Estresse de polarização de porta positiva
- RT:
-
Temperatura do quarto
- SIMS:
-
Espectrometria de massa de íon secundário
- SS:
-
Balanço de sublimiar
- TFT:
-
Transistor de filme fino
- V O :
-
Vaga de oxigênio
- V O H:
-
Hidrogênio preso na vacância de oxigênio
- V T :
-
Tensão de limiar
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- μ FE :
-
Mobilidade de efeito de campo
Nanomateriais
- Acessórios de impressão 3D com materiais de alto desempenho
- Usando resina epóxi com arte
- Controle de Polarização Terahertz Completo com Largura de Banda Ampliada via Metasurfaces Dielétricos
- Transistores de efeito de campo Nanoflake SnSe multicamadas com contatos óhmicos de baixa resistência
- Ótimo aprimoramento da condutividade térmica do composto de silicone com nanofios de cobre ultralongos
- Fabricação de nanopadrão ordenado usando copolímero tribloco ABC com sal em tolueno
- Eletrodo de porta de prata impresso a jato de tinta curado por UV com baixa resistividade elétrica
- RGO e redes de grafeno tridimensionais TIMs co-modificados com alto desempenho
- Deposição de camada atômica de nanofilmes de óxido de índio para transistores de filme fino
- Melhoria do desempenho do dispositivo a-IGZO TFT usando um processo de interface limpa por meio de nanocamadas Etch-Stopper



