Nanocrystal-Embedded-Insulator (NEI) FETs Ferroelétricos para dispositivos de capacitância negativa e aplicações de memória não volátil
Resumo
Nós relatamos um novo transistor de efeito de campo ferroelétrico (FeFET) com isolador de nanocristal embutido (NEI) com camada isolante unificada-ferroelétrica / dielétrica (FE / DE) muito fina, que é promissor para lógica de baixa tensão e memória não volátil ( NVM) aplicativos. A natureza ferroelétrica das camadas NEI compreendendo ZrO ortorrômbico 2 nanocristais incorporados em Al amorfo 2 O 3 é comprovado por medições de tensão de polarização, microscopia de força piezoresposta e medições elétricas. O desempenho dependente da temperatura e o comportamento de resistência de um FET de capacitância negativa NEI (NCFET) são investigados. Um FeFET com FE / DE de 3,6 nm de espessura atinge uma janela de memória maior do que 1 V, pavimentando um caminho para o dimensionamento final da espessura de FE para permitir FeFETs tridimensionais com passo de aleta muito pequeno.
Histórico
Os transistores de efeito de campo com uma camada isolante de porta ferroelétrica (FeFETs) têm atraído um interesse considerável para uma variedade de aplicações de circuitos integrados. Devido às suas propriedades inerentes de capacitância negativa (NC), um FeFET pode atingir um comportamento de chaveamento mais acentuado do que um MOSFET convencional, permitindo operação com tensão mais baixa [1]. Várias estruturas de canal [2,3,4] e materiais [5,6,7] obtiveram oscilação subliminar (SS) abaixo de 60 mV / década. Além disso, histerese na corrente-tensão ( I - V ) característica devido à polarização remanescente ( P r ) pode ser usado para aplicações de memória não volátil (NVM) [8]. O desenvolvimento de materiais para FeFETs recentemente se concentrou em HfO dopado com policristalino 2 devido a sua melhor escalabilidade de espessura [9] e compatibilidade do processo CMOS [2]. No entanto, ainda existe um limite fundamental para HfO 2 escala de espessura para evitar corrente de fuga de porta indesejada; isto, por sua vez, limita o FinFET [2]. Inspirado no conceito de MOS nanocristal e dispositivo de memória [10, 11], uma camada dielétrica isolante (DE) com nanocristais ferroelétricos (FE) embutidos é apresentada neste trabalho. O novo projeto de dispositivo resultante ilustrado na Fig. 1 é chamado de FeFET “Nanocrystal-Embedded-Insulator” (NEI). A principal vantagem desse projeto é uma camada FE / DE unificada mais fina que atende ao requisito de vazamento de porta baixa.
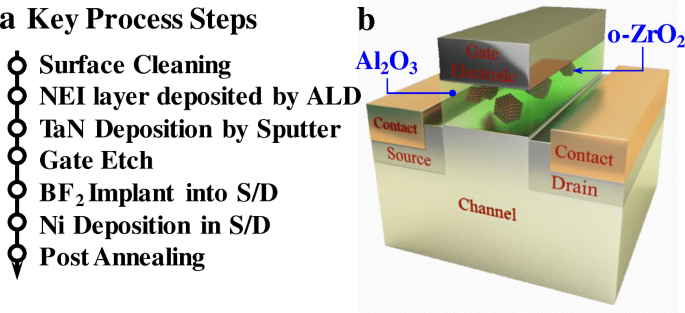
a Principais etapas do processo para a fabricação dos transistores de efeito de campo ferroelétricos NEI. b Esquema 3D do NEI FeFET fabricado
Neste trabalho, NEI FeFETs são relatados. Propriedades físicas e ferroeletricidade das camadas NEI com diferentes espessuras físicas são caracterizadas. O desempenho elétrico dos NEI FeFETs é investigado para lógica de baixa tensão e aplicações NVM.
Métodos
As principais etapas do processo para a fabricação de NEI FeFETs são mostradas na Fig. 1a. Bolachas de Ge tipo n de quatro polegadas (001) com uma resistividade de 0,088–0,14 Ω cm foram usadas como substratos iniciais. Após a limpeza pré-gravada usando HF diluído, pastilhas de Ge (001) foram carregadas em uma câmara de deposição de camada atômica (ALD) para a deposição da camada NEI compreendendo ZrO 2 nanocristais incorporados em Al amorfo 2 O 3 matriz. Camadas NEI com as várias espessuras foram utilizadas neste trabalho. A porta de metal TaN foi depositada nos NEI FeFETs usando a pulverização catódica reativa. Após a padronização e gravação do portão, BF 2 + íons foram implantados nas regiões de fonte / drenagem a uma energia de 20 keV e uma dose de 1 × 15 cm −2 . Níquel (Ni) de trinta nanômetros foi depositado nas regiões de fonte / drenagem usando o processo de decolagem. Finalmente, a fabricação do dispositivo foi concluída com o recozimento térmico rápido (RTA). Transistores de efeito de campo semicondutores de óxido metálico de controle (MOSFETs) com um Al puramente dielétrico 2 O 3 camada isolante de portão também foi fabricada.
A Figura 1b mostra o esquema 3D do NEI FeFET fabricado, que compreende nanocristais de FE embutidos em uma camada isolante de porta DE amorfa. Embora o volume do material FE seja pequeno, é suficiente para aplicações NCFET e NVM. O material isolante DE é a chave para alcançar baixo vazamento na porta e baixa tensão de operação; ele deve ter uma grande diferença de energia e alta permissividade dielétrica ( κ ) Também deve fornecer um campo altamente coercitivo ( E c ) dos nanocristais de FE incorporados.
A imagem do microscópio eletrônico de transmissão transversal (XTEM) na Fig. 2a mostra a fonte / dreno, o canal e as regiões da borda da porta de um FeFET fabricado. As Figuras 2b ec indicam que as espessuras das camadas NEI estudadas neste trabalho são 3,6 e 2,1 nm, respectivamente. Observe que uma camada interfacial de GeO x existe entre a camada NEI e Ge, embora não possa ser visto.
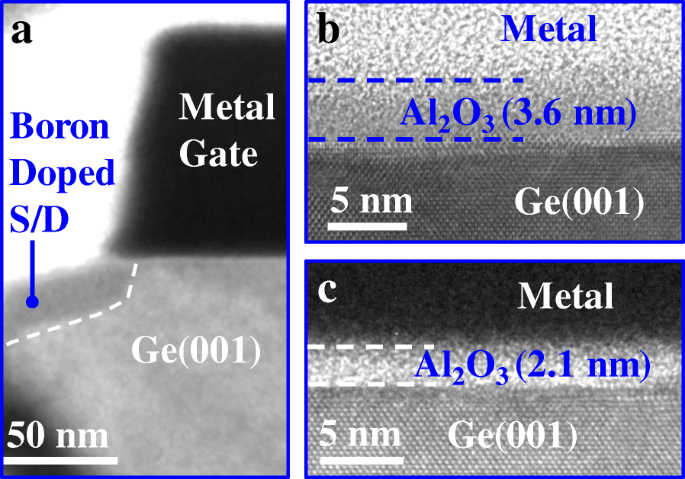
a Imagem XTEM mostrando regiões de porta, canal e fonte / dreno de NEI-FeFET. b e c Imagens XTEM de empilhamento de portas de FeFETs com camadas NEI de 3,6 e 2,1 nm de espessura, respectivamente
Imagens TEM de alta resolução (HRTEM) na Fig. 3 demonstram o ZrO 2 nanocristais incorporados em Al amorfo 2 O 3 em Ge (001) nas amostras NEI com espessuras de 3,6 e 6 nm. Em nosso trabalho anterior, mostramos que a porcentagem atômica de Zr na camada NEI é inferior a 0,5% [12]. Com base nos padrões de difração, o espaçamento interplanar d dentro dos nanocristais é calculado como sendo 0,173 nm, o que corresponde a ZrO ortorrômbico orientado para (111) 2 fase [13].
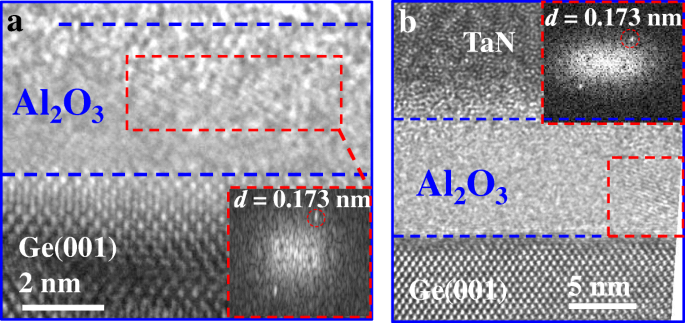
Imagens HRTEM mostrando nanocristais incorporados em Al amorfo 2 O 3 para as amostras com espessuras de a 3,6 nm e b 6 nm. As inserções mostram que o espaçamento interplanar d no nanocristal é 0,173 nm, correspondendo a o-ZrO 2 (111) fase
Polarização vs. tensão ( P - V ) e medições de microscopia de força de resposta piezoresposta (PFM) foram realizadas nas amostras NEI com as diferentes espessuras. Para caracterizar a ferroeletricidade da camada NEI, P - V curvas de TaN / NEI (3,6 nm) / Ge, TaN / NEI (6 nm) / Si 0,7 Ge 0.3 , e TaN / NEI (10 nm) / capacitores TaN são mostrados na Fig. 4a, b e c, respectivamente. A camada NEI exibe um P inferior do que os valores relatados de HfZrO 2 (HZO) [14], que é devido ao fato de que a relação de volume de ZrO 2 nanocristal em Al 2 O 3 matriz é bastante baixa. Vê-se que a polarização remanescente P r do filme NEI aumenta com o aumento da espessura do filme. P-V as curvas na Fig. 4c indicam que a ferroeletricidade da camada NEI degenera enquanto a temperatura de recozimento aumenta de 450 para 550 ° C. Observa-se que a razão para o não divulgado P-V loops é porque realmente existe um vazamento. Foi relatado que o deslocamento resultante no campo elétrico zero diminui à medida que a faixa de varredura da tensão é reduzida [3, 15, 16]. As imagens de amplitude (superior) e de fase (inferior) de 3,6 nm, 6 nm e 10 nm NEI foram medidas, conforme mostrado nas Fig. 5a, be c, respectivamente. Como mostrado na Fig. 6, os padrões que indicam a polaridade oposta escrita na superfície de NEI em TaN exibem um contraste mais claro com o aumento da espessura do filme.
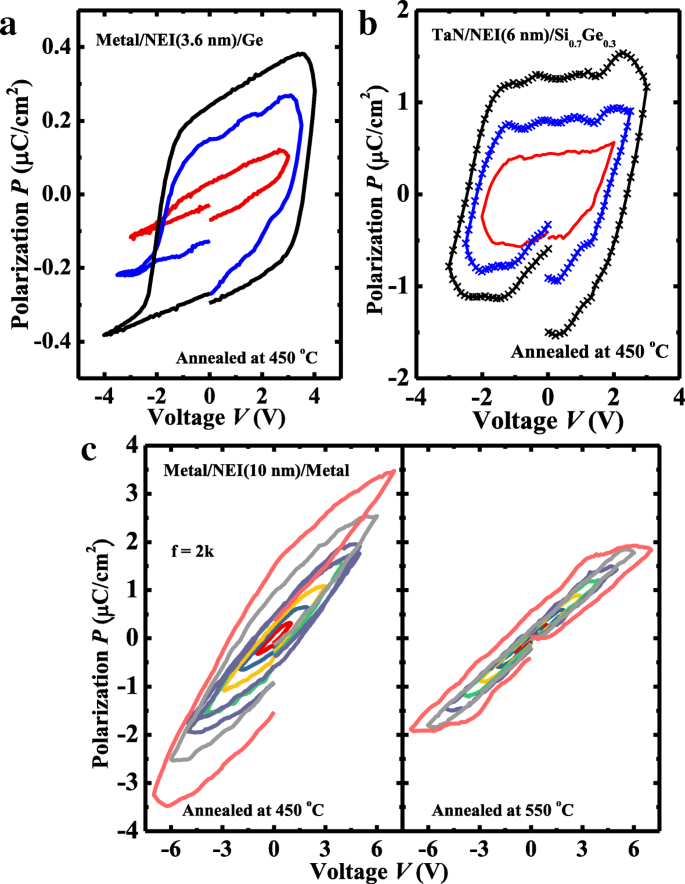
a - c Medido P - V curvas de TaN / NEI (3,6 nm) / Ge, TaN / NEI (6 nm) / Si 0,7 Ge 0.3 , e TaN / NEI (10 nm) / TaN, respectivamente
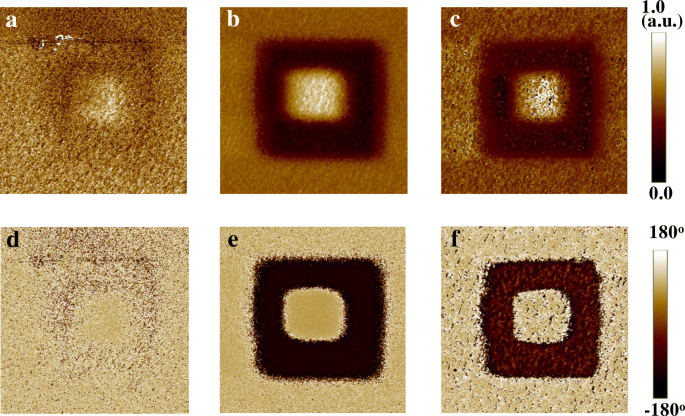
a - c Imagens de amplitude (superior) e fase (inferior) de medição de PFM para NEI de 3,6, 6 e 10 nm em TaN, respectivamente
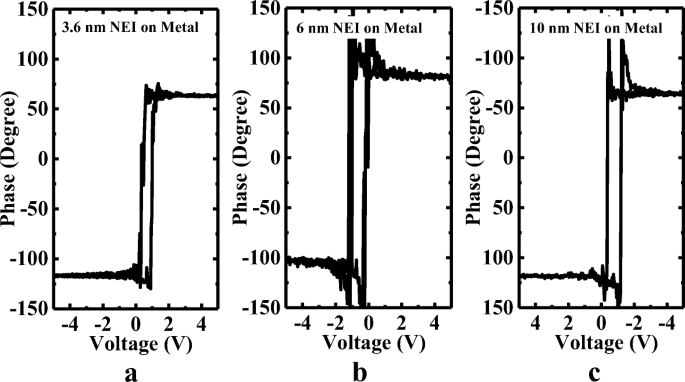
a - c Características de mudança de fase de 3,6, 6 e 10 nm NEI em TaN, respectivamente. Observa-se que a polaridade oposta pode ser escrita na superfície da camada NEI
Resultados e discussão
NEI NCFET
A Figura 7a mostra o I medido DS - V GS curvas dos NCFETs NEI com uma espessura NEI de 3,6 nm recozidos a 450 ° C e 500 ° C. Os NCFETs exibem pouca histerese indicando o bom casamento entre a capacitância ferroelétrica e a capacitância MOS nos transistores. Os NCFETs mostram o efeito NC induzido no sentido horário I-V loops, que está em contraste com os do sentido anti-horário por captura / retirada de carga [17]. O vazamento do portão eu G em função de V GS do mesmo par de dispositivos demonstra que a formação de nanocristais em Al 2 O 3 não aumenta o vazamento da comporta. A Figura 7b mostra que os NCFETs alcançam os pontos SS íngremes abaixo de 60 mV / década para as varreduras para frente e para trás. As flutuações de SS no NEI NCFET, também observadas em NC FinFETs [2, 18], podem ser devidas à troca de polarização pelos diferentes nanocristais ou domínios ferroelétricos. O medido eu DS - V DS curvas para o mesmo par de dispositivos na Fig. 7c mostram que em ∣ V GS - V TH ∣ =∣ V DS ∣ =1,0 V, o NCFET com RTA a 500 ° C atinge 29% maior I DS em comparação com o transistor recozido a 450 ° C. Isso é atribuído ao fato de que a mobilidade da portadora no canal e as características de resistência de contato podem ser melhoradas com o aumento da temperatura de anelamento [19]. A característica típica induzida pela camada ferroelétrica, resistência diferencial negativa (NDR), é observada no I DS - V DS curvas para os NCFETs recozidos nas diferentes temperaturas.
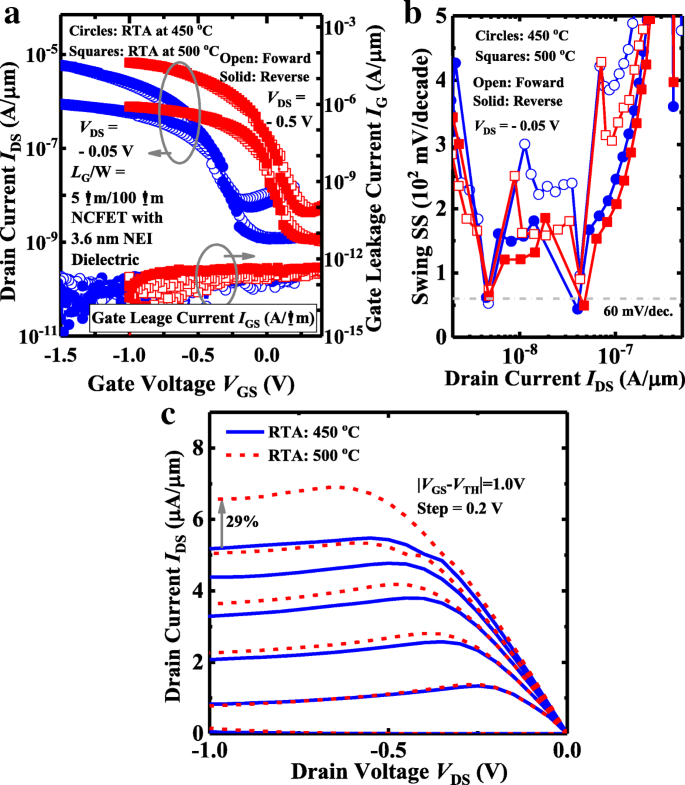
a Medido I DS - V GS e eu G - V GS curvas de NCFETs com NEI de 3,6 nm recozido a 450 ° C e 500 ° C. b NEI NCFETs tem pontos abaixo de 60 mV / década para um V DS valor de - 0,05 V. c eu DS - V DS curvas para os NCFETs NEI mostrando os fenômenos NDR óbvios. Transistor NC recozido a 500 ° C atinge 29% I DS melhoria em comparação com o dispositivo com RTA a 450 ° C a uma tensão de alimentação de 1,0 V
A Figura 8a mostra o I medido DS - V GS curvas de um NEI NCFET e um MOSFET de controle com a mesma espessura de isolador de 2,1 nm. Os dispositivos têm um L G de 6 μm. O NCFET exibe as características livres de histerese. A inserção mostra o ponto SS vs. I DS curvas para os dispositivos, demonstrando que SS melhorado é alcançado no NCFET em comparação com o dispositivo de controle, até a tensão limite. A Figura 8b mostra o I DS - V DS curvas do NEI NCFET e do MOSFET de controle. NCFET exibe o fenômeno NDR para o baixo V GS . O efeito NDR corresponde às características melhoradas de redução da barreira induzida por dreno (DIBL) no NCFET em comparação com o MOSFET de controle, conforme mostrado na Fig. 8a. Em ∣ V GS - V TH ∣ =∣ V DS ∣ =1,0 V, 16% I DS o aprimoramento é obtido no NCFET em comparação com o dispositivo de controle. O NCFET com NEI de 2,1 nm tem o NDR menos significativo comparado ao transistor com NEI de 3,6 nm, o que é consistente com a conclusão em [20].
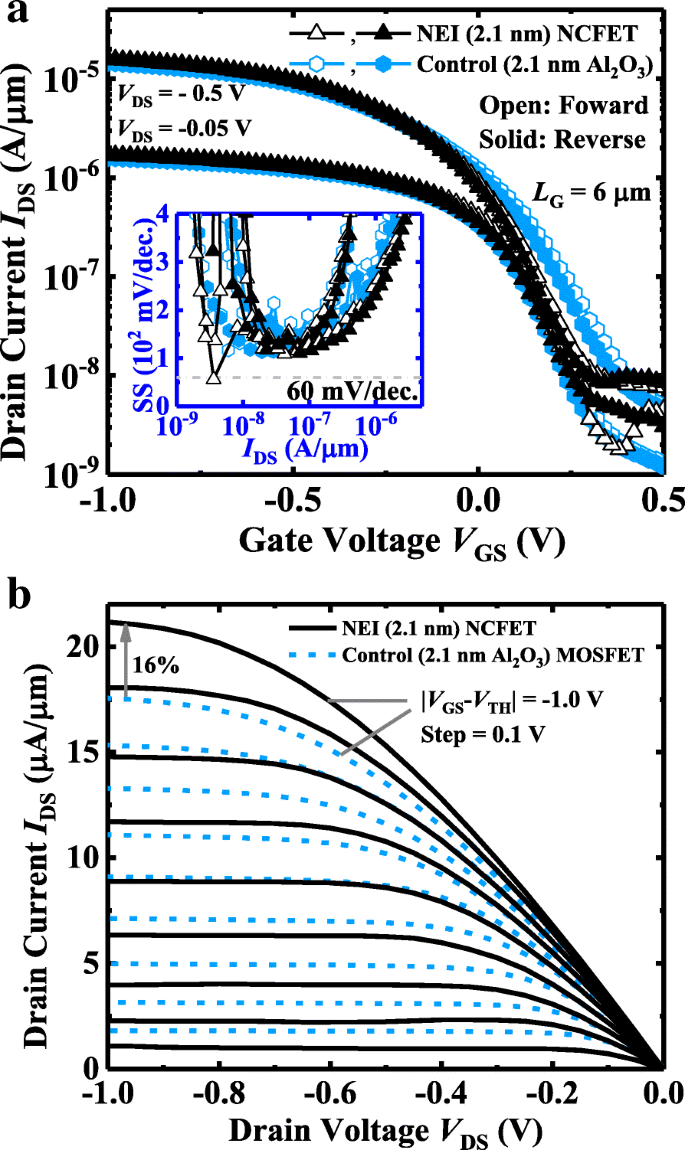
a eu DS - V GS curvas de um NEI NCFET e controle MOSFET com Al puro 2 O 3 dielétrico. Ambos os dispositivos possuem isolador de porta de 2,1 nm. A inserção mostra que o NCFET tem SS mais íngreme do que o dispositivo de controle até a tensão limite. b Medido I DS - V DS curvas para NCFET e controle MOSFET. NDR é observado para NCFET em V muito baixo GS . Em ∣ V GS - V TH ∣ =∣ V DS ∣ =1,0 V, NCFET atinge 16% I DS melhoria em comparação com o dispositivo de controle
A dependência da temperatura do NCFET com NEI de 3,6 nm de espessura é investigada aqui. A Figura 9a mostra I DS - V GS curvas medidas a 10 ° C e 30 ° C. A inserção indica que o desempenho SS do transistor não se degrada em temperaturas elevadas. Conforme a temperatura aumenta, o I - V curva muda para V mais negativo GS devido ao efeito dominante da ferroeletricidade, que é o oposto da tendência de um MOSFET convencional. A Figura 9b resume as mudanças na tensão de histerese e na tensão de limite de chaveamento direto com a temperatura. Avançar V GS muda para valores mais negativos à medida que a temperatura aumenta, o que pode ser devido ao aumento E c do NEI.
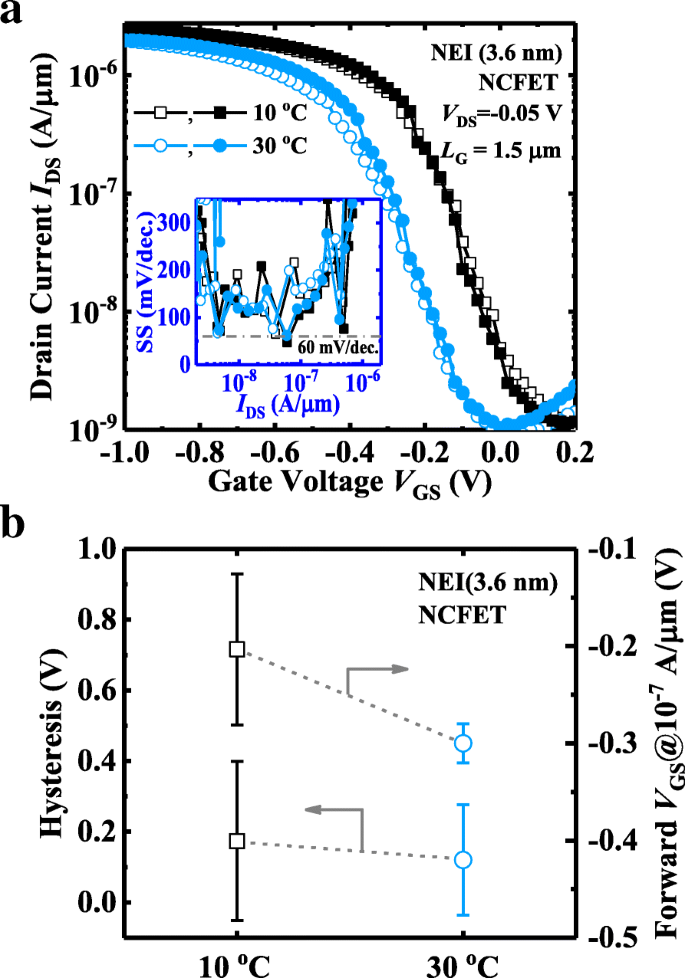
a eu DS - V GS de um NEI (3,6 nm) NCFET medido a 10 ° C e 30 ° C. As curvas mostram uma mudança em direção a voltagem mais negativa com o aumento da temperatura, como esperado. A inserção mostra o ponto íngreme SS. b Gráficos estatísticos de histerese (esquerda) e para a frente V GS @ 10 −7 A / μm (direita) para NCFETs com camada NEI de 3,6 nm. Avançar V GS muda na direção negativa com o aumento da temperatura
NEI FeFET para aplicativo de memória não volátil
Aumentando o alcance de V GS varredura, a voltagem de histerese de um NEI FeFET pode ser aumentada para atingir uma janela de memória grande e estável (MW) para operações de leitura e gravação. Como mostrado na Fig. 10, um FeFET com NEI de 3,6 nm demonstra que o MW aumenta de 0,2 para 1,14 V como V GS a faixa de varredura varia de (0,1 V, - 0,1 V) a (1 V, - 2 V). A resistência de varredura DC de outro dispositivo de memória FeFET é mostrada na Fig. 11a, a Fig. 11b ilustra as características de histerese como uma função do número de ciclos de varredura DC. Estável I-V janela de histerese de ~ 0,65 V é vista.
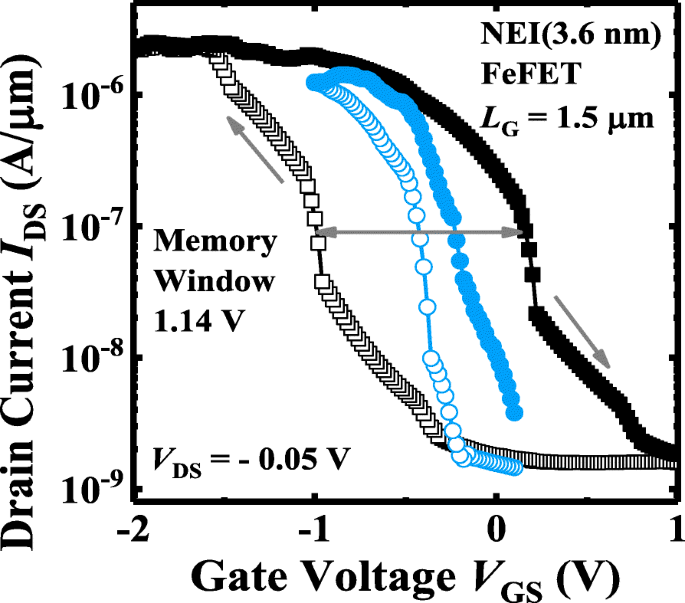
Para um grande V GS Faixa de varredura DC, um MW de 1,14 V é observado para o FeFET NEI (3,6 nm)
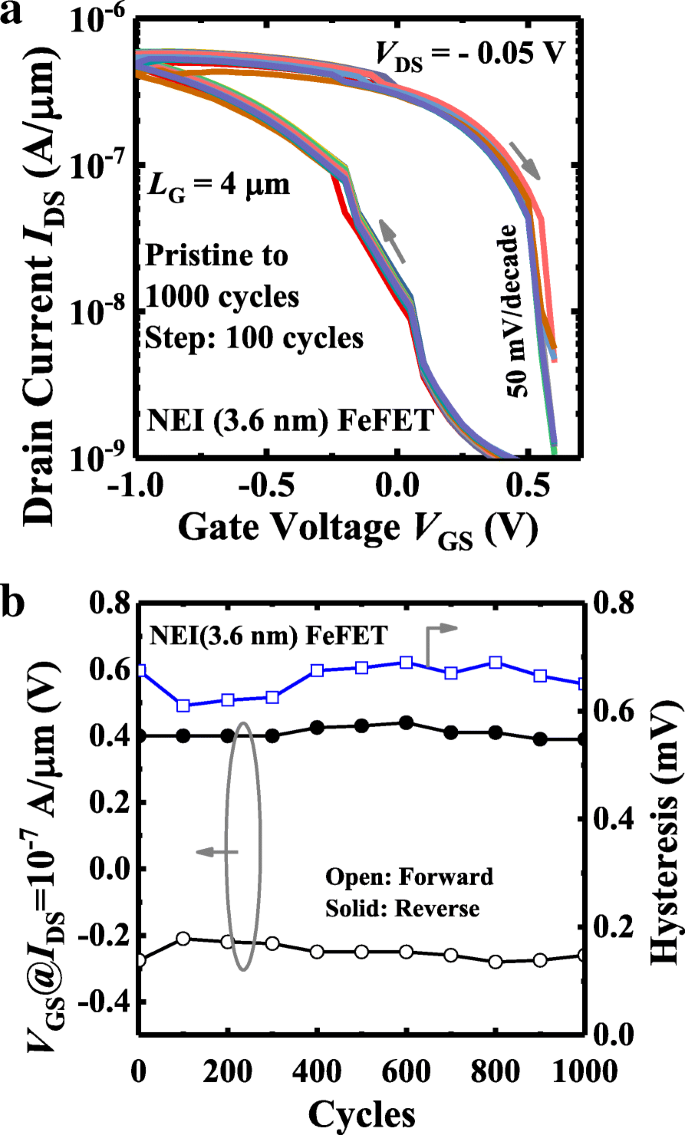
a Medido I DS - V GS curvas para NEI (3,6 nm) FeFET, através de 1000 ciclos de varredura DC. b As medições de resistência de varredura DC mostram que o NEI FeFET tem um MW estável por 1000 ciclos
A Figura 12 compara o dispositivo de memória NEI FeFET com FeFETs relatados, no que diz respeito à espessura da camada MW e FE [8, 21–24]. Deve-se notar que o dispositivo NEI FeFET neste trabalho atinge um MW considerável (> 1 V) com a espessura FE relatada mais fina de 3,6 nm. Especulamos que é mais fácil alcançar a fase FE estável em NEI com uma espessura menor, em comparação com o HfO dopado 2 [28,29,30].
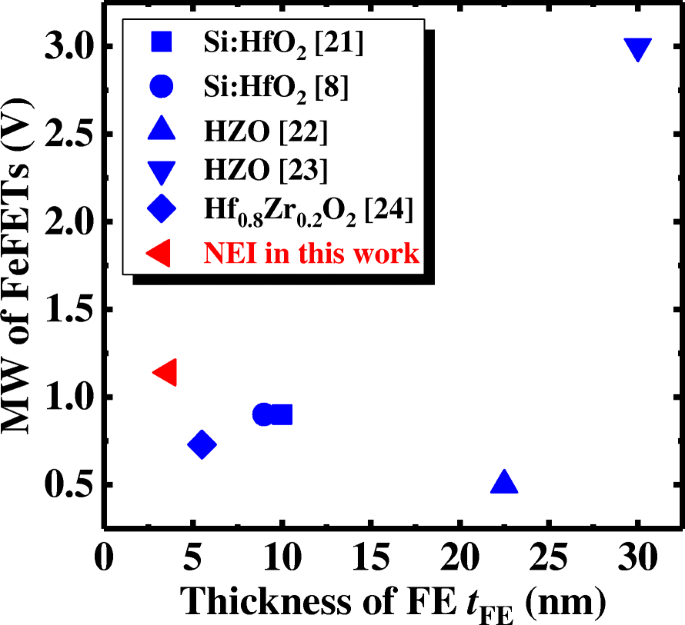
Comparação do dispositivo de memória NEI FeFET contra FeFETs relatados, com relação a MW e t FE . O FE mais fino é obtido pelo dispositivo de memória NEI FeFET
Finalmente, as vantagens do NEI FeFET fornecido pelo ZrO 2 nanocristais embutidos em isolador de porta amorfa são discutidos. A Figura 13 compara a camada NEI com HfO dopado relatado 2 filmes [2, 3, 21, 25-27], no que diz respeito a E c e P r . NEI pode alcançar um P muito mais baixo r em comparação com HfO dopado 2 para semelhante E c . Nossos experimentos demonstraram que um P r abaixo de 1 μC / cm 2 pode fornecer o MW necessário nos FeFETs. A polarização excessiva pode levar a uma maior despolarização, resultando em piores características de retenção, o que foi relatado em [25]. Além disso, as propriedades FE e DE da camada NEI podem ser ajustadas separadamente: P r é aumentado / reduzido aumentando / diminuindo o volume de nanocristais de FE, e κ é aumentado incorporando outros elementos na matriz amorfa (por exemplo, . , LaAlO 3 ), para otimizar o desempenho do FeFET.

Comparação de camadas NEI contra HfO dopado relatado 2 filmes, no que diz respeito a E c e P r . NEI atinge P muito mais baixo r em comparação com HfO dopado 2 mantendo E semelhante c. [2, 3, 21, 25,26,27]
Conclusões
Novos FeFETs com ZrO 2 nanocristais incorporados em um Al amorfo 2 O 3 camada isolante de porta são relatados. As análises físicas indicam que menos de 0,5% Zr em Al 2 O 3 produz ferroeletricidade suficiente para aplicações NCFET e NVM. O efeito NC estável é observado em diferentes temperaturas de medição. É demonstrada a operação de memória FeFET estável com isolador de porta fino (espessura total de 3,6 nm). MW estável é alcançado em 1000 ciclos de resistência DC. O projeto NEI FeFET proposto fornece um caminho para reduzir a espessura da camada isolante da porta FE / DE para ser compatível com FinFETs com passos de aleta muito pequenos.
Abreviações
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposição de camada atômica
- BF 2 + :
-
Íon fluoreto de boro
- DC:
-
Corrente direta
- Ec:
-
Campo coercitivo
- FeFET:
-
Transistor de efeito de campo ferroelétrico
- Ge:
-
Germânio
- GeO x :
-
Óxido de germânio
- HF:
-
Acido hidrosulfurico
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- I DS :
-
Corrente de drenagem
- MOSFETs:
-
Transistores de efeito de campo semicondutores de óxido metálico
- MW:
-
Janela de memória
- NC:
-
Capacitância negativa
- NDR:
-
Resistência diferencial negativa
- NEI:
-
Isolador embutido em nanocristal
- Ni:
-
Níquel
- Pr:
-
Polarização remanescente
- RTA:
-
Recozimento térmico rápido
- SS:
-
Balanço de sublimiar
- TaN:
-
Nitreto de tântalo
- V GS :
-
Tensão do portão
- V TH :
-
Tensão de limiar
- ZrO 2 :
-
Dióxido de zircônio
Nanomateriais
- Sensores e processadores convergem para aplicações industriais
- Nanopartículas multifuncionais de ouro para aplicações diagnósticas e terapêuticas aprimoradas:uma revisão
- Avanços e desafios dos nanomateriais fluorescentes para aplicações biomédicas e de síntese
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Compostos de grafeno e polímero para aplicações de supercapacitor:uma revisão
- Avaliação de estruturas de grafeno / WO3 e grafeno / CeO x como eletrodos para aplicações de supercapacitor
- Funções duplas do dispositivo V / SiOx / AlOy / p ++ Si como seletor e memória
- Acionamentos para aplicações de refrigeração industrial e refrigeração industrial
- Tornos giratórios para aplicações de mandrilamento e torneamento
- Metais especiais para aplicações de dispositivos médicos



