Comutação analógica e comportamento sináptico artificial de Ag / SiOx:Ag / TiOx / p ++ - Dispositivo Memristor Si
Resumo
Neste estudo, inserindo uma camada de buffer de TiO x entre o SiO x :Camada Ag e o eletrodo inferior, desenvolvemos um dispositivo de memristor com uma estrutura simples de Ag / SiO x :Ag / TiO x / p ++ -Si por um processo de deposição física de vapor, no qual o crescimento e a ruptura do filamento podem ser controlados de forma eficiente durante a comutação analógica. As características sinápticas do dispositivo de memristor com uma ampla faixa de mudança de resistência para modulação de peso por meio da implementação de trens de pulsos positivos ou negativos foram investigadas extensivamente. Várias funções de aprendizagem e memória foram alcançadas simultaneamente, incluindo potenciação / depressão, facilitação de pulso pareado (PPF), plasticidade de curto prazo (STP) e transição de STP para LTP (plasticidade de longo prazo) controlada por pulsos repetidos mais do que uma operação de ensaio e também a plasticidade dependente do tempo de pico (STDP). Com base na análise das características I-V logarítmicas, verificou-se que a evolução / dissolução controlada de filamentos Ag condutores através das camadas dielétricas pode melhorar o desempenho do dispositivo de memristor de teste.
Introdução
Em 2008, o conceito teórico de memristor do Prof. Chua [1] tornou-se realidade quando Strukov et al. publicaram seus estudos sobre a relação entre fluxo magnético e carga em um TiO 2 pela primeira vez, com base em dois terminais compactos [2], o que despertou o interesse de pesquisadores em todo o mundo. Além de várias aplicações potenciais que vão desde operações lógicas e sistemas de radiofrequência reconfiguráveis até aplicações de memória não volátil [2,3,4], os memristores também foram investigados para emular as funções bio-sinápticas por causa de sua estrutura semelhante e dinâmica de trabalho. Hoje em dia, é amplamente aceito que a emulação direta de funções sinápticas em um dispositivo eletrônico é crucial para o desenvolvimento de sistemas de computação neuromórficos inspirados no cérebro [5,6,7]. No entanto, as sinapses eletrônicas tradicionalmente projetadas são baseadas em tecnologias de semicondutor de óxido metálico complementar (CMOS), que estão sofrendo o efeito de gargalo de von Neumann em termos do complicado processo de execução de computação, os limites da densidade de integração e dissipação de energia. Portanto, o uso de um dispositivo de dois terminais ajustável infundiu muitas oportunidades promissoras para desenvolver novas estruturas para sinapses eletrônicas, que são resultado das propriedades exclusivas de memristores com característica não volátil, tamanho em nanoescala, baixo consumo de energia, resposta mais rápida, etc. . [8, 9].
Recentemente, vários materiais (por exemplo, óxidos de metal como ZnO 2 , WO x , SnO x [10, 11], calcogenetos como Cu 2 S, Ag 2 S [12, 13], e materiais ferroelétricos como La 2 O 3 , Pb 0.8 Ba 0.2 ZrO 3 [14, 15]) foram investigados para a concepção e fabricação de dispositivos de memristor. Para muitos dispositivos, a mudança na resistência é atribuída à migração induzida pelo campo de vacâncias de oxigênio ou íons metálicos (por exemplo, Ag + , Cu 2+ e Al 3+ ) e a formação de um caminho altamente condutor. O caminho condutor em memristores é geralmente chamado de "filamento condutor (CF)", que pode ser quebrado posteriormente durante uma operação de comutação. Em geral, dois tipos de comportamentos de comutação foram observados em memristores, ou seja, abrupta (comutação digital) e gradual (comutação analógica). A mudança abrupta na resistência é consistente com o sinal digital (0 ou 1), o que é benéfico para o armazenamento de informações [16, 17].
Em contraste com a comutação digital, a sintonia de condutância contínua em memristores tem algumas semelhanças com uma sinapse biológica, que é a unidade celular básica para as funções de aprendizagem e memória no cérebro humano [18]. Em vários dispositivos de memristor, as mudanças de condutância analógica usadas para emular a modulação de peso das sinapses biológicas foram realizadas [19, 20]. Ag difusivo em a-Si e memristores à base de óxido com Pt / a-Si:Ag / Pt e Pt / SiO x N y :Estruturas Ag / Pt imitaram com sucesso o Ca 2+ ou Na + dinâmica em bio-sinapses [21, 22]. Da mesma forma, filamentos de íons de oxigênio / vacâncias em memristores à base de óxido metálico também foram propostos para realizar funções sinápticas, incluindo potenciação de curto prazo (STP) e facilitação de pulso pareado (PPF) [23, 24]. No entanto, as regras de aprendizagem biológica são diversas e, até agora, nem todas as funções sinápticas estiveram envolvidas nos modelos de memristor [16].
Além da seleção de materiais, o controle do crescimento e ruptura do filamento através da inserção de uma camada dielétrica adicional na estrutura "metal / camada memristiva / metal" oferece certas vantagens para emular funções sinápticas, incluindo STP e LTP, bem como baixo consumo de energia. Recentemente, a fim de controlar a taxa de formação / ruptura do filamento condutor, Wang et al. [25] demonstraram o comportamento de comutação analógica inserindo um SiO 2 camada em um TaO x com base em memristor. Wan et al. [26] também realizaram a comutação analógica e funções STP e STDP emuladas inserindo uma camada de óxido de grafeno reduzida na estrutura de Ag / SrTiO 3 / FTO memristor para controlar o crescimento excessivo de Ag-filamento. Além disso, foi relatado [27, 28] que com base no conhecimento do TiO x material com alta constante dielétrica (~ 40) e baixo bandgap (~ 3 eV), o desempenho do dispositivo de memristor em termos de durabilidade e uniformidade do ciclo foi aprimorado notavelmente pela inserção de um TiO 2 camada fina com o HfO 2 camada memristiva. Além disso, foi relatado [24] que, devido à baixa mobilidade iônica e baixa taxa de reação redox, o TiO x o filme fino também pode atuar como uma camada tampão para evitar o crescimento excessivo do filamento condutor, permitindo um melhor comportamento sináptico e mantendo um bom contato do filamento condutor durante os processos de chaveamento resistivo.
Neste artigo, relatamos uma nova estrutura de Ag / SiO x :Ag / TiO x / p ++ -Dispositivos de memristor Si e seus comportamentos de comutação analógica. Comparado com um dispositivo de camada única relatado anteriormente [22, 29], descobriu-se que a inserção de um TiO x camada, como mostrado na estrutura acima, afeta o comportamento de comutação do dispositivo de memristor em termos de aumentar a janela de condutância e manter um estado estável durante os processos de comutação. Além disso, a condutância do dispositivo de memristor pode ser facilmente ajustada em trens de pulso positivo e negativo, respectivamente. Nossos resultados recentes demonstram que obtivemos com sucesso uma comutação analógica confiável e funções bio-sinápticas devidamente emuladas, como plasticidade de curto e longo prazo (STP e LTP), função de facilitação de pulso pareado (PPF), plasticidade dependente do tempo de pico ( STDP), bem como transição de STP para LTP em Ag / SiO x :Ag / TiO x / p ++ Dispositivo -Si memristor.
Métodos
- i.
Fabricação do dispositivo:conforme mostrado na Fig. 1a, nosso memristor foi projetado como Ag / SiO x :Ag / TiO x / p ++ -Estrutura Si. O p ++ -Si substratos (15 × 15 mm 2 ) com uma resistividade de cerca de 0,01 Ω cm foram limpos por um método padrão e, em seguida, os dispositivos foram fabricados neles. Todos os processos a seguir foram realizados à temperatura ambiente em um sistema de alto vácuo. Primeiro, uma camada de óxido de titânio de ~ 10 nm de espessura foi depositada em p ++ -Si substratos por pulverização catódica RF magnetron usando um TiO de cerâmica de alta pureza 2 alvo. Então, um SiO de ~ 95 nm de espessura x :Camada de Ag foi depositada por co-sputtering RF usando um SiO 2 alvo com pequenas fatias de Ag colocadas no caminho de pulverização magnética. Durante o processo de deposição, a taxa de fluxo de Ar e a pressão foram mantidas em 50 sccm e 20 mTorr, respectivamente, enquanto a potência de RF foi mantida em 80 W. Finalmente, o eletrodo superior (TE) da camada de Ag de ~ 30 nm de espessura foi padronizado através de uma técnica de fotolitografia e lift-off em que as finas camadas de metal foram depositadas usando magnetron DC sputtering. O diâmetro do eletrodo individual é de cerca de 150 μm.
- ii.
Métodos de caracterização:medições de microscopia eletrônica de transmissão (TEM) e análises de espectroscopia de fotoelétrons de raios-X (XPS) foram realizadas para analisar a microestrutura de SiO x :Ag e TiO x camadas e o estado químico dos átomos de Ag, respectivamente, em que a amostra TEM foi feita primeiro usando feixe de íons focado (FIB, FEI Nova Nano Lab 200) e depois observada sob um sistema FEI Phillips CM10-Supra TEM. As caracterizações elétricas foram realizadas com um analisador de semicondutor (Keithley 2636B) acoplado a uma estação de sonda. Durante a medição elétrica, as polarizações positivas e negativas foram definidas pela corrente que flui entre o eletrodo superior e o inferior. Todas as medições elétricas foram realizadas à temperatura ambiente do ar.

Esquema do Ag / SiO x :Ag / TiO x / p ++ -Dispositivo de memristor Si e sua análise TEM transversal. a Ilustração esquemática do dispositivo e analogia entre a sinapse biológica e a sinapse eletrônica. b Vista transversal do TEM de uma única unidade de memristor de Ag / SiO x :Ag / TiO x / p ++ -Estrutura Si. O SiO x :Ag e TiO x filmes finos imprensados entre Ag TE e p ++ Eletrodos -Si BE. c O mapeamento elementar da seção transversal do dispositivo
Resultados e discussão
Um esquema do dispositivo e da configuração de medição é descrito na Fig. 1a. O dispositivo tem uma estrutura simples que consiste em SiO x :Ag e TiO x camadas finas imprensadas entre um Ag TE e um p ++ -Si BE que é confirmado pelo TEM transversal da célula de memristor e mapeamento elementar mostrado na Fig. 1b e c. O estado químico dos átomos de Ag na superfície de SiO x é analisado pelo XPS, conforme mostrado no Arquivo Adicional 1:Figura S1. O espectro Ag3d para Ag é deconvoluído em um único dupleto com energias de ligação de 368,0 eV para Ag3d 5/2 e 374,0 eV para Ag3d 3/2 , que são precisamente atribuídos ao estado metálico Ag. A imagem HRTEM no arquivo adicional 1:a Figura S2 mostra uma seção transversal do TiO amorfo x camada, enquanto os pequenos nanoclusters de Ag são visíveis em SiO x :Camada de Ag, que é provavelmente causada pela difusão externa de Ag durante o processo de preparação da amostra TEM para minimizar a energia interfacial total do sistema de material [22]. Além disso, a transformada rápida de Fourier (FFT) confirma que os nanoclusters de Ag embutidos em SiO x têm estrutura policristalina, como os nanocristais de Ag (111) e Ag (002). No Ag / SiO x :Ag / TiO x / p ++ -Dispositivo memristor Si, o Ag / SiO x :Ag e o TiO x / p ++ -Si como a membrana pré-sináptica e a membrana pós-sináptica, respectivamente, conforme ilustrado na Fig. 1a. O peso sináptico muda com a liberação de Ca 2+ ou Na 2+ íons em uma lacuna entre as membranas pré e pós-sináptica chamada “fenda” pela membrana pré-sináptica quando os pulsos neurais são recebidos. Da mesma forma, a condutância do Ag / SiO x :Ag / TiO x / p ++ -Dispositivo de memristor Si pode ser modulado artificialmente como uma sinapse eletrônica por meio da migração de íons Ag sob os impulsos de tensão.
A Figura 2a mostra a curva de corrente-tensão (I-V) do Ag / SiO x :Ag / TiO x / p ++ -Dispositivo de memristor Si na escala semilogarítmica. Sob a polarização de varredura de 0 V → +4,0 V → −4,0 V → 0 V, a curva I-V medida mostra um loop de histerese comprimido, que é uma impressão digital de um memristor. Quando uma polarização positiva é aplicada ao Ag TE, um aumento gradual na corrente até o limite de corrente de conformidade (I cc ) ocorre, e o estado de resistência do dispositivo é alterado de um estado de alta resistência (HRS) para um estado de baixa resistência (LRS), que é chamado de processo “SET”. Ao passo que, quando uma polarização negativa é aplicada ao Ag TE, ocorre uma diminuição na corrente e o estado de resistência é retornado ao HRS do LRS, o que é chamado de processo de “RESET”. Isso indica que a condutividade do dispositivo pode ser modulada correspondentemente com uma polarização de varredura positiva ou negativa, mostrando um comportamento de chaveamento resistivo bipolar. Em vez de um aumento ou diminuição abrupta da corrente durante os processos de AJUSTE e RESET em um regime de alta tensão, muito interessante, a corrente do dispositivo aumenta ou diminui consecutivamente sob a varredura de tensão repetida de 0 V → +2,1 V ou 0 V → -2,1 V, como mostrado na Fig. 2b. A relação de corrente e tensão versus tempo (I-V-t) também é plotada na inserção da Fig. 2b para mostrar as mudanças na condutância mais claramente. Como em uma biosinapse, uma resposta óbvia do dispositivo da evolução down-up ou up-down da corrente é observada após a implementação de partes consecutivas positivas (1ª-5ª) e negativas (6ª-10ª) das curvas I-V, respectivamente. O aumento (ou diminuição) contínuo na corrente durante as varreduras de tensão positiva (ou negativa) indica que a resistência do dispositivo pode ser modulada pelo modo de varredura DC. Também é observado que durante cada varredura positiva ou negativa subsequente, a curva I – V pega onde a última é interrompida, mostrando um recurso de comutação analógico típico para um dispositivo de memristor. O desempenho de resistência do dispositivo de memristor pode ser avaliado pela implementação de uma tensão de varredura bipolar mais ampla em uma tensão de leitura de +0,3 V, como na Fig. 2c, mostrando que o dispositivo pode ser operado de forma estável e uniforme entre LRS e HRS durante o set / reset operação acima de 10 3 ciclos.

Características I – V do Ag / SiO x :Ag / TiO x / p ++ Dispositivo -Si memristor. a Comportamento de comutação bipolar b Potenciação ou depressão pela repetição de varreduras de voltagem. A inserção mostra a relação tensão e corrente versus tempo (V-I-t), demonstrando o estado de condutância durante a potenciação ou depressão. c Teste de desempenho de ciclagem de resistência em uma tensão de leitura de -0,3 V por 10 3 ciclos de uma faixa mais ampla de varreduras bipolares de 0 a +4,0 V para configuração e 0 a -4,0 V para reinicialização. d Propriedades repetidas de modulação de condutância
O dispositivo de memristor também pode ser operado sob os sinais de pulso em vez de tensão de varredura de polarização CC. A Figura 2d mostra a resposta do dispositivo na forma de potenciação ou depressão após a implementação de pulsos repetitivos de potencialização (polarização positiva) e depressores (polarização negativa). As amplitudes dos pulsos de potencialização e depressão são +1,2 V e -1,2 V, respectivamente, e todas as larguras e intervalos de pulsos são fixados em 5 ms. Aqui, a modulação da condutância no dispositivo é observada independentemente do viés de pulso positivo ou negativo, que é semelhante à resposta sináptica na forma de potenciação ou depressão sob o estímulo potenciador e depressivo, respectivamente. Obviamente, descobriu-se que a resposta do dispositivo pode ser ajustada de ciclo a ciclo dependendo do número de pulsos de estimulação, indicando que uma potenciação e depressão estável e uniforme além da polaridade de polarização aplicada pode ser usada para emular o ajuste de peso e memória realce em uma sinapse eletrônica [30].
Para a compreensão do comportamento de chaveamento, os mecanismos de condução são analisados pelo ajuste das características I-V. Para este propósito, um SiO autônomo x :Memristor baseado em filme fino de Ag com a estrutura de Ag / SiO x :Ag / p ++ -Si também é fabricado. Conforme mostrado na Fig. 3a, a resposta do dispositivo às varreduras de tensão quase CC indica um comportamento típico de chaveamento de limite, conforme relatado anteriormente [29, 31]. As direções das setas mostram que o dispositivo pode ser alternado entre os dois estados como memória volátil. No entanto, a curva I-V de Ag / SiO x :Ag / TiO x / p ++ -Dispositivo de memristor Si mostra que a situação é bastante diferente do SiO autônomo x :Dispositivo de memristor baseado em Ag. A Figura 3b mostra que o dispositivo exibe comportamentos de comutação bipolar no aspecto do LRS e do HRS sob a parte positiva e negativa da curva I-V, enquanto as tensões de operação são relativamente mais altas. A Figura 3c demonstra a curva I-V de Ag / SiO x :Ag / TiO x / p ++ - Dispositivo de memristor Si, que é ajustado como Ln (I) versus Ln (V) de dados da região positiva para HRS e LRS. Esses resultados de ajuste mostram que o comportamento de transporte de carga em HRS é consistente com um mecanismo de condução limitada de carga espacial controlado por armadilha clássico (SCLC), que consiste em três porções como a região ôhmica (I / V), a região da lei de Child (I / V 2 ), e a região de aumento de corrente íngreme [32]. Considerando que, o comportamento linear no LRS, onde a inclinação é =1, indica um excelente comportamento ôhmico, conforme mostrado na Fig. 3c. Os diferentes comportamentos de condução em HRS e LHR são evidenciados pela formação de filamento Ag condutivo em LRS [32]. A Figura 3d sustenta ainda que a comutação resistiva é causada pela formação / ruptura do filamento condutor. Pode ser visto que enquanto o LRS do dispositivo é independente do tamanho da célula do dispositivo, o HRS do dispositivo é proporcional ao tamanho da célula. Esta propriedade independente de tamanho no LRS foi geralmente observada em dispositivos de memória condutores baseados em filamentos [33]. Portanto, pode-se concluir que o fenômeno de comutação resistiva em Ag / SiO x :Ag / TiO x / p ++ -Dispositivo de memristor Si normalmente se origina da formação / ruptura controlada de filamento condutor sob a tensão de polarização positiva / negativa. As mudanças graduais na condutância podem resultar da variação da lacuna transversal entre TE e BE sob o campo elétrico semelhante a outros relatórios [34]. Assim, a resistência total do dispositivo pode ser descrita como R =Rij =V / I de acordo com o circuito equivalente, onde Rij é definido como a resistência relacionada ao tamanho do gap lateral de CF entre TE e BE. Portanto, se esta lacuna pode ser ajustada através da modulação do tamanho Ag CF entre TE e BE usando uma polarização adequadamente programada, então a condução ou a resistência do dispositivo memristivo pode ser ajustada gradualmente.

Análise do mecanismo de condução de Ag / SiO x :Ag / p ++ -Si e Ag / SiO x :Ag / TiO x / p ++ Dispositivos -Si. a A curva linear I – V de Ag / SiO x :Ag / p ++ -Si e b Ag / SiO x :Ag / TiO x / p ++ Dispositivo -Si. c Os mecanismos de condução correspondem a SCLC em HRS e Ohmic em LRS para o Ag / SiO x :Ag / TiO x / p ++ -Dispositivo Si de acordo com os resultados de ajuste da região positiva da curva I – V em ( b ) d Dependência da área celular da condutância no LRS ou no HRS
Um modelo físico correspondente também é apresentado na Fig. 4 para interpretar o mecanismo de comutação em SiO autônomo x :Ag e SiO x :Ag / TiO x com base em dispositivos de memristor. O comportamento das nanopartículas de Ag em SiO x As células baseadas em células podem ser interpretadas com base em reações eletroquímicas (migração e acúmulo de íons de Ag e átomos de Ag) entre os eletrodos bipolares, semelhante ao relatado anteriormente [22, 35]. Quando a tensão de varredura é aplicada, as nanopartículas de Ag crescem ainda mais para preencher a lacuna entre os eletrodos, resultando em um aumento abrupto de corrente até o nível de conformidade, e o memristor é ligado em LRS (como mostrado no painel do meio da Fig. 4a). Após a remoção da polarização elétrica, os nanoclusters alongados de Ag que formaram a ponte no início são contraídos agora rapidamente [22], e o dispositivo retorna para HRS (como mostrado no último painel da Fig. 3a) [35], indicando uma comutação de limiar bipolar comportamento em um memristor que pode ser alternado entre os dois estados como em dispositivos de memória volátil.
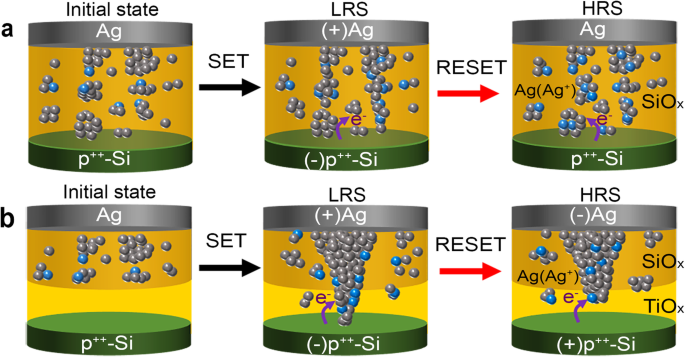
Diagrama esquemático do modelo físico para o comportamento de comutação. a Ag / SiO x :Ag / p ++ -Dispositivo de memristor Si; b Ag / SiO x :Ag / TiO x / p ++ - Dispositivo de memristor Si
A situação é bem diferente no caso de SiO x :Ag / TiO x com base em dispositivo memristor, onde o SiO x camada fina tem um intervalo de banda alto (~ 9 eV) e uma constante dielétrica inferior (~ 3), mas o TiO x camada tem um intervalo de banda baixo (~ 3 eV) e uma constante dielétrica alta (~ 40), o que torna o campo elétrico através de SiO x camada mais alta que a do TiO x camada, dissolvendo mais átomos de Ag na camada de comutação [28]. É a baixa mobilidade iônica e a baixa taxa de reação redox do óxido de titânio que controla a migração e o acúmulo de átomos de Ag e íons de Ag através da camada interfacial [36]. Esses dois fatos, conforme mencionado acima, podem causar a formação de filamentos em forma de nano-cone de TE a BE [37]. A região metálica concentrada na forma de confinamento efetivo do crescimento do filamento na forma de nano-cone de TE a BE pode oferecer controle dos estados de resistência durante a operação cíclica [38]. Quando o eletrodo Ag superior é suficientemente polarizado positivamente através das camadas duplas, o campo elétrico através das camadas dielétricas é suficiente para conduzir os íons Ag do Ag TE para p ++ -Si BE através da camada interfacial, levando a diminuir o gap efetivo entre os eletrodos (como mostrado no painel do meio da Fig. 4b). Os filamentos de Ag não são dissolvidos a menos que uma voltagem negativa seja aplicada e tende a manter sua forma original, mesmo que a voltagem de polarização seja removida. Quando uma tensão negativa é aplicada, um RESET normal começa, e Ag CFs são parcialmente desolados (geralmente no local mais fino) devido ao processo eletroquímico termicamente assistido [39]. O dispositivo de memristor é DESLIGADO e volta ao HRS (último painel da Fig. 4b), e então alternado reversivelmente entre dois estados (mostrado na Fig. 3b) como um dispositivo de memória não volátil. O painel esquerdo da Fig. 4b apresenta que os filamentos formados aqui devem ser mais grossos do que aqueles no painel do meio da Fig. 4a, que não podem ser dissolvidos e rompidos a menos que uma voltagem negativa seja aplicada. A parte do filamento no SiO x camada ainda é muito mais fina do que a parte do nano-cone no TiO x camada, e a forma de todo o filamento é de alguma forma como um nano-cone. Assim, quando uma polarização negativa é aplicada, o filamento se rompe rapidamente quando a voltagem negativa é aplicada (Fig. 3b), enquanto a voltagem aumentará ainda mais e a corrente será novamente aumentada, indicando um risco de SET negativo em polarização alta intervalo devido aos átomos de Ag residuais existentes perto da superfície de BE.
Na verdade, a resistência total do memristor no HRS está apenas relacionada à lacuna entre a ponta do nano-cone do filamento e o eletrodo inferior, que pode ser aumentada ou diminuída ajustando a polarização elétrica [33]. Essa tendência de alterar o HRS em memristores pode ser vista na Fig. 2b, na qual a corrente pode ser aumentada ou diminuída consecutivamente sob o viés de varredura repetido de 0 V a +2,1 V e de 0 V a -2,1 V, respectivamente. Por outro lado, a varredura constante de uma tensão abaixo de +2,1 V não é suficiente para formar um filamento condutor através do TE e BE. Em vez disso, o filamento condutor de Ag pode acumular gradualmente átomos de Ag, levando a uma diminuição na lacuna efetiva entre os eletrodos, conforme mostrado no Arquivo adicional 1:Figura S3. Portanto, usando a polarização de programação adequada, a transição da comutação de limiar típica para a comutação gradual pode ser realizada e a resistência total da célula de memória pode ser ajustada ajustando a lacuna efetiva entre os eletrodos, conforme pode ser observada em uma sinapse biológica.
Semelhante a uma bio-sinapse, estímulos de entrada com programação de pulso adequada podem alterar os estados de condutância do dispositivo de memristor para realizar várias tarefas neurais. PPF é outro tipo de recurso crucial, que pode ajustar a condutância por soma temporal de estímulos de entrada e realizar várias tarefas neurais de curto prazo, incluindo filtragem sináptica e adaptação [40, 41]. A função PPF em uma biosinapse funciona da seguinte maneira:a segunda resposta pós-sináptica torna-se maior do que a primeira durante dois estímulos de spikes sucessivos, deixando o tempo de intervalo dos spikes menor que o tempo de recuperação [22]. A Figura 5a mostra a resposta do dispositivo, que é monitorada após a implementação de um par de pulsos de facilitação em amplitude +2,0 V com largura e intervalo fixos denominados como uma escala de 0,08 s. Um aumento perceptível na corrente como uma resposta do segundo pulso do que o primeiro é observado, indicando uma mudança aparente do estado de condutância após a implementação da programação de pulso adequada. Durante o intervalo entre dois pulsos subsequentes, uma queda de corrente é observada, o que pode ser atribuído à existência de caráter volátil no dispositivo. A queda na condutância pode corresponder à difusão dos átomos de Ag após a remoção do pulso de potencialização [42]. A função PPF bem-sucedida só pode ser executada quando o intervalo de tempo entre dois pulsos consecutivos é menor que o tempo de relaxamento de difusão dos átomos de Ag, causando mais átomos de Ag empurrados no SiO x :Ag / TiO x camada. Além disso, um estado de saturação é alcançado quando o dispositivo é continuamente estimulado com uma série de pulsos de facilitação com amplitude +2,0 V e uma largura e intervalo fixos denominados como uma escala de 0,08 s, conforme mostrado na Fig. 5b. Os resultados mostram que quando pulsos de alta frequência são aplicados, o que bombeia mais átomos de Ag no SiO x camada até que uma ponte condutora seja formada através do TE e BE, atingindo um nível de saturação [22]. Este fenômeno é bastante semelhante à regra de aprendizagem de Hebbian, onde as mudanças de peso sináptico devem ter um valor saturado para evitar excitabilidade excessiva dos neurônios com os picos não corados do trem de pulso aplicados [43].
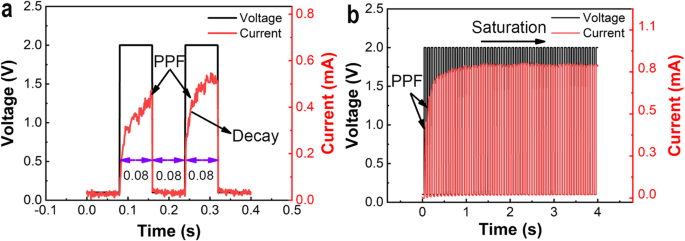
Resultados experimentais de facilitação de pulso pareado (PPF) . a Implementação de PPF em Ag / SiO x :Ag / TiO x / p ++ Dispositivo -Si usando altura de pulso de +2,0 V com 0,08 s. b Demonstração do movimento sináptico de peso de saturação usando trem de pulso de amplitude +2,0 V com a mesma largura e intervalo de 0,08 s
Além disso, da mesma forma que em uma sinapse biológica, um memristor sofrerá uma perda de memória com uma diminuição repentina na corrente após a implementação do pico de potencialização, o que pode ser atribuído como a existência de STP no memristor [44, 45]. Em neurobiologia, STP e LTP são comumente atribuídos como memória de curto prazo (STM) e memória de longo prazo (LTM) [46]. Foi estabelecido que a transição de STP para LTP pode ocorrer através da repetição de estímulos (ou seja, um processo de ensaio) [46, 47]. A fim de verificar e comparar este comportamento com aqueles observados em sinapses biológicas, uma sequência de pulsos de voltagem foi implementada em nosso Ag / SiO x :Ag / TiO x / p ++ Dispositivos -Si memristor. A Figura 6a mostra o aumento da corrente de um estado inicial de 0,05 mA para 1,8 mA após a implementação de 15 pulsos consecutivos (amplitude +1,4 V, largura e intervalo 5 ms). O decaimento normalizado atual ((I t -I o ) / I o × 100%) é medido na tensão de leitura +0,3 V imediatamente após a imposição de pulsos de potencialização com o tempo ( t ), como mostrado na Fig. 6b. A relação entre a queda normalizada da corrente e o tempo bem ajustada pela relação dada na Eq. (1) [48]:
$$ {\ Delta I} _t / {\ Delta I} _o \ times 100 \% =\ exp \ left [- {\ left (t / \ tau \ right)} ^ {\ beta} \ right] $$ ( 1)
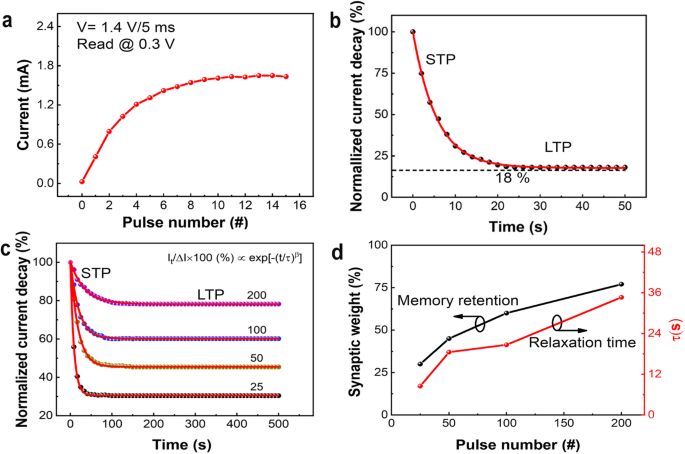
Decadência atual e retenção de memória em Ag / SiO x :Ag / TiO x / p ++ -Si memristor. a Aumento na corrente após a implementação de 15 pulsos idênticos de potencialização consecutivos. b A queda da corrente é monitorada em uma tensão de leitura de +0,3 V após a estimulação do dispositivo. c O decaimento de corrente normalizado versus tempo mostrando a transição de STP para LTP após a implementação de trens de pulso do número de estimulação. d A retenção de memória e o tempo de relaxamento ( τ ) para números de pulso
aqui, τ é chamado de tempo de relaxamento, e β é chamado de índice de alongamento (0 < β <1). Geralmente, esta relação é usada para descrever os processos de relaxamento em materiais desordenados com uma distribuição aleatória de energias. A curva mostra que a queda no peso sináptico é semelhante à "curva de esquecimento" da memória humana em psicologia [49], que apresenta uma queda rápida no início que poderia ser chamada de STP e então gradualmente atinge um nível estável que poderia ser chamado de LTP no dispositivo. No entanto, uma queda óbvia da corrente normalizada no dispositivo é observada em um intervalo de tempo muito curto ( t ) e então atinge um nível de saturação em um estado de baixa condutância (até 16% em 50 s). Nesta situação, sem qualquer outra mudança nos parâmetros de pulso, realizamos um outro processo de simulação com um número repetido de pulsos. A corrente é medida em uma tensão de leitura de +0,3 V imediatamente após a imposição de diferentes números de pulsos (ou seja, 25, 50, 100 e 200) do mesmo estado inicial para cada conjunto de trens de pulso. A Figura 6c mostra que a queda normalizada da corrente com o tempo em cada conjunto de medições é ajustada pela relação dada na Eq. (1). A Figura 6d mostra que por um aumento do número de estimulação, o tempo de relaxamento ( τ ) aumenta, indicando que o processo de esquecimento desvanece lentamente. Meanwhile, an obvious elevation of the current level is observed, implying a positive change in synaptic weight (conductance), as shown in Fig. 6d by the black line. These results presented in Fig. 6 provide clear evidence of the existence of STP and LTP in our device. A smaller number of stimulations can only induce STP in the device, with a slight rise in conductance at saturation level. Therefore, by increasing the number of repetitive stimulations, the rehearsal process not only rises a conductance level but also is achieved a long-lasting memory retention phenomenon, as shown in Fig. 6d by the red line.
The conventional digital-type memories require the non-volatility to store the information, while in bio-synapse, information processes and accordingly reconfigures the memory status. It can be seen in Fig. 6 that the transition from STP to LTP is realized, and the synaptic weight is adjusted accordingly, while the unimportant ones with small synaptic weight are temporarily stored and then diminished with time. This phenomenon is quite similar to the “multi-store model” presented by Atkinson and Shiffrin [50]. In this model, first input information is analyzed, then stored in different hierarchy levels, according to the importance of “synaptic weight” through the rehearsal process. Therefore, an increase in synaptic weight and resultant prolonged relaxation time (τ ) in our device as a function of stimulation numbers has best verified the rehearsal scheme.
Besides the pulse repetition process, the transition of the STP to the LTP phenomenon is further examined as a function of pulse strength. The device response is monitored after implementation of different pulse amplitudes, i.e., +1.2 V, +1.6 V, +2.0 V, and +2.8 V with similar width and interval scale of 3 ms, as shown in Fig. 7a. The current is monitored with a readout voltage of +0.3 V after imposing each pulse train consisting of 50 pulses. The fitted results with the stretched exponential relaxation model in Fig. 7a shows that the relaxation time is increased as a function of pulse strength (as shown in Fig. 7b red line). Meanwhile, as shown in Fig. 7b, an elevation of the synaptic weight of about 90% is observed at a larger τ of 43 s and +2.8 V amplitude, which is much higher than the synaptic weight of about 25% at a smaller τ of 10 s and +1.2 V amplitude (as shown in Fig. 7b black line), indicating the formation of LTP. Based on these results, it is easy to find that the formation and persistence of LTP in our device are highly dependent on both pulse numbers or pulse amplitude. These results coincide with the facts that the memory states, i.e., STM and LTM, and their stabilities in bio-synapses are related to the input stimulus characteristics.
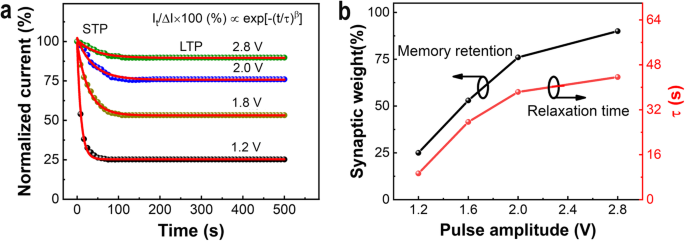
Experimental results of current decay in Ag/SiOx :Ag/TiOx / p ++ -Si memristor device after the stimulation process. a The normalized current decay versus time showing the transformation from STP to LTP; b The memory retention and relaxation time (τ ) as a function of the pulse amplitude
The spike-time-dependent-plasticity (STDP) is another fundamental character for learning and memory function [51] in a biological synapse. It has been reported [52] that in the electronic synapse, the weight can be modulated by a relative timing of pre- and post-synaptic pulses. The Hebbian STDP rule works as follows:if the pre-spike precedes the post-spike (Δt> 0), it could reinforce the connection strength between two neurons. In contrast, if the post-spike heads the pre-spike (Δt <0), it could weaken the connection strength between two neurons. Such kinds of reinforcement and weakening of connection strength between two neurons are also called LTP and LTD, respectively [45]. In the whole process, the order of pre- and post-spikes with respect to time determines the weight change (ΔW) polarity. In order to emulate the STDP rule in our device, a pair of pulses (+1.2 V, 5 ms, and −1.2 V, 5 ms) as pre- and post-spiking signals are implemented, as shown in Fig. 8a. It can be seen that there will emerge a more considerable conductance change (synaptic weight) with the decrease of Δt (in both cases when Δt> 0 and Δt <0). The percentage change in synaptic weight is defined as ΔW =(Gt −G0 )/G0 × 100%. Here, G0 is the conductance measured before stimulation and Gt is the conductance measured after the stimulation using pre- and post-spiking pairs, respectively. A plot is shown in Fig. 8b, that can explain the relationship between ΔW and Δt before and after the simulation process. It can be seen that when the pre-synapse (positive) appears before the post-spike (negative) (Δt> 0), the conductance is enhanced with an increase in ΔW along with the decrease in Δt. On the contrary, when the pre-synapse (positive) appears after the post-spike (negative) (Δt <0), the net conductance of the device is decreased (depressed) in ΔW along with the increase in Δt. These results have demonstrated that our Ag/SiOx :Ag/TiOx / p ++ -Si memristor device has successfully emulated the Hebbian STDP learning rule in the form of an artificial synapse.
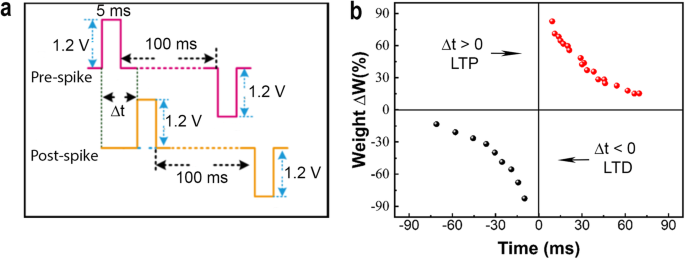
Experimental results for implementation of STDP rule in Ag/SiOx :Ag/TiOx / p ++ -Si memristor device. a The schematic illustration of implementing electrical programming bias comprising the pair of pulses at amplitudes +1.2 V and −1.2 V fixed with the same width of 5 ms. The approaching time difference between stimulus pulses is Δt ms (t =±10n, n =1, 2, …, 10); b The synaptic weight (ΔW) as a function of spike timing (Δt), demonstrating well on the potentiation and depression behaviors in the memristor device
Conclusões
In summary, a new kind of memristor device with the simple structure of Ag/SiOx :Ag/TiOx / p ++ -Si has been fabricated by a physical vapor deposition process. The synaptic characteristics of the memristor with a wide range of resistance change for synaptic weight modulation by implementing positive or negative pulse trains have been investigated extensively. Several crucial learning and memory functions have been demonstrated simultaneously in such a single fabricated memristor device, including short-/long-term potentiation and depression (STP/STD, LTP/LTD), PPF and the STP-to-LTP transition as well as STDP, which are adjusted and controlled by repeating pulses more than a rehearsal operation. Furthermore, the analysis of logarithmic I-V characteristics with corresponding physical model indicates that the controlled formation/dissolution of Ag-filaments across the Ag and p ++ -Si electrodes could improve the performance of the new Ag/SiOx :Ag/TiOx / p ++ -Si memristor device with a buffer layer of TiOx between the SiOx :Ag layer and the bottom electrode. This developed device, as an artificial synapse, might bring a potential research prospect in the design and hardware implementation of new-generation biomimetic neural networks and computing systems.
Disponibilidade de dados e materiais
Todos os dados estão totalmente disponíveis sem restrição.
Abreviações
- BE:
-
Eletrodo inferior
- HRS:
-
Estado de alta resistência
- I-V:
-
Corrente electrica
- LRS:
-
Estado de baixa resistência
- LTM:
-
Long-term memory
- LTP:
-
Long-term plasticity
- PPF:
-
Paired-pulse-facilitation
- SCLC:
-
Space-charge limited conduction
- STDP:
-
Spike-time-dependent-plasticity
- STM:
-
Short-term memory
- STP:
-
Short-term plasticity
- TE:
-
Eletrodo superior
- TEM:
-
Microscopia eletrônica de transmissão
- XPS:
-
espectroscopia de fotoelétrons de raios-X
Nanomateriais
- Sinais analógicos e digitais
- Tipos de sensores analógicos e digitais com aplicativos
- Funções duplas do dispositivo V / SiOx / AlOy / p ++ Si como seletor e memória
- Efeitos das variações de gravação na formação do canal Ge / Si e desempenho do dispositivo
- Efeito da bicamada CeO2 − x / ZnO e ZnO / CeO2 − x heteroestruturas e polaridade de eletroformação nas propriedades de comutação da memória não volátil
- Absorvente infravermelho próximo aprimorado:silício preto estruturado fabricado em duas etapas e sua aplicação no dispositivo
- Propriedades fotocatalíticas aprimoradas de resposta à luz visível de compostos de nanofolha Ag / BiPbO2Cl
- Dispositivo multifuncional com funções selecionáveis de absorção e conversão de polarização na faixa Terahertz
- Inteligência Artificial prevê o comportamento de sistemas quânticos
- Vantagens e desvantagens da inteligência artificial



