Efeito da bicamada CeO2 − x / ZnO e ZnO / CeO2 − x heteroestruturas e polaridade de eletroformação nas propriedades de comutação da memória não volátil
Resumo
Dispositivos de memória com bicamada CeO 2 − x / ZnO e ZnO / CeO 2 − x heteroestruturas ensanduichadas entre eletrodos de topo de Ti e de fundo de Pt foram fabricadas por RF-magnetron sputtering em temperatura ambiente. Materiais semicondutores do tipo N foram usados em ambas as heteroestruturas do dispositivo, mas curiosamente, a mudança na heteroestrutura e na polaridade da eletroformação causou variações significativas nas propriedades de chaveamento resistivo (RS). Os resultados revelaram que a polaridade de eletroformação tem grande influência em ambos CeO 2 − x / ZnO e ZnO / CeO 2 − x desempenho de heteroestrutura, como tensão de eletroformação, boa resistência de ciclo a ciclo de comutação (~ 10 2 ) e relação ON / OFF. Um dispositivo com CeO 2 − x Heteroestrutura / ZnO revela bom desempenho RS devido à formação da barreira Schottky nas interfaces superior e inferior. O mecanismo de condução dominante do estado de alta resistência (HRS) foi a emissão Schottky na região de alto campo. A natureza da dependência da temperatura do estado de baixa resistência e HRS confirmou que RS é causado pela formação e ruptura de filamentos condutores compostos por vazios de oxigênio.
Histórico
As memórias flash convencionais estão enfrentando seus limites físicos e práticos, portanto, a busca de novos candidatos possíveis para aplicações de memória não volátil se tornou muito necessária. Com relação a isso, vários novos tipos de memória foram sugeridos como candidatos à memória não volátil de próxima geração [1, 2]. Dentre eles, a memória de acesso aleatório resistiva (RRAM) está sendo considerada a melhor candidata para a substituição de memórias convencionais devido às suas características únicas, como alta capacidade de escalonamento, longo tempo de retenção de memória, menor tamanho do dispositivo, velocidade de comutação rápida, baixa utilização de energia , não volatilidade e estrutura simples [3]. A célula de memória de RRAM é uma estrutura semelhante a um condensador, metal-óxido-metal (MOM). Os comportamentos de chaveamento resistivo bipolar (BRS) e RS unipolar (URS) entre dois estados de resistência, ou seja, estado de baixa resistência (LRS) e estado de alta resistência (HRS) de um filme de resistor, podem ser alcançados pela aplicação de tensão externa com magnitude apropriada e polaridades [4,5,6].
O desempenho de chaveamento de um dispositivo RS depende da uniformidade da tensão SET, da tensão RESET e dos níveis de corrente no LRS e HRS [7]. Esses parâmetros de comutação são influenciados pelos dielétricos do filme, materiais do eletrodo e técnica de fabricação / operação. Numerosos modelos foram propostos até agora para explicar a dependência das características de comutação em relação a esses parâmetros. O comportamento de comutação pode ser categorizado como limitado em massa ou limitado pela interface [8]. Para chaveamento do tipo bulk-limited, os parâmetros de chaveamento são fortemente dependentes da permissividade dos filmes dielétricos [9]. No entanto, a comutação limitada do eletrodo é devido à correlação de elétrons na interface metal-dielétrica e à função de trabalho dos materiais do eletrodo [10]. A interface entre um ânodo e filme dielétrico também pode afetar os parâmetros RS de um dispositivo de memória [10, 11].
Entre vários óxidos, céria (CeO 2 ) foi considerado um material promissor para aplicações de dispositivos de memória RS devido à sua grande constante dielétrica (~ 26), menor energia livre de Gibbs (- 1024 kJ / mol), duas oxidações (Ce + 4 para Ce + 3 ) estados, e distribuição de vagas (particularmente vagas de oxigênio) em um padrão não estequiométrico [12, 13]. Por outro lado, o óxido de zinco (ZnO), devido às suas propriedades excepcionais, está sendo amplamente utilizado em várias aplicações. Observa-se que o ZnO está sendo utilizado como dielétrico devido à sua transparência óptica, grande gap, estabilidade química e alta resistividade (10 5 Ω-cm) [14]. Recentemente, estruturas de memória RS de bicamada foram propostas para mostrar propriedades superiores sobre dispositivos baseados em camada única em termos de redução de eletroformação e / ou tensões SET / RESET, melhoria de uniformidade na comutação, longa resistência e auto-conformidade [15]. Xu et al. [16] investigou o comportamento RS do ZrO 2 e pilhas de camada dupla de ZnO ilustrando que a migração de vacâncias de oxigênio depende da altura da barreira interfacial de óxido. Comportamento RS observado na bicamada MnO / CeO 2 estrutura foi proposta como sendo devido à reação de oxidação e redução de CeO 2 conforme relatado por Hu et al. [17]. Yang et al. [18] revelou boas características de chaveamento resistivo de dispositivos CuO / ZnO de camada única em comparação com dispositivos baseados em ZnO de camada única. Park et al. [19] demonstrou operação RS mais confiável e reproduzível observada em Pt / TiO x / ZnO / Pt células de memória do que o observado em células de memória Pt / ZnO / Pt. Hsieh et al. [20] descreveu que Ni / ZnO / HfO 2 / Dispositivos de Ni exibiram comportamento de chaveamento resistivo bipolar com características de vários níveis durante o processo de RESET. Todas essas características aprimoradas de RS motivaram investigações profundas da bicamada, tanto como ZnO / CeO 2 ou como CeO 2 / Heteroestruturas ZnO, uma vez que nenhum estudo sobre essas pilhas e a influência da formação de polaridade em suas características RS e seu desempenho de memória ainda foi relatado.
Neste trabalho, relatamos a influência da heteroestrutura de bicamada, bem como da polaridade de eletroformação nas propriedades RS de ZnO / CeO 2 − x e CeO 2 − x Dispositivos de memória baseados em / ZnO. Os resultados mostraram que o CeO positivamente eletroformado 2 − x Dispositivos / ZnO e ZnO / CeO eletroformado negativamente 2 − x dispositivos demonstram tensões de eletroformação mais baixas e resistência de comutação ciclo a ciclo muito melhor (~ 10 2 ) atuação. A dependência da temperatura das resistências LRS e HRS desses dispositivos de bicamada com polaridades de polarização opostas indica que o mecanismo RS observado pode ser explicado por canais de condução baseados em vacâncias de oxigênio.
Métodos
Dois tipos de Ti / CeO 2 / ZnO / Pt e Ti / ZnO / CeO 2 Dispositivos de heteroestrutura Pt / Pt foram preparados neste trabalho para estudo comparativo. Para fabricação do primeiro Ti / CeO 2 / Dispositivo de heteroestrutura ZnO / Pt, uma camada ativa de filme fino de ZnO (~ 10 nm) foi depositada em Pt / Ti / SiO comercial 2 / Si (Pt) substratos em temperatura ambiente por radiofrequência (RF) magnetron sputtering usando ZnO (99,99% puro) alvo de cerâmica. Durante a deposição, potência RF de 75 W e pressão de ~ 10 mTorr sob Ar:O 2 (6:18) mistura (taxa de fluxo =24 sccm) foram mantidos. Então, CeO 2 camada (5 nm) foi depositada em ZnO / Pt por pulverização catódica RF magnetron sob as mesmas condições para formar a bicamada CeO 2 / Heteroestrutura ZnO. Finalmente, eletrodo superior de Pt / Ti (TE) foi depositado em ambas as heteroestruturas por pulverização sequencial de magnetron de corrente contínua (DC) usando máscara de sombra de metal. Essa técnica produziu dispositivos circulares (células de memória) com diâmetro de 150 μm. Aqui, o Pt foi usado como uma camada protetora para proteger o Ti TE da oxidação. Da mesma forma, um segundo Ti / ZnO / CeO 2 / Pt dispositivo de heteroestrutura também foi fabricado sob as mesmas condições mantidas para Ti / CeO 2 / Heteroestruturas ZnO / Pt. Ambos Ti / CeO 2 / ZnO / Pt e Ti / ZnO / CeO 2 Os dispositivos de memória de heteroestrutura / Pt foram caracterizados pelo analisador de parâmetros de semicondutores Agilent B1500A usando um método de medição de duas sondas padrão. A estrutura de bicamada desses dispositivos foi caracterizada usando microscopia eletrônica de transmissão de alta resolução de visão cruzada (HRTEM-JEM 2001F).
Resultados e discussão
A Figura 1a, b mostra a configuração esquemática da bicamada Ti / CeO 2 / ZnO / Pt e Ti / ZnO / CeO 2 / Dispositivos de memória de heteroestrutura Pt, respectivamente. A Figura 2a-d mostra a tensão-corrente típica ( I - V ) curvas de Ti / CeO 2 − x / ZnO / Pt e Ti / ZnO / CeO 2 − x / Dispositivos de memória de heteroestrutura Pt, incluindo também o processo de eletroformação inicial, indicando características típicas de RS bipolares. Quando uma varredura de + 2 V foi aplicada ao TE, um salto repentino de corrente ocorreu a 0,6 V, indicando a formação de caminhos condutores entre dois eletrodos (Fig. 2a). O dispositivo permaneceu no estado LIGADO (LRS) depois que a tensão de eletroformação positiva foi removida. A Figura 2a também mostra que o dispositivo comutou com sucesso de volta para HRS com uma varredura de tensão negativa de 0 a -1 V, e para LRS novamente com uma varredura de voltagem positiva de 0 a + 1 V. Uma polaridade oposta, ou seja, tensão de eletroformação negativa, também foi fornecido para ativar / iniciar o comportamento de comutação na mesma célula de memória de heteroestrutura. A este respeito, quando uma varredura de 0 a - 8 V foi aplicada ao TE, a resistência do dispositivo exibiu uma queda repentina em - 5,6 V, transformando-o assim do estado OFF denominado eletroformação negativa (Fig. 2b). Após a eletroformação negativa, o dispositivo falhou em RESET positivo e SET negativo devido à sua quebra irreversível. É notado que tensões de eletroformação negativas muito mais altas são necessárias para iniciar as características RS do que tensões de eletroformação positivas. Porém, após a eletroformação negativa, não houve histerese de chaveamento, pois o dispositivo permaneceu no estado ON independente da aplicação das tensões SET e RESET; esse fato indica a formação de filamentos condutores permanentes durante o processo de eletroformação. A quebra irreversível durante a eletroformação negativa pode ser resultado de diferentes alturas de barreira de tunelamento iniciadas pela diferença nas funções de trabalho do eletrodo superior e inferior [21]. Estes resultados mostram que o dispositivo com Ti / CeO 2 − x A heteroestrutura / ZnO / Pt pode ser adequada para características não voláteis apenas se for eletroformada com polaridade positiva, seguida por polaridades negativa e positiva de operações RESET e SET correspondentes. A única diferença entre o segundo (Ti / ZnO / CeO 2 − x / Pt) e primeiro (Ti / CeO 2 − x / ZnO / Pt) dispositivos é a posição das camadas isolantes na heteroestrutura em sanduíche. É por isso que o dispositivo com Ti / ZnO / CeO 2 − x / Pt heteroestrutura também pode ser eletroformado em ambas as polaridades positiva e negativa de potenciais de polarização da mesma forma Ti / CeO 2 − x / ZnO / Pt dispositivo de heteroestrutura. A Figura 2c mostra o típico bipolar I-V curvas para tal eletroformação positiva e comportamento de comutação subsequente. Com varredura de 0 a + 4 V, o dispositivo foi eletroformado para colocá-lo no estado LIGADO (uma mudança abrupta de resistência em + 3 V), conforme ilustrado na Fig. 2c. O dispositivo foi então LIGADO abaixo de + 2 V (CONFIGURAÇÃO positiva) e DESLIGADA a -1,5 V (REINICIALIZAÇÃO negativa) durante o ciclo de comutação repetível. Da mesma forma, o dispositivo com a mesma heteroestrutura eletroformada negativamente (em - 3,5 V) apresentou RESET positivo (em + 1,5 V) e SET negativo (em - 2,5 V) como óbvio na Fig. 2d. Para proteger ambos os dispositivos de avarias permanentes, a conformidade de corrente de 1 mA foi aplicada durante os processos de eletroformação e SET.
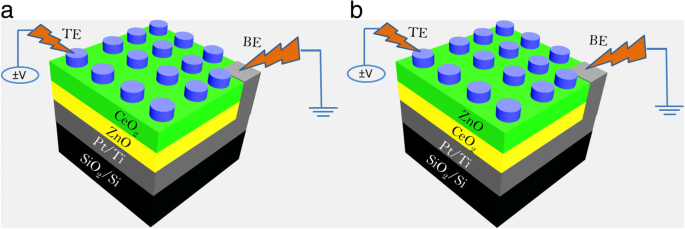
Configuração esquemática da bicamada a Ti / CeO 2 / ZnO / Pt e b Ti / ZnO / CeO 2 / Dispositivos Pt
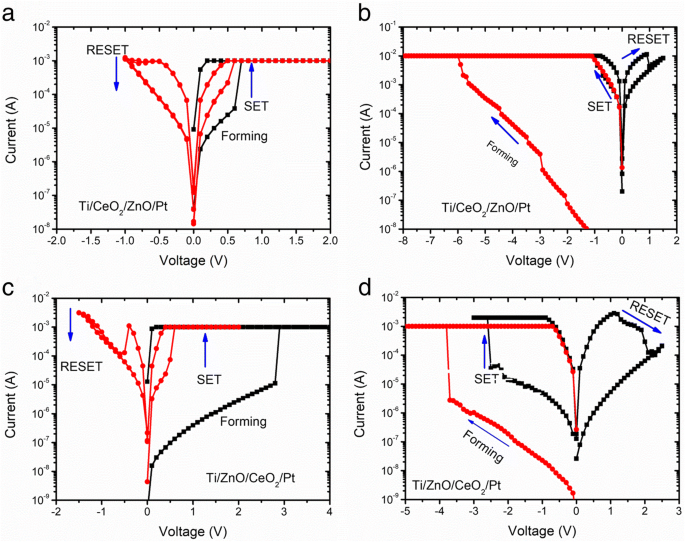
Os dispositivos representam o comportamento bipolar típico. a Formação positiva (+ ve) e operação de comutação subsequente e b formação negativa (−ve) e operação de comutação do Ti / CeO 2 − x / ZnO / Pt hetrestruturas. c + ve formação e operação de comutação e d Formação de veias e operação de comutação de Ti / ZnO / CeO 2 − x / Dispositivos de memória Pt. As setas indicam as direções de mudança
Para verificar a uniformidade dos parâmetros de comutação para ambos os dispositivos de memória de heteroestrutura, probabilidades cumulativas de tensões operacionais (tensões SET e RESET) observadas em vários ciclos de comutação são exibidas na Fig. 3a, b. O Ti / CeO 2 − x / ZnO / Pt dispositivo de memória de heteroestrutura exibe variações relativamente mais estreitas nas tensões SET e RESET em comparação com Ti / ZnO / CeO 2 − x / Dispositivo de memória de heteroestrutura Pt. A Figura 3c, d revela a análise estatística das tensões médias de SET, RESET e eletroformação de ambos os dispositivos de memória de heteroestrutura. O Ti / CeO 2 − x Dispositivos / ZnO / Pt requerem tensões de eletroformação muito mais baixas em comparação com as necessárias para Ti / ZnO / CeO 2 − x / Dispositivos de memória de heteroestrutura Pt, mas as tensões SET e RESET demonstram apenas pequenas variações. Flutuações menores nas tensões de operação de ambos os dispositivos podem estar associadas à criação e ruptura de filamentos que ocorrem nas interfaces. Liu et al. [22] sugeriu que as baixas tensões SET / RESET e uniformidade de comutação observada em WO x / NbO x A estrutura em bicamada pode ser atribuída ao efeito combinado da migração de oxigênio entre duas camadas de óxido e a transição metal-isolante. Como energia livre de Gibbs ΔG da formação de óxido para ZnO e CeO x tem uma grande diferença de cerca de 706 kJ / mol (para CeO 2 , ΔG =- 1024 kJ / mol e para ZnO é - 318,52 kJ / mol) e ocorre o efeito de aquecimento localizado, a troca de oxigênio é induzida. É bem conhecido que a camada fina de ZnO possui muitas lacunas de oxigênio devido à baixa energia de formação [23]. Além disso, muitas vacâncias iniciais de oxigênio presentes na camada de ZnO desempenham um papel importante na condução por meio de armadilhas rasas [24]. Além disso, afirma-se que o fenômeno de formação livre em dispositivos baseados em ZnO pode ser creditado a uma alta concentração de vacâncias de oxigênio já presentes nos cristais de ZnO [25]. De todos os fatos acima mencionados, pode-se concluir que na presença de filme de ZnO possuindo muitas vacâncias de oxigênio em ambos os dispositivos de heteroestrutura (ZnO / CeO 2 − x e CeO 2 − x / ZnO) desempenha um papel crucial na redução das tensões operacionais. As vacâncias de oxigênio em ZnO podem atuar como armadilhas rasas para elétrons e elétrons nesses locais de captura podem ser facilmente capturadas ou desencapadas em pequenos valores de tensões SET e RESET.

Distribuição de probabilidade cumulativa ciclo a ciclo de tensões operacionais em a Ti / CeO 2 − x / ZnO / Pt e b Ti / ZnO / CeO 2 − x / Dispositivos de memória de heteroestrutura Pt. c Análise estatística das tensões SET e RESET de Ti / CeO 2 − x / ZnO / Pt e Ti / ZnO / CeO 2 − x / Dispositivos de memória de heteroestrutura Pt. d Avaliação estatística das tensões de eletroformação para Ti / CeO 2 − x / ZnO / Pt e Ti / ZnO / CeO 2 − x / Dispositivos de memória de heteroestrutura Pt
Para investigar a confiabilidade de ambas as heteroestruturas do dispositivo, foram realizados testes de resistência em diferentes polaridades do potencial de polarização. Os valores de resistência de HRS e LRS são obtidos a 0,2 V de ciclos de comutação de resistência DC. A Figura 4a descreve as características de resistência de Ti / CeO 2 − x / ZnO / Pt dispositivo de memória de heteroestrutura. É visto que Ti / CeO positivamente eletroformado 2 Os dispositivos de memória de heteroestrutura / ZnO / Pt exibiram boa resistência com janela de memória de ~ 10 que poderia garantir HRS e LRS claramente distinguíveis. Formação da barreira Schottky em Ti / CeO 2 − x interface é devido à diferença de função de trabalho entre o Ti TE e a camada adjacente de CeO 2 − x , levando a boas propriedades RS. Quando o mesmo dispositivo de heteroestrutura (Ti / CeO 2 − x / ZnO / Pt) foi eletroformado negativamente, o dispositivo não pôde ser alterado de LRS para HRS como mostrado na Fig. 4b. A Figura 4c ilustra as características de resistência de Ti / ZnO / CeO positivamente eletroformado 2 − x / Dispositivo de memória de heteroestrutura Pt exibindo propriedades de resistência muito pobres. A janela de memória parece estar quase recolhida, tornando os estados LIGADO e DESLIGADO praticamente indistinguíveis. Este fato pode ser atribuído à incapacidade do ZnO em capturar os portadores injetados devido à presença de alta concentração de vacâncias, o que torna a condução em direção ao Ti TE, pois nenhuma barreira é formada na interface Ti / ZnO devido à diferença desprezível da função de trabalho entre Ti (4,33 eV) e ZnO (4,35 eV), e isso leva a uma baixa resistência [26]. Outra razão pode ser a alta densidade de defeitos dentro do ZnO / CeO 2 − x matriz criada sob forte campo elétrico, porque a migração de vacância de oxigênio é significativamente aumentada ao longo dos defeitos estendidos. Além disso, as vacâncias de oxigênio carregadas positivamente segregadas nos locais de defeito aumentam os estados de densidade da superfície, resultando no colapso da razão ON / OFF. Isso sugere que, quando o contato de bloqueio Ti / ZnO é formado, os níveis de Fermi estão alinhados entre si devido ao movimento dos elétrons do Ti para o ZnO. Como resultado, a maioria dos portadores são reunidos na superfície da camada de óxido e quase nenhuma barreira é formada [26]. A Figura 4d demonstra características de resistência muito melhores do Ti / ZnO / CeO formado negativamente 2 − x / Dispositivo de memória de heteroestrutura Pt em comparação com aqueles de dispositivo formado positivamente. Zhu et al. [27] fabricou três tipos diferentes de dispositivos:(i) Ag / ZnO / NSTO / In, (ii) Ag / CeO 2 / NSTO / In, e (iii) Ag / CeO 2 / ZnO / NSTO / In. O dispositivo de bicamada (CeO 2 − x / ZnO), em comparação com os de camada única, exibiu melhor comportamento de RS com retenção de dados de cerca de 10 anos. Eles atribuíram melhores características RS de heteroestruturas de bicamada à barreira de interface entre CeO 2 − x / Estrutura de bicamada de ZnO e a existência de grande número de vagas atuando como centros de armadilha em filmes de ZnO.
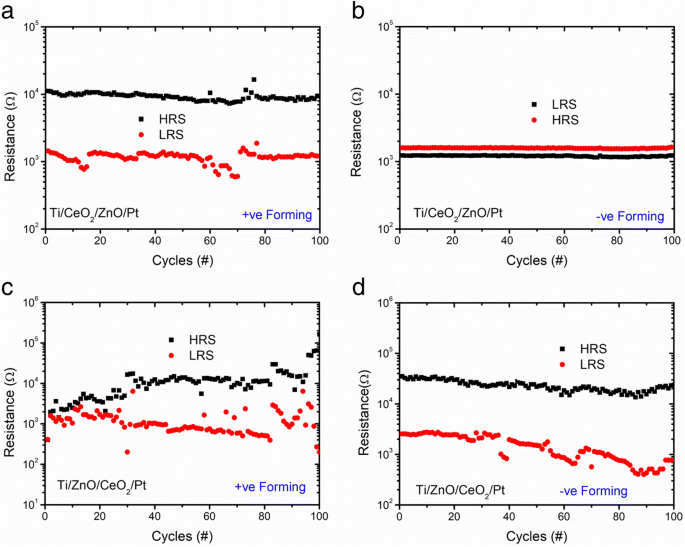
Características de resistência de a positivamente eletroformado e b Ti / CeO eletroformado negativamente 2 − x Dispositivos de memória de heteroestrutura / ZnO / Pt. c Eletroformado positivamente e d Ti / ZnO / CeO eletroformado negativamente 2 − x / Dispositivos de memória de heteroestrutura Pt
O desempenho de retenção de ambos CeO 2 − x / ZnO e ZnO / CeO 2 − x heteroestruturas de duas camadas também foram investigadas. O tempo de retenção de ambos os dispositivos de heteroestrutura foi medido à temperatura ambiente com uma tensão de leitura de 0,2 V, como é óbvio na Fig. 5a, b. Nenhuma energia elétrica era necessária para manter a resistência constante em qualquer estado. Até o tempo de retenção de 10 4 s, as resistências de HRS e LRS não revelam sinais de deterioração, o que implica que as informações armazenadas em ambos os dispositivos de heteroestrutura podem ser mantidas por muito mais tempo do que 10 4 s.

Características de retenção de a Ti / CeO positivamente eletroformado 2 − x / ZnO / Pt dispositivos de memória de heteroestrutura e b Ti / ZnO / CeO eletroformado negativamente 2 − x / Dispositivos de memória de heteroestrutura Pt em temperatura ambiente
Para investigar sobre o mecanismo de condução predominante na região de alto campo de ambos os dispositivos de memória de heteroestrutura, o procedimento de ajuste de curva foi realizado sob positivo (para CeO 2 − x / ZnO) e negativo (para ZnO / CeO 2 − x ) polaridades do potencial de polarização. A Figura 6a, b descreve que os ajustes de curva linear para dados experimentais estão bem alinhados com o comportamento de emissão Schottky para ambos os dispositivos de heteroestrutura em suas respectivas polaridades de polarização. A emissão de Schottky é conhecida por ocorrer quando o eletrodo injeta elétrons ativados termicamente através da barreira na banda de condução do isolador, por isso é chamado de mecanismo de eletrodo limitado. Geralmente, a emissão Schottky surge quando o contato do eletrodo é altamente injetivo. A relação linear de ln ( I ) vs. √ V indica que os elétrons atingiram uma quantidade adequada de energia para vencer a barreira de energia. A condução ôhmica (a corrente é proporcional à voltagem aplicada) ocorrendo em uma região de baixo campo mostra que a corrente flui devido aos elétrons gerados termicamente (os resultados não são mostrados aqui). O modelo de emissão de Schottky geralmente pode ser descrito por uma equação da forma [28]:\ (\ ln (J) =\ ln {A} ^ {\ ast} {T} ^ 2-q \ left ({\ varPhi} _b- \ sqrt {\ frac {qV} {4 \ pi {\ varepsilon} _o {\ varepsilon} _rd}} \ \ right) / {k} _BT \), onde J é a densidade atual, A * é constante de Richardson, T é a temperatura, q é carga elétrica, V é voltagem eclética, ε r é a constante dielétrica, ε o é a permissividade do espaço livre, d é a espessura do filme e k B é a constante de Boltzmann. Além disso, os valores de resistência dependentes da temperatura de LRS e HRS foram medidos na tensão de 0,2 V na faixa de temperatura de 200–300 K para ambos CeO 2 − x / ZnO e ZnO / CeO 2 − x dispositivos de memória de heteroestrutura, como mostrado na Fig. 6c, d. Pode-se notar que as propriedades de transporte elétrico de ambos os dispositivos de heteroestrutura em estado de baixa resistência são de natureza metálica, isto é, as resistências em LRS aumentam com o aumento da temperatura. Em contraste com isso, as propriedades de transporte elétrico para ambos os dispositivos no HRS são semicondutores por natureza, isto é, as resistências no HRS diminuem com o aumento das temperaturas. Valores de energia de ativação ( E a ) obtidos a partir de gráficos de Arrhenius de LRS de ambos os dispositivos de heteroestrutura (resultados não mostrados) são ~ 0,092 eV, e comparáveis à energia da primeira ionização de vacâncias de oxigênio (~ 0,1 eV) [25, 26, 29], o que indica que o primeiro A ionização das vacâncias de oxigênio é responsável pela condução no HRS, confirmando ainda mais a dominância da emissão de Schottky como mecanismo de condução operativo no HRS. O comportamento metálico em LRS e o comportamento semicondutor em HRS de ambos os dispositivos de heteroestrutura fornecem evidências suficientes no suporte do comportamento de comutação em Ti / CeO 2 − x / ZnO / Pt e Ti // ZnO / CeO 2 − x / Pt dispositivos de memória de heteroestrutura que podem ser associados a mecanismo filamentar condutivo baseado em vacâncias de oxigênio.
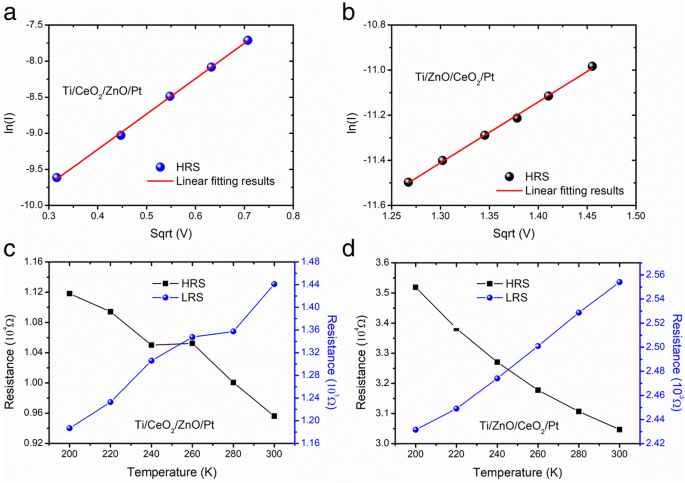
registrar I-V 1/2 características no HRS do estado SET. a Para Ti / CeO 2 − x / ZnO / Pt. b Para Ti / ZnO / CeO 2 − x / Dispositivos de memória de heteroestrutura Pt. Dependência da temperatura de LRS e HRS de c Ti / CeO 2 − x / ZnO / Pt e d Ti // ZnO / CeO 2 − x / Dispositivos de memória de heteroestrutura Pt
A Figura 7 descreve o diagrama de banda de energia proposto de CeO 2 e materiais semicondutores do tipo ZnO n-n no estado estacionário. A diferença entre as funções de trabalho de ZnO (4,35 eV) e CeO 2 (3,33 eV) é igual a 1,02 eV para a mesma transição eletrônica na vacância de oxigênio [30]. A função de trabalho inferior do CeO 2 (3,33 eV) do que o de ZnO (4,35 eV) permite o movimento de elétrons de CeO 2 ao ZnO, originando sua maior concentração na matriz.
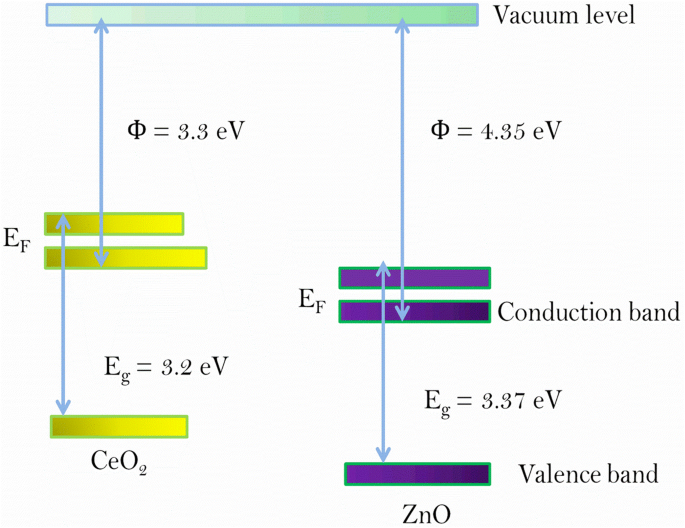
Diagrama de banda de energia de CeO 2 e materiais semicondutores do tipo ZnO n
De acordo com nosso estudo anterior [31], as características RS de Ti / CeO de camada única 2 − x / Pt device foram atribuídos à formação de uma camada interfacial de TiO que desempenha um papel fundamental na criação e ruptura de caminhos filamentosos condutores. Warule et al. propuseram que o comportamento do RS nos dispositivos Ti / ZnO / Pt foi induzido pela criação e desconexão de filamentos condutores baseados em vacâncias de oxigênio [32]. Além disso, o fenômeno de livre formação em dispositivos Ti / ZnO / Pt está relacionado com a existência de uma quantidade considerável de vacâncias de oxigênio nos dispositivos Ti / ZnO / Pt preparados [32,33,34]. A barreira Schottky na interface ZnO / Pt pode ser eliminada pela existência de uma quantidade adequada de vacâncias de oxigênio no filme de ZnO, resultando em um contato ôhmico na interface ZnO / Pt. Consequentemente, a formação da camada interfacial de TiO pode ser associada ao efeito RS na bicamada ZnO / CeO 2 − x e CeO 2 − x / Heteroestruturas ZnO. É bem conhecido que o Ti é um metal altamente reativo com o oxigênio atmosférico:portanto, pode facilmente formar uma camada de TiO na interface Ti / óxido [35]. Em Ti / ZnO / CeO 2 − x / Pt dispositivo de memória de heteroestrutura, ZnO é semicondutor do tipo n e contém uma grande quantidade de vacâncias de oxigênio nele, então um contato ôhmico é formado na interface Ti / ZnO [36]. Como o Ti e o ZnO têm aproximadamente as mesmas funções de trabalho, o Ti é incapaz de extrair íons de oxigênio do ZnO para criar uma camada interfacial de TiO. Foi relatado que íons de oxigênio não reticulados e oxigênio relacionados com defeitos reticulados existem em filmes de ZnO [37]. Devido à deposição de céria (CeO 2 ) por RF sputtering em temperatura ambiente, fabricado CeO 2 os filmes são policristalinos por natureza. Portanto, os filmes de céria podem ser não estequiométricos, como já provamos em nosso trabalho de pesquisa anterior que a céria é reduzida a CeO 2 − x [12]. Hu et al. [17] também relatou tal redução de CeO 2 durante a deposição em CeO 2 − x . Defeitos no CeO 2 − x os filmes são insuficientes para mobilizar os íons de oxigênio. Portanto, CeO 2 − x camada serve como reservatório de oxigênio em Ti / ZnO / CeO 2 − x / Heteroestrutura Pt. Energia de Gibb para a formação de CeO 2 é muito menor (- 1024 kJ / mol) do que o de ZnO (- 318,52 kJ / mol), conforme descrito anteriormente, portanto, existem oxigênios não reticulados em ZnO devido à sua natureza não estequiométrica, que se movem em direção a CeO 2 camada, mesmo na ausência de viés externo [37]. Portanto, quando o Ti TE é depositado no ZnO, nenhuma camada interfacial é esperada se formar entre o Ti e o ZnO, embora a energia de Gibbs de formação do TiO seja menor do que a do ZnO. Quando a voltagem positiva é aplicada ao TE, os íons de oxigênio são atraídos para o CeO 2 − x A interface / Pt e os filamentos condutores são gerados com vacâncias de oxigênio devido às suas habilidades de deriva e arranjo de linha.
Por outro lado, em Ti / CeO 2 − x / ZnO / Pt dispositivos de memória de heteroestrutura, uma camada interfacial de TiO muito fina é formada em Ti / CeO 2 − x interface tão óbvia a partir da imagem HRTEM (Fig. 1c) e como sugerido por nosso estudo anterior [37]. A energia de Gibbs de formação de TiO (- 944 kJ / mol) é relativamente maior do que CeO 2 − x (-1024 kJ / mol); portanto, embora o Ti, devido à sua alta afinidade com oxigênio, capture íons de oxigênio do CeO 2 − x para formar a camada interfacial de TiO, uma parte dos íons de oxigênio retorna ao CeO 2 − x camada na ausência / presença de um campo negativo externo [38]. A energia de Gibbs de formação de óxido para TiO e ZnO é - 944 kJ / mol e - 318,52 kJ / mol, respectivamente. Consequentemente, pode-se obter a energia de Gibbs de formação de óxido para (1/2) CeO 2 =- 512 kJ / mol. Comparando com o ZnO, a afinidade do oxigênio do Ce é um pouco maior do que a do Zn, então os íons de oxigênio se difundem do ZnO para o CeO 2 − x camada e, em seguida, para a camada de TiO de onde esses íons podem migrar para TE, deixando espaços vazios de oxigênio nas camadas de óxido. Consequentemente, todos os íons de oxigênio se reúnem na interface superior e filamentos condutores com vacâncias de oxigênio são formados entre os eletrodos. Na presença de polaridade de polarização oposta, os íons de oxigênio são enviados de volta para as camadas de óxido, resultando no preenchimento das lacunas de oxigênio levando à ruptura do filamento.
As funções de trabalho dos eletrodos de Ti superior e inferior de Pt são 4,33 e 5,65 eV, respectivamente [39]. A afinidade eletrônica e a função de trabalho do ZnO (3,37 eV e 4,35 eV) são maiores do que aquelas do CeO 2 (3,50 eV e 3,2 eV) [40]. Portanto, uma barreira de energia no ZnO / CeO 2 − x interface é esperada, como a barreira Schottky. No regime de voltagem positiva, os elétrons não podem ser facilmente injetados através dos defeitos no CeO 2 pelo eletrodo inferior de Pt para a camada de ZnO porque a função de trabalho do ZnO é maior do que CeO 2 . É por isso que os elétrons são menos capazes de derivar do ZnO para o eletrodo superior de Ti, já que o Ti é incapaz de atrair íons de oxigênio do ZnO devido às suas funções de trabalho semelhantes. A altura da barreira no topo Ti / ZnO e CeO 2 − x As interfaces de fundo / Pt são, respectivamente, 0,05 eV e 2,45 eV, altura da barreira em CeO 2 A interface inferior / Pt é mais alta, de modo que os elétrons não podem ser disparados facilmente do metal para o dielétrico, o que resulta na formação de uma barreira Schottky na interface inferior [41].
No entanto, a altura da barreira da interface Ti / ZnO superior é insignificante devido a funções de trabalho semelhantes, mas é muito maior no CeO inferior 2 − x / Pt interface é por isso que a polaridade do campo de polarização não é suficiente para equilibrar as alturas de barreira das duas interfaces; consequentemente, a resistência e as características de comutação de Ti / ZnO / CeO 2 − x Heteroestruturas / Pt não são tão boas na polaridade positiva da polarização aplicada. Quando a varredura de tensão negativa é aplicada ao eletrodo superior de Ti, a injeção de elétrons do Ti TE é incapaz de controlar a barreira na interface Ti / ZnO porque nenhuma barreira Schottky é formada na interface Ti / ZnO superior no Ti / ZnO / CeO 2 − x / Pt heteroestrutura como mostrado na Fig. 8a, b.
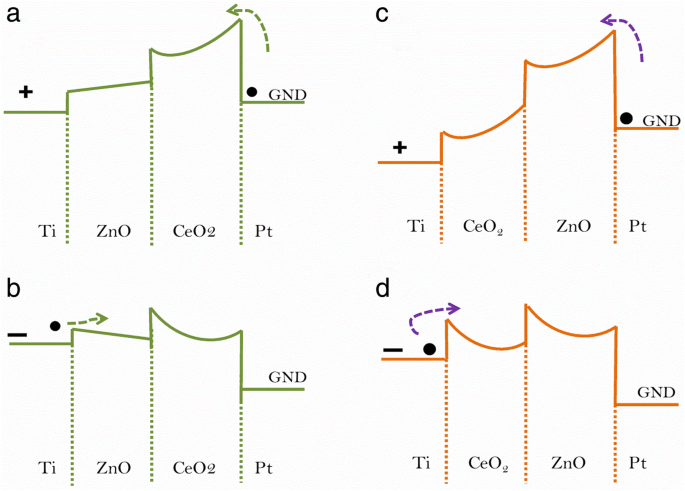
Diagramas esquemáticos para o deslocamento da banda de condução de a , b Ti / ZnO / CeO 2 − x / Pt e c , d Ti / CeO 2 − x Dispositivos de memória de heteroestrutura / ZnO / Pt. As setas representam a direção da deriva dos elétrons de acordo com as polaridades de comutação
Na região de tensão positiva, por outro lado, os elétrons podem ser facilmente injetados através dos defeitos em ZnO do eletrodo de Pt para o CeO 2 − x camada. Esses elétrons são então desviados de CeO 2 − x camada ao eletrodo superior de Ti. As alturas de barreira do topo Ti / CeO 2 − x (1,13 eV) e as interfaces ZnO / Pt (2,28 eV) inferiores sugerem uma emissão Schottky como mostrado na Fig. 8c, d. Quando uma tensão negativa é varrida para o eletrodo superior de Ti, a injeção de elétrons do eletrodo superior é controlada por esta barreira Schottky em Ti / CeO 2 − x interface, porque os fenômenos de captura e remoção podem ocorrer facilmente na barreira inferior (1,13 eV). Os íons de oxigênio podem ser migrados para Ti / CeO 2 − x interface aplicando uma tensão positiva. O mecanismo RS em Ti / CeO 2 − x O dispositivo de memória heteroestrutural / ZnO / Pt pode ser explicado pela criação e dissolução de filamentos condutores com vacâncias de oxigênio nas camadas de óxido [41]. Isso significa que os íons de oxigênio podem, portanto, mover-se para frente e para trás entre Ti / CeO 2 − x interface e camadas de óxido por duas polaridades opostas da polarização externa. Quando uma tensão positiva é varrida no eletrodo de Ti, os íons de oxigênio são desviados de CeO 2 − x / ZnO para Ti / CeO 2 − x interface. Os filamentos condutores com vacâncias de oxigênio são formados na camada de óxido e, conseqüentemente, o estado de resistência é alterado de OFF- (HRS) para ON (LRS). Quando uma tensão negativa é varrida no Ti TE, o processo de retirada da armadilha é iniciado e os íons de oxigênio são reunidos no Ti / CeO 2 − x interface são movidos de volta para o eletrodo inferior. Os filamentos condutores são rompidos devido à migração de íons de oxigênio. O dispositivo é então comutado novamente para HRS. Com base nos resultados atuais, investigamos o efeito da heteroestrutura do dispositivo, como CeO 2 − x / ZnO e ZnO / CeO 2 − x e eletroformação de polaridade em parâmetros de comutação resistivos para possíveis aplicações em dispositivos resistivos de memória de acesso aleatório. Notamos que ambas as estruturas do dispositivo e sua polaridade de eletroformação apresentam uma influência significativa nos parâmetros de comutação, como tensão de eletroformação, janela de memória e uniformidade nas tensões SET / RESET. No entanto, é necessária mais atenção para obter tempo de programação / apagamento mais rápido, maior escalabilidade, dispositivos sem eletroformação e de baixo elenco em pesquisas futuras. Em particular, é necessário trabalhar na escolha do material de eletrodo adequado, utilizando nanocristais ou íons de metal incorporados em uma camada isolante e dispositivo de fabricação em estruturas de camada tampão.
Conclusões
Em conclusão, investigações profundas sobre o comportamento de RS foram feitas alterando a morfologia da bicamada ZnO / CeO 2 − x e CeO 2 − x / Heteroestruturas ZnO e sinal de polaridades de eletroformação. Impacto significativo é notado no desempenho, características de resistência, tensões de eletroformação e uniformidade nas tensões operacionais. Resultados experimentais revelam a formação da camada interfacial de TiO em Ti / CeO 2 − x Heteroestrutura / ZnO / Pt na aplicação de polarização positiva e CeO 2 − x camada durante a polaridade negativa serve como um reservatório de oxigênio em Ti / ZnO / CeO 2 − x / Heteroestruturas Pt. Coletivamente, pode desempenhar um papel importante para a melhoria da uniformidade e repetibilidade dos parâmetros RS. O mecanismo de condução dominante no HRS foi a emissão Schottky limitada por eletrodo em uma região de alto campo. A dependência das resistências LRS e HRS com a temperatura leva à conclusão de que o mecanismo RS observado é baseado no movimento das vacâncias de oxigênio sob a tensão aplicada.
Abreviações
- BRS:
-
Comutação resistiva bipolar
- DC:
-
Corrente direta
- HRS:
-
Estado de alta resistência
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- LRS:
-
Estado de baixa resistência
- MOM:
-
Metal-óxido-metal
- RRAM:
-
Memória de acesso aleatório resistiva
- RS:
-
Comutação resistiva
- TE:
-
Eletrodo superior
- URS:
-
Comutação resistiva unipolar
Nanomateriais
- O efeito do plasma sem equilíbrio de contato nas propriedades estruturais e magnéticas de Mn Х Fe3 - X О4 Spinels
- Propriedades paramagnéticas de nanomateriais derivados do fulereno e seus compostos de polímero:efeito drástico de bombeamento
- Síntese hidrotérmica de nanopartículas de In2O3 híbridos gêmeos heteroestruturas de ZnO de disco hexagonal para atividades fotocatalíticas aprimoradas e estabilidade
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Síntese de nanocristais de ZnO e aplicação em células solares de polímero invertido
- Efeito sinérgico do grafeno e MWCNTs na microestrutura e propriedades mecânicas de nanocompósitos Cu / Ti3SiC2 / C
- Fabricação e caracterização de Nano-Clips de ZnO pelo processo mediado por poliol
- Propriedades ópticas de filmes ZnO com dopagem Al-Dopada na região infravermelha e suas aplicações de absorção



