Fabricação de microdiscos GeSn de alta qualidade e com relaxamento de tensão por meio da integração de métodos de crescimento epitaxial seletivo e de corrosão úmida seletiva
Resumo
GeSn é um material promissor para a fabricação de dispositivos fotônicos e nanoeletrônicos on-chip. Técnicas de processamento dedicadas ao GeSn foram desenvolvidas, incluindo epitaxia, recozimento, implantação de íons e corrosão. Neste trabalho, microdiscos GeSn suspensos, relaxados de tensão e de alta qualidade são realizados por uma nova abordagem sem qualquer ataque à liga GeSn. A liga GeSn foi cultivada em substrato Ge (001) pré-padronizado por epitaxia de feixe molecular em baixas temperaturas. A microscopia eletrônica de transmissão e a microscopia eletrônica de varredura foram realizadas para determinar as microestruturas das amostras de GeSn. Os microdiscos com diferentes diâmetros de pedestais de Ge foram fabricados controlando o tempo de corrosão úmida seletiva, e os resultados de micro-Raman mostram que os microdiscos com diferentes dimensões dos pedestais de Ge restantes têm diferentes extensões de relaxamento de deformação. A tensão compressiva dos microdiscos é quase completamente relaxada sob condições adequadas. A tecnologia de processamento de semicondutor apresentada neste trabalho pode ser um método alternativo para fabricar GeSn inovador e outros materiais baseados em micro / nanoestruturas para uma gama de fotônica compatível com Si, 3D-MOSFETs e aplicações de dispositivos microeletromecânicos.
Introdução
Germânio-estanho (GeSn), um material do grupo IV compatível com semicondutor de óxido metálico complementar (CMOS), tem atraído atenção significativa nos últimos anos por suas aplicações em eletrônica e optoeletrônica. Ligar mais Sn em Ge pode melhorar a mobilidade da portadora, bem como alterar o bandgap de transição indireta para direta [1, 2]. Trabalhos teóricos [3,4,5] e estudos de experimentos baseados em fotoluminescência [6,7,8] mostram que a transição indireta para direta para liga GeSn relaxada ocorre em teor de Sn não inferior a 6,5%. No entanto, a baixa (1%) solubilidade de equilíbrio de Sn em Ge [9, 10] e a grande incompatibilidade de rede (~ 15%) entre Ge e α-Sn apresentam enormes desafios para a realização de liga GeSn livre de defeitos com até mesmo um poucos% atômicos de Sn substitucional. O uso de técnicas de crescimento de desequilíbrio, como epitaxia de feixe molecular de baixa temperatura (MBE) [11,12,13,14,15], deposição de vapor químico (CVD) [16,17,18,19,20] e a epitaxia em fase sólida [21, 22] é muito necessária.
No caso da liga GeSn cultivada em substrato virtual Ge relaxado de tensão ou substrato Ge, espera-se que a mais alta qualidade de GeSn seja alcançada na condição pseudomórfica ou totalmente deformada que pode evitar a formação de desajustes e deslocamentos de rosca. No entanto, essa liga de GeSn é comprimida (~ 0,15% por 1% Sn) e esta deformação induzida por epitaxi nega o efeito da liga de Sn com Ge para a conversão de bandgap. Como resultado, um conteúdo de Sn muito mais alto de 17% para epi-camada de GeSn pseudomórfico em Ge (001) [23] é necessário para atingir o bandgap direto, levando a desafios extremamente elevados para epitaxia e baixa qualidade do material. Portanto, a manipulação da deformação sem sacrificar a qualidade do cristal das epi-camadas de GeSn torna-se uma questão muito importante. A remoção seletiva do substrato virtual de Ge indutor de tensão ou substrato de Ge sob as epi-camadas de GeSn para formar microestruturas parcialmente suspensas é uma técnica promissora para superar a deformação compressiva nos filmes de GeSn. Por exemplo, microdiscos suspensos de GeSn com um pilar de suporte no centro foram fabricados [24,25,26,27,28]. A estrutura pode não apenas relaxar a deformação compressiva na camada GeSn através da deformação elástica nas superfícies livres, mas também confinar modelos ópticos perto da borda do microdisco devido ao forte contraste do índice de refração entre o GeSn e o meio circundante (ar), como sussurro -galeria-modo [16, 25]. Até agora, apenas um método para preparar microdisco GeSn através da litografia óptica pós-crescimento e gravação de cima para baixo do filme GeSn bidimensional é relatado [16, 24, 29, 30]. No entanto, o processo pode sofrer efeitos de incompatibilidade térmica durante o processo de corrosão pós-crescimento, o que levará a uma degradação da qualidade do material dos microdiscos GeSn. Recentemente, P.Ponath et al. relatou o crescimento de área seletiva de c altamente cristalino -eixo orientado BTO [31], que nos inspirou para a fabricação de microestruturas GeSn. Depositando microdiscos GeSn diretamente na última etapa em um SiO pré-padronizado 2 / Substrato Ge e, em seguida, atacar seletivamente o substrato Ge seguindo o SiO sacrificial 2 Com remoção de camada, microdiscos suspensos de GeSn podem ser fabricados sem o processo convencional e complexo de corrosão pós-crescimento. Tal método, se viável, pode evitar os problemas acima mencionados e, assim, obter uma microestrutura GeSn de qualidade superior e relaxada de deformação. Além disso, é também um método muito promissor que pode atingir padrões arbitrários com alta precisão e uma boa relação de aspecto, especialmente para integração tridimensional de estruturas de dispositivos complexos que precisam de um controle exato da espessura das camadas.
Neste artigo, estruturas de microdisco GeSn foram fabricadas com sucesso por um novo método. É a primeira vez que se prepara microdiscos GeSn combinando o crescimento epitaxial seletivo com uma etapa simples de corrosão úmida seletiva. A espessura, a concentração de Sn e a qualidade do cristal da epi-camada de GeSn foram caracterizadas por microscopia eletrônica de transmissão de alta resolução (HRTEM) e espectrometria de massa de íons secundários (SIMS). Microscopia eletrônica de varredura (SEM) e espectroscopia micro-Raman (μ-Raman) foram usadas para obter informações sobre as microestruturas dos microdiscos fabricados de GeSn. Os resultados do µ-Raman em temperatura ambiente (RT) mostram que os microdiscos com diferentes dimensões dos pedestais de Ge restantes têm diferentes extensões de relaxamento de deformação. A tensão compressiva dos microdiscos é quase completamente relaxada sob condições adequadas. Este método para fabricar microdiscos sem a necessidade de gravar o próprio GeSn é benéfico para obter GeSn relaxado e de alta qualidade e outras nanoestruturas de materiais.
Métodos
Materiais
Os wafers de Ge foram adquiridos da empresa AXT. Acetona, álcool isopropílico, ácido fluorídrico, álcool etílico, peróxido de hidrogênio, amônia aquosa e hidróxido de potássio foram fornecidos pela Sinopharm Chemical Reagent (China). H desionizado 2 O (18,2 MΩ · cm) foi obtido a partir de um sistema de ultrafiltração (Milli-Q, Millipore, Marlborough, MA).
Preparação do substrato ge padronizado
Bolachas de Ge (001) (tipo n, 0,025–0,031 Ωcm) foram primeiro imersas em acetona e álcool isopropílico por 3 min e, em seguida, limpas quimicamente usando uma solução diluída de ácido fluorídrico (HF:H 2 O =1:20) por 20 s em temperatura ambiente. Isso foi seguido por um enxágue em execução de H 2 desionizado O (DI – H 2 O). O procedimento de limpeza é importante, especialmente o tratamento de HF para remover a camada de óxido nativo e garantir que a superfície Ge esteja limpa e em contato próximo com o próximo SiO 2 camada. Neste caso, o perfil de decolagem é obtido pela deposição de um Si / SiO 2 camada composta. Em seguida, as bolachas foram secas soprando N 2 e rapidamente carregado na câmara de ultra-alto vácuo (UHV) de deposição química de vapor aprimorada por plasma (PECVD) e recozido a 300 ° C por 20 min para liberar completamente o gás. Em seguida, um SiO 2 de 300 nm camada foi depositada na mesma temperatura por PECVD seguido por uma deposição de 50 nm de Si policristalino não dopado por pulverização catódica magnetron em TA, como mostrado na Fig. 1a. Aberturas circulares no Si / SiO 2 camada composta são padronizados usando técnica de fotolitografia padrão (Fig. 1b) e processos de gravação em duas etapas (Fig. 1c, d).
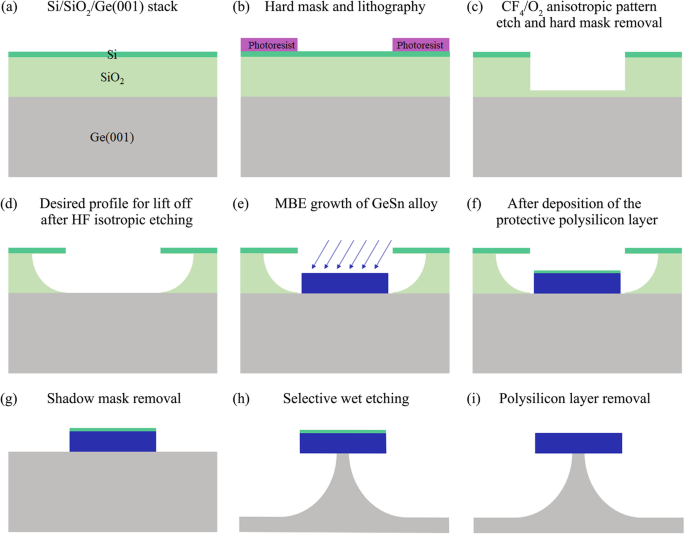
A ilustração esquemática em corte transversal para a fabricação dos microdiscos suspensos GeSn
Em detalhes, antes de padronizar o Si / SiO 2 / Ge wafer, o wafer foi limpo com acetona, álcool etílico e DI-H 2 O, depois seque com N 2 e pré-cozido no forno a 90 ° C. Posteriormente, foi revestido por spin-coating por fotoresiste AZ5214 usando um spin-coater a uma velocidade de 4000 r / min por 30 s e então colocado em uma placa de aquecimento para cozimento macio a 90 ° C por 2 min. A máquina de fazer placas (Heidelberg, uPG501) foi então utilizada para criar matrizes de padrão em forma de círculo no Si / SiO 2 / Pilhas Ge. Os padrões circulares são fixados a 5 μm de distância um do outro, enquanto o diâmetro varia de 3 a 5 μm. Os padrões foram então transferidos para o SiO inferior 2 camada por gravação em duas etapas. A corrosão anisotrópica seca por corrosão iônica reativa com uma mistura de gás de CF 4 e O 2 foi inicialmente empregado para gravar Si / SiO 2 camadas e interrompido com cerca de 20 nm SiO 2 deixou. Em seguida, a dissolução do fotorresiste e a corrosão úmida usando HF diluído à temperatura ambiente foi contratado para remover o SiO esquerdo 2 camada para expor o germânio nas aberturas circulares e também para gravar lateralmente sob a borda de polissilício definida para criar uma saliência que é o perfil desejado para decolagem.
Crescimento GeSn e Fabricação de Microdisco
Para a deposição de filme fino GeSn, um sistema MBE de fonte sólida (Riber SSC) com uma pressão de base de 2 × 10 −10 Torr foi usado [32]. Um evaporador de feixe de elétrons e uma célula de efusão BN pirolítica usando fontes sólidas de alta pureza são equipados para evaporação de Ge e Sn no sistema MBE. Um monitor de cristal de quartzo foi usado para calibrar a taxa de deposição. Antes de carregar os substratos padronizados no sistema UHV, os substratos foram limpos por O 2 plasma para remover qualquer resíduo orgânico induzido por corrosão seca. Seguido por enxágue em acetona, álcool isopropílico e HF diluído, os substratos foram transferidos para a câmara MBE para o crescimento de GeSn. Após a dessorção térmica a 450 ° C por 15 min, os substratos foram resfriados in situ a 150 ° C para o crescimento da camada de liga GeSn com uma taxa de crescimento Ge de 0,5 Å s −1 e um fluxo de Sn controlado como fonte de contaminação. Esta temperatura de crescimento é baixa o suficiente para conter de forma eficiente a segregação da superfície Sn. Para evitar a oxidação, a camada de capa Ge de 10 nm foi finalmente depositada na mesma temperatura.
Após o crescimento, ligas de GeSn com concentração nominal de Sn de 4% e 10% serão utilizadas para a fabricação de microdiscos. Uma camada adicional de polissilício de 30 nm de espessura foi então depositada no topo das amostras em RT usando magnetron sputtering para proteger a camada de GeSn do ataque seguinte. Então, o sacrificial SiO 2 A camada foi removida com HF diluído (1:1), o que também leva à remoção da camada de polissilício sobreposta e do filme GeSn depositado sobre ela. Como pode ser visto na Fig. 2, mesas circulares isoladas de GeSn foram reveladas após o SiO 2 camada foi removida. No entanto, a periferia da mesa circular não é tão lisa, o que é ruim para efeitos de confinamento óptico. A situação inesperada é causada pela deposição de GeSn na borda do SiO inferior 2 camada que surge da corrosão lateral insuficiente do SiO inferior 2 e a deposição do ângulo fora do normal (30 °). Posteriormente, uma etapa simples de corrosão úmida seletiva corta as mesas circulares em RT, resultando em estruturas de microdisco GeSn suspensas. O condicionador seletivo (APM) compreende H 2 O 2 (31% em peso), NH 4 OH (28% em peso) e DI-H 2 O com uma proporção de volume de 2:0,5:80 [30]. Finalmente, a camada superior de polissilício de proteção foi removida por KOH. Um esquema das etapas do processo é mostrado na Fig. 1e – i.
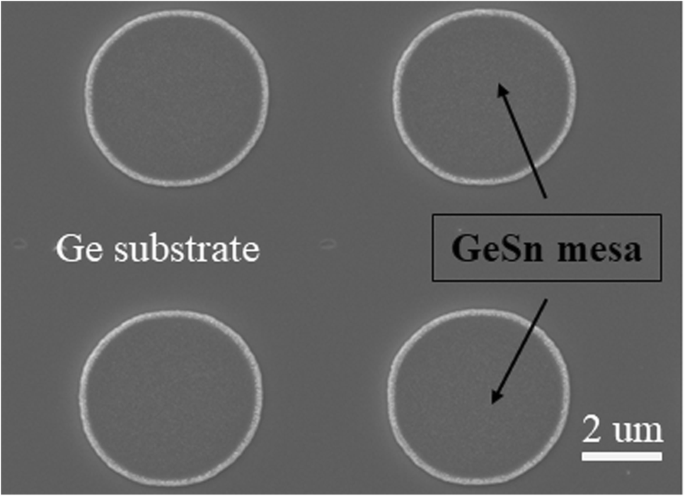
Imagem de vista superior SEM de mesas circulares de GeSn de 5 μm de diâmetro isoladas após a remoção da máscara de sombra
Em nosso método para fabricar microdiscos GeSn, a corrosão úmida seletiva final é importante devido às diferentes taxas de corrosão para os materiais GeSn com diferentes concentrações de Sn. A seletividade etch de Ge sobre Ge 1 − x Sn x também irá variar com a concentração de Sn. Quanto maior for a concentração de Sn em GeSn, maior será a cobertura da superfície de SnO y será desenvolvido [33]. Isso reduzirá a taxa de corrosão úmida de GeSn e levará a uma maior seletividade de corrosão de Ge sobre GeSn. O estudo anterior relatou que o H 2 O 2 corrosão úmida com base (H 2 O 2 :NH 4 OH:H 2 O =2:0,5:80), o mesmo com este trabalho, atinge uma seletividade de Ge sobre Ge 0,928 Sn 0,072 de 9:1 [30].
Resultados e discussão
A Figura 3a mostra a micrografia TEM em corte transversal da mesa circular GeSn de 5 μm de diâmetro sem a camada superior de polissilício. A Figura 3b, c são as micrografias TEM de alta resolução (HRTEM) para as regiões A e B, correspondendo à interface GeSn / Ge e à região intermediária da camada GeSn, respectivamente. A espessura do filme da camada GeSn é cerca de 250 nm (Fig. 3a) abaixo da espessura da máscara de sombra. Como pode ser visto na Fig. 3b, os defeitos estão localizados principalmente na interface GeSn / Ge de 30 nm de espessura, resultando no seguinte crescimento de GeSn de cristal único. A imagem HRTEM da região B mostra franjas de rede claras da camada GeSn, indicando que a liga é altamente cristalina e o padrão de transformação rápida de Fourier (FFT) da região B corresponde ao padrão de difração de GeSn, como mostrado na Fig. 3c. Além disso, para confirmar a concentração de Sn da liga GeSn, a medição SIMS foi concluída como mostrado no detalhe da Fig.3a. A concentração de Sn é de 9,8 ± 0,5%, consistente com o valor nominal de cerca de 10%. Além disso, a distribuição dos átomos de Sn é muito uniforme no perfil de profundidade do filme GeSn conforme crescido.
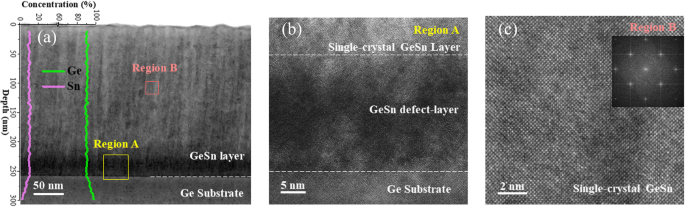
a Imagem TEM em corte transversal da mesa circular GeSn de 5 μm de diâmetro sem camada superior de polissilício. Detalhe:perfil de profundidade SIMS da camada GeSn. b Imagem TEM de alta resolução da interface GeSn / Ge (região A). c Imagem TEM de alta resolução para a região intermediária da camada GeSn (região B). Inserção:padrão FFT da região B
A estrutura da superfície das amostras foi estudada por MEV. A Figura 4a mostra a imagem SEM de vista superior do Ge 0,96 de 5 μm de diâmetro Sn 0,04 mesas circulares após 510 s de corrosão úmida seletiva por solução APM em RT. Deve-se mencionar que os condicionadores são preparados logo antes dos experimentos para evitar os efeitos do envelhecimento dos produtos químicos. A imagem SEM indica que não apenas o substrato Ge, mas também uma parte da mesa GeSn estão gravadas. A falha em formar uma estrutura de disco para Ge 0,96 Sn 0,04 liga é devido à baixa concentração de Sn que resulta na baixa seletividade de Ge sobre GeSn. Em contraste com o Ge 0,96 Sn 0,04 amostras, a amostra de mesa circular GeSn de 5 μm de diâmetro com maior concentração de Sn de 9,8% também foi atacada por APM em RT. Conforme mostrado na Fig. 4b, c. c, as estruturas do microdisco foram formadas com sucesso para Ge 0,902 Sn 0,098 liga após a corrosão úmida de 510 s. Anteriormente, Han et al. [30] relataram que eles fabricaram Ge 0,928 parcialmente suspenso Sn 0,072 microdiscos (5 μm de dimensão) com cerca de 1,2 μm de redução usando o H 2 O 2 decapagem úmida com base em uma seletividade de 7:1. No entanto, após a corrosão úmida seletiva, as bordas de seu disco tornam-se dobradas e fraturadas por causa de fortes forças capilares de atração desenvolvidas entre a estrutura suspensa e o substrato conforme o líquido decapante é removido, o que puxa a estrutura do microdisco liberado para o contato com o substrato [ 24]. Mas este fenômeno não ocorre em nossos experimentos, mesmo prolongando a corrosão seletiva para remover quase completamente o pedestal Ge embaixo. Isso pode ser explicado pela maior seletividade de corrosão e a camada GeSn mais espessa de cerca de 250 nm. Curiosamente, os pedestais mostram facetas inesperadas com orientações diferentes que podem ser causadas pela taxa de corrosão lateral dependente da orientação durante o processo de corrosão úmida seletiva.
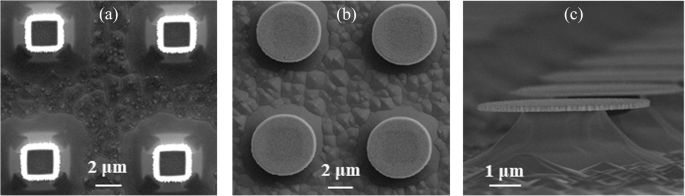
Imagens SEM após corrosão úmida seletiva. a 5 μm de diâmetro Ge 0,96 Sn 0,04 mesas circulares após a gravação de 510 s. b , c 5 μm de diâmetro Ge 0,902 Sn 0,098 mesas circulares após a gravação de 510 s
Além disso, os microdiscos com pedestais Ge de diferentes diâmetros foram fabricados controlando o tempo de corrosão seletivo. A Figura 5a mostra o diâmetro do pedestal Ge remanescente em função do tempo de corrosão no APM. As barras de erro representam o desvio padrão dos dados de cinco microdiscos diferentes na mesma amostra. A tendência de linha semelhante indica que a taxa de corrosão de Ge é aproximadamente igual para Ge 0,902 Sn 0,098 discos com diâmetros diferentes de 3 μm e 5 μm, e está de acordo com o valor da taxa de corrosão da Ref. [30]. Além disso, o diâmetro mínimo do pedestal Ge para o microdisco GeSn em pé é de cerca de 300 nm. Os microdiscos suspensos GeSn serão puxados para baixo pelas fortes forças capilares de atração se os pedestais de Ge ficarem menores.
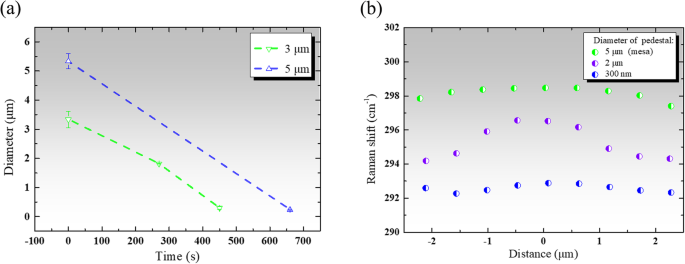
a O diâmetro do pedestal Ge em função do tempo de corrosão úmida seletiva para diâmetros de 3 μm (linha tracejada verde) e 5 μm (linha tracejada azul) Ge 0,902 Sn 0,098 discos. b Medições de varredura de linha de deslocamento Raman realizadas ao longo do diâmetro de 5 μm Ge 0,902 Sn 0,098 mesa (ponto verde) e microdiscos com pedestal Ge de 2 μm de diâmetro (ponto roxo) e pedestal Ge de 300 nm de diâmetro (ponto azul)
A fim de investigar a distribuição da deformação elástica dos microdiscos GeSn, μ-Raman foi realizado em RT em discos de 5 μm de diâmetro, usando um laser de 633 nm para excitação com um tamanho de ponto de cerca de 600 nm. A potência do laser é de apenas 1% da potência máxima (15 mw) para minimizar os efeitos térmicos [34], e a profundidade de penetração do laser de excitação nos filmes GeSn é de aproximadamente 50 nm [26]. O deslocamento Raman foi medido ajustando os espectros com funções Lorentzianas.
A Figura 5b mostra as varreduras de linha Raman unidimensionais para Ge 0,902 Sn 0,098 microestruturas. É claramente observado (1) para a mesa de 5 μm de diâmetro sem corte inferior, o pico Raman associado ao modo de fônon Ge-Ge LO muda sem evidência em direção aos números de onda mais baixos do centro para a borda da mesa, e o grande deslocamento Raman indica que há uma grande deformação compressiva na mesa GeSn; (2) para o microdisco de 5 μm de diâmetro com pedestal Ge de 2 μm de diâmetro, o pico Raman associado ao modo de fônon Ge-Ge LO muda obviamente para números de onda mais baixos do centro para a borda do disco, revelando um gradiente de tensão devido à ancoragem para o pedestal Ge comparativamente grande. E o microdisco GeSn de 5 μm com pedestal de 2 μm de diâmetro ainda mantém em sua periferia uma certa tensão de compressão; (3) as posições de pico Ge-Ge medidas ao longo do diâmetro de 5 μm Ge 0,902 Sn 0,098 microdisco com pedestal Ge de 300 nm de diâmetro permanece consistente e tem um deslocamento Raman reduzido óbvio. Portanto, espera-se que os discos com pedestais estreitos de Ge (cerca de 300 nm de diâmetro) estejam totalmente relaxados.
Na Fig. 6, apresentamos o espectro de espalhamento Raman típico de 5 μm de diâmetro Ge 0,902 Sn 0,098 microdisco com pedestal Ge de 300 nm de diâmetro. Para os discos, os espectros Raman mostram um pico assimétrico a uma frequência de 292,4 cm −1 correspondente ao modo Ge-Ge LO. Os espectros Raman registrados para a mesa de 5 μm de diâmetro e o substrato Ge (001) em massa de referência também são plotados para comparação. Observe que após o corte inferior, limpe o deslocamento Raman (- 6,3 cm −1 ) do pico Ge-Ge pode ser observado para microdiscos Sn de 9,8%, uma vez que a mudança de frequência Raman em ligas semicondutoras é influenciada principalmente pela deformação e composição. Estudos Raman anteriores [33, 35,36,37] mostraram que o deslocamento Raman do modo de fônon Ge-Ge LO em GeSn pode ser expresso como uma função da concentração de Sn x Sn e a deformação biaxial no plano ε ∥ seguinte Eq. (1):

Comparação dos espectros Raman de 5 μm Ge 0,902 Sn 0,098 microdisco com pedestal Ge de 300 nm de diâmetro, 5 μm Ge 0,902 Sn 0,098 diâmetro mesa e um substrato Ge em massa como uma referência. Detalhe:visão ampliada dos espectros Raman. Os picos Ge-Sn também podem ser observados em torno de 260 cm −1 , e deslocar para baixo com a diminuição do diâmetro dos pedestais Ge
$$ \ Delta \ omega ={\ omega} _ {\ mathrm {Ge} \ mathrm {Sn}} - {\ omega} _ {\ mathrm {Ge}} =\ mathrm {A} \ cdotp {x} _ { \ mathrm {Sn}} + \ mathrm {B} \ cdotp {\ varepsilon} _ {\ parallel} $$ (1)
onde ω GeSn e ω Ge são a posição de pico do modo de fônon Ge-Ge LO em GeSn e em Ge em massa, respectivamente, enquanto A e B são coeficientes.
Os picos Ge-Ge LO Raman para a mesa e os discos mostram o deslocamento de - 1,4 cm −1 e - 7,7 cm −1 em comparação com o pico Ge em massa (300,1 cm −1 ) Tomando os coeficientes de resultados experimentais anteriores [37], o valor da coloração biaxial no plano ε ∥ é calculado em -1,18% para o GeSn mesa conforme crescido. Para os microdiscos fabricados, a coloração biaxial no plano ε ∥ é aproximadamente igual a 0, confirmando o relaxamento quase total da deformação dos microdiscos. De acordo com o cálculo teórico recente de Ge 1- x Sn x estrutura de banda eletrônica [38], o Ge conforme crescido 0,902 Sn 0,098 camada é um material bandgap indireto com energia bandgap de cerca de 0,56 eV, enquanto o Ge totalmente relaxado 0,902 Sn 0,098 microdisco é um material bandgap direto com energia de bandgap de 0,50 eV.
Conclusões
Em conclusão, os microdiscos GeSn foram fabricados com sucesso combinando o crescimento epitaxial seletivo com o processo de corrosão úmida seletiva. HRTEM e SEM foram realizados para confirmar que a liga GeSn é altamente cristalina e que a estrutura do microdisco GeSn é facilmente formada por uma simples corrosão úmida seletiva. As medições μ-Raman revelam que o relaxamento de tensão do microdisco GeSn será maior com a diminuição do diâmetro do pedestal Ge devido à restrição mecânica simultaneamente decrescente do pedestal Ge menor. E, finalmente, os microdiscos GeSn de alta qualidade e com relaxamento total de deformação foram obtidos por esse método mais econômico. O processo de fabricação também é um método muito promissor para atingir tamanhos menores de GeSn mesa até que o efeito do tamanho quântico lateral se torne importante, e para obter outras nanoestruturas GeSn, como pontos quânticos GeSn, nanomesh GeSn e nanofios GeSn para futuros fotônicos e eletrônicos compatíveis com Si aplicativos do dispositivo.
Disponibilidade de dados e materiais
Os dados que suportam as conclusões deste trabalho estão disponíveis com o autor para correspondência, mediante solicitação razoável.
Abreviações
- APM:
-
Mistura de peróxido de amônia (condicionador úmido)
- FFT:
-
Transformação rápida de Fourier
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- MBE:
-
Epitaxia de feixe molecular
- PECVD:
-
Deposição de vapor químico intensificada por plasma
- RT:
-
Temperatura do quarto
- SEM:
-
Microscopia eletrônica de varredura
- SIMS:
-
Espectrometria de massa de íon secundário
- μ-Raman:
-
Espectroscopia Micro-Raman
Nanomateriais
- Classe abstrata Java e métodos abstratos
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- Fabricação de filmes finos SrGe2 em substratos Ge (100), (110) e (111)
- Fabricação, Caracterização e Atividade Biológica de Sistemas de Nanotransmissão de Avermectina com Diferentes Tamanhos de Partículas
- Avanços recentes em métodos sintéticos e aplicações de nanoestruturas de prata
- Fabricação e caracterização de Nano-Clips de ZnO pelo processo mediado por poliol
- Fabricação de nanofibras helicoidais CA / TPU e sua análise de mecanismo
- Fabricação e propriedade fotocatalítica de novos nanocompósitos SrTiO3 / Bi5O7I
- Compreendendo o mecanismo de crescimento de camadas epitaxiais de GaN em grafite esfoliado mecanicamente
- Gravação a Laser e Gravação a Laser



