Crescimento e corrosão seletiva de estruturas multicamadas de silício / silício-germânio dopadas com fósforo para aplicação de transistores verticais
Resumo
Os transistores de efeito de campo gate-all-around (vGAAFETs) são considerados candidatos potenciais para substituir os FinFETs por tecnologia avançada de fabricação de circuitos integrados em / além do nó de tecnologia de 3 nm. Uma multicamada (ML) de Si / SiGe / Si é comumente cultivada e processada para formar transistores verticais. Neste trabalho, a incorporação de P em Si / SiGe / Si e ataque vertical desses MLs seguido por ataque seletivo SiGe na direção lateral para formar estruturas para vGAAFET foram estudados. Várias estratégias foram propostas para a epitaxia, como purga de hidrogênio para esgotar o acesso de átomos de P na superfície de Si e / ou inserir um Si ou Si 0,93 Ge 0,07 espaçadores em ambos os lados das camadas de Si dopadas com P, e substituindo SiH 4 por SiH 2 Cl 2 (DCS). Os resultados experimentais mostraram que a segregação e a autodopagem também poderiam ser aliviadas pela adição de 7% de Ge ao Si dopado com P. A estrutura tinha boa qualidade de rede e quase não teve relaxamento de deformação. A corrosão seletiva entre Si dopado com P (ou Si dopado com P 0,93 Ge 0,07 ) e o SiGe também foi discutido usando corrosão úmida e seca. O desempenho e a seletividade de diferentes métodos de corrosão também foram comparados. Este artigo fornece conhecimento de como lidar com os desafios ou dificuldades da epitaxia e da corrosão de camadas do tipo n na estrutura vertical de GAAFETs.
Introdução
À medida que o dimensionamento do semicondutor de óxido de metal complementar (CMOS) atinge sua limitação física, os efeitos de canal curto enfraquecem significativamente o desempenho do transistor. Uma solução para esses problemas são os novos projetos de transistores, por exemplo, GAAFETs (transistores de efeito de campo gate-all-around), que também é considerado o candidato mais promissor para transistores em nanoescala até o nó de tecnologia de 3 nm [1,2,3 , 4,5,6]. Nanofios / nanofolhas laterais e verticais são estruturas principais de acordo com o International Roadmap for Device and Systems (IRDS) 2020 para substituir FinFETs [7]. GAAFETs verticais (ou vGAAFETs) têm design de flexibilidade livre no comprimento da porta e têm grande potencial para aumentar a densidade integrada [4, 8]. Existem duas categorias principais para implementar estruturas verticais de nanofios:ascendente e descendente. O método bottom-up introduziu catalisador metálico, o que pode trazer problemas de compatibilidade de processo [9, 10]. O método top-down é o principal na indústria por causa de seu melhor controle da configuração de nanofios e sua compatibilidade com FinFET [4, 11,12,13,14]. O método de cima para baixo para fabricar GAAFETs verticais atrai muita atenção. Portão de autoalinhamento com controle preciso do comprimento do portão foi uma questão crucial [15, 16]. Para alcançar um melhor controle de comprimento de porta eficaz ou reduzir a variação, o comprimento de porta pode ser determinado principalmente pela espessura do material do canal epitaxialmente crescido em uma superfície plana inferior, como Si / SiGe / Si, e SiGe era o material do canal [17, 18,19,20]. Além disso, outro desafio crítico de integração reside na dopagem entre o canal e as regiões S / D [16, 20, 21], especialmente com o controle de junção nítida [20]. Comparado com o processo tradicional de implantação de fonte / dreno, o processo epitaxy simplifica o processo de fabricação, reduz os danos à superfície e atinge um perfil de dopagem uniforme. No entanto, a estrutura de sanduíche de Si dopado com P / SiGe / Si dopado com P é difícil de crescer epitaxialmente devido à segregação, autodopagem e fenômenos de difusão externa dos dopantes tipo n mais comuns, fósforo [22, 23], arsênio [24, 25] e / ou antimônio [26, 27] na interface Si / SiGe em sistemas de deposição química de vapor (CVD). Portanto, os átomos doadores segregados reunidos na interface Si / SiGe e na camada de SiGe seriam dopados, o que pode degradar o desempenho do transistor com alto vazamento.
Uma estratégia para impedir a segregação do dopante é aplicar temperatura de crescimento muito baixa. Há uma série de relatórios que fazem muitos esforços para aumentar o doping do tipo n por epitaxia de feixe molecular (MBE) [28]; entretanto, este método não foi aplicado para CVD. O equipamento MBE é principalmente de design de chip único, exigindo alto vácuo e baixa taxa de transferência. Além disso, o equipamento MBE não é compatível com tamanhos de wafer acima de 8 polegadas na indústria. Portanto, a tecnologia MBE não é adequada para aplicações de produção em massa industrial. No entanto, o sistema RPCVD possui forte capacidade de produção e estrutura de equipamento simples, o que é adequado para a indústria de CI [29]. A primeira ideia para o crescimento do RPCVD é regular o fluxo de hidrogênio na câmara, uma vez que o hidrogênio é o gás portador e pode afetar a cinética dos gases precursores. Li et al . [23] relataram que o hidrogênio mudou a estrutura de ligação dos átomos hospedeiros na superfície e reduziu a energia de segregação aplicando baixa temperatura de crescimento no sistema CVD térmico rápido (RTCVD). No entanto, o efeito do hidrogênio não foi explorado na interface Si / SiGe no sistema CVD de pressão reduzida (RPCVD). Suvar et al . [30] inseriu camadas espaçadoras de Si não dopado de 30 nm entre Si dopado com P e SiGe para diminuir a concentração de P na interface por um fator de 4 (de 8 × 10 19 cm −3 para 2 × 10 19 cm −3 ), mas o pico de dopagem P não pode ser eliminado. Bennett et al . [31] estudaram o efeito da deformação na dopagem do tipo n em Si. A solubilidade sólida de dopagem foi aumentada pela introdução de tensão de tração em Si. Christensen et al . [32] não encontraram nenhuma dependência significativa da difusividade P no conteúdo de Ge em Si 1-x Ge x (0 ≤ x ≤ 0,22). E os coeficientes de difusão de P tiveram pouca diferença entre Si relaxado e SiGe deformado biaxialmente por compressão. Zangenberg et al . [33] observaram um aumento do coeficiente de difusão por um fator de 2 a 825 ° C para Si relaxado 0,88 Ge 0,12 .
Neste trabalho, vários métodos foram propostos para melhorar a incorporação de P no Si em uma multicamada de Si / SiGe / Si usando RPCVD. Nos experimentos, estratégias diferentes, como purga de hidrogênio, inserção de camadas espaçadoras não dopadas, mudança do precursor de Si de SiH 4 para SiH 2 Cl 2 (DCS), e modulando o perfil de deformação pela introdução de Si 0,93 Ge 0,07 camada sacrificial em ambos os lados da camada de SiGe foram apresentados. Além disso, a corrosão seletiva de SiGe foi discutida para formar uma camada fina de SiGe (pretendida como uma camada de canal) [6, 34]. As características de gravação de ferramentas de gravação úmida e seca também foram comparadas. A estrutura final deve ser usada para vGAAFETs para nó de tecnologia abaixo de 10 nm no futuro.
Métodos
Multicamadas de Si / SiGe / Si (MLs) foram cultivadas em pastilhas de Si <100> de 200 mm com equipamento RPCVD (ASM Epsilon 2000). Os substratos de Si foram limpos com solução de mistura de H 2 SO 4 e H 2 O 2 , seguido por HF diluído para remover o óxido nativo antes de inserir nas travas de carga da câmara de epitaxi. As amostras foram limpas in situ por recozimento a 1050 ° C para remover o óxido nativo para obter uma superfície de Si de alta qualidade. Os precursores de Si, Ge e P foram SiH 4 (ou SiH 2 Cl 2 ), 10% GeH 4 em H 2 e 2% PH 3 em H 2 . A temperatura de crescimento foi de 650 ° C, enquanto a pressão da câmara foi mantida a 80 Torr durante a epitaxia. Em alguns experimentos, a pressão da câmara foi reduzida a 10 Torr para aumentar o Si dopado com P 0,93 Ge 0,07 camada nas regiões de fonte / dreno (S / D). O conteúdo de Ge no canal SiGe foi mantido constante em 0,22. Para estudar as características de ataque seletivo, nitreto de 50 nm / óxido de 30 nm foi depositado como máscara para proteger os MLs inferiores. Litografia e corrosão vertical anisotrópica seca foram realizadas para formar padrões cubóides separados. Experimentos seletivos de corrosão foram realizados com a ferramenta de corrosão úmida de HF (6%):H 2 O 2 (30%):CH 3 COOH (99,8%) =1:2:4 e ferramenta de gravação a seco de CF 4 :O 2 :He =4:1:5 [35].
Os MLs Si / SiGe / Si foram caracterizados pelas técnicas de microscopia eletrônica de transmissão de alta resolução (Thermo Scientific Talos F200) (HRTEM), espectroscopia de energia dispersiva de raios-X (EDX), difração de raios-X de alta resolução (HRXRD) e mapa de rede recíproca de alta resolução (HRRLM) da Bruker JV Delta-x, microscopia eletrônica de varredura (SEM) da Hitachi (Japão) e espectroscopia de massa de íons secundários (SIMS).
Resultados e discussão
Epitaxia de Si / SiGe / Si MLs dopados com P
Neste estudo, a incorporação de P em Si e SiGe foi inicialmente explorada. As estruturas ML são mostradas na Fig. 1a. Um ML de Si dopado com P / Si não dopado com aumento de PH 3 o fluxo cresceu e os perfis das camadas foram examinados por SIMS na Fig. 1b. A figura mostra que a concentração de P aumenta e atinge o nível mais alto de 2,6 × 10 19 cm −3 . Mais duas amostras com perfil de 'P-dopado Si / Si 0,72 Ge 0,28 Si dopado com / P e Si dopado com Si / P 0,72 Ge 0,28 / Si 'foram projetados e o perfil P é demonstrado na Fig. 1c, d, respectivamente. Na Fig. 1c, um empilhamento de P é observado nas interfaces de Si / Si dopado com P 0,72 Ge 0,28 multicamadas. O empilhamento interfacial de P aumenta com o aumento da concentração de P de baixo para cima nas multicamadas, e a concentração mais alta é 1,6 × 10 20 cm −3 , que é 6 vezes mais que a concentração na Fig. 1b (2.6 × 10 19 cm −3 ) Em Si dopado 0,72 Ge 0,28 camadas (Fig. 1d), as concentrações de P são notavelmente mais altas e não há picos na interface. Por causa do doping, a porcentagem de Ge é ligeiramente aumentada. Este comportamento está relacionado à adsorção aprimorada de SiH 4 e GeH 4 na presença de PH 3 . Além disso, devido à dopagem, as espessuras das camadas são diferentes entre as Fig. 1c, d, que possuem o mesmo tempo de crescimento. Isso significa que P-doping aumenta a taxa de crescimento de Si 0,72 Ge 0,28 camadas e a absorção de GeH 4 , enquanto a taxa de crescimento do Si é retardada devido à adsorção de P. Esses fenômenos são consistentes com o resultado relatado nas Refs. [36,37,38]. Do exposto, a segregação de P e o fenômeno de autodopagem são graves na interface Si / SiGe. O pico de dopagem P na interface Si / SiGe faz a dopagem não intencional na camada de SiGe. Uma vez que SiGe se destina a ser a camada de canal nos transistores, o perfil de dopagem não homogêneo ou altos níveis de dopagem de fundo limitariam as aplicações do dispositivo [39]. Vários métodos para eliminar o pico P seriam discutidos abaixo. Para uma melhor comparação, todas as camadas de SiGe são tensionadas e a taxa de fluxo de SiH 4 (SiH 2 Cl 2 ) e GeH 4 pois a camada de SiGe não foi alterada em todos os experimentos.
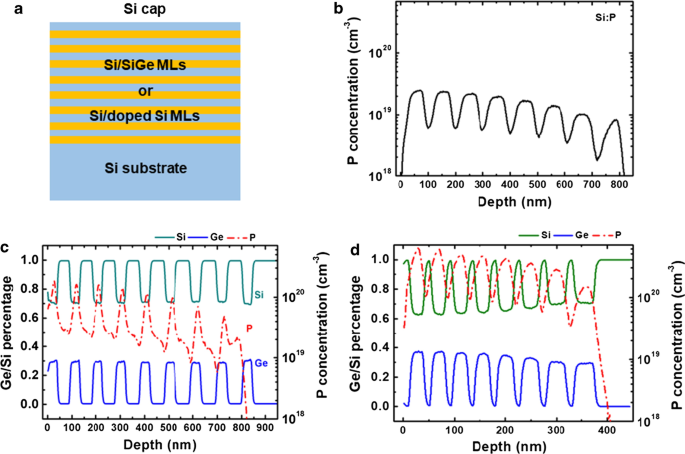
a Diagrama esquemático de Si / SiGe / Si MLs dopados com P. b Concentração de dopagem P de Si MLs dopados com Si / P não dopados. Porcentagem de Ge / Si e concentração de P de c Si não dopado 0,72 Ge 0,28 Si dopado com / P, d Si não dopado / Si dopado por P 0,72 Ge 0,28 MLs. Nenhuma purga e camada espaçadora não dopada foram consideradas
Impacto das camadas espaçadoras
Camadas espaçadoras de Si não dopadas foram inseridas entre a camada de Si dopada no fundo e a camada de SiGe não dopada para absorver o excesso de átomos de P. A Figura 2a mostra o diagrama esquemático da estrutura projetada e a Fig. 2b – d demonstra os resultados do perfil de espaçadores de Si integrados com espessura de (b) 3 nm, (c) 5 nm e (d) 10 nm. Os picos de empilhamento de P são reduzidos, enquanto a porcentagem de Si / Ge e a concentração de P nas camadas de Si são mantidas constantes como na Fig. 2b – d. O nível de empilhamento P é reduzido em 82%, de 4 × 10 19 cm −3 na Fig. 2b a 7 × 10 18 cm −3 na Fig. 2d, quando a espessura do espaçador X b aumentou de 3 para 10 nm. O aumento da espessura das camadas espaçadoras de Si não dopadas aumenta a absorção de átomos de P excessivos. Na Fig. 2d, a inclinação do perfil P em Si 0,86 Ge 0,14 A superfície / Si é de 15,9 nm / dec, enquanto que em Si / Si 0,86 Ge 0,14 interface a inclinação é 31,3 nm / dec. Enquanto isso, a camada espaçadora de Si muito espessa não é uma solução apropriada, uma vez que a resistência da folha aumenta. Portanto, um compromisso entre a resistência da folha e o não controlado do perfil P deve ser feito para os transistores. A Figura 2 revela também o impacto da camada espaçadora entre o Si / Si 0,86 Ge 0,14 camadas ( X b ) era diferente da camada entre o Si 0,86 Ge 0,14 / Si ( X t ) Na Fig. 2b, c, as espessuras do espaçador entre o Si 0,86 Ge 0,14 / Si foram 3 nm e 5 nm, enquanto na Fig. 2d, nenhuma camada espaçadora foi inserida. No entanto, a inclinação do perfil P no Si 0,86 Ge 0,14 / Si é o mesmo (cerca de 15,9 nm / dec), embora na Fig. 2d a camada espaçadora superior tenha sido removida, mas nenhuma influência no perfil de dopagem foi observada. A partir dos resultados acima, o pico P estava apenas no Si / Si 0,86 Ge 0,14 interface, possivelmente devido ao limite de solubilidade; o excesso de átomos de P pode formar dímeros de P – P na superfície e ser incorporados na camada de cobertura de SiGe. Além disso, há uma autodopagem de P durante o crescimento de SiGe após Si dopado com P. Portanto, os métodos para eliminar o excesso de átomos de P ou melhorar a solubilidade do Si têm sido procurados.
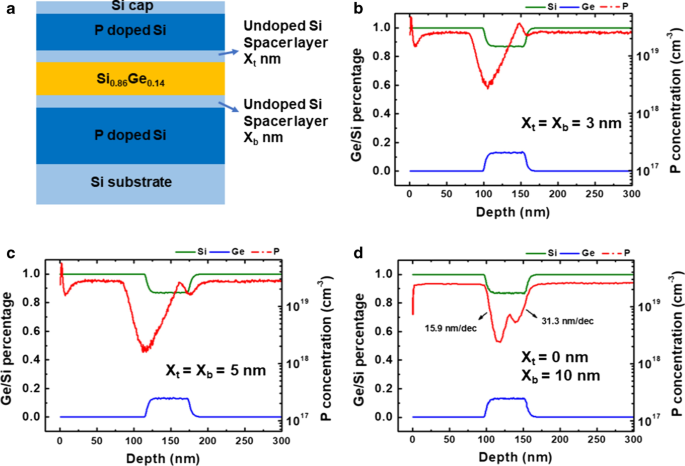
a O esquema de amostras experimentais com diferentes camadas espaçadoras não dopadas. E perfis de Ge, Si e P de Si / Si dopado com P 0,86 Ge 0,14 / MLs de Si dopados com P com camadas espaçadoras de Si não dopadas de b 3 nm, em ambas as interfaces, c 5 nm, em ambas as interfaces, d 10 nm, apenas em uma interface com Si 0,86 Ge 0,14
Impacto da purga de hidrogênio na interface de MLs de Si / SiGe / Si
Nesta seção, a camada espaçadora de Si foi fixada em 5 nm e a purga de hidrogênio foi introduzida para limpar o excesso de átomos de P após o crescimento de Si dopado com P. Pode ser visto na Fig. 3c, d que aumentar o fluxo de hidrogênio de 20 para 60 sccm e o tempo de purga de 2 para 10 min não tem efeito óbvio no pico P. A concentração de dopagem em Si é 3 × 10 19 cm −3 , que é igual ao discutido na seção “Impacto das camadas espaçadoras”. A concentração de pico de P na interface é a mesma com a concentração em Si da Fig. 3d. As espessuras das camadas são iguais em diferentes condições de purga. Os átomos de P não podem ser eliminados pelo hidrogênio; isso pode ser explicado pela formação de complexos P estáveis na superfície. Mudar parâmetros como temperatura, pressão, tempo de purga seria útil [24, 40], mas um tempo de purga muito longo não é adequado devido ao custo do tempo, e a alta temperatura (> 950 ° C) causa interdifusão de Si-Ge [41] .
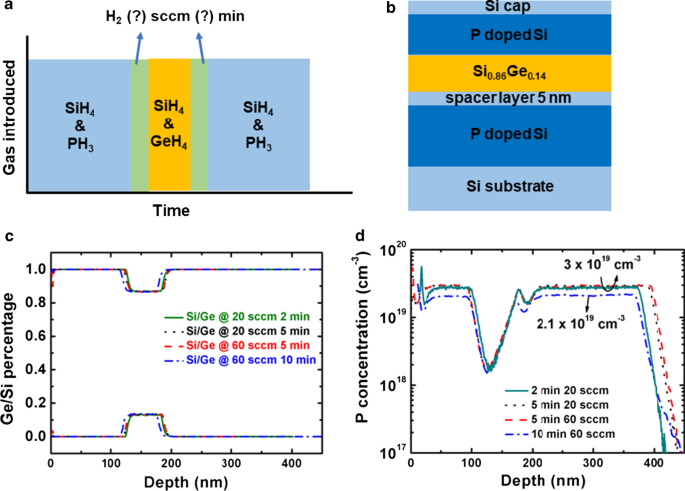
Diagramas esquemáticos de a estratégia de dopagem de H 2 condições de purga e b estrutura experimental de Si / SiGe / Si MLs. c Perfil Ge / Si e d Concentração de P de Si / Si dopado com P 0,86 Ge 0,14 / Si MLs dopados com P
Impacto da química do crescimento na incorporação de P
Nestes experimentos, o precursor Si, SiH 4 , foi substituído por SiH 2 Cl 2 (DCS). Nessas amostras, os parâmetros de crescimento foram os mesmos de antes, as estruturas contêm camada espaçadora de Si de 5 nm e o tempo de purga é de 5 min com fluxo de 60 sccm. A ideia por trás é investigar se a química baseada em Cl poderia limpar o excesso de átomos de P pela superfície de Si e as reações de P-Cl, Si-Cl ou Ge-Cl poderiam acontecer [42]. Na Fig. 4, a concentração de pico P reduz por um fator de 2 (de 2,6 × 10 19 cm −3 para 1,3 × 10 19 cm −3 ), e as concentrações de P nas camadas de Si são 2,6 × 10 19 cm −3 . O conteúdo estimado de Ge é de 30%, que é maior do que SiGe com SiH 4 . O maior teor de Ge demonstra que o Cl removeu preferencialmente os átomos de Si nas reações de superfície. Este resultado também pode ser explicado pela relação diferente da razão de fluxo de gás e concentração de Ge com SiH 4 e SiH 2 Cl 2 precursores gasosos [32, 43]. Outra explicação foi que os átomos de Ge aumentaram a dessorção de hidrogênio, aumentando então os locais de nucleação livres [44]. O declive da concentração de P do Si 0,7 Ge 0.3 A interface / Si era de 13,2 nm / dec, um pouco mais nítida do que Si 0,86 Ge 0,14 Interface / Si (15,9 nm / dec). A inclinação do perfil P no Si / Si 0,7 Ge 0.3 interface era de 20 nm / dec. Portanto, introduzindo mais HCl ou aumentando a proporção de gás de SiH 2 Cl 2 e GeH 4 , os átomos de P segregados na superfície de Si dopado podem ser atacados por HCl para formar dímeros de P-Cl e a concentração de pico de P em Si / SiGe pode ser inferior [38, 45].
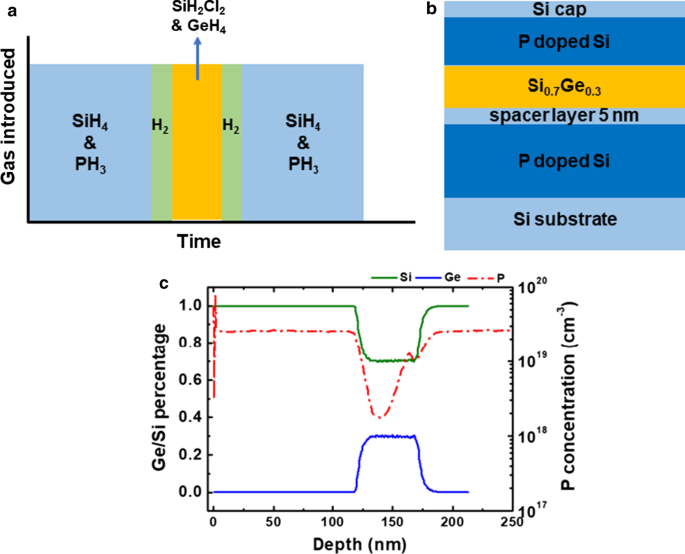
Diagramas esquemáticos de a estratégia de doping para mudar a química do crescimento, b estrutura experimental de Si / SiGe / Si MLs. A camada de SiGe foi cultivada com DCS. O tempo de purga foi de 5 min com fluxo de 60 sccm após Si dopado. A camada espaçadora de Si não dopado era de 5 nm entre o Si dopado no fundo e o SiGe não dopado. c Perfil Ge / Si e concentração de P de Si / Si dopado com P 0,7 Ge 0.3 / Si MLs dopados com P
Impacto do conteúdo ge no perfil P
Como discutimos antes, a incorporação de P em SiGe foi notavelmente maior do que em Si. Portanto, isso pode levantar a ideia de adicionar algumas porcentagens de Ge (7%) em espaçadores de Si (5 nm) poderia melhorar a incorporação de P no Si. É importante mencionar aqui que nosso propósito não é alterar significativamente o caráter do Si dopado com P, mas impedir a segregação do P no Si. Nessas amostras, a pressão da câmara foi reduzida para 10 Torr durante o crescimento das camadas espaçadoras. A taxa de crescimento dependente de dopagem e a porcentagem de Ge seriam importantes nesta condição. Da Fig. 5b, as camadas superior e inferior eram 110 nm Si 0,93 Ge 0,07 com concentração de P de 1 × 10 20 cm −3 , a camada do meio tinha 40 nm de Si 0,78 Ge 0,22 com concentração de P de 3,5 × 10 19 cm −3 . O declive da concentração de P de Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 foi de cerca de 33 nm / dec. A inclinação não era acentuada porque a diferença percentual Ge entre as duas camadas não era grande o suficiente. Na Fig. 5d, três camadas de Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 Si dopado com / P 0,93 Ge 0,07 MLs foi crescido para verificar a uniformidade de dopagem, e seu diagrama de estrutura foi mostrado na Fig. 5c. Observa-se que, da camada inferior para a superior, a concentração de P está diminuindo, o que pode ser explicado pelo efeito de memória de P. Os átomos de P residuais na câmara ou átomos de P difusos acumulam-se na superfície do filme e bloqueiam os sítios ativos livres em a superfície [38, 39]. Embora o pico P tenha sido eliminado, a segregação entre Si 0,78 Ge 0,22 e Si 0,93 Ge 0,07 ainda estava sério.
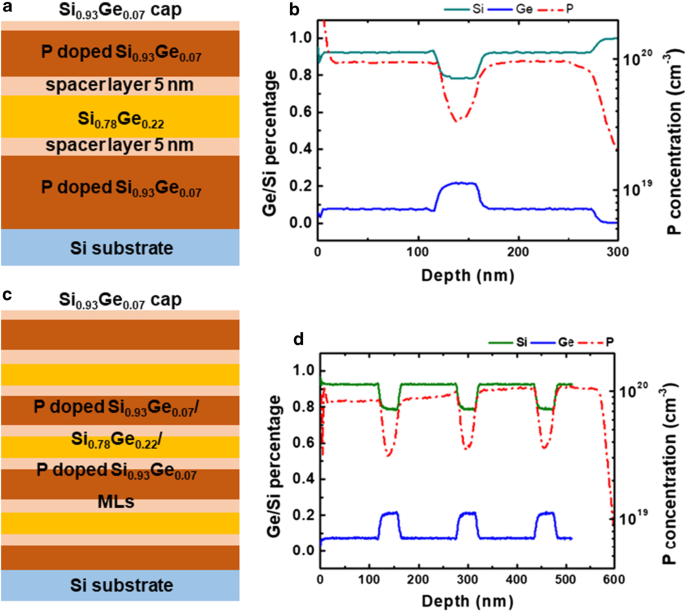
a Diagrama esquemático, b Perfil Ge / Si e P em uma camada de Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 Si dopado com / P 0,93 Ge 0,07 ML. c Diagrama esquemático, d Perfil Ge / Si e P em três camadas de Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 Si dopado com / P 0,93 Ge 0,07 ML
Características de corrosão seletiva de MLs de Si / SiGe / Si
Quando a estrutura de ML é crescida com sucesso (usando as estratégias de crescimento acima), os NWs são formados por decapagem vertical usando SiO 2 / SiN como máscara. Posteriormente, a camada de SiGe deve ser gravada seletivamente para Si na direção lateral para formar a camada de canal com uma largura projetada. Nestes experimentos, dois tipos de estruturas de ML foram escolhidos:Si dopado com P / SiGe / Si dopado com P (amostra-1, na Fig. 2c) e Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 Si dopado com / P 0,93 Ge 0,07 (amostra-2, na Fig. 5b). Essas escolhas são feitas de acordo com as discussões acima, onde a difusão externa de P foi (parcialmente) suprimida, bem como as perspectivas de aplicação do dispositivo são consideradas.
O ataque na direção vertical foi executado por ataque seco, enquanto para o ataque lateral foi aplicado um ataque seletivo a seco ou úmido. Os perfis de corrosão da amostra-1 são mostrados na Fig. 6a, b. E a imagem TEM e o mapeamento EDS da Fig. 6a foram mostrados na Fig. 7. Nestes experimentos, a máscara é óxido / nitreto. A Figura 6a mostra após 11,5 s de gravação a seco de CF 4 / O 2 /Ele. A seletividade do etch de Si 0,86 Ge 0,14 e o Si dopado com P é 5,8. A Figura 6b mostra que após 20 min de corrosão úmida de HF (6%) / H 2 O 2 (30%) / CH 3 COOH (99,8%). A gravação úmida removeu a máscara (SiO 2 / SiN) e, como resultado, a camada de capa de Si foi gravada em ~ 10 nm também. Conforme discutido na seção “Impacto das camadas espaçadoras”, há um empilhamento de P no Si / Si dopado com P 0,86 Ge 0,14 interface. A corrosão úmida é sensível ao nível de dopagem; portanto, a primeira interface foi gravada mais rápido. Como resultado, a interface de ataque frontal não é vertical e é facetada ou inclinada. A seletividade média foi inferior a 4,2. Comparando os dois métodos de corrosão, a corrosão seca é sensível à porcentagem de Ge com melhor seletividade de SiGe, enquanto a corrosão úmida é sensível à concentração de dopante. As gravuras da amostra-2 também são estudadas na Fig. 6c, d. Fenômenos semelhantes foram observados nesta amostra, enquanto as profundidades gravadas seletivas de SiGe eram mais profundas (Fig. 6a, c) devido à maior porcentagem de Ge. Na gravação a seco, a seletividade de Si 0,78 Ge 0,22 e Si dopado com P 0,93 Ge 0,07 foi de 6,3, enquanto na corrosão úmida, a seletividade média foi inferior a 2,5. Portanto, o ataque a seco foi a melhor escolha em consideração à uniformidade e seletividade do ataque.
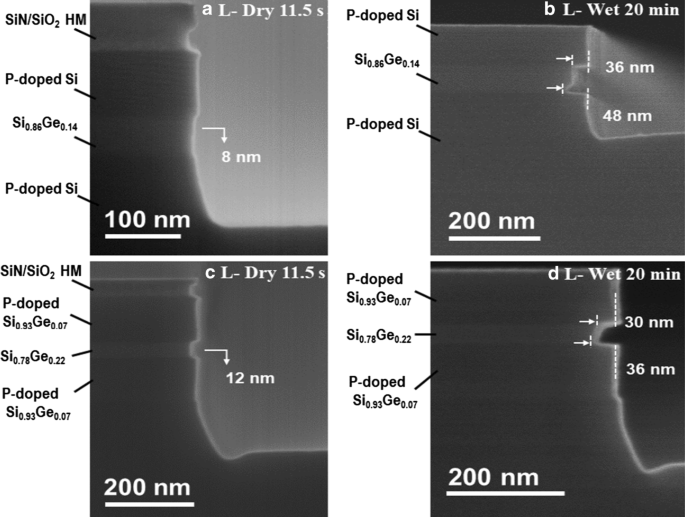
Imagens SEM de Si / Si dopado com P 0,86 Ge 0,14 / Si dopado com P na Fig. 2c com a Gravura a seco de 11,5 s, b Corrosão úmida por 20 min e Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 Si dopado com / P 0,93 Ge 0,07 MLs com c Gravura a seco de 11,5 s, d Gravura úmida de 20 min. A gravação a seco era CF 4 :O 2 :He =4:1:5, e a corrosão úmida era HF (6%):H 2 O 2 (30%):CH 3 COOH (99,8%) =1:2:4
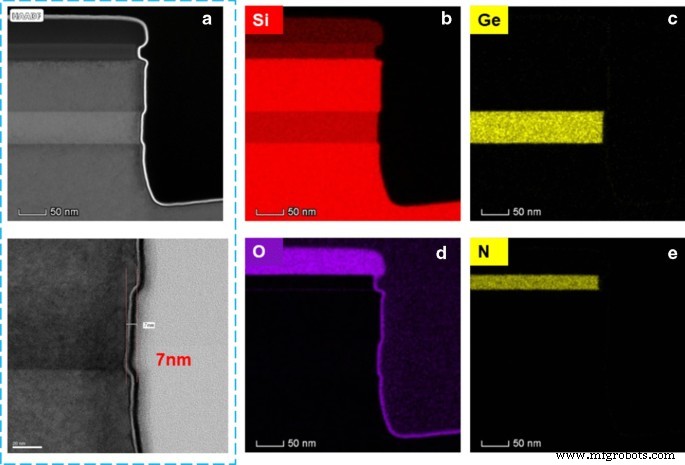
a Imagens TEM, b - e Mapeamento EDS de Si / Si dopado com P 0,86 Ge 0,14 Si dopado com / P na Fig. 6a com ataque a seco de 11,5 s. Os elementos em b é Si, em c é Ge, em d é O, e em e é N
Análises adicionais foram realizadas para investigar a cepa após as etapas de ataque na amostra-1 e amostra-2. A Figura 8a-h mostra (004) curvas oscilantes (RCs) dessas amostras como segue:conforme crescido, após corrosão vertical, e corrosão lateral SiGe usando corrosão úmida e seca. Na análise RC, o alargamento (largura total metade do máximo ou FWHM) é um indicador para a densidade do defeito e a posição do pico de SiGe em comparação com o Si determina a quantidade de deformação na camada. Ressaltamos aqui que o alargamento do pico também pode ser devido à espessura fina da camada. Portanto, será difícil distinguir da análise RC a contribuição da densidade de defeitos, mas só podemos comparar FWHM em algumas extensões dessas análises. Nesses RCs, a amostra-1 (Fig. 8a-d) tem uma única camada de SiGe; enquanto isso, a amostra-2 (Fig. 8e-h) mostra dois picos representando 7% e 22% Ge. Para amostras crescidas, uma interferência do feixe de raios X é observada, o que causa franjas na camada de espessura. O surgimento dessas franjas mostra uma interface SiGe / Si de alta qualidade. Em RCs, da amostra-1 e da amostra-2, o pico Ge mudou em direção ao pico do substrato Si, indicando relaxamento de tensão. Nenhum deslocamento adicional do pico de Ge foi detectado após a corrosão lateral a seco de SiGe. Este é um resultado promissor para o desempenho do transistor, uma vez que a mobilidade da portadora na região do canal depende da deformação. Enquanto isso, a tensão foi mais relaxada para o SiGe gravado a úmido, e mais mudanças em direção ao pico do substrato foram observadas. Isso mostra que a corrosão úmida não é adequada para a corrosão SiGe lateral, formando a camada do canal.
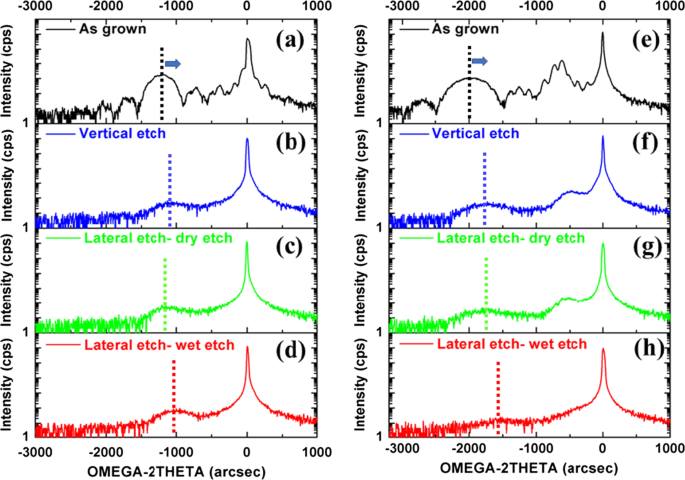
Curva oscilante HRXRD em torno da reflexão (004) da amostra-1, Si / Si dopado com P 0,86 Ge 0,14 / Si MLs dopados com P com camada espaçadora de 5 nm em a - d , e amostra-2, Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 Si dopado com / P 0,93 Ge 0,07 MLs em e - h . Ambas as duas amostras têm quatro painéis:conforme crescido, após corrosão vertical, corrosão úmida lateral de SiGe de HF (6%) / H 2 O 2 (30%) / CH 3 COOH (99,8%) 20 min, e corrosão seca lateral de CF 4 / O 2 / He 11,5 s
Outras análises de raios-X foram realizadas para descobrir mais informações sobre a densidade do defeito nas amostras na Fig. 9a-h. HRRLMs, que são baseados em medições bidimensionais, foram realizados aqui como mostrado na Fig. 9a-h. O indicador para a densidade de defeito em HRRLMs é o alargamento da camada de SiGe ao longo da direção ω (ω é o ângulo do feixe incidente). A posição dos picos de Si e SiGe fornece os componentes de deformação em paralelo e perpendicular à direção de crescimento. Na amostra-1 e na amostra-2, as camadas de SiGe crescidas mostram um alargamento ω menor e a camada está alinhada com o Si mostrando camadas de SiGe totalmente deformadas (ver Fig. 9a, e). A Figura 9b mostra a amostra após o ataque vertical, o pico de SiGe mudou em direção ao substrato de Si de uma maneira semelhante nos resultados de RC na Fig. 8b indicando relaxamento de tensão. Mas, surpreendentemente, a amostra de gravação a seco lateral (Fig. 9c) mostra um claro alargamento ω do pico de SiGe junto com uma mudança no espaço recíproco, que está na direção fora do alinhamento com o pico de Si. No entanto, a amostra de ataque úmido (na Fig. 9d) é totalmente alinhada à deformação e tem uma intensidade de camada menor do que a de ataque seco (na Fig. 9c). Nesse caso, espera-se que os defeitos gerados tenham origens diferentes nessas amostras, uma vez que a natureza do processo de corrosão é diferente. Amostra-2 contém duas camadas de SiGe; o Si 0,93 Ge 0,07 o pico sobrevive após a corrosão nas direções vertical e lateral, enquanto Si 0,78 Ge 0,22 desaparece após o ataque vertical mostrando o relaxamento total da deformação (Fig. 8f-h). A fraca estabilidade do processo da amostra-2 pode originar-se do dopagem P, que promove a formação de deslocamentos inadequados.

HRRLMs de Si / Si dopado com P 0,86 Ge 0,14 / Si MLs dopados com P com camada espaçadora de 5 nm (amostra-1) em a - d e Si dopado com P 0,93 Ge 0,07 /Si0,78 Ge 0,22 Si dopado com / P 0,93 Ge 0,07 MLs (Amostra-2) em e - h . Os dois mapeamentos têm quatro painéis:conforme crescido, após a corrosão vertical, a corrosão úmida lateral de HF (6%) / H 2 O 2 (30%) / CH 3 COOH (99,8%) 20 min, e corrosão seca lateral de CF 4 / O 2 / He 11,5 s
Conclusões
Neste trabalho, a epitaxia de Si MLs dopados com P-Si / SiGe / P-dopados com MLs de Si juntamente com a corrosão desses MLs como estruturas iniciais para vGAAFET foi investigada. Primeiramente, foi estudada a incorporação de P em Si / SiGe / Si MLs. Diferentes estratégias para a epitaxia e a estrutura de ML têm sido propostas para eliminar o pico segregado por P na interface da heteroestrutura Si / SiGe. A partir de experimentos, a inserção da camada espaçadora não dopada pode diminuir o pico P. A purga de hidrogênio para limpar o excesso de átomos de P não foi muito útil e os dímeros de P-P estáveis não puderam ser totalmente removidos. Substituindo SiH 4 com SiH 2 Cl 2 como precursor de Si para introduzir a química de Cl durante o crescimento, diminuiu o pico de P segregado notavelmente devido às reações de superfície ativa de Cl. O impacto de Si 0,93 Ge 0,07 camadas espaçadoras após Si dopado com P também foram investigadas. Os resultados mostraram que o pico de P na interface SiGe desapareceu, enquanto a incorporação de P nessas camadas melhorou em uma magnitude de ordem. Na segunda parte deste estudo, o ataque vertical de Si / SiGe / Si ML foi realizado para formar NWs, e posteriormente, nesses NWs, o SiGe foi seletivo a úmido ou seco. A corrosão úmida foi sensível à concentração de dopante; entretanto, a corrosão seca foi sensível ao conteúdo de Ge. A decapagem a seco foi mais apropriada para estruturas do tipo n com perfil de ataque uniforme e maior seletividade. Para Si / Si dopado com P 0,86 Ge0.14 /P-doped Si MLs, the selectivity was 5.8 with dry etch and 4.2 for wet etch. The selectivity of P-doped Si0.93 Ge0.07 /Si0.78 Ge0.22 /P-doped Si0.93 Ge0.07 MLs was 6.3 with dry etch and 2.5 with wet etch. The strain in SiGe was mostly preserved in Si/SiGe/Si after vertical and lateral etch; meanwhile, this strain in MLs with introduced Si0.93 Ge0.07 spacer layer had poor stability after etch process.
Disponibilidade de dados e materiais
The authors declare that the data supporting the findings of this study are available within the article.
Abreviações
- vGAAFET:
-
Vertical gate-all-around field-effect transistors
- ML:
-
Multilayer
- CMOS:
-
Complementary metal oxide semiconductor
- MBE:
-
Epitaxia de feixe molecular
- RPCVD:
-
Reduced pressure chemical vapor deposition
- RTCVD:
-
Rapid thermal chemical vapor deposition
- S/D:
-
Source/drain
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- HRXRD:
-
High-resolution X-ray diffraction
- HRRLM:
-
High-resolution reciprocal lattice map
- SEM:
-
Microscopia eletrônica de varredura
- SIMS:
-
Secondary ion mass spectroscopy
- RC:
-
Rocking curve
- FWHM:
-
Full-width-half-maximum
- HM:
-
Hardmask
Nanomateriais
- Tornando o desempenho do aplicativo melhor para usuários e clientes da CyrusOne
- Espaçadores de ar para chips de 10 nm
- Crescimento direto de estruturas ZnO semelhantes a penas por uma técnica de solução fácil para aplicação de detecção de foto
- Avaliação de estruturas de grafeno / WO3 e grafeno / CeO x como eletrodos para aplicações de supercapacitor
- Uma Sonda Fluorescente Resumível BHN-Fe3O4 @ SiO2 Híbrida Nanoestrutura para Fe3 + e sua Aplicação em Bioimagem
- Escolha de um tipo de processo e equipamento de soldagem robótica para sua aplicação
- As empresas se preparam para as grandes mudanças e desafios tecnológicos de 2019
- Torno vertical para aplicações de fundição, forjamento e torneamento
- Torno vertical para aplicações de fundição, forjamento e torneamento(2)
- Máquinas VMC para produção e eficiência



