Estudo de simulação do transistor de efeito de campo do túnel de porta dupla com espessura de canal de passo
Resumo
Espera-se que o transistor de efeito de campo de túnel de porta dupla (DG TFET) estenda as limitações da corrente de fuga e da inclinação do sublimiar. No entanto, também sofre de comportamento ambipolar com a arquitetura fonte / dreno simétrica. Para superar a corrente ambipolar, deve-se introduzir assimetria entre a fonte e o dreno. Neste artigo, investigamos os desempenhos de DG TFET com espessura de canal de degrau (SC TFET), utilizando a simulação 2D. A assimetria entre a fonte e o dreno é introduzida através da espessura do canal do degrau; portanto, espera-se que o comportamento ambipolar seja aliviado. Os resultados mostram que o TFET SC exibe redução significativa da corrente ambipolar em comparação com o TFET DG convencional. Os mecanismos do SC TFET são amplamente discutidos para explorar o insight físico. Os impactos introduzidos pelos parâmetros da estrutura na tensão inicial, inclinação subliminar, corrente de drenagem no estado ligado e no estado ambipolar também são exibidos na determinação da estrutura ótima.
Histórico
À medida que o processo de escalonamento extremo continua, a tecnologia CMOS com MOSFET convencional encontra vários desafios, como o aumento da corrente de fuga e a inclinação de sublimiar ( SS ) O transistor de efeito de campo de túnel (TFET), que utiliza os mecanismos de tunelamento banda a banda (BTBT), deve estender as limitações de corrente de fuga e SS [1,2,3,4,5,6,7,8]. O TFET à base de silício apresenta vantagens como alta confiabilidade e baixo custo. No entanto, o TFET convencional à base de silício exibe uma corrente relativamente baixa em comparação com o MOSFET devido à taxa de BTBT restrita [9,10,11]. Para desenvolver o potencial do TFET à base de silício, várias novas estruturas de TFET foram propostas recentemente para aumentar a corrente no estado. O TFET de porta dupla (DG TFET) mostra uma taxa de BTBT melhorada, levando ao aumento da corrente on-line [12,13,14]. No entanto, a corrente ambipolar do DG TFET também é aumentada, uma vez que a melhora da taxa de BTBT é ativada no estado ambipolar [15]. Para superar ainda mais a corrente ambipolar, deve-se introduzir assimetria entre a fonte e o dreno [16]. DG TFETs com subposição porta-dreno e menor concentração de dopagem no dreno são métodos comuns para aliviar o problema ambipolar [17,18,19]. Mas a subposição porta-dreno requer maior distância S / D e menor concentração de dopagem no dreno aumenta as resistências em série [15]. Um trabalho anterior mostrou que os efeitos ambipolares no TFET com subposição de dreno poderiam ser ainda mais aliviados usando os espaçadores de baixo k e colocando os contatos na configuração superior e inferior [15], sugerindo que estratégias de assimetria combinadas podem ser significativas em melhorar o desempenho do TFET. Em nosso trabalho anterior, o FinFET com largura de aleta de assimetria demonstrou melhorar o desempenho do FinFET [20]. Também se acredita que a espessura do canal t si tem um impacto significativo na taxa de BTBT da DG TFET [21]; portanto, a assimetria entre a espessura da fonte e a espessura do dreno pode aliviar ainda mais a corrente ambipolar e precisa ser estudada minuciosamente.
Neste artigo, investigamos os vários desempenhos do DG TFET com espessura de canal de degrau (SC TFET), a assimetria entre a fonte e o dreno é introduzida através da espessura do canal de degrau de forma que se espera que a corrente ambipolar seja reduzida. O restante deste artigo está organizado da seguinte forma:a Seção 2 apresenta a estrutura do dispositivo e a configuração da simulação. Na Seção 3, os mecanismos do SC TFET são amplamente discutidos. A discussão detalhada sobre os impactos dos parâmetros da estrutura nas curvas de transferência, tensão inicial ( V início ), SS médio e a corrente de dreno no estado on / ambipolar também é apresentada. Finalmente, as conclusões deste artigo são esclarecidas na seção IV.
Estrutura e Simulação
O diagrama esquemático do SC TFET considerado neste artigo é mostrado na Fig. 1a. A espessura do canal perto da região de origem não é igual à espessura do canal perto da região de drenagem. A espessura do canal muda gradativamente em um determinado ponto na região do canal. A altura e a posição do degrau são indicadas como H e L s respectivamente. t si1 e t si2 são a espessura do canal perto da região de origem e da região de drenagem, respectivamente. A espessura efetiva do óxido (EOT) é de 1 nm em nossa simulação. A região de origem é altamente dopada com p (10 20 átomos / cm 3 ) e a região de drenagem é altamente n-dopada (10 20 átomos / cm 3 ) para reduzir a resistência em série [15], a região do canal é levemente n-dopada (10 17 átomos / cm 3 ) A fim de analisar a tensão inicial com várias configurações de espessura de canal, a função de trabalho da porta de metal é fixada em 4,5 eV, o comprimento da porta é igual ao comprimento do canal L ch e ajustado para 50 nm [22,23,24,25]. As simulações são realizadas usando Sentaurus TCAD versão I-2013.12 [26, 27]. O modelo de dependência de dopagem e o modelo de mobilidade dependente de campo são o modelo de mobilidade unificada da Philips e o modelo de mobilidade Lombardi, respectivamente. As estatísticas de Fermi – Dirac, Shockley – Read – Hall e o modelo de recombinação Auger também são utilizadas. A fim de contabilizar as regiões de fonte / drenagem altamente dopadas, o modelo de estreitamento de gap é ativado. O modelo BTBT não local baseado na aproximação de Wentzel – Kramer – Brillouin (WKB) sintonizado com os resultados experimentais de [28] e o modelo de quantização de gradiente de densidade são habilitados para alcançar a simulação precisa [29, 30]. A tensão inicial é definida como a tensão da porta na qual a inclinação do sublimiar é máxima. A média de SS é extraído da corrente de estado desligado para I d =10 −11 A / μm.
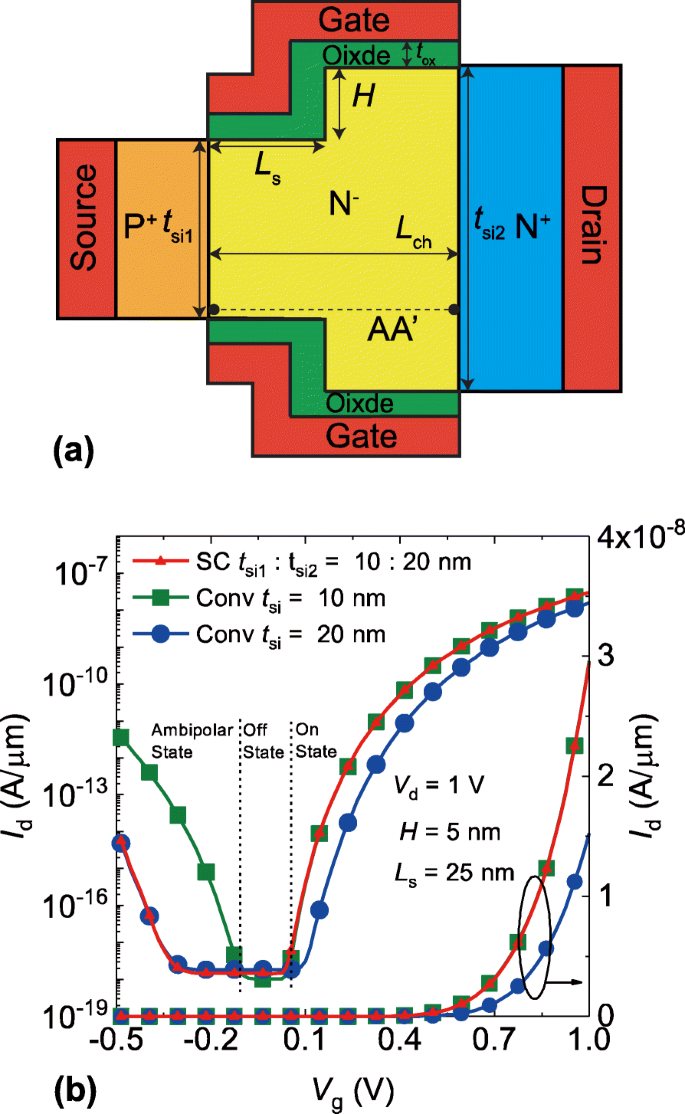
a Diagrama esquemático 2D do SC TFET, t si1, e t si2 são as espessuras do canal perto da região da fonte e da região do dreno, a assimetria entre a fonte e o dreno é obviamente introduzida. Linha de corte AA 'é a linha de corte ao longo da direção horizontal. A distância vertical entre a linha de corte e a superfície da região da fonte é de 0,5 nm. b Curvas de transferência do SC TFET e DG TFETs convencionais em escala logarítmica e linear
Resultados e discussão
Curvas e mecanismo de transferência
A Figura 1b mostra as curvas de transferência de SC TFET e DG TFET convencional em escala logarítmica e linear, respectivamente. Marcamos o estado ligado, desligado e ambipolar na Fig. 1b. Para TFETs, uma corrente mais alta de estado ligado e uma corrente mais baixa de estado ambipolar são sempre desejadas, o que requer que o V início e SS deve ser baixo, enquanto o estado desligado deve ter uma ampla faixa de tensão. Conforme mostrado na Fig. 1b, o V início do DG TFET convencional com espessura de canal de 10 nm são menores do que do DG TFET com espessura de canal de 20 nm. O extraído V início da DG TFET com t si =10 nm é 0,04 V e sua média extraída SS é 44,8 mV / dec, o V início e a média de SS de DG TFET convencional com t si =20 nm é 0,1 V e 50,6 mV / dec, respectivamente. A corrente de drenagem do DG TFET convencional com t si =10 nm é melhorado em 94,7% em comparação com o DG TFET convencional com t si =20 nm. A principal razão desta melhoria da corrente de drenagem é a redução do SS e V início . No entanto, o intervalo fora do estado do DG TFET convencional com t si =10 nm é apenas 0,17 V. O DG TFET convencional com t si =20 nm, em comparação, exibe uma faixa de estado desligado de 0,45 V. Como resultado, a corrente de estado ambipolar do DG TFET convencional com t si =20 nm é reduzido em 3 ordens de magnitude em comparação com o DG TFET convencional com t si =10 nm.
Para uma comparação justa, o t si1 e t si2 de SC TFETs são iguais às espessuras de canal de DG TFETs convencionais, respectivamente. A espessura mais estreita do canal t si1 de SC TFET é de 10 nm e a maior espessura do canal t si2 de SC TFET é de 20 nm. A posição do degrau é assumida no meio do canal e no L s é 25 nm. Pode-se observar que o SC TFET apresenta características promissoras incluindo a alta corrente de dreno no estado ligado, bem como a ampla faixa fora do estado. A corrente de drenagem do SC TFET no estado ligado é semelhante em comparação com o DG TFET convencional com t si =10 nm, a média SS é 45,8 mV / dec e o V início é 0,03 V. No entanto, a faixa de estado desligado do SC TFET é melhorada em até 123,5% e a corrente do estado ambipolar também é reduzida em 3 ordens de magnitude em comparação com o DG TFET convencional com t si =10 nm. Como resultado, as características on-state do SC TFET são semelhantes ao DG TFET convencional com espessura de canal estreita, o SC TFET também mostra curvas off / ambipolares quase paralelas ao DG TFET convencional com ampla espessura de canal. Conseqüentemente, o SC TFET pode atingir baixo SS , reduzido V início , e ampla faixa fora do estado simultaneamente.
Para explorar o mecanismo físico do SC TFET, comparamos as taxas de BTBT e os diagramas de banda de energia no estado ligado, próximo ao ponto inicial e no estado ambipolar, respectivamente. A Figura 2a mostra as taxas de BTBT do SC TFET e dos DG TFETs convencionais. Pode-se observar que a taxa de BTBT depende fortemente da espessura do canal. Na verdade, a relação entre a espessura do canal e a corrente BTBT I BTBT pode ser expresso como [31].
$$ {I} _ {BTBT} \ propto \ exp \ left (- \ frac {4 \ lambda \ sqrt {2 {m} ^ {\ ast} {E_g} ^ {2/3}}} {3 \ mathrm {\ hslash} \ left (\ Delta \ Phi + {E} _g \ right)} \ right) $$ (1)

a Taxas BTBT e b diagrama de banda de energia do SC TFET e os DG TFETs convencionais no estado ligado, a distância é a posição lateral da linha de corte AA 'na Fig. 1
Onde λ =( ε si t si t boi / 2 ε boi ) 1/2 é o comprimento natural, ε si e ε boi são a permissividade do silício e do óxido, respectivamente e t boi é a espessura do óxido. Δ Φ é a faixa de energia na qual o tunelamento pode ocorrer, E g é o gap na junção do túnel, e m * é a massa de tunelamento. A equação (1) indica que o I BTBT deve aumentar à medida que t si reduz. Portanto, a taxa BTBT do DG TFET convencional com t si =10 nm deve ser maior do que o DG TFET convencional com t si =20 nm. O SC TFET mostra distribuição semelhante de taxa de BTBT ao DG TFET convencional com t si =10 nm. Isso ocorre porque o BTBT ocorre principalmente perto da junção da fonte no estado ligado, portanto, a espessura do canal perto da junção da fonte determinará a taxa de BTBT no estado. A Figura 2b mostra o diagrama de banda de energia do SC TFET e dos DG TFETs convencionais. Como a taxa de BTBT está fundamentalmente relacionada à distância de tunelamento, o diagrama de banda de energia, que pode apresentar a distância de tunelamento de forma clara, explicará a origem da variação das taxas de BTBT. Na Fig. 2b, a distância mínima de tunelamento do SC TFET está localizada perto da junção da fonte e é mais ou menos igual à do DG TFET convencional com t si =10 nm. A distância mínima de tunelamento do DG TFET convencional com t si =20 nm é significativamente mais largo; portanto, sua taxa de BTBT é reduzida em comparação com o SC TFET e o DG TFET convencional com espessura de canal mais fina.
A Figura 3a mostra as taxas de BTBT quando a tensão da porta é zero e está próxima da tensão inicial. Pode-se observar que o SC TFET possui a maior taxa de BTBT, seguido pelo DG TFET convencional com t si =10 nm. O DG TFET convencional com t si =20 nm mostra a taxa de BTBT mais baixa. A Figura 3b exibe o diagrama da banda de energia correspondente. Pode-se observar que a localização de distância mínima da banda de valência à banda de condução é no centro da região do canal. Além disso, a distância mínima do DG TFET convencional com espessura de canal mais larga é maior do que a do TFET SC e DG TFET convencional com espessura de canal mais fina. Isso indica que a espessura do canal também tem um impacto significativo na taxa de BTBT no ponto inicial. Portanto, o V início depende da espessura do canal também. Outro fato é que o SC TFET exibe maior taxa de BTBT do que o DG TFET convencional com t si =10 nm, embora suas espessuras mínimas de canal sejam iguais. Este fenômeno é atribuído à variação da distribuição de potencial introduzida pelo eletrodo de canto da porta, como também pode ser observado em outros trabalhos [32, 33]. Como resultado, o SC TFET mostra o menor V início , seguido pelo DG TFET convencional com espessura de canal fino, e o DG TFET convencional com espessura de canal largo exibe o maior V início .

a Taxas BTBT e b diagrama de banda de energia do SC TFET e os DG TFETs convencionais no ponto de início próximo, a distância é a posição lateral da linha de corte AA 'na Fig. 1
A Figura 4a mostra a comparação das taxas de BTBT no estado ambipolar. Uma vez que a taxa de BTBT é fortemente dependente da espessura do canal, o TFET convencional com t si =10 nm mostra a taxa de BTBT mais significativa em comparação com as outras duas estruturas TFET. O SC TFET, no entanto, mostra a taxa de BTBT semelhante ao DG TFET convencional com t si =20 nm. É porque o tunelamento é gerado principalmente próximo à região do dreno e o SC TFET tem uma espessura de canal mais ampla próximo à região do dreno. Na Fig. 4b, o diagrama da banda de energia no estado ambipolar também é exibido. Percebe-se claramente que a distância mínima de tunelamento está localizada próximo à região de drenagem. Além disso, as distâncias de tunelamento do SC TFET e DG TFET convencional com maior espessura de canal são maiores do que aquelas do DG TFET convencional com canal mais fino, resultando na baixa corrente ambipolar do SC TFET e DG TFET convencional com maior espessura de canal.

a Taxas BTBT e b diagrama de banda de energia do SC TFET e os DG TFETs convencionais no estado ambipolar, a distância é a posição lateral da linha de corte AA 'na Fig. 1
Impactos de H e L S em características DC
A Figura 5a mostra as curvas de transferência do SC TFET com vários H e t si1 =10 nm. Pode-se ver que o H tem menos impacto na corrente no estado. A corrente ambipolar, no entanto, reduz significativamente à medida que o H aumenta, o intervalo fora do estado melhora com o aumento de H também. Também pode ser visto que a redução da corrente ambipolar diminui à medida que o H aumenta. A razão para isso é que o efeito de acoplamento da estrutura de porta dupla tende a ser menos significativo com uma espessura de canal maior [31]. Portanto, como o H aumenta, as taxas de BTBT tornam-se mais independentes da espessura do canal, levando à saturação da corrente ambipolar. Para explorar ainda mais o parâmetro de estrutura ideal, os efeitos de H varia de 0 a 15 nm nos desempenhos do dispositivo são extraídos e mostrados na Fig. 5b – d. A Figura 5b exibe o V início e a variação da taxa BTBT com diferentes H e t si1 . Pode ser visto que o V início diminui monotonicamente com o aumento de H . Isso porque o eletrodo de canto da porta introduziria a variação da distribuição de potencial na região do canal [32, 33], resultando na alteração da taxa de BTBT e do V início . A Figura 5b demonstra que a taxa de BTBT aumenta conforme o H melhora. Como resultado, o V diminuiu início pode ser encontrado com o H aumentado . Também se pode observar que V início aumenta conforme o t si1 aumenta. A principal razão é que o aumento t si1 enfraquece a taxa de BTBT, resultando em um V mais alto início . Na Fig. 5c, a média extraída SS de SC TFET com vários H e t si1 é mostrado. A tendência do SS com H diferente é o oposto do V início . Em outras palavras, o SS sobe conforme o H aumenta. Mencionamos que a corrente de drenagem no estado depende do t si1 , de modo que os TFETs SC com diferentes H mas com o mesmo t si1 deve ter a corrente de drenagem semelhante no estado ligado. Além disso, sabe-se também que o V início diminui com o aumento de H . Isso implica que a faixa de tensão da porta para conduzir a mesma corrente de drenagem é melhorada conforme H aumenta. Como resultado, a média de SS aumenta monotonicamente com o aumento de H . Também pode ser visto que o aumento de t si1 irá minar o SS , que é devido à capacidade de controle de porta reduzida. A Figura 5d mostra a corrente de drenagem no estado ligado e no estado ambipolar com diferentes H e t si1 , respectivamente. A corrente no estado é quase independente no H , mas é muito afetado pelo t si1 , que corresponde ao nosso resultado anterior de que o tunelamento no estado ocorre principalmente próximo à região de origem e é fortemente dependente da espessura do canal próximo à região de origem. A corrente ambipolar, no entanto, reduz à medida que o H aumenta. Uma vez que o tunelamento do estado ambipolar é dominado perto da região de drenagem, o aumento de H irá melhorar a espessura do canal no lado do dreno e, assim, enfraquece a corrente ambipolar. Também pode ser visto que a corrente ambipolar cai mais significativamente quando o H é menor que 10 nm, o que se deve ao maior efeito de acoplamento com espessura de canal mais fina.

Os impactos de H no a curvas de transferência, b V taxa de início e BTBT, c média SS , e d drenar a corrente no estado on / ambipolar, H é a altura do degrau e H =0 nm representa o DG TFET convencional
Na Fig. 6a, as curvas de transferência de SC TFET com diferentes L s são apresentados respectivamente. L s =0 nm representa o DG TFET convencional com t correspondente si2 e L s =50 nm representa o DG TFET convencional com t correspondente si1 . Pode-se ver que a localização do degrau tem um impacto significativo na corrente ambipolar e na faixa do estado desligado. Os TFETs SC com L s menos de 30 nm mostram corrente ambipolar semelhante e faixa de estado desligado. Como o L s excede 30 nm, a corrente ambipolar é bastante aumentada. A Fig. 6b mostra o V início e a variação da taxa BTBT com vários L s e t si1 , a tendência de que o V início aumenta conforme o t si1 melhorias também podem ser claramente observadas. O ponto de inflexão da mudança no L s =10 nm é o resultado da variedade de t si1 . Desde L s =0 nm é o DG TFET convencional com uma espessura de canal maior, a taxa de BTBT reduziria, levando a um aumento de V início e uma diminuição da corrente no estado. Exceto o caso do DG TFET convencional, o V início de SC TFET é aumentado monotonicamente conforme o L s aumenta, o que é devido à taxa de BTBT reduzida induzida pela estrutura do canal de degrau. A Figura 6c exibe os impactos do L s e t si1 na SS de SC TFETs. O aumento t si1 resulta no SS degradado . De acordo com a Eq. (1), uma espessura de canal elevada diminuiria os efeitos de acoplamento entre os eletrodos de porta, levando a uma capacidade de controle de porta reduzida e um aumento de SS [12]. Como o L s cair, a região com maior espessura de canal se expandirá e enfraqueceria a capacidade geral de controle da porta. Como resultado, uma redução de L s irá minar o SS de SC TFETs, que podem ser claramente observados na Fig. 6c. A Figura 6d apresenta a corrente de dreno no estado ligado e ambipolar com diferentes L s e t si1 , respectivamente. Pode-se observar que a corrente no estado do SC TFET é mais ou menos igual ao DG TFET convencional com correspondente t si1 . Quanto à corrente ambipolar, o SC TFETs com L s menos de 30 nm mostram a corrente semelhante aos DG TFETs convencionais com t correspondente si2 . Quando o L s aumenta para 40 nm, a corrente ambipolar aumenta dramaticamente. Na verdade, para o caso de SC TFET com L s =40 nm e t si1 =20 nm, sua corrente ambipolar é ainda maior do que a do DG TFET convencional com t si1 =20 nm. Isso ocorre porque a parte vertical do eletrodo de porta pode aumentar a área de tunelamento, especialmente quando a parte vertical do eletrodo de porta está perto da junção PN [34]. Isso indica que o L s deve ser inferior a 40 nm com o objetivo de reduzir a corrente ambipolar.

Os impactos de L s no a curvas de transferência, b V taxa de início e BTBT, c média SS , e d drenar a corrente no estado on / ambipolar, L s é a distância lateral da região de origem ao degrau, L s =0 nm representa o DG TFET convencional com t correspondente si2 e L s =50 nm representa o DG TFET convencional com t correspondente si1.
Para determinar os parâmetros de estrutura ideais do SC TFET, uma simulação ortogonal é conduzida estudando o efeito combinado do H e o L s no desempenho do dispositivo. O t si1 é fixado em 10 nm para alcançar uma maior corrente no estado ligado. Na Fig. 7a, a corrente ambipolar é extraída em função do L s com vários H . Pode ser visto claramente que a corrente ambipolar reduz significativamente à medida que o H diminui, o que sugere que um H maior é promissor em termos de obtenção de uma corrente ambipolar mais baixa. No entanto, pode-se observar que o benefício de um maior H é menos significativo. Portanto, um H =15 nm seria o valor ideal considerando que um maior H só poderia aumentar a área do dispositivo. Enquanto isso, um decréscimo de L s também irá diminuir a corrente ambipolar, especialmente com um maior H . Portanto, um menor L s é desejado para o propósito de corrente ambipolar mínima. No entanto, um L inferior s também pode levar a um aumento da inclinação subliminar, como pode ser observado na Fig. 7b. A inclinação do sublimiar aumenta lentamente com um L mais alto s mas aumenta rapidamente com um L inferior s , indicando que um L s cerca de 25 nm seria o valor de compromisso. Como resultado, os parâmetros de dispositivo ideais seriam H =15 nm e L s =25 nm onde a corrente ambipolar e a inclinação subliminar são relativamente baixas.
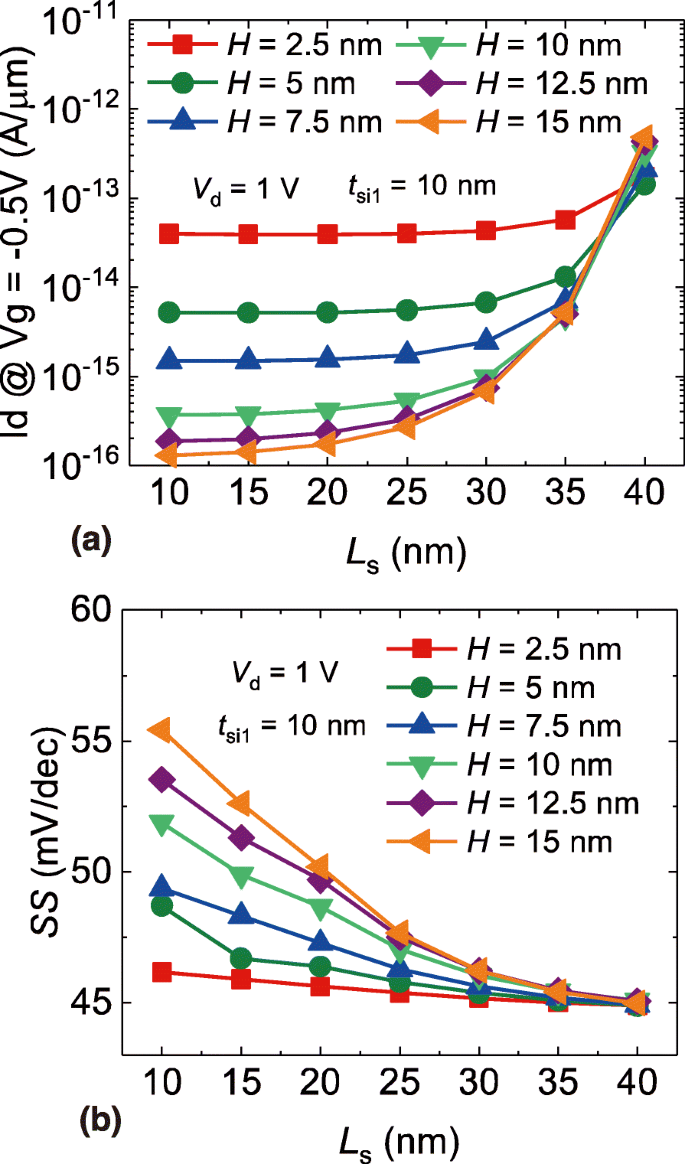
a A corrente ambipolar e b a inclinação subliminar do SC TFET como uma função do L S com vários H
Método de Fabricação
Um processo de fabricação viável do SC TFET é exibido na Fig. 8. Devido ao formato único do canal, a espessura do canal pode ser alcançada mais facilmente adotando a estrutura vertical. O processo começa com a preparação do substrato de silício com SiN e deposição fotorresistente, conforme mostrado na Fig. 8a. Na Fig. 8b, o padrão de SiN é obtido por litografia, seguido pela gravação para formar a região do canal, então o N + região é introduzida por uma implantação vertical de As e recozimento [35]. Em seguida, o óxido de isolamento é depositado para evitar que a região do dreno ataque ácido no processo a seguir, conforme mostrado na Fig. 8c. Na Fig. 8d, a incineração e o corte são adotados utilizando-se o ataque químico de íons de reação [36] para reduzir a espessura e a largura do SiN. A espessura do canal de degrau é então introduzida por corrosão, como mostrado na Fig. 8e. Os processos restantes são semelhantes ao TFET vertical convencional, envolvendo formação de óxido de porta, deposição de porta, exposição ao silício e implantação da região de origem [35, 37], como mostrado na Fig. 8f.
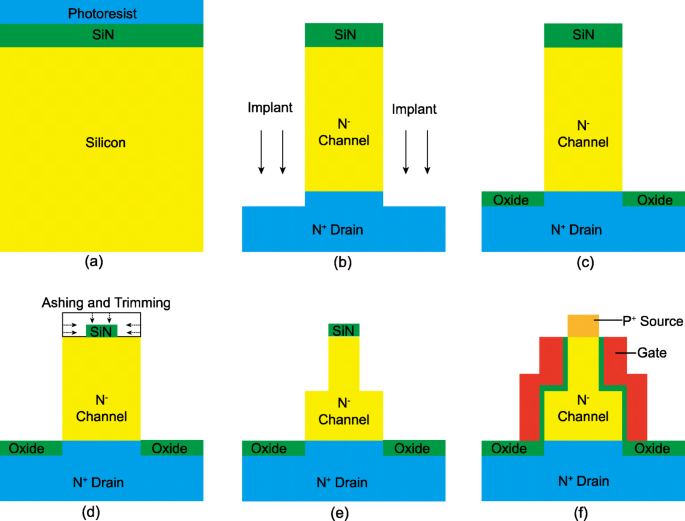
Processo de fabricação do SC TFET. a Preparação de substratos de silicone com SiN e deposição fotorresistente. b Ataque, implantação e recozimento. c Deposição de óxido de isolamento. d Reduzindo a espessura e a largura do SiN por incineração e aparagem. e A espessura do canal de degrau é introduzida. f Formação de óxido de porta, deposição de porta, planarização de porta e implantação de região de origem
Conclusão
Investigamos os desempenhos elétricos de DG TFET com espessura de canal de passo (SC TFET), utilizando a simulação 2D. A assimetria entre a fonte e o dreno é introduzida através da espessura do canal do degrau; portanto, o comportamento ambipolar é significativamente aliviado. O SC TFET exibe características no estado semelhantes do DG TFET convencional com t correspondente si1 e curvas paralelas / ambipolares do DG TFET convencional com t correspondente si2 . Como resultado, o SC TFET pode atingir uma ampla faixa fora do estado, baixa corrente ambipolar e manter o SS baixo simultaneamente. Os mecanismos do SC TFET são amplamente discutidos para explorar o insight físico. Os impactos introduzidos pelos parâmetros de estrutura na tensão inicial, inclinação subliminar, corrente de drenagem no estado ligado e estado ambipolar também são estudados para determinar a estrutura ótima. O SC TFET com H de 15 nm e L s de 25 nm mostra os desempenhos ideais. Além disso, a arquitetura da espessura do canal de degrau fornece um método de assimetria alternativo. Uma vez que as estratégias de assimetria combinadas provaram ser eficazes, nosso trabalho poderia fornecer ainda mais melhorias no desempenho do TFET.
Disponibilidade de dados e materiais
Todos os dados estão totalmente disponíveis sem restrição.
Abreviações
- DG TFET:
-
Transistor de efeito de campo de túnel de porta dupla
- SC TFET:
-
DG TFET com espessura de canal de degrau
- SS :
-
Declive de sublimiar
- BTBT:
-
Tunelamento banda a banda
- EOT:
-
Espessura efetiva de óxido
- V início :
-
Tensão inicial
- H :
-
Altura do degrau
- L s :
-
Posição do degrau
- L ch :
-
Comprimento do canal
- t si :
-
Espessura do canal
- t si1 :
-
Espessura do canal perto da região de origem
- t si2 :
-
Espessura do canal perto da região de drenagem
Nanomateriais
- Conectando as peças:Integrando o componente portátil em conformidade com o FACE a um ambiente de simulação
- O Transistor de efeito de campo de junção (JFET) como uma chave
- Compreendendo os componentes de corrente de vazamento em transistores MOS de canal curto
- Em sintonia com o coração de um átomo de cobre
- MoS2 com Espessura Controlada para Evolução Eletrocatalítica de Hidrogênio
- Efeito de superfície no transporte de petróleo em nanocanais:um estudo de dinâmica molecular
- O estudo de um novo sistema micelar em forma de verme aprimorado por nanopartículas
- A otimização da programação de DRAM 1T sem capacitor baseada no TFET de porta dupla
- Transistores de efeito de campo ferroelétricos baseados em padrões de faixa de micron-largas dominadas por nanotubo de carbono de parede única com camada de controle de defeito de HfO2
- Channel Plasmon Nanowire Lasers com cavidades em V-Groove



