Propriedades elétricas das superredes de onda média e longa InAs / GaSb cultivadas em substratos de GaAs por epitaxia de feixe molecular
Resumo
No presente trabalho, relatamos as propriedades de transporte elétrico no plano de superredes de onda média (MWIR) e infravermelho de onda longa (LWIR) InAs / GaSb tipo II (T2SLs) crescidas por sistema de epitaxia de feixe molecular (MBE) em GaAs (001) substrato. A enorme incompatibilidade de rede entre o substrato T2SL e GaAs é reduzida pelo crescimento da camada tampão de GaSb com base na técnica de matriz de desajuste interfacial (IMF). Para compensar a deformação no InAs / GaSb T2SL, utilizamos uma sequência especial de venezianas para obter interfaces do tipo InSb e do tipo GaAs. Verifica-se que o MWIR InAs / GaSb T2SL apresenta um p - e n -tipo de condução em baixas e altas temperaturas, respectivamente. Curiosamente, observa-se que a mudança de temperatura de condução é dependente da temperatura de crescimento. Por outro lado, a condução LWIR T2SL é dominada apenas por elétrons. É importante notar que o mecanismo de espalhamento dominante no LWIR T2SL em baixas temperaturas é o mecanismo de espalhamento da rugosidade da interface.
Histórico
Já que InAs / GaSb T2SL foi conceituado por Sai-Halasz et al. [1] em 1977, grandes atenções foram pagas na investigação deste material semicondutor. Os fotodetectores baseados neste T2SL apresentam teoricamente maior potencial sobre o telureto de mercúrio e cádmio (HgCdTe) e os sistemas de material infravermelho de última geração para a próxima geração de aplicações de infravermelho (IR) [2, 3]. Curiosamente, InAs / GaSb T2SL exibe uma linha de banda de gap quebrada tipo II incomum, onde a banda de condução de InAs mínima está localizada 140 meV abaixo do topo da banda de valência GaSb [1]. Consequentemente, a transição fundamental entre as sub-bandas de buracos pesados e o fundo da banda de condução depende da espessura da camada de InAs ou GaSb [4]. Porém, a principal vantagem desse alinhamento é a redução da taxa de recombinação Auger graças à supressão de algumas vias não radiativas na banda de valência [5]. Além disso, o tunelamento banda a banda diminui significativamente devido às grandes massas efetivas (≈ 0,04 m 0 ) de elétrons e lacunas [6]. Essas duas últimas características permitem a redução da corrente escura, que leva à alta temperatura de operação (QUENTE) do fotodetector.
InAs / GaSb T2SL é tradicionalmente cultivado em substrato de GaSb com correspondência de rede. No entanto, este último é caro e está disponível em tamanhos pequenos, com menos de 3 pol., O que impede a realização de matrizes de plano focal de grande formato (FPAs). Além disso, substratos de GaSb não são “epi-ready” e suas superfícies de crescimento contêm muitos defeitos macroscópicos [7]. Além disso, o coeficiente de absorção é relativamente alto no substrato GaSb (≈ 100 cm −1 ) para radiação IR acima de 5 μm [8]. Devido às suas inúmeras vantagens, o GaAs tem sido proposto como um candidato viável para o crescimento do InAs / GaSb T2SL [9,10,11,12]. Na verdade, eles são "epi-ready", têm boa relação custo-benefício e estão disponíveis em tamanhos grandes de até 6 pol. Além disso, o GaAs tem um coeficiente de absorção duas ordens de magnitude inferior ao do GaSb. Infelizmente, existe uma enorme incompatibilidade de rede (~ 7,5%) entre GaAs e InAs / GaSb T2SL que resulta em alta densidade de deslocamento de desajuste (10 9 cm −2 ) [13]. Portanto, é obrigatório conceber novas técnicas de crescimento para aliviar a tensão e reduzir a densidade de deslocamento. Entre essas técnicas estão a nucleação a baixa temperatura [14] e a técnica IMF [15, 16].
Para melhorar o desempenho dos fotodetectores baseados no InAs / GaSb T2SL, é necessária uma melhor compreensão dos parâmetros fundamentais. Um desses parâmetros é a concentração do transportador de fundo que está associada ao tempo de vida do transportador minoritário e aos comprimentos de difusão. É importante notar que os materiais a granel InAs e GaSb têm polaridade oposta de concentração de portadores. Na verdade, os materiais InAs e GaSb cultivados usando epitaxia de feixe molecular (MBE) são residualmente n - e p -tipo, respectivamente [17, 18]. Consequentemente, prevê-se que a condução do InAs / GaSb T2SL seja dependente da espessura de cada constituinte.
Neste artigo, investigamos as propriedades de transporte no plano de 10 ML InAs / 10 ML GaSb e 24 ML InAs / 7 ML GaSb T2SLs dedicados à detecção em regiões MWIR e LWIR, respectivamente, cultivadas em GaAs semi-isolantes (001) substratos. Este estudo é realizado através da realização de uma medição do efeito Hall dependente da temperatura usando o método Van der Pauw. Além disso, é apresentada a influência da temperatura de crescimento na condução do InAs / GaSb T2SL.
Métodos
As amostras InAs / GaSb T2SL foram cultivadas em substratos GaAs (001) semisolantes em um sistema MBE de fonte sólida RIBER Compact 21-DZ. Este último é equipado com células de efusão padrão para elementos do grupo III (índio (In) e gálio (Ga)) e células quebradas com válvula para materiais do grupo V (arsênio (As) e antimônio (Sb)). As temperaturas do cracker foram mantidas em 900 ° C para As e Sb para produzir As 2 e Sb 2 , respectivamente. O termopar do manipulador (TC) e o BandiT (BT) são utilizados para monitorar a temperatura de crescimento. Este último foi calibrado a partir da temperatura de dessorção do óxido de GaAs. Após a desoxidação dos substratos de GaAs a 610 ° C (medido por BT), uma camada de GaAs de 250 nm de espessura foi depositada a 585 ° C (BT) para obter uma superfície inicial lisa. Posteriormente, uma camada tampão de GaSb de 1 μm de espessura foi cultivada usando a técnica de IMF a uma temperatura BT de 440 ° C [16, 19]. Esta técnica consiste na formação de uma matriz periódica de deslocamento incorreto de 90 ° na interface GaAs / GaSb levando a uma densidade de deslocamento baixa (≈ 10 6 cm −2 ) [20]. Após o crescimento da camada tampão de GaSb, o BT não pode mais ser usado devido às mudanças de emissividade, rugosidade da superfície e mecanismos extras de absorção radiativa [21]. Assim, a temperatura de crescimento do InAs / GaSb T2SL é controlada apenas pelo TC. MWIR 10 ML InAs / 10 ML GaSb T2SLs são cultivados em diferentes temperaturas de substrato, 330, 390 e 400 ° C (TC) para investigar a influência da temperatura de crescimento nas propriedades de transporte. Por outro lado, o LWIR 24 ML InAs / 7 ML GaSb T2SL foi depositado a apenas 390 ° C. A fim de compensar a deformação entre InAs e GaSb, a sequência de venezianas especiais, que foi relatada como levando a uma melhor qualidade estrutural [22, 23], foi usada da seguinte maneira:o crescimento de InAs foi seguido por uma imersão de Sb de 8 s para formar InSb ligações semelhantes, ao passo que o crescimento de GaSb foi seguido por 2 s de As soak para aumentar a interface semelhante a GaAs. A razão de fluxo V / III é de 8,3 e 4,6 para InAs e GaSb, respectivamente. Além disso, a taxa de crescimento é de 0,5 ML / s para InAs e GaSb. O crescimento foi monitorado in situ pelo sistema de difração de elétrons de alta energia por reflexão (RHEED).
As amostras cultivadas foram avaliadas por difração de raios-X de alta resolução (HRXRD) de PANalytical X'Pert para investigar as propriedades estruturais. O Cu Kα 1 radiação ( λ ≈ 1,5406 Å) originado de um foco de linha e um monocromador Ge (004) de quatro saltos foram utilizados. As propriedades de transporte foram avaliadas por medições de efeito Hall usando o método Van der Pauw em um sistema ECOPIA, com uma faixa de temperatura de 80–300 K. As medições foram realizadas em amostras quadradas de 6 × 6 mm 2 ; o contato era feito por pontos de índio em cada canto. Um campo magnético de 0,4 T foi aplicado normal às amostras.
Resultados e discussão
A Figura 1 ilustra o HRXRD medido e simulado 2θ-ω curvas de varredura da reflexão simétrica (004) para os T2SLs MWIR e LWIR InAs / GaSb. A simulação é realizada pelo software “Epitaxy” fornecido pela PANalytical X’Pert. Como se pode verificar, existem satélites bem resolvidos com uma encomenda até 4 para MWIR T2SL e até 7 para um LWIR. Isso indica a alta qualidade estrutural das camadas crescidas, especialmente para LWIR T2SL. Por outro lado, a largura total na metade do máximo (FWHM) do pico de ordem zero medido em ω-2θ direção é 107 e 99 arcsec para MWIR e LWIR T2SLs, respectivamente. O período da superrede ( L ) é determinado a partir da distância angular entre dois satélites adjacentes (Δ θ ) do seguinte modo:

HRXRD 004 2θ-ω digitalização de a MWIR b e LWIR InAs / GaSb T2SLs. HRXRD experimental (linha preta) e simulado (linha vermelha) 2θ-ω procura o (004) reflexo de a MWIR T2SL; existem satélites bem resolvidos com uma ordem de até 4, o que é uma característica de boa qualidade da superrede. O FWHM do pico da ordem zero é 107 arcsec, b e LWIR InAs / GaSb T2SLs; existem picos de satélite com uma ordem de até 7, o que confirma a alta qualidade cristalina. O FWHM do pico da ordem zero é 99 arcsec. O período de cada superrede é calculado a partir da distância entre satélites adjacentes
$$ L =\ lambda / \ left (2 \ times \ Delta \ theta \ times \ mathit {\ cos} {\ theta} _ {SL} \ \ right) $$ (1)
onde λ é o comprimento de onda do feixe de raios-X incidente mencionado anteriormente e θ SL é o ângulo de Bragg do pico de ordem zero da superrede. Na Fig. 1, o período dos T2SLs MWIR e LWIR é de 6,74 ± 0,01 e 10,24 ± 0,02 nm, respectivamente. Ao ajustar a curva medida com a simulada, a composição de um período de MWIR T2SL é considerada a seguinte:GaSb 3,4 nm (11,2 ML), GaAs 0,1 nm (0,2 ML), InAs 3,0 nm (10,1 ML) e InSb 0,2 nm (0,5 ML). Além disso, as espessuras dos constituintes LWIR T2SL são as seguintes:GaSb 2,3 nm (7,5 ML), GaAs 0,1 nm (0,2 ML), InAs 7,4 nm (24,7 ML) e InSb 0,4 nm (1 ML). A incompatibilidade de rede determinada a partir do ângulo entre o pico de ordem zero e a camada de buffer GaSb é 8,9 × 10 −3 e 4,5 × 10 −3 para MWIR e LWIR T2SLs, respectivamente. A Figura 2 apresenta o mapa do espaço recíproco (RSM) assimétrico (115) para os T2SLs crescidos. Em ambas as amostras, os satélites das superredes e o pico de GaSb estão alinhados verticalmente (eles têm o mesmo componente do vetor de espalhamento Q x ), o que leva à conclusão de que ambos os T2SLs estão praticamente totalmente tensos.

Assimétrico 115 RSM de a MWIR e b LWIR InAs / GaSb T2SLs. O mapa do espaço recíproco para a reflexão assimétrica (115) de a MWIR e b LWIR InAs / GaSb T2SLs. Os picos em ambas as superredes são alinhados verticalmente (eles têm o mesmo valor do vetor de dispersão Q x ) Portanto, as duas superredes para MWIR e LWIR estão praticamente totalmente tensionadas
Os parâmetros elétricos in-plane dos MWIR InAs / GaSb T2SLs crescidos são ilustrados na Fig. 3. Como pode ser visto, o InAs / GaSb T2SL dopado não intencionalmente exibe uma mudança reprodutível no tipo de condutividade. Apesar da influência da camada de buffer GaSb ( p -tipo) nas medições do efeito Hall, deve-se notar que a alteração do tipo de condutividade é devida apenas à camada T2SL. Essa mudança também foi relatada por vários grupos [6, 24,25,26]. O T2SL exibe um p -tipo de condução abaixo da temperatura em que a mudança ocorre ( T ch ) e um n -tipo de condução acima de T ch . Como mencionado anteriormente, as camadas InAs e GaSb exibem um n -tipo e p -tipo de condução, respectivamente. Portanto, o background residual do InAs / GaSb T2SL com espessura semelhante para os dois constituintes é induzido pela compensação da portadora majoritária dos constituintes binários do T2SL [27]. Para o valor de T ch , Mohseni et al. [6] relataram um valor de 140 K, Christol et al. [24] obteve um valor de 190 K, enquanto Khoshakhlagh et al. [25] apontaram um valor de 200 K. O comportamento da concentração e mobilidade do portador da folha é governado pelos conhecidos mecanismos intrínsecos de espalhamento de fônons (acústico, piezoelétrico, polar e óptico não polar). Excepcionalmente, a mobilidade do Hall aumenta com o aumento da temperatura acima de T ch (Fig. 3b); isto é provavelmente devido às armadilhas ionizadas devido à interface InSb na interface GaSb-on-InAs [6]. T ch o valor é 145, 195 e 225 K, para o T2SL crescido a 330, 390 e 400 ° C, respectivamente (Fig. 3); isso é devido provavelmente para a alta concentração de orifício na temperatura de crescimento mais alta, o que muda o T ch para baixar a temperatura. A alta concentração do orifício é devido a defeitos e vacâncias ionizadas em alta temperatura de crescimento. O InAs / GaSb T2SL cultivado a 390 ° C é caracterizado por uma concentração de portador de 1,8 × 10 16 e 2,5 × 10 16 cm −3 a 80 e 300 K, respectivamente. Esse resultado é melhor do que o relatado por Mohseni et al. [6] (a concentração de Hall varia de 1,5 a 4 × 10 17 cm −3 ) e praticamente igual ao relatado por Christol et al. [24] (concentração Hall de 1,6 × 10 16 e 6 × 10 16 cm −3 a 100 e 300 K, respectivamente). Por outro lado, a mobilidade Hall é 1300 ( p -tipo) e 3200 cm 2 / V s ( n -tipo), a 80 e 300 K, respectivamente. A mobilidade alcançada é muito maior do que a relatada por Christol et al. [24], que obteve uma mobilidade Hall de 100 e 1800 cm 2 / V s a 100 e 300 K, respectivamente.

a Concentração Hall e b Mobilidade Hall do MWIR InAs / GaSb T2SL crescido a diferentes temperaturas. Os parâmetros elétricos dos T2SLs MWIR InAs / GaSb cresceram a diferentes temperaturas. a Concentração Hall:os três T2SLs exibem uma mudança de condutividade. Eles são p -tipo em baixas temperaturas e n -tipo em altas temperaturas. b Mobilidade Hall:existem duas regiões para a tendência de mobilidade. Para baixa temperatura, a mobilidade diminui devido aos diferentes mecanismos de espalhamento. Para altas temperaturas, a mobilidade aumenta com o aumento da temperatura, o que pode ser explicado pelas armadilhas ionizadas na interface do tipo InSb. A temperatura na qual a mudança de condutividade ocorre aumenta quando a temperatura de crescimento aumenta, o que é devido aos altos níveis de defeito em temperaturas mais altas
A resistividade das três diferentes amostras é mostrada na Fig. 4. Pode-se notar que a resistividade e a temperatura possuem duas inclinações bem definidas. Para cada amostra, duas energias de ativação térmica podem ser extraídas da lei de Arrhenius. Para o n -tipo região, a energia de ativação E um é 58, 72 e 68 meV para o T2SL cultivado a 330, 390 e 400 ° C, respectivamente. Enquanto para o p -tipo região, E ap é igual a 7, 12 e 14 meV, para o T2SL InAs / GaSb depositado a 330, 390 e 400 ° C, respectivamente. Para baixas temperaturas (abaixo de T ch ), o T2SL mostra um p -tipo devido a p -tipo de operadoras associadas a E ap que dominam os mecanismos de geração e recombinação de portadores. Para temperaturas acima de T ch , o T2SL exibe um n -tipo de condução devido à ativação de portadores de nível profundo associados com alta energia de ativação E um . A origem destes níveis profundos são os níveis rasos nos InAs bulk que resultam do alinhamento da banda entre InAs e InAs / GaSb T2SL e que atuam como níveis profundos nos InAs / GaSb T2SL [28].
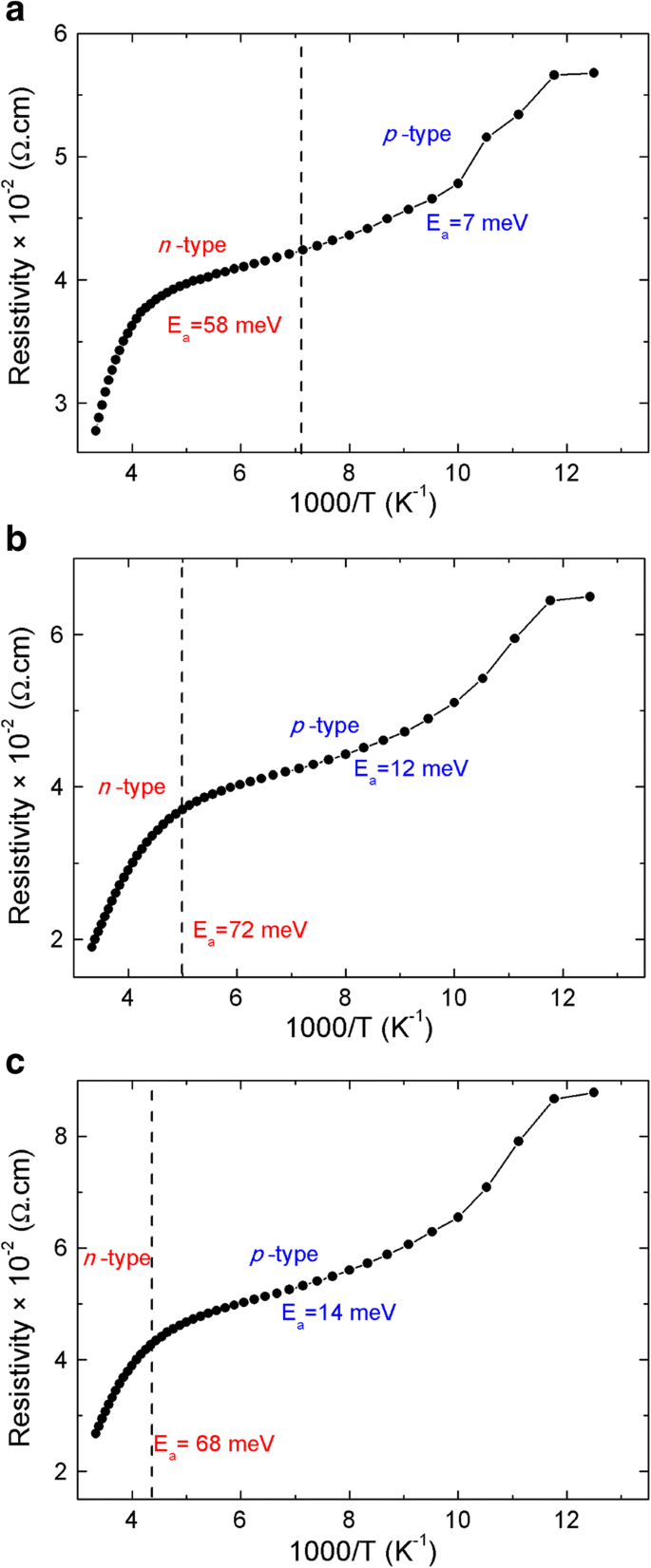
Resistividade Hall do MWIR InAs / GaSb T2SL aumentada em a 330 ° C, b 390 ° C e c 400 ° C. A resistividade Hall do MWIR InAs / GaSb T2SL depositado em diferentes temperaturas de crescimento, a 330 ° C, b 390 ° C e c 400 ° C. Para cada gráfico, existem duas inclinações bem definidas. Da lei de Arrhenius, duas energias térmicas podem ser extraídas, o que confirma a existência de dois níveis de impureza. Um representa o n -tipo portadores, e o segundo corresponde ao p -tipo transportadoras. O nível de impureza profunda associado ao n -tipo transportadoras é o resultado da formação da banda entre InAs e InAs / GaSb T2SL
A concentração Hall, a mobilidade e a resistividade do LWIR InAs / GaSb T2SL são apresentadas na Fig. 5. Em oposição ao MWIR T2SL, não existe alteração do tipo de condutividade no caso desta amostra. Este T2SL exibe um n -tipo de condução. A influência do p -tipo GaSb buffer (portadores de baixa mobilidade) camada na medição do efeito Hall para este n -tipo T2SL (transportadoras de alta mobilidade) é insignificante, uma vez que a mobilidade Hall é proporcional ao quadrado da mobilidade das transportadoras. Khoshakhlagh et al. [25] relataram o mesmo resultado para 13 ML InAs / 7 ML GaSb T2SL. Além disso, Szmulowicz et al. [29] apontou que LWIR T2SL, em que a camada InAs é mais espessa que GaSb, tende a ser n -modelo. Este n a condução do tipo é devido à grande espessura da camada InAs (residualmente n -dopado.) em comparação com o de GaSb. Estes n Os portadores do tipo estão associados a uma energia de ativação de 33 meV (Fig. 5b). O comportamento da concentração e mobilidade Hall é típico para n -tipo semicondutores, exceto a faixa de temperatura abaixo de 95 K, onde a concentração e mobilidade do portador são quase independentes da temperatura. Isso é uma indicação da existência de um mecanismo de espalhamento independente da temperatura nesta região de temperatura. Este último é demonstrado ser o mecanismo de espalhamento de rugosidade da interface (IRS) [30,31,32,33,34]. Este mecanismo é dominante em baixas temperaturas, onde o espalhamento de fônons é congelado [35]. O mecanismo de IRS se deve à existência de interfaces, bem como à variação das espessuras das camadas, o que resulta na variação dos níveis de energia eletrônica; portanto, eles agem como uma fonte de espalhamento de portadoras [35]. Além disso, a mobilidade Hall dominada pelo mecanismo IRS é proporcional à sexta potência da espessura InAs (\ (\ mu \ propto {d} _ {\ mathrm {InAs}} ^ {6.2} \)) [35].

a Concentração de salão, mobilidade de salão e b Resistividade Hall de LWIR InAs / GaSb T2SL dopado involuntariamente. As propriedades de transporte do LWIR InAs / GaSb T2SL. a Concentração e mobilidade no hall:esta superrede exibe apenas n -tipo de condução para toda a faixa de temperatura. A concentração de Hall aumenta com o aumento da temperatura, que é causada pelos efeitos da ionização. Por outro lado, o comportamento da mobilidade de Hall é regido pelos diferentes mecanismos de espalhamento (fônons e impurezas ionizadas) para temperaturas superiores a 95 K. Para temperaturas abaixo de 95 K, a mobilidade é constante (assim como a concentração de Hall), o que confirma a existência de outro mecanismo de espalhamento independente da temperatura. Este último é o mecanismo de rugosidade da interface. b Resistividade de Hall:da lei de Arrhenius, existe apenas uma energia térmica associada a um nível de impureza
Conclusões
Em resumo, InAs / GaSb T2SLs foram cultivados em substrato de GaAs usando uma camada de buffer de GaSb com base na técnica de IMF. Além disso, esses T2SLs foram demonstrados para regiões de detecção MWIR e LWIR. Verificou-se que MWIR T2SL apresenta uma alteração no tipo de condução, forma p - para n -tipo à medida que a temperatura aumenta. Além disso, a temperatura na qual a mudança ocorre aumenta à medida que a temperatura de crescimento dos T2SLs aumenta. Essa mudança no tipo de condução é atribuída à existência de dois níveis de impurezas com duas energias de ativação diferentes. Por outro lado, a condução LWIR InAs / GaSb T2SL demonstra ser n -tipo para toda a faixa de temperatura. Além dos mecanismos de espalhamento convencionais, o mecanismo IRS provou ser o mecanismo de espalhamento dominante em baixas temperaturas. Estes resultados permitem uma melhor compreensão das propriedades físicas do InAs / GaSb T2SL, o que conduz à melhoria do desempenho do fotodetector IR baseado neste material.
Abreviações
- BT:
-
Bandido
- FPAs:
-
Matrizes de plano focal
- FWHM:
-
Largura total pela metade no máximo
- QUENTE:
-
Alta temperatura de operação
- HRXRD:
-
Difração de raios-x de alta resolução
- IMF:
-
Matriz de desajuste interfacial
- IR:
-
Infravermelho
- IRS:
-
Espalhamento de rugosidade da interface
- LWIR:
-
Infravermelho de onda longa
- MBE:
-
Epitaxia de feixe molecular
- MWIR:
-
Infravermelho de onda média
- RHEED:
-
Difração de elétrons de alta energia de reflexão
- RSM:
-
Mapa do espaço recíproco
- T2SL:
-
Superrede tipo II
- TC:
-
Par termoelétrico
Nanomateriais
- Preparação e propriedades magnéticas de nanopartículas de espinélio FeMn2O4 dopadas com cobalto
- Em direção aos nanofluidos de TiO2 - Parte 1:Preparação e propriedades
- Modelagem de Dinâmica Molecular e Simulação de Corte de Cério com Diamante
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- Dependência da temperatura do gap em MoSe2 crescido por epitaxia de feixe molecular
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Efeitos bipolares na fotovoltagem de heteroestruturas de pontos quânticos de InAs / InGaAs / GaAs metamórficos:soluções de caracterização e design para dispositivos sensíveis à luz
- Preparação e propriedades ópticas de filmes GeBi usando o método de epitaxia de feixe molecular
- Sondando as propriedades estruturais, eletrônicas e magnéticas dos aglomerados Ag n V (n =1–12)
- Dependência da toxicidade das nanopartículas em suas propriedades físicas e químicas



