Janela de memória e melhoria da resistência de FeFETs baseados em Hf0.5Zr0.5O2 com camadas de sementes de ZrO2 caracterizadas por medições de pulso de tensão rápida
Resumo
O HfO 2 O transistor de efeito de campo ferroelétrico (FeFET) com uma pilha de portas de metal / ferroelétrico / isolante / semicondutor (MFIS) está sendo considerado um possível candidato para memória não volátil de alta densidade e velocidade de gravação rápida. Embora o desempenho de retenção do HfO 2 O FeFET baseado em uma pilha de portas MFIS pode satisfazer os requisitos para aplicações práticas, sua janela de memória (MW) e confiabilidade com relação à resistência devem ser melhoradas ainda mais. Este trabalho investiga a vantagem de empregar ZrO 2 camadas de sementes no MW, retenção e resistência do Hf 0,5 Zr 0,5 O 2 (HZO) -based FeFETs com MFIS gate stacks, usando medições rápidas de pulso de tensão. Verificou-se que o FeFET baseado em HZO com um ZrO 2 camada de sementes mostra um MW inicial maior e extrapolado de 10 anos, bem como desempenho de resistência aprimorado em comparação com o FeFET à base de HZO sem o ZrO 2 camada de sementes. Os resultados indicam que o emprego de uma pilha de portas de alto k / Si cristalino direto melhoraria ainda mais o MW e a confiabilidade do HfO 2 com base em FeFETs.
Histórico
HfO 2 películas finas ferroelétricas são consideradas como materiais de empilhamento de porta promissores para transistores de efeito de campo ferroelétrico (FeFETs) devido à sua compatibilidade e escalabilidade de semicondutor de óxido metálico complementar (CMOS). Entre vários tipos de estruturas de empilhamento de portas que podem ser usadas em FeFETs, um metal / ferroelétrico / isolante / semicondutor (MFIS) representa uma configuração mais prática porque segue as arquiteturas de dispositivo MOS atuais e combina bem com o moderno high-k metal-gate (HKMG) processos. Portanto, grandes esforços têm sido feitos para projetar e fabricar FeFETs com estruturas de pilha de portas MFIS para aplicações em memórias não voláteis incorporadas, transistores de efeito de campo de capacitância negativa, neurônios artificiais, sinapses e dispositivos de lógica em memória [1,2,3,4 , 5,6,7,8].
Até agora, FeFETs de alta densidade e velocidade de gravação rápida com estruturas de pilha de portas MFIS foram fabricados com sucesso usando processos HKMG [9, 10]. Além da alta densidade de integração e velocidade de gravação rápida, uma grande janela de memória (MW) e uma alta confiabilidade com respeito à retenção e resistência também são essenciais para o emprego de FeFETs para aplicações de memória não volátil [11,12,13,14]. Devido a um grande deslocamento de banda para o silício, um campo altamente coercivo e uma constante dielétrica moderada do HfO 2 filmes finos ferroelétricos baseados em HfO 2 FeFETs com base em estruturas MFIS gate stack exibem propriedades de retenção confiáveis (extrapolação de 10 anos) [15,16,17]. No entanto, embora o HfO 2 filmes finos baseados em demonstram resistência moderada acima de 1 × 10 9 ciclos de comutação [14, 18], HfO 2 FeFETs com base em estruturas de pilha de portas MFIS têm uma resistência bastante limitada variando de 1 × 10 4 para 1 × 10 7 ciclos de comutação [17, 19,20,21,22,23]. Teoricamente, o emprego de camadas isolantes de alto k deve reduzir o campo elétrico na pilha de portas MFIS, o que aliviaria a curvatura da banda, melhorando assim as propriedades de resistência e os MWs do HfO 2 com base em FeFETs [12, 14]. Experimentalmente, Ali et al. verificou que o aumento do valor k da camada isolante ultrafina (ou seja, usando SiON em vez de SiO 2 ) pode melhorar efetivamente as propriedades de resistência, bem como o MW do HfO 2 com base em FeFETs [13]. Em nossa pesquisa anterior [24], relatamos que a inserção de um ZrO 2 cristalino camada high-k nas pilhas de gate MFIS pode melhorar a qualidade cristalina e suprimir a formação da fase monoclínica em Hf 0,5 Zr 0,5 O 2 (HZO) filmes finos, o que leva a um grande MW de 2,8 V caracterizado pelo método de varredura de tensão DC.
Neste trabalho, relatamos a caracterização dos MWs, retenção e resistência dos FeFETs à base de HZO com e sem ZrO cristalino 2 camadas de sementes usando medições rápidas de pulso de tensão positiva e negativa. Além disso, a vantagem de empregar ZrO cristalino 2 camadas de sementes no MW e propriedades de resistência são discutidas.
Métodos
Os FeFETs de canal n com e sem ZrO 2 camadas de sementes foram fabricadas usando um processo de última porta, conforme descrito em [24]. O ZrO 2 camada de sementes e a camada de HZO foram ambas cultivadas a uma temperatura de crescimento de 300 o C por deposição de camada atômica (ALD). O esquema dos FeFETs fabricados é mostrado na Fig. 1a, cuja largura do canal ( W ) e comprimento ( L ) foram 80 e 7 μm, respectivamente. Enquanto isso, TaN / HZO / TaN e TaN / HZO / ZrO 2 / Capacitores TaN também foram fabricados para avaliar as propriedades ferroelétricas dos filmes finos de HZO. A tensão de polarização ( P-V ) os loops de histerese dos capacitores foram medidos usando um sistema de teste ferroelétrico Radiant Technologies RT66A, enquanto as características do dispositivo de FeFETs foram medidas por um analisador de dispositivo semicondutor Agilent B1500A com uma unidade geradora de pulso (B1525A) [20]. Duas sequências de teste principais usadas para MW e medições de resistência são mostradas nas Fig. 1b e c. Para medições de MW e retenção, pulsos de programar / apagar (P / E) foram primeiro aplicados às portas de FeFETs, e as operações de leitura foram realizadas em diferentes intervalos de tempo usando I D - V G varrer ( V D =0,1 V) para detectar V TH . Geralmente, V TH é determinada como uma tensão de porta correspondente a uma corrente de drenagem de 10 −7 A ∙ W / L [25], e o MW é definido como a diferença de V TH valores entre os estados programado e apagado. Para medições de resistência, o MW foi medido após um certo número de pulsos P / E alternados.

a Esquema dos FeFETs fabricados. O ZrO cristalino adicional 2 camada de semente é marcada por linhas de grade pretas. b , c Sequências de teste usadas para MW e medições de resistência
Resultados e discussão
A Figura 2a mostra o P – V loops de histerese do TaN / HZO / TaN e TaN / HZO / ZrO 2 / Capacitores TaN. Notavelmente, o TaN / HZO / ZrO 2 / O capacitor TaN possui propriedades ferroelétricas ainda melhores do que o capacitor TaN / HZO / TaN, o que é consistente com os resultados relatados [26], indicando que o ZrO cristalino 2 A camada de semente pode de fato melhorar a qualidade cristalina e suprimir a formação de fase monoclínica em filmes finos de HZO [24]. A Figura 2b mostra o I D - V G curvas dos FeFETs à base de HZO com e sem ZrO cristalino adicional 2 camadas de sementes após pulsos P / E. As linhas de símbolo vermelho representam o I D - V G curvas após a aplicação de um pulso de programa de 7 V / 100 ns, enquanto as linhas de símbolo azuis representam o I D - V G curvas após a aplicação de um pulso de apagamento de - 7 V / 100 ns. Pode-se ver que o eu D - V G curvas de ambos os FeFETs mostram características de comutação no sentido anti-horário, sugerindo que os MWs dos FeFETs presentes são originados da comutação de polarização das camadas HZO, ao invés do aprisionamento de carga e injeção. No entanto, o FeFET à base de HZO com o ZrO cristalino adicional 2 camada de semente exibe um MW melhorado de 1,4 V, aproximadamente 1,8 vezes maior do que (0,8 V) do FeFET à base de HZO sem o ZrO cristalino adicional 2 camada de sementes. Além disso, o MW obtido de 1,4 V é comparável aos melhores resultados relatados até o momento [9, 11, 14, 17, 21,22,23, 27].
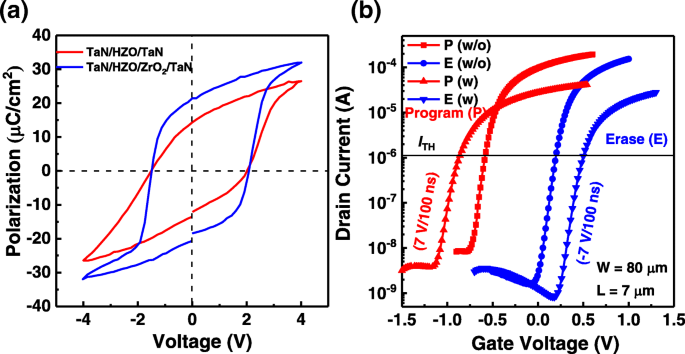
a P – V loops de histerese de TaN / HZO / TaN e TaN / HZO / ZrO 2 / TaN estruturas MFM medidas a 4 V e uma frequência de 5 kHz. b eu D - V G curvas de FeFETs baseados em HZO com (w) e sem (w / o) ZrO 2 camadas de sementes após um pulso de programa (+ 7 V / 100 ns) e um pulso de apagamento (- 7 V / 100 ns)
Confiabilidade em relação à retenção dos FeFETs à base de HZO com e sem ZrO cristalino adicional 2 camadas de sementes também foram avaliadas. A Figura 3 mostra o V TH características de retenção após a aplicação de um pulso de programa de 7 V / 100 ns e um pulso de apagamento de - 7 V / 100 ns em temperatura ambiente. É claro que o V TH os valores são aproximadamente lineares com a escala de tempo logarítmica. O MW extrapolado após 10 anos para o FeFET à base de HZO com o ZrO cristalino adicional 2 camada de semente é 0,9 V, maior do que (0,6 V) para o FeFET à base de HZO sem o ZrO cristalino adicional 2 camada de sementes. Uma vez que a espessura equivalente de capacitância espessa (CET) do ZrO 2 (1,5 nm) / SiO 2 (2,6 nm) camadas isolantes de porta levariam a um campo de despolarização aprimorado na pilha de portas [13, 15], uma melhoria adicional nas propriedades de retenção poderia ser esperada se a espessura do SiO 2 camada é reduzida.

Características de retenção de FeFETs baseados em HZO com e sem ZrO 2 camadas de sementes
A Figura 4 mostra a evolução de I D - V G curvas após ± 7 V / 100 ns alternando ciclos P / E. Para o FeFET sem o ZrO cristalino adicional 2 camada de sementes, deslocamento significativo e degradação de declive no I D - V G curvas são observadas desde os primeiros estágios do ciclo P / E, e o I D - V G curvas nos estados apagados exibem mais degradação de declive em comparação com os estados do programa. Para o FeFET com o ZrO cristalino adicional 2 camada de sementes, embora o I D - V G curvas em estados apagados exibem uma mudança positiva óbvia durante os estágios iniciais do ciclo P / E que é atribuída ao efeito de "despertar" [13, 28,29,30,31,32], nenhuma mudança óbvia de I D - V G curvas nos estados do programa são observadas até 1 × 10 3 ciclos. Além disso, para o FeFET com o ZrO cristalino adicional 2 camada de semente, o I D - V G curvas em ambos os estados apagado e programa exibem apenas uma ligeira degradação do declive até 1 × 10 3 ciclos.
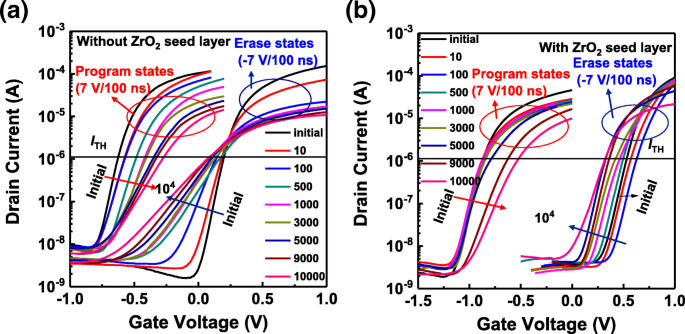
Evolução de I D - V G curvas de FeFETs baseados em HZO a sem e b com ZrO 2 camadas de sementes com ciclo P / E
De acordo com relatórios anteriores [12, 28, 33], a mudança paralela em I D - V G curvas é atribuída ao acúmulo gradual de cargas presas na pilha de portas, enquanto a degradação da inclinação em I D - V G curvas é o resultado da geração de interceptação de interface. Uma vez que as cargas presas podem ser retiradas por meios elétricos, mas a geração de armadilhas de interface é irreversível, minimizar a geração de armadilhas de interface é extremamente importante para melhorar as propriedades de resistência [28]. As interceptações de interface geradas por ciclagem P / E (Δ N it ) pode ser descrito usando a Eq. (1) [34, 35]:
$$ \ Delta \ mathrm {SS} =\ frac {\ Delta {N} _ {it} kT \ ln 10} {C_ {FI} {\ varnothing} _F} $$ (1)
onde ΔSS é a mudança da oscilação do sublimiar, k é a constante de Boltzmann, T é a temperatura absoluta, C FI é a capacitância total da pilha de portas, e ∅ F é o potencial Fermi. O Δ N it como uma função do ciclo P / E para os FeFETs à base de HZO com e sem ZrO cristalino adicional 2 camadas de sementes são mostradas na Fig. 5. Claramente, para o FeFET sem o ZrO cristalino adicional 2 camada de semente, o Δ N it aumenta obviamente a partir dos estágios iniciais do ciclo P / E, e Δ N it nos estados apagados é muito maior do que nos estados do programa. No entanto, o Δ N it para o FeFET com o ZrO cristalino adicional 2 camada de sementes quase não muda até 1 × 10 3 ciclos, e é sempre menor do que para o FeFET sem o ZrO cristalino adicional 2 camada de sementes. Porque inserir o ZrO adicional 2 camada de sementes reduz o campo elétrico na pilha de portas e, assim, a curvatura da banda é mais fraca, a geração de armadilha de interface é aliviada [12, 14].
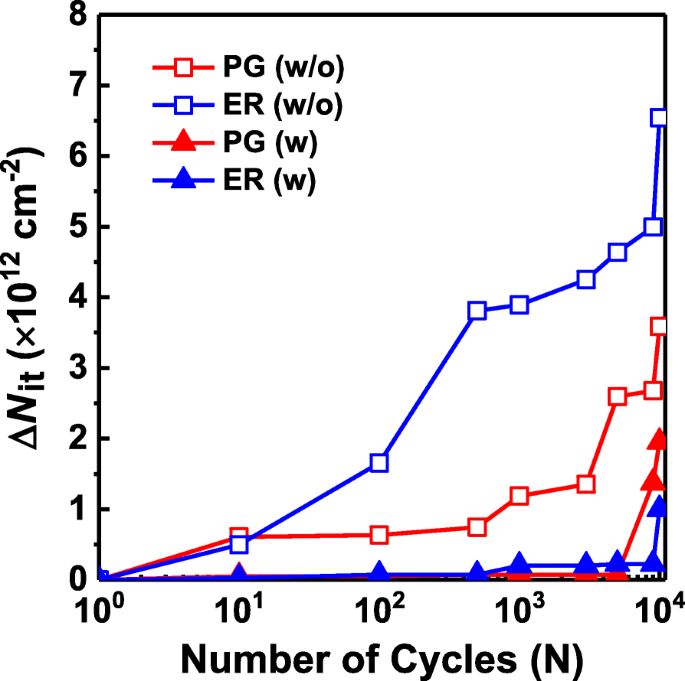
Evolução de ∆ N it com ciclagem P / E
A Figura 6 mostra a evolução das características da corrente de fuga da porta ( I G - V G curvas) de FeFETs baseados em HZO com e sem ZrO 2 camadas de sementes com ciclagem P / E. Para o FeFET sem o ZrO cristalino adicional 2 camada de sementes, a corrente de fuga da porta aumenta dramaticamente desde os estágios iniciais do ciclo P / E. No entanto, a corrente de fuga da porta para o FeFET com o ZrO cristalino adicional 2 camada de sementes quase não muda até 5 × 10 2 ciclos, e é sempre menor do que para o FeFET sem o ZrO cristalino adicional 2 camada de sementes. É relatado que o aumento na corrente de fuga da porta pode estar relacionado aos traps de interface gerados [28]. A redução na corrente de fuga de porta com ciclagem para o FeFET com o ZrO cristalino adicional 2 camada de sementes seria atribuída à supressão da geração de armadilhas de interface.
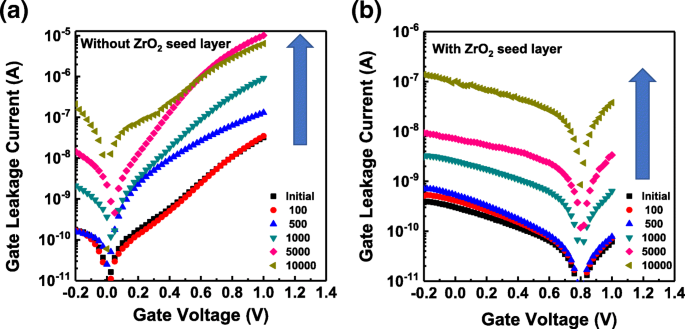
Evolução das características de corrente de fuga da porta ( I G - V G curvas) de FeFETs baseados em HZO a sem e b com ZrO 2 camadas de sementes com ciclo P / E
O V TH valores para programas e estados de apagamento extraídos do I D - V G curvas dos FeFETs à base de HZO com e sem ZrO cristalino adicional 2 as camadas de sementes são mostradas na Fig. 7. O FeFET à base de HZO com o ZrO cristalino adicional 2 camada de semente sempre exibe um MW maior do que o FeFET à base de HZO sem o ZrO cristalino adicional 2 camada de sementes. Além disso, o MW do FeFET à base de HZO sem o ZrO cristalino adicional 2 camada de semente diminui obviamente a partir dos estágios iniciais do ciclo P / E, enquanto o MW do FeFET à base de HZO com o ZrO cristalino adicional 2 camada de sementes diminui ligeiramente até 1 × 10 3 ciclos. À medida que o número de ciclagem P / E aumenta ainda mais, o FeFET à base de HZO com o ZrO cristalino adicional 2 camada de semente também mostra degradação óbvia na inclinação do I D - V G curvas e o MW, devido à geração aprimorada de armadilhas de interface. No entanto, o MW do FeFET à base de HZO com o ZrO cristalino adicional 2 camada de semente ainda é maior que 0,9 V até 1 × 10 4 ciclos, que é aproximadamente 2,3 vezes maior do que (0,4 V) do FeFET à base de HZO sem o ZrO cristalino adicional 2 camada de sementes. Conforme discutido anteriormente, a diminuição do campo elétrico necessário para a obtenção de estados de polarização mais saturados são provavelmente responsáveis pelas propriedades de resistência aprimoradas.

Evolução de V TH com ciclagem P / E
Conclusões
Os MWs, bem como a confiabilidade com relação à retenção e resistência dos FeFETs baseados em HZO com o TaN / HZO / SiO 2 / Si e TaN / HZO / ZrO 2 / SiO 2 / Si MFIS gate stacks foram caracterizados por medições rápidas de pulso de tensão. Os resultados mostram que o FeFET à base de HZO com o ZrO cristalino adicional 2 camada de semente exibe uma grande janela de memória inicial de 1,4 V e uma retenção extrapolada de 10 anos de 0,9 V, maior do que a janela de memória inicial (0,8 V) do FeFET à base de HZO sem o ZrO cristalino adicional 2 camada de sementes. Além disso, a confiabilidade com relação à resistência do FeFET à base de HZO pode ser melhorada inserindo o ZrO cristalino 2 camada de semente entre a camada HZO e o SiO 2 Substrato / Si. O MW e a melhoria da resistência de FeFETs baseados em HZO com ZrO 2 as camadas de sementes estão principalmente relacionadas à melhoria da qualidade cristalina da camada HZO e à geração suprimida de armadilhas de interface devido à diminuição do campo elétrico necessário para a obtenção de estados de polarização mais saturados. Com base neste trabalho, espera-se que o emprego de uma pilha de portas high-k / Si cristalino direto melhoraria ainda mais os MWs e a confiabilidade do HfO 2 com base em FeFETs e, portanto, justifica mais estudos e desenvolvimento.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste artigo estão incluídos no artigo.
Abreviações
- CMOS:
-
Semicondutor de óxido metálico complementar
- FeFET:
-
Transistor de efeito de campo ferroelétrico
- FeFETs:
-
Transistores de efeito de campo ferroelétrico
- HKMG:
-
High-k metal-gate
- HZO:
-
Hf 0,5 Zr 0,5 O 2
- I D :
-
Corrente de drenagem
- L:
-
Comprimento
- MFIS:
-
Metal / ferroelétrico / isolante / semicondutor
- MW:
-
Janela de memória
- P / E:
-
Programar / apagar
- P – V :
-
Polarização - tensão
- SS :
-
Balanço de sublimiar
- V G :
-
Tensão do portão
- V TH :
-
Tensão de limiar
- W:
-
Largura
- Δ N it :
-
A interface gerada intercepta
Nanomateriais
- ST:MCUs de 8 bits com analógico rico e DMA em pacote SO-8 de baixo custo
- Nanomaterial inteligente e nanocompósito com atividades agroquímicas avançadas
- Memória resistiva ZrO2 / ZrO2 - x / ZrO2 sem conformidade com comportamento de comutação multiestado interfacial controlável
- Mecanismo de condução e resistência aprimorada em RRAM baseado em HfO2 com tratamento de nitridação
- Melhoria de modulação e absorção de frequência do microbolômetro THz com estrutura de microponte por antenas tipo espiral
- Morfologia, estrutura e propriedades ópticas de filmes semicondutores com Nanislands GeSiSn e camadas deformadas
- FETs de canal U de porta retangular de alto desempenho com distância de apenas 2 nm entre os contatos de origem e drenagem
- Uma referência de voltagem sem resistor de baixa potência em nanoescala com alto PSRR
- Camada atômica depositada Memristor flexível à base de Hf0.5Zr0.5O2 com plasticidade sináptica de curto / longo prazo
- Alta tensão de ruptura e baixa resistência dinâmica ON AlGaN / GaN HEMT com implantação de íons de flúor na camada de passivação SiNx



