Caracterização e fabricação do CFM-JTE para dispositivo de energia 4H-SiC com proteção de alta eficiência e janela de tolerância de dose JTE aumentada
Resumo
Um retificador 4H-SiC PiN de 13,5 kV com uma área ativa considerável de 0,1 cm 2 é fabricado neste papel. A extensão de terminação de junção modulada por campo de carga (CFM-JTE) foi proposta para satisfazer o requisito de voltagem reversa ultra-alta, que aumenta a janela de tolerância de dose de JTE, tornando-a aproximadamente 2,8 vezes a do JTE convencional de duas zonas. Além disso, o CFM-JTE pode ser implementado através do processo JTE convencional de duas zonas. A corrente direta medida é de até 100 A @ V F =5,2 V na ausência de tecnologia de aprimoramento da vida útil da portadora. A estrutura CFM-JTE atinge 96% da tensão de ruptura teórica da junção do plano paralelo com uma área terminal relativamente pequena de 400 μm, o que contribui para alcançar a figura de mérito do Baliga de 58,8 GW / cm 2 .
Introdução
O carboneto de silício se tornou uma nova opção para melhorar as aplicações de energia devido às suas características de alta tensão operando em camadas ativas mais finas, densidade de energia estendida, comutação de maior frequência, melhor dissipação de calor, menor tamanho do sistema e menor custo do sistema [1, 2]. Nos últimos anos, retificadores comerciais de SiC e MOSFETs foram classificados em 1,2-1,7 kV. No entanto, em campos de aplicação representativos, como redes inteligentes, veículos elétricos, fontes de alimentação de pulso e fontes de alimentação de estado sólido de ultra-alta tensão, há uma demanda crescente por capacidade de bloqueio de mais de 10 kV e capacidade de corrente direta de mais de 1000 A cm -2 .
Até agora, os principais desafios enfrentados pelos dispositivos eletrônicos de potência de 10 kV e SiC de nível superior se concentraram no desempenho da tecnologia de terminação de junção, simplificação dos processos de fabricação, alta qualidade da camada epitaxial espessa e redução de defeitos de superfície. Para dispositivos de SiC de ultra-alta voltagem, o comprimento da estrutura terminal é principalmente 6–8 vezes maior do que a espessura epitaxial [3], o que reduz enormemente a taxa de utilização do wafer e, portanto, aumenta o custo de fabricação. Os retificadores 4H-SiC PiN se tornaram os candidatos mais adequados para aplicações de ultra-alta tensão como resultado do efeito de modulação da condutividade. Para a estrutura do anel limitador de campo (FLR), um projeto de otimização preciso pode ser obtido por meio de cálculo analítico [4], enquanto a fotolitografia atual não consegue realizar o espaço preciso e a largura dos anéis. O novo terminal de anel de limitação de campo para dispositivo de SiC de 10 kV foi aplicado para ter uma alta eficiência de proteção reversa [5, 6], mas sua área terminal excede 700 μm, resultando em consumo adicional do wafer de SiC. A extensão de terminação de junção (JTE) é outra estrutura de proteção de terminal de alta eficiência frequentemente usada, mas sua eficiência é extremamente sensível à dose de JTE. Para níveis de voltagem ultra-alta, os MZ-JTEs e os CD-JTEs [7] são utilizados para modular criticamente o campo elétrico e requerem condições e tempos de implantação de íons estritos, o que por sua vez aumenta a complexidade e o custo de fabricação. A fim de melhorar a capacidade de condução, pesquisas sobre as características da altura da barreira entre diversos metais e SiC têm sido realizadas [8, 9]. Normalmente, o filme de Ti / Al com 50-100 nm de espessura é formado para o contato ôhmico do anodo e o filme de Ni para o contato ôhmico do cátodo, respectivamente. Além disso, a escala da área ativa do retificador 4H-SiC afetará muito as características da corrente direta. Verificou-se que na camada epitaxial do tipo 4H-SiC N, o Z 1/2 centro ( E C —0,65 eV), o nível do aceitador da monovacância do carbono, afeta principalmente o tempo de vida do portador [10]. A implantação de íons de alumínio levará a uma grande concentração de níveis profundos massivos envolvendo o Z 1/2 centro na periferia da mesa e região de terminação da junção [11], resultando em uma diminuição no tempo de vida da portadora. Portanto, retificadores 4H-SiC com uma grande área ativa (> 9 mm 2 ) são necessários no projeto e fabricação para o impacto da redução da vida útil do portador na região da periferia da mesa e a região de terminação é relativamente insignificante.
Neste artigo, o retificador 4H-SiC CFM-JTE PiN é fabricado em uma camada epitaxial de 100 μm de 5 × 10 14 cm −3 e atinge capacidade de bloqueio considerável de 13,5 kV no estado desligado e corrente direta de 100A @ V F =5,2 V no estado ligado. O diferencial na resistência do retificador CFM-JTE PiN é medido em 3,1 mΩ cm 2 à temperatura ambiente. O CFM-JTE obtém 96% da tensão de ruptura teórica por meio do conceito e da análise da modulação do campo de carga, o que expande favoravelmente a janela de tolerância da dose de implantação e leva a um comprimento de terminação aceitável de 400 μm.
Métodos
Análise da estrutura do dispositivo
O projeto, otimização e análise são executados pelo Silvaco-TCAD. A Figura 1 mostra o esquema da estrutura 4H-SiC PiN com terminação, envolvendo:(a) modulação por campo de carga (CFM-JTE), (b) JTE assistido por anel externo (ORA-JTE) e (c) JTE de duas zonas (TZ-JTE). No estado de bloqueio, a taxa de ionização de colisão elétron-buraco está intimamente relacionada à intensidade do campo elétrico. Um conceito de modulação de campo elétrico de carga E q ( r ) é proposto para revelar o mecanismo de modulação do CFM-JTE através do método de superposição vetorial do campo elétrico terminal causado pelo campo elétrico de carga E q ( r ) na Fig. 1a. O CFM-JTE consiste na região JTE1, região JTE2 e três grupos de anéis. Os anéis múltiplos dividem equivalentemente o terminal em cinco zonas dopadas:R 1 -R 2 , R 2 -R 3 , R 3 -R 4 , R 4 -R 5 e R 5 -R 6 , onde cobranças efetivas de Q 1 , Q 2 , Q 3 , Q 4 e Q 5 são apresentados, respectivamente. Com base na decomposição e sobreposição de vetores de campo elétrico em x e y coordenadas, o campo elétrico geral localizado em R i ponto causado pelo campo potencial aplicado E p ( r ) e o campo elétrico de carga E Qi ( r ) gerado por cada Q i pode ser expresso analiticamente no x e y direções, conforme fornecido nas Eqs. (1) e (2), respectivamente.
$$ E_ {Ri, x} =E_ {px} + \ mathop \ sum \ limits_ {j =1} ^ {i - 1} E_ {Qjx} - \ mathop \ sum \ limits_ {j =i} ^ {5 } E_ {Qjx} $$ (1) $$ E_ {Ri, y} =E_ {py} + \ mathop \ sum \ limits_ {j =1} ^ {i - 1} E_ {Qjy} + \ mathop \ sum \ limits_ {j =i} ^ {5} E_ {Qjy} $$ (2)
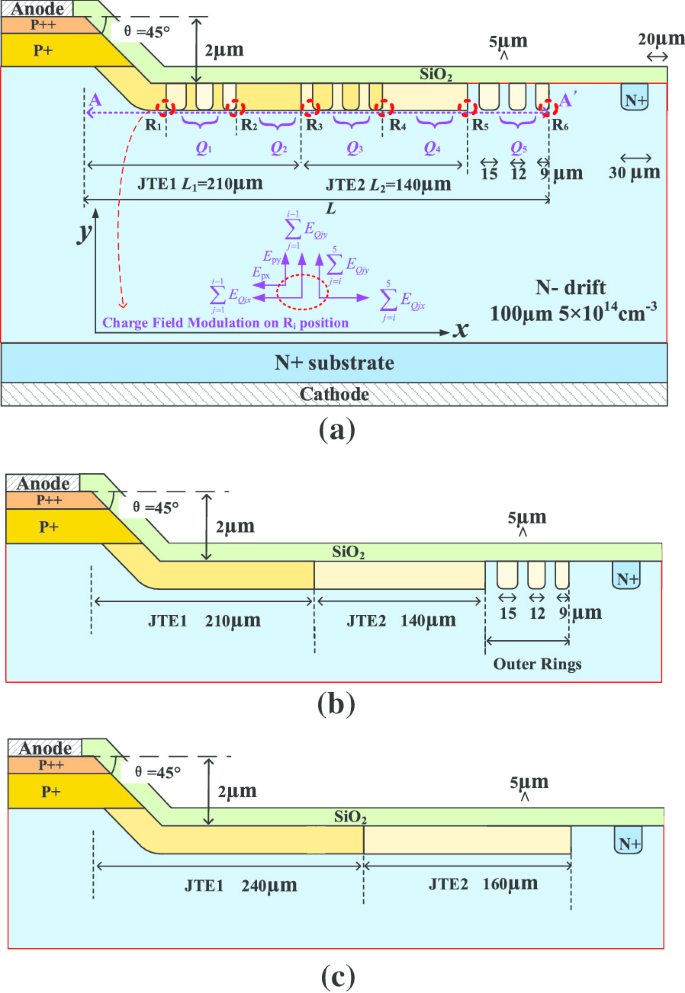
Seção esquemática do retificador 4H-SiC PiN com a CFM-JTE, b ORA-JTE, c TZ-JTE convencional
No estado desligado, a região de depleção de baixo dopagem contrai prematuramente e aborta na região de terminação devido ao efeito de curvatura na junção principal PiN. Assim, o campo potencial aplicado E p ( r ) está totalmente concentrado na periferia da junção principal. A existência de Q i promove o esgotamento ao longo do CFM-JTE até a camada epitaxial mais externa. A força do campo elétrico de carga E Qi está associado à quantidade de Q i . A diminuição em Q i ao longo da borda externa do terminal atinge efetivamente a modulação do campo elétrico na região do terminal. Consequentemente, através do mecanismo e efeito da modulação do campo elétrico de carga, CFM-JTE supera a deficiência de baixo coeficiente de difusão de SiC para formar o efeito de dopagem lateral variado (VLD), que é uma tecnologia de proteção de terminal de junção altamente eficaz, robusta e madura para dispositivos de Si [12, 13]. A largura do anel ( w r ) de cada grupo é reduzido para 15 μm, 12 μm e 9 μm, respectivamente. O espaço de cada anel é igual ao mesmo valor de 5 μm. O comprimento e a dose da região JTE1 e da região JTE2 estão ambos em uma proporção fixa de 3:2. Os parâmetros detalhados do retificador proposto são fornecidos na Tabela 1.
Simulação e otimização
Para diminuir os desvios causados pela sensibilidade da estrutura do dispositivo e das concentrações de dopagem, é aplicada a configuração de processamento Athena. As concentrações de dopagem do CFM-JTE são formadas por meio de múltiplas etapas de simulação do processo de implantação de alumínio. A profundidade total de dopagem chega a quase 1 μm.
A Figura 2 mostra as capacidades de bloqueio e as tolerâncias à dose de implantação de CFM-JTE, ORA-JTE e TZ-JTE convencional. As quatro estruturas de terminação compartilham um valor de comprimento fixo de L =400 μm para comparar sua eficiência. Tanto o comprimento quanto a dose de JTE1 e JTE2 são fixados na proporção de 3:2. A simulação é realizada na estrutura 2-D, e o critério de avaliação de quebra é que a corrente de fuga reversa atinge 1 × 10 –9 A. A linha sólida preta representa o BV teórico que é calculado como 14,1 kV de acordo com [10, 14], e a linha tracejada cinza indica 12 kV. A margem de projeto de 20% é aplicada na meta para 10 kV considerando a tolerância do processo e o desvio da simulação. No TZ-JTE convencional, a tensão de ruptura é bastante sensível à dose de implantação e atinge mais de 12 kV apenas quando a dose varia entre 0,98 e 1,14 × 10 13 cm −2 . A sensibilidade de ORA-JTE à concentração de injeção de JTE é aliviada e uma janela de tolerância mais ampla de 0,97-1,28 × 10 13 cm −2 é obtido para manter a tensão alvo acima de 12 kV. O CFM-JTE tem a tolerância mais ampla da janela de dose de implantação em um intervalo de 0,86-1,30 × 10 13 cm −2 , que é aproximadamente 2,8 vezes o do TZ-JTE convencional e 1,4 vezes o do ORA-JTE. Assim, o CFM-JTE apresenta melhor robustez para variações de processos.
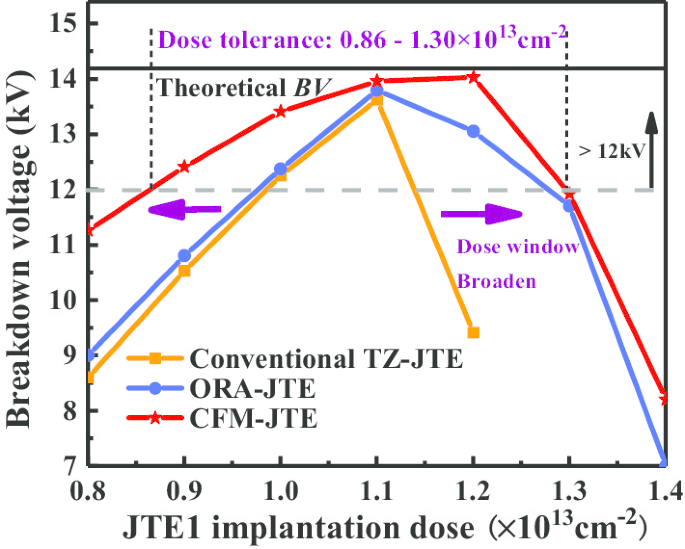
Comparação das capacidades de degradação com a janela de dosagem JTE para o retificador 4H-SiC PiN com CFM-JTE, ORA-JTE e TZ-JTE convencional
A Figura 3 mostra a comparação da distribuição e intensidade do campo elétrico superficial de CFM-JTE, ORA-JTE e TZ-JTE no estado de bloqueio. O pico do campo elétrico concentra-se principalmente na junção principal e na periferia do terminal. CFM-JTE disponível nivela a distribuição do campo elétrico e promove a intensidade do campo elétrico ao longo do terminal, o que, em última análise, melhora a capacidade de bloqueio de forma eficiente.
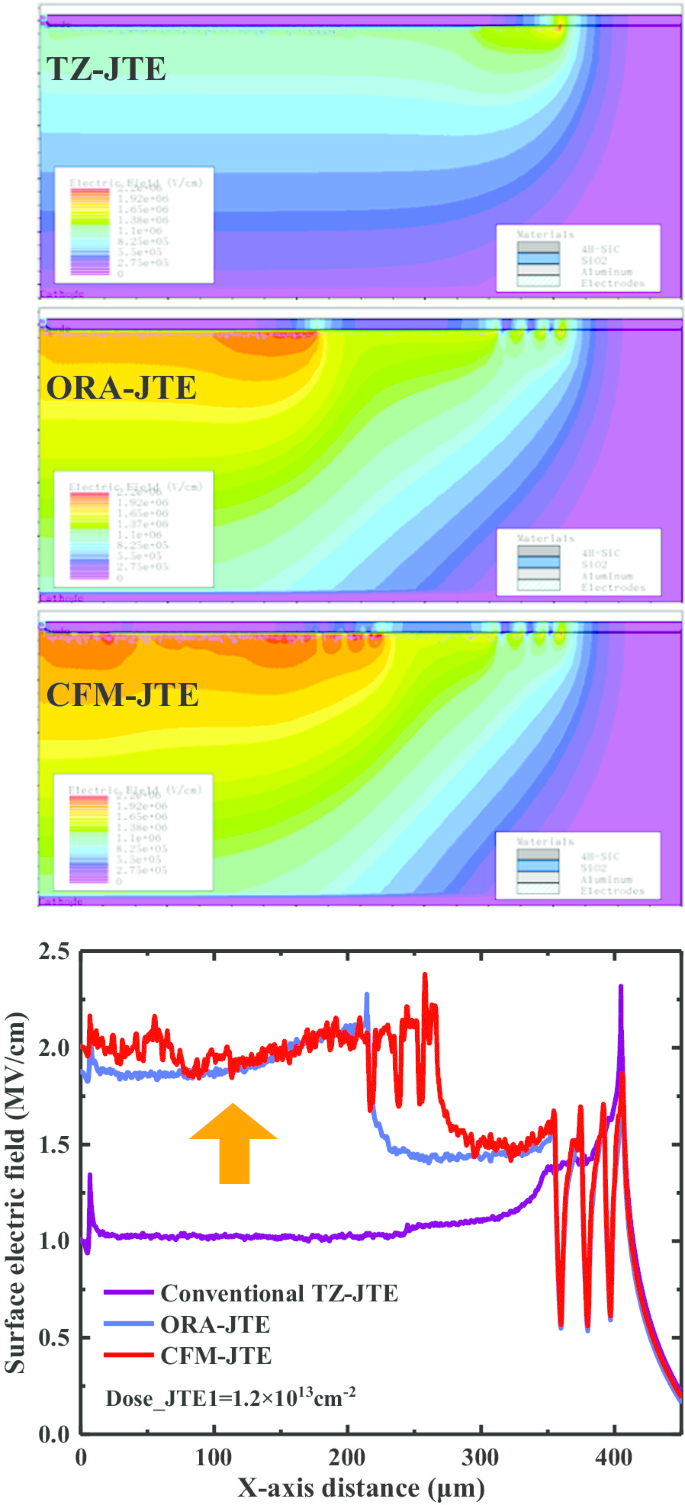
Distribuição e intensidade do campo elétrico de superfície reversa em CFM-JTE, ORA-JTE e TZ-JTE convencional
A fim de compreender o mecanismo de modulação do campo elétrico de carga CFM-JTE, as distribuições do campo elétrico de ruptura através da linha de corte AA 'na Fig. 1a com diferentes doses de implantação de JTE1 são plotadas na Fig. 4. A existência de Q i , especialmente o altamente dopado Q 1 zona próxima à junção principal, alivia imensamente a concentração de linhas de campo elétrico no canto de gravação da mesa. O Q 5 zona é definida para aliviar o congestionamento do campo elétrico em R 5 ponto na Fig. 1a. Os resultados demonstram que a uniformidade da distribuição do campo elétrico pode ser efetivamente melhorada através da modulação do campo elétrico de carga E Qi ( r ) no terminal. Assim, a capacidade da tensão de bloqueio e a confiabilidade do dispositivo podem ser melhoradas.

Distribuições de campo elétrico de superfície em decomposição correspondendo a diferentes doses de implantação de JTE1
O tamanho da área do terminal afeta diretamente a eficiência da utilização do chip. No estado de bloqueio, o campo potencial aplicado é agrupado em torno da periferia da junção principal. A região JTE1 perto da junção principal precisa introduzir mais cargas para aumentar o efeito de modulação do campo de carga ( E q ) Assim, L 1 precisa ser definido mais do que L 2 . Quando a proporção de L 1 para L 2 é fixada em 3:2, as capacidades de bloqueio de comprimentos diferentes L no terminal são comparativamente analisados na Fig. 5.

Capacidades de bloqueio com diferentes comprimentos de terminal
As distribuições de campo elétrico correspondentes são exibidas na Fig. 6. A área em grande escala do CFM-JTE é propícia para aumentar a carga necessária Q i e dando jogo total ao efeito de modulação de E Qi ( r ), de modo a obter uma maior janela de tolerância à dose de implantação (TW). Quando o comprimento CFM-JTE L é definido como 300 μm, 350 μm, 400 μm e 450 μm, a faixa TW aumenta sequencialmente, correspondendo a 3 × 10 12 cm −2 , 3,2 × 10 12 cm −2 , 4,4 × 10 12 cm −2 e 4,7 × 10 12 cm −2 na faixa, na condição de que o BV seja superior a 12 kV. É mais apropriado selecionar um comprimento de terminal L de 400 μm neste trabalho com base na compensação de tamanho do terminal, janela de tolerância de dose JTE, modulação do campo elétrico do terminal e capacidade de tensão de ruptura.
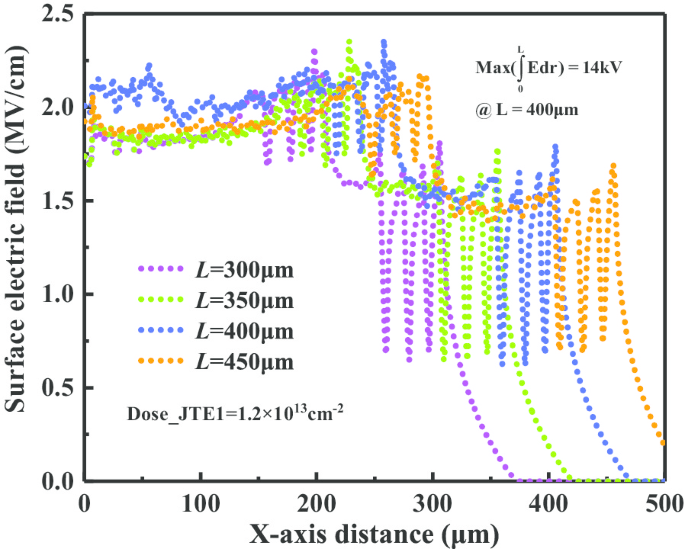
Distribuições de campo elétrico de superfície em decomposição correspondendo a diferentes comprimentos de terminais
A existência de estados de superfície deve ser considerada na fabricação real do retificador 4H-SiC PiN. Esses estados de superfície são derivados de buracos presos em estados de interface profundos, cargas de óxido fixas de P-SiC (incluindo P ++ camada e região P-JTE) / SiO 2 interface e o processo de implementação [15,16,17,18]. Para a terminação CFM-JTE, a modulação do campo elétrico na interface S 1 e S 2 por carga positiva de interface ( Q it ), cobranças efetivas ( Q j ) e o potencial aplicado na direção da vertical é analisado na Fig. 7.
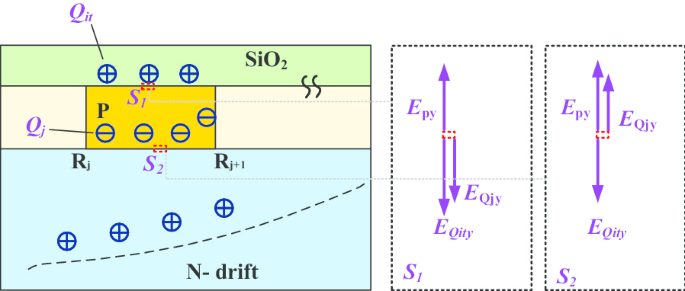
Modulação do campo elétrico em S 1 e S 2 por carga positiva de interface ( Q it ), cobranças efetivas ( Q j ) e potencial aplicado
Cobranças de interface positivas ( Q it ) gerar um campo de carga oposto ( E Qity ) em comparação com o campo potencial aplicado ( E py ), ajudando a mitigar a intensidade do campo elétrico na direção da interface vertical. A Figura 8 exibe as distribuições do campo elétrico em SiO 2 Interface / SiC S 1 sob condições de diferentes Q it .

Distribuições de campo elétrico em SiO 2 Interface / SiC com diferentes Q it
Em termos de análise de modulação do campo de carga na interface S 2 , E Qity é o oposto da direção do vetor de E py e E Qjy . A existência de Q it ajuda a reduzir o campo elétrico em S 2. Considerando a existência de carga de interface ( Q it ), uma carga efetiva de ionização maior Q j é necessário para neutralizar a intensidade do campo elétrico gerado pelo Q it . Consequentemente, quando a quantidade de Q it aumenta, a concentração ideal da dose de implantação de JTE deve ser aumentada simultaneamente para manter a mesma capacidade de bloqueio. Conforme mostrado na Fig. 9, a BV-Dose geral a curva muda na direção de subida com o aumento em Q it .

Comparação de influências para a capacidade de bloqueio por cargas de interface no retificador 4H-SiC PiN
Resultados e discussão
O retificador CFM-JTE 4H-SiC PiN proposto foi fabricado em um wafer tipo N de 4 polegadas com 4 ° fora do eixo (0001). O wafer é cultivado por meio de epitaxia com quatro camadas (N + , N - , P + , P ++ ) correspondendo à concentração de 1 × 10 18 cm −3 , 5 × 10 14 cm −3 , 1 × 10 18 cm −3 e 5 × 10 19 cm −3 . O principal fluxo do processo de fabricação CFM-JTE é mostrado na Fig. 10. O P ++ camada é desenvolvida através de epitaxia para obter uniformidade e altamente dopagem para promover a qualidade de contato ôhmico entre o SiC e o metal anódico. A estrutura de ataque em mesa é formada na instalação ICP-RIE através da máscara de ataque em mesa. O gás de corrosão é composto principalmente de SF 6 e oxigênio. Implantações múltiplas de íons de Al são implementadas em uma energia máxima de 500 keV para formar a estrutura CFM-JTE. Uma implantação de íon Al em duas etapas é aplicada para formar as cinco zonas dopadas decrescentes. JTE1 e R 2 -R 3 zonas são formadas através da primeira máscara de implantação. JTE2, R 1 -R 2 , R 3 -R 4 , R 4 -R 5 e R 5 -R 6 regiões são configuradas simultaneamente pela implantação de íon Al através da segunda máscara de implantação. Como é sabido por todos, a taxa de ativação de íons no carboneto de silício não é alta após o implante com íons de alta energia, acompanhada por severos danos à rede. A fim de melhorar a situação indesejável acima, as implantações de íons de alumínio são realizadas a uma temperatura de 500 ° C através de uma máscara de óxido. O recozimento pós-implantação foi conduzido em ambiente de argônio a uma temperatura de 1800 ° C por 10 min com uma tampa de carbono para renovar ainda mais o dano causado pela implantação de íons de alta energia e melhorar a precisão da concentração de dopagem, aumentando o íon efetivo taxa de ativação. O contato ôhmico SiC tipo P é formado usando Al / Ti. O processo RTA é consistentemente realizado e inspecionado por dois minutos em um ambiente de nitrogênio de gás inerte a uma temperatura de 1000 ° C. Camadas de passivação de alta qualidade (SiO 2 camada, Si 3 N 4 filme e camada espessa de poliimida) são depositados para evitar vazamento na superfície e evitar faíscas no ar [5]. O retificador CFM-JTE PiN cobre uma área ativa de até 0,1 cm 2 . O processo de fabricação é consistente com o retificador convencional JTE 4H-SiC PiN de duas zonas, sem nenhuma máscara extra ou etapas de processo, o que é extremamente propício para reduzir a complexidade e o custo de fabricação.
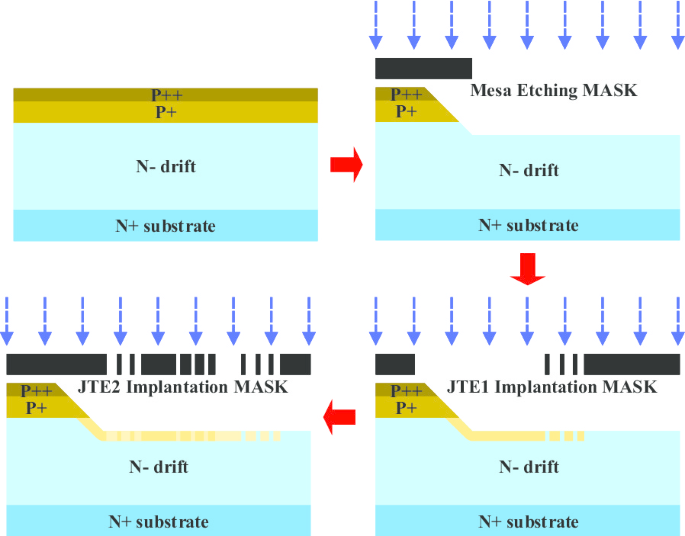
Fluxo do processo do CFM-JTE
As características diretas do retificador CFM-JTE PiN fabricado são testadas no wafer usando o instrumento Curve Tracer CS-3200. O retificador CFM-JTE PiN fabricado exibe uma grande capacidade de condução de corrente direta sem a tecnologia de aprimoramento da vida útil da portadora. A corrente direta é medida até 100 A correspondendo a uma tensão direta de 5,2 V, como mostrado na Fig. 11. A resistência diferencial ligada do retificador proposto é medida como 3,1 mΩ cm 2 à temperatura ambiente, correspondendo à tensão direta de 3,6 V. As características de condução direta em diferentes temperaturas também são ilustradas na inserção da Fig. 11. O I – V curva mostra peculiaridade do coeficiente de temperatura negativa. Isso ocorre porque conforme a temperatura aumenta, a mobilidade do material diminui, enquanto o gap mais estreito do material de SiC reduz o potencial autoconstruído da junção P – N e a vida útil do portador da região de deriva se estende com o aumento de temperatura, levando a um aumento na densidade de corrente. A tensão de ativação medida é definida em uma densidade de corrente direta de 10 A · cm −2 . Reduz gradualmente de 3,14 para 3,04 V quando a temperatura ambiente sobe de 25 para 150 ° C. A mudança máxima da tensão de ativação direta ficou parada em uma faixa de 3%, correspondendo a um valor de 0,1 V, que exibe estabilidade de temperatura muito melhor do que Si PiN.
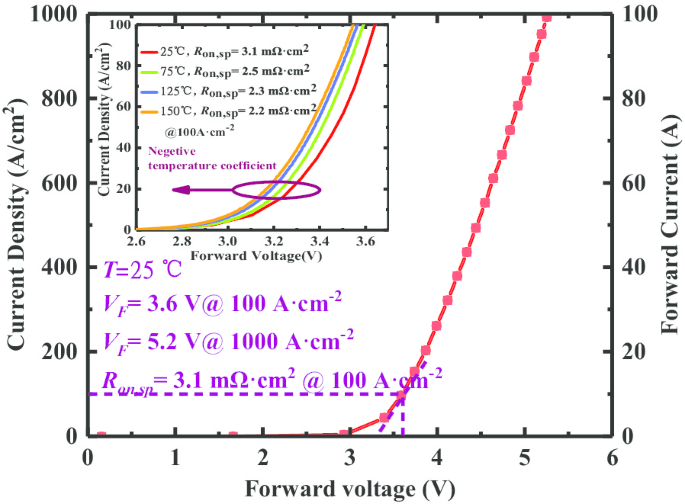
Avançar I – V curva do retificador CFM-JTE PiN e características em diversos ambientes de temperatura na inserção
Os retificadores 4H-SiC PiN com CFM-JTE, ORA-JTE, bem como o TZ-JTE convencional são fabricados no wafer de 4 polegadas e seus efeitos de proteção de terminal são mostrados na Fig. 12. Medições reversas de tensão de ruptura são executadas e imersas em óleo fluorinert para evitar formação de arco no ar. Em medições experimentais com dose JTE1 de 1,2 × 10 13 cm −2 , os retificadores PiN com ORA-JTE e o convencional TZ-JTE obtêm as capacidades de bloqueio de 12,5 kV e 9,6 kV, respectivamente, com o mesmo comprimento terminal de 400 μm.
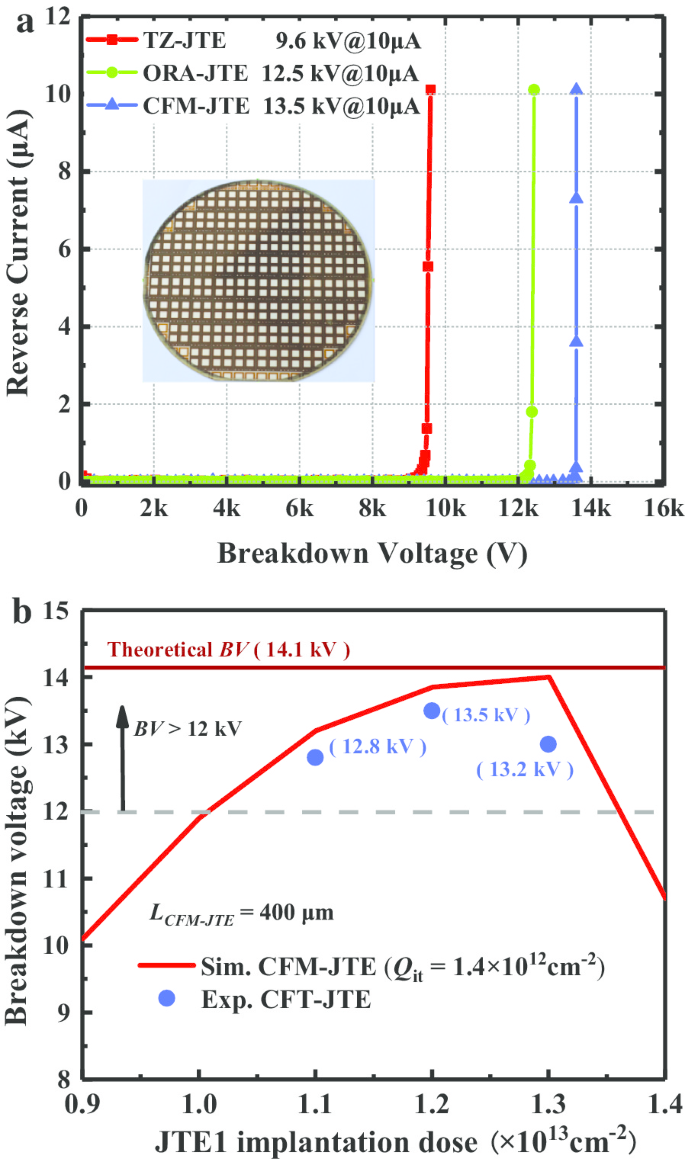
Características de decomposição do retificador 4H-SiC PiN fabricado. a Medido BV dos CFM-JTE, ORA-JTE e TZ-JTE. b BV medida do CFM-JTE com diferentes doses de implantação. Marcas sólidas são os valores experimentais
Amostras de vários lotes de retificadores CFM-JTE PiN podem obter repetidamente a tensão de ruptura de 13,5 kV na corrente de fuga de 10 μA. A tensão de bloqueio experimental atinge até 96% do valor de ruptura teórico, o que indica que o CFM-JTE possui maior eficiência de proteção do terminal. Uma tensão suportável de mais de 130 V / μm foi alcançada na camada de deriva de 100 μm do retificador 4H-SiC PiN. A figura de mérito de Baliga (BFOM =BV 2 / R ligado, sp ) atinge 58,8 GW / cm 2 à temperatura ambiente. Os CFM-JTE PiNs com diferentes doses de implantação de JTE1 foram fabricados. Os valores experimentais e simulados da tensão de ruptura são representados na Fig. 12b. Os valores experimentais estão de acordo com a tendência de simulação e confirmam que a estrutura CFM-JTE pode expandir a janela de tolerância de dose JTE de forma eficaz. A Tabela 2 compara as características dos retificadores 4H-SiC de ultra-alta voltagem relatados recentemente. O retificador CFM-JTE 4H-SiC fabricado neste trabalho apresenta excelente desempenho nos aspectos de capacidade de bloqueio de ultra-alta tensão, capacidade de condução de corrente direta ultra-alta e alta eficiência de terminação.
Conclusões
Neste trabalho, o retificador 4H-SiC CFM-JTE PiN foi projetado e fabricado com sucesso. A tensão de ruptura experimental do CFM-JTE PiN é de 13,5 kV correspondendo a 96% do valor de bloqueio teórico. O CFM-JTE exibe uma eficiência de proteção terminal muito melhor em comparação com o ORA-JTE (BV =12,5 kV, com eficiência de proteção de até 88%) e o convencional TZ-JTE (BV =9,6 kV, com eficiência de proteção de até 68% ) O retificador CFM-JTE PiN adquire uma grande corrente direta de 100 A @ V F =5,2 V sem usar a tecnologia de aprimoramento da vida útil da portadora e exibe um avanço estável I – V características em várias temperaturas. A figura de mérito do Baliga para o retificador CFM-JTE PiN atinge 58,8 GW / cm 2 à temperatura ambiente. A tolerância da janela de dose de implantação para CFM-JTE é ampliada com base na modulação do campo elétrico de carga, que é aproximadamente 2,8 vezes a do TZ-JTE convencional e 1,4 vezes a do ORA-JTE, mostrando uma robustez muito melhor à variação do processo. Além disso, o processo de fabricação do CFM-JTE é consistente com o processo TZ JTE convencional sem aumentar o número de processos ou máscaras excepcionalmente complexos, o que demonstra que o CFM-JTE é ideal para aplicações de ultra-alta potência com eficiência terminal satisfatória e tolerância do processo.
Disponibilidade de dados e materiais
Todos os dados estão disponíveis sem restrições.
Abreviações
- SiC:
-
Carboneto de silício
- JTE:
-
Extensão de terminação de junção
- CFM:
-
Campo de carga modulado
- TZ-JTE:
-
Extensão de terminação de junção de duas zonas
- FLR:
-
Anel limitador de campo
- MZ-JTE:
-
Extensão de terminação de junção de zona múltipla
- CD-JTE:
-
Extensão de terminação de junção contra dopada
- Ti:
-
Titânio
- Al:
-
Alumínio
- E c :
-
Banda de condução de energia
- V F :
-
Tensão direta
- ORA-JTE:
-
Extensão de terminação de junção assistida por anel externo
- E q :
-
Carregar campo elétrico
- E p :
-
Campo potencial aplicado
- Q i :
-
Carga efetiva
- VLD:
-
Dopagem lateral variada
- w r :
-
Largura do anel
- 2D:
-
Bidimensional
- BV:
-
Queda de tensão
- TW:
-
Janela de tolerância
- Q it :
-
Carga de interface
- Q j :
-
Carga efetiva de ionização
- RTA:
-
Recozimento térmico rápido
- R ligado, sp :
-
Resistência específica
- BFOM:
-
Figura de mérito de Baliga
Nanomateriais
- Considerações de design de proteção, controle e detecção de circuitos para aplicativos de segurança doméstica inteligente
- Fabricação e caracterização de novo composto de suporte de catalisador anódico de nanofibra de carbono Tio2 para célula de combustível de metanol direto via método de eletrofiação
- Fabricação, Caracterização e Atividade Biológica de Sistemas de Nanotransmissão de Avermectina com Diferentes Tamanhos de Partículas
- Fabricação, caracterização e citotoxicidade de nanopartículas de carbonato de cálcio derivadas de casca de ouro conjugada em forma esférica para aplicações biomédicas
- A Fabricação e Desempenho de Absorção de Ondas Eletromagnéticas de Alta Eficiência de Nanocompósitos Estruturados com CoFe / C Core – Shell
- Fabricação e caracterização de Nano-Clips de ZnO pelo processo mediado por poliol
- Síntese e caracterização de zeólitos ZSM-5 hierárquicos com mesoporosidade excepcional e excelentes propriedades catalíticas
- Litografia de difração baseada em máscara de uma etapa para a fabricação de estruturas suspensas 3D
- Novo dispositivo modula a luz visível com o menor espaço e menor consumo de energia
- A abordagem de segurança de gás e chama para a indústria de geração de energia



