Otimização de contatos ôhmicos para nanowires de p-GaAs
Resumo
O desempenho de contatos ôhmicos aplicados a nanofios semicondutores (NWs) é um aspecto importante para viabilizar seu uso em dispositivos eletrônicos ou optoeletrônicos. Devido às pequenas dimensões e orientação superficial específica de NWs, a tecnologia de processamento padrão amplamente desenvolvida para heteroestruturas planas não pode ser aplicada diretamente. Aqui, relatamos a fabricação e otimização de contatos Pt / Ti / Pt / Au Ohmic para nanofios de GaAs do tipo p crescidos por epitaxia de feixe molecular. Os dispositivos foram caracterizados por medições de corrente-tensão (IV). A linearidade das curvas de características IV de nanofios individuais foi otimizada ajustando o layout das camadas de metal de contato, o tratamento de superfície antes da evaporação do metal e o recozimento térmico pós-processamento. Nossos resultados revelam que a resistência de contato é notavelmente diminuída quando uma camada de Pt é depositada no nanofio de GaAs antes do layout de multicamadas Ti / Pt / Au tradicional usado para GaAs planares do tipo p. Esses achados são explicados por uma qualidade melhorada da interface metal-GaAs, que foi evidenciada por medições de difração de raios-X de incidência rasante em filmes finos metálicos semelhantes depositados em substratos de GaAs (110). Em particular, mostramos que o Ti exibe baixo grau de cristalinidade quando depositado na superfície de GaAs (110), o que afeta diretamente a resistência de contato dos dispositivos NW. A deposição de uma camada fina de Pt nas NWs antes de Ti / Pt / Au resulta em uma diminuição de 95% na resistência elétrica total de NWs de GaAs dopados com Be-dopado que está associada ao maior grau de cristalinidade de Pt do que Ti quando depositado diretamente em GaAs (110).
Introdução
Uma etapa importante na fabricação de dispositivos semicondutores eletrônicos e optoeletrônicos é obter contatos ôhmicos confiáveis e de alta qualidade na interface metal-semicondutor. Para tanto, o GaAs é um material importante e amplamente utilizado em aplicações tecnológicas como dispositivos a laser, células solares e fotodetectores. Portanto, a fabricação de contato ôhmico para camadas de GaAs dopadas do tipo p e tipo n tem sido alvo de um grande número de investigações [1]. De um modo geral, a fabricação de contatos ôhmicos para materiais semicondutores inclui quatro etapas:(1) remoção do óxido nativo da superfície, (2) passivação dos estados de superfície na interface semicondutor-metal, (3) deposição de camadas metálicas atuando como o contatos elétricos e (4) recozimento térmico [2, 3]. Partindo da seleção de metais que fornecem baixa resistência de contato e excelente estabilidade térmica, ligas à base de Au têm sido amplamente exploradas, especificamente para GaAs do tipo p na forma de Au / Zn / Au [1, 3, 4] e Ti / Camadas de Pt / Au [1, 5]. Por outro lado, nanofios semicondutores III-V (NWs) surgiram como uma classe mais nova de materiais em nanoescala promissores para aplicação como LEDs [6, 7], células solares [8, 9] e fotodetectores [10], e estes foram acionados desenvolvimentos específicos no processamento de dispositivos.
A maioria da tecnologia relatada na literatura para fabricação de contato ôhmico foi desenvolvida para GaAs (100) filmes finos e estruturas em massa, enquanto o crescimento autocatalisado de GaAs NWs produz (110) orientação superficial nas paredes laterais [11,12,13, 14,15]. Diferentes orientações de superfície exibem diferentes estados eletrônicos [16] que afetam as propriedades da interface e as alturas da barreira Schottky [17,18,19]. Além disso, a orientação da superfície pode afetar a dinâmica de cristalização das películas de metal depositadas. Bons contatos ôhmicos para p-GaAs NWs foram relatados anteriormente [20,21,22,23,24,25,26,27,28] usando uma variação de tratamentos químicos para remover o óxido nativo, passivação de superfície e diferentes camadas metálicas depositado nas NWs. Então, o uso de contatos elétricos de Pt / Ti / Pt / Au para filmes finos de GaAs do tipo p foi relatado para produzir baixa resistividade de contato ôhmica mesmo para concentrações moderadas de dopante devido à baixa altura da barreira Schottky de Pt / GaAs [29]. Além disso, Pt foi considerado termicamente estável com pequenas taxas de reação ao GaAs para tratamentos térmicos com temperaturas variando de 300 a 500 ° C [29,30,31]. A multicamada metálica de Pt / Ti / Pt / Au é a mais frequentemente relatada [20, 23, 25, 26, 28] contato ôhmico com p-GaAs NWs. No entanto, uma compreensão mais abrangente das propriedades do metal na formação de contato ôhmico é a chave para melhorar ainda mais a qualidade do contato elétrico em dispositivos em nanoescala. Devido à ampla gama de técnicas de crescimento NW e concentrações de dopante em p-GaAs NWs relatadas recentemente, seria inviável fazer uma comparação das resistências de contato, quando disponíveis. Em vez disso, uma investigação abrangente de diferentes rotas de manufatura de contato no mesmo conjunto de amostras NW seria mais adequada para excluir o efeito das propriedades NW.
Aqui, abordamos os efeitos de diferentes contatos elétricos baseados em Pt e Ti e tratamentos de superfície antes da evaporação do metal nas características gerais de corrente-tensão (IV) de GaAs autocatalisados e dopados NWs crescidos em substratos de Si [11, 32 ] Analisamos as mudanças na resistência total dos canais NW com base na investigação estrutural por difração de raios-X de filmes finos de Ti, Pt e Pt / Ti depositados em substratos de GaAs (110). Mostramos que uma alta resistência de contato está associada a um baixo grau de cristalinidade do Ti quando depositado diretamente no GaAs (110), enquanto os contatos elétricos Pt / Ti / Pt / Au resultam em uma diminuição notável da resistência de contato, o que é atribuído a a melhoria da qualidade da camada de metal observada nas primeiras camadas de Pt / Ti depositadas na superfície de GaAs (110).
Materiais e métodos
Crescimento Nanowire
Os NWs de GaAs dopados com Be-catalisados autocatalisados foram cultivados por epitaxia de feixe molecular de fonte sólida (MBE) em padrões de óxidos livres de litografia fabricados em substratos de p-Si (111) por epitaxia de gotícula e oxidação espontânea [32]. A temperatura de crescimento NW foi de 640 ° C, conforme determinado por pirômetro, e um fluxo de Ga correspondente à taxa de crescimento planar de 0,3 μm / h em GaAs (100) foi usado. Um umedecimento de 60 s Ga precedeu o crescimento NW, que foi iniciado com o fornecimento de As 2 com relação de pressão equivalente de feixe V / III de 9 e fluxo Be correspondendo a 2,0 × 10 19 cm −3 concentração de dopagem do tipo p; isto foi determinado a partir do crescimento de amostras de calibração planar com Be-dopado GaAs (100) por medições de Hall à temperatura ambiente. A duração do crescimento foi de 60 min. Mais detalhes da metodologia de crescimento e as propriedades estruturais dos NWs não dopados e Be-dopados podem ser encontrados nas Refs. [11, 32, 33]. Em suma, os NWs são compostos de zinco blende GaAs puro com a formação de alguns planos gêmeos [33]. Os NWs têm formato hexagonal com paredes laterais compostas exclusivamente por (110) facetas orientadas, como foi previamente determinado a partir da análise estrutural dos NWs Be-dopados [33] e posteriormente confirmado em NWs GaAs não dopados crescidos em condições semelhantes [12].
Fabricação e caracterização de contatos
Os NWs foram transferidos mecanicamente para um substrato de p-GaAs (100) coberto com um SiO de 200 nm 2 camada, que foi pré-padronizada por fotolitografia e evaporação de feixe de elétrons de blocos de Ti / Au para caracterização de transporte. A posição dos fios transferidos no substrato foi identificada por imagem de microscopia eletrônica de varredura (MEV) de baixa ampliação. A resistência de feixe de elétrons positivo foi revestida por spin no substrato e exposta com feixe de elétrons nas áreas de contato elétrico. O resist foi desenvolvido em MIBK:solução IPA após a exposição do feixe de elétrons e possivelmente seguido por um tratamento de plasma de oxigênio para remover o resist residual das paredes laterais NW, conforme descrito na Tabela 1. Os efeitos do tratamento de plasma de oxigênio no desempenho do dispositivo serão discutido posteriormente no texto. Antes da evaporação do metal das camadas de contato, as amostras foram tratadas quimicamente para remover o óxido nativo e passivar as paredes laterais NW expostas, conforme descrito posteriormente no texto. A decolagem foi feita mergulhando a amostra em acetona aquecida, enxaguando em IPA e secando com nitrogênio.
Desenvolvemos cinco processos distintos combinando diferentes tratamentos de superfície das paredes laterais NW expostas com diferentes camadas metálicas usadas como contatos elétricos. Isso nos permitiu determinar as contribuições individuais de cada parâmetro na resistência de contato resultante quando aplicado aos NWs de GaAs tipo p. Para a remoção do óxido nativo da superfície, usamos um NH 2,8% 4 OH ou HCl 3,7% diluído em H 2 O seguido por H 2 O enxágue. Para a passivação da superfície, usamos uma solução de 15% de (NH 4 ) 2 S x diluído em H 2 O (aquecido a 45 ° C) seguido por H 2 O enxágue. As multicamadas metálicas foram depositadas usando evaporação de feixe eletrônico e eram Ti / Pt / Au (20/20/200 nm) ou Pt / Ti / Pt / Au (5/10/10/200 nm). Um recozimento térmico rápido (RTA) de 400 ° C por 30 s foi usado para a multicamada de Pt / Ti / Pt / Au. Os processos usados para cada amostra são especificados na Tabela 1. Para cada amostra, 4 contatos elétricos uniformemente espaçados foram fabricados ao longo do eixo NW. Neste trabalho, restringimos a análise IV aos pares de contatos localizados na região central do NW. Os dados IV foram obtidos em temperatura ambiente usando uma estação de sondagem da Keysight.
Investigação estrutural por difração de raios-X de incidência de pastagem
A fim de investigar as propriedades estruturais dos contatos elétricos nos NWs, padrões de difração de raios-X de incidência rasante (GIXRD) foram medidos a partir de filmes finos de Ti, Pt e Pt / Ti de referência evaporados em substratos de GaAs (110) não dopados. Preparamos as amostras de filme fino descritas na Tabela 2 usando a remoção de óxido nativo por HCl:H 2 O e passivação de superfície por (NH 4 ) 2 S x da mesma forma que para os dispositivos NW. O pequeno ângulo de incidência dos raios X usados no GIXRD permite analisar filmes metálicos com a mesma espessura dos contatos NW devido à pequena profundidade de penetração. Os padrões GIXRD foram medidos usando radiação Cu Kα com comprimento de onda de 1,54 Å e um ângulo de incidência de ω =0,75 ° em relação à superfície da amostra. As posições dos picos de difração são indexadas de acordo com os arquivos ICDD # 00-044-1294 e # 00-004-0802 para Ti empacotado hexagonal fechado (HCP) e cúbico centrado na face (FCC) Pt, respectivamente, e são corrigidos pela contabilização de o efeito da refração dos raios-X em experimentos GIXRD conforme descrito na Ref. [34].
Resultados e discussão
A Figura 1a mostra as características IV para as amostras P1 a P5, e a Fig. 1b uma imagem SEM de um GaAs NW Be-dopado com contatos elétricos usados para caracterização de transporte. A forma quase simétrica e não linear dos IVs para P1 a P4 na Fig. 1a indica que os contatos são do tipo Schottky com alturas de barreira semelhantes para cada contato [35]. A não linearidade do IV para a amostra P1 evidentemente mostra que o processo p-GaAs padrão como em P1 não produz contatos ôhmicos como é o caso para filmes finos planares de GaAs. Normalmente, em NWs de GaAs dopados, a remoção de óxido de HCl é usada, possivelmente seguida por (NH 4 ) 2 S x passivação da superfície antes da evaporação do metal para formação de contato ôhmico [20, 21, 36, 37] em vez de NH 4 OH. Além disso, o tratamento com plasma de oxigênio da superfície NW exposta foi usado anteriormente para remover a resistência residual das paredes laterais NW [36, 38]. No entanto, como efeito colateral, esse processo pode induzir defeitos superficiais em GaAs, como vacâncias de As, resultando em armadilhas do tipo doador que são responsáveis pela compensação do portador e, portanto, aumentando a largura da camada de depleção [5].
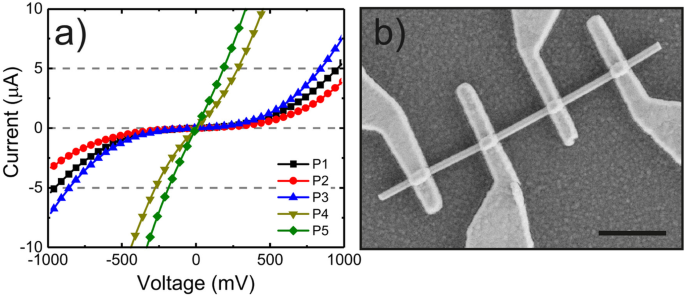
a IV de NWs de GaAs dopados com contatos elétricos fabricados usando os processos P1 – P5, conforme descrito na Tabela 1. b Imagem SEM de um representante Be-dopado GaAs NW com quatro contatos elétricos uniformemente espaçados. A barra de escala é 1 μm
Para avaliar o efeito do tratamento com plasma de oxigênio na resistência de contato de p-GaAs NWs, comparamos o IV de uma amostra com (P2) e sem (P3) limpeza com plasma de oxigênio antes do tratamento de superfície com HCl e (NH 4 ) 2 S x na Fig. 1a. P2 produz o pior desempenho IV (definido como o valor da corrente elétrica para a mesma voltagem aplicada) em todas as amostras, mas a amostra P3, por sua vez, exibe melhor desempenho IV do que o processo p-GaAs padrão P1 e o plasma de oxigênio limpo P2. Isso implica em dois resultados significativos:(i) o efeito do tratamento com plasma de oxigênio é prejudicial à resistência de contato, e (ii) o P3 com remoção de óxido de HCl combinado com (NH 4 ) 2 S x a passivação da superfície aumenta a altura da barreira Schottky da interface metal-semicondutor em comparação com P1.
O desempenho IV e o caráter ôhmico (avaliado qualitativamente pela linearidade IV) foram fortemente aumentados em P4 quando comparado a P3 pela adição de uma camada de Pt de 5 nm sob a multicamada Ti / Pt / Au, como pode ser visto na Fig. 1a. A resistência de contato é ainda mais diminuída em P5 após RTA 30 s a 400 ° C, alcançando um comportamento IV linear e desempenho IV melhorado em comparação com P4.
A fim de quantificar o efeito dos parâmetros de processamento na resistência de contato das amostras P1-P5 (tratamentos químicos, multicamadas metálicas), mostramos na Fig. 2a os IVs de P1-P5 usando uma faixa de polarização menor; neste caso, os IVs apresentam comportamento linear e são governados principalmente pela resistência de contato [35]. A resistência total do canal (contatos + NW) na faixa de 100 mV da Fig. 2a foi calculada a partir de um ajuste linear da curva de características IV, e os resultados são mostrados na Fig. 2b. Como os diâmetros de todos os NWs investigados são semelhantes e há apenas uma pequena variação fio-a-fio na concentração de dopante, como relatamos anteriormente [33], quaisquer alterações na resistência total foram atribuídas à resistência de contato. A maior resistência em P2 em comparação com P1 e P3 confirma o efeito prejudicial do tratamento com plasma de oxigênio a partir da análise qualitativa dos IVs na Fig. 1a. Um resultado notável é a diminuição na resistência total de 1400 kΩ em P3 para 72 kΩ em P4 e uma diminuição adicional para 40 kΩ após RTA em P5, alcançada pela deposição de uma camada de Pt adicional antes da multicamada Ti / Pt / Au usada em amostras P1 – P3.
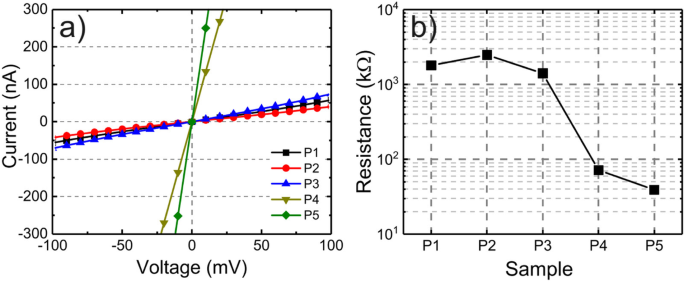
a IV de P1 a P5 na faixa de tensão aplicada de 100 mV. b Resistência total do canal de P1 – P5 obtida a partir do ajuste linear dos IVs em a
Uma compreensão mais abrangente da microestrutura da interface metal-semicondutor após a fabricação do contato é necessária para estabelecer uma correlação das mudanças na resistência de contato observada nas amostras P1 – P5. O uso de Ti e Pt na fabricação de contato ôhmico para GaAs foi relatado anteriormente [39, 40], e as propriedades estruturais de filmes finos de Ti e Pt evaporados para a superfície de GaAs (100) [41] e substratos de vidro amorfo [42, 43 ] também foram analisados. No entanto, nenhum estudo detalhado foi encontrado para a superfície GaAs (110). Espera-se que as diferentes orientações de superfície influenciem a dinâmica de cristalização dos filmes finos de Ti e Pt. Além disso, a passivação química da superfície por (NH 4 ) 2 S x poderia influenciar ainda mais os filmes finos resultantes. O grau de cristalização de filmes finos de Pt (5 nm), Ti (20 nm) e Pt / Ti (5/20 nm) depositados em substrato GaAs (110) não dopado foi investigado por GIXRD a fim de obter informações das propriedades estruturais das primeiras camadas metálicas em contato com as NWs em P1 – P5. Antes da evaporação do metal, os substratos GaAs (110) passaram pela remoção do óxido nativo por HCl:H 2 O e o (NH 4 ) 2 S x Passos de passivação de superfície conforme as amostras NW P3 – P5. Os detalhes dos tratamentos de superfície e filmes finos metálicos evaporados no substrato GaAs (110) estão resumidos na Tabela 2.
Os padrões GIXRD das amostras S1-S4 são mostrados na faixa de ângulo de difração de 30 a 60 ° na Fig. 3a e na faixa de 60 a 90 ° na Fig. 3b. Os padrões de difração na Fig. 3 são deslocados verticalmente e separados em duas faixas de ângulo de difração para fornecer uma escala melhor para visualização. Primeiro, nos concentramos no efeito de (NH 4 ) 2 S x passivação de superfície no grau de cristalinidade dos filmes de Ti evaporados no substrato GaAs (110) comparando as amostras S1 e S2. Na Fig. 3a, observamos a sobreposição de picos de baixa intensidade Ti (002) e Ti (101) centrados em 38,4 e 40,2 °, respectivamente, para S1 e S2. Além disso, um pico de Ti (102) significativamente mais amplo centrado em 53,0 ° também é observado para ambas as amostras, o que sugere um caráter amorfo. O pico Ti (103) centrado em 70,6 ° na Fig. 3b é observado apenas para S1, que é a única disparidade significativa entre as amostras. Em geral, as baixas intensidades e os picos amplos de S1 e S2 indicam uma baixa cristalinidade dos filmes de Ti quando depositados na superfície de GaAs (110) após a remoção do óxido de HCl e independentemente do uso de (NH 4 ) 2 S x passivação. No caso de S3, para o qual Pt foi depositado no substrato GaAs (110) com o mesmo tratamento de superfície que em S2, observamos Pt (111), Pt (200), Pt (220), Pt (311) muito mais pronunciados. e picos de difração de Pt (222) centrados em 39,8 °, 46,3 °, 67,5 °, 81,3 ° e 85,7 °, respectivamente. Isso indica que o filme de Pt em S3 exibe um maior grau de cristalinidade em comparação com as amostras de Ti. O mesmo se aplica a S4 que mostra assinaturas de difração de Pt semelhantes a S3 na Fig. 3a, b. Os picos amplos e assimétricos entre 35 ° -45 °, 65 ° -75 ° e 75 ° -90 ° para S4 são formados devido à sobreposição de Ti (002) -Ti (101) -Pt (111), Ti ( 103) -Pt (220), e Ti (004) -Pt (311) -Pt (222) picos de difração, respectivamente. Uma comparação qualitativa dos padrões GIXRD de S2, S3 e S4 implica que o grau de cristalinidade de Ti em S4 está pelo menos no mesmo nível que em S1. O pico Ti (103) em 70,6 ° é observado como um ombro claro no pico Pt (220) na Fig. 3b e o pico Ti (102) em 53,0 ° na Fig. 3a está presente com baixa intensidade, mas largura de linha estreita em S4 embora exibindo um pico muito amplo, de tipo amorfo, em S1 e S2. Este resultado sugere um grau melhorado de cristalinidade do Ti quando depositado na Pt em vez da superfície GaAs (110), que será a seguir diretamente correlacionado às propriedades dos contatos elétricos descritas nas Figs. 1 e 2.
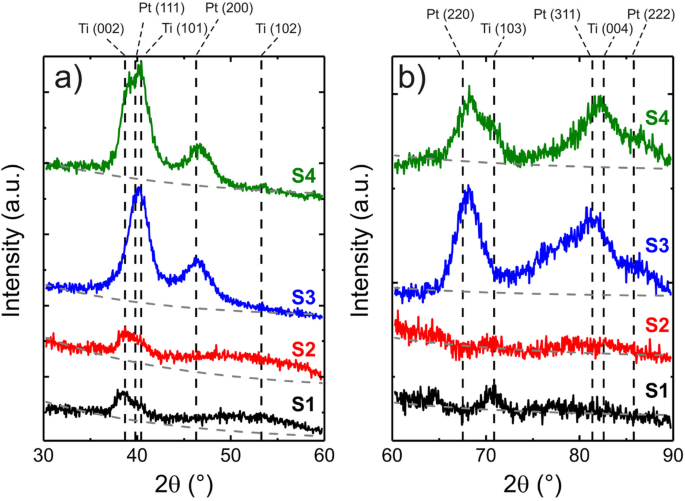
Padrões GIXRD das amostras S1 – S4 do a Intervalo de ângulo de difração de 30 a 60 ° e ( b ) Faixa de 60 a 90 °. As linhas cinza tracejadas representam linhas de base de decaimento exponencial que se originam da difusão difusa de raios-X. As linhas pretas tracejadas verticais correspondem aos diferentes planos de difração de Ti e Pt, rotulados no topo de a e b
A análise GIXRD das camadas metálicas em S1-S4 nos permite correlacionar o grau de cristalinidade de Ti e Pt depositados no substrato GaAs (110) e os resultados de resistência total de P1-P5 na Fig. 2b. É importante enfatizar que, neste trabalho, baseamos nossas correlações das mudanças na resistência total de P1-P5 principalmente nos dados GIXRD obtidos de S1-S4. Assumimos que outros fatores, como a qualidade da interface metal-NW devido à geometria hexagonal das paredes laterais NWs, têm contribuições desprezíveis nas mudanças de resistência total observadas em P1 – P5. O (NH 4 ) 2 S x a passivação da superfície tem um efeito benéfico nas propriedades da interface GaAs-metal, conforme parece comparando a resistência IV e total das amostras P1 e P3, mas com um baixo grau de cristalinidade do filme de Ti quando depositado diretamente na superfície de GaAs (110) , conforme observado em S1 e S2. Isso poderia ser o resultado de uma reação do enxofre com o Ti crescido. Além disso, foi relatado que o Ti é altamente reativo com as impurezas remanescentes na câmara de evaporação durante a deposição do metal [41], formando camadas adicionais entre o metal / GaAs e, portanto, aumentando a resistência de contato [5]. Conforme discutido anteriormente, o aumento na resistência de contato em P2 foi atribuído aos possíveis danos superficiais causados pela limpeza do plasma de oxigênio. A adição de uma fina camada de Pt entre a superfície de Ti e GaAs (110) como em S4 resulta em um maior grau de cristalinidade do filme de Ti quando comparado a S1 e S2. Esse resultado pode ser correlacionado com a diminuição da resistência total do canal de 1400 kΩ em P3 para 72 kΩ em P4 que está associada a uma diminuição da resistência de contato. O RTA diminui ainda mais a resistência total do canal para 40 kΩ em P5, além do aumento do caráter ôhmico do IV mostrado na Fig. 2a. Este resultado indica que nenhuma reação prejudicial ocorre entre a superfície de Pt e GaAs na temperatura de recozimento e no tempo utilizado [29,30,31].
Conclusões
A influência do tratamento químico de superfície antes da evaporação do metal e da formação de contatos ôhmicos para NWs de GaAs autocatalisados com Be-dopado foi investigada correlacionando a caracterização de transporte de NWs individuais e análise estrutural de filmes finos de Ti, Pt e Pt / Ti depositados em Substratos de GaAs. Mostramos que o Ti exibe baixo grau de cristalinidade quando depositado na superfície de GaAs (110), o que afeta diretamente a resistência de contato dos dispositivos NW. A deposição de uma camada fina de Pt nas NWs antes de Ti / Pt / Au resulta em uma diminuição de 95% na resistência elétrica total de NWs de GaAs dopados com Be-dopado que está associada ao maior grau de cristalinidade de Pt do que Ti quando depositado diretamente em GaAs (110). Além disso, mostramos que o recozimento térmico das camadas metálicas diminui ainda mais a resistência de contato. Esses achados são de importância tecnológica no projeto de contatos ôhmicos para dispositivos baseados em GaAs NWs e mostram as contribuições individuais de cada etapa de processamento, descrita na Tabela 1, na resistência total e no caráter ôhmico dos dispositivos NW. Para melhorar ainda mais o desempenho do dispositivo, seria necessária uma otimização sistemática dos parâmetros de cada etapa individual. Em particular, mostramos que a interface metal-semicondutor nas paredes laterais NW desempenha um papel importante no desempenho do dispositivo e abre o caminho para futuras investigações do processo de cristalização de filmes finos metálicos depositados em diferentes orientações de superfície de materiais semicondutores III-V.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste estudo estão incluídos no artigo.
Abreviações
- FCC:
-
Cúbico centrado no rosto
- GIXRD:
-
Difração de raios-X de incidência de pastagem
- HCP:
-
Embalado hexagonal fechado
- IV:
-
Corrente electrica
- NW:
-
Nanowire
- RTA:
-
Recozimento térmico rápido
- SEM:
-
Microscopia eletrônica de varredura
Nanomateriais
- Contatos de tungstênio para aparelhos elétricos
- Mudar design de contato
- Contact “Bounce”
- Relés de retardo
- Funções de lógica digital
- Lentes de contato
- Cientistas de materiais ensinam nanofios a 'dançar'
- Otimização de Filme Fino Altamente Refletivo para Micro-LEDs de Ângulo Total
- Transistores de efeito de campo Nanoflake SnSe multicamadas com contatos óhmicos de baixa resistência
- Matrizes nanopilar de GaAs com cobertura au fabricada por corrosão química assistida por metal



