Crescimento autocatalisado de nanofios de GaSb verticais em hastes de InAs por deposição de vapor químico orgânico-metálico
Resumo
Nós relatamos o primeiro crescimento autocatalisado de nanofios de GaSb de alta qualidade em hastes de InAs usando deposição de vapor químico orgânico de metal (MOCVD) em substratos de Si (111). Para alcançar o crescimento de nanofios de heteroestrutura InAs / GaSb verticais, as taxas de fluxo de duas etapas do trimetilgálio (TMGa) e trimetilantimônio (TMSb) são usadas. Primeiro, usamos taxas de fluxo TMGa e TMSb relativamente baixas para preservar as gotículas de Ga nas hastes finas de InAs. Em seguida, as taxas de fluxo de TMGa e TMSb são aumentadas para aumentar a taxa de crescimento axial. Por causa da taxa de crescimento radial mais lenta de GaSb em temperatura de crescimento mais alta, os nanofios de GaSb crescidos a 500 ° C exibem diâmetros maiores do que aqueles cultivados a 520 ° C. No entanto, no que diz respeito ao crescimento axial, devido ao efeito Gibbs-Thomson e à redução da supersaturação das gotas com o aumento da temperatura de crescimento, os nanofios de GaSb crescidos a 500 ° C são mais longos do que aqueles cultivados a 520 ° C. Análises detalhadas de microscopia eletrônica de transmissão (TEM) revelam que os nanofios de GaSb têm uma estrutura cristalina perfeita de zinco-blenda (ZB). O método de crescimento apresentado aqui pode ser adequado para o crescimento de outros nanofios de antimonídeo, e os nanofios de heteroestrutura axial de InAs / GaSb podem ter forte potencial para uso na fabricação de novos dispositivos baseados em nanofios e no estudo da física quântica fundamental.
Histórico
Nanofios semicondutores III-V foram reconhecidos como candidatos promissores para dispositivos eletrônicos, ópticos e quânticos em nanoescala de próxima geração devido às suas propriedades eletrônicas, ópticas e geométricas únicas [1,2,3]. Entre os materiais semicondutores III-V, por causa de suas vantagens únicas, como bandgap estreito e direto, pequena massa efetiva do portador e a maior mobilidade do portador, os III-antimonídeos têm forte potencial para uso na fabricação de infravermelho de onda média e longa fotodetectores [4], transistores de baixa potência e alta velocidade [5,6,7] e no estudo da física quântica fundamental [8,9,10]. No entanto, devido à sua grande massa atômica, a baixa volatilidade do Sb elementar e a baixa temperatura de fusão dos compostos III-antimonídeo, alcançando o crescimento de nanofios à base de antimonídeo, é extremamente desafiador [11].
Em particular, os nanofios de GaSb, considerados nanofios de antimonídeo do tipo p extremamente importantes, foram cultivados principalmente com a ajuda de catalisadores de Au [12,13,14,15,16]. No entanto, a introdução de Au pode formar centros de recombinação de nível profundo indesejados no gap de Si e degradar as propriedades eletrônicas e ópticas dos nanofios III-V [17, 18]. Portanto, é altamente desejável cultivar nanofios de GaSb sem nenhum catalisador estranho. Além disso, para o crescimento vertical de nanofios de antimonídeo, a nucleação direta no substrato é muito difícil. Para evitar o problema de nucleação, uma haste curta de outro material é sempre cultivada primeiro para auxiliar o crescimento de nanofios de GaSb verticais. Recentemente, o crescimento autocatalisado de nanofios de GaSb em hastes de GaAs foi realizado por epitaxia de feixe molecular (MBE) [19], mas até onde sabemos, não há relatórios sobre o crescimento de nanofios de GaSb de alta qualidade sem o uso de catalisadores estranhos com base em uma técnica de deposição de vapor químico orgânico de metal (MOCVD). Aqui, apresentamos o crescimento autocatalisado de nanofios de GaSb com o auxílio de hastes de InAs usando MOCVD em substratos de Si (111). Por um lado, o crescimento de nanofios de GaSb em hastes de nanofios de InAs por um mecanismo autocatalisado é difícil devido à mudança de ânions e cátions da haste de InAs para o GaSb superior. Por outro lado, devido à baixa incompatibilidade de rede de 0,6% e ao alinhamento de banda quebrada do tipo II exclusivo entre InAs e GaSb, o crescimento de nanofios de GaSb em hastes de InAs para formar nanofios de heteroestrutura axial de InAs / GaSb permite uma nova plataforma para muitas aplicações, incluindo dispositivos baseados em tunelamento [7, 14, 20, 21], transistores semicondutores de óxido de metal complementar de alta velocidade (CMOS) [22, 23], pesquisas sobre hibridização elétron-buraco [9] e exciton- e estudos de spin-física [24].
Neste artigo, nanofios de GaSb de alta qualidade com paredes laterais lisas foram obtidos por meio do controle cuidadoso das condições de crescimento. Para alcançar o crescimento de nanofios de heteroestrutura vertical de InAs / GaSb, taxas de fluxo relativamente baixas de trimetilgálio (TMGa) e trimetilantimônia (TMSb) foram usadas primeiro para preservar as gotículas de Ga nas hastes de InAs. Em seguida, as taxas de fluxo TMGa e TMSb foram aumentadas para aumentar o crescimento axial dos nanofios de GaSb. Por causa da taxa de crescimento radial mais lenta de GaSb em temperatura de crescimento mais alta, nanofios de GaSb crescidos a 500 ° C têm diâmetros maiores do que aqueles crescidos a 520 ° C. Além disso, devido ao efeito Gibbs-Thomson e à redução na supersaturação de gotículas com o aumento da temperatura de crescimento, os nanofios de GaSb crescidos a 500 ° C são maiores em diâmetro e comprimento do que aqueles cultivados a 520 ° C. Análises detalhadas de microscopia eletrônica de transmissão (TEM) revelam que a estrutura cristalina das hastes InAs é composta por um politipo de estruturas wurtzita (WZ) e zinco-blenda (ZB), enquanto os nanofios GaSb crescidos axialmente têm uma estrutura cristalina ZB pura completamente livre de defeitos planares.
Métodos
Crescimento Nanowire
Os nanofios de heteroestrutura InAs / GaSb foram cultivados por um sistema MOCVD de chuveiro acoplado (AIXTRON Ltd, Alemanha) a uma pressão de câmara de 133 mbar. Trimetilíndio (TMIn) e TMGa foram usados como precursores do grupo III, e arsina (AsH 3 ) e TMSb foram usados como precursores do grupo V. Hidrogênio de pureza ultra-alta (H 2 ) foi usado como gás de arraste e a taxa de fluxo total de H 2 era de 12 slm. Os nanofios foram cultivados em substratos de Si (111). Antes do crescimento, os substratos foram aquecidos a 635 ° C para recozimento e, em seguida, resfriados a 400 ° C sob AsH 3 fluxo para formar (111) superfícies semelhantes a B [25]. Os caules InAs foram cultivados a 545 ° C por 45 s com TMIn e AsH 3 taxas de fluxo de 1,0 × 10 −6 mol / min e 2,0 × 10 −4 mol / min, respectivamente. Posteriormente, os fluxos de origem foram trocados de TMIn e AsH 3 para TMGa e TMSb, e os substratos foram resfriados à temperatura específica para o crescimento axial dos nanofios de GaSb. Finalmente, as amostras foram resfriadas à temperatura ambiente usando TMSb como agente protetor.
Métodos de caracterização
A morfologia dos nanofios foi caracterizada por microscopia eletrônica de varredura (SEM) (Nova Nano SEM 650), e TEM (JEM2010F TEM; 200 kV) em conjunto com espectroscopia dispersiva de energia de raios-X (EDS) foi usada para investigar a estrutura cristalina e a distribuição da composição elementar, respectivamente. Para observações de TEM, os nanofios crescidos foram transferidos mecanicamente das amostras para grades de cobre revestidas com um filme de carbono. As medições Raman foram realizadas em geometria de retroespalhamento à temperatura ambiente usando um laser de comprimento de onda de 532 nm como fonte de excitação (Jobin-Yvon HR Evolution Raman System). As amostras foram excitadas com uma potência de laser de 0,36 mW sobre um tamanho de ponto de aproximadamente 1 μm.
Resultados e discussão
A Figura 1 mostra uma ilustração esquemática do crescimento axial de nanofios de GaSb em hastes InAs e as sequências de fornecimento de fonte para o crescimento dos nanofios. Os nanofios crescem por meio de um mecanismo autocatalisado e as gotículas catalíticas mudam de In para Ga gradualmente após a troca dos fluxos de TMIn e AsH 3 para TMGa e TMSb. Em comparação com os nanofios de haste, os nanofios de GaSb são sempre com um diâmetro muito mais espesso, o que significa que o tamanho das gotículas catalíticas de Ga é muito maior do que o das gotículas de In. Então, a coleta excessivamente rápida de adátomos Ga pelas gotas nas hastes finas de InAs pode causar um escorregamento das gotas (como mostrado no arquivo adicional 1:Figura S1). Para garantir que as gotículas catalíticas tenham tempo suficiente para coletar adátomos Ga durante o estágio de transição de InAs para GaSb, primeiro usamos taxas de fluxo relativamente baixas de TMGa e TMSb para proteger as gotículas de Ga nas hastes de InAs, como mostrado na Fig. 1. Durante a primeira etapa, as taxas de fluxo TMGa e TMSb foram 0,35 × 10 −6 mol / min e 2,0 × 10 −6 mol / min, que corresponde a uma razão V / III de ~ 5,7, e o processo de crescimento permaneceu 15 min (região 2 na Fig. 1). Depois disso, para aumentar a taxa de crescimento axial, as taxas de fluxo de TMGa e TMSb foram aumentadas para 0,7 × 10 −6 mol / min e 4,0 × 10 −6 mol / min para o crescimento subsequente de nanofios de GaSb (mantendo a razão V / III constante), respectivamente. Usando as taxas de fluxo TMGa e TMSb de duas etapas, percebemos com sucesso o crescimento vertical de nanofios de GaSb em hastes InAs. Considerando o tempo de crescimento inalterado dos nanofios de GaSb com as taxas de fluxo baixas, a menos que especificamente indicado, os tempos de crescimento para os nanofios de GaSb mencionados nos parágrafos a seguir são idênticos ao do crescimento de GaSb com as taxas de fluxo altas (região 3 na Fig. 1) .
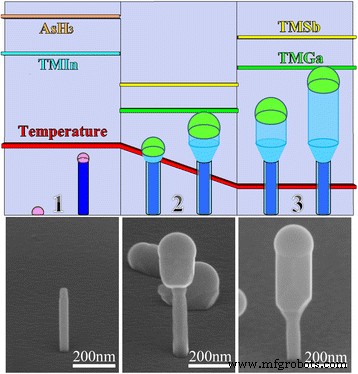
A ilustração do crescimento axial de nanofios de GaSb em hastes de InAs e as sequências de fornecimento de fonte para o crescimento dos nanofios. Os nanofios de GaSb apresentados aqui foram cultivados a 520 ° C
Imagens SEM típicas dos nanofios de GaSb cultivados em hastes de InAs em diferentes temperaturas de 480, 500, 520 e 545 ° C são mostradas na Fig. 2a-d, respectivamente (as hastes de InAs antes do crescimento de GaSb são mostradas no arquivo adicional 1:Figura S2). O tempo de crescimento do GaSb é de 10 min. Observou-se que o comportamento de crescimento do GaSb é muito sensível à temperatura de crescimento. Claramente, a 480 ° C, em vez de crescimento axial, o GaSb tende a crescer radialmente ao redor das hastes de InAs ou ao longo da direção plana (Fig. 2a). Detalhes sobre o crescimento radial de conchas de GaSb em núcleos de InAs e o crescimento planar de nanofios de antimonídeo foram relatados em outro lugar [26,27,28]. No entanto, a situação muda conforme a temperatura de crescimento de GaSb aumenta para 500 ou 520 ° C, onde o crescimento axial de nanofios de GaSb é realizado nas hastes InAs independentes (Fig. 2b, c). As gotículas de Ga nas pontas dos nanofios indicam um mecanismo de crescimento autocatalisado vapor-líquido-sólido (VLS) dos nanofios de GaSb. O diâmetro dos segmentos GaSb superiores é geralmente mais espesso do que os segmentos InAs, e o aumento da largura dos segmentos GaSb na interface InAs / GaSb indica que o tamanho das gotículas catalíticas Ga aumenta gradualmente no estágio de crescimento inicial de GaSb. Além disso, os segmentos de haste muito mais finos na Fig. 2c podem implicar que o crescimento radial de GaSb foi reduzido gradualmente com o aumento da temperatura de crescimento de 500 a 520 ° C. No entanto, quando a temperatura é aumentada para 545 ° C, os nanofios de GaSb parecem estar crescendo ao longo da direção plana ou inclinada. Além disso, a maioria das hastes de InAs desapareceu e o diâmetro das hastes de InAs residuais é muito fino (marcado pelos círculos vermelhos na Fig. 2d, e mais imagens SEM são mostradas no arquivo adicional 1:Figura S3). Especulamos que as hastes de InAs são seriamente decompostas na alta temperatura de crescimento de 545 ° C, resultando na queda dos nanofios de GaSb durante o processo de crescimento. Portanto, para obter o crescimento vertical de nanofios de GaSb em hastes de nanofios InAs, a temperatura de crescimento do nanofio de GaSb deve ser controlada cuidadosamente.

As imagens SEM com inclinação de 80 ° dos nanofios de GaSb cultivados em hastes de InAs em a 480 ° C, b 500 ° C, c 520 ° C e d 545 ° C durante 20 min. As condições de crescimento das hastes do nanofio InAs foram mantidas constantes. Inserções em b e c mostram imagens SEM de maior ampliação. Os círculos vermelhos em d marque as hastes InAs residuais
A Figura 3 exibe as distribuições estatísticas do diâmetro e comprimento dos segmentos de GaSb mostrados na Fig. 2b, c, onde as temperaturas de crescimento de GaSb são 500 e 520 ° C, respectivamente. Claramente, a distribuição de tamanho de nanofios de GaSb crescidos na mesma temperatura (pontos vermelhos ou azuis na Fig. 3) demonstra que os nanofios mais grossos tendem a ser mais longos. Este fenômeno também foi relatado para o crescimento catalisado por Ga de nanofios GaAsP por MBE [29] e para o crescimento catalisado por Au de nanofios de heteroestrutura InAs / InSb por epitaxia de feixe químico (CBE) [30] e nanofios InGaSb por MOCVD [31 ] A razão é atribuída principalmente à supersaturação efetiva inferior (Δ μ ) nas gotículas catalíticas menores. Para o mecanismo de crescimento VLS, a supersaturação Δ μ , que é a mudança no potencial químico por par III-V na gota catalítica e no nanofio, é a principal força motriz para o crescimento do nanofio. Durante o processo de crescimento autocatalisado, os nanofios são cultivados em um ambiente rico no grupo III e a concentração dos átomos do grupo V incorporados na gota catalítica domina a supersaturação efetiva. Para o crescimento autocatalisado de nanofios de GaSb, a supersaturação efetiva Δ μ é dominado pela concentração de átomos de Sb incorporados nas gotículas catalíticas de Ga. Portanto, a supersaturação efetiva Δ μ pode ser apresentado como [32, 33]
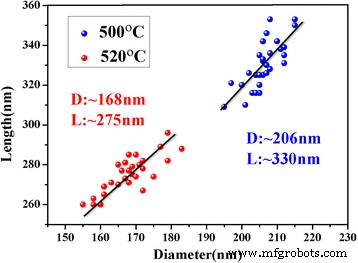
Os dados estatísticos do diâmetro e comprimento dos nanofios GaSb crescidos a 500 e 520 ° C
.
$$ \ varDelta \ mu ={k} _ {\ mathrm {B}} T \ ln \ left ({x} _ {\ mathrm {Sb}} / {x} _ {\ mathrm {Sb}, \ mathrm { eq}} \ right) $$ (1)
onde k B é a constante de Boltzmann, T é a temperatura absoluta. x Sb e x Sb, eq são a fração atômica de Sb nas gotículas catalíticas de Ga durante o processo de crescimento do nanofio e em equilíbrio com o cristal do nanofio de GaSb, respectivamente. Além disso, com base na teoria clássica de crescimento do cristal, a taxa de crescimento axial do nanofio ( v ) pode ser expresso como [34].
$$ v \ sim {\ left (\ varDelta \ mu / {k} _ {\ mathrm {B}} T \ right)} ^ 2 $$ (2)
Claramente, a taxa de crescimento do nanofio tem uma forte dependência da concentração de Sb x Sb nas gotículas de Ga. Por causa do efeito Gibbs-Thomson, a pressão de vapor de Sb nas gotículas catalíticas pode aumentar significativamente à medida que o diâmetro diminui [35, 36]. Então, as gotículas menores podem mais facilmente dessorver átomos de Sb das partículas catalíticas de Ga, o que resultará na concentração de Sb mais baixa ( x Sb ) nas gotículas catalíticas Ga menores. Como consequência, a supersaturação efetiva nas gotículas menores é menor do que nas maiores, reduzindo assim a taxa de crescimento axial dos nanofios de GaSb pelo mecanismo de crescimento autocatalisado.
Além disso, ao comparar as distribuições de tamanho de nanofios GaSb crescidos a 500 e 520 ° C, os nanofios GaSb crescidos a 500 ° C (pontos azuis na Fig. 3; diâmetro médio e comprimento ∼206 e ~ 330 nm) são observados como tendo um diâmetro e um comprimento maiores do que os nanofios de GaSb crescidos a 520 ° C (pontos vermelhos na Fig. 3; diâmetro e comprimento médio ∼168 e ~ 275 nm). Os nanofios mais finos crescidos a 520 ° C podem ser atribuídos à taxa de crescimento radial mais lenta de GaSb em temperatura de crescimento mais alta. No entanto, para o crescimento axial, diferente do efeito Gibbs-Thomson, o aumento na temperatura de crescimento também pode reduzir a supersaturação da gota e reduzir ainda mais a taxa de crescimento axial dos nanofios de GaSb [29, 37]. Assim, os nanofios de GaSb crescidos a 500 ° C são maiores em diâmetro e comprimento do que os nanofios de GaSb crescidos a 520 ° C.
Para determinar ainda mais os benefícios decorrentes da assistência dos nanofios de haste, comparamos os nanofios de GaSb crescidos diretamente em substratos de Si e em hastes InAs curtas, como visto na Fig. 4. Os nanofios de GaSb mostrados na Fig. 4a, b foram cultivados a 500 ° C, enquanto os nanofios de GaSb apresentados na Fig. 4c foram cultivados a 520 ° C. Claramente, as hastes de nanofios InAs desempenham um papel crucial no crescimento bem-sucedido de nanofios GaSb verticais. Conforme mostrado na Fig. 4a, os nanofios de GaSb crescidos diretamente em substratos de Si (111) preferem crescer ao longo da direção planar (mais imagens SEM estão disponíveis no arquivo adicional 1:Figura S4), e especulamos que esta questão dos nanofios de antimonídeo diretamente nucleado em substratos está associado ao efeito surfactante dos adátomos Sb, que pode diminuir o ângulo de contato entre as gotículas de Ga pré-depositadas e a superfície do substrato de Si [38, 39]. Considerando que, como mostrado na Fig. 4b, c, nanofios de GaSb verticais são obtidos com a ajuda de hastes InAs curtas. Notamos que, na Fig. 4b, c, o tempo de crescimento das hastes do nanofio InAs é diminuído para 20 s (resultando no comprimento dos nanofios InAs sendo geralmente abaixo de 120 nm), enquanto o tempo de crescimento dos nanofios GaSb é aumentado para 30 minutos. Todos os nanofios de GaSb têm paredes laterais extremamente lisas ao longo de todo o comprimento, sem afilamento visível. Notavelmente, os segmentos de haste InAs têm quase o mesmo diâmetro que os nanofios GaSb superiores (como mostrado na inserção da Fig. 4b, c), o que indica que a taxa de crescimento radial de GaSb em torno das hastes InAs é mais rápida do que em torno dos nanofios GaSb superiores . Essa diferença pode estar associada ao fato de que os adátomos reagentes difundidos da superfície do substrato tendem a se reunir em torno das paredes laterais dos nanofios de InAs finos e curtos, resultando no aumento local da taxa de crescimento radial de GaSb em torno das hastes de InAs. Finalmente, com tempo de crescimento suficiente, os nanofios crescidos têm um diâmetro quase uniforme ao longo da direção de crescimento; o mesmo comportamento também foi observado no crescimento de nanofios de InSb baseados em hastes curtas de InAs por MOCVD [40].

As imagens SEM com inclinação de 80 ° dos nanofios de GaSb cultivados sem hastes InAs ( a ), e nas hastes InAs curtas ( b , c ) Os nanofios GaSb mostrados em a e b foram cultivados a 500 ° C, enquanto os nanofios de GaSb em c foram cultivadas a 520 ° C. Inserções em b e c mostrar imagens SEM de maior ampliação
Para examinar as características estruturais dos nanofios obtidos, medições detalhadas de TEM foram realizadas. A Figura 5a mostra uma imagem TEM de baixa resolução de campo claro (BF) de um nanofio de GaSb típico cultivado em uma haste de InAs a 520 ° C (como mostrado na Fig. 2c). Após o crescimento subsequente do nanofio GaSb, o nanofio InAs mais fino tem uma morfologia aproximada. Isso pode ser atribuído à pirólise de InAs e ao crescimento radial irregular de GaSb durante o processo de crescimento de nanofios de GaSb. A Figura 5b-e representa as imagens TEM de alta resolução (HRTEM) correspondentes tiradas das regiões marcadas com quatro retângulos vermelhos na Fig. 5a. A micrografia HRTEM e o padrão de transformada rápida de Fourier (FFT) associado na Fig. 5b revelam que o nanofio GaSb crescido axialmente tem uma estrutura de cristal ZB pura completamente livre de defeitos planares, que é comumente observada no crescimento de nanofios de antimonídeo. No entanto, os defeitos planares ocasionais (planos gêmeos (TPs) e falhas de empilhamento (SFs)) que se apresentam no topo e na região de crescimento inicial do nanofio de GaSb (Fig. 5c, d) podem ser causados por uma ligeira flutuação das condições de crescimento local durante o eventual processo de resfriamento e o estágio inicial de transição do InAs para o GaSb superior. Além disso, os átomos residuais de As também podem desempenhar um papel na formação de defeitos planares na região de transição (como mostrado nas análises de EDS abaixo). Em contraste, como mostrado na Fig. 5e, a estrutura cristalina da haste InAs é composta por um politipo de estruturas WZ e ZB com um grande número de defeitos planos ao longo de sua direção de crescimento; devido à coexistência de estruturas WZ e ZB, os pontos FFT correspondentes se dividem e são ligeiramente alongados ao longo da direção de crescimento (inserção na Fig. 5e). Defeitos estruturais em nanofios demonstraram ser capazes de causar inibições indesejáveis da mobilidade do portador [41] e, portanto, reduzir as propriedades de transporte no sistema de heteroestrutura InAs / GaSb. Recentemente, foi relatado que a incorporação de Sb melhora efetivamente a qualidade do cristal dos nanofios InAs [42, 43], aumentando assim muito o potencial da engenharia de fase do cristal dos nanofios InAs sem quaisquer catalisadores estranhos.
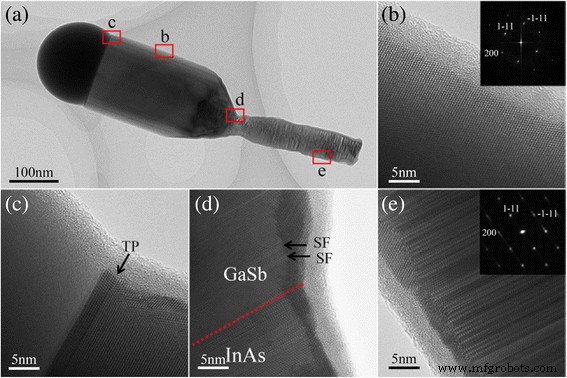
a Uma imagem TEM de baixa ampliação de um nanofio de heteroestrutura InAs / GaSb típico. b - e Imagens TEM de alta resolução (HRTEM) tiradas das regiões marcadas com retângulos vermelhos em ( a ) respectivamente. Todas as imagens HRTEM são adquiridas do eixo da zona 〈110〉. A linha tracejada vermelha em d indica a interface entre a haste InAs e o nanofio GaSb superior. As inserções em b e e são os padrões de transformada rápida de Fourier (FFT) correspondentes do nanofio GaSb e da haste InAs, respectivamente
A Figura 6a-f mostra uma imagem TEM de outro nanofio de heteroestrutura InAs / GaSb e as análises EDS correspondentes. Todas as medições de EDS usam os sinais de emissão Lα de In, As e Sb e o sinal de emissão Kα de Ga. A varredura da linha EDS ao longo da direção axial (Fig. 6b) e mapeamento elementar da composição de nanofios (Fig. 6c-f) mostram que a gota contém principalmente Ga e uma pequena quantidade de In, enquanto quase nenhum As ou Sb é observado, o que confirma diretamente o mecanismo de crescimento autocatalisado dos nanofios de GaSb (porcentagem atômica da análise quantitativa do ponto EDS no ponto 1:Ga, 96,13%; In, 3,8%; As, 0; Sb, 0,07%, respectivamente. Os espectros EDS das análises de ponto nos dois pontos são mostrados no arquivo adicional 1:Figura S5). Esta fraca concentração de In na gota é atribuída principalmente à dissolução dos átomos de In na gota de Ga durante o estágio de transição inicial de InAs para GaSb. Além disso, de acordo com a varredura de linha EDS na Fig. 6b, o crescimento de nanofios de GaSb começa nas hastes InAs e na análise do ponto EDS da distribuição da composição elementar no ponto 2 (Ga, 48,86%; In, 0,91%; As, 0,70%; Sb, 49,53%), a razão estequiométrica de átomos de Ga e Sb no segmento de GaSb crescido é de aproximadamente 1:1. No entanto, os sinais relativamente altos de Ga e Sb na seção InAs se originam do crescimento radial do GaSb em torno da haste InAs, e o gradiente elementar para os sinais In, As, Ga e Sb perto da interface pode ser causado principalmente por o residual In e As após o TMIn e AsH 3 fluxos são desligados.

a A ilustração dos nanofios de heteroestrutura axial de InAs / GaSb e uma imagem TEM de baixa ampliação de um nanofio InAs / GaSb crescido a 520 ° C. b Varredura de linha EDS ao longo da linha vermelha marcado em ( a ) c - f Mapas de composição EDS do nanofio em ( a ), mostrando a distribuição Ga, Sb, In e As. Dois lugares em a marque as posições onde as análises de pontos EDS foram realizadas
Para analisar as propriedades ópticas dos nanofios de GaSb crescidos, medições Raman foram realizadas. A Figura 7 mostra os espectros Raman de um substrato GaSb (100) e os nanofios de GaSb crescidos nas hastes InAs curtas. Dois picos de dispersão são observados no espectro do GaSb em aproximadamente 226,5 e 235,2 cm −1 (linha vermelha na Fig. 7) e são atribuídos aos modos de fônon óptico transversal (TO) e óptico longitudinal (LO) do GaSb, respectivamente. Para nanofios de GaSb, dois picos semelhantes também foram observados claramente em aproximadamente 225,0 e 233,6 cm −1 no espectro Raman (linha azul na Fig. 7), indicando alta qualidade fotônica dos nanofios GaSb obtidos. Em medições de retroespalhamento Raman, o modo de fônon TO é proibido na direção (100), um pequeno pico de modo de fônon TO para o substrato GaSb (100) em massa pode ser atribuído a uma leve orientação incorreta ou imperfeição do substrato [44]. No entanto, para os nanofios de GaSb, como os nanofios crescem ao longo da direção vertical (111) e com seis {110} paredes laterais, os modos de fônon TO e LO podem ser claramente observados no espectro Raman. Além disso, em comparação com GaSb em massa, os modos de fônon TO e LO dos nanofios de GaSb exibem uma redução de marcha fraca. Em medidas de espalhamento Raman, tanto o confinamento quântico quanto os defeitos podem induzir o downshift da frequência dos picos de fônons [45]. Considerando que, por causa do grande diâmetro dos nanofios de GaSb crescidos, que quase não mostra nenhum efeito de confinamento quântico, especulamos que essa redução fraca da frequência de fônons pode estar associada a defeitos de superfície dos nanofios de GaSb. Com as taxas de fluxo de duas etapas do TMGa e TMSb, percebemos o crescimento vertical de nanofios ZB GaSb puros em hastes InAs por MOCVD sem nenhum catalisador estrangeiro. Esperamos que, otimizando ainda mais os parâmetros de crescimento, como a temperatura de crescimento e diferentes combinações das taxas de fluxo TMGa e TMSb no processo de crescimento de duas etapas, nanofios de GaSb com uma razão de aspecto mais alta possam ser alcançados.

Espectros Raman de um substrato GaSb (100) ( linha vermelha ) e os nanofios GaSb ( linha azul ) As linhas verdes são resultados de ajuste Lorentziano de múltiplos picos
Conclusões
Em resumo, demonstramos o crescimento autocatalisado de nanofios de GaSb em hastes de InAs por MOCVD. Para perceber o crescimento dos nanofios de heteroestrutura verticais de InAs / GaSb, primeiro usamos taxas de fluxo TMGa e TMSb relativamente baixas para preservar as gotículas de Ga nas hastes de InAs. Em seguida, as taxas de fluxo de TMGa e TMSb são aumentadas para melhorar a taxa de crescimento axial. Por causa da taxa de crescimento radial mais lenta de GaSb em temperatura de crescimento mais alta, os nanofios de GaSb crescidos a 500 ° C têm um diâmetro maior do que aqueles cultivados a 520 ° C. Porém, para o crescimento axial, devido ao efeito Gibbs-Thomson e à redução da supersaturação das gotículas com o aumento da temperatura de crescimento, os nanofios de GaSb crescidos a 500 ° C são mais longos do que aqueles cultivados a 520 ° C. Medições detalhadas de TEM revelam que a estrutura cristalina das hastes InAs é uma mistura de estruturas WZ e ZB, enquanto os nanofios GaSb superiores têm uma fase de cristal ZB perfeita, e as análises Raman indicam alta qualidade óptica dos nanofios GaSb obtidos. O método de crescimento apresentado aqui pode ser adequado para o crescimento de outros nanofios à base de antimonídeo. Além disso, os nanofios GaSb crescidos em hastes InAs podem apresentar novas possibilidades para aplicações em dispositivos baseados em nanofios e para o estudo da física quântica.
Abreviações
- CMOS:
-
Semicondutor de óxido metálico complementar
- EDS:
-
Espectroscopia de energia dispersiva
- FFT:
-
Transformação rápida de Fourier
- LO:
-
Óptica longitudinal
- MBE:
-
Epitaxia de feixe molecular
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- SEM:
-
Microscopia eletrônica de varredura
- SF:
-
Falha de empilhamento
- TEM:
-
Microscopia eletrônica de transmissão
- TMGa:
-
Trimetilgálio
- TMSb:
-
Trimetilantimônia
- PARA:
-
Transversal óptico
- TP:
-
Avião duplo
- VLS:
-
Vapor-líquido-sólido
- ZB:
-
Blenda de zinco
Nanomateriais
- O que é deposição de vapor químico?
- Cientistas de materiais ensinam nanofios a 'dançar'
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Desvendando a evolução morfológica e cinética de corrosão de nanofios de silício poroso durante a corrosão química assistida por metal
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Filme WS2 de área grande com grandes domínios únicos cultivados por deposição de vapor químico
- Controlando o crescimento de seleneto de índio de alta uniformidade (In2Se3) Nanofios por meio do processo de recozimento térmico rápido em baixa temperatura
- Desempenho de magnetização uniaxial de matrizes nanofio Fe texturizadas eletrodepositadas por uma técnica de deposição potencial pulsada
- Propriedades elétricas das superredes de onda média e longa InAs / GaSb cultivadas em substratos de GaAs por epitaxia de feixe molecular
- Crescimento auto-propagado de MOCVD e fotoluminescência dramaticamente aprimorada de nanofios InGaAs / InP Core – Shell



