Detector infravermelho de comprimento de onda longo P + –π – M – N + InAs / GaSb Superlattice de longo comprimento de onda infravermelho com vulcanização anódica de alto desempenho - pré-tratado
Resumo
O detector infravermelho de superrede InAs / GaSb foi desenvolvido com tremendo esforço. No entanto, o desempenho dele, especialmente detectores infravermelhos de comprimento de onda longo (LWIR), ainda é limitado pelo desempenho elétrico e eficiência quântica óptica (QE). Forçando a região ativa a ser p O tipo por meio de dopagem adequada pode melhorar muito o QE, e a técnica de passagem pode ser empregada para melhorar muito o desempenho elétrico. No entanto, a tensão de polarização de saturação é muito alta. A redução da tensão de polarização de saturação tem amplas perspectivas para a aplicação futura de dispositivos de controle de tensão de porta. Neste artigo, relatamos que o gated P + - π –M – N + Os detectores infravermelhos de longo comprimento de onda da superrede InAs / GaSb exibem diferentes níveis de dopagem na região π que têm uma tendência de saturação mínima reduzida a - 10 V com um SiO de 200 nm 2 camada após um pré-tratamento simples e eficaz de vulcanização anódica. A tensão de polarização da porta de saturação é muito menor do que -40 V que relatou com a mesma espessura de um SiO de 200 nm 2 camada de passivação e estrutura semelhante. A caracterização ótica e elétrica indica que o desempenho elétrico e ótico do dispositivo seria enfraquecido pela concentração excessiva de dopagem. Em 77 K, o comprimento de onda de corte de 50% do dispositivo é de cerca de 8 µm, o comprimento de onda de corte de 100% é de 10 µm, a eficiência quântica máxima é 62,4%, o máximo de responsividade é 2,26 A / W a 5 µm e o máximo RA do dispositivo é 1259,4 Ω cm 2 . Além disso, a detectividade específica do detector dopado com Be 780 ° C sem eletrodo de porta exibe um pico de 5,6 × 10 10 cm Hz 1/2 / W a 5 µm com uma tensão de polarização reversa de 70 mv, que é mais de três vezes a do detector dopado com Be 820 ° C. Além disso, a detectividade específica de pico pode ser aumentada para 1,3 × 10 11 cm Hz 1/2 / W a 5 µm com uma tensão de polarização de reserva de 10 mv que tem a polarização de - 10 V no eletrodo da porta.
Introdução
Superredes de camada deformada tipo II (T2SLs) têm se tornado cada vez mais o foco da pesquisa atual desde Sai-Halasz et al. [1] propôs sua concepção. Detectores infravermelhos de alto desempenho podem ser gerados projetando cuidadosamente a estrutura de banda e deformação dos T2SLs [2]. A superrede InAs / GaSb, um membro bem estudado dos T2SLs, é um excelente sistema de materiais com amplas perspectivas no detector infravermelho [3]. O detector infravermelho de superrede InAs / GaSb foi desenvolvido com tremendo esforço. No entanto, o desempenho dele, especialmente os detectores infravermelhos de longo comprimento de onda (LWIR), ainda é limitado pelo desempenho elétrico e eficiência quântica óptica (QE) [4]. A temperatura ambiente correspondente (com base no solo) do detector LWIR é em torno de 300 K, que corresponde ao comprimento de onda de pico de 9,6 µm (o centro da janela de transmissão atmosférica do LWIR) e tem uma ampla gama de aplicações [5]. É amplamente utilizado em vários campos, como detecção de gás, visão noturna, alerta infravermelho, sensoriamento remoto infravermelho e orientação infravermelho, não apenas para uso militar, mas também para a vida das pessoas. É extremamente significativo e desafiador fabricar detectores infravermelhos de ondas longas de alto desempenho.
O projeto estrutural e a preparação do processo do detector têm um impacto significativo no desempenho do detector LWIR. Aumentar a espessura da região ativa parecia ser a forma mais direta e eficaz de melhorar o QE. Porém, mais centros de armadilhas são introduzidos junto com o aumento da espessura, levando a uma redução nas características elétricas do detector. No LWIR e nos detectores infravermelhos de comprimento de onda muito longo (VLWIR), a camada InAs tende a ser mais espessa do que a camada GaSb. Assim, o material é n -tipo (as operadoras minoritárias são buracos). Forçando a região ativa a ser p O tipo por meio de dopagem adequada pode aumentar muito o QE sem qualquer alteração no tamanho da região do dispositivo [6]. Porém, quanto maior for a concentração de dopagem, maior será a melhoria no desempenho do dispositivo. Particularmente, o desempenho elétrico [7] e o desempenho óptico do dispositivo podem ser enfraquecidos pela concentração excessiva de dopagem.
Além de alterar a concentração de doping no π região, a técnica de gating tem sido aplicada nos detectores infravermelhos de comprimento de onda médio (MWIR) e detectores LWIR [8] recentemente para melhorar o desempenho do dispositivo. No entanto, requer uma tensão de polarização de porta muito alta. A polarização da porta pode ser expressa pela Eq. (1).
$$ \ sigma =\ varepsilon \ varepsilon_ {0} V / d, $$ (1)
onde \ (\ varepsilon \) denota a constante dielétrica relativa da camada dielétrica, \ (\ varepsilon_ {0} \) representa a constante dielétrica do vácuo, V refere-se à tensão de polarização da porta de saturação, d é a espessura da camada dielétrica, e σ representa a densidade de carga na interface. A polarização do portão foi enfraquecida com base na fórmula com grande esforço; os meios de usar dielétrico alto-k, como Y 2 O 3 [9] para passivar ou reduzir a espessura da camada [10] é eficaz. No entanto, existem poucas pesquisas sobre como reduzir a densidade de carga. Neste artigo, a anodização é realizada primeiro para reduzir significativamente o viés de saturação. Uma mistura de NaS 2 · 5H 2 O e etilenoglicol são usados como a solução de vulcanização. Durante o processo de cura anódica, a combinação de átomos de enxofre e ligações pendentes na superfície do dispositivo fecha os canais condutores na superfície do dispositivo [11], reduz a recombinação da superfície do dispositivo e enfraquece a densidade de carga superficial do dispositivo. Em seguida, obtém-se uma camada de enxofre elementar denso e uniforme na superfície do dispositivo. Em seguida, a superfície da camada de enxofre elementar é coberta com uma camada de 200 nm SiO 2 . O eletrodo da porta é colocado no SiO 2 camada. A tensão de polarização da porta de saturação é reduzida conforme a densidade de carga na interface diminui.
Neste estudo, LWIR P pré-tratado por vulcanização anódica + - π –M – N + os detectores são fabricados sob uma tensão de polarização de porta de baixa saturação baseada em InAs / GaSb T2SLs com diferentes dopagens π regiões. Os resultados indicam que quanto maior a concentração de dopagem, maior a melhora no desempenho do dispositivo. Especificamente, o desempenho elétrico e óptico do dispositivo seria enfraquecido pela concentração excessiva de dopagem. Além disso, o pré-tratamento de vulcanização anódica pode reduzir significativamente a polarização do gate em -10 V, que é muito menor do que o relatado na mesma espessura de um SiO 2 de 200 nm camada de passivação com cerca de 40 V em estrutura semelhante.
Métodos
Materiais e estrutura
Os materiais são produzidos por um sistema GEN 20 MBE de fonte sólida no n de 2 polegadas -tipo GaSb (001) substratos. Neste trabalho, o detector LWIR de alto desempenho é baseado no P + - π –M – N + estrutura. Um esquema dos dispositivos, padrões de difração de raios-X de alta resolução (HRXRD) e microscopia de força atômica (AFM) é ilustrado nas Figs. 1 e 2. A Figura 1 indica que a estrutura consiste em um P + de 1300 nm de espessura Buffer de GaSb, seguido por um 8-ML InAs / 12-ML GaSb de 500 nm de espessura (Be:cerca de 1 × 10 18 cm −3 ) P + região, um 12-ML InAs dopado com P-2000 nm (Be:780 ° C 800 ° C 820 ° C) / 7-ML GaSb π região, um 500 nm não dopado 18-ML InAs / 3-ML GaSb / 5-ML AlSb / 3-ML GaSb região M, um 500 nm de espessura 18-ML InAs / 3-ML GaSb / 5-ML AlSb / 3-ML GaSb (Si:cerca de 1 × 10 18 cm −3 ) N + região e um N + de 30 nm Camada InAs Cap. E também mostra o alinhamento da banda de simulação com a estrutura. Considerando que o desempenho do P + - π –M – N + O detector LWIR seria significativamente influenciado pela dopagem do π região, preparamos três amostras com diferentes temperaturas de dopagem Be variando de 780 a 820 ° C.
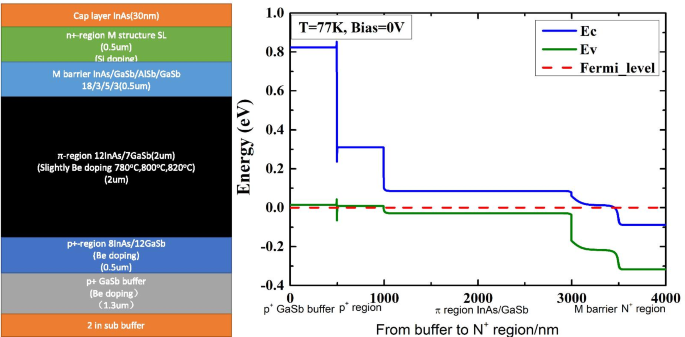
A estrutura epitaxial e o alinhamento da banda dos materiais com diferentes níveis de dopagem da região π

Curvas de balanço HRXRD para amostras com diferentes níveis de dopagem da região π
Os períodos da superrede de 59,3 Å, 58,4 Å e 89,5 Å para o p -contato, p - região ativa e camada de estrutura M, com incompatibilidades de rede de 60 segundos de arco, 0 segundos de arco e 0 segundos de arco, correspondentemente, são exibidos na Fig. 2. A largura total na metade do máximo para os SLs em cada região é 32 arco seg, 25 arco seg e 12 arco seg, indicando que o material tem alta qualidade nas interfaces.
A Figura 3 mostra que as etapas atômicas aparecem com a raiz quadrada média (RMS) da rugosidade com 1,87 Å em uma área de 10 × 10 µm.
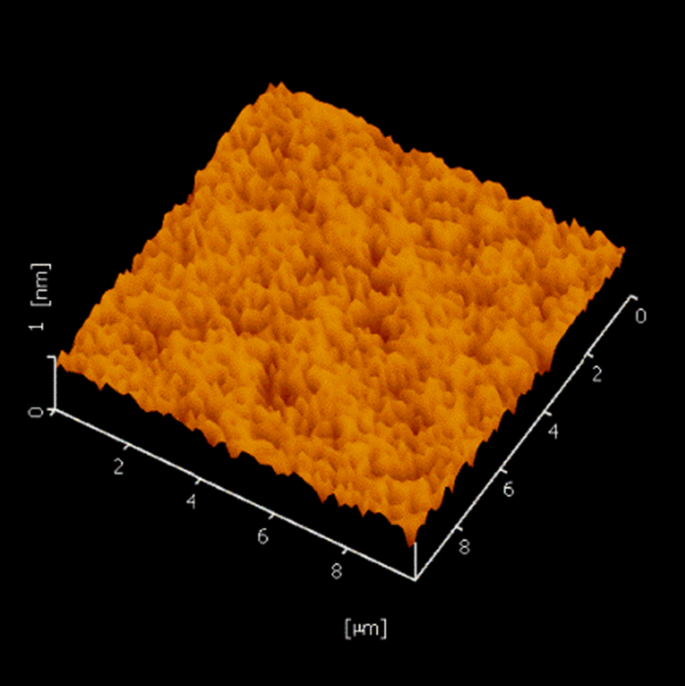
AFM de 10 × 10 µm 2 área de uma amostra
Estrutura e fabricação do dispositivo
O processo é semelhante ao da Referência [12]. Primeiro, o wafer é coberto com SiO 2 como uma máscara de hark. Em seguida, as etapas de litografia padrão correspondentes são adotadas. Em seguida, fazemos a máscara rígida aberta por sistema de plasma acoplado indutivamente (ICP). Em seguida, a mesa é obtida usando um sistema de plasma indutivamente acoplado (ICP) com um CH 4 / Cl 2 / Mistura de Ar. Especificamente, as bolachas são gravadas da camada superior para o P + contato [12]. Depois disso, o SiO restante 2 camada é removida. Em seguida, imergimos um lado do wafer em uma solução mista de sulfeto de sódio e etilenoglicol e, em seguida, aplicamos uma corrente constante ao wafer e definimos uma voltagem limite. Uma camada de átomo de enxofre será formada na superfície do filme e a resistência mudará. A voltagem no wafer aumentará gradualmente até atingir o limite de voltagem e, então, a vulcanização estará concluída. Então, a camada elementar de enxofre é coberta com uma camada de 200 nm SiO 2 . Além disso, a fotolitografia é realizada novamente para abrir a janela através da camada de SiO 2 e enxofre elementar como as regiões de contato de metal dos eletrodos de metal superior e inferior. Além disso, é realizada outra fotolitografia desenhada com duas formas de eletrodos; uma forma de eletrodo é para o diodo fechado (GD) e a outra é para o diodo ungated (UGD). Ti (50 nm) / Pt (50 nm) / Au (300 nm) é depositado por feixe de elétrons depositado para os eletrodos de metal. Finalmente, os eletrodos superior, inferior e de porta são adquiridos por levantamento de metal.
A Figura 4 ilustra a estrutura do GD. Como sabemos, o ângulo de inclinação da corrosão do material pode ser ajustado alterando a potência de ICP, potência de RF, fluxo de gás e pressão da câmara. Neste estudo, o ângulo de inclinação real da parede lateral está entre 80 graus e 85 ° para facilitar o contato da porta de depósito na parede lateral. O eletrodo da porta é colocado na parede lateral do SiO 2 camada.
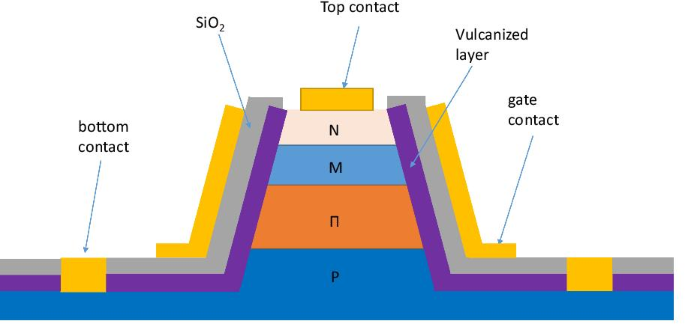
O diagrama da estrutura do dispositivo de GD
A Figura 5 demonstra que os meios-diodos são depositados como GDs nas três matrizes (780 ° C, 800 ° C e 820 ° C de dopagem). Então, tanto o diodo fechado (GD) quanto o diodo ungated (UGD) podem ser obtidos. Em última análise, a amostra A (780 ° C GD), a amostra B (780 ° C UGD), a amostra C (800 ° C GD), a amostra D (800 ° C UGD), a amostra E (820 ° C GD) e a amostra F (820 ° C UGD) podem ser adquiridos.

Imagem do dispositivo sob um microscópio óptico
Resultados e discussão
Em detectores infravermelhos, uma detectividade específica ( D *) geralmente é usado para caracterizar o desempenho do detector, que é calculado pela Eq. (2)
$$ D ^ {*} =\ frac {Ri} {{\ sqrt {2qJ + 4 \ frac {kT} {{RA}}}}} $$ (2)
onde q denota o valor da cobrança eletrônica; K refere-se à constante de Boltzmann; T é a temperatura Kelvin; Ri refere-se à responsividade do detector infravermelho; J é a densidade de corrente escura do dispositivo sob uma certa polarização; e RA refere-se ao produto do valor da resistência e área do molde. J e RA caracterizam o desempenho elétrico do dispositivo. E Ri pode ser convertido em QE com a fórmula:
$$ QE =\ frac {hC} {{q \ lambda}} Ri $$ (3)
onde \ (h \) é a constante de Planck, \ ({} C \) é a velocidade da luz, q denota a quantidade de carga eletrônica, \ ({} \ lambda \) é o comprimento de onda específico, e QE e Ri caracterizam o desempenho óptico do dispositivo. A Figura 6 exibe as características ópticas das amostras com diferentes π níveis de dopagem da região a 77 K. Todas as amostras têm um comprimento de onda de corte de 50% semelhante a 8 µm e um comprimento de onda de corte de 100% de 10 µm a 77 K. Embora o QE e a responsividade do dispositivo possam ser aumentados alterando o tipo de doping para ser p -tipo do π região, quanto maior a temperatura, maior o QE e a responsividade. No entanto, o QE e a responsividade são significativamente reduzidos com o aumento na concentração de dopagem. Para superredes de camada deformada tipo II (T2SLs), a temperatura de dopagem durante o crescimento é crítica para a concentração de dopagem. Quanto maior for a temperatura, maior será a concentração de dopagem. O QE de 780 ° C atinge seu valor máximo de 62,4%, que é 1,5 vezes maior que o QE de 820 ° C. Isso ocorre porque muitas impurezas são introduzidas com o aumento na concentração de dopagem, levando à diminuição do excesso de vida útil do portador / comprimento de difusão e à redução do QE e da responsividade [6]. Além disso, eles causam o desvio para o vermelho espectroscópico na Fig. 6a. As Figuras 6a eb indicam que 780 ° C é a melhor temperatura de dopagem dos materiais para caracterização óptica, com o pico de responsividade de 2,26 A / W a 5 µm e o pico de QE de 62,4%.
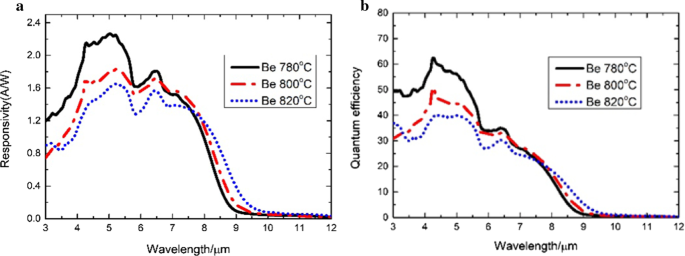
As características ópticas das amostras com diferentes níveis de dopagem da região π a 77 K
A Figura 7 exibe as características elétricas das amostras UGD com diferentes π níveis de dopagem na região a 77 K. O desempenho elétrico do dispositivo seria altamente afetado por diferentes π concentrações de dopagem na região [7]. Com o aumento no nível de dopagem da região π, o produto do valor da resistência e da área do molde (RA) em certa polarização torna-se menor, e a densidade da corrente escura torna-se maior correspondentemente. Semelhante à Referência [6], RA atinge seu máximo próximo a 0 V com uma quebra suave conforme a polarização reversa aumenta, sugerindo que o dispositivo tem um modo de corrente escura de tunelamento. Atingimos um máximo de RA de 1259,4 Ω cm 2 com Be dopado com 780 ° C a - 200 mv que é quase 40 vezes maior que o Be dopado com 820 ° C. A Figura 7b ilustra que a densidade de corrente escura é semelhante na polarização negativa na faixa de - 0,1 a 0 V, e a densidade de corrente escura com Be dopado com 780 ° C é um pouco menor em comparação com outras. A corrente escura é 4,9 × 10 −3 A / cm 2 para o dispositivo com ser dopado com 780 ° C a - 70 mv.
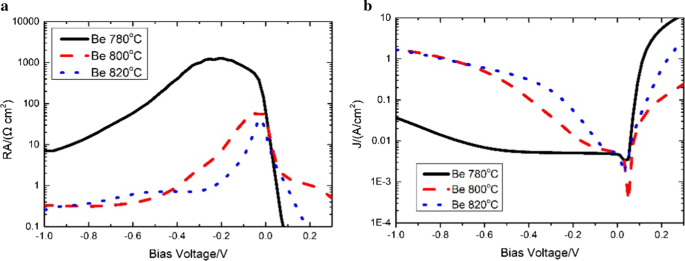
As características elétricas das amostras UGD com diferentes π níveis de dopagem da região em 77 K
O D correspondente * pode ser calculado tomando o Ri específico, J , e os valores de RA sob diferentes tensões de polarização a 77 K. A Figura 8 exibe a detectividade das amostras UGD com diferentes π regiões. Em - 30 mv, a detectividade de pico é 5,6 × 10 10 cm Hz 1/2 / W a 5 µm com Be dopado com 780 ° C, enquanto é 3,8 × 10 10 cm Hz 1/2 / W com Be dopado com 820 ° C. O pico de detectividade do Be dopado com 780 ° C é 1,5 vezes maior que o do Be dopado com 820 ° C. Portanto, a concentração de dopagem apropriada é extremamente significativa. No entanto, uma concentração de dopagem muito alta enfraqueceria o desempenho do dispositivo.

Correlação entre a detectividade específica em 77 K de amostras UGD com π níveis de dopagem e comprimento de onda da região
A Figura 9 apresenta as características elétricas da amostra GD com Be dopado com 760 ° C a 77 K. Diferente dos dispositivos de controle de tensão de porta comuns, o pré-tratamento de vulcanização anódica é realizado pela primeira vez neste estudo para reduzir notavelmente a tensão de polarização de porta de saturação. Além disso, uma mistura de NaS 2 · 5H 2 O e etilenoglicol são usados como a solução de vulcanização. O método de passivação por vulcanização de ânodo é empregado para formar uma camada de enxofre elementar denso e uniforme na superfície do dispositivo. Durante a reação eletroquímica, os átomos de enxofre são combinados com as ligações oscilantes na superfície do dispositivo, contribuindo para o fechamento dos canais eletrônicos gerados pelas ligações oscilantes da superfície e isolando o mecanismo de recombinação elétron-buraco da superfície do dispositivo [11]. Então, a superfície da camada de enxofre elementar é coberta com uma camada protetora de 200 nm SiO 2 , e o eletrodo de porta é colocado na parede lateral do SiO 2 camada. Conforme relatado em pesquisas anteriores, a correlação entre o viés de saturação e a espessura da camada dielétrica do dispositivo é quase linear. A Figura 9 sugere que a tendência de saturação do dispositivo pode ser reduzida em cerca de - 10 V através de um pré-tratamento de vulcanização simples e eficaz; este valor reduzido em outras pesquisas é cerca de 40 V e é quatro vezes maior em dispositivos de estrutura semelhante com a mesma espessura SiO 2 camada [10]. Além disso, o RA atinge seu máximo de 25 Ω cm 2 perto de 0 V. A tendência de queda diminuiu significativamente quando aplicamos a tensão de polarização negativa em cerca de - 10 V. Quando aplicamos a tensão de polarização de - 10 V no eletrodo de porta, RA é 10 Ω cm 2 a - 0,3 V, que é 40 vezes maior que sem tensão de polarização aplicada. Além disso, é quase duas ordens de magnitude menor do que sob nenhuma tensão de polarização em - 0,6 V. A Figura 9b indica que a corrente escura atinge seu mínimo de 2 × 10 –4 A / cm 2 próximo a 0 V, e é reduzido em uma ordem de magnitude em - 0,3 V. Como sabemos, a curva IV não mudaria com a polarização da porta em 0 V quando a tensão de polarização for positiva. Além disso, o RA do dispositivo aumenta significativamente quando a tensão de polarização aumenta de 0 a - 10 V; enquanto isso, a corrente escura do dispositivo diminui correspondentemente. Quando a tensão de polarização varia de -10 a -20 V, o RA do dispositivo diminui ligeiramente e a corrente escura do dispositivo aumenta correspondentemente. Em polarização de alta reserva (por exemplo, -1 V) entre os eletrodos superior e inferior, a corrente escura diminui com polarização de porta e, em seguida, aumenta ligeiramente além de -12 V. É principalmente para a característica de polarização de porta. Uma introdução adicional é mostrada na Fig. 10. Para polarização reversa baixa (por exemplo, - 0,1 V), a corrente escura parece aumentar à medida que a polarização da porta aumenta, o que é completamente diferente daquela em -1 V. Para polarização reversa diferente, suspeitamos que o principal mecanismo de vazamento é diferente. Para polarização de baixa reserva, a polarização de porta alta mostra influência negativa, pois influencia o espalhamento superficial de elétrons e elétrons quentes. E para polarização reversa alta, o vazamento diminui para a corrente de vazamento de superfície. Então é diferente.

As características elétricas das amostras GD com 780 ° C podem ser dopadas com diferentes tensões de polarização de porta e a tensão de polarização no eletrodo superior e inferior
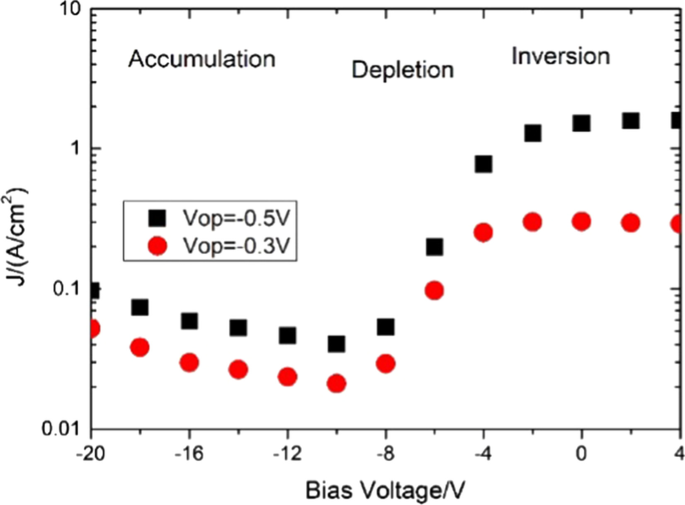
Correlação entre a densidade de corrente escura reversa e o viés de porta da amostra GD com 780 ° C Ser dopado em diferentes vieses de operação de diodo
Conforme ilustrado na Fig. 10, em polarização de alta reserva (por exemplo, -1 V) entre o eletrodo superior e inferior, a corrente escura diminui com polarização de porta e, em seguida, aumenta ligeiramente além de -12 V; podemos ver que o dispositivo existe em três estágios com a mudança na tensão de polarização em 77 K [10]. De acordo com a Referência [13], o P + e N + regiões para P + –Π – M – N + dispositivo de estrutura são fortemente dopados, e a região M é uma região de banda larga com uma massa efetiva maior em comparação com o π e P + região; portanto, o viés de porta tem muito mais influência sobre o π região em comparação com outras [13]. Usando um método semelhante com Chen [10], três estágios durante o processo de alta tensão de polarização negativa (- 20 a - 10 V) sendo aplicada no eletrodo de porta são analisados; os resultados indicam que a parede lateral da mesa está na condição plana ou sob acumulação [8], e a densidade da corrente escura aumenta ligeiramente com a polarização da porta devido à interface de vulcanização. Suspeito de vulcanização, interface ligeiramente não homogênea de densidade, em algum lugar densidade insuficiente ligeiramente quebrada. Quando a tensão de polarização negativa (- 10 a - 2 V) é aplicada, a parede lateral da mesa se esgota e a corrente escura aumenta suavemente. Além disso, a largura de depleção induzida por campo atinge seu máximo e a formação da camada de inversão quando a tensão de polarização em - 2 V é aplicada à polarização de porta positiva; assim, a densidade de corrente escura se mantém constante. De acordo com a Referência [14], é explicado porque a corrente de geração-recombinação de superfície (G-R) em - 0,5 V é maior do que em - 0,3 V.
A Figura 11 exibe que, com a polarização da porta em - 10 V, o D * para amostra GD com 780 ° C Ser dopado atinge seu pico de detectividade de 1,3 × 10 11 cm Hz 1/2 / W a 5 µm, que é mais de duas vezes que sob tensão sem polarização com 780 ° C Ser dopado e mais de três vezes que sob tensão sem polarização com 820 ° C Ser dopado com 77 K. Isso indica que aplicando polarização negativa apropriada pode melhorar significativamente o desempenho do dispositivo.
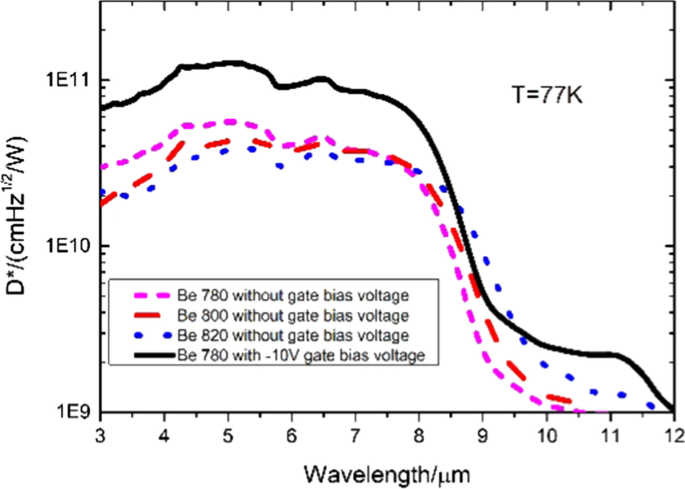
Correlação entre a detectividade da amostra GD com amostras dopadas de 780 ° C e UGD com diferentes níveis de dopagem da região π e o comprimento de onda a 77 K
Conclusões
2017 Northwestern University relatou fotodetectores infravermelhos de comprimento de onda longo (LWIR) nBn baseados em InAs / InAs 1− x Sb x superredes tipo II. O dispositivo exibiu um comprimento de onda de corte de ∼ 10 µm a 77 K com uma responsividade de pico de 2,65 A / W, correspondendo a uma eficiência quântica de 43% e RA 664 Ω cm 2 e uma densidade de corrente escura de 8 × 10 5 A / cm 2 , tensão de polarização abaixo de 80 mV a 77 K; o fotodetector exibiu uma detectividade específica de 4,72 × 10 11 cm Hz 1/2 / W [5]. A capacidade de resposta máxima deste dispositivo é 1,3 × 10 11 cm Hz 1/2 / W a 5 µm e 0 V com tensão de polarização de porta de -10 V que é comparável ao dispositivo nBn. Mas o ponto fraco é a uniformidade de RA do dispositivo, que influencia o desempenho do dispositivo.
Em conclusão, forçando a região ativa a ser p -tipo por meio de doping no π A região pode melhorar efetivamente o desempenho da superrede LWIR InAs / GaSb P + - π –M – N + detector [6]. Porém, quanto maior for a concentração de dopagem, maior será a melhoria no desempenho do dispositivo. Particularmente, o desempenho elétrico e óptico do dispositivo pode ser reduzido pela concentração excessiva de dopagem. A caracterização óptica a 77 K indica que obtemos um máximo de QE de 62,4% a 4,26 µm e um máximo de 2,26 A / W a 5 µm com Be dopado com 780 ° C. A caracterização elétrica sugere que um máximo de RA de 1259,4 Ω cm 2 com Be dopado com 780 ° C. A detectividade específica atinge seu máximo de 5,6 × 10 10 cm Hz 1/2 / W a 5 µm com Be dopado com 780 ° C. Além disso, a tendência de saturação do dispositivo pode ser drasticamente reduzida por meio de um pré-tratamento de vulcanização anódica simples e eficaz. O pré-tratamento de vulcanização exibe seu potencial para reduzir a tensão de polarização da porta. A caracterização elétrica ilustra que o viés de saturação é de apenas - 10 V, enquanto é de 40 V em outras pesquisas sem pré-tratamento de vulcanização em uma estrutura semelhante com a mesma espessura do SiO 2 camada. Além disso, o desempenho do dispositivo pode ser significativamente melhorado pela aplicação de uma polarização negativa adequada no eletrodo de porta. No máximo 1,3 × 10 11 cm Hz 1/2 / W é alcançado a 5 µm e 0 V com tensão de polarização de porta de -10 V com Be dopado com 780 ° C a 77 K. Limitada pelo equipamento experimental e pelas condições experimentais, escolhemos SiO 2 como camada dielétrica, mas no seguimento, é considerado o uso de meio Hi-K para experimentos posteriores. Teoricamente, a tensão de polarização da porta pode ser ainda mais reduzida.
Disponibilidade de dados e materiais
Os autores declaram que os materiais e dados estão prontamente disponíveis aos leitores sem qualificações indevidas para acordos de transferência de material. Todos os dados gerados ou analisados durante este estudo estão incluídos neste artigo.
Abreviações
- LWIR:
-
Detectores infravermelhos de comprimento de onda longo
- QE:
-
Eficiência quântica
- T2SLs:
-
Superredes de camada deformada Tipo II
- VLWIR:
-
Detectores infravermelhos de comprimento de onda muito longo
- MWIR:
-
Detectores infravermelhos de comprimento de onda médio
- HRXRD:
-
Difração de raios-x de alta resolução
- AFM:
-
Força atômica microscópica
- ICP:
-
Plasma indutivamente acoplado
- GD:
-
Diodo fechado
- UGD:
-
Diodo ungated
- D *:
-
Detetividade específica
- RA:
-
Produto do valor da resistência e área da matriz
- Ri:
-
Responsividade do detector infravermelho
- G – R:
-
Geração-recombinação
Nanomateriais
- Entrevista com especialista:Oxford Performance Materials ’Scott DeFelice sobre a evolução dos polímeros de alto desempenho para impressão 3D
- Síntese fácil de WS2 / Bi2MoO6 heteroestruturado como fotocatalisadores acionados por luz visível de alto desempenho
- Crescimento autocatalisado de nanofios de GaSb verticais em hastes de InAs por deposição de vapor químico orgânico-metálico
- Biocompatibilidade aprimorada em TaO anódico x arranjos de nanotubos
- Desempenho fotocatalítico acionado por luz visível de nanocompósitos N-dopados com ZnO / g-C3N4
- Preparação e desempenho fotocatalítico de fotocatalisadores de estrutura oca LiNb3O8
- Um romance fotocatalisador de heterojunção Bi4Ti3O12 / Ag3PO4 com desempenho fotocatalítico aprimorado
- Desempenho aprimorado de um novo catalisador PdAu / VGCNF anódico para eletro-oxidação em uma célula de combustível de glicerol
- Detector de UV com alimentação própria de alto desempenho baseado em matrizes de nanomace SnO2-TiO2
- Avaliação automática do desempenho do detector de raios-X



