Camadas ótimas de dopagem de silício de barreiras quânticas na sequência de crescimento, formando potencial de confinamento suave de oito períodos em 0,2Ga0,8N / GaN poços quânticos de azul LEDs
Resumo
Os recursos de oito períodos In 0.2 Ga 0.8 Poços quânticos N / GaN (QWs) com dopagem de silício (Si) nas primeiras duas a cinco barreiras quânticas (QBs) na sequência de crescimento de diodos emissores de luz azul (LEDs) são explorados. Epilayers de QWs 'estruturas são cultivadas em 20 pares de In 0,02 Ga 0,98 Superrede N / GaN atuando como camadas de alívio de tensão (SRLs) em substratos de safira padronizados (PSSs) por um sistema de deposição de vapor químico orgânico de metal de baixa pressão (LP-MOCVD). Espectro de fotoluminescência dependente da temperatura (PL), corrente versus tensão ( I - V ) curvas, potência de saída de luz versus corrente de injeção ( L - eu ) curvas e imagens de microscopia eletrônica de transmissão de alta resolução (HRTEM) de epilayers são medidas. As consequências mostram que QWs com quatro QBs dopados com Si têm maior energia de localização da portadora (41 meV), tensões de ativação (3,27 V) e de ruptura (- 6,77 V) mais baixas, e maior potência de saída de luz de LEDs azuis em injeção mais alta atual do que outras amostras. A baixa altura de barreira de QBs em uma amostra de QB dopada com quatro Si resulta em potencial de confinamento suave de QWs e menor ativação e tensões de ruptura do diodo. As imagens HRTEM evidenciam que esta amostra possui interfaces relativamente difusivas de QWs. A propagação uniforme de portadores entre oito QWs e localização superior de portadores em cada poço são responsáveis pelo aumento da potência de saída de luz, em particular, para alta corrente de injeção na amostra QB dopada com quatro Si. Os resultados demonstram que quatro QBs de oito Em 0.2 Ga 0.8 N / GaN QWs com dopagem de Si não apenas reduzem o efeito Stark confinado ao quantum (QCSE), mas também melhoram a distribuição e localização de portadoras em QWs para melhor desempenho óptico de LEDs azuis.
Histórico
A dopagem com silício (Si) em barreiras quânticas GaN (QBs) pode acender a triagem Coulomb do campo de polarização e causar a supressão do efeito Stark confinado por quantum (QCSE) em poços quânticos InGaN / GaN (QWs). As recombinações radiativas de excitons em QWs InGaN / GaN podem ser aumentadas consideravelmente através de QBs dopados com Si [1,2,3,4]. Flutuações composicionais de índio (In) e separação de fase espinodal ocorrem na liga ternária InGaN por conta da lacuna de miscibilidade de fase sólida inerente de GaN e InN. A formação de clusters In-rich poderia atuar como fortes localizações de portadores, evitando as armadilhas de centros de recombinação não radiativa (NRCs) e facilitando a recombinação radiativa de excitons em QWs InGaN / GaN [5,6,7,8,9,10]. A flutuação da composição do índio em QWs InGaN / GaN tem um impacto significativo sobre o comportamento dos dispositivos, por exemplo, eficiência quântica interna (IQE), eficiência quântica externa (EQE) e características de corrente-tensão. A flutuação do índio nos QWs InGaN / GaN deve ser levada em consideração para uma melhor explicação do desempenho dos dispositivos [11]. InGaN / GaN QWs com QBs dopados com Si mostraram as propriedades de modificações da nanoestrutura do material e formações de ilhas em nanoescala devido ao crescimento em espiral das camadas QW [12], promoção da estabilidade térmica de InGaN / GaN QWs [13], melhoria da potência de saída de luz e comportamentos de descarga eletrostática (ESD) do LED conforme a concentração de dopagem em QBs é aumentada [14], fácil bloqueio do transporte do portador do orifício levando à recombinação de excitons nos poços entre GaN tipo p (p-GaN ) e as barreiras dopadas [15], etc.
Os períodos favoráveis e a espessura de InGaN / GaN QWs para alto brilho e alto EQE sob alta corrente de injeção (acima de várias dezenas de mA) de LEDs azuis são relatados [16,17,18]. Nos relatórios, nove períodos de InGaN / GaN QWs crescidos em substratos de safira padronizados (PSSs) mostram uma melhoria significativa no poder de emissão de luz e nas propriedades de queda do EQE [16]. Os melhores desempenhos ópticos e elétricos dos LEDs azuis são demonstrados se a região ativa consiste em 12 períodos de InGaN / GaN QWs na corrente de injeção de 42 A / cm 2 [17]. A redução aparente do droop EQE e o aumento do IQE são demonstrados para a espessura do QB reduzida de 24,5 para 9,1 nm nos resultados da simulação de LEDs InGaN / GaN [18]. A dopagem de Si na espessura adequada e no número de QBs em QWs InGaN / GaN é crucial para a promoção do brilho e da eficiência dos LEDs azuis InGaN operando em alta corrente de injeção. Neste relatório, apresentamos as características ópticas, elétricas e materiais do In 0.2 de oito períodos Ga 0.8 N / GaN QWs com os primeiros dois a cinco QBs na sequência de crescimento possuindo dopagem de Si de LEDs azuis. Os resultados fornecem uma visão mais profunda sobre os mecanismos de localização de portadora, potencial de confinamento e QCSE de QWs em comportamentos de luminescência de LEDs azuis sob alta corrente de injeção.
Métodos Experimentais
A Figura 1 representa a ilustração esquemática das estruturas da camada de material de amostras de LED azul. As epilayers são depositadas por um reator horizontal de um sistema de deposição de vapor químico orgânico de metal de baixa pressão (LP-MOCVD) em PSSs de orientação (0001) (plano c). O diâmetro, altura e intervalo de estruturas de pirâmide regulares em PSSs são 2, 1,5 e 1 μm, respectivamente. Os PSSs têm espessura de 3 μm e são pré-aquecidos a 1150 ° C em ambiente de hidrogênio antes do crescimento das epilayers. Trimetilgálio (TMGa), trimetilíndio (TMIn), trimetilalumínio (TMAl) e NH gasoso 3 são utilizados como precursores de fase de vapor de gálio elementar (Ga), In, alumínio (Al) e nitrogênio (N), respectivamente. Silano (SiH 4 ) e bis-ciclopentadienil magnésio (Cp 2 Mg) são precursores do dopante Si e magnésio (Mg) nas substâncias do tipo n e p, respectivamente. Gases transportadores de precursores são a mistura de hidrogênio (H 2 ) e nitrogênio (N 2 ) com a proporção de 1:1 que é quimicamente não reativa.
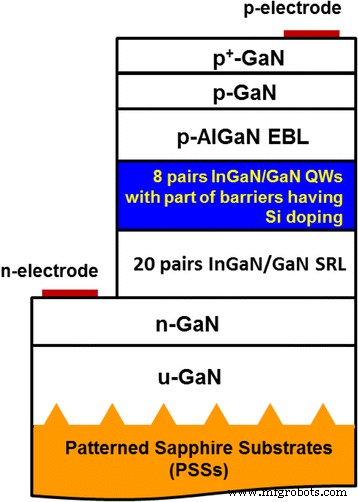
Diagrama esquemático de estruturas de camadas de chips de LED azuis fabricados. Estes desenhos esquemáticos das espessuras da camada epitaxial são exagerados para maior clareza e não estão em escala
Camada tampão de GaN não dopado (u-GaN) e, em seguida, GaN tipo n dopado com Si (n-GaN) com uma espessura de 3 e 3,3 μm são cultivados em PSSs. A concentração de dopagem de n-GaN é 10 19 cm −3 . Vinte pares de In 0,02 Ga 0,98 A superrede N / GaN com a espessura de 2/2 nm são subsequentemente depositadas em n-GaN. Ele desempenha o papel de camadas de alívio de tensão (SRLs), que é usado para reduzir a extensão da deformação das epilayers em PSSs.
Camadas ativas de LEDs azuis contêm In 0.2 de oito pontos Ga 0.8 N / GaN QWs. As espessuras de QW e QB são 2,5 e 8 nm com a temperatura de crescimento de 750 e 900 ° C, respectivamente. Dopagem de Si com concentração em torno de 3 × 10 17 cm −3 nos primeiros dois, três, quatro e cinco QBs na sequência de crescimento é denominado como amostras A, B, C e D, respectivamente. tipo p Al 0,16 Ga 0,84 A camada de bloqueio de elétrons N (EBL) tem uma espessura de 20 nm e é cultivada a 950 ° C com dopagem de Mg. Camada de janela p-GaN ep + Camada de contato -GaN são cultivadas a 950 ° C com uma espessura de 100 e 20 nm, e as concentrações de dopagem são 10 19 e 10 20 cm −3 .
As epilayers são gravadas seletivamente na camada n-GaN por um sistema de plasma indutivamente acoplado (ICP) para formar um LED de estrutura mesa. A camada de contato transparente (TCL) de óxido de índio e estanho (ITO) é depositada no p + -GaN superfície por um evaporador de feixe de elétrons. Camadas de eletrodo de contato multi-metal de cromo / platina / ouro (Cr / Pt / Au) são subsequentemente evaporadas no p + Camadas -GaN e n-GaN para um bom contato ôhmico. Os wafers de LED são lapidados e polidos até cerca de 120 μm para o corte de chips. Dispositivos LED padrão do tipo mesa com chip quadrado de 1 mm 2 são produzidos.
A corrente versus tensão ( I - V ) curvas e a potência de saída de luz ( P fora ) versus corrente de injeção ( L - eu ) curvas de 20 a 300 mA em temperatura ambiente (RT) de diodos são medidas. Espectros de fotoluminescência dependente da temperatura (PL) de oito períodos em 0,2 Ga 0.8 N / GaN QWs são examinados. A fonte de luz de excitação do PL é o laser He-Cd (325 nm) com potência média de 45 mW. As imagens de microscopia eletrônica de transmissão de alta resolução (HRTEM) são tiradas de um microscópio eletrônico de transmissão de emissão de campo EM-3000F (FE-TEM) com uma tensão de aceleração de 300 kV e resolução de 0,14 nm.
Resultados e discussão
A Figura 2 representa os espectros de PL das amostras em várias temperaturas de 10 a 300 K. A diminuição monotônica da intensidade do pico de PL com o aumento da temperatura pode ser observada. Isso se origina do aumento do processo de recombinação não radiativa com o aumento da temperatura. Todos os perfis espectrais de PL são ajustados por funções de forma de linha gaussiana para encontrar as variações da energia máxima do pico com a temperatura, conforme demonstrado na Fig. 3. A energia máxima do pico de emissão de PL para o In 0,2 não dilatado Ga 0.8 N / GaN QWs é 2,68 eV à temperatura ambiente. Isso significa que as energias de pico PL de amostras com os primeiros dois a cinco QBs com dopagem de Si exibem um deslocamento para o azul quando comparado com o não dopado. Os primeiros dois a cinco QBs com dopagem de Si podem diminuir o QCSE em QWs de forma eficaz. Deve ser apontado que o uso de PSSs e SRLs nas estruturas de epilayers pode reduzir a parte do campo piezoelétrico (PZ), bem como QCSE em In 0.2 Ga 0.8 N / GaN QWs.

Espectros de PL dependentes da temperatura de amostras em várias temperaturas de 10 a 300 K

Variações da energia máxima do pico de PL em relação à temperatura das amostras. As curvas de melhor ajuste usando a equação de Varshni são mostradas em linhas sólidas grossas e pretas
Na Fig. 3, podem ser mostradas as variações da energia máxima de pico de PL versus temperatura que exibem curvas em forma de S de todas as amostras. As curvas em forma de S exibem o deslocamento inicial do vermelho, depois do azul e, em seguida, do vermelho com o aumento da temperatura. Esse comportamento é atribuído à luminescência coletiva dependente da temperatura de fortes excitons localizados em QWs. A equação empírica de Varshni mostrada abaixo pode ser usada para ajustar a variação do azul para o vermelho das variações da forma de S [19,20,21].
$$ {E} _ {\ mathrm {g}} (T) ={E} _ {\ mathrm {g}} (0) - \ frac {\ alpha {T} ^ 2} {\ left (T- \ beta \ right)} - \ frac {\ sigma ^ 2} {k _ {\ mathrm {B}} T} $$ (1)
onde E g (0), α , β e σ são os parâmetros de ajuste. E g (0) é a energia do gap de QW na temperatura absoluta 0 K. α e β são os coeficientes térmicos que são parâmetros dependentes do material. σ é o parâmetro de alargamento gaussiano e reflete fisicamente o grau de distribuição térmica das portadoras dentro dos estados localizados na cauda da banda. O segundo termo na equação. (1) indica que a energia do gap de energia dos semicondutores tende a diminuir com o aumento da temperatura e é conhecida como a redução do gap de energia devido ao aumento da amplitude das vibrações atômicas. O terceiro termo é usado para caracterizar o grau de localização da portadora com a temperatura sob a suposição de distribuição não degenerada da portadora e densidade de estado localizada semelhante a Gauss. A forte localização da portadora é um aspecto crucial para perceber o aumento da recombinação radiativa e IQE em InGaN QWs devido à melhoria da sobreposição entre as funções de onda de elétron e buraco. A equação de Varshni não é aplicável na faixa de desvio para o vermelho da energia de pico PL em baixa temperatura, devido à forte degenerescência na distribuição de portadores. Os melhores resultados de ajuste das amostras são ilustrados em curvas sólidas grossas e pretas na Fig. 3. A energia de localização das amostras A, B, C e D é 24, 28, 41 e 13 meV, respectivamente. A amostra C possui a maior energia de localização, σ (41 meV). A localização do portador nos QWs com quatro QBs dopados com Si é mais forte do que os outros. A menor energia de localização ( σ ) acontece na amostra D com o valor 13 meV.
Tensão de corrente ( I - V ) as características sob polarização direta e reversa dos LEDs azuis são demonstradas na Fig. 4. Nesta figura, as tensões de ativação para as amostras A, B, C e D são 3,41, 3,47, 3,27 e 4,03 V na corrente direta 20 mA, respectivamente. As tensões de ruptura para as amostras A, B, C e D são - 8,85, - 9,99, - 6,77 e - 11,55 V na corrente reversa 1 μA, respectivamente. A amostra C tem as menores tensões de ativação e de ruptura. A amostra D tem as maiores tensões de ativação e de ruptura. Consequentemente, a altura de barreira mais baixa de QBs é sugerida na amostra C. O potencial de confinamento macio (suave) de QWs é esperado na amostra com os primeiros quatro QBs tendo dopagem de Si. O perfil de potencial de confinamento suave implica que os deslocamentos da banda de condução e valência de QWs não são considerados funções de passo acentuado, isto é, potencial de confinamento não retangular. Potenciais de confinamento suaves podem suprimir a recombinação Auger em grande medida e prevenir o acúmulo de muitos portadores nos primeiros poços na direção da injeção de InGaN / GaN QWs [22,23,24]. O potencial de confinamento suave também pode ser obtido por meio de uma diminuição linear da composição de In ao longo da direção de crescimento de QWs de InGaN / GaN. Isso pode ter uma melhor distribuição de portadores entre QWs e transporte de furos que resulta em melhora da queda rápida de EQE e potência de saída de luz [25,26,27,28,29,30].
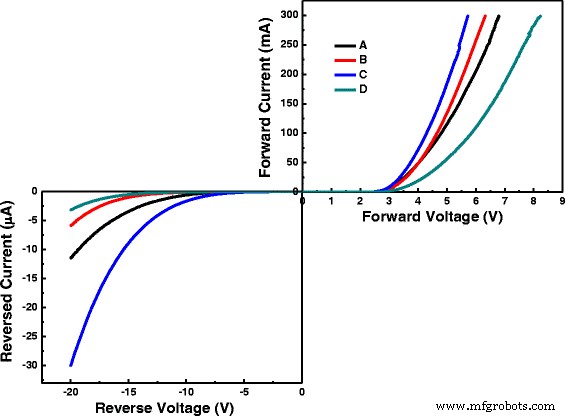
Tensão de corrente ( I - V ) curvas sob polarização direta e reversa de diodos
A Figura 5 mostra as medidas de potência de saída de luz ( P fora ) de LEDs versus corrente de injeção ( L - eu ) curva de 0 a 300 mA por um testador de chip. O aumento do P fora com o aumento da corrente de injeção de L - eu curvas podem ser observadas. O mais alto e o mais baixo P fora para alta corrente de injeção são mostrados nas amostras C e D, respectivamente. Saturação de P fora na corrente de injeção 300 mA são mostrados em todas as amostras, exceto para a amostra C. Efeito de saturação de P fora é referido ao atual transbordando os QWs. O menor transbordamento de corrente dos QWs ocorre no potencial de confinamento suave dos QWs e forte localização do portador dentro da amostra QW. Melhor distribuição de portadores entre oito QWs e forte recombinação radiativa de portadores dentro de QWs são exibidos na amostra com quatro QBs contendo dopagem de Si.

Potência de saída de luz ( P fora ) versus corrente de injeção ( L - eu ) curvas de 0 a 300 mA de diodos
As imagens de campo escuro, campo claro e campo claro ampliado do microscópio eletrônico de transmissão de alta resolução (HRTEM) das amostras são mostradas nas Figs. 6, 7 e 8. Na Fig. 6, os contrastes claro e escuro correspondem às camadas de epilação InGaN e GaN. Oito períodos de QWs e 20 pares de superredes podem ser observados. Na Fig. 7, as variações de contraste escuro representam as flutuações do conteúdo In local e a formação de aglomerados ricos em índio em QWs [31,32,33,34]. Aglomerados ricos em índio atuam como estados localizados relativamente profundos de portadores, levando a uma alta recombinação excitônica radiativa. Distorção de rede e defeitos de falha de empilhamento são observados em torno desses aglomerados ricos em índio, indicando que a energia de deformação relaxou parcialmente na camada InGaN como mostrado no zoom na imagem do quadrado vermelho na Fig. 8a. Comparado com as imagens de campo claro ampliadas, interfaces mais difusivas (não abruptas) de QWs nas amostras C e D são vistas como exibidas na Fig. 8c, d. O agente vem da conhecida interdifusão de átomos de In e Ga na interface poço / barreira. O confinamento e a localização da portadora de QWs muito fracos ocorreram na amostra D, o que está de acordo com o pior comportamento optoeletrônico desta amostra. Nas imagens, os deslocamentos de threading (TDs) não se formam em todas as amostras. Os NRCs ocorrem principalmente em locais TD. Melhor qualidade de epilayers é mostrada nessas amostras como esperado devido ao emprego de PSSs e SRLs [35,36,37]. Quatro QBs com dopagem de Si em QWs de oito períodos são a condição favorável para modificar o potencial de confinamento para atingir o potencial de confinamento suave de InGaN / GaN QWs, levando ao melhor desempenho optoeletrônico do LED azul.
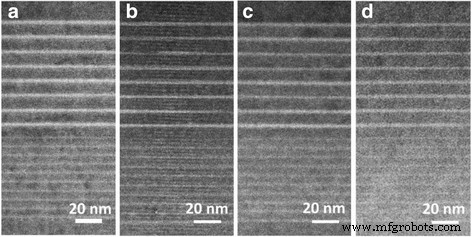
Imagens de campo escuro das amostras. a Amostra A. b Amostra B. c Amostra C. d Amostra D
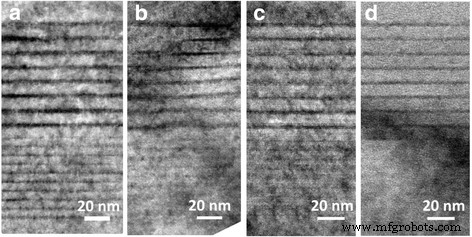
Imagens de campo claro das amostras. a Amostra A. b Amostra B. c Amostra C. d Amostra D
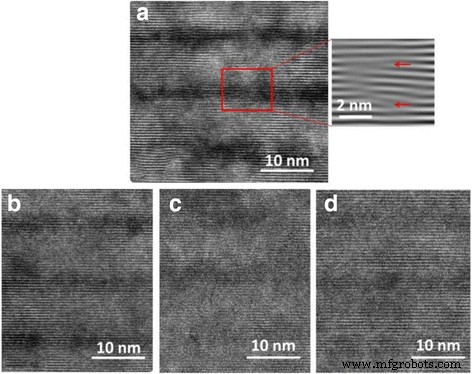
Imagens ampliadas de campo claro das amostras. a Amostra A. b Amostra B. c Amostra C. d Amostra D
Conclusões
Espectros de PL dependentes da temperatura, I - V curvas, L - eu curvas e imagens HRTEM de LEDs azuis com oito pontos em 0.2 Ga 0.8 N / GaN QWs tendo os primeiros dois a cinco QBs na sequência de deposição contendo dopagem com Si foram investigados. Os resultados demonstram que a amostra com os primeiros quatro QBs contendo dopagem com Si tem altura de barreira relativamente menor e maior energia de localização de portadores, o que é evidenciado por interfaces difusivas de QWs em imagens HRTEM. O potencial de confinamento suave de QWs acompanhado de localização de portadora mais forte dentro de QWs dá origem a uma distribuição mais uniforme de portadora entre oito QWs e maior recombinação radiativa de portadoras dentro de QWs nesta amostra. Uma diminuição dos processos Auger e vazamento de portadores, bem como um aumento da recombinação radiativa de QWs ocorreu em LEDs azuis com quatro QBs dopados com Si sob alta corrente de injeção. Os resultados fornecem condições ideais de QBs com dopagem de Si através da análise dos efeitos da localização do portador, potencial de confinamento, campo PZ e nanoestruturas de material nas propriedades de luminescência de In 0,2 Ga 0.8 N / GaN QWs de LEDs azuis.
Abreviações
- Al:
-
Alumínio
- Cp 2 Mg:
-
Bis-ciclopentadienil magnésio
- EBL:
-
Camada de bloqueio de elétrons
- EQE:
-
Eficiência quântica externa
- FE-TEM:
-
Microscópio eletrônico de transmissão de emissão de campo
- Ga:
-
Gálio
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- ICP:
-
Plasma indutivamente acoplado
- Em:
-
Índio
- IQE:
-
Eficiência quântica interna
- ITO:
-
Óxido de índio estanho
- I - V :
-
Corrente versus tensão
- L - eu :
-
Potência de saída de luz versus corrente de injeção
- LP-MOCVD:
-
Deposição de vapor químico orgânico de metal a baixa pressão
- Mg:
-
Magnésio
- N:
-
Azoto
- n-GaN:
-
GaN tipo n
- NRCs:
-
Centros de recombinação não radiativa
- PL:
-
Fotoluminescência
- PSSs:
-
Substratos de safira estampados
- PZ:
-
Piezoelétrico
- QBs:
-
Barreiras quânticas
- QCSE:
-
Efeito Stark confinado por quantum
- QWs:
-
Poços quânticos
- RT:
-
Temperatura do quarto
- Si:
-
Silício
- SiH 4 :
-
Silane
- SRLs:
-
Camadas de alívio de tensão
- TCL:
-
Camada de contato transparente
- TMAl:
-
Trimetilalumínio
- TMGa:
-
Trimetilgálio
- TMIn:
-
Trimetilíndio
- u-GaN:
-
GaN não dopado
Nanomateriais
- 5G e GaN:a mudança de LDMOS para GaN
- O rearranjo atômico de poços quânticos múltiplos baseados em GaN em gás misto H2 / NH3 para melhorar propriedades estruturais e ópticas
- Impacto dos estados da superfície e da fração da toupeira de alumínio no potencial da superfície e 2DEG em HEMTs AlGaN / GaN
- Emissão multicolor da estrutura ultravioleta de nanopiramida quasicristal fotônica baseada em GaN com InxGa1 semipolar − xN / GaN vários poços quânticos
- Análise de refletância infravermelha de camadas epitaxiais de GaN dopado tipo n cultivadas em safira
- Pontos quânticos de bismuto em poços quânticos de GaAsBi / AlAs recozidos
- Rompendo a largura do canal Multi-Mesa limitada de HEMTs normalmente fora de GaN por meio da modulação do comprimento do orifício
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- Compreendendo o mecanismo de crescimento de camadas epitaxiais de GaN em grafite esfoliado mecanicamente
- Preparação de um arranjo de nanosfera de poliestireno periódico usando o método Dip-Drop com ataque pós-deposição e sua aplicação para melhorar a eficiência de extração de luz de InGaN / G…



