Morfologia, estrutura e propriedades ópticas de filmes semicondutores com Nanislands GeSiSn e camadas deformadas
Resumo
As dependências da espessura de transição crítica de crescimento bidimensional para tridimensional (2D-3D) na composição de filmes GeSiSn com um conteúdo fixo de Ge e de Sn de 0 a 16% na temperatura de crescimento de 150 ° С foram obtidas. . Os diagramas de fase da mudança da superestrutura durante o crescimento epitaxial de Sn em Si e em Ge (100) foram construídos. Usando os dados do diagrama de fase, torna-se possível identificar a cobertura de Sn na superfície de Si e controlar a segregação de Sn na superestrutura observada no padrão de difração de elétrons de alta energia de reflexão (RHEED). As estruturas multicamadas com as camadas pseudomórficas GeSiSn e matriz de ilha com uma densidade de até 1,8 × 10 12 cm −2 foram crescidos considerando a supressão da segregação Sn pela diminuição da temperatura de crescimento do GeSiSn e do Si. A superestrutura de domínio duplo (10 × 1) relacionada à presença de Sn na superfície foi observada pela primeira vez nas estruturas periódicas de multicamadas durante o crescimento de Si na camada GeSiSn. As estruturas GeSiSn / Si periódicas demonstraram a fotoluminescência na faixa de 0,6–0,85 eV correspondendo à faixa de comprimento de onda de 1,45–2 μm. O cálculo do diagrama de banda para a estrutura com o Ge pseudomórfico 0,315 Si 0,65 Sn 0,035 camadas permite assumir que os picos de fotoluminescência correspondem às transições interbandas entre o X vale em Si ou o Δ 4 -valley em GeSiSn e a sub-banda de buracos pesados na camada GeSiSn.
Histórico
Os dispositivos emissores de luz efetivos não foram apresentados uma vez que o Si é o semicondutor com o bandgap indireto, embora os dispositivos fotônicos de silício, como guias de onda [1], fotodetectores [2] e moduladores [3] tenham sido criados com sucesso.
A adição de Sn na matriz de solução sólida Ge, Si ou GeSi é uma das abordagens para a obtenção do semicondutor bandgap direto que é baseado nos materiais do grupo IV. A inclusão de Sn na rede Ge reduz a diferença entre os mínimos de Г e L vales, e GeSn pode se tornar um material bandgap direto. Como foi mostrado, a exatidão para a rede cúbica GeSn surge no conteúdo de Sn de cerca de 9% [4, 5]. Este valor pode ser inferior a 6% na presença da deformação de tração, enquanto para filmes com deformação compressiva, a transição pode ser esperada para o conteúdo de Sn maior que 11% [6]. A redução do bandgap devido à inclusão de Sn permite aumentar o comprimento de onda operacional da faixa do infravermelho próximo a médio, o que é desejável no campo das interconexões ópticas, em sistemas de comunicação de fibra óptica de nova geração, sensores, processamento de sinal, conversão de energia e dispositivos de armazenamento óptico [7]. Portanto, nos últimos anos, o interesse pela classe de materiais Ge-Si-Sn aumentou significativamente.
Grandes esforços são reunidos para a obtenção de filmes GeSn epitaxiais de qualidade instrumental [8, 9]. Um dos problemas sérios é a formação de inclusão (precipitados) de Sn durante o crescimento da camada GeSn [10, 11]. Além da precipitação, a segregação Sn é observada no processo de GeSn, crescimento da camada GeSiSn e oxidação do filme GeSn [11, 12]. Técnicas de crescimento fora do equilíbrio, como a epitaxia de feixe molecular (MBE) e deposição química de vapor (CVD), servem a métodos confiáveis de precipitação e supressão de segregação. Para reduzir o efeito da precipitação e segregação do Sn, pode-se realizar a diminuição da temperatura de crescimento [13] ou a inclusão da deformação, ou a adição do terceiro elemento, por exemplo, Si, que reduz a tensão local em torno dos átomos de Sn.
Os dados sobre morfologia e estrutura superficial ou sobre os mecanismos de formação de filmes GeSiSn monocristalinos são, praticamente, não encontrados na literatura, apesar da grande promessa dos materiais baseados em compostos do grupo IV. Esses dados são necessários para a criação de nanoheteroestruturas com camadas GeSiSn tensionadas e relaxadas. Neste artigo, os dados relacionados à criação de estruturas multicamadas, superredes não apenas com camadas pseudomórficas GeSiSn, mas também com nanoislândias GeSiSn, são demonstrados pela primeira vez, e não contêm deslocamentos e permitem variar a largura do bandgap do material em uma ampla faixa e cobrir a faixa de comprimento de onda infravermelho anteriormente indisponível para GeSi.
O objetivo deste trabalho é estudar o crescimento do filme pseudomórfico GeSiSn elasticamente estressado, a formação de nanoislândulas tridimensionais e obter as estruturas periódicas multicamadas contendo camadas GeSiSn pseudomórficas e nanoislândias.
Em nossos artigos anteriores [14,15,16], os diagramas cinéticos do estado morfológico do filme GeSiSn foram construídos para várias incompatibilidades de parâmetros de rede entre GeSiSn e Si na faixa de conteúdo de Sn de 0 a 8% usando a difração de elétrons de alta energia de reflexão ( RHEED). Este artigo inclui novas dependências críticas de espessura de transição de crescimento bidimensional para tridimensional (2D-3D) na composição do filme GeSiSn com um conteúdo de Ge fixo no intervalo de conteúdo de Sn de 0 a 16%. Os diagramas de fase da mudança da superestrutura durante o crescimento de Sn em Si e Ge (100) foram obtidos. Apesar do fato de que em [17,18,19], reconstruções de superfície de Sn em Si foram estudadas em diferentes coberturas de estanho, nossos dados demonstraram novas superestruturas. Além disso, o diagrama de fase da mudança da superestrutura durante o crescimento de Sn em Ge (100) não foi apresentado antes em qualquer lugar. As propriedades ópticas de estruturas periódicas de multicamadas, incluindo camadas pseudomórficas GeSiSn, foram inicialmente estudadas pelo método de fotoluminescência para amostras com diferentes conteúdos de Sn. O cálculo do diagrama de bandas de heteroestruturas GeSiSn / Si foi realizado utilizando a abordagem da teoria do modelo sólido [20].
Experimental
Todas as amostras com camadas pseudomórficas GeSiSn e com nanoislands GeSiSn foram cultivadas em condições de vácuo ultra-alto 10 −7 –10 −8 Pa no equipamento de epitaxia de feixe molecular (MBE) “Katun C.” A câmara de crescimento epitaxial possui o evaporador de feixe de elétrons para Si e as células de efusão Knudsen para Ge e Sn. A taxa de crescimento da camada GeSiSn foi variada de 0,015 a 0,05 nm / s. O crescimento epitaxial foi realizado em substratos de Si (100) na faixa de temperatura de 150–450 ° C com um conteúdo de Sn de 0 a 20%. Não apenas camadas GeSiSn únicas, mas também estruturas periódicas multicamadas, contendo heterojunções GeSiSn / Si, foram obtidas. No início, a camada GeSiSn foi depositada, a qual foi então coberta por uma camada de Si de 10 nm na temperatura de crescimento de 400–500 ° С. A principal técnica para controlar as mudanças na morfologia e na estrutura da superfície e investigar os mecanismos de crescimento foi a reflexão da difração de elétrons de alta energia (RHEED). O padrão RHEED foi gravado em uma câmera de vídeo durante o crescimento. Em seguida, um perfil, juntamente com uma das direções cristalográficas, foi escolhido, e as mudanças de intensidade desse perfil em coordenadas espaço-temporais foram criadas. A análise da distribuição de intensidade espaço-temporal do RHEED nos permitiu estudar os mecanismos de crescimento bidimensional, mudanças na superestrutura e formação de ilhas tridimensionais. O momento da transição do crescimento bidimensional para o tridimensional (transição 2D-3D) foi determinado a partir da dependência do tempo da intensidade do padrão RHEED junto com uma das hastes na direção em que o reflexo do volume aparece. As dependências da espessura crítica de transição 2D-3D no conteúdo GeSiSn com um conteúdo Ge fixo foram criadas com base no método de determinação de transição 2D-3D. Com base nessas dependências, a espessura da camada pseudomórfica GeSiSn foi definida em estruturas multicamadas, e camadas com uma matriz GeSiSn nanoisland foram criadas. A morfologia e a estrutura da superfície foram analisadas por microscopia de tunelamento de varredura (STM) em equipamento de ultra alto vácuo Omicron-Riber. As propriedades ópticas da amostra foram estudadas por espectroscopia de fotoluminescência (PL) usando um monocromador ACTON 2300i e um detector OMA-V resfriado baseado na matriz de fotodiodo InGaAs com uma banda de sensibilidade de 1,1 a 2,2 μm. Para excitar a fotoluminescência, foi utilizada a radiação laser Nd:YAG (532 nm).
Resultados e discussão
Foi estudado o crescimento do filme fino de GeSiSn na temperatura de 150 ° С na faixa de teor de Sn de 0 a 16%. O acúmulo de deformações ocorre durante a deposição da camada GeSiSn causada pela incompatibilidade entre os parâmetros de rede GeSiSn e Si. A transição da transição 2D-3D é observada em uma certa espessura. O procedimento para determinar a transição 2D-3D no exemplo do Ge 0.6 Si 0,28 Sn 0,12 o crescimento é apresentado na Fig. 1. Existem os padrões RHEED iniciais da superfície de Si antes do Ge 0,6 Si 0,28 Sn 0,12 deposição de filme (Fig. 1a), o padrão RHEED final (Fig. 1c) formado pelo Ge 0,6 Si 0,28 Sn 0,12 arranjo de ilhas e a camada de umedecimento, bem como a distribuição de intensidade de espaço-tempo do perfil vertical indicada pela seta na Fig. 1a e a dependência da intensidade do perfil horizontal (perfil horizontal indicado na distribuição de intensidade de espaço-tempo na Fig. 1b) no Ge 0,6 Si 0,28 Sn 0,12 espessura do filme (Fig. 1b). O momento de transição 2D-3D foi determinado traçando a tangente ao gráfico de intensidade na espessura (Fig. 1b) na região de um aumento acentuado de intensidade. Tal abordagem é geralmente aceita [21].
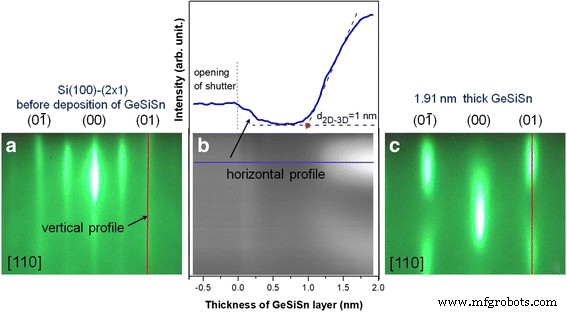
Determinação do momento de transição 2D-3D durante o crescimento do filme GeSiSn: a Padrão RHEED da superfície Si (100) - (2 × 1) antes do Ge 0,6 Si 0,28 Sn 0,12 o crescimento é mostrado, b a distribuição da intensidade espaço-temporal do perfil vertical na escala de cinza e a dependência da intensidade do perfil horizontal no Ge depositado 0,6 Si 0,28 Sn 0,12 espessura do filme. Os perfis são indicados pelas setas em ( a ) e ( b ), e c o padrão RHEED final após o Ge 0,6 de 1,91 nm de espessura Si 0,28 Sn 0,12 deposição
As dependências da espessura de transição 2D-3D crítica na composição para filmes GeSiSn com um conteúdo de Ge fixo e um conteúdo de Sn de 0 a 16% são construídas (Fig. 2) usando a técnica de transição 2D-3D descrita acima. Anteriormente, os diagramas cinéticos para o estado morfológico de filmes GeSiSn na faixa de temperatura de 150–450 ° С, em uma incompatibilidade de rede diferente entre GeSiSn e Si, foram publicados [14]. Com base na análise do diagrama cinético, a temperatura ótima de 150 ° С foi determinada, na qual a espessura crítica de transição 2D-3D atinge seu valor máximo e a segregação Sn é suprimida. O valor da espessura do filme GeSiSn abaixo da curva correspondente à espessura de transição 2D-3D crítica na temperatura e composição determina a região de existência dos filmes pseudomórficos. A diminuição da espessura crítica de transição 2D-3D, com o aumento do conteúdo de Sn de 0 a 16%, é observada nas curvas (Fig. 2). Esse comportamento é explicado pelo efeito de tensão. O aumento do conteúdo de Sn de 0 a 16%, por exemplo, o Ge 0,6 Si 0,28 Sn 0,12 crescimento, resulta no aumento da incompatibilidade de parâmetro de rede entre Ge 0,6 Si 0,28 Sn 0,12 e Si de 2,5 a 5,6%, respectivamente, e reduzindo o tempo e, conseqüentemente, a espessura de transição para nanopartículas tridimensionais. A natureza da característica que aparece na curva com o conteúdo de 30% Ge e é observada no conteúdo de Sn de 3 a 10% até o final não é completamente clara. Conhecendo a magnitude da espessura crítica de transição 2D-3D, é possível obter os filmes pseudomórficos GeSiSn e utilizá-los nas estruturas periódicas multicamadas com a heterojunção GeSiSn / Si. Em nossos experimentos, a precisão da determinação da espessura de transição 2D-3D crítica é de 0,06 nm e é determinada principalmente pela imprecisão de manter a taxa de fluxo de Si devido à instabilidade de operação da fonte.
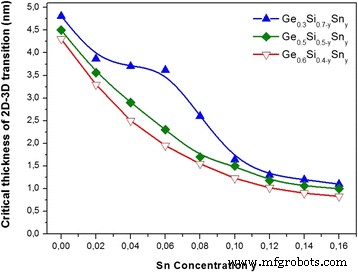
A espessura crítica de transição 2D-3D depende da composição do filme GeSiSn em vários valores fixos de conteúdo de Ge, conteúdo de Sn de 0 a 16% e na temperatura de crescimento de 150 ° С
A escolha da espessura da camada pseudomórfica na base dos diagramas cinéticos obtidos anteriormente [16] e as dependências da espessura de transição 2D-3D crítica na composição (Fig. 2) permitem o crescimento não apenas de camadas GeSiSn únicas, mas também usando essas camadas em estruturas periódicas multicamadas. Na estrutura GeSiSn / Si periódica, onde a camada GeSiSn é coberta pela camada de Si, o problema surge devido à segregação de Sn na superfície de Si. A segregação de Sn leva à reconstrução da superfície e ao aparecimento de toda a série de superestruturas dependendo da concentração de Sn na superfície. A investigação da reconstrução da superfície durante o crescimento de Sn em Si (100) e Ge (100) foi necessária para entender qual revestimento de Sn corresponde à superestrutura observada na imagem RHEED. Os diagramas de fase da mudança da superestrutura foram construídos na faixa de temperatura de 100–750 ° C. Um diagrama semelhante para o crescimento de Sn em Si (100) foi apresentado pela primeira vez em [17]. Ueda et al. Sn depositado em temperatura ambiente seguido de recozimento. Eles observaram a superestrutura somente após o recozimento do filme. Em nossos experimentos, o Sn foi depositado na temperatura de 100 ° С e foi obtido na superfície reconstruída de Si (100– (2 × 1). O aumento da temperatura de até 750 ° С resultou na formação da série de superestruturas no (Fig. 3). O efeito da posição dos átomos de Sn adsorvidos na superfície de Si (100) na energia de ligação do Sn-Si foi estudado por espectroscopia de fotoelétrons em [18]. A diminuição da energia de ligação do Sn-Si foi observada com o Aumento da cobertura de Sn. Assim, todas as reconstruções, que ocorrem durante o crescimento de Sn em Si (100), podem ser explicadas por uma diminuição na energia do sistema de superfície. A transição para o crescimento tridimensional está associada ao acúmulo de deformações devido ao parâmetro de rede incompatível entre Sn e Si de 19%. O aparecimento de filme policristalino foi observado em [17] no filme espesso de 3.2 ML (monocamada) de Sn. A formação do filme policristalino é causada por uma baixa temperatura de deposição do filme Sn. O mesmo raciocínio está relacionado ao Sn crescimento na superfície Ge (100). No momento, contribuições sobre as superestruturas Sn em Ge (100) não foram relatadas na literatura.

Diagramas de fase da mudança da superestrutura durante o crescimento: a Sn em Si (100) e b Sn em Ge (100)
As superestruturas indicadas nos diagramas aparecem tanto com o aumento quanto com a diminuição da temperatura. Esses diagramas de fase ajudam a determinar a concentração de Sn na superfície no crescimento de Si sobre a camada GeSiSn. As superestruturas que aparecem na superfície do Si durante o crescimento periódico da estrutura podem ser observadas em temperaturas que diferem das temperaturas apresentadas nos diagramas de fase. A camada de Si é depositada na superfície GeSiSn em temperaturas de 400–500 ° С; entretanto, as superestruturas que são características para toda a faixa de temperatura apresentada na Fig. 3 podem aparecer. A criação da estrutura com heterojunções GeSiSn / Si requer a prevenção da formação da superestrutura de dois domínios (5 × 1), que está associada à segregação Sn e à obstrução na formação da estrutura periódica multicamadas com as camadas pseudomórficas (Fig. 4a ) A maneira mais simples de suprimir a segregação Sn no crescimento de Si sobre a camada GeSiSn é o crescimento de Si em dois estágios. O primeiro estágio envolve a deposição da camada de Si com 1–2 nm de espessura à temperatura ambiente. O crescimento adicional de Si continua à temperatura de 400–500 ° С. Esta temperatura é determinada pelo conteúdo de Sn na camada GeSiSn. As principais séries de superestruturas que ocorrem durante o crescimento de Si na camada GeSiSn em estruturas periódicas de multicamadas consistem em (2 × 1) + (2 × N), c (8 × 4), (4 × 1), (6 × 1) e (5 × 1). Além disso, a superestrutura de dois domínios (10 × 1) é observada na superfície de Si (Fig. 4b). Esta superestrutura não apareceu nos experimentos no crescimento de Sn em Si e Ge, mas pode-se dizer que corresponde ao revestimento de Sn mínimo, uma vez que desaparece durante um curto recozimento a uma temperatura de 400–500 ° С e (2 × 1) aparece a superestrutura, que é uma característica da superfície de Si.

Superestruturas observadas no crescimento de Si na camada GeSiSn na estrutura periódica de multicamadas na direção azimutal [110]: a (5 × 1) e b (10 × 1)
Estruturas periódicas, contendo camadas pseudomórficas ou uma matriz GeSiSn nanoisland, foram obtidas. Usando os diagramas cinéticos do estado morfológico do filme GeSiSn, um arranjo de ilhas GeSiSn na estrutura periódica multicamadas foi investigado. As imagens STM de Ge 0,75 Si 0,2 Sn 0,05 superfície com o arranjo nanoisland no primeiro (Fig. 5a) e no quinto período (Fig. 5b) com um tamanho de varredura de 400 nm × 400 nm são apresentados. O arranjo de ilhas foi obtido na temperatura de crescimento de 250 ° С. Os histogramas da distribuição do número de ilhas em tamanho também são demonstrados na Fig. 5. As ilhas com densidade 5,18 × 10 11 cm −2 e o tamanho médio de 8,95 nm são apresentados na Fig. 5c. O Ge depositado 0,75 Si 0,2 Sn 0,05 a espessura do filme era 1,78 nm. O tamanho médio da ilha no quinto período é de cerca de 4 nm, e a densidade da ilha chega a 1,8 × 10 12 sm −2 com uma espessura efetiva de Ge 0,75 Si 0,2 Sn 0,05 filme 1,89 nm, e segue do histograma da Fig. 5d. Um aumento na densidade por um fator de 3,5 e uma diminuição no tamanho da ilha por um fator de 2 podem estar relacionados ao aumento da fração de Sn na superfície de Si com um aumento no número do período. Esta afirmação é confirmada pela mudança nas superestruturas, observada pelo padrão RHEED durante o crescimento do filme de Si sobre a camada GeSiSn, de (2 × 1) e (2 × N) para a estrutura da superfície c (8 × 4). A formação da superestrutura c (8 × 4) ocorre durante o processo de crescimento de Sn em Si, a partir da espessura de cobertura de 0,4 monocamada (ML) à temperatura de crescimento de 400 ° С. Com a diminuição da temperatura de crescimento para 100 ° С, podemos aumentar a densidade da ilha, mas a qualidade da superfície é pior. Um aumento da temperatura de crescimento para mais de 250 ° C aumenta a segregação de Sn. Assim, a faixa de temperatura de crescimento ideal das camadas GeSiSn com o arranjo de ilhas é 150–250 ° С, onde as oscilações de reflexão especular são observadas no crescimento da camada de umedecimento GeSiSn, correspondendo ao mecanismo de crescimento 2D.

Imagens STM do Ge 0,75 Si 0,2 Sn 0,05 superfície com o tamanho de varredura de 400 nm × 400 nm: a o Ge 0,75 Si 0,2 Sn 0,05 superfície no primeiro período, b o Ge 0,75 Si 0,2 Sn 0,05 superfície no quinto período; os histogramas de distribuição para o número de ilhas no tamanho da base para o Ge 0,75 Si 0,2 Sn 0,05 filme: c no primeiro período (o Ge 0,75 Si 0,2 Sn 0,05 espessura do filme é igual a 1,78 nm) e d no quinto período (o Ge 0,75 Si 0,2 Sn 0,05 espessura do filme é igual a 1,89 nm)
A perfeição cristalina da estrutura multicamadas foi estudada por microscopia eletrônica de transmissão (TEM). As imagens TEM para uma estrutura multicamadas com Ge 0,5 Si 0,45 Sn 0,05 Heterojunção / Si e um período de 25 nm são mostrados na Fig. 6. A partir dos dados TEM, pode-se concluir que nossas amostras não contêm deslocamentos de rosca e são cristalinas perfeitas com interfaces nítidas. O estado do filme GeSiSn pseudomórfico em uma estrutura periódica de multicamadas, a rede cristalina e as cepas são discutidos em [14] com base na análise de dados obtida com o auxílio do TEM. A composição do filme GeSiSn foi determinada definindo fluxos de Si, Ge e Sn. As taxas de crescimento de Si, Ge e Sn foram medidas com um medidor de espessura de quartzo. A composição do filme GeSiSn foi identificada por difratometria de raios-X. A análise mostrou a coincidência das composições definidas e medidas.
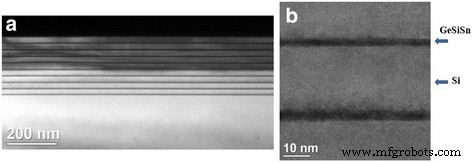
a Imagem TEM da estrutura de múltiplas camadas, incluindo Ge 0,5 Si 0,45 Sn 0,05 heterotransição com o período de 25 nm. b Imagem TEM de alta resolução da mesma estrutura
As propriedades ópticas de estruturas periódicas multicamadas com camadas GeSiSn foram investigadas por fotoluminescência para estruturas com diferentes conteúdos de Sn. As estruturas demonstraram sua fotoluminescência na faixa de 0,6–0,8 eV, que corresponde à faixa de comprimento de onda de 1,45–2 μm (Fig. 7). Os espectros de fotoluminescência com os máximos de intensidade em 0,78, 0,69 e 0,65 eV foram obtidos. Eles correspondem aos comprimentos de onda de 1,59, 1,8 e 1,9 μm e são observados a 3,5, 4,5 e 6% Sn, respectivamente. O aumento do conteúdo de Sn na camada GeSiSn leva tanto à diminuição da energia das transições ópticas quanto ao aumento da intensidade da fotoluminescência. O aumento da intensidade pode ser causado pelo aumento da profundidade do poço quântico para um maior conteúdo de Sn na camada de solução sólida GeSiSn. Para avançar na faixa de comprimento de onda em mais de 2 μm, é necessário um aumento do conteúdo de Sn nas camadas GeSiSn. Para determinar as transições ópticas observadas nos espectros de luminescência, foi necessário calcular o diagrama de bandas da heteroestrutura GeSiSn / Si.

Os espectros de fotoluminescência de estruturas periódicas de multicamadas com o conteúdo de 3,5, 4,5 e 6% de Sn nas camadas pseudomórficas GeSiSn
O diagrama de banda da heteroestrutura GeSiSn / Si foi calculado usando a abordagem da teoria do modelo sólido [20]. Dentro deste modelo, os dois semicondutores que formam a heterojunção precisam ser colocados na única escala de “energia” para determinar a posição da banda na heterojunção. O valor de bandgap de valência para heteroestruturas Ge / Si na heterojunção é bem conhecido [22] e é igual a 0,54 eV; além disso, a banda de valência Ge encontra-se mais elevada na energia do que a banda de valência Si. O bandgap entre Ge e Sn é conhecido a partir do modelo apresentado em [23] e é de 0,69 eV [24]. Assim, o valor do bandgap na heterointerface para o Si / Si 1-x-y Ge x Sn y heteroestrutura pode ser escrita como:
$$ {E} _ {v, av} =0,54x + 1,23y $$
Uma vez que a banda de valência semicondutora é formada pelas sub-bandas de buracos pesados e leves, e também pela sub-banda dividida pela interação spin-órbita; então, a posição da banda de valência ( E v, av ) calculada a média nas três sub-bandas é usada para determinar o bandgap e a construção do diagrama de bandas da heteroestrutura. Para determinar a posição da sub-banda pesada e leve, bem como a sub-banda dividida pela interação spin-órbita, as seguintes expressões são usadas:
$$ {\ displaystyle \ begin {array} {l} {E} _ {\ mathrm {HH} \ left (\ mathrm {LH} \ right)} ={E} _ {v, av} + {\ Delta} _0 / 3 \\ {} {E} _ {\ mathrm {SO}} ={E} _ {v, av} -2/3 {\ Delta} _0 \ end {array}}, $$
onde os índices HH, LH e SO indicam as sub-bandas de buraco pesado e leve, bem como a sub-banda de spin dividido. O Δ 0 valor denota a energia de divisão spin-órbita no semicondutor. Depois de determinar a posição da sub-banda da banda de valência na heterojunção, as posições dos vales da banda de condução correspondentes são determinadas usando a expressão:
$$ {E} ^ n ={E} _ {\ mathrm {Ge}} ^ n \ left (1-xy \ right) + {E} _ {\ mathrm {Si}} ^ nx + {E} _ {\ mathrm {Sn}} ^ ny- {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ nx \ left (1-xy \ right) - {b} _ {\ mathrm {Sn} \ mathrm {Ge }} ^ ny \ left (1-xy \ right) - {b} _ {\ mathrm {Si} \ mathrm {Sn}} ^ n xy, $$
onde indexa n = Γ , L e X indicar os vales correspondentes \ ({b} _ {\ mathrm {SiGe}} ^ n \), \ ({b} _ {\ mathrm {SnGe}} ^ n \), e \ ({b} _ {\ mathrm {SiSn}} ^ n \) –– parâmetros de “arqueamento”, levando em consideração o desvio da lei linear para a largura do bandgap, \ ({E} _ {\ mathrm {Ge}} ^ n \), \ ({ E} _ {\ mathrm {Si}} ^ n \), e \ ({E} _ {\ mathrm {Sn}} ^ n \) –– Lacunas das bandas Ge, Si e Sn no vale correspondente. Quase todos os parâmetros são retirados de [24]. Os parâmetros de curvatura para vales L e Г são retirados de [25].
Após determinar a posição de todas as bandas de interesse na heterojunção, consideramos seu deslocamento sob a influência de deformações. A influência das deformações no gap foi levada em consideração por meio das constantes de potencial de deformação [26]. Uma vez que as camadas bidimensionais eram pseudomórficas, em nosso caso, a abordagem padrão foi usada para determinar as deformações que são descritas, por exemplo, em [26]:deformações em um plano de poço quântico podem ser determinadas a partir de ε xx (yy) = ε ǀǀ =( a GeSiSn - a Si ) / a Si , onde a –– a constante de rede do material correspondente. Na direção, que é perpendicular ao plano do poço quântico, o valor de deformação ε zz =−2 ( С 12 / С 11 ) ε xx pode ser determinado através do C 12 e C 11 módulos elásticos do composto cristalino. A constante de rede da solução sólida foi determinada a partir da relação quadrática:
$$ {a} _ {\ mathrm {Ge} \ mathrm {SiSn}} ={a} _ {\ mathrm {Ge}} \ left (1-xy \ right) + {a} _ {\ mathrm {Si} } x + {a} _ {\ mathrm {Sn}} y + {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ {\ hbox {'}} x \ left (1-x \ right) + { b} _ {\ mathrm {Sn} \ mathrm {Ge}} ^ {\ hbox {'}} y \ left (1-y \ right), $$
onde a Ge , a Si , a Sn –– Parâmetros de rede Ge, Si e Sn [24], \ ({b} _ {\ mathrm {SiGe}} ^ {\ hbox {'}} \) =- 0,026 Å, \ ({b} _ {\ mathrm {SnGe}} ^ {\ hbox {'}} \) =0,166 Å –– parâmetros de «arqueamento», levando em consideração o desvio da lei de Vegard.
Com base nos cálculos do diagrama de banda, os picos PL correspondem às transições interbandas entre o vale X de Si ou o Δ 4 -valley de GeSiSn e a banda de buraco pesado na camada GeSiSn (Fig. 8).
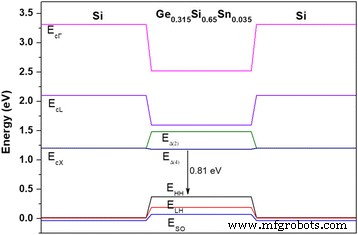
O Si / Ge 0,315 Si 0,65 Sn 0,035 / Si diagrama de banda de heterocomposição
Conclusões
As dependências críticas da espessura de transição 2D-3D na composição das camadas GeSiSn com um conteúdo fixo de Ge e Sn, variando de 0 a 16% na temperatura de crescimento de 150 ° С, foram determinadas. Os diagramas de fase da superestrutura para o crescimento epitaxial de Sn em Si (100) e Ge (100) foram feitos. As estruturas periódicas de multicamadas com camadas pseudomórficas e com uma matriz de ilha GeSiSn de densidade de até 1,8 × 10 12 sm −2 foram obtidos. Pela primeira vez, na estrutura periódica de multicamadas durante o crescimento de Si na camada GeSiSn, uma superestrutura de dois domínios (10 × 1), que se transforma em uma superestrutura (2 × 1) em um ligeiro recozimento, foi observada. As estruturas periódicas GeSiSn / Si demonstraram sua fotoluminescência na faixa de 0,6–0,8 eV, que corresponde à faixa de comprimento de onda de 1,45–2 μm. Com base nos cálculos do diagrama de banda para a estrutura com Ge pseudomórfico 0,315 Si 0,65 Sn 0,035 camadas, os picos PL correspondem às transições interbandas entre o vale X de Si ou o Δ 4 -valley de GeSiSn e a banda de buraco pesado na camada GeSiSn. O progresso adicional na região de ondas longas requer uma investigação das propriedades ópticas das estruturas com um grande conteúdo de Sn.
Abreviações
- CVD:
-
Deposição de vapor químico
- MBE:
-
Epitaxia de feixe molecular
- ML:
-
Monocamada
- PL:
-
Fotoluminescência
- RHEED:
-
Difração de elétrons de alta energia de reflexão
- STM:
-
Microscopia de varredura por tunelamento
- TEM:
-
Microscopia eletrônica de transmissão
Nanomateriais
- Nanopartículas de semicondutor
- Estrutura e propriedades eletrônicas da nanoargila caulinita dopada com metal de transição
- Modulação das propriedades de anisotropia eletrônica e óptica de ML-GaS por campo elétrico vertical
- Síntese fácil e propriedades ópticas de pequenos nanocristais de selênio e nanorods
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- Influência da Água na Estrutura e Propriedades Dielétricas da Microcristalina e Nano-Celulose
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Propriedades ópticas e eletrônicas de fotodiodos N + / P de silício hiperdopado com enxofre induzido por laser de femtosegundo
- Preparação e propriedades ópticas de filmes GeBi usando o método de epitaxia de feixe molecular



