Estudo dos primeiros princípios de defeitos pontuais na superrede de GaAs / AlAs:a estabilidade de fase e os efeitos na estrutura da banda e na mobilidade do portador
Resumo
Superredes semicondutoras avançadas desempenham papéis importantes em futuras aplicações críticas de alta tecnologia, como aeroespacial, física de alta energia, detecção de ondas gravitacionais, astronomia e áreas relacionadas ao nuclear. Sob tais condições extremas, como ambientes de alta irradiação, essas superredes semicondutoras tendem a gerar vários defeitos que, em última análise, podem resultar na falha dos dispositivos. No entanto, na superrede como GaAs / AlAs, a estabilidade de fase e o impacto no desempenho do dispositivo de defeitos pontuais ainda não estão claros até o momento. Os cálculos atuais mostram que na superrede GaAs / AlAs, os defeitos anti-local são energeticamente mais favoráveis do que os defeitos de vacância e intersticiais. O As X (X =Al ou Ga) e X Como defeitos sempre induzem metalicidade da superrede GaAs / AlAs e Ga Al e Al Ga defeitos anti-site têm pequenos efeitos na estrutura eletrônica. Para superrede de GaAs / AlAs com defeitos intersticiais ou de vazio, é encontrada redução significativa de gap ou metalicidade induzida. Cálculos posteriores mostram que os defeitos intersticiais e de vazio reduzem significativamente a mobilidade do elétron, enquanto os defeitos anti-local têm influências relativamente menores. Os resultados avançam na compreensão dos efeitos dos danos por radiação da superrede GaAs / AlAs, que assim fornecem orientação para o projeto de superrede de semicondutor altamente estável e durável com base em optoeletrônicos e eletrônicos para aplicações em ambientes extremos.
Histórico
A superrede (SL) é um material artificial que consiste em camadas finas alternadas de dois ou mais componentes diferentes. O (GaAs) n / (AlAs) m é um dos mais importantes SL desde o desenvolvimento de transistores de alta mobilidade de elétrons (HEMT) e lasers em cascata quântica (QCLs) algumas décadas atrás [1,2,3,4,5,6]. Recentemente, com os avanços das técnicas de epitaxia e nanofabricação de filmes, o (GaAs) n / (AlAs) m SLs baseados e nanodispositivos com (n + m) variando de 2 a 10 demonstraram propriedades físicas interessantes relacionadas à luminescência e absorção óptica, absorção de dois fônons e Raman, bem como espectros infravermelhos, que assim encontraram aplicações promissoras em optoeletrônica, detecção, LED, energia e áreas civis e industriais relacionadas com laser [7,8,9,10,11,12]. Enquanto isso, para outras aplicações críticas de alta tecnologia, como aeroespacial, física de alta energia, detecção de ondas gravitacionais, astronomia, viagens espaciais, nuclear e áreas relacionadas à segurança nacional, os SLs e dispositivos semicondutores são expostos a diferentes ambientes de radiação, ou seja, X- raios, nêutrons, elétrons, íons, etc., que podem resultar na geração de defeitos contendo impurezas, vazios, intersticiais, antisites e complexo destes. Uma vez que os materiais semicondutores e as propriedades físicas relacionadas desempenham um papel importante na operação e funcionamento desses dispositivos eletrônicos e circuitos integrados, pequenas quantidades de defeitos podem alterar drasticamente suas propriedades ópticas e de transporte, especialmente em sistemas multicamadas [13].
Os efeitos de impurezas estranhas ou defeitos intrínsecos nos SLs de semicondutores e seus materiais componentes foram extensivamente investigados nas últimas décadas. Zollo et al. empregaram o método da teoria funcional da densidade (DFT) para investigar a estabilidade de defeitos pontuais em GaAs e descobriram que os defeitos antisite eram mais favoráveis [14]. Kahaly et al. estudaram a estrutura GaAs / AlAs SL pelo método DFT e encontraram a vacância de arsênio (V As ) defeito na interface e próximo a ela levou a uma condução quase 2-DEG entre o arsenieto dielétrico isolante [7]. Spasov et al. estudaram os efeitos das impurezas de nitrogênio no transporte de portadores e na recombinação elétron-buraco em diodos GaAs / AlAs SL [9]. Eles relataram que as impurezas N modificaram a energia da minibanda eletrônica e impediram a difusão de elétrons através da minibanda SL, o que pode levar a uma forte recombinação radiativa de pares elétron-buraco [9]. Wang et al. estudaram a inter-difusão induzida pela impureza Zn em estruturas GaAs / AlAs SL empregando um ab initio método de dinâmica molecular (AIMD) [15]. Seus resultados sugeriram que a difusão do Zn foi auxiliada pelos elementos do grupo III, que foram ejetados no canal intersticial e se difundiram rapidamente, desordenando assim a superrede [15]. Mitra e Stark descobriram que a presença de vacâncias aumentou a mistura de Ga / Al em GaAs / AlAs SL, resultante do mecanismo de difusão de anel de dois átomos proposto [16]. Recentemente, uma simulação AIMD da resposta à radiação de GaAs / AlAs SL foi realizada [17], na qual as energias mínimas para cada átomo a ser permanentemente deslocado de seu sítio de rede foram determinadas, os caminhos para geração de defeitos foram fornecidos, e os tipos de defeitos criados foram identificados. Ele revelou que o par Ga (ou Al ou As) Frenkel criado e As Ga -Ga As O par anti-local tem efeitos profundos na densidade da distribuição de estado e estrutura de banda de GaAs / AlAs SL [17].
Até agora, a estabilidade de defeitos pontuais na estrutura do SL e as propriedades de transporte, como a mobilidade da portadora, ainda permanecem desconhecidas. Portanto, é de vital importância investigar como a presença de defeitos de vacância, intersticiais e anti-local influenciam a estabilidade estrutural e as propriedades elétricas do GaAs / AlAs SL. Neste estudo, a estabilidade de fase de vacância de Ga (ou Al ou As) único, intersticial de Ga (ou Al ou As) único e Ga único As (ou Al As ou como Ga ou como Al ) defeitos anti-local foram estudados. É mostrado que os defeitos anti-sítio são energeticamente mais favoráveis do que os defeitos de vazio e intersticiais. As estruturas de banda desses estados defeituosos foram investigadas pelo método híbrido DFT, que incorpora uma parte da troca exata da teoria Hartree-Fock com o resto da energia de correlação de troca de outras fontes ( ab initio ou empírico) [18], e espera-se que ofereça uma descrição mais precisa da estrutura eletrônica de materiais semicondutores do que o DFT padrão. Em particular, a mobilidade do elétron foi prevista. Acontece que os defeitos intersticiais e de vazio reduzem significativamente a mobilidade do elétron, enquanto os defeitos anti-local têm influências relativamente menores. Este trabalho avançará a compreensão dos efeitos dos danos por radiação da superrede semicondutora e fornecerá orientação para o projeto de superredes semicondutoras altamente estáveis e duráveis baseadas em eletrônicos e optoeletrônicos para aplicações em ambientes extremos.
Métodos
Neste estudo, os relaxamentos estruturais são realizados dentro do framework DFT padrão e as estruturas de bandas são calculadas pelo DFT híbrido no framework de Heyd-Scuseria-Emzefhof (HSE) [19] com base nas estruturas relaxadas. Todos os cálculos são realizados empregando Vienna Ab Initio Pacote de simulação (VASP) [20]. Pseudopotenciais de onda aumentada em projetores são usados para descrever a interação entre íons e elétrons, e os efeitos de correlação de troca são tratados usando a aproximação de densidade local na parametrização de Ceperley-Alder [21]. Os critérios de convergência para energias e forças totais são 10 −4 eV e 10 −3 eV / Å, respectivamente. O grupo de pontos de origem do cristal AlAs e GaAs é o T d grupo de blenda de zinco, conforme mostrado na Fig. 1a. A ilustração dos defeitos pontuais considerados é fornecida na Fig. 1b. O GaAs / AlAs SL contendo duas monocamadas de GaAs alternadas com duas monocamadas de AlAs é considerado neste estudo e a configuração geométrica é ilustrada na Fig. 2, juntamente com os defeitos pontuais considerados.

Vista esquemática das estruturas geométricas de a XAs (X =Ga ou Al); b os defeitos em XAs. V X :(X =Ga, Al ou As) X vacância; X int :X intersticial; X Como :X ocupando o sítio da rede As; Como X :Como ocupando o local da rede X. As esferas amarela e roxa representam os defeitos de vacância e intersticiais, respectivamente

Vista esquemática das estruturas geométricas de a superrede ideal de GaAs / AlAs; b e c Superrede de GaAs / AlAs com diferentes defeitos pontuais. X Y :(X, Y =Ga, Al ou As) X ocupando o local da rede Y; V X :X vaga; X int :X intersticial. As esferas amarela e carmim representam a vacância e os defeitos intersticiais, respectivamente
Resultados e discussão
Propriedades do estado fundamental de GaAs e AlAs
Conforme mostrado na Tabela 1, as constantes de rede do bulk GaAs e AlAs são determinadas como sendo 5,61 e 5,63 Å, respectivamente, o que concorda bem com os valores experimentais e outros teóricos [22,23,24]. Parece que a incompatibilidade de rede entre GaAs e AlAs é pequena, e a constante de rede de GaAs / AlAs SL é definida como o valor intermediário de 5,62 Å. O módulo de bulk é calculado por \ (B =\ frac {1} {3} \ left ({C} _ {11} +2 {C} _ {12} \ right) \) [25], onde o C 11 e C 12 representam as constantes elásticas. O módulo de bulk de GaAs é calculado em 76,3 GPa, que está próximo do resultado de 76,5 GPa para AlAs. Esses resultados estão de acordo com os dados teóricos e experimentais [22, 26, 27].
A energia de formação de defeito na superrede de GaAs / AlAs
Para GaAs / AlAs SL e estados em massa, a energia de formação de defeito é calculada por \ ({E} _f ={E} _ {def} - {E} _ {undef} + \ sum \ limits_i \ Delta {n} _i { \ mu} _i \) [28]. Aqui, E def é a energia total da célula de simulação defeituosa após o relaxamento, E undef é a energia total da supercélula ideal relaxada, Δ n i é a mudança no número de espécies i ( eu =Ga, Al ou As) e μ i é o potencial químico das espécies i [28].
Para XAs em massa (X =Al ou Ga), os potenciais químicos de As e X obedecem às seguintes restrições:\ ({\ mu} _X \ le {\ mu} _X ^ {massa} \), \ ({\ mu} _ {As} \ le {\ mu} _ {As} ^ {bulk} \), e \ ({\ mu} _ {As} + {\ mu} _X ={\ mu} _ {XAs} ^ {bulk } \), onde \ ({\ mu} _X ^ {bulk} \), \ ({\ mu} _ {As} ^ {bulk} \), e \ ({\ mu} _ {XAs} ^ {bulk } \) correspondem à energia total do bulk X, bulk As e bulk XAs, respectivamente. As energias de formação de defeito sob condição rica em X, ou seja, \ ({\ mu} _X ={\ mu} _X ^ {bulk} \) e \ ({\ mu} _ {As} ={\ mu} _ {XAs } ^ {bulk} - {\ mu} _X ^ {bulk} \), e condição As-rich, ou seja, \ ({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \ ) e \ ({\ mu} _X ={\ mu} _ {XAs} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \), estão resumidos na Tabela 2. Para GaAs, em As- condições ricas o As Ga (Como ocupando o local da rede Ga), o defeito anti-local é considerado o mais energeticamente favorável, conforme indicado pela menor energia de formação de 1,57 eV. O próximo defeito favorável é o Ga As (Ga ocupando o sítio da rede As) defeito anti-sítio, com a energia de formação de 2,31 eV. O As intersticial (As int ) tem a maior energia de formação de 5,20 eV, sugerindo que é mais difícil de formar do que outros defeitos pontuais considerados. Sob condições ricas em Ga, o V Ga , Como int e As Ga defeitos têm energias de formação maiores, e o V As , Ga int e Ga As defeitos têm energias de formação menores, em comparação com a condição rica em As. Obviamente, a estabilidade do defeito depende do ambiente químico. Em comparação com GaAs, as energias de formação de defeito em AlAs são geralmente maiores, exceto os casos de As int e como X (X =Al ou Ga) em condições ricas em As. O As Al e Al As defeitos anti-local são determinados como os defeitos mais favoráveis em condições ricas em As e ricas em Al, respectivamente. Semelhante ao caso de GaAs, o As int também é desfavorável em AlAs. As energias de formação de defeito sob condições ricas em As e ricas em X (X =Ga ou Al) em XAs em massa são plotadas na Fig. 3. A Figura 3a mostra que As Ga e Ga As defeitos anti-local são mais favoráveis sob condições ricas em As e ricas em Ga, respectivamente. Observa-se que o As Al defeito anti-local é preferível na maioria dos casos (ver Fig. 3b). Sob condição rica em Al, a estabilidade de fase de Al As , V As e As Al os defeitos estão próximos uns dos outros, conforme indicado pelas energias de formação de 3,0, 3,16 e 3,24 eV, respectivamente. Além disso, descobrimos que em GaAs e AlAs, a não favorabilidade de As int é independente do ambiente químico. Zollo et al. realizaram cálculos de primeiros princípios em GaAs e seus resultados DFT mostraram que as energias de formação de As Ga e Ga As foram menores do que os de vacância e defeitos intersticiais [14], o que é consistente com nossos resultados.
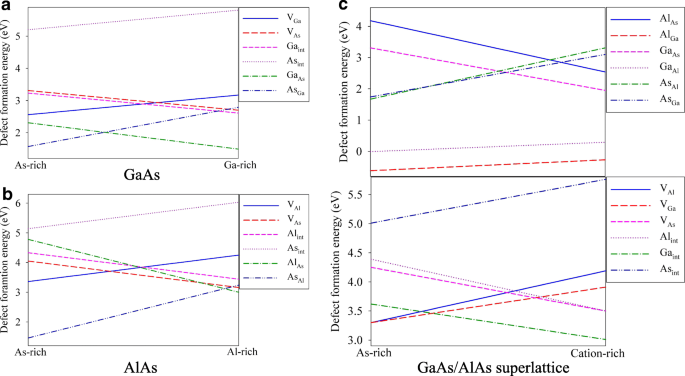
As energias de formação de defeitos sob condições ricas em As e ricas em cátions em a GaAs, b AlAs e c Superrede de GaAs / AlAs. X Y :(X, Y =Ga, Al ou As) X ocupando o local da rede Y; V X :X vaga; X int :X intersticial
O E f em GaAs / AlAs a estrutura SL também é calculada sob a condição As-rich, ou seja, \ ({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \), \ ({\ mu} _ {Al} ={\ mu} _ {Al As} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \), e \ ({\ mu} _ {Ga} ={\ mu} _ {Ga As} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \), e condição rica em cátions, ou seja, \ ({\ mu} _ {Al} ={\ mu} _ {Al } ^ {bulk} \), \ ({\ mu} _ {Ga} ={\ mu} _ {Ga} ^ {bulk} \) e \ ({\ mu} _ {As} =\ left ({\ mu} _ {SL} ^ {bulk} - {n} _ {Al} \ times {\ mu} _ {Al} ^ {bulk} - {n} _ {Ga} \ times {\ mu} _ {Ga} ^ {bulk} \ right) / {n} _ {As} \), onde n Al , n Ga e n Como representam o número de átomos de Al, Ga e As na célula de simulação, respectivamente. Conforme mostrado na Tabela 3, o Al Ga defeito tem energias de formação negativas, ou seja, - 0,62 e - 0,27 eV sob condições ricas em As e ricas em cátions, respectivamente, indicando que a formação de Al Ga defeito anti-local é um processo exotérmico. Quanto a Ga Al defeito, as energias de formação são tão pequenas quanto - 0,01 eV na condição rica em As e 0,29 eV na condição rica em cátions. Obviamente, a formação de Al Ga e Ga Al defeitos anti-local na estrutura GaAs / AlAs SL são muito mais fáceis do que outros defeitos pontuais. Sob a condição As-rich, as energias de formação dos segundos defeitos favoráveis de As Ga e As Al são determinados como 1,67 e 1,74 eV, respectivamente. Para os intersticiais, a estabilidade de fase segue a tendência de Ga int > Al int > Como int sob condições ricas em As e ricas em cátions. As energias de formação de defeito na estrutura GaAs / AlAs SL também são plotadas na Fig. 3c. Em comparação com os GaAs em massa, os defeitos pontuais em GaAs / AlAs SL são geralmente mais difíceis de formar, exceto no caso de As int (ver Fig. 3a, c). As energias de formação de As int em gaAs em massa são 5,20 e 5,81 eV em condições ricas em As e ricas em Ga, que são ligeiramente maiores do que os valores correspondentes de 5,01 e 5,76 eV em GaAs / AlAs SL. Conforme mostrado na Fig. 3b e c, a estabilidade de defeitos pontuais na estrutura de AlAs e SL em massa mostra características diferentes. O Al As e como int defeitos são mais energeticamente favoráveis em GaAs / AlAs SL do que em AlAs em massa, enquanto V As o defeito é mais preferível em AlAs em massa do que na estrutura SL. É perceptível que sob condições As-rich e Al-rich, as energias de formação de Al int a granel AlAs são comparáveis aos de GaAs / AlAs SL. Semelhante ao caso de Al int , o V Al defeito na estrutura de AlAs e SL em massa mostra favorabilidade semelhante, conforme indicado pelas energias de formação comparáveis. No caso de As Al defeito, a energia de formação sob condição rica em As é menor (1,46 eV) na estrutura SL, enquanto na condição rica em cátions, o valor é menor (3,10 eV) em AlAs bruto, sugerindo que a estabilidade de As Al depende do ambiente químico.
Comparando a estabilidade do defeito em bulk AlAs, GaAs e GaAs / AlAs SL, descobrimos que os defeitos anti-local são sempre mais preferíveis do que vacâncias e intersticiais, especialmente para os casos de Ga Al e Al Ga em GaAs / AlAs SL. Também é observado que sob condições As-rich e catation-rich, o As int o defeito é o mais difícil de formar nos estados em massa e na estrutura GaAs / AlAs SL.
Os efeitos de defeitos de ponto nas estruturas de banda da superrede de GaAs / AlAs
O estado primitivo da superrede de GaAs / AlAs
Os intervalos de banda para GaAs em massa, AlAs e GaAs / AlAs SL estão resumidos na Tabela 4, e suas estruturas de banda são apresentadas na Fig. 4. Os cálculos DFT híbridos determinam o intervalo de banda direto de GaAs como 1,44 eV (ver Fig. 4a ), que concorda bem com o valor experimental de 1,52 eV [29] e outros cálculos [24]. Em contraste, o DFT padrão prevê um valor de gap de 0,5 eV, que subestima amplamente o gap de GaAs. Para AlAs, a estrutura da banda é de caráter indireto e o gap híbrido DFT é 2,16 eV (ver Fig. 4b), que é 0,85 eV maior que o resultado DFT e em boa concordância com o valor experimental de 2,22 eV [23]. Conforme mostrado na Fig. 4c, o gap de GaAs / AlAs SL é determinado como direto e é consistente com o estudo de Botti et al., Que encontraram o gap de (GaAs) m / (AlAs) m SL (m ≥ 2) para ser direto no ponto Γ [3]. Em nossos cálculos, o gap direto para GaAs / AlAs SL é determinado em 2,06 eV pelo método híbrido DFT, o que está de acordo com o valor experimental de 2,10 eV [30].

As estruturas de banda de a GaAs, b AlAs e c Superrede de GaAs / AlAs. Os valores DFT híbridos são plotados nos painéis do lado esquerdo e os resultados do DFT são plotados nos painéis do lado direito
Os efeitos dos defeitos anti-local na estrutura da banda da superrede de GaAs / AlAs
Na estrutura GaAs / AlAs SL, o Ga Al e Al Ga defeitos antisite são mais energeticamente favoráveis do que outros defeitos pontuais. Conforme mostrado na Fig. 5a e b, as estruturas de banda de Ga Al e Al Ga os estados defeituosos são muito semelhantes aos do estado original e as lacunas de banda são determinadas como 1,98 e 2,01 eV, respectivamente. Isso deve ser devido ao fato de que os elementos químicos Al e Ga têm configuração de elétron de valência semelhante, ou seja, 3s 2 3p 1 para Al e 4s 2 4p 1 para Ga, e nenhum elétron extra ou lacuna são introduzidos na formação de Ga Al e Al Ga defeitos anti-site. As estruturas de banda para As Ga e As Al estados defeituosos são representados nas Fig. 5c e d. Acontece que esses dois defeitos modificam consideravelmente a estrutura de bandas de GaAs / AlAs SL. Tanto o As Ga e As Al defeitos anti-local introduzem elétrons extras e agem como dopantes do tipo n. Os níveis de impureza estão distantes das bandas de valência e cruzam o nível de fermi, conforme mostrado nas Fig. 5c e d. Esses níveis de defeitos profundos podem atuar como o centro de recombinação para os portadores.

As estruturas de banda da superrede de GaAs / AlAs defeituosa com diferentes defeitos anti-local. a :Ga ocupando o sítio da rede Al; b :Al ocupando o sítio da rede Ga; c :Como ocupando o local da rede Ga; d :Como ocupando o site da rede Al
A Figura 6 apresenta as estruturas de banda e densidade parcial de estado (PDOS) de SL defeituoso com Ga As e Al As defeitos. Conforme mostrado na Fig. 6a, a estrutura da banda para Ga As O SL defeituoso tem caráter de divisão de rotação. Nas sub-bandas de spin-down, o nível fermi passa pelos níveis de defeito introduzidos pelo Ga As defeito, indicativo de caráter semimetálico do SL defeituoso. De acordo com a definição de gap semimetálico [31], o gap de Ga As o estado defeituoso é de cerca de 0,10 eV. Conforme mostrado no PDOS do SL com defeito com Ga As , as sub-bandas spin-down perto do nível fermi são principalmente contribuídas por p ondas parciais. Devido às configurações de elétrons de valência semelhantes entre os átomos de Ga e Al, as estruturas de banda de spin up e spin down de Al As estado defeituoso são determinados (ver Fig. 6b), e o gap é calculado em 0,15 eV. No geral, o Al Ga e Ga Al defeitos antisite têm efeitos insignificantes na estrutura eletrônica do GaAs / AlAs SL. Também é observado que o SL com defeito com As Al e As Ga defeitos mostram metalicidade, enquanto os SLs defeituosos com Ga As e Al As são semi-metálicos.

As estruturas de banda e a densidade parcial do estado da superrede de GaAs / AlAs defeituosa com a Ga Como e b Al As defeitos anti-site. X Como (X =Ga ou Al) X ocupando o local da rede As
Os efeitos dos defeitos de vacância na estrutura da banda da superrede de GaAs / AlAs
As estruturas de banda da estrutura de SL com diferentes vacâncias são plotadas na Fig. 7, e seus PDOS correspondentes são representados na Fig. 8. O caráter de divisão de spin da estrutura de banda também é encontrado no caso de SL defeituoso com V Ga e V Al defeitos, como mostrado nas Fig. 7a e b. Na verdade, a remoção de átomos de suas posições originais deixa quatro ligações pendentes relacionadas ao sp 3 orbitais. Durante o relaxamento estrutural, os átomos mais próximos ao redor da vacância são igualmente deslocados em direção ao local da rede vazia, o que resulta na simetria do local definida pelo D tetragonal 2 d grupo de pontos. Os níveis de defeitos induzidos aparecem próximos à banda de valência e localizam-se na região proibida do GaAs / AlAs SL. O intervalo de banda é determinado como sendo 0,47 e 0,44 eV para o SL com V Ga e V Al defeitos, respectivamente. Conforme mostrado no PDOS de SL com defeito com V Ga e V Al (ver Fig. 8a eb), a principal influência das vagas do grupo III é no p estados. Conforme mostrado na Fig. 7c, a estrutura de banda do SL defeituoso com V As o defeito se divide em partes de aumento e redução de rotação, e os níveis de defeito aparecem perto da banda de condução. Desde o V As defeito atua como um dopante tipo n, o nível de fermi muda para energia mais alta e cruza a borda do nível de defeito. Kahaly et al. investigaram as propriedades elétricas das heterointerfaces GaAs-AlAs e descobriram que V As defeito na interface leva a quase 2-DEG [7], o que é consistente com nossos resultados. Nossos cálculos mostram que as vagas têm efeitos diferentes na estrutura de banda de GaAs / AlAs SL, ou seja, o V As defeito induz metalicidade de GaAs / AlAs SL e do V Ga e V Al os defeitos reduzem significativamente o gap da estrutura SL.

As estruturas de banda da superrede de GaAs / AlAs defeituosa com a V Ga , b V Al e c V Como defeitos de vacância. V X (X =Ga, Al ou As) X vaga

A densidade parcial do estado da superrede de GaAs / AlAs defeituosa com a V Ga , b V Al e c V Como defeitos de vacância. V X (X =Ga, Al ou As) X vaga
Os efeitos dos defeitos intersticiais na estrutura da banda da superrede de GaAs / AlAs
A Figura 9 apresenta as estruturas de banda da estrutura SL com defeitos intersticiais. É notado que o nível de fermi muda para alta energia e cruza a borda da banda de condução (ver Fig. 9a eb), devido ao fato de que os intersticiais do grupo III são defeitos semelhantes aos doadores. Consequentemente, as SLs com defeito com Ga int e Al int mostrar caráter metálico. Como mostrado na Fig. 9c, nas partes de spin-up e spin-down da estrutura de banda, os níveis de impureza aparecem perto da banda de condução e o nível de fermi cruza a borda do nível de impureza, indicando a metalicidade induzida de GaAs / AlAs SL defeituoso com Como int . Obviamente, os defeitos intersticiais alteram significativamente as estruturas eletrônicas de GaAs / AlAs SL e geralmente induzem a metalicidade da estrutura SL defeituosa.

As estruturas de banda da superrede de GaAs / AlAs defeituosa com a Ga int defeito, b Al int defeito e c Como int defeito. X int (X =Ga, Al ou As) X intersticial
Comparando as estruturas de banda e PDOS representativos do GaAs / AlAs SL com antisites, vacâncias e intersticiais, descobrimos que os defeitos modificam as estruturas eletrônicas consideravelmente, exceto os casos de Ga Al e Al Ga defeitos anti-site. Além disso, o estreitamento do gap e até mesmo a metalicidade são induzidos, o que influenciará drasticamente o desempenho do GaAs / AlAs SL.
Os efeitos de defeitos de pontos na mobilidade de elétrons da superrede de GaAs / AlAs
A mobilidade do elétron em 0 K pode ser calculada a partir da equação μ = eτ / m ∗ , onde e é a carga do elétron, τ é o tempo de relaxamento, e m ∗ é a massa efetiva do portador [32]. As massas efetivas do elétron podem ser avaliadas a partir da curvatura das estruturas de banda através da relação \ ({m} ^ {\ ast} ={\ mathrm {\ hslash}} ^ 2 {\ left (\ frac {d ^ 2 \ varepsilon } {dk ^ 2} \ right)} ^ {- 1} \) [32], onde ℏ é a constante de Planck reduzida, k é o vetor de onda, e ε é a energia mínima da banda de condução. Conforme mostrado na Fig. 4a e b, obtemos m * =0,057 m e para GaAs e m * =0,19 m e para AlAs, concordando bem com os valores experimentais de 0,057 m e para GaAs [33] e 0,124 m e para AlAs [34], onde m e é a massa do elétron estático. O tempo de relaxação para AlAs e GaAs é assumido como sendo 0,17 e 0,48 ps, respectivamente [35]. A mobilidade de elétrons de GaAs e AlAs em 0 K são calculados em 1,48 × 10 4 cm 2 / Vs e 1,57 × 10 3 cm 2 / Vs, respectivamente, que é comparável aos valores experimentais de 0,94 × 10 4 cm 2 / Vs para GaAs [36] e 0,28 × 10 3 cm 2 / Vs para AlAs [37].
Conforme mostrado na Tabela 5, a massa efetiva do elétron no ponto Г (\ ({m} _ {\ Gamma} ^ {\ ast} \)) é determinada como sendo 0,113 m e para o primitivo GaAs / AlAs SL e o tempo de relaxamento τ é assumido como sendo 0,4 ps [38]. A mobilidade do elétron ao longo da direção z, ou seja, direção Γ-X na zona de Brillouin ( μ Γ - X ) é calculado como 0,623 × 10 4 cm 2 / Vs para GaAs / AlAs SL ideal, que é comparável ao valor experimental de 1,0 × 10 4 cm 2 / Vs [38]. Quanto ao SL defeituoso com defeitos anti-site, o valor de μ Γ - X é comparável ao do SL ideal, exceto para os casos de Ga As e Al As defeitos. A mobilidade do elétron ao longo da direção Γ-X é determinada como sendo 0,263 × 10 4 cm 2 / Vs e 0,311 × 10 4 cm 2 / Vs para Ga As e Al As estados defeituosos, respectivamente, que são muito menores do que para o estado ideal. É notado que o Ga int , Al int e como int defeitos também reduzem a mobilidade do elétron significativamente, conforme indicado pelos valores de 0,225 × 10 4 cm 2 / Vs para Ga int , 0,243 × 10 4 cm 2 / Vs para Al int e 0,315 × 10 4 cm 2 / Vs para As int . Em comparação com o defeito anti-local e intersticial, as lacunas têm os efeitos mais profundos. Para V Ga e V Al defeitos, os valores de μ Γ - X são cerca de seis vezes menores do que o estado original. The V As defeito também diminui significativamente a mobilidade do elétron, conforme indicado por 0,127 × 10 4 cm 2 / Vs. Tanaka et al. investigaram os efeitos da irradiação de elétrons nas propriedades elétricas de heteroestruturas GaAs / AlGaAs e descobriram que a mobilidade do elétron foi reduzida em doses maiores que 5 × 10 20 cm −2 [10]. Especialmente, a criação de defeitos na região do canal de GaAs, ao invés da camada n-AlGaAs, é considerada a principal causa da degradação da mobilidade [10]. Recentemente, foi sugerido que os elétrons são possivelmente presos por defeitos ou impurezas e produzem estados metaestáveis acompanhados de relaxamento da rede [39]. Consequentemente, a estrutura eletrônica e a mobilidade da portadora do GaAs / AlAs SL são influenciadas significativamente pelos defeitos pontuais. Portanto, é necessário aumentar a tolerância à radiação do GaAs / AlAs SL para melhorar seu desempenho eletrônico em ambiente de radiação.
Conclusões
Neste trabalho, um estudo da teoria do funcional da densidade híbrida é realizado para investigar os efeitos do defeito pontual nas propriedades elétricas da superrede de GaAs / AlAs (SL). As energias de formação de defeito calculadas mostram que os defeitos anti-local são os mais favoráveis em GaAs e AlAs em massa. Na estrutura GaAs / AlAs SL, os defeitos anti-local são sempre dominantes em condições ricas em cátions e As-ricas e os defeitos intersticiais são muito difíceis de formar durante toda a gama de potenciais químicos. É mostrado que os diferentes defeitos pontuais têm vários efeitos nas estruturas eletrônicas do GaAs / AlAs SL. O As X (X =Al ou Ga) e X Como defeitos antisite sempre induzem metalicidade, embora os SLs defeituosos com X As antisites mostram divisão de rotação. Quanto às vagas, o SL defeituoso com V As mostra o caráter de metalicidade, e os defeitos de vacância do grupo III reduzem o gap da superrede significativamente. A metalicidade também é encontrada no GaAs / AlAs SL defeituoso com os defeitos intersticiais. Os cálculos adicionais de mobilidade da portadora mostram que os defeitos intersticiais e de vazio reduzem a mobilidade do elétron significativamente, enquanto os defeitos anti-local têm influência relativamente menor.
Abreviações
- 2-DEG:
-
Gás de elétron bidimensional
- AIMD:
-
Ab initio dinâmica molecular
- Al:
-
Alumínio
- AlAs:
-
Arsenieto de alumínio
- Como:
-
Arsênico
- Como X :
-
Como ocupando o site da rede X
- DFT:
-
Teoria da densidade funcional
- Ga:
-
Gálio
- GaAs:
-
Arsenieto de gálio
- HEMT:
-
Transistores de alta mobilidade de elétrons
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
Diodo emissor de luz
- N:
-
Azoto
- PDOS:
-
Densidade parcial do estado
- QCLs:
-
Lasers em cascata quântica
- SL:
-
Superrede
- VASP:
-
Viena Ab Initio Pacote de Simulação
- V X (X =Ga, Al ou As):
-
X vaga
- X As :
-
X ocupando o site de rede As
- X int :
-
X intersticial
- Zn:
-
Zinco
Nanomateriais
- Revelando a estrutura atômica e eletrônica das nanofibras de carbono de copo empilhado
- Absorvedor perfeito de banda ultra-estreita e sua aplicação como sensor plasmônico na região visível
- Estudo de primeiros princípios sobre a estabilidade e imagem STM de Borophene
- Efeito do tratamento de recozimento in situ na mobilidade e morfologia de transistores de efeito de campo orgânico baseados em TIPS-Pentaceno
- Os efeitos da relação Li / Nb na preparação e desempenho fotocatalítico de compostos Li-Nb-O
- Influência da Água na Estrutura e Propriedades Dielétricas da Microcristalina e Nano-Celulose
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Estudo experimental sobre as características de fluxo e transferência de calor de nanofluidos de TiO2-água em um tubo espiralado
- Os efeitos de acoplamento de polaritons de plasma de superfície e ressonâncias de dipolo magnético em metamateriais
- Estudo sobre a memória de comutação de resistência multinível e fotovoltagem dependente do estado da memória em junções Pt / Nd:SrTiO3



