Análise comparativa de defeitos em camadas de GaN implantadas e dopadas com magnésio em substratos de GaN independentes
Resumo
A dopagem ineficiente do tipo p induzida por Mg tem permanecido um grande obstáculo no desenvolvimento de dispositivos eletrônicos baseados em GaN para iluminação de estado sólido e aplicações de energia. Este estudo relata uma análise estrutural comparativa de defeitos em camadas de GaN em substratos de GaN independentes, onde a incorporação de Mg é realizada por meio de duas abordagens:implantação de íons e dopagem epitaxial. A microscopia eletrônica de transmissão de varredura revelou a existência de defeitos piramidais e de linha apenas na amostra implantada com Mg, enquanto a amostra dopada com Mg não mostrou a presença desses defeitos, o que sugere que a natureza dos defeitos depende do método de incorporação. A partir da espectrometria de massa de íons secundários, uma correspondência direta é observada entre as concentrações de Mg e a localização e o tipo desses defeitos. Nossas investigações sugerem que esses defeitos piramidais e de linha são espécies ricas em Mg e sua formação pode levar à redução da densidade de orifícios livres, o que ainda é uma grande preocupação para materiais e dispositivos baseados em p-GaN. Como substratos de GaN autônomos oferecem uma plataforma para a realização de dispositivos verticais baseados na junção pn, a investigação estrutural comparativa de defeitos originados devido a diferentes processos de incorporação de Mg em camadas de GaN em tais substratos provavelmente dará mais informações para a compreensão dos mecanismos de autocompensação de Mg e, em seguida, otimizar o processo de dopagem e / ou implantação de Mg para o avanço da tecnologia de dispositivo baseado em GaN.
Introdução
Nas últimas três décadas, o GaN emergiu como um dos semicondutores compostos mais investigados em todo o mundo. Isso se deve principalmente ao seu tremendo potencial não apenas em aplicações de iluminação de estado sólido, mas também em operações de alta potência, alta frequência e alta temperatura [1,2,3,4,5,6,7,8]. Para o emprego bem-sucedido de dispositivos baseados em GaN e heteroestruturas relacionadas em tais aplicações e operações, o dopagem controlável do tipo n e do tipo p é o principal requisito. Nesse aspecto, alcançar e controlar o doping do tipo n em camadas epilépticas de GaN ou monocristais agora está otimizado em grande medida em comparação com sua contraparte do tipo p, que ainda é um gargalo para a academia e também para a indústria. Até agora, o Mg provou ser o dopante do tipo p mais eficiente, apesar de sua alta energia de ativação, que requer uma grande quantidade de concentrações de Mg (cerca de 10 19 cm −3 ou mais) a ser incorporado a fim de atingir concentrações de buraco livre razoáveis próximas a 10 18 cm −3 . Qualquer aumento nas concentrações atômicas de Mg além de 10 19 cm −3 levar a uma diminuição na concentração do buraco livre [9,10,11]. Este fenômeno é atribuído principalmente à criação de N vacâncias [12,13,14], defeitos pontuais relacionados ao Mg [10, 15] ou complexos carregados e / ou neutros relacionados às vacâncias de Mg que abaixa o nível de Fermi e satura o buraco livre concentrações [16, 17]. Com base nas medições de fotoluminescência dando origem a um pico de 2,9 eV, um complexo de defeito doador profundo Mg-V N também foi considerado o principal motivo para o mecanismo de autocompensação. [17,18,19]. Portanto, apesar do número de pesquisas significativas feitas no sentido de compreender a incorporação de Mg no GaN, esse problema ainda permanece obscuro e uma análise mais aprofundada precisa ser realizada.
A maioria dos relatórios anteriores sobre análise de defeitos usando estudos microscópicos em escala atômica são baseados em camadas de GaN dopadas com Mg cultivadas em safira usando deposição de vapor químico orgânico de metal (MOCVD) ou epitaxia de feixe molecular (MBE). Para o melhor de nosso conhecimento, existem apenas alguns relatórios sobre a análise de defeitos em substratos GaN autônomos dopados com Mg e não há nenhum relatório sobre a análise de defeitos baseada em microscopia eletrônica de transmissão em substratos GaN autônomos onde o Mg é incorporado por meio de implantação de íons. Agora é bem aceito que substratos de GaN independentes têm várias vantagens sobre camadas de GaN crescidas por MOCVD / MBE em substratos estranhos, devido ao nível reduzido de densidades de deslocamento e suas aplicações em dispositivos verticais eficientes. A obtenção de atividade dopante do tipo p suficiente em tais substratos por meio de implantação de íons precisa ser explorada para comercialização e desenvolvimento de iluminação de estado sólido com base em GaN e dispositivos de alta potência. Mantendo todas essas questões como objetivo principal, realizamos uma análise estrutural detalhada de defeitos de incorporação de Mg em camadas autônomas de GaN, onde a incorporação de Mg é obtida por dopagem e implantação de íons.
Métodos Experimentais
Substratos n-GaN autônomos crescidos usando epitaxia de fase de vapor de hidreto são usados em nosso estudo. Depois disso, as camadas epitaxiais são cultivadas por MOCVD nesses substratos. A incorporação de Mg é realizada por meio de duas abordagens:implantação de íons e dopagem epitaxial. No primeiro caso, o Mg é implantado na camada epitaxial de GaN não dopada de 4 μm de espessura sem depositar qualquer camada de proteção nas camadas de GaN não dopadas, enquanto no segundo caso, GaN dopado de Mg de 1 μm de espessura é epitaxialmente crescido em 4 μm - camadas de GaN não dopadas de espessura continuamente. Para uma comparação confiável, o nível de incorporação de Mg é mantido igual a 4 × 10 19 cm −3 em ambos os casos. A implantação de Mg é realizada a 500 ° C seguida de recozimento a 1350 ° C para ativação dos dopantes. As energias de implantação são tomadas como 15, 30, 55, 95 e 180 keV com respectivas dosagens de 3,0 × 10 13 , 5,5 × 10 15 , 1,1 × 10 14 , 1,9 × 10 14 e 8 × 10 14 cm −2 , para obter um perfil de caixa de 200 nm de profundidade. As medições Hall são realizadas para avaliar as propriedades elétricas de amostras de GaN dopadas com Mg e implantadas com Mg. Para a amostra de GaN dopada com Mg, a concentração e a mobilidade do orifício são 3,4 × 10 17 cm −3 e 9,5 cm 2 / V-s. Por outro lado, as propriedades elétricas da amostra implantada com Mg não puderam ser avaliadas adequadamente devido à sua natureza altamente resistiva. A distribuição de Mg em função da profundidade é investigada usando espectrometria de massa de íons secundários (SIMS), enquanto a análise de microscopia eletrônica de transmissão de varredura (STEM) é usada para investigações estruturais de defeitos induzidos por Mg. Para isso, a espectroscopia de raios-X por dispersão de energia de elétrons e STEM (EDS) foi realizada pelo JEOL JEM-ARM200F operado a 200 e 80 kV. Para esses estudos, os espécimes de TEM foram preparados por moagem de feixe de íons focalizado usando feixes de Ga seguida por moagem de íons de Ar de baixa energia resfriada por nitrogênio líquido.
Resultados e discussão
Análise de defeitos na camada de GaN implantada com magnésio
A Figura 1 (a) mostra a imagem de campo claro (BF) -STEM de GaN implantado com Mg, enquanto (b) mostra o perfil SIMS correspondente. A seta mostrada na Fig. 1 (a) representa a direção positiva [0001], e as imagens são visualizadas ao longo do eixo da zona [11 \ (\ overline {2} \) 0]. Percebe-se que os defeitos não se distribuem uniformemente em função da profundidade, de fato, observa-se uma correlação direta entre as concentrações de Mg e os defeitos. A maioria dos defeitos são acumulados a cerca de 150 nm da superfície, onde a concentração de Mg é superior a 10 19 cm −3 conforme observado a partir de medições SIMS. Para uma melhor compreensão dos defeitos e suas visualizações devido à implantação de Mg em GaN, a imagem é realizada na condição do eixo fora da zona inclinando a amostra 10 ° em torno do eixo c a partir do eixo [11 \ (\ overline {2} \) 0] . Esta condição enfraquece o contraste de difração devido ao cristal perfeito e aumenta o contraste dos defeitos o que permite uma melhor visualização dos defeitos em comparação com o ambiente circundante. A imagem BF-STEM da amostra de GaN implantada com Mg obtida sob as condições do eixo fora da zona é mostrada na Fig. 1 (c), onde alguns defeitos de linha são vistos a uma profundidade de cerca de 200 nm da superfície. O correspondente perfil de Mg SIMS é apresentado em (d) em escala linear onde uma correspondência direta é observada entre a existência desses defeitos de linha e a concentração de Mg. Esses defeitos estão localizados em uma região estreita, onde a concentração de Mg é cerca de 10 19 cm −3 alcance.
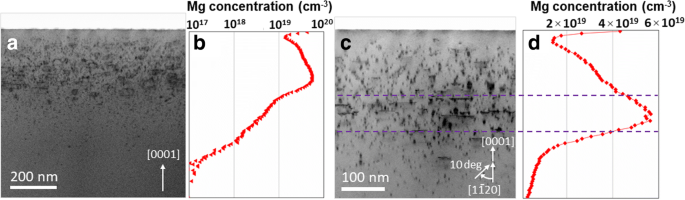
a Imagem STEM de corte transversal de campo claro da amostra de GaN implantada com Mg obtida ao longo do eixo [11 \ (\ overline {2} \) 0] e b perfil de profundidade correspondente de Mg obtido usando SIMS. Para melhor visualização dos defeitos e sua relação com a concentração de Mg, a imagem é realizada sob a condição do eixo fora da zona, conforme mostrado em c . Perfil de Mg correspondente a c é mostrado em d em escala linear onde os defeitos de linha são observados em uma região estreita com a maior concentração de Mg
Além disso, a imagem BF-STEM de alta ampliação é realizada sob condição de eixo fora da zona, como mostrado na Fig. 2 (a) com (b) mostrando a região selecionada de (a) em uma ampliação maior. Conforme mostrado em (b), quatro tipos de estruturas rotuladas como A, B, C e D são observadas. Os defeitos marcados como “A” são de forma piramidal, enquanto “B” aparecem como defeitos de linha.

a Imagem STEM de campo claro em corte transversal da amostra de GaN implantada com Mg obtida na condição do eixo fora da zona para fortalecer os contrastes dos defeitos. Vista ampliada da região marcada em ( a ) é apresentado em ( b ), onde quatro tipos diferentes de defeitos marcados como A, B, C e D são observados. Imagem TEM de alta resolução dos domínios piramidais marcados como A em ( b ) é mostrado em ( c ) com representação esquemática na parte inferior direita. A rede distorcida no domínio piramidal é representada por compressão ( c ) conforme mostrado em ( d ) A imagem TEM de alta resolução de um defeito típico do tipo C ou D é apresentada em ( e ) com imagem comprimida em ( f ), mostrando o contraste do campo de deformação em torno do defeito
As observações estruturais desses defeitos são importantes do ponto de vista da compreensão dos mecanismos de compensação de Mg, e as próximas seções do manuscrito são principalmente dedicadas à análise estrutural dos defeitos do tipo “A” e “B”. As estruturas mostradas como "A" são defeitos piramidais com direção positiva [0001] apontando para sua cabeça, sua base no plano [0001] com seis paredes em [11 \ (\ overline {2} \) 3] planos inclinados como mostrado por imagem TEM de alta resolução de um desses defeitos na Fig. 2 (c). A representação esquemática de tal domínio piramidal também é mostrada na Fig. 2 (c). A Figura 2 (c) é comprimida perpendicular à direção [0001] como mostrado em (d), onde a rede parece estar distorcida no domínio piramidal em comparação com a matriz de GaN circundante, indicando deslocamento entre as sub-redes Ga e N dentro e fora desses domínios piramidais . Isso é consistente com os achados de Vennegues et al. [20] onde tipos semelhantes de domínios piramidais são observados. Os defeitos de forma piramidal semelhantes são observados anteriormente em filmes de GaN dopados com Mg e sua existência é geralmente explicada pela modificação na estrutura atômica de GaN devido à introdução de Mg [19,20,21,22,23,24]. Liliental-Weber et al. [25, 26] propuseram que tais defeitos piramidais se originam de aglomerados ricos em Mg presentes perto da cabeça dessas pirâmides. A estrutura de GaN na fase wurtzita é geralmente descrita pelo empilhamento hexagonal de N planos com metade dos tetraedros da sub-rede N preenchidos por átomos de Ga. Vennegues et al. [27] com base em suas investigações propuseram que a introdução de um nível mais alto de Mg em GaN resulta na substituição de Ga por Mg, formando Mg 3 N 2 , um composto de Mg-N relatado como tendo uma estrutura antibixbyite. A estrutura de antibixbyte de Mg 3 N 2 corresponde ao preenchimento dos sítios de tetraedros da sub-rede N com Mg, que ocupa três de cada quatro sítios. Conforme o modelo proposto por Vennegues et al. [27], um domínio piramidal pode ser considerado como dois cristais de GaN de polaridade oposta separados por uma monocamada de Mg 3 N 2 . Isso é ainda apoiado pelas investigações de Hansen et al. [28] onde esses domínios piramidais foram propostos como Mg 3 N 2 inclusões. Vennegues et al. [27] e Leroux et al. [23] também relataram que a formação de tais domínios piramidais com tamanho nanométrico também requer uma incorporação de Mg de baixo a médio 10 19 cm −3 alcance. Isso é consistente com nossas descobertas, onde os defeitos da forma piramidal são observados em níveis inferiores a 10 19 cm −3 Concentrações de Mg vistas a partir da correlação entre a imagem STEM (Fig. 1 (c)) e o perfil SIMS correspondente (Fig. 1 (d)). Portanto, os defeitos de forma piramidal rotulados como estruturas “A” na Fig. 2 (b) de nosso estudo são considerados domínios piramidais ricos em Mg e sua formação pode estar diretamente ligada ao mecanismo de compensação de Mg nas camadas de p-GaN. Outros tipos de defeitos, conforme mostrado na Fig. 2 (b), são defeitos do tipo “C” e “D”, que são estruturas essencialmente semelhantes, com variação em suas dimensões. O contraste que parece ser alongado ao longo da direção [0001] quando visto do eixo [11 \ (\ overline {2} \) 0], é provavelmente originado de deformação. Para esclarecer ainda mais isso, a imagem TEM de alta resolução de um defeito semelhante é apresentada na Fig. 2 (e) com (f) mostrando a mesma imagem comprimida perpendicularmente à direção [0001]. A rede distorcida ao longo da direção [0001] sugere constante de rede diferente devido ao campo de deformação diferente ao longo desta direção. Como o Mg é menor em tamanho em comparação ao Ga, espera-se que sua incorporação nos sítios de Ga produza deformações na rede, o que pode levar a esse contraste em torno desses defeitos.
Outro tipo de defeito, identificado como “B” na Fig. 2 (b), parecem ser defeitos de linha perpendiculares à direção [0001], quando vistos do eixo [11 \ (\ overline {2} \) 0]. É importante notar que esse tipo de defeito parece estar acumulado em uma região estreita com concentrações de Mg mais altas (conforme observado a partir da correspondência entre a imagem BF-STEM e o perfil de Mg SIMS mostrado na Fig. 1 (c) e (d)) que sugere que sua formação está associada à sobreincorporação de Mg. Outra observação é a presença dos domínios piramidais nas bordas desses defeitos de linha que indicam que o acúmulo desses domínios pode resultar em sua formação. No entanto, não se deve descartar que possa ser simplesmente uma sobreposição aleatória de defeitos piramidais e de linha e mais investigações são necessárias nessa direção. A imagem BF-STEM mostrando esses tipos de defeitos é apresentada na Fig. 3 (a). Para melhor compreensão desses defeitos, a amostra é inclinada em cerca de 10 ° em torno do eixo perpendicular à direção [0001] e a imagem BF-STEM obtida é mostrada na Fig. 3 (b). Esta inclinação da amostra excita fortemente os pontos de difração ao longo da direção 1–100, o que resulta em contraste aprimorado do campo de deformação na direção em torno do defeito. A partir desse contraste de campo de deformação, o defeito que apareceu como a linha (ver Fig. 2 (a) e (b)) na verdade consiste em um par de linhas separadas por alguns nm, mais profundas na direção [0001].

a Imagem STEM de campo claro transversal de amostra de GaN implantada com Mg para analisar defeitos do tipo B que aparecem como pirâmides truncadas ou forma trapezoidal. b representa a imagem obtida inclinando a amostra em 10 ° em torno do eixo perpendicular a c -eixo onde um contraste diferente é observado nas bordas desses defeitos
Pode haver a possibilidade da presença de Mg nesses defeitos, pois eles aparecem na região mais estreita, onde a concentração de Mg é superior a 10 19 cm −3 conforme observado a partir da correspondência entre a imagem STEM (Fig. 1 (c)) e o perfil do Mg SIMS (Fig. 1 (d)). Para validar essa crença de que esses tipos de defeitos possuem Mg, realizamos medições de microscopia eletrônica de transmissão de varredura-espectroscopia de energia dispersiva (STEM-EDS) com diâmetro de sonda de EDS menor que 0,2 nm, em duas regiões diferentes:"longe do defeito" e “No defeito” identificado como pontos 1 e 2, respectivamente, conforme mostrado na Fig. 4 (a). Os espectros EDS comparativos dos pontos 1 e 2 na faixa de energia de 1,19 keV a 1,35 keV, onde o pico de Mg é esperado, são representados graficamente na Fig. 4 (b) com a inserção mostrando os espectros EDS completos. A presença de Mg é claramente observada no defeito (ponto 2). Para justificar ainda mais isso, realizamos o mapeamento STEM-EDS em uma amostra de GaN implantada com Mg semelhante. A Figura 4 (c) apresenta a imagem STEM de uma amostra de GaN implantada com Mg com setas para baixo mostrando esses defeitos de linha, e o mapa EDS correspondente de Mg é mostrado na Fig. 4 (d). A presença de Mg é claramente observada nesses defeitos. Portanto, esses defeitos contêm Mg e sua formação em concentrações de Mg superiores a 10 19 cm −3 é provável que seja outra causa de compensação de Mg.

a Imagem STEM em corte transversal da amostra de GaN implantada com Mg, mostrando um defeito individual tipo “B”. Os pontos 1 e 2 representam regiões onde as medições de EDS são realizadas e os espectros de EDS resultantes são mostrados em b . Os espectros de EDS na faixa de energia de 1,19-1,40 keV são plotados em b com inserção mostrando os espectros EDS completos com picos de Ga e N. c e d apresentar imagem STEM e mapa de Mg correspondente de uma amostra global implantada com Mg semelhante, mostrando a presença de Mg nesses tipos de defeitos
Análise de defeitos na camada de GaN com dopagem magnética
Em seguida, realizamos investigações estruturais na amostra de GaN, onde a camada de GaN dopada com Mg de 1 μm de espessura é epitaxialmente cultivada em uma camada epitaxial de GaN não dopada de 4 μm de espessura. Vale a pena mencionar novamente que o nível de Mg é mantido o mesmo, ou seja, 4 × 10 19 cm −3 para uma comparação significativa entre duas abordagens de incorporação de Mg:dopado epitaxialmente e implantação de íons. A Figura 5 (a) mostra a imagem BF-STEM de GaN dopado com Mg crescido epitaxialmente em substratos GaN independentes, visto ao longo de [11 \ (\ overline {2} \) 0] enquanto (b) mostra o perfil de Mg em função da profundidade de GaN obtidos usando SIMS. Observe que a concentração de Mg permanece quase constante em cerca de 4 × 10 19 cm −3 dentro do campo de visão da Fig. 5 (a) (até 700 nm), ao contrário do caso anterior de GaN implantado com Mg, onde a concentração de Mg foi considerada uma função da profundidade de GaN (ver Figs. 1 (a) - (d )).
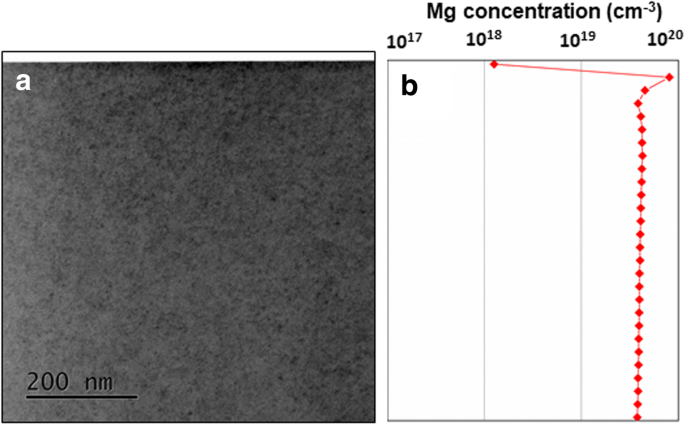
a Imagem STEM de corte transversal de campo claro da amostra granel de GaN dopada com Mg obtida ao longo do eixo [112 ̅0] e b perfil de profundidade correspondente de Mg obtido usando SIMS. Defeitos semelhantes a pontos são encontrados uniformemente distribuídos pela amostra
Para realizar a análise de defeitos na amostra de GaN dopada com Mg, imagem STEM na condição do eixo fora da zona inclinando a amostra a 10 ° em torno de c -eixo do eixo [11 \ (\ overline {2} \) 0] é executado. As Figuras 6 (a) e (b) representam as imagens BF-STEM e DF-STEM, onde defeitos semelhantes a pontos com tamanho de cerca de 5 nm são observados uniformemente distribuídos pela amostra. Observe aqui que o perfil de Mg também parece ser uniforme neste caso, conforme observado a partir do perfil SIMS (ver Fig. 5 (b)). A distribuição uniforme de Mg e esses defeitos na amostra de GaN sugere uma correlação direta entre esses defeitos e a incorporação de Mg. Esses defeitos semelhantes a pontos de cerca de 5 nm são provavelmente precipitados de Mg (e, possivelmente, falhas de empilhamento induzidas por ele). Devido ao seu pequeno tamanho, a precipitação de Mg em si não pôde ser confirmada diretamente por medições de EDS (os picos de Ga e Mg ficam muito próximos um do outro, o que torna o mapeamento de pequenas diferenças de concentração extremamente difícil).
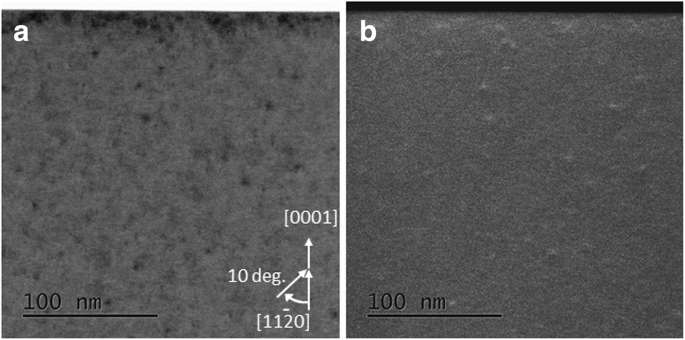
Seção transversal a STEM-BF e b Imagens STEM-ADF de amostra granel de GaN dopada com Mg obtidas na condição do eixo fora da zona para fortalecer os contrastes dos defeitos
Esta observação é completamente diferente do caso anterior de amostra implantada com Mg, em que os defeitos se acumularam a 200 nm da superfície onde a concentração de Mg era máxima. Além disso, ao contrário da amostra implantada com Mg, não observamos quaisquer defeitos piramidais e de duas linhas (marcados como A e B na Fig. 2 (b)) na amostra de GaN dopada com Mg. Curiosamente, defeitos piramidais e de linha também são relatados nas amostras de GaN, onde o Mg é incorporado por outras técnicas que não a implantação de íons. Por exemplo, Khromov et al. [29] relataram a existência de defeitos piramidais em amostras de GaN dopadas com Mg cultivadas por MOCVD. No entanto, eles observaram tais defeitos apenas em amostras de GaN dopadas mais altas, onde a concentração de Mg era de cerca de ~ 5 × 10 19 cm −3 . No entanto, em amostras com Mg ~ 2 × 10 18 cm −3 , estes domínios piramidais não foram observados. Vennegues et al. [27] também observaram tais domínios piramidais em amostras de GaN dopadas com Mg cultivadas com MOCVD com concentrações de Mg na faixa de 10 19 cm −3 alcance. Eles não observaram tais defeitos em amostras com concentrações de Mg inferiores a 10 19 cm −3 . Em nosso trabalho, nível semelhante de Mg ~ 4 × 10 19 cm −3 é incorporado via implantação iônica e dopagem epitaxial para analisar a presença desses defeitos. Esses defeitos são observados apenas em amostras implantadas com Mg, não em amostras dopadas com Mg, o que sugere que a distribuição de Mg também deve ser considerada para explicar sua existência. A partir das medições de SIMS, o Mg está distribuído de maneira não uniforme na amostra implantada com Mg (Figs. 1 (b) e (d)), enquanto a amostra dopada com Mg mostrou uma distribuição uniforme de Mg (Fig. 5 (b)). Além disso, na amostra implantada com Mg, esses defeitos foram encontrados para existir apenas em uma janela estreita com maior concentração de Mg em comparação com a matriz circundante. Portanto, a formação desses defeitos está ligada ao nível de Mg incorporado e à distribuição de Mg e é provável que se formem nas regiões onde o Mg está na faixa de 10 19 cm −3 . Parece que o perfil de Mg não uniforme em amostras implantadas com Mg leva a uma distribuição não uniforme de defeitos. No entanto, não se deve negar as possibilidades como defeitos não uniformemente distribuídos causando distribuição não uniforme de Mg ou dependência do perfil de implantação de Mg na existência de tais defeitos; portanto, mais investigações são necessárias nesse sentido. Nossa análise comparativa de defeitos em GaN com incorporação de Mg sugere que a natureza e o tipo dos defeitos dependem do método de incorporação.
Conclusões
Para resumir, as investigações estruturais baseadas em microscopia eletrônica de transmissão de varredura de defeitos em epi-camadas implantadas com Mg e dopadas com Mg em substratos de GaN independentes revelaram que a natureza dos defeitos depende fortemente do método de incorporação de Mg. GaN implantado com Mg mostrou a presença de domínios piramidais apontando para a direção [0001] e defeitos de duas linhas com características separadas por alguns nanômetros mais profundos na direção [0001]. Acredita-se que os domínios piramidais sejam Mg 3 N 2 com base em estruturas, enquanto que os defeitos de linha também apresentam Mg, conforme observado na espectroscopia de dispersão de energia. Esses defeitos de linha estão localizados a uma profundidade de cerca de 200 nm da superfície, em uma região estreita com concentração de Mg de cerca de 10 19 cm −3 o que sugere que sua formação está ligada ao nível de concentração de Mg implantado. Espera-se que a formação desses defeitos no GaN na implantação de Mg contribua significativamente para os mecanismos de autocompensação de Mg, levando a uma dopagem do tipo p ineficiente. Pelo contrário, a amostra de GaN dopada com Mg mostrou apenas a presença de defeitos semelhantes a pontos que se encontram uniformemente distribuídos por toda a amostra. O presente estudo destacando a dependência do método de incorporação de Mg e suas concentrações na natureza e tipo de defeitos pode ser útil para escolher a quantidade apropriada de Mg a ser incorporado para alcançar alta condutividade do tipo p em materiais à base de GaN para operação eficiente do dispositivo.
Abreviações
- ADF:
-
Campo escuro anular
- BF:
-
Campo brilhante
- EDS:
-
Espectroscopia de dispersão de energia
- MBE:
-
Epitaxia de feixe molecular
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- SIMS:
-
Espectrometria de massa de íon secundário
- STEM:
-
Microscopia eletrônica de transmissão de varredura
Nanomateriais
- Exemplo de circuitos e listas de rede
- Método e análise da corrente de malha
- 5G e GaN:a mudança de LDMOS para GaN
- 5G e GaN:inovações futuras
- Análise de Actina e Organização de Adesão Focal em Células U2OS em Nanoestruturas Poliméricas
- Análise de refletância infravermelha de camadas epitaxiais de GaN dopado tipo n cultivadas em safira
- Eletrospinning em substratos isolantes pelo controle da molhabilidade e umidade da superfície
- Fabricação de filmes finos SrGe2 em substratos Ge (100), (110) e (111)
- Um estudo de nanofibras de carbono e carbono ativo como supercapacitor simétrico em eletrólito aquoso:um estudo comparativo
- Morfologia, estrutura e propriedades ópticas de filmes semicondutores com Nanislands GeSiSn e camadas deformadas



