Redistribuição de portadora entre dois tipos de estados localizados nos poços quânticos InGaN / GaN estudados por fotoluminescência
Resumo
Os poços multiquânticos InGaN / GaN (MQWs) são preparados na mesma condição por deposição de vapor químico orgânico de metal (MOCVD), exceto a espessura das camadas de cobertura adicionalmente crescidas em cada camada do poço InGaN. A intensidade da fotoluminescência (PL) da amostra da camada de cobertura fina é muito mais forte do que a da amostra da camada de cobertura mais espessa. Curiosamente, a amostra da camada de cobertura espessa tem dois picos de fotoluminescência sob alto poder de excitação, e as curvas de energia-temperatura de pico PL mostram uma transição anômala da forma de V invertida para a forma de S regular com aumento do poder de excitação. Enquanto isso, ele exibe uma estabilidade térmica mais pobre da amostra da camada de cobertura espessa sob maior potência de excitação do que sob menor potência de excitação. Esse fenômeno atípico é atribuído à redistribuição de portadores entre os dois tipos de estados localizados, que é induzida pela distribuição não homogênea da composição de índio na amostra da camada de cobertura espessa. Além disso, a luminescência de estados localizados profundos tem uma melhor estabilidade térmica, e a luminescência de estados localizados superficiais tem uma estabilidade térmica fraca. Na verdade, tal distribuição de índio não homogênea mais severa pode ser causada pela degradação do crescimento epitaxial subsequente da região MQWs de InGaN / GaN devido ao maior tempo de crescimento da camada cap de GaN em baixa temperatura.
Introdução
A estrutura do poço multiquântico InGaN / GaN (MQW) tem recebido grande atenção devido ao seu amplo uso em diodos emissores de luz (LEDs) e diodos laser (LDs) [1,2,3,4,5,6]. Embora a alta densidade de deslocamento de segmentação e redução da sobreposição de função de onda causada pela polarização espontânea e piezoelétrica de InGaN / GaN MQWs, sua eficiência de luminância ainda é surpreendentemente alta [7,8,9,10]. Uma das principais razões é que a localização de excitons em potenciais mínimos devido às flutuações do conteúdo de índio leva à formação de estados semelhantes a pontos quânticos em poços quânticos InGaN / GaN [11]. No entanto, permanece ambíguo como os papéis dos estados de localização desempenham no mecanismo de luminescência. Vários estudos relataram o efeito das flutuações da composição de InGaN nas recombinações radiativa e Auger [12,13,14]. Simulações teóricas de ligação apertada atomística usadas por Jones descobriram que a localização aumenta as taxas de recombinação radiativa e Auger, mas a taxa de recombinação Auger aumenta em uma ordem de magnitude maior do que a radiativa [15]. Experimentalmente, a localização do portador leva ao relaxamento da regra de seleção k no processo de recombinação Auger e, portanto, aumenta fortemente o processo de recombinação Auger em QWs polares InGaN / GaN sob alta excitação óptica [16]. É bem conhecido que o comportamento em forma de S dependente da temperatura da energia de pico de luminescência é uma impressão digital da localização do portador. Muitos modelos, como o modelo de conjunto de estado localizado (LSE), são propostos para explicar a localização da portadora e o comportamento de redistribuição térmica, mostrando que a variação da energia do pico de luminescência com a temperatura pode ser influenciada pelo processo de redistribuição de portadora única sob diferentes níveis de excitação [17, 18,19,20,21]. Geralmente, os dispositivos fabricados como diodos laser estão sempre operando com uma densidade de portadora injetada mais alta [22]. Neste caso, os espectros de fotoluminescência de estados localizados podem exibir um comportamento único em diferentes níveis de excitação associados à uniformidade de estados localizados. Mais estudos são, portanto, necessários para entender o efeito das flutuações das ligas nos dispositivos InGaN.
Neste trabalho, duas amostras típicas com diferentes espessuras de camadas cap GaN que são adicionalmente crescidas em cada camada de poço InGaN são preparadas por sistema de deposição de vapor químico orgânico de metal (MOCVD). As propriedades dos MQWs são caracterizadas em detalhes por difração de raios-X de alta resolução (HRXRD), fotoluminescência dependente da temperatura (TDPL) e medições de fotoluminescência dependente da potência (PDPL). Verificou-se que a amostra da camada de cobertura espessa mostra um pico anômalo no lado de maior energia sob alta potência de excitação óptica. Isso implica a coexistência de dois tipos diferentes de estados localizados. Enquanto isso, a intensidade do PL decai mais rápido em baixas temperaturas quando a potência de excitação está aumentando. Portanto, podemos assumir que a fotoluminescência de estados localizados profundos tem uma melhor estabilidade térmica, e a fotoluminescência de estados localizados rasos tem uma estabilidade térmica pobre.
Métodos
Materiais
As amostras InGaN / GaN MQW com diferentes espessuras de camada de cobertura crescidas em substrato de safira plano C por um AIXTRON 3 × 2 em reator de chuveiro de acoplamento próximo são estudadas. Trimetilgálio (TMGa), trimetilíndio (TMIn) e amônia (NH 3 ) foram usados para o crescimento epitaxial como precursores de fonte de Ga, In e N, respectivamente, em que H 2 e N 2 foram o gás portador do crescimento de GaN e InGaN, respectivamente. MQW consiste em dois períodos de InGaN / GaN QWs. Durante o crescimento de cada camada de poço, a taxa de fluxo TMIn foi mantida constante. Em seguida, uma camada de cobertura de GaN foi cultivada na mesma temperatura, bem como a camada, isto é, 710 ° C. Posteriormente, a temperatura foi elevada para 830 ° C, e permaneceu por vários segundos, e então a camada de barreira cresceu a 830 ° C. Ambas as amostras A e B são cultivadas nas mesmas condições, exceto o tempo de crescimento da camada cap GaN, ou seja, é 30 s para a amostra A e 200 s para a amostra B. O diagrama esquemático de estrutura e parâmetros de crescimento de dois InGaN / GaN MQWs A e B são mostrados na Fig. 1.
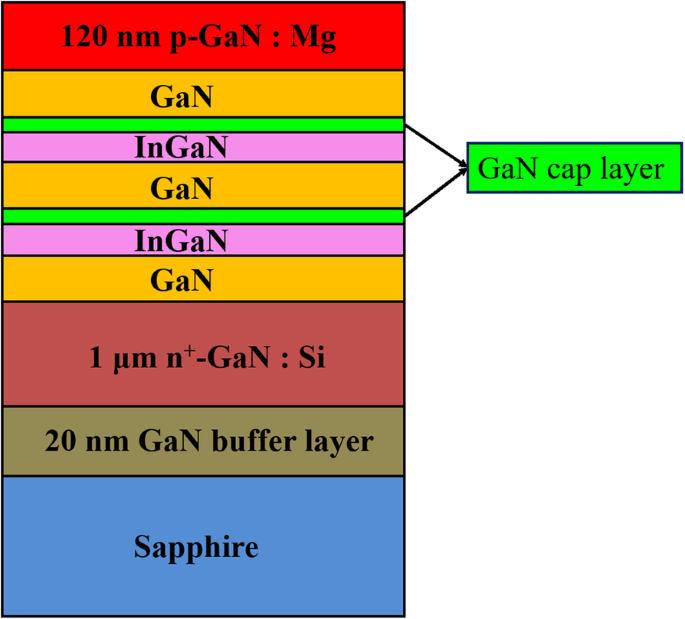
O diagrama esquemático em corte transversal das estruturas da epilayer de dois MQWs
Caracterização
Para determinar o conteúdo médio de índio, a espessura do período e a qualidade do material de dois InGaN / GaN MQWs, a medição de difração de raios-X de alta resolução (HRXRD) é realizada com Rigaku Ultima IV com radiação Cu-Ka (λ =1,54 Å) que operou a 40 kV e 30 mA. Para medições de fotoluminescência dependente da temperatura (TDPL) e PL dependente da potência de excitação (PDPL), um laser de 405 nm foi usado como uma fonte de luz de excitação com tamanho de ponto de 0,5 mm 2 , e a potência de excitação variou de 0,01 a 50 mW. As amostras foram montadas em criostato He de ciclo fechado e a temperatura controlada de 10 a 300 K.
Resultados e discussões
Para investigar as propriedades estruturais das duas amostras A e B, as varreduras simétricas ω-2θ (0002) foram realizadas, conforme mostrado na Fig. 2a. O pico do substrato se origina do plano GaN (002) e os picos do satélite vêm de MQWs. Picos de satélite até a quarta ordem podem ser claramente observados em todas as duas amostras, indicando uma boa periodicidade de camada. Além disso, a composição média do índio e a espessura periódica podem ser obtidas ajustando-se as curvas medidas, conforme mostrado na Tabela 1. Pode-se observar que conforme a espessura da camada de cobertura aumenta, a espessura da barreira de GaN e a espessura e composição do índio do InGaN as camadas do poço aumentam ligeiramente. Na verdade, como a taxa de crescimento da camada de cobertura é tão pequena quanto 0,006 nm / s e a temperatura de crescimento é tão baixa quanto 710 K, a mudança na espessura da barreira é relativamente pequena. No entanto, observando que o crescimento de camadas adicionais de capa de GaN pode ter influências não apenas na espessura da camada de barreira, mas também na difusão, evaporação e redistribuição de átomos de In nas camadas de poço de InGaN, como será discutido em detalhes posteriormente.

As varreduras de Omega-2theta e o mapeamento do espaço recíproco de ambas as amostras são realizados por HRXRD. a Curvas HRXRD Omega-2theta no plano GaN (0002) para as amostras A e B. b Mapeamento do espaço recíproco (RSM) para a difração de GaN (10-15) da amostra A
Enquanto isso, para examinar o estado de deformação das camadas GaN QB e InGaN QW, é realizado o mapeamento recíproco do espaço (RSM) na vizinhança do plano GaN (10-15). O resultado da amostra A é mostrado na Fig. 2b (a figura RSM de B é semelhante, mas não mostrada aqui). Podemos observar que para a amostra A, os picos do satélite MQW e GaN se alinham bem na mesma linha vertical, indicando que os MQWs de ambas as amostras estão totalmente deformados sem qualquer relaxamento [23].
A Figura 3 mostra as medições de PDPL para duas amostras a 10 K. É interessante descobrir que as duas amostras exibem comportamentos bastante diferentes. Para a amostra A, há um pequeno pico localizado no lado da energia inferior (pico A 1 ) do pico dominante A 2 . Confirma-se que o pico A 1 é uma réplica do phonon que está a 92 meV do pico principal A 2 . A réplica do phonon de B 2 também aparece na amostra B e é chamado de pico B 1 . Por outro lado, na Fig. 3b, pode-se observar que há apenas um pico de luminescência dominante B 2 com a potência de excitação inferior a 5 mW. No entanto, quando a potência de excitação é superior a 10 mW, outro pico B 3 aparece anormalmente no lado de maior energia de B 2 e pico B 3 gradualmente se torna o pico de emissão dominante em vez do pico B 2 quando a potência de excitação aumenta ainda mais. Aqui, podemos assumir que a maioria das portadoras ópticas excitadas primeiro ficou presa no primeiro tipo de estados eletrônicos (por exemplo, estados localizados criados pelos aglomerados locais In-rich) e, em seguida, recombinar radiativamente, produzindo pico de luminescência A 2 e B 2 . [24].
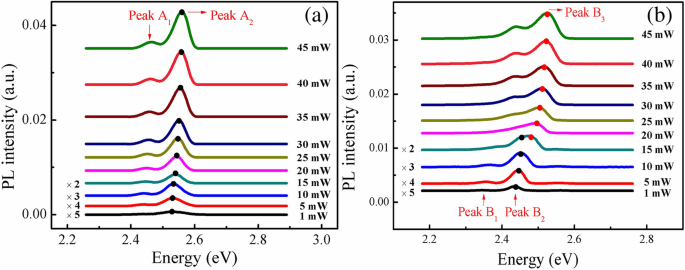
Espectros PL das amostras A ( a ) e B ( b ) em várias potências de excitação diferentes, medidas sob temperaturas de 10 K
Para examinar o comportamento do pico anômalo B 3 da amostra B, além disso, realizamos as medições de TDPL sob diferentes potências de excitação mostradas na Fig. 4, em que as Fig. 4a e b são os espectros PL obtidos sob uma potência de excitação de 5 mW e 40 mW, respectivamente. Observe que o fenômeno de dois picos dos espectros de emissão na Fig. 4b foi claramente visto em temperaturas abaixo de 200 K e tornou-se borrado em direção a 300 K. Resumindo o comportamento do espectro de emissão, pode-se ver que a transição do pico de emissão de baixa energia para o o pico de emissão de alta energia ocorre em uma faixa estreita de potência de excitação e tem um caráter de “comutação”. Fora da estreita região de transição, baixa energia única ( B 2 ) ou alta energia ( B 3 ) pico de emissão domina em potências de excitação baixa e alta, respectivamente.
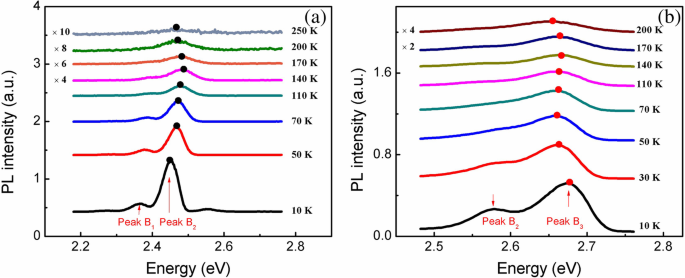
Espectros PL da amostra B em uma faixa de temperatura de 10-300 K, medida sob potências de excitação de 5 mW ( a ) e 40 mW ( b )
Além disso, uma inspeção mais próxima da variação da energia de pico de emissão dominante com a temperatura de ambas as amostras, podemos encontrar algo único. Conforme mostrado na Fig. 5a, quando a potência de excitação aumenta de 5 para 40 mW para a amostra A, a variação da energia de pico PL com o aumento da temperatura (chamada curva ET abaixo) mostra curvas em "forma de V invertido", que é diferente da regular Forma em “S”. A forma de V invertida é quase inalterada com o aumento da potência de excitação, exceto uma mudança geral para o azul da energia de pico. A dependência invertida da temperatura em forma de “V” é explicada como uma ação conjunta do efeito de preenchimento do portador nos centros de luminescência e efeito de encolhimento do bandgap acompanhado com o aumento da temperatura [25, 26]. Por outro lado, como mostrado na Fig. 5b, as curvas E-T para a amostra B sob a potência de excitação inferior a 5 mW mostram uma forma de V invertida. Esta situação é semelhante à amostra A. No entanto, quando a potência de excitação aumenta gradualmente para 40 mW, um primeiro desvio para o vermelho aparece na faixa de temperatura mais baixa e as curvas E-T têm uma forma S regular. Aparentemente, este fenômeno contradiz a expectativa de que quando a potência de excitação for grande o suficiente, o efeito de localização desaparecerá completamente, e o comportamento da temperatura do pico de energia seguirá de perto a lei de Varshni [27].

Energia de pico de emissão de PL em função da temperatura para as amostras A ( a ) e B ( b ) sob diferentes potências de excitação. As linhas sólidas são curvas de ajuste teóricas usando o modelo LSE. Os pontos são os dados do experimento
Assim, para explicar quantitativamente a dependência da potência ótica excitada anômala observada da luminescência de estados localizados, o modelo de luminescência LSE foi empregado para ajustar as curvas E-T, que é proposto por Q. Li et al. Este modelo pode ser usado em todas as faixas de temperatura, e não só pode se ajustar às curvas E-T em forma de “S”, mas também em formas de “V” ou “V” invertido. Além disso, também foi provado que o modelo LSE pode ser reduzido ao modelo de cauda de banda de Eliseev et al. Em altas temperaturas [24, 25]. Neste modelo, o pico de energia em função da temperatura pode ser descrito como [18,19,20,21]:
$$ E (T) =\ left ({E} _0- \ frac {\ alpha {T} ^ 2} {\ theta + T} \ right) - {xk} _BT $$ (1)
onde θ é a temperatura de Debye do material específico e a é o parâmetro Varshni, k B é a constante de Boltzmann, e x pode ser resolvido numericamente pela seguinte equação transcendental [18,19,20,21]:
$$ {xe} ^ x =\ left [{\ left (\ frac {\ sigma} {k_BT} \ right)} ^ 2-x \ right] \ left (\ frac {\ tau_r} {\ tau_ {tr} } \ right) {e} ^ {\ left ({E} _0- {E} _a / {k} _BT \ right)} $$ (2)
onde σ é o desvio padrão da distribuição dos estados localizados. Em outras palavras, significa a largura da distribuição de densidade do estado do tipo Gaussiano. τ r e τ tr representam a recombinação radiativa e o tempo de vida de escape do portador localizado e, portanto, τ r / τ tr implica a porção de portadores que se recombina de forma não radiativa. E 0 é a energia central dos centros localizados, e E a fornece um nível de “marcação” abaixo do qual todos os estados localizados são ocupados por portadores a 0 K, que é exatamente como o nível quase-Fermi na distribuição Fermi-Dirac. É óbvio que E 0 e E a juntos estão relacionados à origem dos centros localizados de luminescência [17].
Os parâmetros de ajuste obtidos de ambas as amostras são mostrados na Tabela 2. Para a amostra A, a energia central E 0 e E a muda para 19 meV e 18 meV de 5 a 40 mW, respectivamente. Percebe-se que o E 0 - E a e σ está quase inalterado. É porque à medida que a potência excitada aumenta, mais e mais portadores ficarão excitados. Primeiro, o forte campo piezoelétrico dos poços InGaN será filtrado pelos portadores fotogerados, levando a um aumento da energia central E 0 . Em segundo lugar, mais e mais portadoras ocuparão estados eletrônicos mais elevados de acordo com o efeito de preenchimento, o que resulta no aumento do nível de quase-Fermi das portadoras localizadas E a . Portanto, E 0 - E a representa a ação conjunta do efeito de triagem de polarização e efeito de preenchimento de portador e, portanto, um blueshift geral na posição de pico para a amostra A é observado. Ao contrário da amostra A, para a amostra B, de 5 a 40 mW, há aumentos maiores de E 0 e E a , 73 meV e 57 meV, respectivamente. E 0 - E a aumentar em 16 meV, τ r / τ tr muda em várias ordens de magnitude, e σ diminui um pouco. Essas mudanças são tão grandes que temos que assumir que a origem dos centros de luminescência é diferente em diferentes potências de excitação de 5 mW e 40 mW.
Portanto, sugere-se que para a amostra B, existem dois tipos de estados de localização, distribuindo-se em duas profundidades de energia diferentes nas camadas do poço devido à distribuição não homogênea da composição de índio, ou seja, com maior composição de índio (estados de localização profunda) e menor composição do índio (estados de localização rasos). Além disso, para explicar o fenômeno da amostra B acima, os diagramas esquemáticos que indicam o possível mecanismo de redistribuição de portadores entre dois tipos de estados localizados são plotados na Fig. 6. Em 10 K, sob menor potência de excitação, como 5 mW, mostrado na Fig. 6a, a maioria dos portadores ópticos excitados primeiro fica presa no primeiro tipo de estados eletrônicos (estados localizados profundos) e, portanto, o pico de energia inferior domina, enquanto a 40 mW, mostrado na Fig. 6b, mais e mais fotogerado os portadores ocuparão o nível de energia mais alto e, então, os estados localizados rasos com a densidade do estado de energia mais alta também serão preenchidos e, portanto, o pico de energia mais alto domina gradualmente com o aumento da potência excitada. Portanto, E 0 e E a aumenta muito, e τ r / τ tr aumento em várias ordens, o que implica a capacidade de fuga dos portadores de estados localizados. À medida que a temperatura aumenta para 30 K, a 5 mW, como mostrado na Fig. 6c, os portadores fotogerados com uma certa quantidade de energia térmica são usados principalmente para preencher os estados localizados mais profundos, resultando em um primeiro blueshift das curvas E-T; no entanto, na Fig. 6d, quando se trata de 40 mW, com base na suposição de que estados localizados rasos têm mais capacidade do que estados localizados profundos, a maioria dos portadores fotogerados permanece em estados localizados rasos e será capaz de transferir para estados localizados profundos que têm uma forte capacidade de ligar portadores. Portanto, as curvas E-T mudam para o vermelho. Em outras palavras, as mudanças anormais de aparência das curvas ET estão preocupadas com vários tipos de estados de localização devido à distribuição não homogênea do índio nas camadas do poço InGaN da amostra B. E tais flutuações composicionais devem ser principalmente devido às flutuações aleatórias da liga em um escala atômica [28].

Diagramas esquemáticos indicando o possível mecanismo da variação anômala da energia de pico PL vs. curvas T com diferentes potências de excitação. As distribuições da portadora em T inferior (10 K) são mostradas em ( a ) e ( b ) para P =5 mW e 40 mW, respectivamente. As distribuições da portadora em T superior (30 K) são mostradas em ( c ) e ( d ) para P =5 e 40 mW, respectivamente
Além disso, o aparecimento de pico de emissão de alta energia sob alta potência de excitação da amostra B também leva a uma variação anômala da intensidade integrada PL. Na Fig. 7, as curvas de intensidade x temperatura integradas das amostras A e B medidas em potências de excitação de 5 mW e 20 mW são plotadas, respectivamente. Em primeiro lugar, observe que a têmpera térmica da amostra B é obviamente mais rápida do que a da amostra A. Geralmente, a têmpera térmica de luminescência dos MQWs InGaN é dominada pelos processos de recombinação não radiativa que podem ser descritos pela equação de Arrhenius. Portanto, a extinção térmica rápida implica uma estabilidade térmica pobre da amostra B. Além disso, quando a potência de excitação é alta o suficiente, o impacto dos centros de recombinação não radiativa em temperaturas relativamente baixas não será tão significativo, porque os centros de recombinação não radiativa são facilmente saturados pelos transportadores em excesso [27]. Isso pode explicar perfeitamente a variação mais lenta da intensidade integrada PL vs. curvas 1 / T com o aumento do poder de excitação da amostra A. No entanto, é bastante interessante para a amostra B que a intensidade integrada normalizada sob o poder de excitação de 5 mW seja ainda maior do que abaixo de 20 mW quando a temperatura é inferior a 125 K, e torna-se oposta a temperaturas superiores a 125 K. Como mencionado antes, assume-se que apenas um pico de emissão de energia inferior que é originado de estados localizados profundos é dominante a 5 mW, enquanto outro mais alto originado de estados localizados rasos torna-se dominante a 20 mW. Portanto, conclui-se que os centros de luminescência localizados profundos apresentam melhor eficiência de luminescência do que os centros de luminescência rasos. Isso concorda bem com o resultado da pesquisa anterior relacionada aos estados localizados [28]. Portanto, também pode ser provado, até certo ponto, que existem dois tipos de estados localizados excitados a 20 mW para a amostra B.
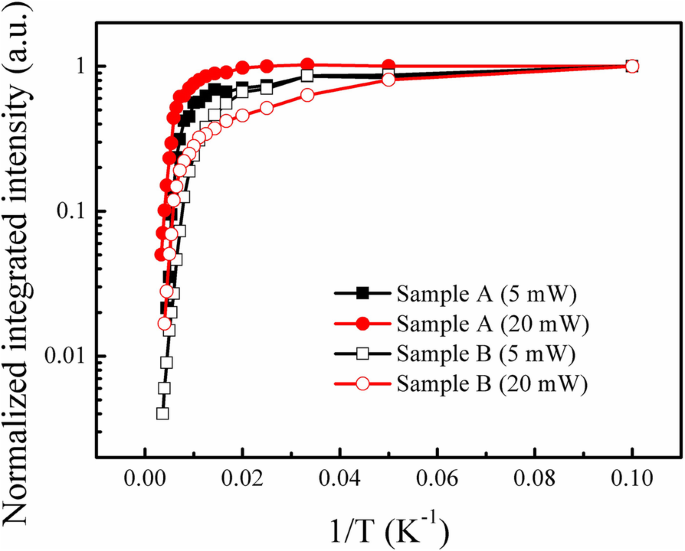
A intensidade integrada extraída dos espectros PL de ambas as amostras em uma faixa de temperatura de 10-300 K, medida sob potências de excitação de 5 mW e 20 mW
Com base em todas essas análises, demonstramos que o pico B 3 origina-se dos estados de localização com menor potencial relacionado à distribuição não homogênea da composição de índio da amostra B. Concorda bem com os resultados experimentais do pico de energia de emissão mais alto B 3 e a redução do IQE da amostra B em baixas temperaturas sob maior poder de excitação. Na verdade, no processo de crescimento de QWs, considerando os efeitos de tração, os átomos de índio tendem a se acumular no topo da camada QW de InGaN e formar uma camada extra conhecida como camada flutuante de índio [29]. O crescimento da camada de capa de GaN mais espessa em baixa temperatura é prejudicial à evaporação desses átomos flutuantes de índio. Consequentemente, os átomos de In podem se incorporar na camada de cobertura de GaN e na camada de barreira após o crescimento de QW [30]. Naturalmente, esse comportamento resultará em um aumento da espessura da camada do poço e, portanto, o QCSE é aprimorado. A deformação mais alta e o campo piezoelétrico mais forte no QW ativo induziriam um relaxamento mais localizado e, portanto, potenciais localizados mais profundos e barreiras mais altas. Enquanto isso, mais deslocamentos e defeitos são introduzidos no crescimento subsequente da camada de barreira de GaN. Geralmente, há grande tensão de tração perto dos deslocamentos e os átomos de índio podem tender a se acumular perto dos deslocamentos e se distribuir de forma não homogênea. [31, 32] Portanto, no crescimento da camada do poço InGaN, há mais áreas ricas e pobres em índio associadas ao aumento da densidade de deslocamento. Isso significa que a escala das flutuações do índio se tornará maior à medida que a espessura da camada de cobertura aumenta. Em nossos experimentos, ele mostra que dois tipos diferentes de estados de localização são introduzidos na amostra B com camada de cobertura mais espessa, e o pico PL de maior energia de emissão é ativado sob maior potência de excitação. Por outro lado, o portador fotogerado permanece em estados localizados profundos pode filtrar os defeitos e, portanto, tem uma melhor estabilidade térmica, enquanto o portador fotogerado permanece em estados localizados rasos será capturado pela recombinação não radiativa relacionada ao defeito, uma vez que eles podem superar o altura da barreira relativamente mais baixa.
Conclusões
Em resumo, as amostras de poços multiquânticos de InGaN / GaN (MQW) com diferentes espessuras de camadas de cobertura de GaN adicionalmente crescidas nas camadas de poços de InGaN são preparadas por sistema de deposição de vapor químico orgânico de metal (MOCVD). Suas propriedades estruturais e ópticas são investigadas por medições HRXRD, TDPL e PDPL e analisadas. Os resultados do PDPL mostram que um pico de energia de alta emissão adicional é excitado em uma potência de excitação mais alta apenas para a amostra B que é cultivada com camadas de cobertura espessa. Enquanto isso, os resultados de TDPL medidos em diferentes potências de excitação para a amostra B revelam que as curvas E-T do pico PL dominante mudam da forma de V invertida para a forma de S regular quando a potência de excitação aumenta. Além disso, foi encontrada uma estabilidade térmica mais pobre da amostra B em alta potência de excitação. Esses fenômenos anômalos implicam que há dois tipos de estados localizados da amostra B que são induzidos pela distribuição relativamente não homogênea do índio. Essas conclusões nos dão uma compreensão mais aprofundada do mecanismo de fotoluminescência de poços quânticos verdes InGaN / GaN e do efeito de inomogeneidade em alto nível de excitação, o que pode nos ajudar na fabricação de diodos laser InGaN / GaN.
Abreviações
- HRXRD:
-
Difração de raios-x de alta resolução
- LDs:
-
Diodos laser
- LEDs:
-
Diodos emissores de luz
- LSE:
-
Conjunto de estados localizados
- MOCVD:
-
Sistema de deposição de vapor químico orgânico de metal
- MQWs:
-
Poços multiquânticos
- NH 3 :
-
Amônia
- PDPL:
-
Fotoluminescência dependente de energia
- RSM:
-
Mapeamento de espaço recíproco
- TDPL:
-
Fotoluminescência dependente da temperatura
- TMGa:
-
Trimetilgálio
- TMIn:
-
Trimetilíndio
Nanomateriais
- O rearranjo atômico de poços quânticos múltiplos baseados em GaN em gás misto H2 / NH3 para melhorar propriedades estruturais e ópticas
- O Projeto da Camada de Emissão para Multiplicadores de Elétrons
- Emissão multicolor da estrutura ultravioleta de nanopiramida quasicristal fotônica baseada em GaN com InxGa1 semipolar − xN / GaN vários poços quânticos
- Detectando Exciton Espacialmente Localizada em Superredes de Pontos Quânticos Auto-Organizados InAs / InGaAs:Uma Forma de Melhorar a Eficiência Fotovoltaica
- Pontos quânticos de bismuto em poços quânticos de GaAsBi / AlAs recozidos
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Camadas ótimas de dopagem de silício de barreiras quânticas na sequência de crescimento, formando potencial de confinamento suave de oito períodos em 0,2Ga0,8N / GaN poços quânticos de azul LED…
- Uma investigação em uma célula solar de silício cristalino com camada de silício preta na parte traseira
- Fotocondutividade entre bandas de pontos quânticos InAs / InGaAs metamórficos na janela de 1,3-1,55 μm



