Efeito de resistência diferencial negativa em dispositivo RRAM baseado em Ru fabricado por deposição de camada atômica
Resumo
Neste trabalho, dispositivos RRAM baseados em Ru com camada atômica depositada AlO y / HfO x camada funcional foram fabricados e estudados. Um comportamento da resistência diferencial negativa (NDR) foi observado durante o processo de ajuste da tensão, e sua origem física foi explorada. Com base no entendimento da física da comutação resistiva, acredita-se que o comportamento do NDR medido esteja associado ao efeito de reinicialização parcialmente unipolar, que é devido à recombinação entre as vacâncias de oxigênio e os íons de oxigênio liberados termicamente do RuO 2 camada de interface. As características elétricas medidas e os resultados da espectroscopia de fotoelétrons de raios-X (XPS) verificaram a interpretação física.
Introdução
Como uma das memórias não voláteis emergentes mais promissoras, a memória de acesso aleatório resistiva (RRAM) tem sido extensivamente estudada em relação à otimização de materiais, melhoria de desempenho e integração de dispositivos [1,2,3,4]. Devido às vantagens significativas, como estrutura celular simples, velocidade operacional rápida, baixo consumo de energia e potencial incomparável de miniaturização [5], RRAM tem sido amplamente aplicado em computação neuromórfica inspirada no cérebro e lógica booleana reconfigurável [6,7,8,9 , 10] e também exibe grande potencial para aplicações de memória de classe de armazenamento (SCM) [11]. No entanto, conforme indicado pelo International Roadmap for Devices and Systems 2017 (https://irds.ieee.org/images/files/pdf/2017/2017IRDS_ES.pdf), os desafios, incluindo escalabilidade, confiabilidade do dispositivo e compatibilidade do processo ainda estão prejudicando Desenvolvimentos da RRAM. Portanto, a construção de dispositivos RRAM compatíveis com CMOS com desempenho superior é de grande importância para aplicações que são baseadas na estrutura 1T1R da célula RRAM [12,13,14]. De acordo com um estudo anterior [15], um dispositivo RRAM baseado em Ru apresenta grande potencial em comparação com os baseados em Pt, enquanto a resistência diferencial negativa (NDR) foi demonstrada durante um processo de ajuste de tensão. Os fenômenos NDR acompanhados de comutação resistiva foram investigados em outras estruturas RRAM, que foram principalmente devido à armadilha / detrap de portadores eletrônicos entre estados profundamente localizados induzidos por nanopartículas metálicas implantadas [16, 17], ou o acúmulo de defeitos causados pela reinstalação da junção [18]. Embora o aparecimento de NDR em células RRAM baseadas em Ru sob grande corrente ainda esteja pendente, neste trabalho foi avaliado o desempenho elétrico de um dispositivo RRAM baseado em Ru fabricado pela técnica de deposição de camada atômica (ALD). Com base na caracterização de espectroscopia de fotoelétrons de raios-X (XPS) e medições elétricas com diferentes estímulos, o fenômeno NDR no RRAM baseado em Ru pode ser explicado no arcabouço do modelo de filamento condutor de vacância de oxigênio.
Métodos
O diagrama esquemático da estrutura do dispositivo e da matriz RRAM fabricada são mostrados na Fig. 1a, b, respectivamente. The Ru / AlO y / HfO x / TiN O dispositivo RRAM foi fabricado em um SiO 2 de 300 nm oxidado termicamente substrato. Um filme fino de Ru de 80 nm foi depositado em uma camada de adesão de Ti de 20 nm como um eletrodo de fundo por pulverização catódica DC (Angstrom Engineering NEXDEP) usando um alvo de metal Ru. SiO 2 crescido por deposição química de vapor intensificada por plasma (PECVD) serve como dielétrico para isolar eletrodos e formar as vias. Em seguida, a camada resistiva de 2 nm AlO y e 3 nm HfO x foi depositado por um sistema de deposição de camada atômica (PICOSUN R200) a 300 ° C com precursores de trimetilalumínio (TMA) e tetraquis [etilmetilamino] háfnio (TEMAH). Depois disso, TiN de 80 nm foi pulverizado por pulverização catódica reativa usando um alvo de Ti e gravado para formar os padrões de eletrodo superiores. Outro ataque a seco também foi executado para expor o eletrodo inferior ao contato elétrico.
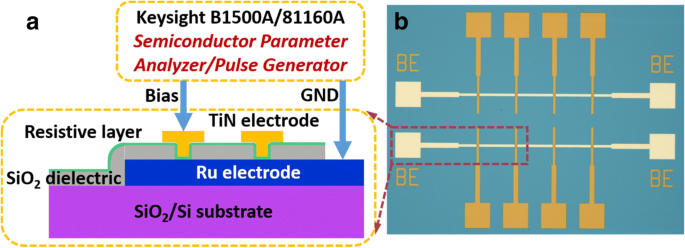
a Diagrama esquemático de um dispositivo baseado em Ru. b Matriz RRAM fabricada
A análise dos elementos foi realizada por um sistema de espectroscopia de fotoelétrons de raios-X (XPS) (Thermo Scientific ESCALAB 250Xi) usando a amostra fresca sem um eletrodo de topo. Antes da medição, a limpeza da superfície foi conduzida com plasma Ar antes da medição para eliminar a influência de C. A posição de pico de Al 2p foi usada para calibração. As medidas elétricas foram realizadas em temperatura ambiente por um analisador de dispositivo semicondutor (Agilent B1500A) e gerador arbitrário de função de pulso (Agilent 81160A).
Resultados e discussão
As características IV típicas dos dispositivos RRAM baseados em Ru são mostradas na Fig. 2a. Após a eletroformação, uma tensão positiva (2,5 V) foi aplicada para definir o processo para alternar a célula do estado de alta resistência (HRS) para o estado de baixa resistência (LRS) com uma corrente de conformidade de 1 mA para evitar a quebra permanente durante a condução formação de filamento (CF). Após a transição definida, uma tensão negativa (- 2,3 V) foi usada para mudar o dispositivo de LRS para HRS com uma corrente decrescente gradual. A fim de avaliar a variabilidade da resistência de dispositivo para dispositivo, 10 células RRAM baseadas em Ru foram escolhidas arbitrariamente. Conforme representado na Fig. 2b, os resultados estatísticos demonstram a excelente uniformidade de HRS e LRS com uma janela de resistência maior que 10 3 , que pode ser um candidato promissor para aplicativos lógicos baseados em NVM. Em comparação com os dispositivos baseados em Pt relatados anteriormente [2], é importante notar que um fenômeno NDR foi observado durante o processo de ajuste, onde a corrente diminui com o aumento da tensão (fase de ajuste 1) em uma escala de tensão limitada seguida de aumento à corrente de conformidade (fase de ajuste 2).

a Características DC. b Distribuições estatísticas HRS / LRS de 10 dispositivos RRAM baseados em Ru
A variabilidade ciclo a ciclo de dispositivos RRAM baseados em Ru também foi investigada no modo de pulso para estudar a uniformidade do ciclo. Os pulsos para conjunto (2,4 V, 15 ns) e pulso (- 3 V, 100 ns) são usados para alternar o dispositivo entre LRS e HRS com uma tensão de leitura de 0,1 V após cada pulso. Conforme mostrado na Fig. 3a, o dispositivo de 1000 ciclos tem uma distribuição uniforme com desvios padrão de 379 Ω e 3 × 10 5 Ω para LRS e HRS, o que resulta em uma janela de memória estável maior que 100. Nenhuma degradação de resistência ocorre mesmo após 10 6 ciclos de comutação conforme relatado anteriormente na Ref. [15]. Além disso, o dispositivo também demonstra uma excelente propriedade de retenção, conforme mostrado na Fig. 3b. As resistências LRS e HRS mantêm um valor constante acima de 10 5 s a 120 ° C sem falha.

a 1000 ciclos de resistência. b Comportamento de retenção de alta temperatura de um Ru / AlO y / HfO x / Dispositivo TiN RRAM
A fim de explorar o fenômeno NDR, o I – V as curvas foram medidas no modo de varredura de tensão e no modo de varredura de corrente. A Figura 4a exibe o processo de formação de cinco células RRAM frescas selecionadas aleatoriamente. A corrente aumenta gradualmente seguido por um descolamento, indicando a formação de CF, enquanto nenhum NDR foi observado. Após a eletroformação, as operações de ajuste em diferentes modos de varredura são conduzidas na mesma célula a fim de observar a variação da corrente, conforme mostrado na Fig. 4b. Para o conjunto acionado por corrente, a corrente aumenta lentamente com uma diminuição repentina na tensão, demonstrando a transição da resistência de HRS para LRS. Esse comportamento é diferente da característica que é impulsionada pela voltagem, que pode ser devido ao aquecimento Joule induzido por diferentes estímulos através do CF. Além disso, operações consecutivas de set / reset sob diferentes vieses foram realizadas para investigar o estado de resistência intermediária na região NDR. Uma tensão de parada apropriada de 1 V foi aplicada durante o processo de ajuste, conforme mostrado na Fig. 4c, para terminar a varredura no fundo do vale. Um estado de resistência não volátil foi obtido após a remoção da tensão, que exibiu um comportamento de chaveamento resistivo unipolar. Portanto, esse fenômeno NDR é provisoriamente atribuído a uma segunda reinicialização do CF durante o processo definido.
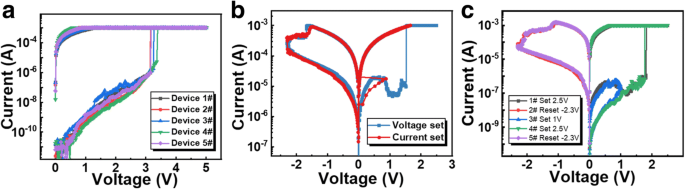
a Formação de tensão de cinco dispositivos RRAM baseados em Ru. b Processos de ajuste acionados por tensão e por corrente na mesma célula RRAM. c Processo de configuração incompleto com a tensão de parada na parte inferior do vale da corrente
Combinado com as medições em diferentes modos e processos de fabricação de dispositivos, bem como as propriedades de RuO 2 , a origem física do fenômeno NDR foi proposta, conforme ilustrado na Fig. 5. Um estudo anterior [19, 20] sugeriu que a geração e recombinação da vacância de oxigênio esgotada de elétrons ( V o ) e íon de oxigênio (O 2− ) sob diferentes polaridades elétricas são responsáveis pelo HfO convencional x dispositivos RRAM bipolares baseados em, que é semelhante aos processos de fase 2 e de reset. No entanto, ao contrário do processo de conjunto convencional, uma segunda ruptura do CF ocorre desconectando o eletrodo Ru e CF e levando ao NDR. Em geral, os átomos de oxigênio se dissociam em V o e O 2− sob o campo elétrico com a deriva do O 2− para o eletrodo superior, deixando o V o para formar o CF que é usado para o transporte de elétrons. Mas devido ao aquecimento Joule causado pelo campo elétrico, o RuO formado 2 camada de interface se decompõe lentamente a ~ 600 ° C e libera O 2− que poderia se recombinar com o elétron empobrecido V o ( V o 2+ ) próximo ao eletrodo Ru (set-phase 1) [21], resultando em uma diminuição da corrente. Este processo também pode ser visto como um processo de reinicialização unipolar parcial. Com o aumento da tensão, o CF entre TE e BE será reconstruído por um acúmulo de V o conforme mostrado na fase de ajuste 2 e a célula RRAM muda para LRS. Durante a reinicialização, dois processos ocorrem simultaneamente:(1) o O 2− liberado do eletrodo TiN rapidamente se recombina com o V carregado positivamente o por causa da seção de captura aprimorada, (2) o O 2− deriva em direção a BE reage com Ru e reforma o RuO 2 camada de interface devido ao aquecimento Joule local [22]. Nesta condição, a célula RRAM muda para HRS.

Processos físicos de comutação resistiva em RRAM baseado em Ru. a Efeito NDR (set-phase 1). b Processos SET comuns (fase 2). c Processo de RESET do dispositivo
Análise XPS do RuO 2 A camada de interface, que foi formada durante o processo de fabricação do dispositivo, também suporta a explicação proposta do efeito NDR. A Figura 6a mostra o espectro completo de XPS da amostra, que inclui os níveis de núcleo O 1s, Ru 3d, Al 2p e Hf 4f. Todos os outros picos não marcados correspondem a esses elementos com diferentes órbitas de elétrons. A curva de ajuste na Fig. 6b se encaixa perfeitamente com os dados experimentais e é dividida em quatro picos, que correspondem ao Ru 3d 5/2 (280,01 eV para Ru e 280,75 eV para RuO 2 ) e Ru 3d 3/2 (284,3 eV para Ru e 285,26 eV para RuO 2 ) níveis básicos, demonstrando a coexistência de Ru e RuO 2 na película fina [23]. A baixa intensidade de Ru 3d 5/2 pico indica que o RuO formado 2 camada de interface é muito fina, como esperávamos.

Espectros XPS de a Ru / AlO y / HfO x filme fino e b Nível do núcleo Ru 3d. O RuO 2 filme fino entre Ru e AlO y formulários durante o processo ALD [18]
Conclusão
Neste estudo, o Ru / AlO compatível com CMOS y / HfO x / TiN dispositivo RRAM foi fabricado. O excelente desempenho de comutação foi alcançado com resistência uniforme de dispositivo a dispositivo e uma grande janela de resistência, bem como uma boa propriedade de retenção de alta temperatura. Com base nas medições elétricas e na análise XPS, o fenômeno NDR no processo de conjunto pode ser explicado pela recombinação de vacâncias de oxigênio e íons de oxigênio liberados do RuO 2 camada de interface devido ao aquecimento Joule eletricamente induzido.
Abreviações
- ALD:
-
Deposição de camada atômica
- CF:
-
Filamento condutor
- HRS:
-
Estado de alta resistência
- LRS:
-
Estado de baixa resistência
- NDR:
-
Resistência diferencial negativa
- PECVD:
-
Deposição de vapor químico intensificada por plasma
- RRAM:
-
Memória de acesso aleatório resistiva
- SCM:
-
Memória de classe de armazenamento
- XPS:
-
espectroscopia de fotoelétrons de raios-X
Nanomateriais
- O que é o efeito de pele?
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- O efeito dos ânions sulfato na nucleação ultrafina do titânia
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Efeitos das variações de gravação na formação do canal Ge / Si e desempenho do dispositivo
- Efeito da temperatura nas propriedades mecânicas de nanofibras de PU eletrofiado



