Passivação de Si melhorada e Eficiência de célula solar PERC por óxido de alumínio depositado por camada atômica com recozimento pós-recozimento de duas etapas
Resumo
Neste estudo, óxido de alumínio (Al 2 O 3 ) os filmes foram preparados por deposição de camada atômica espacial usando água deionizada e trimetilalumínio, seguido de oxigênio (O 2 ), formação de gás (FG) ou recozimento em duas etapas. O tempo de vida de portadores minoritários das amostras foi medido por Sinton WCT-120. A passivação por efeito de campo e a passivação química foram avaliadas por carga de óxido fixa ( Q f ) e densidade de defeito de interface ( D it ), respectivamente, usando medição de capacitância-tensão. Os resultados mostram que O 2 o recozimento dá um alto Q f de - 3,9 × 10 12 cm −2 , enquanto o recozimento FG leva a uma excelente hidrogenação da interface de Si com um baixo D it de 3,7 × 10 11 eV −1 cm −2 . Com base na consideração da melhor passivação de efeito de campo proporcionada pelo recozimento com oxigênio e a melhor passivação química proporcionada pela formação de gás, o processo de recozimento em duas etapas foi otimizado. Verifica-se que o Al 2 O 3 filme recozido sequencialmente em oxigênio e, em seguida, na formação de gás exibe um alto Q f (2,4 × 10 12 cm −2 ) e um baixo D it (3,1 × 10 11 eV −1 cm −2 ), resultando na melhor vida útil da portadora minoritária de 1097 μs. O SiN x / Al 2 O 3 a pilha de passivação com recozimento em duas etapas tem uma vida útil de 2.072 μs, perto do limite de vida útil intrínseca. Finalmente, o emissor passivado e a eficiência de conversão da célula traseira foram melhorados de 21,61% usando um processo de recozimento industrial para 21,97% usando o processo de recozimento de duas etapas.
Introdução
Emissor passivado e células traseiras (PERCs) surgiram como uma tecnologia promissora para alta eficiência e custo competitivo nos últimos anos. A maior diferença entre o PERC e a célula solar de silício de campo de superfície traseira totalmente em alumínio tradicional é a passivação traseira dos wafers. Esforços consideráveis têm sido feitos para melhorar a passivação da superfície do wafer. Tempos de vida de portadores minoritários de 0,8-8 ms foram relatados para bolachas de zona flutuante tipo p passivadas por vácuo [1,2,3,4] ou óxido de alumínio de deposição de camada atômica espacial (ALD) (Al 2 O 3 ) [5,6,7]. A qualidade de passivação para bolachas de Czochralski do tipo p é inferior, na faixa de 0,1–2 ms [8, 9]. ALD Al espacial 2 O 3 têm sido extensivamente estudados e aplicados à indústria nos últimos anos devido à sua maior taxa de deposição (0,03-1,2 nm / s) em comparação com um ALD convencional do tipo vácuo (<0,03 nm / s) [10, 11]. Trimetilalumínio (TMA) e H 2 O são os precursores mais amplamente usados, pois são líquidos voláteis de baixo custo e fáceis de manusear. Alguns grupos de pesquisa usam outros precursores, como AlCl 3 ou O 3 [12,13,14]. Al 2 O 3 é atualmente considerado o melhor material de passivação devido ao seu efeito de campo e passivação química [15]. Verificou-se que o H 2 O processo ALD baseado em O leva principalmente a um óxido de silício (SiO x ) camada no Al 2 O 3 / Si interface, e esta camada interfacial pode aparecer após deposição ou recozimento [16]. Pós-recozimento para Al 2 O 3 filmes em nitrogênio ou gás de formação (FG) mostraram aumentar significativamente a vida útil do wafer [12, 17]. Hidrogênio em FG ou Al 2 O 3 causar hidrogenação da interface de Si durante o recozimento. A temperatura de recozimento é normalmente inferior a 500 ° C, após a qual ocorre a desidrogenação. No entanto, outros processos de recozimento para melhorar ainda mais a qualidade de passivação raramente são relatados.
Neste estudo, Al 2 O 3 os filmes são preparados em Si por ALD espacial com TMA e H 2 O como precursores. Efeitos do oxigênio (O 2 ) e pós recozimento FG na passivação de pastilhas de Si são investigadas e analisadas. Um recozimento de duas etapas como uma combinação de O 2 e o recozimento FG é proposto e demonstra uma maior vida útil do wafer em comparação com o processo de recozimento de gás individual. Finalmente, o desempenho fotovoltaico de PERCs fabricados com o padrão da indústria, O 2 , FG e recozimento em duas etapas são apresentados.
Métodos
Wafers de silício Czochralski tipo P (100) com resistividade de 1 Ω cm e espessura de 200 μm foram usados como substratos. Os wafers foram limpos usando o processo RCA padrão, seguido por um mergulho HF de 30 s para remover o óxido nativo dos wafers. O Al 2 O 3 filmes finos com espessura de 18 nm foram depositados usando um sistema ALD espacial, com H 2 O e TMA como oxidante e fonte de alumínio, respectivamente. O intervalo entre as cabeças de injeção de gás e o suporte de substrato móvel era de cerca de 1 mm. Os parâmetros de deposição detalhados estão resumidos na Tabela 1. A temperatura dos tubos era de 70 ° C para evitar a condensação dos precursores. Algumas das bolachas foram passivadas com nitreto de silício (SiN x , 120 nm) / Al 2 O 3 Pilha (18 nm), onde o SiN x camada foi depositada usando uma deposição de vapor de plasma indutivamente acoplado de 13,56 MHz a 120 ° C com uma mistura de gás de amônia (NH 3 ) e tetrametilsilano (TMS). Outros parâmetros para SiN x deposição estão listados na Tabela 2. O oxigênio, FG, ou processo de recozimento de duas etapas foi realizado nas amostras, e os parâmetros de recozimento estão listados na Tabela 3. A vida útil das amostras foi medida por Sinton WCT-120. A capacitância-tensão ( C - V ) a medição foi realizada em amostras de semicondutor de óxido metálico (MOS) por um medidor de capacitor (HP 4284a) a 1 MHz em temperatura ambiente. Para a fabricação de MOS, as bolachas foram depositadas com um Al 2 de 18 nm de espessura O 3 camada e recozido. Filmes de alumínio com espessura de 500 nm foram evaporados em ambos os lados das amostras como eletrodos. A área das amostras MOS era de 1 mm 2 . As imagens transversais das amostras foram obtidas em microscópio eletrônico de transmissão (TEM). Para a fabricação de PERC, um esquema dos dispositivos é mostrado na Fig. 1, onde a passivação ALD está apenas no lado traseiro. As bolachas foram texturizadas com solução alcalina para gerar pirâmides aleatórias. O emissor foi formado por POCl 3 difusão em um forno térmico de tubo padrão com uma resistência de folha de 100 ohms / quadrado. A SiN x de 85 nm de espessura foi depositado na parte frontal do wafer como uma camada anti-reflexiva por deposição de vapor de plasma indutivamente acoplado (ICPCVD). O verso da bolacha foi polido por solução de KOH por 3 min a 70 ° C. O Al 2 O 3 filmes de 18 nm de espessura foram depositados usando ALD espacial. Um ICPCVD SiN x de 120 nm de espessura foi depositado em Al 2 O 3 . As amostras foram recozidas com diferentes processos de recozimento. As aberturas locais traseiras com um diâmetro de 40 μm e um passo de 260 μm foram criadas por traçado a laser de 532 nm. Finalmente, uma grade de prata foi impressa em tela na frente e alumínio no dielétrico traseiro, seguido por co-combustão em uma temperatura de pico de 850 ° C. A tensão-densidade de corrente ( J - V ) as curvas foram medidas por um simulador solar do tipo fonte de luz dupla (Wacom Co., Japão) usando uma lâmpada de xenônio e uma lâmpada de halogênio com um espectro de luz simulado de classe A AM 1.5G calibrado.
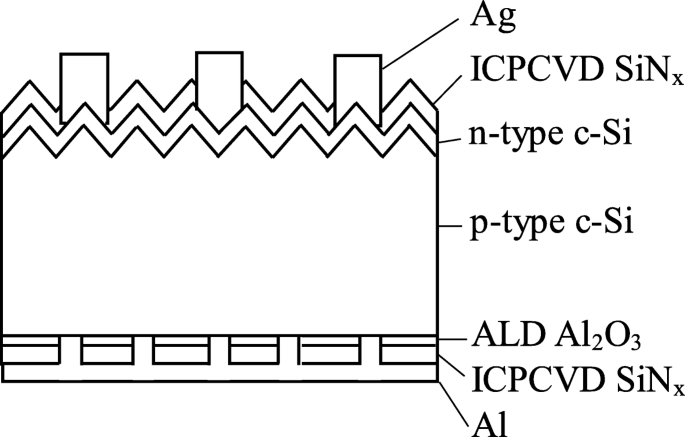
Esquema de células solares PERC com SiN x / ALD Al 2 O 3 passivação traseira
Resultados e discussão
A Figura 2a mostra os tempos de vida do portador minoritário dependente do nível de injeção do Al 2 O 3 / Si / Al 2 O 3 amostras sem e com diferentes processos de recozimento. Antes do recozimento, a vida útil do portador minoritário é inferior a 100 μs em toda a faixa de nível de injeção. A vida útil melhora muito após o processo de recozimento, como consequência da passivação química e da passivação por efeito de campo trazida pelo Al recozido 2 O 3 . No entanto, os valores de vida útil são diferentes nessas três condições de recozimento, em que o recozimento com oxigênio tem a curva mais baixa, o recozimento FG tem a intermediária e o recozimento de duas etapas tem a mais alta. Os valores de vida no nível de injeção de 3 × 10 15 cm −3 são extraídos como mostrado na Fig. 2b. O 2 -, FG- e amostras recozidas em duas etapas têm tempos de vida de 818, 934 e 1098 μs, respectivamente. Observe que o recozimento em duas etapas pode obter o maior tempo de vida apenas com a sequência de recozimento da primeira etapa em O 2 e a segunda etapa em FG. A sequência reversa resulta em um tempo de vida semelhante ao da amostra com O 2 recozimento sozinho. Isso pode ser porque se o recozimento FG foi executado primeiro, o seguinte O 2 o recozimento pode causar desidrogenação. Niwano et al. relatou que para um wafer terminado por Si – H ou Si – H 2 ligações, a exposição ao oxigênio resulta na substituição das ligações de hidrogênio com as ligações Si – O [18].

a Vida útil do portador minoritário dependente do nível de injeção. b Vida útil em um nível de injeção de 3 × 10 15 cm −3 para Al 2 O 3 / Si / Al 2 O 3 amostras com O 2 , FG e recozimento em duas etapas
Como a passivação geral é governada pelo efeito de campo e passivação química, o C - V medição é útil para esclarecer qual passivação domina nos casos de O 2 , FG e recozimento em duas etapas. A Figura 3a mostra o C normalizado - V curvas para as amostras sem e com diferentes processos de recozimento. A magnitude da inclinação das curvas na região de depleção pode ser usada como um indicador da densidade de defeito da interface ( D it ), uma vez que a existência de interceptações de interface causa C - V alongamento da curva [19]. O recozimento em duas etapas fornece a maior inclinação entre as outras e, portanto, a menor D it é esperado. Para obter mais informações, os valores de densidade de carga de óxido fixo ( Q f ) e D it são extraídos do C - V curvas conforme plotado na Fig. 3b. O Q f é útil para avaliar a passivação do efeito de campo e é calculado por [20]
$$ {Q} _f =\ frac {C _ {\ mathrm {ox}} \ left ({W} _ {\ mathrm {ms}} - {V} _ {\ mathrm {fb}} \ right)} {q \ A} $$ (1)
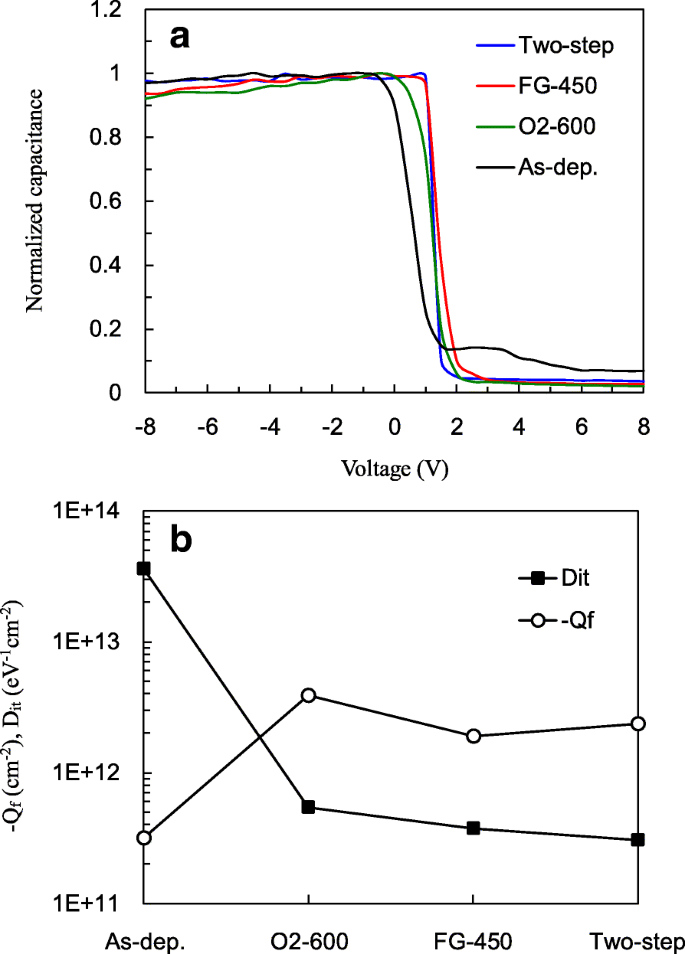
a Normalizado C - V curvas. b D it e Q f para amostras com O 2 , FG e recozimento em duas etapas
onde C boi é a capacitância do óxido de acumulação, W ms é a diferença da função de trabalho entre semicondutor e eletrodo (neste caso - 0,9 V), V fb é a tensão de banda plana, q é a carga do elétron, e A é a área dos dispositivos MOS. O Q f é - 3,2 × 10 −11 cm −2 para a amostra conforme depositada. Q f neste nível leva a uma passivação de efeito de campo fraca [21]. Todas as amostras recozidas elevam Q f ao nível de 10 12 cm −2 . É visto que o O 2 o recozimento dá o maior Q f de 3,9 × 10 12 cm −2 , o recozimento de duas etapas fornece o Q intermediário f , e o recozimento FG dá o menor Q f . Por outro lado, D it valor estimado pelo método Terman [22] também é mostrado para avaliar a passivação química. A amostra conforme depositada tem um D it de mais de 10 13 eV −1 cm −2 . Reduz para 5,4 × 10 11 eV −1 cm −2 para O 2 recozimento, 3,7 × 10 11 eV −1 cm −2 para recozimento FG e 3,1 × 10 11 eV −1 cm −2 para recozimento em duas etapas. Assim, comparando O 2 e recozimento FG, verifica-se que O 2 o recozimento tem a melhor passivação do efeito de campo, enquanto o FG tem a melhor passivação química. O primeiro pode estar ligado à interface SiO x crescimento. Ao contrário do recozimento FG, que é realizado a uma temperatura relativamente baixa e com falta de oxigênio, O 2 espera-se que o recozimento tenha um SiO x melhorado crescimento da camada interfacial. Isso poderia aumentar a possibilidade de substituição de Al por Si no Al 2 O 3 / SiO 2 interface, que é considerada uma possível origem de encargos fixos negativos [23]. Considerando o recozimento de duas etapas, o intermediário Q f é razoável como uma combinação de O 2 e recozimento FG. No entanto, é D it valor é inferior ao do recozimento FG. Isso é explicado pela contribuição adicional pela maior qualidade da camada de óxido interfacial devido à primeira etapa O 2 anelamento. Alguns estudos também relataram que um SiO x mais denso resulta em uma melhor passivação [24]. O inferior D it na amostra de recozimento de duas etapas também pode ser atribuída à melhoria da hidrogenação da superfície de silício induzida pelo hidrogênio em Al 2 O 3 filme.
A Figura 4 mostra as imagens TEM em seção transversal das amostras sem e com diferentes processos de recozimento. Antes do recozimento, um SiO x camada interfacial entre Si e Al 2 O 3 é observado, embora a interface não seja clara. Isso pode ser porque H 2 O foi usado no ciclo ALD da primeira metade. Para O 2 No recozimento, a espessura da camada interfacial aumenta para 5,6 nm, devido ao recozimento em alta temperatura (600 ° C) e em ambiente de oxigênio. Foi relatado que o oxigênio tem um coeficiente de difusão muito pequeno em Al 2 O 3 (~ 10 −38 cm −1 a 600 ° C) [25] e, portanto, é improvável que o oxigênio se difunda através do Al 2 O 3 camada para alcançar a interface Si. Em vez disso, o oxigênio do ambiente se troca com o oxigênio em Al 2 O 3 , criando um oxigênio móvel que pode repetir o processo de intercâmbio no Al 2 mais profundo O 3 região até que o oxigênio alcance a interface Si [26]. A amostra recozida em FG mostra uma interface mais clara com um SiO x muito fino camada interfacial de 1,4 nm, que é semelhante a outros grupos de pesquisa realizando o processo de recozimento em N 2 ou FG [16]. Isso evidencia que o recozimento FG limita o crescimento da camada interfacial. O recozimento de duas etapas mostra um SiO x intermediário espessura da camada interfacial de cerca de 4 nm, como consequência do tempo reduzido do O 2 anelamento.
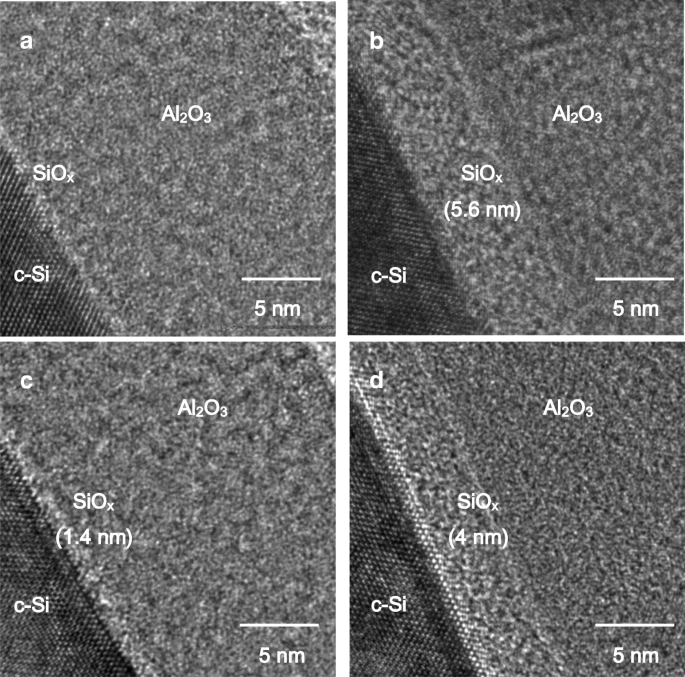
Imagens transversais do TEM para amostras a sem recozimento e com b O 2 , c FG e d recozimento de duas etapas
A Figura 5a mostra o tempo de vida da portadora minoritária dependente do nível de injeção do SiN x / Al 2 O 3 - wafers passivados sem e com diferentes processos de recozimento. Os tempos de vida no nível de injeção de 3 × 10 15 cm −3 são 1569, 1579 e 2072 μs para O 2 , FG e recozimento em duas etapas, respectivamente. As melhorias estão relacionadas ao fato de que o SiN x depositado em vapor químico de plasma os filmes podem conter certas quantidades de hidrogênio, dependendo dos parâmetros do processo de deposição. Durante o processo de recozimento, parte do hidrogênio se moveria em direção à interface de Si, e isso aumenta a hidrogenação da interface de Si [27]. Conforme relatado na literatura [6, 28,29,30], o tempo de vida de SiN x / Al 2 O 3 wafers CZ tipo p passivados estão no intervalo de 0,1–2 ms. A temperatura ideal de recozimento pós-deposição em nitrogênio ou em FG é em torno de 400–500 ° C. Neste trabalho, o SiN x / Al 2 O 3 wafer CZ passivado recozido em FG mostra uma vida útil de 1579 μs e uma temperatura de recozimento ideal de 450 ° C, que estão de acordo com os valores relatados. No entanto, esta temperatura ótima é limitada pela hidrogenação da interface de silício. Do ponto de vista da camada interfacial de óxido de silício, esta camada pode ter diferentes temperaturas ótimas, pois altas temperaturas geralmente melhoram as qualidades dos filmes de óxido de silício. Assim, o recozimento em duas etapas poderia otimizar tanto a qualidade do óxido interfacial quanto a hidrogenação da interface de silício, e leva a uma maior vida útil de 2.072 μs em comparação com o caso de recozimento de fase única de gás de formação. Para investigar a reprodutibilidade, 50 amostras com recozimento em duas etapas foram preparadas e seu tempo de vida de portador minoritário é mostrado na Fig. 5b. As amostras têm valores de vida útil que variam entre 1939 e 2224 μs. O valor médio é 2075 μs e o erro está dentro de ± 7%. O limite de vida intrínseca do wafer usado neste estudo é de cerca de 2300 μs, calculado usando a parametrização de Richter [31]. Assim, o recozimento em duas etapas produz uma vida útil próxima à limitação da vida útil e demonstra excelente passivação de interface. Para outro ALD, uma camada interfacial de óxido de silício entre Al 2 O 3 / Si também é encontrado, e o recozimento em duas etapas deve ser capaz de melhorar a qualidade de passivação dos wafers de Si. AlO x / SiN x é necessário porque o nitreto de silício não só aumenta a passivação, mas também aumenta a refletância traseira e protege AlO x de um processo de cofiring de alta temperatura para a fabricação de PERC.

a Vida útil de portador minoritário dependente de nível de injeção de SiN x / Al 2 O 3 - amostras passivadas com O 2 , FG e recozimento em duas etapas. b Vida útil em um nível de injeção de 3 × 10 15 cm −3 para 50 amostras com recozimento de duas etapas
A Figura 6 mostra a tensão de circuito aberto implícita ( V oc) para o SiN x / Al 2 O 3 - amostras passivadas com diferentes processos de recozimento. Para bolachas tipo p e comprimentos de difusão longos, o V implícito oc pode ser escrito como
$$ \ mathrm {implícito} \ {V} _ {\ mathrm {oc}} =\ frac {kT} {q} \ ln \ left (\ frac {\ Delta n \ \ left ({N} _A + \ Delta n \ right)} {{n_i} ^ 2} \ right) $$ (2)

Implícito V oc do SiN x / Al 2 O 3 - amostras passivadas com O 2 , FG e recozimento em duas etapas
onde k é a constante de Boltzmann, T é a temperatura absoluta, n i é a concentração intrínseca do portador, N A é a concentração do aceitador, e ∆ n é a concentração de portador em excesso medida na intensidade de luz de um sol pelo testador de tempo de vida WCT-120 Sinton. Pode ser visto que o O 2 - e as amostras recozidas com FG têm V implícito semelhante oc valores, que são 696 e 697 mV, respectivamente. O recozimento em duas etapas tem um V implícito oc de 706 mV.
A Figura 7 mostra o J - V características e parâmetros fotovoltaicos como V oc , densidade de corrente de curto-circuito ( J sc ), fator de preenchimento (FF) e eficiência de conversão ( η ) dos PERCs fabricados com diferentes processos de recozimento. O desempenho de um PERC industrial também é mostrado para fins de comparação. O PERC da indústria foi fabricado sob condições idênticas, mas nenhum processo de recozimento adicional foi usado, uma vez que o Al 2 O 3 camada foi recozida durante o SiN x deposição a 400 ° C. Observe que neste estudo, durante os processos de recozimento, a parte frontal foi posicionada para baixo e feita contato com um porta-wafer. O SiN frontal x camada não foi exposta aos gases de recozimento e, portanto, a influência da frente SiN x camada pode ser insignificante. O PERC da indústria mostra o menor V oc de 665,4 mV entre as demais. Isso pode ser atribuído ao seu menor tempo de vida do wafer de 797 μs no nível de injeção de 3 × 10 15 cm −3 . O V oc o valor melhora para 671,3 mV para O 2 recozimento e 672,3 mV para recozimento FG. O recozimento de duas etapas aumenta ainda mais V oc para 675,5 mV, o que é uma melhoria de cerca de 0,6% em comparação com o recozimento de uma etapa, ou de 1,5% em comparação com o recozimento da indústria. Não há muita diferença em J sc e FF entre os PERCs. O recozimento de duas etapas exibe as melhores eficiências de conversão de 21,97%, o que é 0,36% abs mais alto do que o PERC da indústria. Finalmente, cinco PERCs foram fabricados para cada processo de recozimento. O valor médio e intervalo de distribuição de V oc e FF são mostrados na Fig. 8a e b, respectivamente. Os PERCs com o recozimento em duas etapas mostram V oc de 675–677,5 mV com um valor médio de 676 mV e FF de 0,813–0,819 com um valor médio de 0,816.

Curvas de densidade-tensão de corrente e desempenho fotovoltaico de PERCs com fabricação padrão da indústria, O 2 recozimento, recozimento FG e recozimento de duas etapas

Valor médio e intervalo de distribuição de a V oc e b FF para PERCs com diferentes processos de recozimento
Conclusão
O Al 2 O 3 os filmes são preparados usando deposição de camada atômica, seguido por O 2 , FG ou recozimento em duas etapas. Comparando O 2 recozimento com recozimento FG, o primeiro produz um SiO mais espesso x camada interfacial e superior Q f densidade de - 3,9 × 10 12 cm −2 , indicando uma passivação de efeito de campo superior. O recozimento FG mostra o D inferior it de 3,7 × 10 11 eV −1 cm −2 resultante da hidrogenação da interface Si. O recozimento em duas etapas combina as vantagens desses dois processos de recozimento e tem um Q intermediário f e o menor D it de 3,1 × 10 11 eV −1 cm 2 . O SiN x / Al 2 O 3 As amostras passivadas com o recozimento de duas etapas demonstram uma vida útil de portadora minoritária de 2.072 μs, perto do limite de vida útil intrínseca. Para o PERC fabricado com o recozimento de duas etapas, V oc de 675,5 mV e eficiência de conversão de 21,97%, que respectivamente apresentam aumentos de 10 mV e 0,36% abs em relação aos da indústria PERC.
Abreviações
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposição de camada atômica
- C - V :
-
Capacitância-tensão
- D it :
-
Densidade de defeito de interface
- FF:
-
Fator de preenchimento
- FG:
-
Formando gás
- J sc :
-
Densidade de corrente de curto-circuito
- J - V :
-
Densidade-tensão de corrente
- MOS:
-
Semicondutor de óxido metálico
- NH 3 :
-
Amônia
- O 2 :
-
Oxigênio
- PERC:
-
Emissor passivado e célula traseira
- Q f :
-
Carga de óxido fixa
- SiN x :
-
Nitreto de silício
- SiO x :
-
Óxido de silício
- TEM:
-
Microscopia eletrônica de transmissão
- TMA:
-
Trimetilalumínio
- TMS:
-
Tetrametilsilano
- V oc :
-
Voltagem de circuito aberto
- η :
-
Eficiência de conversão
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- Uma investigação em uma célula solar de silício cristalino com camada de silício preta na parte traseira
- Fabricação de 20,19% de célula solar de silício monocristalina eficiente com microestrutura de pirâmide invertida
- Eficiência de conversão de energia aprimorada de células solares de perovskita com um material de conversão ascendente de Er3 + -Yb3 + -Li + TiO2 tri-dopado
- Influência de nanopartículas de Ag com diferentes tamanhos e concentrações incorporadas em uma camada compacta de TiO2 na eficiência de conversão de células solares de perovskita
- Propriedades fotovoltaicas aprimoradas na célula solar de heterojunção plana Sb2S3 com uma abordagem de selenilação rápida
- Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN
- Células solares sensibilizadas por corante:fundamentos e status atual
- Transistor de semicondutor de óxido metálico difundido duplo e lateral de resistência ultrabaixa específica com porta dupla aprimorada e camada P-enterrada parcial



