Desempenho ferroelétrico aprimorado de filmes LiNbO3 dopados com magnésio por uma camada atômica ideal depositada em camada de troca de túnel de Al2O3
Resumo
Estruturas de bicamadas compostas por 5% de LiNbO dopado com Mg 3 filmes de cristal único e ultrafinos Al 2 O 3 camadas com espessura variando de 2 a 6 nm foram fabricadas usando a técnica de fatiamento de íons combinada com o método de deposição de camada atômica. Os resultados da medição de corrente de comutação de domínio transiente revelam que o P-V Os loops de histerese são simetria no modo tipo II com pulso de tensão única por ciclo, que pode ser atribuído ao campo elétrico embutido formado por eletrodos assimétricos e compensação de um campo de impressão interno. Além disso, o Al 2 embutido O 3 , como uma camada de switch de túnel ideal, liga durante a comutação ferroelétrica, mas fecha durante a pós-comutação ou não comutação sob a tensão de pulso aplicada. O Al 2 O 3 camada bloqueia os efeitos adversos, como injeção de carga por eletrodo e melhora as propriedades de resistência à fadiga do LiNbO dopado com Mg 3 capacitores ferroelétricos. Este estudo fornece uma possível maneira de melhorar as propriedades de confiabilidade de dispositivos ferroelétricos na aplicação de memória não volátil.
Histórico
Filmes de cristal único de niobato de lítio (LN), devido às suas excelentes propriedades físicas, [1,2,3,4,5,6] têm sido amplamente utilizados em osciladores de onda acústica de superfície, moduladores eletro-ópticos e armazenamento de dados com base em a troca de domínio. Recentemente, niobato de lítio em isolador (LNOI) em escala de wafer, que tem grande potencial de aplicação para circuitos integrados de alta densidade em dispositivos eletro-ópticos, acústico-ópticos e de armazenamento de dados, é fabricado por uma tecnologia de implantação de íons e ligação de wafer . Esta tecnologia permite uma grande variedade de substratos, como LN, silício e até mesmo o circuito CMOS [3, 7,8,9]. No entanto, o loop de histerese de impressão originado de orientações preferenciais e a baixa resistência à fadiga dos filmes LN, devido à injeção de carga por eletrodo, desestabilizam a retenção de reversão de polarização, o que limita sua aplicação em dispositivos de memória não volátil [10,11,12 , 13]. As orientações preferidas referem-se às camadas passivas interfaciais formadas entre as camadas ferroelétricas e os eletrodos, que podem induzir um forte campo de despolarização na direção oposta à polarização. Ele pode expulsar as cargas injetadas após a remoção da tensão aplicada ou durante o tempo intermitente de estresse de pulso sequente [11, 12]. Por outro lado, devido à presença de camadas passivas interfaciais, a resistência à fadiga dos filmes LN será melhorada pelo bloqueio da injeção de carga do eletrodo após a comutação ferroelétrica. No entanto, o processo de fadiga acelera se o tempo da periodicidade de pulso aplicada for encurtado abaixo de 0,5 s. Isso é descrito pela contribuição das camadas passivas interfaciais da carga espacial acumulativa em certas frequências [11]. É relatado que um Al 2 embutido O 3 filme dielétrico pode atuar como um interruptor de túnel no capacitor de bicamada dielétrico / ferroelétrico, por exemplo, em Al 2 O 3 / Pb (Zr, Ti) O 3 , e Al 2 O 3 / BiFeO dopado com Mn 3 estruturas de bicamada [14,15,16]. O Al 2 O 3 O interruptor de túnel liga-se como um condutor durante a comutação de polarização, mas desliga-se como um isolante para bloquear a injeção de carga pelo eletrodo após a comutação de polarização completa ou nenhuma operação de comutação [14]. Portanto, pode evitar as cargas injetadas indesejadas e o retrocesso de polarização e, em seguida, melhorar a confiabilidade do capacitor de bicamada dielétrico / ferroelétrico.
Neste artigo, nós fabricamos filmes finos de cristal único congruente LN congruente de cristal único LN congruente com 200 nm de espessura Z-cut 5% e, em seguida, depositamos Al ultrafino 2 O 3 camadas com várias espessuras (2–6 nm) em LN para formar estruturas de capacitor de bicamada. O Al 2 O 3 filmes como camadas de switch de túnel podem melhorar a resistência à fadiga. Eletrodos assimétricos (eletrodos Au / Pt) são projetados para formar um campo elétrico embutido contra o campo de despolarização induzido pelas camadas passivas interfaciais. Os resultados elétricos exibem a simetrização do loop de histerese transferido dos transientes de corrente de comutação de domínio com o tempo. Enquanto isso, também prova que o Al 2 embutido O 3 camada atua como uma camada de switch de túnel, que pode aumentar durante a comutação ferroelétrica e fechar após a comutação de polarização concluída ou nenhuma operação de comutação.
Métodos
O LiNbO 3 congruente com corte Z 5% dopado com Mg (LN) filmes finos de cristal único foram removidos de seus cristais em massa usando uma implantação iônica e tecnologia de ligação de wafer, conforme descrito em outro lugar [10, 11, 17, 18]. Em detalhes, a camada de superfície de um cristal bruto LN foi primeiro implantada com íons He na profundidade desejada, controlando a energia de implantação e a dose de íons injetados e, em seguida, a camada de adesão de 5 nm Cr e a camada de eletrodo inferior de Pt de 100 nm são depositadas por DC pulverização catódica (KJ Lesker PVD-75). A camada de superfície foi ligada a outro substrato LN coberto com SiO de 1 μm de espessura 2 camada de buffer e cortado. A espessura do filme LN é controlada a cerca de 200 nm por polimento químico-mecânico. Posteriormente, ultrafino Al 2 O 3 filmes com espessuras ( d ) de 2-6 nm foram depositados por ALD (TFS-200, Beneq, Finlândia). Em detalhes, os gases precursores são dietil zinco e água desionizada. Eles foram pulsados alternadamente na câmara de reação com um tempo de pulso de 50 ms e separados por etapas de purga usando argônio por 2 s na temperatura de reação de 200 ° C [19]. Finalmente, eletrodos de Au no topo com áreas de 1,0 × 10 −4 cm 2 foram depositados através de uma máscara rasa de metal.
As espessuras de Al 2 O 3 camadas depositadas no wafer de Si como contraste foram medidas por um sistema de elipsometria espectroscópica (GES-5E, SOPRA, Courbevoie, França). A estrutura do filme foi analisada por difração de raios-X (XRD) (Bruker D8 Advance) em um modo de varredura θ-2θ com Cu K α radiação, bem como microscopia eletrônica de varredura transversal (SEM, Sigma HD, Zeiss). Para estudar a dinâmica de comutação de domínio, vários pulsos quadrados com um tempo de subida de 10 ns foram aplicados aos eletrodos superiores usando um gerador de pulsos Agilent 8114A de canal único, onde os eletrodos inferiores eram aterrados. No circuito, a corrente de comutação de domínio ( I sw ) em resistores internos em série de todos os instrumentos com a resistência total monitorada usando um osciloscópio LeCroy HDO6054. Os valores de ambas as resistências de saída do gerador de pulsos R W e a resistência de entrada do osciloscópio R O são 50 Ω, respectivamente.
Resultados e discussão
A Figura 1a mostra o resultado de XRD do filme fino LN em um Pt / Cr / SiO 2 / LN substrato. O filme tem forte (00 l ) reflexões indexadas na simetria de fase romboédrica. Além disso, há também alguns picos de difração de filmes de Pt e Cr marcados na Fig. 1a. A ausência de quaisquer outros picos confirma a alta cristalinidade do filme LN sem impureza de fase. A imagem SEM transversal da amostra mostrada na Fig. 1b demonstra a estrutura de interface clara com LN, Pt, Cr e SiO 2 camadas de empilhamento.
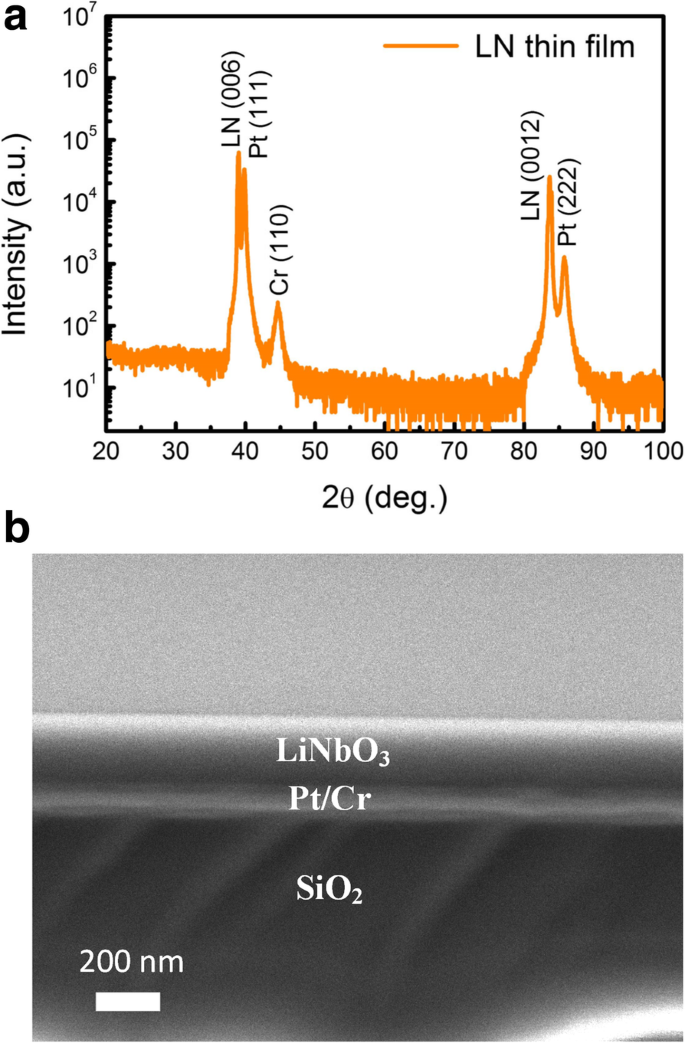
a O padrão XRD e b imagem SEM de seção transversal do LN / Pt / Cr / SiO de 200 nm de corte em Z 2 / LN filme
A fim de estudar o mecanismo cinético de chaveamento de domínio, dois tipos de modos de tensão de pulso são projetados como claramente mostrado nas Fig. 2a e b [11]. O tipo I é configurado como pulsos duplos em polaridades opostas com intervalo de tempo de 5 s. O primeiro pulso é aplicado para trocar o estado de polarização ascendente apontando para o eletrodo superior e o segundo pode trocar a polarização descendente. No entanto, limitado pelo tempo de programação de uma geração de pulso de canal único, o intervalo de tempo mínimo é muito longo para capturar o transiente de corrente de comutação de domínio invocado pelo segundo pulso, devido à orientação de domínio preferida. Para capturar o transiente de corrente de comutação de domínio, um único pulso que se sobrepõe a uma polarização DC de linha de base negativa é proposto no tipo II, onde a polarização DC negativa inicial pode mudar o estado de polarização para cima e o pulso positivo define o domínio para baixo. Aqui, a largura dos dois tipos de pulsos é definida como 1 μs.

O esboço dos dois modos de tensão de pulso de sequência com a tipo I (pulsos duplos em duas polaridades opostas) e b tipo II (um único pulso de comutação sobrepondo-se a uma polarização DC negativa). Transientes de corrente de comutação de domínio sob diferentes V aplicado a uma amostra virgem em c tipo I e d modos do tipo II, onde os insets mostram o ajuste linear da dependência dos platôs da corrente de comutação de domínio em V . P - V loops de histerese sob diferentes V transferido de transientes de corrente de comutação de domínio em e tipo I e f tipo II. Diagrama esquemático da estrutura Au / LN / Pt e as direções do campo elétrico embutido E b e campo de despolarização E d na inserção de e
As Figuras 2c e d mostram os transientes de corrente de comutação de domínio em função do tempo ( t ) de amostra de estrutura Au / LN / Pt sob várias tensões aplicadas ( V ) nos modos tipo I e tipo II, respectivamente. Os platôs de transientes de corrente de comutação de domínio são observados que estreitam em largura, mas aumentam em altura com V aumentando após a corrente de carga do capacitor inicial em 30 ns. A altura do platô em dois modos mostra uma relação linear com o aumento de V e os resultados são resumidos nas inserções pelo ajuste de linha sólida dos dados [11, 13]. A tensão coercitiva ( V c ) o valor nos dois modos pode ser derivado para cerca de 24,7 V a partir da interceptação da linha com o eixo de tensão. Após o término do pulso de comutação, a corrente de descarga do capacitor ocorre após 1 μs, o que sugere que a orientação de domínio preferida é o estado de polarização para cima apontando para o eletrodo superior.
P - V Os loops de histerese sob diferentes tensões aplicadas em dois modos de tipo podem ser transferidos diretamente dos transientes de corrente de comutação de domínio correspondentes na Fig. 2c e d, e os resultados são mostrados na Fig. 2e e f, respectivamente [11, 20]. Uma determinada tensão coercitiva direta de cerca de 25 V invariável com V é obtido nos dois tipos de pulsos. A tensão coercitiva se aproxima de V c extraído do linear I sw - V plot na inserção da Fig. 2c e d. Ao contrário do filme LN não dopado, o V c é variável e o valor é igual às tensões máximas aplicadas [10]. Para o LN dopado com 5% de Mg, o V definido c é invariável com V , conforme mostrado na Fig. 2e e f. Isso ocorre porque a dopagem com Mg pode gerar vacâncias de metal no local de Li e defeitos relacionados à vacância de oxigênio, [21,22,23] que podem reter cargas espaciais e reduzir efetivamente o tempo de degradação da resistência através das camadas interfaciais entre o filme e a parte superior / inferior eletrodos [11]. Portanto, as correntes de comutação de domínio se sobrepõem às correntes de carga do capacitor na aceleração da velocidade de comutação de domínio com um V definido c , conforme mostrado na Fig. 2c e d. No entanto, limitada pelo gerador de pulsos, a tensão de linha de base de saída no modo tipo II não pode ser deslocada simetricamente ao aumentar a tensão de pulso aplicada acima de 32 V. Em comparação com os loops impressos ao longo do eixo de tensão positiva na Fig. 2e, a simetrização dos loops são alcançados ao longo do eixo de tensão na Fig. 2f, diferente daqueles em Pt / LiNbO 3 / Estruturas Pt onde o P - V loops de histerese em qualquer tipo I ou tipo II são impressos em direção a uma tensão positiva [11]. A razão do simétrico P - V loops na Fig. 2f podem ser atribuídos aos eletrodos assimétricos projetados (aqui Au / Pt). A função de trabalho do eletrodo Au é de 5,1 eV, que é ligeiramente menor que a de Pt (5,65 eV) [24]. Haverá indução de um campo elétrico embutido ( E b ) com a direção apontando do eletrodo superior para o eletrodo inferior, mostrado na inserção da Fig. 2e. O campo de despolarização ( E d ) induzida pelas camadas passivas interfaciais tem direção oposta a E b . O E d pode retornar a polarização em um tempo muito curto após o término do pulso de chaveamento no tipo II para os eletrodos simétricos (Pt / Pt) [11]. Em nosso experimento, o E b pode filtrar parcialmente o E d e acumular cargas injetadas em compensação de um campo de impressão interno, [16] que pode retardar o tempo de retrocesso. Conseqüentemente, o domínio comutado pode manter e o transiente de corrente reversa será capturado pelo pulso do tipo II. No entanto, o intervalo de tempo dos dois pulsos com polaridades opostas no modo tipo I é muito longo. Após o primeiro pulso, as cargas injetadas presas por E b será gradualmente expulso do filme por E d antes da chegada do segundo pulso no tipo I [11]. A fim de provar a atribuição de campo elétrico embutido à simetrização dos loops, Pt / LiNbO 3 / Pt a amostra de estrutura simétrica foi preparada e os loops impressos ao longo do eixo de tensão positiva foram transferidos diretamente dos transientes de corrente de comutação de domínio correspondente no arquivo adicional 1:Figura S1a em pulso positivo com tensões / larguras de 30-40 V / 500 ns, mostrado no arquivo adicional 1:Figura S1b.
As Figuras 3a eb mostram a corrente de comutação de domínio ( I sw ) transientes versus tempo ( t ) de LN e Al 2 O 3 (6 nm) / Amostras LN sob tensão aplicada diferente ( V ) no modo tipo I. Após o patamar de comutação de domínio, a corrente de comutação I sw decai e é dado por:[13]
$$ {I} _ {\ mathrm {sw}} ={I _ {\ mathrm {sw}}} ^ 0 \ exp \ left (- \ frac {t- {t} _0} {R _ {\ mathrm {L} } {C} _ {\ mathrm {i}}} \ right) \ left ({t} _0 \ le t \ le {t} _ {\ mathrm {sw}} \ right) $$ (1)
onde t 0 , t sw , R L e C i são o tempo de início da comutação de domínio, o tempo de conclusão da comutação de domínio, a resistência total de todos os resistores em série no circuito e a capacitância não ferroelétrica interfacial, respectivamente. Isso descreve o efeito de captura de carga, que pode ser modelado como uma camada passiva interfacial em série com uma camada ferroelétrica ideal. eu sw 0 é definido como corrente de comutação e é dado por:
$$ {I _ {\ mathrm {sw}}} ^ 0 =\ frac {V- {V} _ {\ mathrm {fc}}} {R _ {\ mathrm {L}}} $$ (2)

a , b eu sw - t dependências no tipo I sob diferentes V aplicado ao Al 2 O 3 / LN bicamada com o Al 2 O 3 espessura d =0 e 6 nm, respectivamente, ajustados por uma série de linhas pontilhadas paralelas à Eq. (1). c Os platôs da corrente de comutação de domínio em função da tensão aplicada com diferentes Al 2 O 3 espessuras de camada, onde as linhas sólidas mostram o melhor ajuste dos dados para a Eq. (2) d O Al 2 O 3 - espessura da camada d dependência da tensão coercitiva ( V c ) extraído de c . e , f A capacitância interfacial extraída C i e resistência de contato R C como funções do Al 2 O 3 espessura da camada d
Durante a comutação de domínio, a tensão aplicada na camada ferroelétrica é fixada na tensão coercitiva V fc , e a tensão extra ( V - V fc ) é aplicado a R L . R L também incluiu o circuito de resistência parasita ( R P ) e resistência de contato ( R C ) entre o filme e os eletrodos; portanto, R L = R O + R W + R P + R C . A parte decaída dos transientes da corrente de comutação em função do tempo pode ser ajustada pela Eq. (1). A constante de tempo R L C i pode ser estimado a partir da inclinação das linhas ajustadas. A Figura 3c mostra I sw 0 - V parcelas com diferentes Al 2 O 3 espessuras. R L e V C foram estimados a partir das encostas e do X - interceptação do eixo das linhas lineares ajustadas. Pode ser visto que o V C é aumentado linearmente com o aumento de Al 2 O 3 espessura d , conforme mostrado na Fig. 3d. Aqui, o C i os valores foram estimados como os limites de erro em cada V na Fig. 3e [13]. Os resultados mostram que C i valor quase se manteve constante (1,4 ± 0,2) nF com Al crescente 2 O 3 espessura da camada de 0 a 6 nm.
Para calcular R C , os eletrodos superior e inferior estão em curto, o que pode obter o R P (~ 2 Ω) com diferentes tensões aplicadas, mostradas como a calibração do circuito pelos símbolos abertos na Fig. 3c. Portanto, o R C correspondendo a d é calculado e o resultado é mostrado na Fig. 3f. R C aumenta linearmente de 3 ± 2,5 Ω em d =0 a 55 ± 10 Ω em d =6 nm. O quase d -independente grande C i valores sugerem que o Al 2 O 3 camada funciona como um resistor em série durante a comutação de domínio. Isso significa que o Al 2 O 3 o interruptor do túnel foi ligado durante a comutação FE.
A fim de obter a capacitância total da bicamada durante a não comutação FE, a comutação ( P sw ) e sem comutação ( P nsw ) polarizações vesus V com d aumentados de 0 a 6 nm sob pulsos no modo tipo I são medidos e os resultados são mostrados na Fig. 4a. O objetivo da escolha do pulso do tipo I é obter a curva de P nsw - V quando a direção da tensão aplicada é consistente com a orientação de polarização, a partir da qual a capacitância total ( C tot ) da bicamada pode ser calculado a partir da relação, C tot = S · dP nsw / dV , onde S é a área do eletrodo. Ele pode excluir totalmente os efeitos de carga pela comutação FE no modo de pulso tipo I, mas usar o modo tipo II não pode atingir esse efeito com a polarização de comutação negativa, que pode alternar de volta a polarização envolvida com a injeção de cargas. A diferença entre P sw e P nsw é 2Pr, como mostrado na Fig. 4a. Tem uma pequena mudança com d de 0 a 6 nm, enquanto o P nsw (símbolos abertos) os sinais são muito fracos para serem monitorados por um osciloscópio. Para provar o Al 2 O 3 camada de interruptor de túnel funcionando como um capacitor dielétrico, o C direto tot medições usando um analisador de impedância de baixa frequência a 100 kHz sem polarização CC adicional foram realizadas e seus resultados são mostrados na Fig. 4b, que pode ser ajustada pela Eq. (3):
$$ \ frac {1} {C _ {\ mathrm {tot}}} =\ frac {1} {C _ {\ mathrm {f}}} + \ frac {d} {\ varepsilon_0 {\ varejpsilon} _ {\ mathrm {Al}} S} $$ (3)
onde ε Al é a constante dielétrica do Al 2 O 3 camada e ε 0 é a permissividade do vácuo do espaço livre. C f e S representam a capacitância da camada ferroelétrica e a área do eletrodo, respectivamente. A Figura 4b mostra o 1 / C linear tot versus d trama, o que sugere que o Al 2 O 3 camada torna-se um filme dielétrico altamente isolante em situação de não comutação ou pós-comutação. Pode-se deduzir que C f ≈ 14 pF e ε Al ≈ 7,9 da Eq. (3). Portanto, o fino interposto Al 2 O 3 camada é provado como um capacitor dielétrico. Durante a não comutação de FE, bem como após a comutação de FE, o Al 2 O 3 o interruptor do túnel fecha como um isolante.
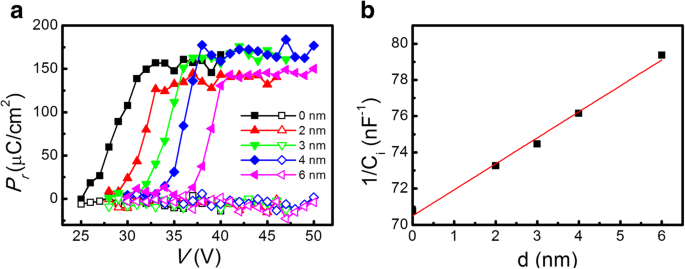
a A mudança ( P sw ) e sem comutação ( P nsw ) polarizações versus V com d aumentou de 0 para 6 nm sob pulsos no modo tipo I. b O Al 2 O 3 - espessura da camada d dependência de 1 / C tot medido por um analisador de impedância a 100 kHz
As Figuras 5 mostram os diagramas esquemáticos do Al 2 O 3 / Estrutura de bicamada LN comutada no modo tipo I ou tipo II. A Figura 5a esboça o circuito on-off equivalente dos resistores e capacitores em série para o Al 2 O 3 interruptor de túnel. No estado inicial, como mostrado na Fig. 5b, a orientação de polarização preferida é o estado de polarização para cima apontando para o eletrodo superior. O campo elétrico embutido induzido pelos eletrodos assimétricos direciona do eletrodo Au para o eletrodo Pt. Ao aplicar a tensão de polarização, ocorre a comutação FE. Entende-se que a tensão é aplicada inversamente proporcional à capacitância do circuito. Em Al 2 O 3 / Estrutura de bicamada LN, durante a comutação FE, a camada LN tem uma grande capacitância. Portanto, a maior parte da tensão externa aplicada se aplica ao Al 2 O 3 camada. Ultrathin Al 2 O 3 camada é injetada pela carga do eletrodo. Ele liga como um resistor quando a tensão aplicada excede o Al 2 O 3 limiar de tunelamento, conforme mostrado na Fig. 5c. Após a conclusão da comutação FE ou para o caso de uma situação de não comutação, a capacitância da camada LN é muito pequena e a tensão aplicada em Al 2 O 3 diminui mais baixo do que a tensão de limite de tunelamento. Neste momento, o Al 2 O 3 camada atua como um isolante e desliga, conforme mostrado na Fig. 5d.
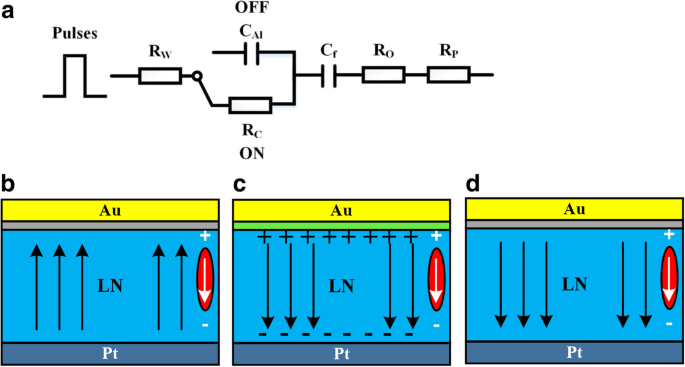
Diagramas esquemáticos do Al 2 O 3 / Estrutura de bicamada LN comutada em tipo I ou tipo II. a O esboço do circuito on-off equivalente dos resistores e capacitores em série para o Al 2 O 3 interruptor de túnel. b Orientação de polarização preferencial inicial e campo elétrico embutido; c O Al 2 O 3 interruptor de túnel ligado e comutação de domínio; d O Al 2 O 3 interruptor de túnel desligado e polarização mantida
A Figura 6 mostra as dependências do número de ciclos de polarizações trocadas em Al 2 O 3 / Estrutura de bicamada LN com a espessura de Al 2 O 3 variando de 0 a 6 nm no modo tipo I. A largura dos pulsos é de 1000 ns com uma periodicidade de 0,5 s. Pode ser visto claramente que a resistência à fadiga do Al 2 O 3 A estrutura da bicamada / LN é melhorada gradualmente com o aumento do Al 2 O 3 espessura com mais de 10 4 ciclos de estresse de pulso. A propriedade de fadiga no modo tipo II é semelhante ao resultado no modo tipo I, que foi mostrado no Arquivo Adicional 1:Figura S2 de informações de apoio. Infelizmente, a interrupção elétrica ocorreria facilmente no modo tipo II após longa tensão DC aplicada com cerca de 10 4 ciclos de estresse de pulso. Os dados podem ser ajustados usando o modelo para a coexistência do domínio-parede pinning e depinning dentro de cada ciclo, como mostrado pelas linhas contínuas na Fig. 6, onde a física da fadiga foi atribuída à injeção de carga por eletrodo [13]. Quando o Al 2 O 3 camada inserida entre o eletrodo Au e a camada LN, pode bloquear o caminho de carga de injeção pelo eletrodo e melhorar a resistência à fadiga. No entanto, na estrutura de duas camadas, algumas questões devem ser consideradas mais detalhadamente. Por exemplo, com o aumento da espessura de Al 2 O 3 de 0 a 6 nm, a tensão coercitiva aumentou de cerca de 25 para 34 V, que pode ser reduzida melhorando a qualidade do Al 2 O 3 camada. Na verdade, algumas camadas atômicas de Al 2 O 3 com alta qualidade ou menos defeito pode bloquear efetivamente as cargas injetadas pelos eletrodos, o que é confirmado em outro lugar, otimizando as condições de processamento de deposição da camada atômica (como temperatura e tempo) [25].
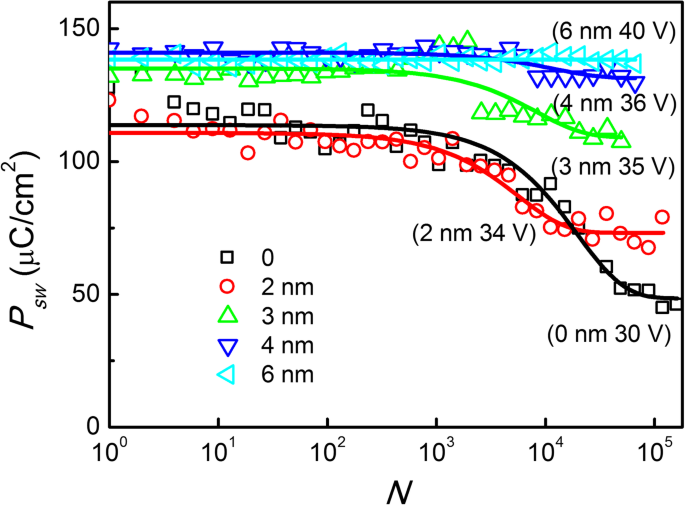
Dependências do número de ciclos de polarizações trocadas em Al 2 O 3 / Estrutura de bicamada LN com a espessura de Al 2 O 3 variando de 0 a 6 nm em mais de 10 4 ciclos de estresse de pulso. A largura dos pulsos é de 1000 ns na periodicidade de 0,5 s
Recentemente, memórias de parede de domínio ferroelétricas baseadas nas paredes de domínio carregadas condutoras apagáveis e a leitura elétrica não destrutiva dos estados de polarização foram propostas em nosso seguinte trabalho de pesquisa [26, 27]. Grande condutividade de paredes de domínio carregadas em cristais únicos de niobato de lítio é obtida após a troca de domínio [28, 29]. Portanto, os filmes mais finos de cristal único de niobato de lítio em substratos de silício são os materiais promissores para memórias de parede de domínio ferroelétricas integradas e suas propriedades de retenção e resistência à fadiga podem ser melhoradas pelo projeto de Al 2 O 3 / bicamada de niobato de lítio.
Conclusões
LiNbO 3 de duzentos nanômetros filmes de cristal único com 5% de dopagem de Mg foram preparados por corte iônico de camadas superficiais de cristais únicos LN em massa e, em seguida, o Al 2 ultrafino O 3 filmes com espessuras variando de 2 a 6 nm como camadas de switch de túnel foram depositados em filme LN dopado com Mg a 5% para formar estruturas de bicamada por deposição de camada atômica. O simetrizado P-V loops de histerese ao longo do eixo de tensão são observados sob tensões de pulso aplicadas no modo tipo II, que pode ser atribuído ao campo elétrico embutido induzido por eletrodos assimétricos em Au / LiNbO 3 / Pt e compensação do campo de impressão interno. A corrente de comutação de domínio ( I sw ) transientes e seus transferidos P-V os loops de histerese revelam que o Al 2 ultrafino O 3 camada funciona como um switch de túnel de ideia. Ele liga durante a comutação FE, mas fecha durante a não comutação ou após a comutação FE, minimizando a interferência adversa com a comutação FE. Além disso, a resistência à fadiga do capacitor FE é melhorada gradualmente com o aumento da espessura da camada de switch de túnel de 2 para 6 nm. O Al 2 O 3 A estrutura de bicamada / LN abre caminho para o projeto de dispositivos ferroelétricos robustos para aliviar o problema de fadiga por injeção de carga de eletrodo.
Abreviações
- ALD:
-
Deposição de camada atômica
- CMOS:
-
Semicondutor de óxido de metal complementar
- FE:
-
Ferroelétrico
- LN:
-
Niobato de lítio
- SEM:
-
Microscopia eletrônica de varredura
- XRD:
-
Difração de raios X
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Fabricação de Hierárquicas ZnO @ NiO Core – Shell Heteroestruturas para melhorar o desempenho fotocatalítico
- Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN
- Efeitos das variações de gravação na formação do canal Ge / Si e desempenho do dispositivo
- Desempenho analógico / RF do transistor de efeito de campo de túnel de fonte dupla com porta em forma de T
- Desempenho termoelétrico aprimorado de filmes finos epitaxiais com ba-dopagem biCuSeO orientados ao eixo c



