Investigação da banda de energia na camada atômica depositada em heterojunções AZO / β-Ga2O3 (\ (\ overline {2} 01 \))
Resumo
Os efeitos dopados com Al nos deslocamentos de banda de ZnO / β-Ga 2 O 3 interfaces são caracterizadas por espectroscopia de fotoelétrons de raios-X e calculadas por simulações de primeiro princípio. Os deslocamentos da banda de condução variam de 1,39 a 1,67 eV, os deslocamentos da banda de valência reduzem de 0,06 a - 0,42 eV, exibindo uma dependência quase linear em relação à razão de dopagem de Al variando de 0 a 10%. Consequentemente, um alinhamento de banda tipo I se forma na interface de ZnO / β-Ga 2 O 3 heterojunção e o AZO / β-Ga 2 O 3 interface tem um alinhamento de banda do tipo II. Isso ocorre porque a incorporação de Al no ZnO abriria as lacunas de banda devido à forte mistura de elétrons de Al e O, e as bordas da banda de condução e valência consequentemente se deslocam em direção ao nível inferior.
Histórico
Recentemente, um óxido semicondutor Ga 2 O 3 tem atraído interesses generalizados por causa de suas características únicas, como grande intervalo de banda, alta velocidade de saturação do elétron e resistência a alta temperatura [1]. Existem cinco tipos de isômeros para Ga 2 O 3 :α, β, γ, δ e ε, onde β-Ga 2 O 3 pode ser cultivado mais facilmente e tem sido amplamente estudado [2]. Em particular, β-Ga 2 O 3 tem um campo elétrico de colapso maior do que o de materiais semicondutores tradicionais de terceira geração, como SiC e GaN [3]. As propriedades condutoras do tipo n podem ser moduladas por dopagem Sn [4] ou Si [5]. Então, β-Ga 2 O 3 dispositivos baseados em [6, 7] têm amplas perspectivas de aplicação nas áreas de tecnologia da informação, conservação de energia e redução de emissões. No entanto, β-Ga 2 O 3 dispositivos baseados em tem uma limitação comum:o contato entre β-Ga 2 O 3 e a maioria dos metais tende a ser Schottky por causa da grande barreira induzida pelo largo bandgap e concentração finita de portadores. Nos últimos anos, inserindo um interlayer, como ITO [8] e AZO [9], entre Ga 2 O 3 e metais é mostrado ser um método válido para reduzir a barreira de energia entre β-Ga 2 O 3 e metal.
O óxido de zinco dopado com Al (ZnO) tem ganhado muita atenção devido à baixa resistividade e menor custo de fabricação do que o ITO [10]. Em particular, a alta estabilidade térmica, alta mobilidade e concentração de portadores tornam-no um candidato promissor da camada semicondutora intermediária (ISL) [11]. Até agora, filmes de ZnO dopados com Al podem ser cultivados através das seguintes técnicas:epitaxia de feixe molecular (MBE) [12], pulverização catódica de magnetron [13], deposição de vapor químico (CVD) [14] e deposição de camada atômica (ALD) [ 15]. Especialmente, ALD é um método renomado para preparar filme de nanoespessura que exibe grande uniformidade excelente de área e une taxa de crescimento por ciclo por causa da reação de superfície autolimitada incluindo a adsorção química autolimitada e reação sequencial autolimitante [16]. Além disso, ALD pode reduzir a desordem da interface e modular de forma mais precisa a concentração de dopagem de Al, alterando as razões dos ciclos de crescimento.
Observe que o deslocamento da banda de condução (CBO) determina a barreira de energia para o transporte de elétrons, portanto, um CBO menor é benéfico para formar um contato ôhmico. Com base em nosso trabalho anterior [17], ao aumentar a concentração de dopagem de Al, o filme de ZnO dopado com Al muda de policristalino para amorfo, e seu bandgap também aumenta. No entanto, os deslocamentos de banda de diferentes ZnO / β-Ga dopados com Al 2 O 3 as heterojunções não foram amplamente estudadas. Neste trabalho, os filmes de ZnO com diferentes razões de dopagem de Al foram respectivamente depositados em β-Ga 2 O 3 substratos por ALD. Os resultados mostram que o VBO e o CBO são quase linearmente dependentes da razão de dopagem de Al.
Métodos
Os substratos são bulk β-Ga 2 O 3 (\ (\ overline {2} 01 \)) e a concentração de doping é de cerca de 3 × 10 18 / cm 3 . O processo de limpeza para Ga 2 O 3 Os substratos foram submetidos à lavagem ultrassônica em acetona e isopropanol a cada 10 min com repetição três vezes. Posteriormente, o Ga 2 O 3 os substratos foram enxaguados com água desionizada. Posteriormente, os filmes de ZnO dopados com Al foram cultivados no Ga 2 O 3 substrato por ALD (Wuxi MNT Micro Nanotech Co., LTD, China). Três tipos de amostras foram preparadas. Em primeiro lugar, os filmes de ZnO não dopados foram cultivados por ALD com os precursores de Zn (C 2 H 5 ) 2 (DEZ) e H 2 O em 200 o C. Em segundo lugar, os filmes de ZnO dopados com Al foram realizados adicionando um pulso de trimetilalumínio (TMA) e H 2 O a cada 19º ciclo de DEZ e H 2 O pulsante (denotado como 5% de dopagem de Al) a uma temperatura de substrato de 200 o C durante ALD. Em terceiro lugar, os filmes de ZnO dopados com Al de proporção de 9:1 (denotados como dopagem com 10% de Al) também foram preparados. A taxa de crescimento de ZnO e Al 2 O 3 foi de 0,16 e 0,1 nm / ciclo, respectivamente. Cada tipo de filme incluía duas espessuras diferentes, ou seja, 40 nm e 10 nm para o filme espesso e fino, respectivamente. Além disso, o β-Ga 2 O 3 substrato foi usado para estudar o material a granel. Ga 2 p , Zn 2 p CLs, e a banda de valência máxima (VBM) foram medidos por espectroscopia de raios-X (XPS) (AXIS Ultra DLD, Shimadzu) e a etapa de resolução XPS espectros é de 0,05 eV. Para evitar a contaminação da superfície da amostra durante o processo de transferência da câmara ALD para XPS, o ataque de íon Ar foi realizado antes da medição XPS. Observe que o efeito de carga pode mudar o espectro XPS e o BE de C 1 s o pico é calibrado em 284,8 eV para resolver o problema.
Resultados e discussões
O deslocamento da banda de valência (VBO) de ZnO / β-Ga dopado com Al 2 O 3 heterojunção pode ser obtida por meio da seguinte fórmula [18]:
$$ \ Delta {E} _V =\ left ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} - {E} _ { \ mathrm {VBM}} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \ right) - \ left ({E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm { AZO}} - {E} _ {\ mathrm {VBM}} ^ {\ mathrm {AZO}} \ right) - \ left ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga }} _ 2 {\ mathrm {O}} _ 3} - {E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm {AZO}} \ right) $$ (1)
onde \ ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) se refere à energia de ligação (BE) de Ga 2 p nível do núcleo (CL) em massa β-Ga 2 O 3 , \ ({E} _ {\ mathrm {VBM}} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) refere-se ao BE de VBM em massa β-Ga 2 O 3 , \ ({E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm {AZO}} \) refere-se ao BE de Zn 2 p CL em filmes espessos de ZnO dopados com Al, \ ({E} _ {\ mathrm {VBM}} ^ {\ mathrm {AZO}} \) refere-se ao BE de VBM em filmes espessos de ZnO dopados com Al. O último \ ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) e \ ({E} _ {\ mathrm {Zn } \ 2p} ^ {\ mathrm {AZO}} \) referem-se ao BE de Ga 2 p e Zn 2 p CLs em filmes finos de ZnO dopados com Al, respectivamente.
Posteriormente, com base no E g e ∆E V , o CBO no ZnO / β-Ga dopado com Al 2 O 3 interface pode ser calculada pela seguinte equação:
$$ \ Delta {E} _C ={E} _g ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} - {E} _g ^ {\ mathrm {AZO}} - \ Delta {E } _V $$ (2)
onde \ ({E} _g ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) é o bandgap de Ga 2 O 3 e \ ({E} _g ^ {\ mathrm {AZO}} \) é o bandgap do ZnO dopado com Al. Os bandgaps para ZnO não dopado, 5% dopado com Al, ZnO dopado com 10% Al e β-Ga 2 O 3 são 3,20 eV, 3,25 eV, 3,40 eV e 4,65 eV, respectivamente [17, 19]. O bandgap aumenta com uma razão de dopagem de Al mais alta, concordando bem com a simulação na próxima parte.
A Figura 1 mostra os CLs e VBM dos elementos Ga e Zn de β-Ga 2 O 3 , filmes de ZnO dopados com 5% e 10% de Al, espessos não dopados e. Ajustando a área linear e a zona de banda plana do espectro VBM pode-se deduzir o VBM [20]. A Figura 2 mostra Ga 2 p e Zn 2 p CL de vários ZnO / β-Ga dopados com Al fino 2 O 3 heterojunções. As diferenças de BE de Ga 2 p e Zn 2 p CLs para o ZnO / β-Ga não dopado, 5% dopado com Al 2 O 3 e 10% de ZnO / β-Ga dopado com Al 2 O 3 são obtidos como sendo 96,12 eV, 96,16 eV e 95,94 eV, respectivamente. Em seguida, os VBOs nas interfaces são determinados como 1,39 eV, 1,52 eV e 1,67 eV para o ZnO / β-Ga não dopado e 5% dopado com Al 2 O 3 e 10% de ZnO / β-Ga dopado com Al 2 O 3 amostras, respectivamente.
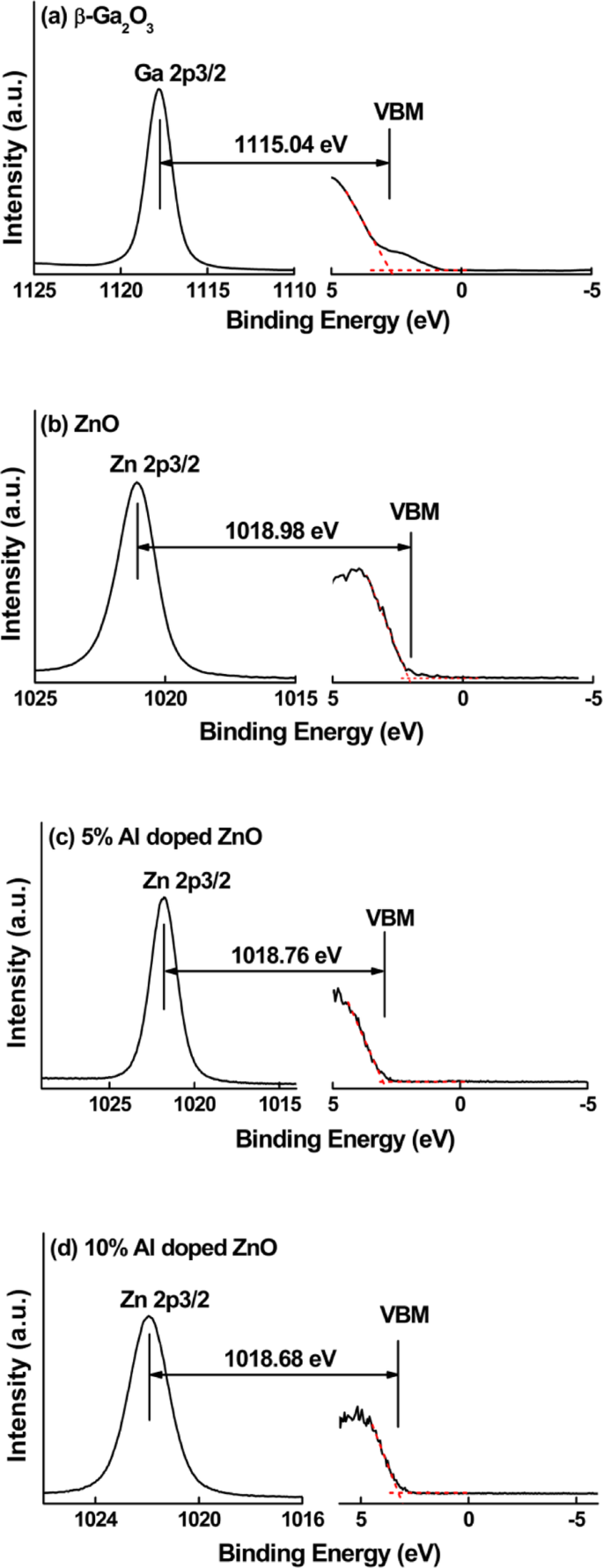
Espectros XPS de alta resolução para nível de núcleo e banda de valência máxima (VBM) de a Ga 2 p espectro de nível central e VBM de β-Ga 2 nua O 3 , b Zn 2 p espectro de nível central e VBM de ZnO / β-Ga puro e espesso 2 O 3 , c Zn 2 p espectro de nível de núcleo e VBM de ZnO / β-Ga 5% dopado com Al 2 espesso O 3 , e d Zn 2 p espectro de nível de núcleo e VBM de ZnO / β-Ga dopado com 10% de Al espessura 2 O 3

Os espectros do nível do núcleo de Ga 2 p e Zn 2 p obtido a partir de espectros XPS de alta resolução de a thin ZnO / β-Ga 2 O 3 , b fino 5% de ZnO / β-Ga dopado com Al 2 O 3 , e c ZnO / β-Ga dopado com 10% de Al fino 2 O 3
O alinhamento sistemático da banda para 0%, 5% e 10% de ZnO / β-Ga dopado com Al 2 O 3 as heterojunções são calculadas pelas equações acima, conforme mostrado na Fig. 3. O deslocamento da banda de ZnO / β-Ga não dopado 2 O 3 a heterojunção pertence ao tipo I. Enquanto 5% e 10% de ZnO / β-Ga dopado com Al 2 O 3 as heterojunções têm deslocamentos de banda do tipo II. A Figura 4 representa os alinhamentos de banda de ZnO / β-Ga dopado com Al 2 O 3 interfaces têm uma relação linear semelhante com a concentração de dopagem de Al. O CBO varia de 1,39 a 1,67 eV com a concentração dopada com Al aumentando de 0 a 10%. Enquanto o VBO reduz de 0,06 para - 0,42 eV com a concentração de Al-dopado aumentando de 0 a 10%. Observa-se que o CBO e VBO para AZO / β-Ga pulverizado 2 O 3 são 0,79 eV e 0,61 eV, respectivamente [9]. As bandas de condução e valência deslocam-se para baixo neste trabalho, o que pode ser devido às diferentes proporções de composição e estrutura cristalina introduzidas pelos métodos de depósito.

Diagrama esquemático de alinhamento de banda de a ZnO / β-Ga puro 2 O 3 , b 5% de ZnO / β-Ga dopado com Al 2 O 3 , e c 10% de ZnO / β-Ga dopado com Al 2 O 3

Os deslocamentos da banda de condução e valência de AZO / β-Ga depositado na camada atômica 2 O 3 heterojunções fabricadas em diferentes razões de dopagem de Al
Fora isso, as simulações do primeiro princípio foram realizadas pelo Vienna Ab-initio Simulation Package (VASP) [21,22,23,24] para investigar a estrutura da banda eletrônica e o alinhamento da banda de ZnO / Ga 2 dopado com Al O 3 heterojunções. Durante o cálculo, as interações elétron-íon foram tratadas pelos pseudo-potenciais ultramacios, e as funções de onda e potenciais foram expandidos pela base da onda plana [25]. Além disso, a aproximação de gradiente generalizado (GGA) proposta por Perdew, Burke e Ernzerhof (PBE) foi implementada para descrever as energias de correlação de troca [26]. Antes de iniciar a simulação, testes convergentes foram realizados. Ele mostrou que a energia de corte de 450 eV para a base de onda plana e grades de espaço k de 3 × 3 × 3 com o esquema Monkhorst Pack deu os resultados bem convergentes. Na otimização da estrutura, um método de gradiente conjugado foi usado e a força residual foi liberada até que fosse inferior a 0,01 eV / Å. Além disso, as funções de densidade híbrida com base na aproximação PBE semi-local foram implementadas. Para corrigir o bandgap subestimado, 35% da troca de PBE foi substituída pela exata [27]. Para identificar o deslocamento da borda da banda com a mudança do nível de dopagem de Al, o potencial eletrostático médio (AEP) foi calculado e alinhado ao nível de vácuo que foi dimensionado para 0 V. O VBM e o mínimo da banda de condução (CBM) foram consequentemente alinhados a o AEP baseado no diagrama de bandas [28]. Neste trabalho, ZnO bulk com 16 átomos de O e 16 átomos de Zn na supercélula foi usado. Para introduzir o dopagem com Al, um ou dois átomos de Zn na supercélula foram substituídos pelos átomos de Al, criando a estrutura dopada com Al com concentração de dopagem de 3,21% e 6,25%, respectivamente.
A Figura 5 a – c mostra os diagramas de banda calculados das estruturas de ZnO dopado com 3,21% e dopado com Al 3,21% e ZnO com 6,25% com Al, respectivamente. Isso mostra claramente que ZnO é um semicondutor de bandgap direto com bandgap de 3,42 eV, e tanto o CBM quanto o VBM estavam localizados no ponto Γ da zona de Brillouin. Esses resultados de simulação teórica correspondem muito bem ao valor experimental [29]. Com o doping com Al, pôde-se constatar que os níveis de Fermi se deslocaram para cima na banda de condução, que converte o ZnO puro em um semicondutor do tipo n. Nesse ínterim, os bandgaps também aumentaram para 4,83 eV e 5,42 eV para 3,21% de ZnO dopado com Al e 6,25% de ZnO dopado com Al, respectivamente. Embora os bandgaps aqui para o ZnO dopado sejam maiores do que nossos resultados experimentais; no entanto, isso pode ser atribuído à negligência dos estados de defeito interfacial, bem como de outros defeitos de cristal.
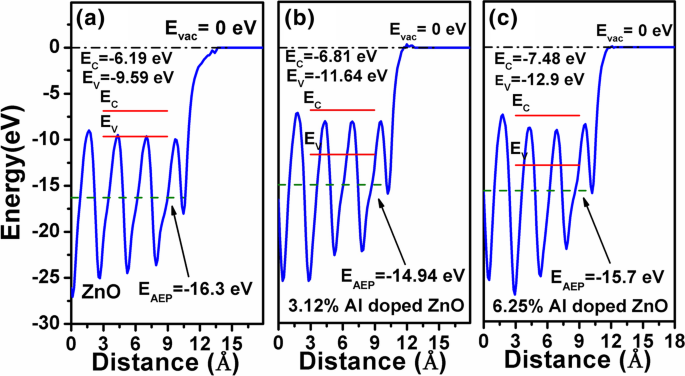
O diagrama de banda calculado de a ZnO não dopado, b 3,21% de ZnO dopado com Al e c 6,25% de estrutura de ZnO dopada com Al. Os níveis de Fermi foram definidos para 0 eV
A Figura 6 a – c apresenta os alinhamentos das bandas de ZnO não dopado, 3,21% dopado com Al e ZnO dopado com 6,25% com Al ao nível de vácuo. Para as bandas de condução dos materiais, devido à forte mistura de elétrons entre o elemento Al e O, pode-se verificar que o nível de energia diminui de - 6,19 eV do ZnO para - 6,81 eV para o ZnO dopado com 3,21% de Al ( Δ E =0,62 eV) e ainda diminui para - 7,48 eV para o ZnO dopado com Al 6,25% ( ΔE =1,29 eV). Nesse ínterim, devido à abertura do bandgap, também pode ser verificado que a borda da banda de valência se move para baixo de - 9,59 eV para o ZnO para - 11,64 eV para 3,21% de ZnO dopado com Al ( ΔE =2,05 eV) e - 12,9 eV para o ZnO dopado com 6,25% de Al ( ΔE =3,31 eV). Ao todo, atribuído à forte mistura de elétrons Al e O, poderia ser entendido que incorporar Al no ZnO abriria as lacunas de banda. Além disso, mudaria tanto a banda de condução quanto a borda da banda de valência em direção ao nível de energia inferior quando alinhada com o nível de vácuo.
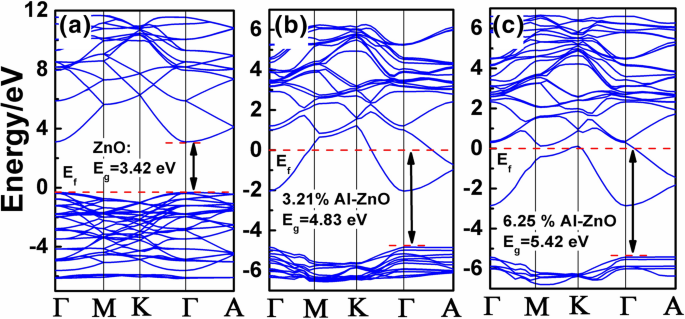
O alinhamento da banda de AZO / β-Ga 2 O 3 heterojunções com a não dopado, b 3,21% e c 6,25% de ZnO dopado com Al. Os níveis de vácuo foram escalados para 0 eV
Conclusões
Em conclusão, os alinhamentos de banda de diferentes ZnO / β-Ga dopados com Al 2 O 3 (\ (\ overline {2} \) 01) interfaces foram investigadas pelo XPS. Um alinhamento de banda tipo I se forma na interface de ZnO / β-Ga 2 O 3 heterojunção. Enquanto o AZO / β-Ga 2 O 3 interface tem um alinhamento de banda do tipo II. Os CBOs variam de 1,39 a 1,67 eV e os VBOs reduzem de 0,06 a - 0,42 eV com a concentração de Al-dopado aumentando de 0 a 10%. Além disso, os cálculos da função de densidade mostram que os deslocamentos de banda mudam devido à forte mistura de elétrons de Al e O quando o Al é incorporado ao ZnO. Esses resultados sugerem que o ZnO puro é um ISL válido para reduzir a altura da barreira e promover o transporte de elétrons.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste manuscrito estão incluídos no manuscrito.
Abreviações
- AEP:
-
Potencial eletrostático médio
- ALD:
-
Deposição de camada atômica
- BE:
-
Energia de ligação
- CBM:
-
Banda de condução mínima
- CBO:
-
Deslocamento da banda de condução
- CL:
-
Nivel CENTRAL
- CLs:
-
Níveis principais
- CVD:
-
Deposição de vapor químico
- DEZ:
-
Zn (C 2 H 5 ) 2
- Ga 2 O 3 :
-
Óxido de gálio
- GaN:
-
Nitreto de gálio
- GGA:
-
Aproximação de gradiente generalizado
- ISL:
-
Camada semicondutora intermediária
- PBE:
-
Perdew, Burke e Ernzerhof
- SiC:
-
Carboneto de silício
- TMA:
-
Trimetilalumínio
- VASP:
-
Pacote de simulação Ab initio de Viena
- VBM:
-
Banda de valência máxima
- VBO:
-
Deslocamento da banda de valência
- XPS:
-
Espectroscopia de raios X
- ZnO:
-
Óxido de zinco
Nanomateriais
- Teoria da banda dos sólidos
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Uma investigação em uma célula solar de silício cristalino com camada de silício preta na parte traseira
- Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN
- Investigação da banda de energia em ZnO / β-Ga2O3 depositado na camada atômica (\ (\ overline {2} 01 \)) Heterojunções
- Investigação da Faixa de Energia nas Heterojunções de Bissulfeto de Molibdênio e ZrO2
- Deposição de camada atômica aprimorada com plasma de baixa temperatura de SiO2 usando dióxido de carbono



