Efeito Lateral Fotovoltaico Grande em Heterojunção MoS2 / GaAs
Resumo
Bissulfeto de molibdênio (MoS 2 ) filmes em nanoescala são depositados em substratos de GaAs por meio da técnica de pulverização catódica de magnetron e MoS 2 Heterojunções / GaAs são fabricadas. O efeito fotovoltaico lateral (LPE) do MoS fabricado 2 / As heterojunções de GaAs são investigadas. Os resultados mostram que um grande LPE pode ser obtido no MoS 2 / n Heterojunção -GaAs. O LPE exibe uma dependência linear da posição da iluminação do laser e a sensibilidade consideravelmente alta de 416,4 mV mm - 1 . Esta sensibilidade é muito maior do que os valores em outro MoS relatado 2 dispositivos baseados em Comparativamente, o LPE no MoS 2 / p -A heterojunção GaAs é muito mais fraca. Os mecanismos para o LPE são revelados pela construção do alinhamento da banda de energia do MoS 2 / Heterojunções GaAs. As excelentes características do LPE tornam o MoS 2 filmes combinados com semicondutores de GaAs candidatos promissores para a aplicação de detectores sensíveis à posição de alto desempenho.
Histórico
Devido às suas excelentes propriedades, dissulfeto de molibdênio (MoS 2 ) está sendo investigado como um tipo típico de materiais bidimensionais para desenvolver dispositivos microeletrônicos de próxima geração e dispositivos optoeletrônicos [1,2,3,4,5]. Ao contrário do grafeno, MoS 2 tem óbvio intervalo de banda e seu intervalo diminui com o aumento do número de camadas [6]. A presença do gap óbvio permite a fabricação do MoS 2 transistores com uma relação liga / desliga superior a 10 8 e os fotodetectores com alta responsividade [7, 8]. Recentemente, MoS 2 combinado com outros semicondutores tem atraído muito interesse, como GaAs, Si e GaN [9,10,11,12,13]. Estas heteroestruturas projetadas fornecem rota técnica viável para MoS 2 com base em materiais para desenvolver dispositivos optoeletrônicos aplicáveis na prática. Entre todos esses semicondutores em massa, GaAs tem um gap direto adequado de ~ 1,42 eV e alta mobilidade de elétrons (~ 8000 cm 2 V −1 s −1 ) Lin et al. MoS fabricado 2 / Células solares GaAs com eficiência de conversão de energia acima de 9,03% [9]. Além disso, Xu et al. relatou um MoS 2 / Fotodetector autopropulsado de GaAs com detectividade extremamente alta de 3,5 × 10 13 Jones [10]. Em relatórios anteriores, os estudos sobre MoS 2 / As heteroestruturas de GaAs têm se concentrado principalmente na aplicação na área de células solares e fotodetectores. No entanto, o MoS 2 / GaAs como um detector sensível à posição (PSD) com base no efeito fotovoltaico lateral (LPE) foi relatado raramente. Diferente do efeito fotovoltaico longitudinal comum, o LPE origina-se da difusão lateral e recombinação das portadoras geradas por fótons na camada de inversão da interface [14,15,16,17,18]. No efeito LPE, uma fotovoltagem lateral (LPV) pode ser obtida e ela muda linearmente com a posição do ponto de laser na região ativa da superfície do dispositivo. Essas características tornam o LPE muito útil no desenvolvimento de PSDs de alto desempenho e têm sido amplamente estudadas na área de robótica, aplicações biomédicas, controle de processos, sistemas de informação de posição e assim por diante.
Neste trabalho, MoS 2 filmes finos com diferentes espessuras são depositados na superfície de n - / p Substratos -GaAs via técnica de pulverização catódica de magnetron. Um grande LPE é observado no MoS fabricado 2 / n -GaAs heterojunção, e a sensibilidade atingiu 416,4 mV mm −1 . Nossos resultados mostram ainda que o LPE exibe uma dependência óbvia dos tipos de portadores dos substratos de GaAs e da espessura do MoS 2 filmes. Através da construção do alinhamento da banda de energia na interface, são propostos os mecanismos para o LPE nos dispositivos.
Métodos
MoS 2 filmes finos foram depositados em substratos de GaAs orientados para (100) usando a técnica de pulverização catódica de magnetron DC. O MoS 2 pós (pureza, ~ 99%) foram prensados a frio em um disco sob a pressão de 20,0 MPa. O disco fabricado (Φ60,0 mm × 4,5 mm) foi usado como o alvo durante a pulverização catódica. O n- / p Substratos -GaAs foram usados em nossos experimentos, respectivamente. Antes da deposição, os substratos foram limpos por ultrassom em sequência com álcool, acetona e água desionizada. Posteriormente, MoS 2 filmes finos com diferentes espessuras ( d MoS2 =~ 10, 30, 50, 90 nm) foram cultivados nos substratos de GaAs à temperatura de 400 ° C, respectivamente. Durante a deposição, a pressão e a potência de trabalho foram mantidas em 1,0 Pa e 10,0 W, respectivamente. Como referência, MoS 2 filmes finos também foram depositados em GaAs intrínseco ( i -GaAs) substratos nas mesmas condições. Finalmente, cerca de 300 μm In pads com um diâmetro de 0,5 mm conforme os eletrodos foram pressionados no MoS 2 filme.
O MoS 2 os filmes foram caracterizados por espectroscopia Raman (HORIBA, HR800) com comprimento de onda de excitação de 488 nm. A superfície da amostra foi digitalizada por um microscópio de força atômica (AFM). A espectroscopia de fotoemissão de raios-X (XPS) foi realizada por um espectrômetro Kratos Axis ULTRA com uma fonte monocromática de raios-X Al Kα. A taxa de deposição foi obtida pela espessura do microscópio eletrônico de varredura transversal (MEV) (Arquivo adicional 1:Figura S1) e o tempo de deposição, então cada espessura de filme foi determinada pela taxa de deposição e cada tempo de deposição. Os espectros de transmissão foram medidos por espectrofotômetro Shimadzu UV-3150. A espectroscopia de fotoelétrons ultravioleta (UPS) foi realizada usando uma lâmpada de descarga de gás He-I não filtrada (21,22 eV). Os LPVs foram medidos usando um voltímetro Keithley 2000 e um estágio motorizado elétrico tridimensional com um laser de comprimento de onda de 650 nm como fonte de iluminação. A corrente-tensão ( I - V ) as curvas foram medidas com um Keithley 2400 SourceMeter.
Resultados e discussão
A Figura 1 mostra o espectro Raman do MoS 2 filme no substrato GaAs. Além do pico do substrato GaAs em ~ 287,1 cm −1 , dois MoS característicos 2 Picos Raman podem ser vistos, o A 1g modo a ∼ 406,7 cm −1 e E 1 2g modo a ∼ 378,9 cm −1 . As duas inserções à direita mostram a ilustração da vibração atômica no MoS 2 . O A 1g modo corresponde aos átomos de S oscilando em antifase ao longo da direção fora do plano, e o E 1 2g modo corresponde aos átomos de S e Mo oscilando em antifase paralelo ao plano do cristal. Conforme mostrado na figura, o pico Raman correspondente ao A 1g modo é preferencialmente animado para o filme. De acordo com nossas medições, a relação de intensidade de A 1g / E 1 2g é cerca de 2,1. Essas características Raman são semelhantes a outros resultados relatados sobre MoS 2 filmes finos [19]. A inserção à esquerda mostra uma imagem topográfica AFM do MoS de 40 nm 2 filme crescido no substrato GaAs. Pela figura, podemos ver que a superfície do filme é composta por densos grãos em forma de cone. De acordo com as medições, a rugosidade quadrada média (RMS) do filme é de cerca de 1,7 nm, e o tamanho médio dos grãos é de cerca de 76,3 nm de diâmetro. Esses grãos na superfície podem diminuir a reflexão da superfície para a luz externa e aumentar a absorção de luz do dispositivo fabricado.

Espectro Raman do MoS 2 filme sobre GaAs. As duas inserções da direita mostram as ilustrações esquemáticas do modo oscilante de E 1 2g e A 1g , respectivamente. Código de cor do átomo:azul-esverdeado claro, Mo; amarelo, S. A inserção à esquerda mostra a imagem da morfologia da superfície do MoS conforme crescido 2 filmes
A Figura 2 mostra os espectros XPS do MoS 2 filme. Conforme mostrado na Fig. 2a, os picos em 229,3 e 232,5 eV estão relacionados ao Mo 3d 5/2 e Mo 3d 3/2 orbitais, respectivamente. Conforme mostrado na Fig. 2b, S 2p 3/2 e S 2p 1/2 orbitais de íons sulfeto divalentes (S 2− ) são observados em 162,2 e 163,3 eV, respectivamente. Os resultados estão de acordo com os valores relatados para o MoS 2 cristal [17, 18].

Espectros XPS do MoS 2 filme para a Mo e b Elementos S, respectivamente
A Figura 3a mostra o I longitudinal - V curva do MoS fabricado 2 / n Heterojunções -GaAs. Dois eletrodos In com o diâmetro de cerca de 0,5 mm foram pressionados na superfície do MoS 2 filme e a parte traseira do GaAs, respectivamente. A inserção mostra o circuito esquemático para as medições longitudinais. A tensão direta é definida como uma tensão de polarização positiva aplicada no eletrodo In superior. Conforme mostrado na figura, o MoS fabricado 2 / n Heterojunção -GaAs mostra um comportamento retificador óbvio. A proporção de retificação ( I + / eu - ) medido a ± 1,0 V é cerca de 520. Em nossos experimentos, ambos In / MoS 2 e In / GaAs pertencem a contatos ôhmicos e seus I - V curvas são quase lineares. Assim, a retificadora eu - V característica na heterojunção é principalmente originada do MoS 2 / GaAs contato. A Figura 3b mostra o I transversal - V curva do MoS fabricado 2 / n Heterojunções -GaAs. Dois eletrodos In com o diâmetro de cerca de 0,5 mm foram pressionados na superfície do MoS 2 filme. A inserção superior mostra o circuito esquemático para as medições transversais. Pela figura, o eu - V a curva mostra um aumento ligeiramente não linear das correntes com o aumento das tensões. Isso indica que uma camada de inversão no MoS 2 / n A interface -GaAs é formada [18]. A inserção inferior mostra o I - V curvas do único MoS 2 filmes no substrato GaAs intrínseco. Pela figura, um quase linear I - V curva pode ser vista, indicando ainda a natureza ôhmica do In / MoS 2 contato. Na tensão de + 0,5 V, a corrente do único MoS 2 é cerca de 3,1 × 10 −2 μA, muito menor do que o valor no MoS 2 / n -GaAs, cerca de 2,3 μA. Assim, em comparação com o MoS 2 filme, a camada de inversão no MoS 2 / n A interface -GaAs fornece um caminho com uma resistividade muito menor para o transporte da portadora durante as medições transversais do MoS 2 / n Heterojunção -GaAs.

a Longitudinal I - V curva do MoS fabricado 2 / n Heterojunções -GaAs. A inserção mostra o circuito esquemático para as medições longitudinais. b Transversal I - V curvas do MoS fabricado 2 / n Heterojunções -GaAs. A inserção superior mostra o circuito esquemático para as medições transversais. A inserção inferior mostra o I - V curvas do MoS 2 filmes no substrato GaAs intrínseco
A Figura 4a mostra o circuito esquemático para a medição do LPE do MoS fabricado 2 / Heterojunção GaAs. Dois eletrodos In com o diâmetro de 0,5 mm são pressionados na superfície do MoS 2 filme para realizar as medições do LPE. A distância (2 L ) entre os eletrodos é de ~ 1,0 mm. Durante nossas medições, os eletrodos A e B foram conectados às pontas de prova positiva e negativa de um voltímetro Keithley 2000, respectivamente. A Figura 4b mostra as curvas LPE do MoS 2 / n -GaAs e MoS 2 / p Heterojunções -GaAs, respectivamente. A espessura do MoS 2 filmes é de ~ 30,0 nm. Quando a superfície do MoS 2 filme é parcialmente iluminado por um ponto de laser com o diâmetro de cerca de 0,1 mm, um grande LPE pode ser observado no MoS 2 / n Heterojunção -GaAs. Conforme mostrado na figura, o LPE mostra uma dependência aproximadamente linear da posição do ponto do laser quando o ponto do laser se move entre os eletrodos A e B no MoS 2 superfície. Pela figura, podemos ver que o LPV depende da posição do ponto do laser. Isso pode ser encaixado com a teoria da difusão [16],
$$ \ mathrm {LPV} ={K} _0 \ Big [\ exp \ left (- \ frac {\ left | Lx \ right |} {d} \ right) - \ exp \ left (- \ frac {\ left | L + x \ right |} {d} \ right) $$
onde K 0 , 2 L , d e x representam um coeficiente de proporcionalidade, a distância entre dois eletrodos, o comprimento de difusão do portador e a posição do ponto de laser, respectivamente. Os resultados bem ajustados na figura sugerem claramente que o LPE no MoS 2 / n A heterojunção -GaAs surge do fluxo difuso lateral e da recombinação dos portadores excitados longe da posição do laser. Conforme mostrado na figura, o valor do LPV é zero quando o ponto de luz está no centro entre dois eletrodos, o que pode ser atribuído à simetria de difusão dos portadores. Quando a posição da luz está próxima ao eletrodo A, o LPV é positivo e vice-versa. Isso indica que o LPE no MoS 2 / n -A heterojunção GaAs é causada pelos portadores fotoexcitados do tipo orifício. O LPV máximo é obtido quando a iluminação do laser está mais próxima dos eletrodos. De acordo com nossas medições, a fotovoltagem lateral máxima (LPV max ) é de cerca de 208,2 mV na região linear do MoS 2 / n Heterojunção -GaAs. Comparativamente, o LPV do MoS 2 / p -A heterojunção GaAs é muito menor e seu LPV max é de apenas 7,3 mV, conforme mostrado na figura. Na figura, podemos ver que o LPE do MoS 2 / p -A heterojunção GaAs é determinada pelos portadores fotoexcitados do tipo elétron. Além disso, as características não lineares LPE do MoS 2 / p -A heterojunção GaAs pode ser vista na figura quando o ponto de laser se move entre os eletrodos A e B.
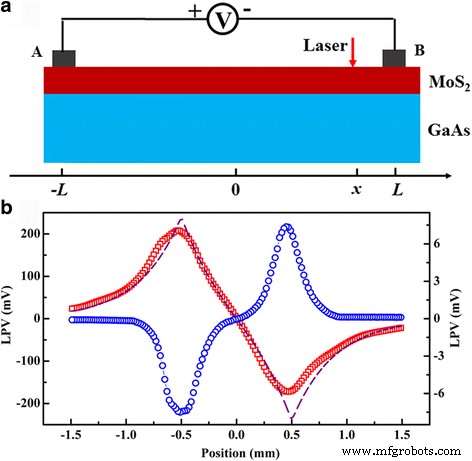
a Circuito esquemático para a medição do LPE. b Curvas LPE do MoS 2 / n -GaAs e MoS 2 / p Heterojunções -GaAs, respectivamente
A Figura 5 mostra a sensibilidade LPE do MoS 2 / n -Heterojunção GaAs em função da potência do laser e da espessura ( d MoS2 ) do MoS 2 filme. A sensibilidade é definida por S =LPV máximo / L . Obviamente, o S aumenta drasticamente com o aumento da potência do laser inicialmente, mas depois satura lentamente quando a potência aumenta ainda mais. Esta saturação pode ser causada pelo rápido aumento da taxa de recombinação dos orifícios fotoexcitados com o aumento da intensidade do laser na região iluminada [20]. Conforme mostrado na figura, um LPE óbvio e uma alta sensibilidade podem ser obtidos mesmo sob a iluminação de laser fraca de 100,0 μW. A partir da figura, uma dependência significativa da sensibilidade na espessura do MoS 2 filmes podem ser vistos. Quando d MoS2 =~ 10,0 nm, S =165,4 mV mm −1 sob a iluminação do laser de 100,0 μW. Com o aumento da espessura do filme, S aumenta gradualmente. Quando d MoS2 =30,0 nm, S atinge 416,4 mV mm −1 . Esta sensibilidade é muito maior do que o MoS relatado 2 Dispositivos / Si [17, 18]. Depois de d MoS2 > 30,0 nm, S diminui com o aumento do MoS 2 grossura. Quando d MoS2 =90,0 nm, S = 283,3 mV mm −1 . Assim, para obter o maior LPE e sensibilidade, há uma espessura ótima do MoS 2 filme no MoS fabricado 2 / n -GaAs, cerca de 30,0 nm.

Dependência de sensibilidades positivas e negativas do MoS fabricado 2 / n -Heterojunção GaAs em potências de laser, respectivamente
A Figura 6a apresenta os espectros UPS do MoS 2 filme no substrato de Si. A função de trabalho ( W ) do filme pode ser calculado a partir da diferença entre o corte da energia de ligação mais alta e a energia do fóton da radiação de excitação. Da figura, W =5,24 eV pode ser obtido. A distância (∆ E ) entre a banda de valência ( E V ) e o nível de Fermi ( E F ) do MoS 2 o filme pode ser extraído da energia inicial, conforme mostrado na inserção. O ∆ E para o MoS 2 o filme tem cerca de 0,51 eV. Usando os dados do espectro de transmitância do MoS 2 filme em substrato de quartzo, ( αhν ) 2 é traçado como uma função da energia do fóton hν , em que h é a constante de Planck e ν é a frequência do fóton. O α é o coeficiente de absorção, calculado por αd =ln (1 / T ) [21], em que d e T são a espessura e a transmitância do filme, respectivamente. O gap de banda ( E g ) do filme pode ser determinado a partir da interceptação da linha no hν eixo, E g =1,54 eV, conforme mostrado na Fig. 6b. Com base nesses parâmetros de banda de energia, o p -tipo de comportamento do MoS 2 o filme pode ser determinado, o que pode ser comprovado por medições de Hall. Os resultados de Hall mostram que a concentração do portador do tipo buraco e a mobilidade são cerca de 3,8 × 10 15 cm −3 e 11,2 cm 2 V −1 s −1 , respectivamente.

a Espectros UPS do MoS 2 filme sobre GaAs, mostrando o nível de Fermi dos filmes e a distância entre o nível de Fermi e a borda superior da banda de condução. b ( αhν ) 2 ~ hν curva do espectro de UV do MoS 2 filme no substrato de quartzo sob a mesma condição de deposição
A fim de esclarecer os mecanismos do LPE no MoS 2 / Heterojunções GaAs, os diagramas de banda de energia na interface são construídos com base nos resultados da Fig. 6. Aqui, E g =1,42 eV e E F =4,17 eV para n -GaAs são levados em consideração para construir a estrutura de bandas [22]. Quando o MoS 2 filme é depositado no substrato GaAs, os elétrons fluem do GaAs para o MoS 2 filme na interface devido ao maior E F do GaAs. O processo de fluxo para quando os níveis de Fermi são iguais e o MoS 2 / GaAs p - n a junção é fabricada, conforme mostrado na Fig. 7a. Consequentemente, um campo embutido ( E bi ) é formado na interface do MoS 2 / Heterojunção GaAs. E bi =[ E F ( n -GaAs) - E F (MoS 2 )] / e =1,07 V e aponta do GaAs para o MoS 2 filme. Assim, o longitudinal assimétrico I - V a curva é mostrada na Fig. 3a. Devido à existência de um forte E bi , grandes quantidades de portadores do tipo orifício são acumulados perto da interface e uma camada de inversão é formada no n Substrato -GaAs perto da interface, como mostrado na Fig. 7b. Semelhante ao gás de furo bidimensional (2DHG) [23], a camada de inversão pode exibir a característica de alta condução devido à alta concentração de folha dos furos ( p + ) Na Fig. 3b, podemos ver que a condução da camada de inversão é muito maior do que o MoS 2 filme. Assim, a condução entre dois eletrodos do mesmo lado do MoS 2 o filme é dominado pela camada de inversão em vez do MoS 2 filme. Quando a junção é parcialmente iluminada pelo laser, a luz é absorvida e os pares elétron-buraco no MoS 2 filme e GaAs podem ser induzidos, respectivamente, como mostrado na Fig. 7c. No entanto, pode-se esperar que a maior parte do laser seja absorvida pelos substratos de GaAs devido à sua espessura muito maior e menor gap. Sob a iluminação do laser, os pares elétron-buraco só podem ser excitados na região iluminada e separados espacialmente pelo E bi . Devido à orientação do E bi apontando de GaAs para MoS 2 , os orifícios fotoexcitados fluem em direção à interface e entram na camada de inversão no GaAs, como mostrado na Fig. 7c. Os orifícios fotoexcitados na camada de inversão se difundem lateralmente longe do ponto iluminado para os dois eletrodos. A concentração dos orifícios excitados coletados pelos dois eletrodos é diferente para diferentes distâncias do ponto iluminado. Assim, um grande LPV é formado entre os eletrodos, e o LPE é observado na heterojunção. Isso está de acordo com os resultados ajustados da Fig. 3b, e o LPE no MoS2 / n As heterojunções -GaAs originam-se principalmente da difusão do portador. Quando o MoS 2 o filme é depositado no p Substrato -GaAs, um p - p heterojunção é formada, como mostrado na Fig. 7d. E F ( p -GaAs) =5,32 eV é usado no diagrama de banda [22]. O E bi do p - p heterojunção pode ser calculada, 0,08 V, e seus pontos de direção do filme para o substrato. Devido ao E bi , portadores do tipo de elétron são acumulados perto da interface da heterojunção e a camada de inversão é formada. Assim, o LPE induzido pela difusão dos elétrons fotoexcitados é obtido no MoS 2 / GaAs p - p heterojunção, como mostrado na Fig. 4. No entanto, a concentração da portadora acumulada na camada de inversão pode ser menor devido ao fraco V bi de apenas 0,08 V no p - p heterojunção em comparação com p -MoS 2 / n Junção -GaAs. Isso aumenta as dificuldades de transporte dos elétrons fotoexcitados na camada de inversão. Sério, as barreiras Schottky podem ser formadas entre o n camada de inversão de tipo e p -MoS 2 filme, como mostrado na Fig. 7e. Essas características do p -MoS 2 / p A junção -GaAs suprime a coleção de elétrons fotoexcitados nos eletrodos. Como resultado, o LPE poderia ser amplamente reduzido. Conforme mostrado na Fig. 4b, o LPV max para o p - p junção é de apenas 7,3 mV enquanto atinge 208,2 mV no p - n junção.

a Alinhamento da banda de energia do MoS 2 / n -GaAs heterojunção e b a ilustração correspondente do contato elétrico na interface. c Mecanismo do LPE no MoS 2 / n Heterojunção -GaAs. d Alinhamento da banda de energia do MoS 2 / p -GaAs heterojunção e e a ilustração correspondente do contato elétrico na interface
Geralmente acontece nos PSDs do tipo heterojunção relatados que o LPE pode ser ajustado mudando a espessura das camadas de cobertura [20]. Isso pode ser bem compreendido considerando a recombinação dos portadores fotoexcitados no filme e a evolução do campo embutido. No MoS 2 / GaAs p - n junção, a recombinação de portadores gerados por fótons pode ser aumentada devido ao longo caminho de transporte no MoS espesso 2 filme antes de serem coletados pelos eletrodos. Isso reduz o LPE das heterojunções. Inversamente, um filme mais fino pode diminuir muito a recombinação, o que causa o aumento do LPE. No entanto, quando o MoS 2 espessura é menor do que o valor crítico, o E bi na interface diminui com a diminuição ainda maior do MoS 2 espessura [24]. Isso pode reduzir a separação de pares de elétrons-lacunas gerados por fótons, e o LPE diminui. Assim, há uma espessura ótima do MoS 2 filme para obter o maior LPE, cerca de 30 nm.
Conclusões
Em resumo, MoS 2 filmes finos foram depositados na superfície do substrato GaAs por meio da técnica de pulverização catódica de magnetron. Um grande LPE foi obtido no MoS fabricado 2 / n -Heterojunção GaAs, e a dependência do LPV com a posição da iluminação do laser mostrou boa linearidade. Devido à formação do forte campo embutido na interface, o MoS 2 / n -A heterojunção GaAs exibiu uma alta sensibilidade de 416,4 mV mm −1 , enquanto o valor era de apenas 7,3 mV mm −1 para o MoS 2 / p -GaAs. Nossos resultados mostraram ainda que o LPE exibiu dependência óbvia da espessura do MoS 2 filmes e cerca de 30,0 nm era a espessura ideal do MoS 2 filme para adquirir o maior LPE no MoS fabricado 2 / n Heterojunções -GaAs. Os mecanismos para o LPE no MoS 2 / Dispositivos GaAs foram esclarecidos com base no alinhamento da banda de energia na interface.
Abreviações
- ∆ E :
-
Distância entre E V e E F
- d MoS2 :
-
Espessura do MoS 2 filme
- E bi :
-
Campo embutido
- E C :
-
Nível da banda de condução
- E F :
-
Nível de energia de Fermi
- E g :
-
Lacuna de banda de energia
- E V :
-
Nível da banda de valência
- I - V :
-
Corrente electrica
- LPE:
-
Efeito fotovoltaico lateral
- LPV:
-
Fotovoltagem lateral
- LPV max :
-
Fotovoltagem lateral máxima
- MoS 2 :
-
Dissulfeto de molibdênio
- PSD:
-
Detector sensível à posição
- UPS:
-
Espectroscopia de fotoelétrons ultravioleta
- W :
-
Função no trabalho
Nanomateriais
- Características fotovoltaicas de dispositivos de heterojunção GaSe / MoSe2
- MoS2 com Espessura Controlada para Evolução Eletrocatalítica de Hidrogênio
- Cristalização dependente da temperatura de nanoflocos MoS2 em nanofolhas de grafeno para eletrocatálise
- Composto de MoS2 / Acetileno com poucas camadas como um ânodo eficiente para baterias de íon-lítio
- Fotorresponsividade dependente de polarização de fototransistores MoS2 multicamadas
- Desempenho de detecção de H2 altamente aprimorado de heterojunções MoS2 / SiO2 / Si de poucas camadas por decoração de superfície de nanopartículas de Pd
- Efeito de diferentes morfologias CH3NH3PbI3 nas propriedades fotovoltaicas de células solares de perovskita
- Otimização de células solares GaAs Nanowire Pin Junction Array usando Heterojunções AlGaAs / GaAs
- Propriedades fotovoltaicas aprimoradas na célula solar de heterojunção plana Sb2S3 com uma abordagem de selenilação rápida
- Propriedades de transporte portador do sensor de gás assimétrico MoS2 sob carga Modulação de barreira baseada em transferência



