Investigação de nitridação no alinhamento de bandas nas interfaces MoS2 / HfO2
Resumo
O efeito do tratamento de nitretação no alinhamento da banda entre algumas camadas de MoS 2 e HfO 2 foi investigado por espectroscopia de fotoelétrons de raios-X. Os deslocamentos de banda de valência (condução) de MoS 2 / HfO 2 com e sem tratamento de nitração foram determinados como 2,09 ± 0,1 (2,41 ± 0,1) e 2,34 ± 0,1 (2,16 ± 0,1) eV, respectivamente. O alinhamento da banda ajustável pode ser atribuído à formação de ligação Mo-N e à curvatura da banda de superfície para HfO 2 desencadeada pela nitretação. Este estudo sobre a engenharia de banda de energia do MoS 2 / HfO 2 heterojunções também podem ser estendidas a outros dielétricos de alto k para integração com materiais bidimensionais para projetar e otimizar seus dispositivos eletrônicos.
Histórico
Atualmente, dichalcogenetos de metais de transição em camadas (TMDCs) têm despertado grande interesse devido às suas propriedades fascinantes para potenciais aplicações em eletrônica moderna e optoeletrônica [1, 2]. Em particular, dissulfeto de molibdênio (MoS 2 ) tem atraído atenção considerável como um material de canal promissor para continuar o dimensionamento além do nó de tecnologia de 7 nm [3, 4]. Estruturalmente, o MoS 2 o cristal é formado por um plano de Mo hexagonalmente, intercalado por dois planos S hexagonais. Um arranjo prismático triangular foi formado por meio das unidades S-Mo-S ligadas covalentemente [5, 6]. MoS 2 possui um bandgap dependente de camada, variando de um bandgap direto (1,8 eV) para MoS de camada única (SL) 2 a um bandgap indireto (1,2 eV) para MoS em massa 2 [7]. Diferente do grafeno com um bandgap zero, a modulação dependente da espessura dos bandgaps motivou a exploração do MoS 2 em dispositivos ópticos e elétricos [3, 8]. Com base na física do MoS 2 , a densidade de estados de MoS de poucas camadas 2 é o triplo do MoS de camada única 2 , resultando em altas correntes de acionamento no limite balístico [8]. Neste contexto, poucas camadas MoS 2 pode oferecer vantagens significativas para aplicações de transistor do que SL MoS 2 [3].
Por outro lado, os dispositivos eletrônicos baseados em dielétricos tradicionais de dióxido de silício estão se aproximando do limite físico devido à sua baixa constante dielétrica [9]. Para obter uma espessura de óxido equivalente fina (EOT), é crucialmente importante integrar dielétricos de alto k com MoS 2 . Até o momento, muitos dielétricos de alto k foram investigados com MoS 2 , incluindo Al 2 O 3 , ZrO 2 , HfO 2 e h-BN [10,11,12,13,14]. DiStefano et al. obteve os respectivos desvios de banda de condução e valência de 3,3 ± 0,2 e 1,4 ± 0,2 eV para MoS de poucas camadas 2 crescido por deposição de vapor de óxido em BN amorfo [13]. Tao et al. relataram que o deslocamento da banda de condução (CBO) para a monocamada MoS 2 / Al 2 O 3 (ZrO 2 ) a heterojunção foi deduzida de 3,56 eV (1,22 eV), enquanto o deslocamento da banda de valência (VBO) foi de 3,31 eV (2,76 eV) [15]. E um CBO de 2,09 ± 0,35 eV e VBO de 2,67 ± 0,11 eV no MoS 2 / HfO 2 interface foram relatados por McDonnell et al. [12]. Entre esses dielétricos de porta, HfO 2 foi considerado um dos candidatos mais promissores devido à sua alta constante dielétrica (k ∼ 20), compatibilidade com poli-SiGe, portas TaN e porta de silício policristalino [16]. No entanto, HfO 2 tem uma estabilidade térmica pobre, grande corrente de fuga, alta densidade de armadilha de óxido, densidade de armadilha de interface, etc. [17]. Essas limitações motivaram extensas investigações na busca de técnicas de passivação, como nitretação de interface ou tecnologias de tratamento de fluoração [18, 19]. Neste trabalho, estudamos os alinhamentos de banda de energia de MoS de poucas camadas 2 no HfO 2 dielétricos com e sem nitretação de plasma, em que o efeito da nitretação de superfície foi caracterizado por espectroscopia de fotoelétrons de raios-X (XPS).
Métodos
O SiO 2 (280 nm) / wafer de Si foi limpo alternadamente com acetona e isopropanol por limpeza ultrassônica a cada 10 min, seguido por enxágue com água deionizada e N 2 seco. O MoS de poucas camadas 2 os filmes foram depositados em SiO 2 / Si substrato por deposição química de vapor (CVD) usando precursores de MoO 3 (0,08 mg, 99%, Alfa Aesar) e pó S (1 g, 99%) [20, 21]. Após o procedimento de crescimento, o MoS 2 filme seria transferido para HfO 2 / Si substrato pelo método poli (metacrilato de metila) (PMMA) [22], conforme ilustrado na Fig. 1a. Neste processo, o PMMA foi primeiro revestido por centrifugação no MoS 2 / SiO 2 Amostras de / Si como camada de suporte. Em seguida, as amostras foram imersas em solução KOH para decapagem do SiO 2 , após o qual o MoS 2 camada com PMMA flutuaria no topo da solução. No final, a camada de PMMA seria dissolvida em acetona após a amostra ser transferida para HfO 2 Substrato / Si. O HfO 2 os filmes foram cultivados no wafer de silício por deposição de camada atômica (ALD) a uma temperatura de 200 ° C usando Hf [N (CH 3 ) (C 2 H 5 )] 4 [tetraquis (etilmetilamido) háfnio, TEMAH] e H 2 O vapor como precursores [23, 24]. Durante o processo de otimização do tempo de tratamento de plasma, foi descoberto que o nitrogênio se difundiria no óxido muito após o tratamento de nitretação de 70 s por medições SIMS, o que deterioraria severamente a qualidade do óxido. Embora o tempo de tratamento com plasma seja de 30 s, nenhum pico N óbvio na superfície do óxido foi observado a partir dos resultados do SIMS. Para a amostra de controle, 50 s N 2 tratamento de plasma foi implementado em HfO 2 / Si substrato a uma pressão de 3 Pa antes do MoS 2 transferir. Sob a condição de plasma, a dose de N resultante é de cerca de 8,4 × 10 14 átomos / cm 2 estimado a partir dos resultados da espectrometria de massa de íons secundários (SIMS). E a concentração de nitrogênio foi calculada em cerca de 1,5% após a nitretação com base nos dados XPS. Quatro amostras 1–4 # foram preparadas para medições XPS:1 # MoS de poucas camadas 2 filme em SiO 2 Substrato / Si (poucas camadas MoS 2 ), 2 # espessura HfO 2 filme em substrato de Si (HfO em massa 2 ), 3 # transferido MoS 2 filme em HfO crescido 2 Substrato / Si (conforme crescido MoS 2 / HfO 2 heterojunção), e 4 # MoS transferido 2 filme em N 2 HfO tratado com plasma 2 Substrato de / Si (MoS nitretado 2 / HfO 2 heterojunção).
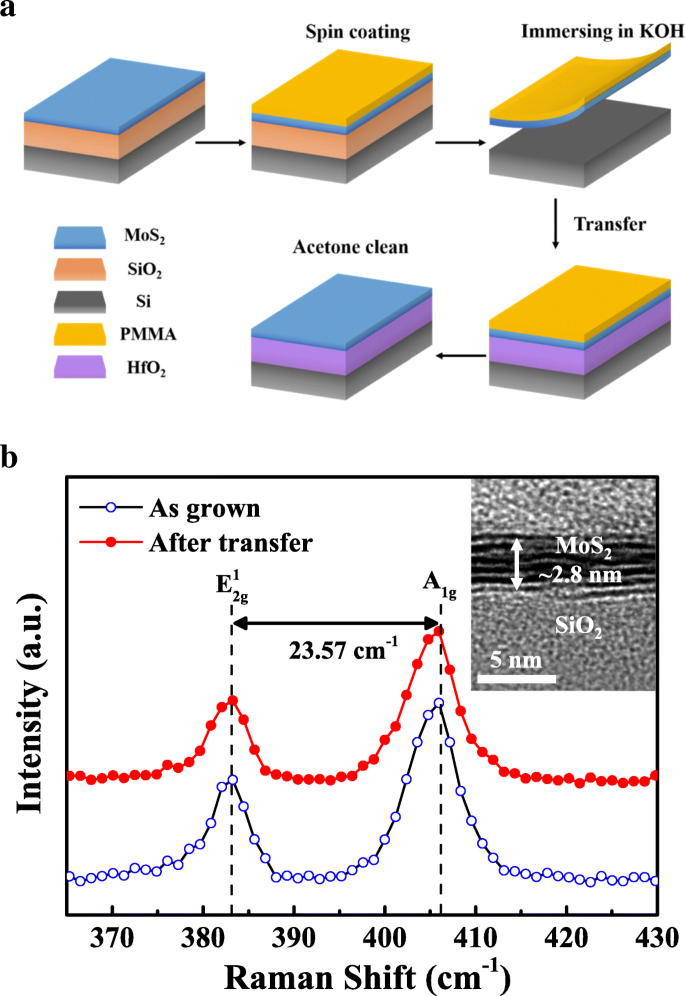
a Fluxo de processo do método de transferência úmida assistida por PMMA para o MoS 2 / ALD-HfO 2 formação de heterojunção. b Respectivos espectros Raman de MoS conforme crescido e transferido 2 filme. A inserção são as imagens de microscopia eletrônica de transmissão de seção transversal de MoS conforme crescido 2 no SiO 2 / Si substrato
Resultados e discussões
RENISHAW inVia Espectroscopia Raman foi empregada para caracterizar os espectros Raman de MoS de poucas camadas 2 filme antes e depois do procedimento de transferência, conforme ilustrado na Fig. 1b. Dois picos Raman podem ser vistos por volta de 382,86 cm −1 e 406,43 cm −1 , correspondendo ao plano (\ ({E} _ {2g} ^ 1 \)) e fora do plano ( A 1 g ) modos, respectivamente [25, 26]. Foi descoberto que quase não há mudança Raman em \ ({E} _ {2g} ^ 1 \) e A 1 g frequências de modo após o processo de transferência, indicando modificação mínima da estrutura. A diferença de frequência ( ∆k ) entre \ ({E} _ {2g} ^ 1 \) e A 1 g modo foi deduzido em cerca de 23,57 cm −1 , designando cerca de quatro a cinco camadas de MoS 2 filme [27]. Conforme mostrado na inserção da Fig. 1b, a espessura do MoS 2 o filme foi verificado ser de aproximadamente 2,8 nm por microscópio eletrônico de transmissão de alta resolução (HRTEM), que é consistente com os espectros Raman mencionados acima. Além disso, apresentamos perfis de profundidade SIMS de MoS transferido 2 filme em HfO nitretado 2 Substrato / Si. A medição SIMS foi realizada em um instrumento Physical Electronics ADEPT 1010 SIMS com feixe de íons primário Cs na energia de 1 keV, no qual íons positivos foram coletados e a compensação de carga realizada. Nesta medição SIMS, o elemento nitrogênio foi quantificado, enquanto os outros elementos (Mo, Hf e Si) são apenas marcadores de camada e não quantificados. Conforme ilustrado na Fig. 2a, os perfis de profundidade para MoS transferido 2 filme em HfO nitretado 2 / Si substrato foram determinados por SIMS, no qual os sinais dos componentes principais representados por Mo, N, Hf e Si são plotados contra a profundidade. A propagação de N no HfO 2 camada foi observada, o que poderia ser intrigado pela injeção de N na camada subjacente durante bombardeios de feixe primário ou tratamentos de plasma. Também é importante notar que os perfis de profundidade perto da camada de superfície são normalmente complicados e sem sentido por causa da contaminação da superfície e dos efeitos da superfície, por exemplo, a intensidade anormal do elemento N perto da superfície [28]. O sinal mais alto do perfil N perto do HfO 2 A interface / Si pode ser atribuída a que o nitrogênio tende a se difundir para o HfO 2 Interface / Si, levando ao acúmulo de N próximo à interface [29]. A cauda de Mo em HfO 2 filme pode ser causado principalmente por bombardeios de feixe primário em medições SIMS [30]. A Figura 2b ilustra os respectivos espectros N 1s XPS para as amostras 3 # e 4 #; os picos de alta intensidade para ambas as heterojunções foram Mo 3p 3/2 enquanto um pico de baixa intensidade em ~ 395,80 eV foi detectado para a heterojunção nitretada, indicando a formação da ligação Mo-N [31].
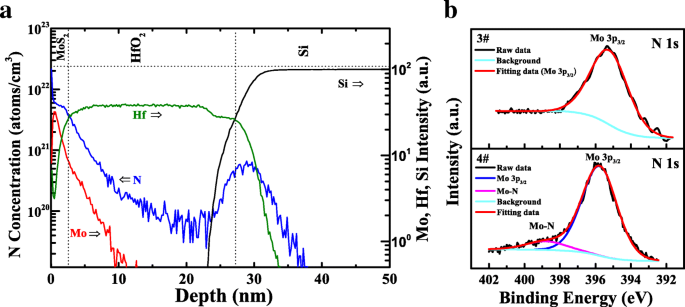
a Perfis de profundidade SIMS de MoS transferido 2 filme em HfO nitretado 2 Substrato / Si. b Espectros N 1s XPS para MoS 2 / HfO 2 heterojunções com e sem tratamento de nitretação, respectivamente
Para obter os alinhamentos de banda entre MoS de poucas camadas 2 e HfO 2 com e sem tratamento de nitretação, as medições de XPS com um passo de 0,05 eV foram realizadas no sistema VG ESCALAB 220i-XL usando uma fonte de raios-X monocromática Al Kα (hν =1486,6 eV). A energia de passagem constante foi fixada em 20 eV. Além disso, o padrão C 1s (284,8 eV) foi usado para calibração de energia de ligação (BE) [32]. Para avaliar os valores de VBO para MoS 2 / HfO 2 heterojunções, níveis centrais (CLs) Mo 3d e Hf 4f foram selecionados para a amostra 1–4 #, respectivamente. A Figura 3a apresenta a varredura estreita XPS de Mo 3d e espectros de banda de valência da amostra 1 # [33]. Assim, a diferença de energia de ligação (BED) entre Mo 3d 5/2 o nível do núcleo e o máximo da banda de valência (VBM) para a amostra 1 # foi calculado como sendo 228,49 ± 0,1 eV. A Figura 3b ilustra os CLs de Hf 4f 7/2 e VBM para a amostra 2 #; o BED correspondente foi determinado como 14,10 ± 0,1 eV. A Figura 3c representa os espectros XPS medidos de Mo 3d e Hf 4f CLs para MoS 2 / HfO 2 heterojunções com / sem tratamento de nitretação. Observa-se que o Mo 3d 5/2 CL mudou de 229,45 ± 0,05 eV para a amostra 3 # para 229,90 ± 0,05 eV para a amostra 4 #. Isso pode ser atribuído ao fato de que uma camada interfacial de nitretação foi introduzida no MoS 2 / HfO 2 interface após o tratamento de plasma, resultando na ligação Mo-N acima mencionada. Com a presença de ligações Mo-N, a transferência de carga consequente entre os elementos Mo e N contribuiu para o Mo medido 3d 5/2 Mudança de CL. Além disso, o Hf 4f 7/2 CL de 17,40 ± 0,05 eV para a amostra 3 # foi deslocado para uma energia de ligação mais alta de 17,60 ± 0,05 eV para a amostra 4 # enquanto O 1s também mostrou uma mudança de 0,20 eV para um BED mais alto, como mostrado na Fig. 3d. Essas mudanças de pico implicam na curvatura da banda para baixo no HfO 2 superfície, o que pode ser interpretado como que o plasma de nitrogênio induziu defeitos do tipo doador para HfO 2 [34]. Baseado no método Kraut [35], o VBO ( ∆E V ) os valores podem ser calculados a partir da seguinte equação:
$$ \ Delta {E} _V =\ left ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S }} _ 2} - {E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \ direita) - \ left ({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} - {E} _ {\ mathrm {VBM}} ^ {{\ mathrm {Hf } \ mathrm {O}} _ 2} \ right) - {\ Delta E} _ {\ mathrm {CL}} $$ (1)
onde \ ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) e \ ( {E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) são energias de ligação de Mo 3d 5/2 CL e VBM para MoS 2 , \ ({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \) e \ ( {E} _ {\ mathrm {VBM}} ^ {{\ mathrm {HfO}} _ 2} \) são energias de ligação de Hf 4f 7/2 CL e VBM para ALD-HfO 2 , ∆E CL =\ ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} - {E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \) refere-se ao BED entre Mo 3d 2/5 e Hf 4f 7/2 CLs para ALD-HfO 2 / MoS 2 heterojunções. Portanto, o ∆E V do MoS 2 em ALD-HfO 2 com e sem tratamento de nitretação foram calculados em 2,09 ± 0,1 e 2,34 ± 0,1 eV, respectivamente.

a Espectros XPS de Mo 3d CL e banda de valência para o MoS de poucas camadas 2 . b Espectros XPS de Hf 4f CL e banda de valência para HfO em massa 2 . Espectro XPS de c Mo 3d, Hf 4f e d O 1s CLs para MoS transferido 2 filme em bulk HfO 2 com / sem tratamento de nitretação
Para avaliar a influência de N 2 tratamento de plasma no deslocamento da banda de condução (CBO, ∆E C ) entre ALD-HfO 2 e MoS de poucas camadas 2 , os bandgaps de 5,9 ± 0,1 eV para HfO 2 e 1,4 ± 0,1 eV para MoS 2 foram usados aqui, respectivamente [7, 36]. Assim, o CBO pode ser alcançado pela seguinte equação:
$$ {\ Delta E} _C ={E} _g ^ {{\ mathrm {HfO}} _ 2} - {E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} - {\ Delta E } _V $$ (2)
onde \ ({E} _g ^ {{\ mathrm {HfO}} _ 2} \) e \ ({E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) são os bandgaps de HfO 2 e MoS 2 , respectivamente. De acordo com a Eq. (2), o ∆E C entre MoS 2 e ALD-HfO 2 com e sem tratamento de nitretação foram calculados em 2,41 ± 0,1 e 2,16 ± 0,1 eV, respectivamente. Os diagramas de banda correspondentes são ilustrados na Fig. 4. Notavelmente, os valores de VBO e CBO dessas duas heterojunções fornecem excelentes confinamentos de elétrons e lacunas, garantindo sua adequação para MoS 2 baseados em FETs [37]. Além disso, a heterojunção nitretada tem um CBO maior em comparação com a heterojunção não nitretada, que é melhor para aplicações de FETs de canal n.
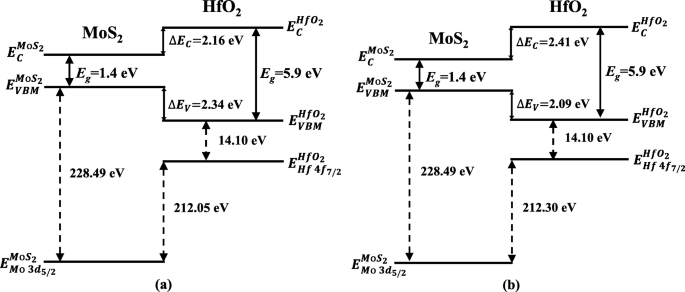
Diagramas de banda do MoS 2 / HfO 2 heterojunção a sem tratamento de nitretação e b com tratamento de nitretação
Conclusões
Em conclusão, as medições XPS revelaram que o alinhamento da banda no MoS 2 / HfO 2 interface pode ser modificada pela introdução de nitretação em HfO 2 superfície antes de empilhar MoS 2 filme. O CBO e VBO foram determinados como sendo 2,16 ± 0,1 e 2,34 ± 0,1 eV para o MoS não nitretado 2 / HfO 2 heterojunção, enquanto o CBO foi alterado até 2,41 ± 0,1 eV e o VBO foi alterado até 2,09 ± 0,1 eV para o MoS nitretado 2 / HfO 2 heterojunção, respectivamente. Uma camada interfacial de nitretação foi introduzida na interface, que resultou na formação da ligação Mo-N. Além disso, o plasma de nitrogênio pode induzir defeitos do tipo doador, levando à curvatura da banda da superfície para HfO 2 . Desta forma, a engenharia de alinhamento de banda interfacial forneceria rotas promissoras para o design flexível e otimização da eletrônica moderna.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste manuscrito estão incluídos no manuscrito.
Abreviações
- ALD:
-
Deposição de camada atômica
- BE:
-
Energia de ligação
- BED:
-
Diferença de energia de ligação
- CBO:
-
Deslocamento da banda de condução
- CL:
-
Nivel CENTRAL
- CVD:
-
Deposição de vapor químico
- FET:
-
Transistor de efeito de campo
- HfO2:
-
Óxido de háfnio
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- MoS 2 :
-
Dissulfeto de molibdênio
- PMMA:
-
Poli (metacrilato de metila)
- SIMS:
-
Espectrometria de massa de íon secundário
- SL:
-
Camada única
- TEMAH:
-
Tetraquis (etilmetilamido) háfnio
- TMDC:
-
Dichalcogeneto de metal de transição
- VBM:
-
Banda de valência máxima
- VBO:
-
Deslocamento da banda de valência
- XPS:
-
espectroscopia de fotoelétrons de raios-X
Nanomateriais
- Introdução à banda Terahertz
- MoS2 com Espessura Controlada para Evolução Eletrocatalítica de Hidrogênio
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- Cristalização dependente da temperatura de nanoflocos MoS2 em nanofolhas de grafeno para eletrocatálise
- Efeito Lateral Fotovoltaico Grande em Heterojunção MoS2 / GaAs
- Fotorresponsividade dependente de polarização de fototransistores MoS2 multicamadas
- Os principais componentes das máquinas de serra de fita
- Como escolher a velocidade de corte?
- A poderosa serra de fita de corte de metal
- Apresentando a serra de fita vertical



