Característica de chaveamento resistivo de baixa potência na memória de acesso aleatório resistiva bi-camada HfO2 / TiOx
Resumo
Dispositivos resistivos de memória de acesso aleatório com deposição de camada atômica HfO 2 e pulverização por radiofrequência TiO x como camadas de comutação resistivas foram fabricadas com sucesso. A característica de baixa potência com 1,52 μW de potência definida (1 μA@1,52 V) e 1,12 μW de potência de reinicialização (1 μA@1,12 V) foi obtida no HfO 2 / TiO x dispositivos resistivos de memória de acesso aleatório (RRAM) controlando o conteúdo de oxigênio do TiO x camada. Além disso, a influência do teor de oxigênio durante o TiO x O processo de pulverização catódica nas propriedades de comutação resistiva seria discutido em detalhes. As investigações indicaram que a “quebra leve” ocorreu facilmente durante o processo elétrico de conformação / solidificação no HfO 2 / TiO x Dispositivos RRAM com alto teor de oxigênio do TiO x camada, resultando em alta potência de comutação resistiva. A característica de baixa potência foi obtida em HfO 2 / TiO x Dispositivos RRAM com densidade de vacância de oxigênio apropriadamente alta de TiO x camada, sugerindo que a densidade de vacância de oxigênio apropriada no TiO x camada poderia evitar "quebra suave" através de todas as camadas dielétricas durante o processo de formação / configuração, limitando assim a corrente que flui através do dispositivo RRAM e diminuindo o consumo de energia operacional.
Introdução
A memória de acesso aleatório resistiva (RRAM) fornece uma solução promissora para reduzir além da memória tradicional baseada em carga devido à estrutura de célula simples, armazenamento não volátil, operação de alta velocidade e alta relação liga / desliga [1,2,3, 4,5,6,7,8,9,10]. Recentemente, One-transistor one-resistor (1T1R) é uma estrutura amplamente aceita para prevenir medições de resistência imprecisas causadas por uma corrente de fuga em 1R array [11, 12]. Além disso, a memória emergente, especialmente a RRAM baseada em óxido, foi proposta para dispositivos sinápticos de plástico devido à modulação gradual da condutância com o número de pulsos, que pode imitar o comportamento sináptico biológico para receber sinais do neurônio pré e pós-sináptico [13,14,15 , 16,17]. No entanto, alta corrente de chaveamento resistiva é a principal limitação para aplicações de baixa potência e alta densidade [18,19,20]. A matriz 1T1R também enfrenta desafios de dimensionamento se a corrente de operação do RRAM não puder ser dimensionada de acordo. Por exemplo, quando a tecnologia CMOS está diminuindo para 27 nm, a corrente do inversor diminuirá para 40 μA [21]. Portanto, é necessário reduzir a corrente de operação do dispositivo RRAM para 10 μA otimizando a estrutura e o material para continuar o escalonamento 1T1R [22]. Além disso, as sinapses biológicas consomem cerca de 1 ~ 10 fJ por evento no cérebro humano complexo, portanto, reduzir o consumo de energia de dispositivos sinápticos elétricos tão pouco quanto as sinapses biológicas são importantes para o desenvolvimento de redes neurais artificiais neuromórficas (RNAs) [23, 24,25]. Portanto, limitar a corrente do dispositivo e reduzir o consumo de energia irá beneficiar o processo prático para armazenamento de dados e aplicação de computação neuromórfica.
Neste trabalho, Pt / HfO 2 / TiO x / Pt dispositivos com um conteúdo de oxigênio diferente de TiO x filme foram fabricados, e características de baixa potência em baixo teor de oxigênio foram demonstradas. O dispositivo de memória atingiu 1,52 μW de potência definida e 1,12 μW de potência de redefinição por meio da redução do conteúdo de oxigênio do TiO x filme durante o processo de pulverização catódica. O mecanismo condutor para característica de baixa potência foi analisado posteriormente para fornecer informações sobre o projeto de óxido RRAM.
Métodos
O Pt / HfO 2 / TiO x A estrutura do dispositivo / Pt e o processo de fabricação são mostrados nas Fig. 1a e b. A princípio, em Si / SiO 2 / Ti substrato, um eletrodo de fundo de Pt de 100 nm (BE) foi preparado por corrente contínua (DC) pulverização catódica em temperatura ambiente. Em seguida, 3 nm HfO 2 foi depositado pela técnica de deposição de camada atômica (ALD) (Picosun R200) a 300 ° C usando TEMAH e H 2 O como precursores. Posteriormente, TiO de 30 nm x foi depositado com diferentes conteúdos de oxigênio por pulverização catódica de radiofrequência. Durante TiO x processo de pulverização catódica, fixando o fluxo de gás total de argônio (Ar) e oxigênio (O 2 ) como 20 sccm e alterando a pressão parcial de oxigênio em 9%, 11% e 13%, três dispositivos de amostra (S1, S2 e S3) foram obtidos para investigar a influência do teor de oxigênio de TiO x filme sobre o desempenho de comutação resistiva. Em seguida, um eletrodo de Pt superior (TE) de 70 nm foi depositado por pulverização catódica DC e padronizado com litografia. Finalmente, dispositivos de forma quadrada de 100 μm × 100 μm foram formados por corrosão iônica reativa (RIE). A tensão de polarização foi aplicada no TE, e o BE foi conectado ao terra. As imagens do microscópio eletrônico de transmissão de alta resolução (HRTEM) da seção transversal do Pt / HfO 2 / TiO x / Pt são mostrados na Fig. 2. As características elétricas dos dispositivos foram medidas com o analisador de parâmetros de semicondutor Agilent B1500A. Os estados químicos dos átomos no TiO x os filmes foram investigados por espectroscopia de fotoelétrons de raios-X (XPS, Axis Ultra).
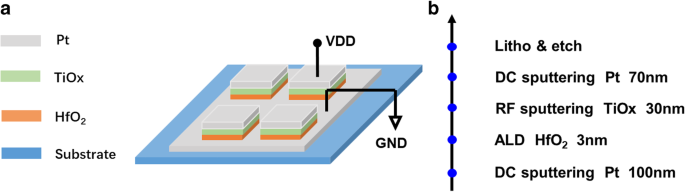
a A estrutura de Pt / HfO2 / TiO x / Dispositivo Pt. b O fluxo do processo de fabricação
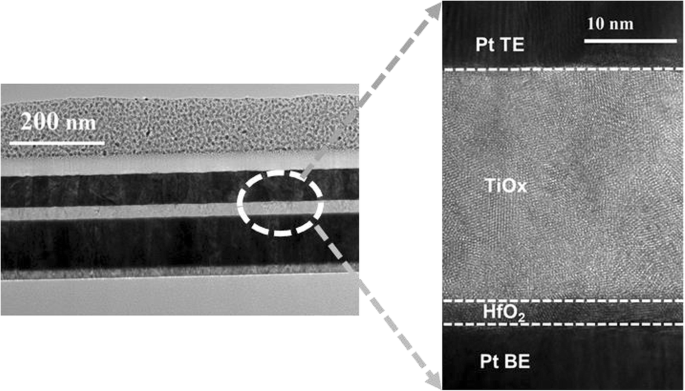
Secções transversais TEM do Pt / HfO 2 / TiO x / Dispositivo Pt
Resultados e discussão
As Figuras 3a, b e c mostram os espectros de nível de núcleo XPS O 1s de TiO x filmes. Para esclarecer a ligação química do oxigênio nos filmes, os picos assimétricos de O 1s são divididos em dois picos, que geralmente são atribuídos ao O 2− ligado por íons metálicos e O 2− na região deficiente de oxigênio [26]. Pressão parcial de oxigênio durante TiO x processo de pulverização catódica foi definido como 9%, 11% e 13%, respectivamente, e o conteúdo deficiente de oxigênio correspondente em três amostras é cerca de 28,23%, 24,06% e 23,63%, indicando que o conteúdo de íons de oxigênio não reticulados e as vacâncias de oxigênio diminuem com o aumento da pressão parcial de oxigênio.

Espectro de varredura O 1s XPS de TiO x filmes em S1, S2 e S3. A pressão parcial de oxigênio foi definida como a 9%, b 11% e c 13% durante TiO x processo de pulverização de filme
Para os dispositivos novos, o estado original é o estado de alta resistência (HRS). Conforme mostrado na Fig. 4, a formação de corrente (CF) é aplicada para iniciar a formação do filamento condutor e alterar o estado do dispositivo para o estado de baixa resistência (LRS) [27]. Ao aplicar 1 μA de conformidade de corrente, um caminho condutor é formado em S1 e o processo de ajuste / reinicialização estável pode ser alcançado na operação subsequente. Para S2 e S3, a operação de reinicialização não é bem-sucedida no estado intermediário do dispositivo durante o processo de CF até que a conformidade atual seja de até 20 mA.
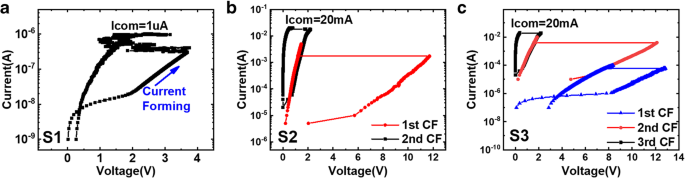
Processo de formação atual do Pt / HfO2 / TiO x / Pt RRAM dispositivo em a S1, b S2 e c S3
Para testar o desempenho elétrico do dispositivo RRAM, são realizadas medições de CC sob varredura de tensão. A tensão de polarização positiva no processo de formação e configuração é aplicada no TE para completar o filamento condutivo, e a tensão de polarização negativa no processo de reinicialização é para quebrar o filamento. Quando a polarização é varrida para frente e para trás, 100 ciclos de curvas de corrente-tensão (IV) de comutação bipolar de três amostras são mostrados na Fig. 5. Os dispositivos S1 alcançam desempenho de comutação resistiva estável em conformidade de corrente de 10 μA, mas a corrente de operação é até 10 mA para as outras duas amostras. A característica de baixa potência de S1 pode ser atribuída ao alto conteúdo de vacância de oxigênio preexistente no TiO x filme, que limita a corrente efetivamente durante o processo de formação / pega.
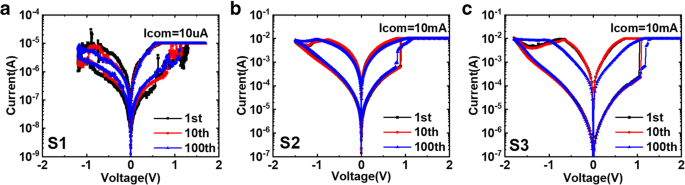
100 ciclos de curvas I-V bidirecionais estáveis em a S1, b S2 e c S3
As Figuras 6 e 7 representam a variação ciclo a ciclo e dispositivo a dispositivo (desvio padrão relativo, ( σ / μ )) de três amostras e as estatísticas estão resumidas nas Tabelas 1 e 2. Para S1, a corrente de salto fraca causa uma distribuição de resistência modesta e os fortes filamentos condutores formados em S2 e S3 garantem a distribuição de resistência relativamente estável. Embora haja uma pequena degradação para S3 após dezenas de ciclos, a proporção liga / desliga ainda é superior a 100.

Variação ciclo a ciclo de R LRS e R HRS por 100 ciclos em a S1, b S2 e c S3

Variação de dispositivo a dispositivo de R LRS e R HRS para 20 dispositivos em a S1, b S2 e c S3
Conforme mostrado na Fig. 8, a potência definida (Pset) 1,52 μW e a potência de reinicialização (predefinida) 1,12 μW são alcançados sob uma corrente de baixa conformidade de 1 μA. O consumo de energia das outras duas amostras é de dezenas de miliwatt devido a 10 mA de corrente de operação. Além disso, os estados de resistência de S1 podem manter as características de retenção acima de 10 4 s abaixo de 85 ° C com relação liga / desliga aproximada de 100, que é estável para aplicações de armazenamento de dados.
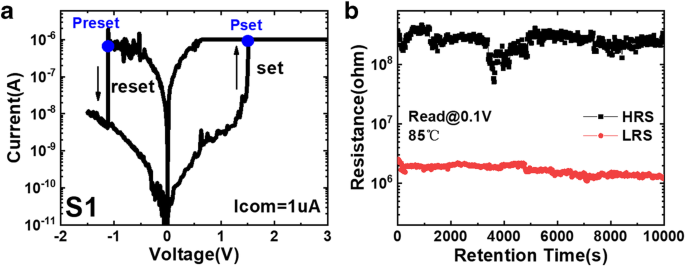
a Desempenho de chaveamento resistivo abaixo da limitação de corrente de 1 μA. b A característica de retenção em S1 é superior a 10 4 s abaixo de 85 ° C
Para elucidar o mecanismo condutor da característica de baixa potência, realizamos medições de temperatura para S1 e S3 com diferentes correntes de operação e investigamos o mecanismo correspondente, conforme mostrado nas Figs. 9 e 10. De 25 ° C a 125 ° C, a resistência de S1 diminui com a temperatura, mas a resistência de S3 quase não muda. A condutância e a temperatura experimentais são ajustadas com o modelo de salto de faixa variável de Mott [28], como mostrado na Fig. 11, que indica que o principal mecanismo condutor de S1 é o salto de elétrons via defeitos de vacância de oxigênio localizados no óxido dielétrico [29]. Ao diminuir a pressão parcial de oxigênio durante o TiO x processo de pulverização catódica, conforme mostrado em S1, o conteúdo de vacância de oxigênio no TiO inicial x camada aumenta e a resistência do filme diminui [30]. A tensão no TE é aplicada principalmente no HfO 2 camada e uma massa de vacâncias de oxigênio são motivadas para formar o filamento condutor. Depois disso, novas vagas de oxigênio também são motivadas no TiO x camada, mas a conexão entre as vagas de oxigênio é fraca. Portanto, a condução de salto de elétrons em TiO x é dominante, o que garante baixa corrente de comutação resistiva de 1 μA.

a A resistência muda com a temperatura em S1. b O diagrama esquemático correspondente do mecanismo condutor

a A resistência muda com a temperatura em S3. b O diagrama esquemático correspondente do mecanismo condutor

Dependência da condutância de S1 em a com a temperatura LRS e b HRS
No entanto, como mostrado na Fig. 10, após aumentar o conteúdo de oxigênio durante TiO x No processo de sputtering, HRS e LRS permanecem quase inalterados com a temperatura, o que está mais provavelmente associado ao mecanismo de transporte semelhante ao metálico, induzido pelo transporte de elétrons através do filamento condutor composto por vacâncias de oxigênio concentradas. Em comparação com o dispositivo RRAM de S1, menos vacâncias de oxigênio no TiO inicial x camada de S3 não são suficientes para a condução do salto de elétrons. Além disso, devido ao aumento da resistência do TiO x filme, a polarização de voltagem é aplicada em ambos HfO 2 camada e TiO x camada ao mesmo tempo. A inicialização elétrica leva a muitas vagas de oxigênio motivadas em HfO 2 e TiO x camadas. Essas vacâncias de oxigênio formam um forte filamento condutor em ambas as camadas dielétricas, e os abundantes elétrons estendidos fluem através das duas vacâncias de oxigênio adjacentes, o que causa alta corrente de operação durante o processo de comutação resistiva.
Em princípio, é possível controlar o conteúdo de oxigênio cuidadosamente para atingir o desempenho de baixa potência em outras memórias resistivas de óxido (OxRRAM) relacionadas à vacância de oxigênio. O requisito para a camada de óxido é que deve haver vacâncias de oxigênio suficientes no estado inicial para a condução de salto elétrico em caso de quebra do dispositivo. No entanto, as vacâncias excessivas de oxigênio causarão característica de resistência instável e deteriorarão o desempenho do dispositivo. Portanto, as vacâncias de oxigênio adequadas são necessárias para limitar a corrente de operação e diminuir o consumo de energia.
A Tabela 3 compara alguns dos principais parâmetros do Pt / HfO 2 / TiO x / Pt dispositivo com outros relatórios recentes. O dispositivo tem méritos importantes de baixa potência de chaveamento resistivo de 1,12 μW e relação acima de 100 HRS / LRS entre vários dispositivos RRAM.
Conclusões
Neste trabalho, a corrente de comutação resistiva 1-μA foi demonstrada em Pt / HfO 2 / TiO x / Dispositivo de estrutura Pt. Para o mecanismo condutor, a condução de salto de elétrons é dominante no baixo teor de oxigênio do TiO x camada, que limita a corrente de operação e diminui o consumo de energia. O transporte metálico é dominante no alto teor de oxigênio do TiO x camada e “quebra suave” de duas camadas dielétricas causa alta corrente de operação e alto consumo de energia. O conteúdo de oxigênio apropriado de TiO x o filme pode limitar a corrente RRAM e contribuir para a característica de baixa potência, que fornece uma solução para grandes problemas de corrente e alta potência de operação e mostra a promessa para futuras memórias não voláteis incorporadas e aplicações de Internet das coisas (IoT).
Abreviações
- 1T1R:
-
Um transistor um resistor
- ALD:
-
Deposição de camada atômica
- ANNs:
-
Redes neurais artificiais
- BE:
-
Eletrodo inferior
- CF:
-
Formação atual
- HRS:
-
Estado de alta resistência
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- IoT:
-
Internet das Coisas
- I-V:
-
Corrente electrica
- LRS:
-
Estado de baixa resistência
- Relação liga / desliga:
-
HRS / LRS
- OxRRAM:
-
Memória resistiva de óxido
- Predefinição:
-
Reiniciar energia
- Pset:
-
Definir potência
- RIE:
-
Gravura de íon reativo
- RRAM:
-
Memória de acesso aleatório resistiva
- TE:
-
Eletrodo superior
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- σ / μ :
-
Desvio padrão relativo
Nanomateriais
- Oxigênio
- Nano grafema, memória transparente flexível à base de silício
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Memória resistiva ZrO2 / ZrO2 - x / ZrO2 sem conformidade com comportamento de comutação multiestado interfacial controlável
- Uma SRAM 4T integrada RRAM com carga de comutação resistiva autoinibida por processo lógico CMOS puro
- Um estudo coletivo sobre modelagem e simulação de memória de acesso aleatório resistiva
- Efeito de campo ferroelétrico Efeito de comutação assimétrica resistiva induzida em BaTiO3 / Nb:SrTiO3 Heterojunções epitaxiais
- Reação de redução de oxigênio no nanocatalisador de PtCo:envenenamento por ânion (Bi) sulfato
- Um estudo da variabilidade na memória de acesso aleatório resistiva de contato por modelo de vacância estocástica
- Novo método cria memória de computador com óxido de titânio



