Análise de refletância infravermelha de camadas epitaxiais de GaN dopado tipo n cultivadas em safira
Resumo
A espectroscopia de refletância infravermelha (IR) é aplicada para estudar multicamadas dopadas com Si n + / n 0 / n + -GaN estrutura crescida em GaN buffer com GaN-template / substrato safira. A análise da estrutura investigada pelos métodos de fotocondicionamento, SEM e SIMS mostrou a existência da camada adicional com a diferença drástica nos níveis de dopagem de Si e O e localizada entre o tampão de GaN epitaxial e o molde. A simulação dos espectros de refletividade experimental foi realizada em uma ampla faixa de frequência. Mostra-se que a modelagem do espectro de reflectância IR utilizando o método da matriz de transferência 2 × 2 e incluindo na análise a camada adicional permite obter o melhor ajuste do espectro experimental, que segue na avaliação das espessuras da camada de GaN que são boas. acordo com os dados SEM e SIMS. A dependência espectral dos modos acoplados plasmon-LO-fônon para cada camada de GaN é obtida a partir da dependência espectral do dielétrico da impureza de dopagem de Si, que é atribuída aos efeitos de compensação pelos estados aceitadores.
Histórico
Nos últimos anos, tem havido grande interesse em materiais de nitreto III, em particular em GaN [1, 2]. Devido ao avanço nas técnicas de crescimento, os filmes epitaxiais de GaN encontraram ampla aplicação em dispositivos optoeletrônicos, como diodos emissores de luz ultravioleta (LEDs) azul e ultravioleta [3], lasers [4] e dispositivos microeletrônicos, e. g., transistores de efeito de campo de alta potência e alta frequência [5, 6]. A concentração e a mobilidade das portadoras livres são os principais parâmetros que determinam o desempenho do dispositivo nas aplicações. A medição Hall da concentração e mobilidade de portadores livres em estruturas de dispositivos baseados em GaN multicamadas não é tarefa tecnológica trivial e demorada, que precisa de contatos ôhmicos anexados a cada camada de medição e procedimentos de medição dedicados.
A espectroscopia de refletância no infravermelho com transformada de Fourier (IV) e a espectroscopia Raman são métodos sem contato e não destrutivos que permitem estudar não apenas as vibrações dos fônons, mas também caracterizar as propriedades dos portadores [7]. No entanto, o problema conhecido da espectroscopia confocal micro-Raman é uma deterioração na resolução espacial de profundidade devido à refração da luz [8]. Foi mostrado na ref. [6] que na varredura de profundidade da estrutura de multicamadas GaN com um comprimento de onda de excitação de 488,0 nm, a resolução de profundidade faz apenas cerca de 1,8 μm, enquanto a resolução lateral é de cerca de 210 nm. A espectroscopia de IV supera esse problema devido à alta sensibilidade à espessura da camada devido aos efeitos de interferência e ao impacto da dispersão do índice de refração em uma ampla faixa espectral.
Os espectros de refletância de infravermelho de filmes finos de GaN foram investigados já em 1973 por A.S. Baker [9], mas a falta de homogeneidade espacial e a baixa qualidade estrutural geral de tais filmes limitaram significativamente a aplicação prática dos resultados obtidos. No entanto, foi demonstrada a possibilidade de determinar parâmetros de fônons ópticos e absorção de portadores livres em filmes finos de GaN. Os estudos detalhados do fônon óptico longitudinal - Os modos acoplados a plasmon (LOPC) em bulk GaN foram realizados por Perlin et al. [10] usando espectroscopia Raman e por Shubert et al. [11] usando elipsometria IR. O efeito de diferentes substratos nas propriedades ópticas de filmes de GaN cúbico e wurtzita também foi estudado em detalhes [12, 13]. Considerando a falta de substratos de GaN nativos, foi demonstrado que o uso de substratos de safira para o crescimento epitaxial do filme de GaN é ideal para explorar em dispositivos que operam em altas temperaturas. Estudos de espectroscopia de reflexão de infravermelho de safira hexagonal [14] mostraram um espectro complexo, cuja forma depende fortemente da polarização e do ângulo de incidência. Isso complica muito as medições e a determinação das características espectrais dos modos de fônon e das propriedades dos portadores livres em um filme fino de GaN crescido em substratos de safira.
Assim, a seleção adequada do algoritmo de análise espectral e a forma da função dielétrica são de grande importância para a análise dos espectros de refletância IV de estruturas multicamadas de GaN sobre safira [15,16,17]. Este artigo mostra a possibilidade de aplicação da espectroscopia de reflectância IR e do método da matriz de transferência 2 × 2 para a análise de estruturas multicamadas planares baseadas em GaN com profundidade não uniforme e perfis de dopagem, que na prática podem ser diferentes tipos de semicondutor III-nitreto- estruturas de dispositivos baseadas em design vertical, como diodos emissores de luz e retificadores, diodos Gunn, transistores de alta mobilidade de elétrons (HEMTs), etc.
Métodos
Experimental
O investigado n + / n 0 / n + Estruturas -GaN foram desenvolvidas em modelos MOCVD GaN em Al 2 O 3 (0001) substratos a uma temperatura de 800 ° C por epitaxia de feixe molecular assistida por plasma usando um N 2 taxa de fluxo de 0,5 sccm e uma potência de plasma de RF de 350 W (Fig. 1). Isso resulta em uma taxa de crescimento de ∼ 0,27 ML s −1 . Primeiro, um tampão de GaN de 0,3 μm de espessura foi cultivado no modelo de GaN MOCVD. Uma camada de GaN dopado com Si de 0,8 μm de espessura foi seguida por uma camada de GaN não dopado com 1,75 μm de espessura e uma camada de GaN dopado com Si de 0,4 μm (Fig. 1). A concentração nominal de dopagem de Si do n + Camadas -GaN tinham ∼ 10 19 cm −3 .
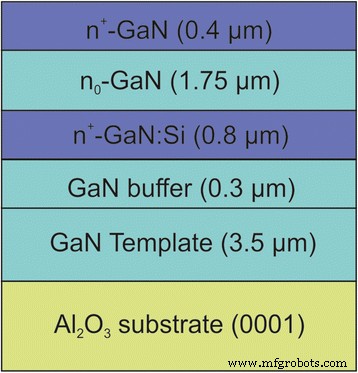
Esquema do investigado n + / n 0 / n + -GaN estrutura crescida em GaN-template / (0001) substrato safira
A fim de examinar as áreas de diferentes concentrações de portadores, a borda clivada da estrutura investigada foi examinada pelo método de foto-corrosão em uma configuração não eletrolítica usando K 2 S 2 O 8 –Solução aquosa KOH (sistema de corrosão KSO-D) [18]. Este método permite revelar as áreas de diferentes concentrações de transportadores e visualizar as diferenças relativas de concentração de transportadores medindo a taxa de corrosão usando perfis de superfície [19, 20]. A seção transversal da amostra investigada foi fotocondicionada por 3 min. Em seguida, as amostras foram examinadas por microscopia eletrônica de varredura (MEV).
Estudos de espectroscopia de massa de íons secundários (SIMS) de amostras foram realizados em um sistema CAMECA IMS6F usando um césio (Cs + ) feixe primário, com a corrente mantida em 400 nA para encontrar o perfil de concentração de impurezas. O tamanho do raster era de cerca de 50 × 50 μm 2 , e os íons secundários foram coletados de uma região central de 30 μm de diâmetro. Para H, C, O e Si, as concentrações foram derivadas das espécies H–, O–, C–, Si–, respectivamente, e o sinal da matriz Ga– foi tomado como referência.
As medições de espectroscopia de refletância infravermelha na faixa espectral de 300–4000 cm −1 com a resolução espectral de 1 cm −1 foram realizados em temperatura ambiente usando espectrômetro Bruker Vertex 70 V FTIR equipado com fonte Globar e um detector de sulfato de triglicina deuterado (DLaTGS) com janela de polietileno. O ângulo de incidência foi de 11 °. S Os espectros polarizados foram medidos usando o polarizador KRS-5. O espectro de refletância de um espelho de ouro foi usado como referência.
Descrição do modelo de análise óptica
A refletância do sistema de camadas / substrato foi calculada usando o método de matriz de transferência 2 × 2 [17, 21] em que um número arbitrário de camadas pode ser incluído e os efeitos de interferência dentro dos filmes são considerados automaticamente. O método da matriz de transferência 2 × 2 para sistemas em camadas isotrópicas permite um cálculo independente de s - e p -espectros de reflexão e transmitância polarizados no caso de sistemas em camadas que consistem em placas isotrópicas biaxiais ou uniaxiais homogêneas com seu eixo c alinhado com o eixo z das coordenadas de laboratório. Neste caso, a matriz de transferência do sistema em camadas 2 × 2 pode ser representada na seguinte visão [21]:
$$ {\ left (\ begin {array} {c} \ hfill {E} _0 ^ {+} \ hfill \\ {} \ hfill {E} _0 ^ {-} \ hfill \ end {array} \ right) } _ {s / p} =\ frac {1} {t_ {0,1} ^ {s / p}} \ left (\ begin {array} {cc} \ hfill 1 \ hfill &\ hfill - {r} _ {1,0} ^ {s / p} \ hfill \\ {} \ hfill {r} _ {1,0} ^ {s / p} \ hfill &\ hfill 1 \ hfill \ end {array} \ right ) {\ displaystyle \ prod_ {l =1} ^ N {T} _ {l / \ left (l + 1 \ right)} ^ {s / p} {\ left (\ begin {array} {c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {array } \ right)} _ {s / p}} ={\ left (\ begin {array} {cc} \ hfill {T} _ {11} \ hfill &\ hfill {T} _ {12} \ hfill \\ {} \ hfill {T} _ {21} \ hfill &\ hfill {T} _ {22} \ hfill \ end {array} \ right)} _ {s / p} {\ left (\ begin {array} { c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {array} \ right)} _ {s / p}. $$ (1)
Asteriscos nos índices superiores de amplitude de campo no meio de saída são usados na Eq. (1) para contabilizar os valores dos componentes do campo elétrico apenas no lado direito do N / N + 1 interface.
A matriz de transferência \ (2 \ times 2 \ kern0.24em {T} _ {l, \ left (l + 1 \ right)} ^ {s / p} \) é responsável pela propagação de ondas planas de l -ésima camada, reflexos múltiplos dentro desta camada e influência de l / (l + 1) interface. Essa matriz pode ser determinada como [17]:
$$ {T} _ {l / \ left (l + 1 \ right)} ^ {s / p} =\ frac {1} {t_ {l / \ left (l + 1 \ right)} ^ {s / p}} \ left (\ begin {array} {cc} \ hfill \ exp \ left (i {\ delta} _l ^ {s / p} \ right) \ hfill &\ hfill - {r} _ {l + 1 , l} ^ {s / p} \ exp \ left (i {\ delta} _l ^ {s / p} \ right) \ hfill \\ {} \ hfill {r} _ {l, l + 1} ^ { s / p} \ exp \ left (-i {\ delta} _l ^ {s / p} \ right) \ hfill &\ hfill \ exp \ left (-i {\ delta} _l ^ {s / p} \ right ) \ hfill \ end {array} \ right), $$ (2)
onde \ ({r} _ {l, l + 1} ^ {s / p} \) e \ ({t} _ {l, l + 1} ^ {s / p} \) denotam reflexão parcial e coeficientes de transmissão para l / (l + 1) interface, \ ({\ delta} _l ^ {s / p} \) é a mudança de fase, imposta à luz após a propagação pelo l- a camada para s - e p -luz polarizada.
Mudança de fase para s - e p -luz polarizada após passar pelo l- a camada pode ser determinada como [17]:
$$ {\ delta} _l ^ {s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _ {l, s / p} \ cos {\ theta} _ {l, s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _l \ sqrt {1 - {\ left (\ frac {1} {n_ {l, s / p}} \ sin \ theta \ right)} ^ 2}, $$ (3)
onde n l é o índice de refração complexo para o l- a camada, d l é a espessura do l- a camada, e θ é o ângulo de incidência.
Coeficientes de reflexão e transmissão parciais para os s - e p -polarizações podem ser calculadas usando as equações de Fresnel. Por exemplo, reflexão parcial e coeficientes de transmissão para os s -polarização tem a seguinte forma [21]:
$$ \ begin {array} {l} {r} _ {l, l + 1} ^ s =\ frac {n_ {ls} \ cos {\ theta} _ {ls} - {n} _ {\ left ( l + 1 \ direita) s} \ cos {\ theta} _ {\ esquerda (l + 1 \ direita) s}} {n_ {ls} \ cos {\ theta} _ {ls} - {n} _ {\ esquerda (l + 1 \ direita) s} \ cos {\ theta} _ {\ esquerda (l + 1 \ direita) s}} \\ {} {t} _ {l, l + 1} ^ s =\ frac {2 {n} _ {ls} \ cos {\ theta} _ {ls}} {n_ {ls} \ cos {\ theta} _ {ls} + {n} _ {\ left (l + 1 \ right) s} \ cos {\ theta} _ {\ left (l + 1 \ right) s}} \ end {array} $$ (4)
As relações de refletância complexas da pilha de multicamadas podem ser obtidas substituindo os coeficientes de reflexão e transmissão parciais para o N + 1 interface (Eqs. (4)) na Eq. (1) e mudanças de fase de todos os N camadas (Eq. (3)):
$$ {R} _ {s / p} ={\ left | {r} _ {0, N + 1} ^ {s / p} \ right |} ^ 2 ={\ left | \ frac {T_ {21 }} {T_ {11}} \ right |} ^ 2. $$
Modelo de função dielétrica IR
O índice de refração depende da função dielétrica complexa ε ( ω ), que pode ser escrito como:
$$ \ varepsilon \ left (\ omega \ right) ={\ varejpsilon} ^ {\ mathrm {lat}} \ left (\ omega \ right) + {\ varejpsilon} ^ {\ mathrm {fc}} \ left (\ omega \ right). $$ (5)
O primeiro termo corresponde à contribuição da dispersão do modo de rede, e o segundo a excitações de portadoras livres.
A contribuição dos modos de rede para a resposta IR ε lat ( ω ) na energia do fônon ℏω pode ser descrito usando um modelo fatorado com alargamento Lorentziano [22]:
$$ {\ varejpsilon} ^ {\ mathrm {lat}} \ left (\ omega \ right) ={\ varepsilon} _ {\ infty} {\ displaystyle \ prod_ {k =1} ^ M \ frac {\ omega_ { \ mathrm {LO} k} ^ 2 - {\ omega} ^ 2-i \ omega {\ gamma} _ {\ mathrm {LO} k}} {\ omega _ {\ mathrm {TO} k} ^ 2 - {\ omega} ^ 2-i \ omega {\ gamma} _ {\ mathrm {TO} k}}}, $$ (6)
onde M é o número de modos de fônon polar infravermelho ativo para s - ou p -polarizações para o c- eixo; ω LOk e ω TOk são a frequência (cm −1 ) do k- o fônon LO e TO; γ LOk e γ TOk são suas constantes de amortecimento (cm −1 ) Para GaN, os parâmetros ω LOk e ω TOk conta para o E 1 (LO), A 1 (LO) e E 1 (TO) e A 1 (TO) modos vibracionais [23].
A contribuição das espécies de portadores livres ε fc ( ω ) à função dielétrica pode ser descrita usando a aproximação clássica de Drude [15]:
$$ {\ varejpsilon} ^ {\ mathrm {fc}} \ left (\ omega \ right) =- {\ varejpsilon} _ {\ infty} \ frac {\ omega_p ^ 2} {\ omega \ left (\ omega + i {\ gamma} _p \ right)}, $$ (7)
com
$$ {\ omega} _p ={\ left (\ frac {N {e} ^ 2} {\ varepsilon _ {\ infty} {\ varejpsilon} _0 {m} ^ {\ ast}} \ right)} ^ {1 / 2} $$ (8) $$ {\ gamma} _p =\ frac {e} {m ^ {\ ast} \ mu} $$ (9)
As frequências de plasma rastreadas ω p (Eq. (8)) dependem da concentração de portador livre N , permissividade dielétrica de alta frequência ε ∞ , e a massa efetiva m ∗ das operadoras gratuitas ( ε 0 é a permissividade do vácuo e e é a carga da unidade elétrica). O parâmetro de amortecimento de plasmon γ p depende da mobilidade da portadora óptica μ (Eq. (9)) [24].
Parâmetros de ω LO e os modos LOPC podem ser determinados a partir da parte imaginária da função de perda de energia - \ (\ mathrm {I} \ mathrm {m} \ left (- \ frac {1} {\ varejpsilon \ left (\ omega \ right)} \ direita) \) [7], onde ε ( ω ) é a função dielétrica complexa, obtida na Eq. (5).
Resultados e discussão
A imagem SEM (Fig. 2) mostra a seção transversal gravada em foto de n + / n 0 / n + -GaN estrutura crescida em GaN-buffer / GaN-template / substrato safira, onde seis camadas distintas são claramente visíveis, que são cinco camadas de GaN com diferentes concentrações de portadores e substrato de safira. Deve-se notar que a espessura total da estrutura de GaN investigada, medida por SEM, concorda com a tecnológica, e as camadas de GaN observadas de acordo com a Fig. 1 podem ser atribuídas provisoriamente ao topo nominal dopado com Si n + região (camada 1), sem dopagem n 0 região (camada 2), n + dopada com Si inferior região (camada 3), buffer de GaN não dopado (camada 4) e modelo de GaN.
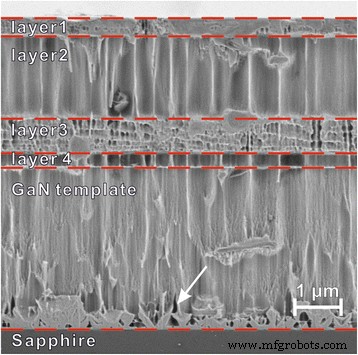
Imagem SEM da seção transversal do n + investigado / n 0 / n + Estrutura -GaN. O padrão irregular de linhas verticais foi formado durante a clivagem (ou seja, antes da foto-corrosão) e é característico das clivagens não polidas de Al 2 O 3 / Heteroestruturas de GaN. Camada piramidal áspera ( orifícios ) no modelo safira / GaN indicado pela seta foi revelado por foto-gravura
Além disso, a fim de ter uma visão mais profunda sobre o nível de impureza / dopagem das amostras investigadas, medições SIMS foram realizadas. Os perfis SIMS obtidos (Fig. 3) estão em boa correlação com a espessura nominal das camadas de GaN e a espessura total da estrutura multicamadas estudada. Todos os elementos examinados (H, C, O, Si) estavam acima do limite de detecção (3 a 5 × 10 16 em / cm 3 ) da técnica SIMS.
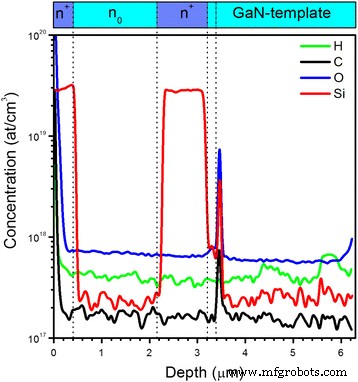
Perfis de elementos de impureza do n + investigado / n 0 / n + Estrutura -GaN medida por SIMS a partir da superfície da amostra
Perfil de dopagem intencional de Si, em geral, concorda com o perfil de dopagem nominal com a concentração de cerca de 2,8 × 10 19 cm −3 na parte superior e inferior com dopagem n + regiões e de cerca de 2,3 × 10 17 cm −3 no não dopado n 0 região. No entanto, como pode ser visto nos dados do SIMS, também há uma camada delta fina (<50 nm) com concentração de Si de 1,1 × 10 19 cm −3 entre o buffer GaN e o modelo GaN. Deve-se notar que a camada delta dopada com Si também contém concentrações mais altas de oxigênio não intencional e impurezas de carbono de 2,4 × 10 19 cm −3 e 1,4 × 10 18 cm −3 , correspondentemente. Essa camada delta está relacionada com a interface de rebrota homoepitaxial, que normalmente surge da contaminação do template GaN com impurezas O, Si e C, absorvidas da atmosfera no processo tecnológico de carregamento ou no início da rebrota [25, 26].
Como discutido acima, a seção transversal SEM e a análise SIMS fornecem a estrutura das camadas de GaN, que difere dos parâmetros nominais por excitação da região de GaN adicional, mas com a espessura geral de acordo com a nominal. A fim de esclarecer a influência da camada delta de GaN adicional encontrada acima no espectro de refletância IR da estrutura investigada, a simulação do espectro experimental foi realizada através da construção de modelos consistindo de seis camadas, que correspondem a parâmetros tecnológicos nominais, imagens SEM ( Fig. 1) e sete camadas de acordo com SIMS. Os espectros calculados com base nos modelos descritos acima são dados na Fig. 4.

Simulações dos espectros de refletância IR com diferentes números de camadas. O espectro experimental do investigado n + / n 0 / n + -A estrutura GaN é mostrada por linha sólida . a Região Reststrahlen. b O espectro ampliado na faixa acima de 750 cm −1
Como pode ser visto na Fig. 4, com base no modelo de sete camadas do perfil SIMS dá a melhor aproximação do espectro de refletância IR experimental. Assim, simulações e análises posteriores são realizadas utilizando este modelo com parâmetros modificados, em comparação com os tecnológicos nominais (Fig. 1), e que dá conta da camada adicional entre a camada de buffer de GaN tecnológica e o template de GaN (Fig. 5).
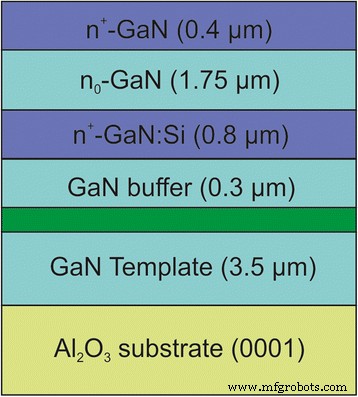
O modelo de 7 camadas usado para simular os espectros de refletância IV do n + investigado / n 0 / n + Estrutura -GaN. Uma camada adicional ( verde ) é a camada de interface fina entre o modelo de GaN e as camadas de GaN investigadas
A Figura 6 mostra s experimentais e teóricos ajustados -espectro de refletância polarizado da estrutura investigada no ângulo de incidência de 11 °. O espectro calculado é baseado no modelo descrito acima (Fig. 5). A dispersão do índice de refração complexo para as camadas de GaN e o substrato de safira foi determinada usando a Eq. (5). O substrato safira foi considerado semi-infinito, o que permitiu desprezar os reflexos internos dentro do substrato e do verso não polido. A complicada estrutura observada na região reststrahlen do espectro é devido a uma combinação da sobreposição de GaN e Al 2 O 3 bandas reststrahlen junto com efeitos de interferência. A comparação desses dados com os espectros calculados não só pode fornecer informações sobre a espessura das várias camadas das amostras, mas também pode ajudar a interpretar a complicada estrutura da região reststrahlen em termos das contribuições dos vários materiais.

Experimental ( linha sólida ) e melhor ajuste calculado ( linha traço e ponto ) Espectros de refletância de IV do n + / n 0 / n + Estrutura -GaN desenvolvida em GaN-template / Al 2 O 3 . a Região Reststrahlen. b Região de interferência
A determinação da espessura da camada a partir da comparação dos dados de refletância com o espectro calculado é um processo de duas etapas [27]. Primeiro, as franjas na região transparente acima das bandas reststrahlen (ω> 1200 cm −1 ) são devidos a efeitos de interferência nas camadas da estrutura multicamadas. Desta forma, a espessura total da estrutura investigada, que é a soma de todas as camadas, pode ser estimada.
Uma vez que a espessura da pilha é conhecida, as espessuras individuais de cada camada podem ser determinadas ajustando os espectros calculados aos efeitos de interferência na região restante do espectro. As espessuras da camada foram variadas levando-se em consideração a espessura total previamente determinada. Sob esta restrição, a refletância acima de 1200 cm −1 não muda significativamente. Os efeitos de interferência na região reststrahlen podem ser distinguidos de outros recursos, como modos vibracionais TO e LO, com base no fato de que as franjas de interferência mudam de posição conforme as espessuras da camada variam [28].
Durante a aproximação do espectro experimental na região reststrahlen, os seguintes parâmetros do modelo foram variados:parâmetros de amortecimento γ LO e γ PARA para E 1 (LO) e E 1 (TO) modos de fonon; frequência de plasma ω p ; parâmetro de amortecimento de plasmon γ p ; e espessuras de camada. Deve-se notar que apenas E 1 fônons de simetria são IR ativos em s -polarização [9]. Frequências iniciais de E 1 (LO) e E 1 Fônons (TO) para GaN e substrato de safira foram retirados dos experimentos de refletância de IV [29] e espalhamento Raman [6, 14]. Os valores típicos da frequência de fonon de GaN são ω TO =560 cm −1 e ω LO =740 cm −1 . As frequências de fônons para cada camada foram refinadas no processo de adaptação. Os parâmetros de melhor ajuste obtidos com as barras de erro são apresentados na Tabela 1. Deve-se notar que as espessuras das camadas obtidas no processo de ajuste estão em boa concordância com os dados do MEV.
Referindo-se à Fig. 6a, o pico de refletância em ~ 450 cm −1 pode ser atribuído ao substrato de safira. As características observadas no intervalo de 500–740 cm −1 são devido a uma combinação de recursos sobrepostos de camadas de GaN e bandas de reststrahlen de safira. Para uma análise mais profunda, os espectros de refletância IV do GaN em massa e da camada de GaN de 6,78 μm de espessura na safira, com a espessura de GaN correspondendo à espessura total da estrutura investigada, foram simulados na região da banda reststrahlen (Fig. 7) . Como pode ser visto na Fig. 7, os espectros de refletância da camada de GaN de 6,78 de espessura na safira e GaN em massa na faixa de 500-740 cm −1 são semelhantes ao espectro experimental. O pequeno recurso em ~ 511 cm −1 está associado ao substrato safira. Deve ser mencionado que em ~ 736 cm −1 , há uma queda fraca que corresponde a A 1 (LO) modo do modelo GaN. De acordo com as regras de seleção, A 1 O modo (LO) é proibido em s espectros de IV polarizados [9]. A possível razão para o registro deste modo proibido pode ser um vazamento de polarização devido à abertura do acessório de refletância, bem como microinhomogeneidades da estrutura do cristal de GaN. Especificamente, isso pode ser causado pela inclinação do c -eixo da estrutura wurtzita em forma de coluna de GaN da direção perpendicular ao plano de crescimento do filme. Este modo não foi levado em consideração em nossa modelagem devido ao seu fraco impacto no espectro resultante. Os recursos na faixa de 750–1200 cm −1 são devido à sobreposição de GaN:Si e bandas reststrahlen de safira e efeitos de interface. A queda em ~ 775 cm −1 está relacionado ao efeito de interface na borda da banda reststrahlen de camadas de GaN e safira. O amplo mergulho em ~ 825 cm −1 está associado à sobreposição do ramo de alta frequência do modo acoplado plasmon-LO-fônon (LPP + ) do n + camadas.
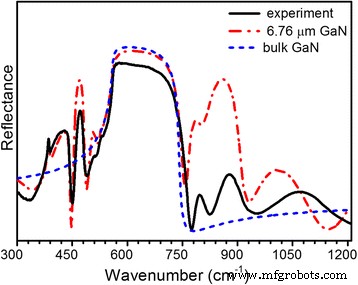
Experimental ( linha sólida ) Espectros de refletância de IV do n + investigado / n 0 / n + -Estrutura de GaN e espectros de refletância calculados de camada de GaN de 6,78 μm de espessura em safira ( linha traço-ponto ) e GaN em massa ( linha tracejada )
A Figura 8 mostra as partes imaginárias calculadas da função de perda de energia para cada camada de acordo com os parâmetros do oscilador dados na Tabela 1 para estimativa de E 1 Modos -LOPC. Como pode ser visto, o ramo de alta frequência dos modos LOPC (LPP + ) em concentrações de portadores inferiores a 10 17 cm −3 (n 0 camada e modelo) quase coincidem com E 1 (LO) modo phonon. O aumento na concentração de portadores na faixa de 2 × 10 17 –3 × 10 18 cm −3 (Fig. 5) leva a uma mudança significativa de alta frequência e ao alargamento do LPP + ramo, que indica o aumento da interação entre o fônon LO e o plasmão e a diminuição da mobilidade dos portadores de carga. Este comportamento do LPP + branch concorda bem com os dados experimentais sobre refletância IV de filmes de GaN dopados com Si cultivados em safira por Z.F. Li et al. [30], e medição Raman em GaN bulk [10] e camadas epitaxiais [31]. Deve-se notar que o LPP de baixa frequência - ramo do LOPC não pode ser definido de forma confiável em nosso caso, como s -espectros de refletância de IV polarizados não foram medidos na faixa de baixa frequência abaixo de 300 cm −1 .

Parte imaginária calculada da função dielétrica obtida para cada camada de GaN analisada a partir da análise de dados de melhor ajuste
Os valores de concentração de transportadores e mobilidade listados na Tabela 2 foram calculados usando Eqs. (8) e (9) com massa efetiva de elétron m * de 0,2 m 0 [32]. Pode ser visto que o perfil de concentração de transportador calculado é semelhante ao perfil de concentração de impureza de Si obtido por medições SIMS (Fig. 3), mas com concentrações de transportador da ordem de magnitude mais baixas em comparação com a concentração de impureza de Si. Essa discrepância nas concentrações de portadores e impurezas de dopagem foi observada anteriormente por M. Bockowski et al. [33], e foi relacionado aos efeitos de compensação por estados aceitadores (provavelmente por vacâncias de gálio), a energia de formação da qual diminui com o aumento da dopagem do tipo n [34]. Deve ser mencionado que a concentração de portadores para o n + camadas na ordem de ~ 10 18 cm −3 está de acordo com os resultados de nossos estudos Raman de estruturas GaN semelhantes com base na análise dos modos LOPC [6]. A diminuição obtida da mobilidade do portador µ com a concentração do portador também está de acordo com os experimentos de Hall em GaN [35] e modelagem teórica [36].
Os valores de permissividade dielétrica de alta frequência ε ∞ foram encontrados no intervalo de 4,99-5,35 (Tabela 1). O aumento em ε ∞ para o dopado n + camadas em comparação com n 0 camadas podem estar relacionadas ao desvio para o vermelho do gap de α-GaN [37]. Deve-se notar que os valores de ε ∞ pode ser determinado com erro relativamente pequeno apenas para filmes de baixa condutividade. Precisão na determinação de ε ∞ diminui com a concentração do portador, o que está relacionado ao fato de que o ε ∞ parâmetro é responsável pelo limite de “alta frequência” quando a função do modelo dielétrico é extrapolada para números de onda mais curtos do que aqueles estudados aqui [11]. A ampla faixa espectral de 300–4000 cm −1 foi analisado a fim de diminuir o erro na determinação de ε ∞ e outros parâmetros envolvidos na modelagem dos espectros de refletância IR de n + camadas.
Conclusões
Os espectros de refletância IV da estrutura de multicamadas consistindo em camadas de GaN crescidas em um substrato de safira e dopadas com diferentes concentrações de impurezas de Si foram medidos e analisados em detalhes. A análise da estrutura investigada por MEV da seção transversal fotocondicionada mostrou boa correlação com os parâmetros tecnológicos das camadas de GaN. A análise de SIMS também revelou a presença de uma camada delta delta perto da interface GaN buffer / GaN-template com maior conteúdo de impurezas de Si e O, o que está relacionado à interface de rebrota homoepitaxial. A modelagem do espectro de refletância IV da estrutura multicamadas estudada, incluindo na análise a camada adicional, permitiu obter o melhor ajuste do espectro experimental. As espessuras obtidas das camadas de GaN estão em boa concordância com os dados SEM e SIMS. Calculado a partir da dependência espectral da permissividade dielétrica, os modos LOPC para cada camada de GaN mostraram deslocamento de alta frequência e alargamento do LPP + ramificar com o aumento da concentração de portadores. A concentração e a mobilidade do portador de carga para cada camada de GaN foram calculadas a partir da frequência do plasmon e do parâmetro de amortecimento. Obtained carrier concentration profile is similar to those obtained by SIMS, but with values of carrier concentration one order of magnitude less than the concentration of Si doping impurity, which can be attributed to compensation effects by the defect acceptor states. Thus, it is demonstrated that IR reflectance spectroscopy and 2 × 2 transfer matrix method can be successfully used for analysis of epitaxial multilayer GaN structures with non-uniform doping profiles, and allow for the determination of the fundamental electron and phonon parameters of each GaN layer.
Change history
Abreviações
- IR:
-
Infrared
- FTIR:
-
Espectroscopia de infravermelho com transformada de Fourier
- SEM:
-
Microscopia eletrônica de varredura
- SIMS:
-
Secondary ion mass spectrometry
- LOPC:
-
Longitudinal optical phonon– plasmon coupled
Nanomateriais
- Estrutura e propriedades eletrônicas da nanoargila caulinita dopada com metal de transição
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- Novos nanocompósitos de poliestireno com polianilina dopada com ácido lauril sulfúrico
- Dependência da temperatura do gap em MoSe2 crescido por epitaxia de feixe molecular
- Nanofios de silício amorfo cultivados em filme de óxido de silício por recozimento
- Células endoteliais de segmentação com nanopartículas de GaN / Fe multifuncionais
- Análise de mapeamento Raman de micro-ressonadores de silício integrados com grafeno
- Camadas ótimas de dopagem de silício de barreiras quânticas na sequência de crescimento, formando potencial de confinamento suave de oito períodos em 0,2Ga0,8N / GaN poços quânticos de azul LED…
- Mudança de estrutura de GaN entre Nanowall Network, Nanocolumn e Compact Film Grown on Si (111) por MBE
- Compreendendo o mecanismo de crescimento de camadas epitaxiais de GaN em grafite esfoliado mecanicamente



