Crescimento auto-propagado de MOCVD e fotoluminescência dramaticamente aprimorada de nanofios InGaAs / InP Core – Shell
Resumo
Nós relatamos o crescimento e a caracterização de nanofios InGaAs / InP núcleo-casca em substratos de Si- (111) por deposição de vapor químico orgânico de metal (MOCVD). A deformação na interface núcleo-casca induzida pela grande incompatibilidade de rede entre o núcleo InGaAs e os materiais da casca InP tem forte influência no comportamento de crescimento da casca InP, levando ao crescimento assimétrico da casca InP em torno do núcleo InGaAs e até mesmo no curvatura dos nanofios. Medições de microscopia eletrônica de transmissão (TEM) revelam que o invólucro InP é coerente com o núcleo InGaAs sem quaisquer deslocamentos desajustados. Além disso, as medições de fotoluminescência (PL) a 77 K mostram que a intensidade do pico de PL dos nanofios de núcleo-casca InGaAs / InP exibe um aumento de ∼ 100 vezes em comparação com a única amostra de núcleo InGaAs sem invólucro InP devido à passivação dos estados de superfície e efetivo confinamento de portador resultante da camada de invólucro InP. Os resultados obtidos aqui aumentam nossa compreensão do comportamento de crescimento de nanofios de heteroestrutura de núcleo-casca distendidos e podem abrir novas possibilidades para aplicações em dispositivos optoeletrônicos baseados em nanofios de heteroestrutura InGaAs / InP na plataforma de Si.
Histórico
Nanofios semicondutores III-V foram reconhecidos como candidatos promissores para dispositivos em nanoescala de próxima geração devido às suas propriedades eletrônicas, ópticas e geométricas únicas [1,2,3,4]. Entre os materiais semicondutores III-V, o nanofio InGaAs ternário é extremamente atraente para aplicações fotônicas e optoeletrônicas devido às suas excelentes propriedades físicas, como grande faixa controlável de band-gap direto, pequena massa efetiva de portadora e alta mobilidade de portadora. Além disso, a integração de materiais III-V com uma plataforma de Si, que permite a combinação das vantagens das propriedades físicas exclusivas dos materiais III-V com tecnologia de semicondutor de óxido de metal complementar (CMOS), foi intensamente estudada. Por causa da pequena pegada, os nanofios fornecem uma oportunidade para a integração de materiais III-V com Si, ignorando a grande diferença nos parâmetros de rede entre os materiais [5, 6]. Até agora, vários dispositivos baseados em nanofios InGaAs ternários foram fabricados em substratos de Si, incluindo transistores de alta velocidade de baixa potência [7, 8], dispositivos baseados em tunelamento [9, 10], diodos emissores de luz (LEDs) [11 ], dispositivos fotônicos [12, 13] e células solares [14, 15].
No entanto, devido à alta relação superfície-volume do nanofio unidimensional, os numerosos estados de superfície tornaram-se a principal limitação na obtenção de dispositivos optoeletrônicos baseados em nanofios de alto desempenho. Por um lado, esses estados de superfície podem degradar muito as propriedades eletrônicas e ópticas dos materiais III-V por meio de espalhamento e um processo de recombinação não radiativa [16,17,18,19,20]. Por outro lado, para nanofios de alguns materiais de gap estreito (como InAs, InGaAs rico em In), a alta densidade de estados de superfície pode levar a uma curvatura da estrutura da banda eletrônica perto da superfície do nanofio (efeito de nível de Fermi de superfície fixado ) Tal estrutura de banda não plana irá ainda causar redistribuição do portador de carga, o que pode dificultar fortemente o desempenho de dispositivos baseados em nanofios ópticos [21]. Portanto, a eliminação desses estados de superfície é altamente necessária. Para nanofios InGaAs ternários com composição mais elevada, o InP é uma camada de passivação de superfície desejável, pois o sistema de material forma um alinhamento de intervalo de banda do tipo I, que pode confinar os portadores em InGaAs de forma eficaz. Além disso, para o sistema de material InGaAs / InP, que tem sido amplamente investigado em estruturas planas, seu comprimento de onda de emissão é sintonizável na faixa de 1,31-1,55 μm, o que tem uma perspectiva promissora na comunicação por fibra óptica.
Neste trabalho, realizamos o crescimento e caracterização de nanofios InGaAs / InP núcleo-casca em substratos de Si- (111) usando deposição de vapor químico orgânico de metal (MOCVD). Verificou-se que a deformação na interface núcleo-casca resultante da grande incompatibilidade de rede entre o núcleo e os materiais da casca tem forte influência no comportamento de crescimento da casca InP. A grande incompatibilidade de rede entre os materiais do núcleo e da casca pode levar à nucleação não uniforme da camada de revestimento de InP em torno dos nanofios do núcleo de InGaAs e até mesmo à dobra dos nanofios. Ao otimizar as condições de crescimento, os nanofios núcleo-shell InGaAs / InP com boa morfologia podem ser alcançados. Além disso, as medições de fotoluminescência (PL) a 77 K mostram que a intensidade do pico de PL dos nanofios núcleo-shell InGaAs / InP mostra um aumento de cerca de 100 vezes em comparação com os nanofios InGaAs nus devido à passivação dos estados de superfície e confinamento efetivo do portador via revestimento InP camada.
Métodos / Experimental
Crescimento Nanowire
Os nanofios de núcleo-shell InGaAs / InP foram cultivados por um sistema MOCVD de chuveiro de acoplamento próximo (AIXTRON Ltd., Alemanha) a 133 mbar. Trimetilíndio (TMIn) e trimetilgálio (TMGa) foram usados como precursores do grupo III, e arsina (AsH 3 ) e fosfina (PH 3 ) foram usados como precursores do grupo V. Hidrogênio de pureza ultra-alta (H 2 ) foi usado como gás de arraste e a taxa de fluxo total de H 2 era de 12 slm. Antes do crescimento, os substratos de Si– (111) foram aquecidos a 635 ° C para recozimento e, em seguida, resfriados a 400 ° C sob AsH 3 fluxo para formar (111) superfícies semelhantes a B [22]. Os nanofios de núcleo InGaAs foram cultivados a 565 ° C por 15 min. Durante o processo de crescimento, TMIn e AsH 3 taxas de fluxo são de 0,8 × 10 - 6 mol / min e 1,0 × 10 - 4 mol / min, enquanto a taxa de fluxo TMGa é variada. A composição da fase vapor de TMGa, Xv, que foi definida como a razão das taxas de fluxo TMGa / (TMGa + TMIn), foi variada de 30 a 40%. O invólucro InP foi cultivado a 565 ° C por 10 min com TMIn e PH 3 taxas de fluxo de 2 × 10 - 6 mol / min e 8,0 × 10 - 4 mol / min, respectivamente. Após o crescimento, as amostras foram resfriadas à temperatura ambiente usando PH 3 como um agente de proteção.
Métodos de caracterização
A morfologia dos nanofios foi caracterizada por microscopia eletrônica de varredura (SEM) (Nova Nano SEM 650) e microscopia eletrônica de transmissão (TEM) (JEM2010F TEM; 200 kV) em conjunto com espectroscopia de energia dispersiva de raios-X (EDS). investigar a estrutura e composição do cristal, respectivamente. Para observações TEM, os nanofios foram transferidos mecanicamente das amostras para grades de cobre revestidas com um filme de carbono. Para investigar as propriedades ópticas dos nanofios crescidos, medições de fotoluminescência (PL) foram realizadas usando um laser de comprimento de onda de 532 nm como fonte de excitação. As amostras foram excitadas com uma potência de laser de ~ 100 mW sobre um tamanho de ponto com um diâmetro de aproximadamente 150 μm. O sinal PL foi alimentado diretamente em um espectrômetro infravermelho com transformada de Fourier (FTIR) e registrado por um detector InSb refrigerado a nitrogênio líquido. O espelho móvel no espectrômetro FTIR funcionou em um modo de varredura rápida [23], diferindo das medições de PL moduladas por varredura em etapas em nanofios de InAs na região do infravermelho médio [24].
Resultados e discussão
A Figura 1 mostra uma ilustração esquemática do crescimento de nanofios de núcleo-shell InGaAs / InP em um substrato Si- (111) e as sequências de fornecimento de fonte para o crescimento dos nanofios. Nanofios de InGaAs crescem por um mecanismo autocatalisado [25]. Observe que as gotas de entrada serão consumidas sob um AsH 3 atmosfera (mostrado na região 3 na Fig. 1). O crescimento excessivo do shell InP foi iniciado trocando o AsH 3 para PH 3 fluxo e abrindo o fluxo TMIn simultaneamente.
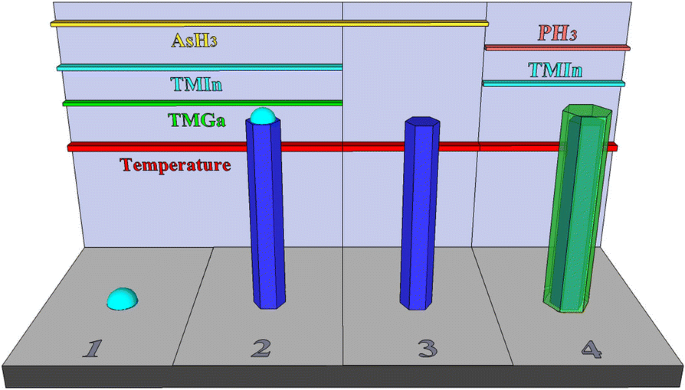
Ilustração esquemática do crescimento de nanofios de núcleo-shell InGaAs / InP e as sequências de fornecimento de fonte para o crescimento de nanofios
A Figura 2a, b mostra imagens SEM típicas de nanofios núcleo-shell InGaAs e InGaAs / InP nus com Xv =30%, respectivamente. Todos os nanofios InGaAs são alinhados verticalmente no substrato de Si com diâmetro uniforme ao longo de todo o comprimento. Após o subsequente crescimento do shell InP, os nanofios ainda estão com facetas laterais suaves, indicando a otimização dos parâmetros de crescimento. A partir das distribuições estatísticas dos diâmetros dos nanofios de núcleo-shell InGaAs e InGaAs / InP nus, o diâmetro médio dos nanofios aumenta de ∼ 65 a ∼ 95 nm após o crescimento do invólucro InP, o que indica a espessura média do invólucro InP de aproximadamente 15 nm. No entanto, os nanofios de núcleo-shell InGaAs / InP na Fig. 2b são visivelmente dobrados, o que é induzido pela tensão no nanofio de núcleo InGaAs causada pelo invólucro InP devido à grande incompatibilidade de rede entre os materiais do núcleo e da camada. A Figura 2c, d mostra imagens SEM dos nanofios núcleo-shell InGaAs / InP com Xv de 35% e 40%, respectivamente. Em comparação com os nanofios na Fig. 2b, a curvatura dos nanofios núcleo-shell InGaAs / InP com Xv de 35% reduziu bastante (Fig. 2c). Aumentando ainda mais o Xv para 40%, os nanofios são retos, sem dobra visível (Fig. 2d). Este fenômeno pode ser atribuído à redução na incompatibilidade de rede entre o núcleo InGaAs e os materiais da casca InP com o aumento da composição de Ga. Além disso, a partir das distribuições estatísticas dos diâmetros dos nanofios núcleo-casca InGaAs / InP, conforme a composição de Ga aumenta, o diâmetro do nanofio aumenta ao mesmo tempo, o que também pode impedir que os nanofios do núcleo InGaAs se dobrem após o revestimento InP.

a Imagens SEM 30 ° de inclinação dos nanofios InGaAs e nanofios núcleo-shell InGaAs / InP com Xv, de b 30%, c 35% e d 40%
Para investigar a estrutura cristalina dos nanofios crescidos e confirmar a existência da estrutura núcleo-casca após o crescimento da casca InP, foram realizadas medições detalhadas de TEM. Conforme mostrado na Fig. 3a, a estrutura cristalina do nanofio InGaAs com Xv de 35% é composta por um politipo de estruturas wurtzita (WZ) e zinco-blenda (ZB) com um grande número de falhas de empilhamento (SFs) ao longo de seu crescimento e devido à coexistência de estruturas WZ e ZB juntamente com defeitos estruturais, os pontos de difração de elétrons de área selecionada (SAED) correspondentes se dividem e são ligeiramente alongados ao longo da direção de crescimento (inserção na Fig. 3a). Esses defeitos planos são comumente observados no crescimento de nanofios de InAs ou InGaAs sem catalisador estranho por MOCVD [26,27,28]. A Figura 3b mostra uma imagem TEM de baixa resolução de campo claro (BF) de um nanofio de núcleo-shell típico InGaAs / InP com Xv de 35% (como mostrado na Fig. 2c). Após o revestimento de InP, o nanofio ainda é bastante reto, sem afilamento. Uma imagem TEM de alta resolução (HR) correspondente é mostrada na Fig. 3c. Uma interface clara entre o núcleo InGaAs e o shell InP pode ser observada. Além disso, nenhum deslocamento desajustado foi encontrado seguindo os planos {111} na interface núcleo-shell. Portanto, o shell InP conforme crescido é coerente com o núcleo InGaAs. Além disso, devido ao crescimento epitaxial coerente da camada de revestimento InP, a estrutura cristalina do invólucro InP herdará completamente a do nanofio núcleo InGaAs, conforme confirmado pela estrutura WZ / ZB mista do nanofio núcleo − shell InGaAs / InP na Fig 3c. Este fenômeno foi observado em nanofios core-shell de outros sistemas de materiais [29,30,31], e o comportamento destaca a necessidade de melhorar a qualidade do cristal dos nanofios InGaAs autocatalisados.
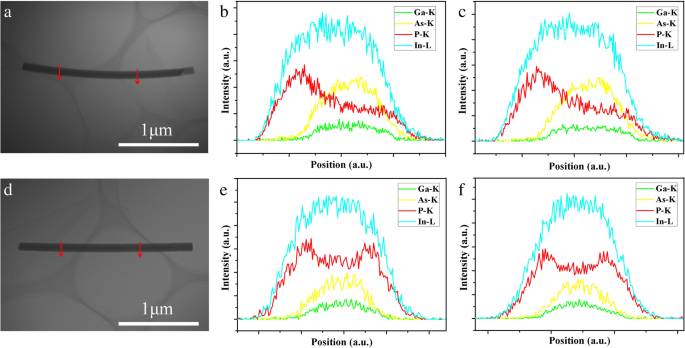
a Imagem HRTEM do nanofio InGaAs nu (Xv =35%) adquirido do eixo da zona <110>. A inserção é o padrão de difração de elétrons de área selecionada (SAED) correspondente. b Imagem TEM de baixa ampliação de um nanofio de núcleo-shell InGaAs / InP (Xv =35%). c Imagem HRTEM do nanofio visto do eixo da zona <110>. A linha tracejada vermelha indica a interface entre o núcleo e a casca
A Figura 4a-c mostra uma imagem TEM de baixa ampliação e análises EDS de um nanofio núcleo-shell InGaAs / InP típico mostrado na Fig. 2b. De acordo com as varreduras de linha EDS através do nanofio, o sinal P pode ser obviamente identificado no espectro, indicando a existência de um shell InP em torno do núcleo InGaAs. Considerando que o espectro EDS do sinal P é assimétrico, o que implica que o crescimento excessivo do shell InP não é uniforme em torno do nanofio principal InGaAs. Especulamos que este fenômeno pode ser induzido principalmente pela incompatibilidade de rede relativamente grande entre os materiais do núcleo e da casca, e tal nucleação não uniforme da casca InP resultará ainda mais na dobra dos nanofios. Em contraste, para o nanofio núcleo-shell InGaAs / InP (Xv =35%) direto na Fig. 2c, as análises de EDS na Fig. 4e-f mostram distribuições simétricas do sinal P em todo o nanofio, indicando a uniformidade melhorada do shell InP ao redor o núcleo InGaAs com o aumento do conteúdo de Ga aqui.
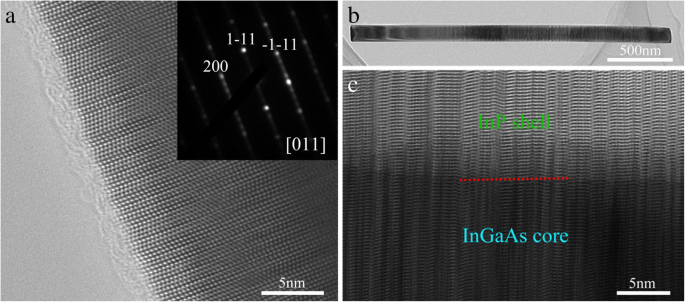
a Uma imagem TEM de baixa ampliação de um nanofio InGaAs / InP (Xv =30%) núcleo-casca. b , c Varreduras de linha EDS ao longo das duas linhas vermelhas marcadas em a . d Uma imagem TEM de baixa ampliação de um nanofio InGaAs / InP (Xv =35%) núcleo-casca. e , f A linha EDS digitaliza ao longo das duas linhas vermelhas marcadas em ( d )
Para investigar as propriedades ópticas dos nanofios crescidos, medições de fotoluminescência (PL) foram realizadas. A Figura 5 compara os espectros PL típicos dos nanofios InGaAs nus e InGaAs / InP (Xv =30%) núcleo-casca a 77 K. O espectro PL dos nanofios InGaAs nus mostra uma emissão muito mais fraca com pico em ∼ 0,73 eV (linha azul em Fig. 5), enquanto o espectro PL dos nanofios núcleo-shell InGaAs / InP exibe uma emissão muito forte com pico de ∼ 0,78 eV (linha vermelha na Fig. 5) e a intensidade do pico PL mostra um aumento de ∼ 100 vezes em comparação para os nanofios InGaAs nus. Como as densidades de nanofios de diferentes amostras são comparáveis, consideramos que esse aumento dramático de emissão de PL de nanofios de núcleo-casca de InGaAs / InP é causado pela supressão efetiva de estados de superfície e confinamento de portador pela camada de revestimento de InP.
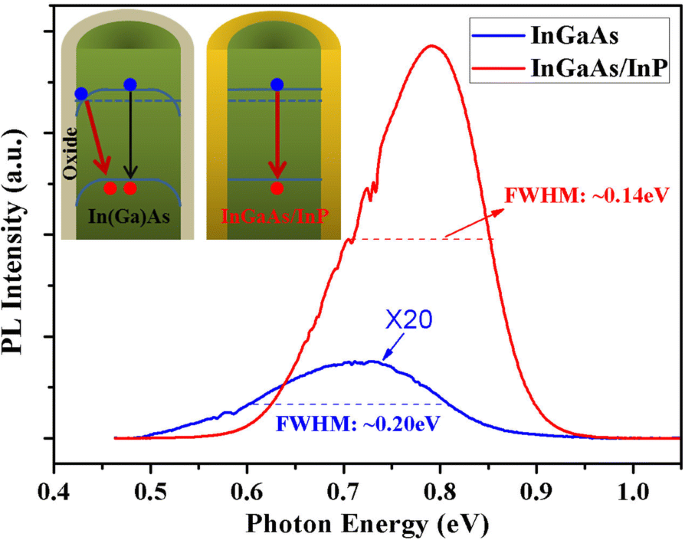
Espectros PL de nanofios de núcleo-casca de InGaAs e InGaAs / InP (Xv =30%) a 77 K. A inserção é uma ilustração esquemática das estruturas de banda de InGaAs e InGaAs / InP de nanofios de núcleo-casca nus
Outra característica interessante é o ligeiro deslocamento para o azul do pico InGaAs / InP PL (∼ 50 meV) em comparação com os nanofios InGaAs nus. Em primeiro lugar, atribuímos esse comportamento diferente a uma mudança no caminho de recombinação da portadora dominante quando o núcleo InGaAs é revestido com invólucro InP. Normalmente, para os nanofios InAs nus ou InGaAs ricos em InGaAs com superfícies cobertas por óxido nativo, o nível de Fermi da superfície é fixado na banda de condução induzida pelos vários estados de superfície, o que causará uma curvatura da banda para baixo perto da superfície do nanofio. Então, essa estrutura de banda não plana levará à redistribuição do portador, onde os elétrons se acumulam perto da superfície do nanofio, enquanto os buracos ficam no centro do nanofio. Sob iluminação, a transição do par elétron-buraco espacialmente indireta com menor energia será preferida, como mostrado na inserção na Fig. 5. Para nanofios InAs nus, foi relatado que a diferença de energia entre a emissão próxima à borda da banda e a relacionada à superfície a emissão é de aproximadamente ~ 35–45 meV [21]. No entanto, para os nanofios InGaAs, como a curvatura da banda da superfície é significativamente reduzida com o aumento da composição de Ga, essa diferença de energia diminuiria simultaneamente e, então, os elétrons seriam menos confinados perto da superfície do nanofio e os buracos seriam menos localizados no centro do nanofio. Portanto, consideramos que o espectro PL dos nanofios InGaAs nus é uma mistura de emissão relacionada à superfície e emissão próxima à borda da banda. Por causa da separação espacial, a probabilidade de transição mediada pela superfície é muito baixa. Além disso, os numerosos estados de superfície podem consumir pares de elétrons-orifícios extras por meio do processo de recombinação não radiativa. Assim, a intensidade PL dos nanofios InGaAs nus é extremamente fraca.
No entanto, a situação mudaria quando os nanofios de núcleo InGaAs fossem revestidos com invólucro InP. Como os estados de superfície dos nanofios do núcleo são removidos efetivamente e o invólucro InP atua como uma barreira de energia, confinando efetivamente os portadores aos nanofios InGaAs, a transição direta perto da borda da banda com maior probabilidade de transição torna-se dominante, conforme confirmado pelo aumento significativo da emissão de PL. Além disso, devido à eliminação da emissão relacionada à superfície, o espectro PL dos nanofios núcleo-shell InGaAs / InP mostra uma largura total mais estreita na metade do máximo (FWHM) em comparação com os nanofios InGaAs nus. Como mencionado anteriormente, por causa da flexão de banda de superfície aliviada para nanofios de InGaAs obtidos aqui, a diferença de energia entre a emissão próxima da borda da banda e a emissão relacionada à superfície deve ser muito menor do que ~ 50 meV obtida aqui. Assim, além deste efeito, especulamos que a deformação é a principal origem do desvio para o azul observado. Como o invólucro InP cresceu coerentemente no núcleo InGaAs livre de deslocamentos desajustados na interface, o núcleo InGaAs está sob tensão compressiva, o que pode induzir o alargamento da lacuna de banda do nanofio do núcleo InGaAs e explicar o desvio para o azul da emissão de pico PL [ 32, 33]. Portanto, ao aumentar a camada de revestimento de InP, a energia de pico de PL dos nanofios de InGaAs deve exibir um desvio para o azul e sua intensidade de emissão de PL pode ser bastante melhorada.
A Figura 6a mostra espectros PL normalizados de nanofios núcleo-shell InGaAs / InP com Xv diferente a 77 K. A energia de pico PL mostra um deslocamento azul contínuo (de ~ 0,78 eV a ~ 0,86 eV) com o aumento de Xv na faixa de 30 a 40 % Além disso, a partir das medições de PL à temperatura ambiente, a emissão dos nanofios núcleo-casca InGaAs / InP atinge o pico na faixa de comprimento de onda de 1,49-1,68 μm, que tem atenuação de potência mínima na comunicação de fibra óptica (região de ~ 1,55 μm). A Figura 6b exibe os espectros PL dependentes da temperatura para a amostra de nanofio núcleo-casca InGaAs / InP com Xv =40%, e a inserção mostra o deslocamento dependente da temperatura correspondente na energia de pico PL. Normalmente, no material a granel monocristalino, a dependência da luminescência com a temperatura exibe um desvio para o vermelho contínuo com o aumento da temperatura de acordo com a equação de Varshni. Curiosamente, a partir da inserção na Fig. 6b, o desvio para o vermelho só pode ser observado na faixa de temperatura de 60–290 K. Quando a temperatura está abaixo de 60 K, a energia de pico PL permanece quase inalterada. Considerando a alta densidade de defeitos estruturais nos nanofios crescidos, especulamos que esse fenômeno é provavelmente causado por estados de armadilha localizados perto da borda da banda [34]. Em baixa temperatura, a emissão é dominada por armadilha assistida. Com o aumento da temperatura, os portadores presos são excitados dos estados de armadilha de baixa energia para a borda da banda. Portanto, a energia de pico de PL na região de baixa temperatura não segue o desvio para o vermelho contínuo comumente observado com a temperatura e tende a ser subestimada em comparação com a borda precisa da banda.
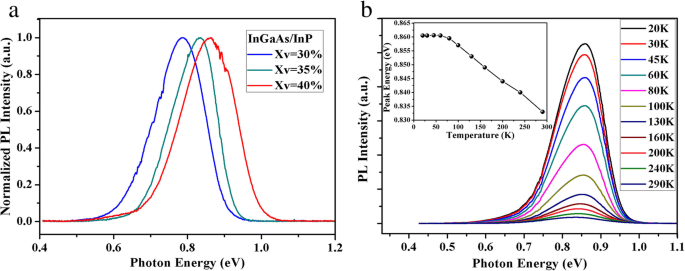
a Espectros PL normalizados de nanofios núcleo-shell InGaAs / InP com diferentes Xv (Xv =30%, 35% e 40%) a 77 K. b Espectros PL dependentes da temperatura de nanofios núcleo-casca InGaAs / InP com Xv =40%. Inserido em b mostra a mudança dependente da temperatura correspondente na energia de pico PL
Conclusões
Em resumo, apresentamos o crescimento e a caracterização de nanofios núcleo-casca InGaAs / InP em substratos de Si- (111) usando MOCVD. A tensão na interface núcleo-casca causada pela grande incompatibilidade de rede entre o núcleo e os materiais da casca tem forte influência no comportamento de crescimento do invólucro InP, levando ao crescimento assimétrico do invólucro InP em torno do núcleo InGaAs e até mesmo à dobra de os nanofios. Medições de TEM revelaram que o shell InP cresceu coerentemente no núcleo InGaAs sem quaisquer deslocamentos desajustados. A partir das medições PL a 77 K, a intensidade do pico PL dos nanofios núcleo-casca InGaAs / InP mostra uma melhoria de ∼ 100 vezes em comparação com os nanofios InGaAs nus devido à passivação dos estados de superfície e confinamento efetivo do portador pela camada de revestimento InP. Esse aumento significativo de emissão dos nanofios com capa de InP nos permite observar a emissão mesmo em temperatura ambiente. No geral, os resultados obtidos aqui aumentam nossa compreensão do comportamento de crescimento de nanofios de heteroestrutura núcleo-casca distendidos e podem pavimentar a base para a fabricação de dispositivos optoeletrônicos baseados em nanofios InGaAs.
Abreviações
- BF:
-
Campo claro
- CMOS:
-
Semicondutor de óxido metálico complementar
- EDS:
-
Espectroscopia dispersiva de energia
- FTIR:
-
Transformada de Fourier Infra-vermelho
- FWHM:
-
Largura total pela metade no máximo
- LED:
-
Diodo emissor de luz
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- PL:
-
Fotoluminescência
- SAED:
-
Difração de elétrons de área selecionada
- SEM:
-
Microscopia eletrônica de varredura
- TEM:
-
Microscopia eletrônica de transmissão
- TMGa:
-
Trimetilgálio
- TMIn:
-
Trimetilíndio
- ZB:
-
Blenda de zinco
Nanomateriais
- Cientistas de materiais ensinam nanofios a 'dançar'
- Nanofibras e filamentos para entrega aprimorada de drogas
- Preparação e atividade de hidrogenação catalítica aprimorada de nanopartículas de Sb / Palygorskite (PAL)
- Crescimento autocatalisado de nanofios de GaSb verticais em hastes de InAs por deposição de vapor químico orgânico-metálico
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- Propriedades de síntese e luminescência de nanopartículas α-NaGdF4 / β-NaYF4:Yb, Er Core – Shell solúveis em água
- Um Projeto Eficiente e Eficaz de Nanofios InP para Captação Máxima de Energia Solar
- Efeito da Estabilidade Térmica Aprimorada da Camada de Suporte de Alumina no Crescimento de Nanotubos de Carbono de Parede Única Alinhados Verticalmente e Sua Aplicação em Membranas de Nanofiltraç…
- Mecanismos de formação de nanofios de InGaAs produzidos por deposição de vapor químico em duas etapas de fonte sólida
- 5G e o desafio do crescimento exponencial de dados



