Estudos experimentais e teóricos do contato de Mo / Au Schottky em filme fino β-Ga2O3 mecanicamente esfoliado
Resumo
Nós estudamos o mecanismo de emissão de corrente reversa do Mo / β-Ga 2 O 3 Diodo de barreira Schottky através das características de corrente-tensão (IV) dependentes da temperatura de 298 a 423 K. A variação da corrente reversa com o campo elétrico indica que a emissão Schottky é o mecanismo de transporte de portadora dominante sob polarização reversa, em vez de Frenkel-Poole modelo de emissão assistida por armadilha. Além disso, uma tensão de ruptura de 300 V foi obtida em ambiente Fluorinert com um campo elétrico médio de 3 MV / cm em Mo / β-Ga 2 O 3 Diodo de barreira Schottky. Os efeitos dos estados de superfície, na distribuição do campo elétrico, também foram analisados por simulação TCAD. Com o aumento das densidades de carga de superfície negativa, o campo elétrico de pico reduz monotonamente. Além disso, a falta de homogeneidade da altura da barreira de Schottky sob polarização direta também foi discutida.
Histórico
Recentemente, o semicondutor de banda larga ultralarga β-Ga 2 O 3 atraiu muitos interesses por suas características excelentes, como alta estabilidade química, grande gap direto de banda larga de 4,8-4,9 eV, alto campo elétrico de colapso teórico ( E BR ) de 8 MV / cm, e figura de mérito de Baliga alta de 3400, que é cerca de dez vezes maior do que a de SiC e quatro vezes maior do que a de GaN [1,2,3]. A combinação de todas essas propriedades com alta qualidade, grande área e econômica β-Ga 2 O 3 substrato cultivado por técnicas de crescimento por fusão torna β-Ga 2 O 3 um material preferido para aplicações eletrônicas de alta tensão e alta potência [4,5,6,7,8,9]. Como um dispositivo eletrônico promissor, β-Ga 2 O 3 Os diodos de barreira Schottky (SBD) foram fabricados com vários metais de eletrodo anódico, incluindo Cu [8], Pd [10], Pt [5, 6, 11,12,13], Au [10, 14], Ni [13, 15 , 16,17,18], e TiN [12], e suas características elétricas diretas e reversas, como a resistência ligada específica, I em / eu desligado proporção, alturas de barreira, corrente de fuga reversa e tensão de ruptura foram investigados de forma abrangente. A altura da barreira Schottky não homogênea e a corrente de polarização reversa não saturante foram relatadas em β-Ga 2 O 3 SBDs [6, 8, 11, 18, 19] enquanto muito menos informações eram conhecidas sobre o mecanismo de transporte de portadora sob polarização reversa, que é essencial para o aumento da tensão de ruptura.
Além disso, não há investigação que foi feita para analisar os mecanismos de emissão de Mo / β-Ga 2 O 3 contato. Se houver algumas armadilhas ou defeitos no β-Ga 2 O 3 substrato, a corrente de fuga estará de acordo com o modelo de emissão de Frenkel-Poole, e a corrente reversa é a emissão de elétrons de um estado aprisionado próximo à interface metal-semicondutor. Caso contrário, o processo principal em corrente reversa será dominado pela emissão Schottky de que os elétrons sobre a barreira Schottky resultam em uma corrente reversa. β-Ga 2 O 3 o cristal também tem uma propriedade única, uma grande constante de rede de 12,23 Å ao longo da direção [100], que permite uma clivagem fácil em cinturões finos ou nanomembranas [9, 20]. Portanto, neste trabalho, nós esfoliamos mecanicamente β-Ga 2 em grande escala O 3 do substrato a granel de baixa densidade de deslocamento e, pela primeira vez, o molibdênio (Mo) termicamente estável foi escolhido como o metal do eletrodo anódico para fabricar o β-Ga 2 O 3 diodos de barreira Schottky verticais. O mecanismo de condução elétrica sob a polarização reversa foi discutido na faixa de temperatura de 298 a 423 K. Este trabalho fornece insights sobre os mecanismos de transporte de portadores que podem ajudar a melhorar as funcionalidades de β-Ga 2 O 3 dispositivos baseados em
Métodos / Experimental
Conforme mostrado na Fig. 1a, b, o diodo barreira Schottky foi fabricado no β-Ga 2 O 3 (100) filme esfoliado mecanicamente a partir de β-Ga dopado com Sn 2 O 3 substrato, com espessura de 15 μm e concentração de elétrons de 2 × 10 17 cm - 3 . Conforme apresentado na Fig. 1d, e, a largura total na metade do máximo (FWHM) e a raiz quadrada média (RMS) foram estimados em 51,9 arcsec e 0,19 nm, respectivamente, por difração de raios-X de alta resolução (HRXRD) e atômica medições de microscópio de força (AFM). A excelente qualidade do cristal e a superfície lisa foram confirmadas pela medição. Após a limpeza química úmida, a pilha de metal Ti / Au (20 nm / 100 nm) foi depositada usando evaporação de feixe E no lado posterior e seguido pelo recozimento térmico rápido (RTA) a 600 ° C por 60 s sob atmosfera de nitrogênio para formar o contato ôhmico. Os eletrodos anódicos circulares de Schottky com diâmetros de 100 μm foram formados na parte frontal por evaporação de metais Mo / Au (40 nm / 100 nm) e processo de lift-off. A Figura 1c mostra a estrutura da seção transversal esquemática do β-Ga 2 O 3 SBD neste trabalho.
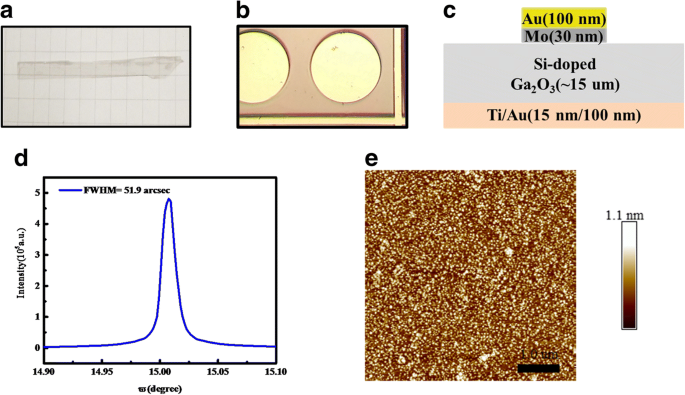
a O β-Ga dopado com Sn 2 O 3 substrato com a espessura de 300 μm. b Os eletrodos do ânodo Schottky são formados na parte frontal com diâmetros de 100 μm. c A estrutura do esquemático através da seção do β-Ga 2 O 3 SBD. d Curva de balanço de XRD e e Imagem AFM do β-Ga 2 O 3 camada de deriva mecanicamente esfoliada de (100) β-Ga 2 O 3 substrato
Resultados e discussão
As características de corrente-tensão (I-V) de Au / Mo / β-Ga 2 O 3 Os diodos de barreira Schottky foram investigados usando um sistema de caracterização de semicondutor Keithley 4200 entre 298 e 423 K. Como mostrado na Fig. 2a, o I em / eu desligado proporção é próxima a 10 10 a 298 K, indicando um bom comportamento retificador. Para a polarização direta de 0,1 a 0,7 V, as curvas semilogarítmicas I-V são quase lineares e exibem um comportamento de forte dependência da temperatura. Com a polarização direta aumentando ainda mais, o desvio da linearidade das curvas IV é atribuído à resistência em série do diodo de barreira Schottky e a relação entre a tensão aplicada e a corrente pode ser expressa como \ (I ={I} _s \ left \ {\ exp \ left [\ frac {q \ left (V- {IR} _s \ right)} {nkT} \ right] -1 \ right \} \) [21,22,23], onde V é a tensão aplicada, R s a resistência em série, T a temperatura absoluta, k a constante de Boltzmann, n o fator de idealidade, e eu s é a corrente de saturação reversa. O n e eu s pode ser determinada a partir da inclinação e interceptação do ln Gráficos I-V, respectivamente. Para o diodo de barreira Schottky ideal, o fator de idealidade n deve ser igual à unidade. Quanto maior o n , maior será o desvio do modelo de emissão térmica (TE). Além disso, de acordo com a equação \ ({\ phi} _b =\ frac {kT} {q} \ ln \ left [\ frac {AA ^ {\ ast} {T} ^ 2} {I_s} \ right] \ ) [21,22,23], os valores de ϕ b em diferentes temperaturas também foram determinados, como mostrado na Fig. 2b, onde ϕ b é a altura da barreira, A é a área do diodo e A * é a constante de Richard efetiva de 40,8 A cm −2 K - 2 com o β-Ga 2 O 3 massa efetiva de m * = 0,34 m 0 [5, 24]. Com o aumento da temperatura de 298 para 423 K, o ϕ b aumenta enquanto n diminui, indicando outro mecanismo de transporte também contribuindo para o transporte de corrente e levando ao desvio das características I-V do modelo TE puro, que foi relatado anteriormente em β-Ga 2 O 3 Díodos de barreira Schottky [25] e outros dispositivos de largura de banda larga [26,27,28,29,30]. A análise de não homogeneidade da altura da barreira pode ser descrita por uma distribuição gaussiana nas alturas das barreiras,
$$ {\ phi} _b =\ overline {\ phi_ {b0}} \ left (T =0 \ right) - \ frac {q {\ sigma} _s ^ 2} {2 kT} $$ (1)
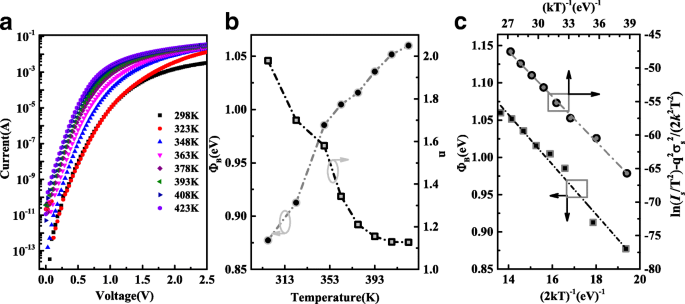
a Características dianteiras I-V de Mo / β-Ga 2 O 3 Diodos de barreira Schottky em diferentes temperaturas. b Dependência do fator de idealidade com a temperatura e altura da barreira Schottky de β-Ga 2 O 3 Diodo de barreira Schottky. c Parcelas de ϕ ap versus q / 2 k Gráfico T e Richardson modificado versus 1 / k T para o β-Ga 2 O 3 Diodos de barreira Schottky
Os valores da altura média da barreira \ (\ overline {\ phi_ {b0}} \) e o desvio padrão σ s são extraídos para serem 1,55 eV e 0,186 eV, respectivamente, da Fig. 2c. Além disso, considerando as inomogeneidades da altura da barreira, o gráfico de Richardson convencional é modificado da seguinte forma:
$$ \ ln \ left (\ frac {I _ {\ mathrm {s}}} {T ^ 2} \ right) - \ left (\ frac {q ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2} {2 {k} ^ 2 {T} ^ 2} \ right) =\ ln \ left ({AA} ^ {\ ast} \ right) - \ frac {q \ overline {\ phi_ {b0}}} {kT} $$ (2)
Conforme mostrado na Fig. 2c, o modificado \ (\ ln \ left ({I} _ {\ mathrm {s}} / {T} ^ 2 \ right) - \ left ({q} ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2/2 {k} ^ 2 {T} ^ 2 \ right) \) versus 1 / kT é uma linha reta. A interceptação da curva é usada para obter o A * de 44,7 A cm −2 K −2 , que está muito próximo do valor teórico de β-Ga 2 O 3 de 40,8 A cm −2 k −2 . Conseqüentemente, as barreiras não homogêneas na interface metal / semicondutor para β-Ga 2 O 3 O SBD pode ser explicado por TE com distribuição gaussiana de barreira sobre os SBHs.
A medição de degradação reversa da temperatura ambiente também foi realizada usando o sistema analisador de semicondutor de alta tensão Agilent B1505A, conforme mostrado na Fig. 3. A tensão de decomposição foi de 260 V enquanto era de 300 V com a amostra submersa em Fluorinert ™ produzido pela empresa 3M que pode prevenir a ruptura do ar sob alta polarização reversa. Para entender a distribuição do campo elétrico, foi realizada simulação numérica com o software ATLAS, conforme mostrado nas Fig. 4a, b. Com o aumento da distância da interface entre o semicondutor e o ânodo para cerca de 1 μm, o campo elétrico diminui gradualmente. Na posição de x =4 μm, o campo elétrico médio é 3 MV / cm, calculado a partir da Fig. 4c. Também mostrado na Fig. 4d, na posição de y =1 nm, o campo elétrico máximo na tensão de ruptura foi de cerca de 8 MV / cm na borda do contato Schottky, que é cerca de 2,7 vezes o do campo elétrico médio. Conforme relatado por AJ Green et al [31] e K. Zeng et al [32], o campo elétrico de pico e o campo elétrico médio da borda do eletrodo foram 5,3, 3,8 MV / cm e 6,1, 4,4 MV / cm, respectivamente, e o campo elétrico de pico de Mo / Ga 2 O 3 O diodo Schottky é relativamente alto. Supõe-se que o β-Ga 2 O 3 nanomembrana obtida por esfoliação mecânica tem um grande número de ligações pendentes e estados de superfície que irão capturar elétrons para esgotar os portadores de ânodo para cátodo sob polarização reversa [33]. Levando em consideração a carga superficial negativa, o resultado da simulação mostrou o campo elétrico na borda do contato Schottky reduzido com densidades de carga superficial negativa aumentando de 0,5 × 10 13 cm −2 para 3 × 10 13 cm −2 , respectivamente. Especialmente com as densidades de carga de superfície negativa de 3 × 10 13 cm −2 , o pico do campo elétrico na borda do contato Schottky é de cerca de 5,2 MV / cm. Portanto, a tensão de ruptura reversa de 300 V pode ser alcançada no β-Ga 2 O 3 nanomembrana com N D =3 × 10 17 cm −2 sem quaisquer estruturas de terminação de borda. Conforme mostrado na Fig. 4d, devido à existência de estado de interface em X - posição abaixo de 2 μm, os elétrons podem ser presos e a região de depleção pode ser formada, resultando no campo elétrico no Y direção. À medida que a concentração do estado da interface aumenta, o campo elétrico no Y direção aumenta, embora o campo elétrico no X a direção se aproxima de zero. Portanto, o campo elétrico aumenta em X -posição abaixo de 2 μm.
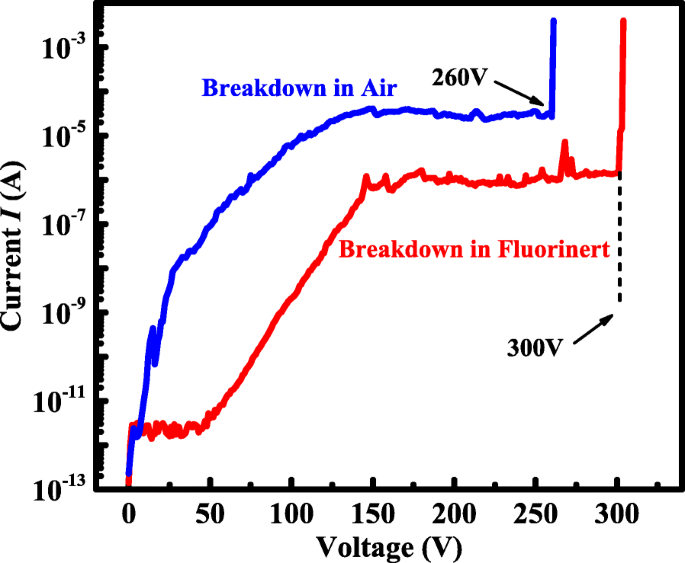
As características inversas de I-V do β-Ga 2 O 3 amostras à temperatura ambiente, respectivamente, em Fluorinert e ar

a Simulação de campo elétrico TCAD fora do estado dos diodos de barreira Schottky sob polarização de - 300 V. b A simulação do campo elétrico das regiões selecionadas na caixa tracejada verde. O potencial ao longo do y eixo em x =4 μm está presente em ( c ), e o campo elétrico na borda do contato Schottky reduzido com diferentes densidades de carga superficial negativa efetiva estão presentes em ( d )
Por outro lado, com o viés reverso V re aumentando, a corrente de fuga I re aumenta em vez de saturar para | V |> 3 k B T / q , como mostrado na Fig. 5a, que é inconsistente com a teoria TE. Portanto, a emissão termiônica aumentada por campo elétrico foi considerada para discutir a dependência do I re em V re , incluindo emissão de Poole-Frenkel e emissão de Schottky [34, 35]. Na emissão de Poole-Frenkel, os elétrons são transportados do metal para o semicondutor por meio de um estado preso e o I re É dado por
$$ {I} _ {re} \ propto E \ exp \ left (\ frac {q} {kT} \ sqrt {\ frac {qE} {{\ pi \ varejpsilon} _S}} \ right) $$ (3 )
enquanto na emissão Schottky, os elétrons ganharão energia suficiente para superar a barreira no metal / semicondutor para formar a corrente e o I re pode ser expresso por
$$ {I} _ {re} \ propto {T} ^ 2 \ exp \ left (\ frac {q} {2 kT} \ sqrt {\ frac {qE} {{\ pi \ varepsilon} _S}} \ right ) $$ (4)
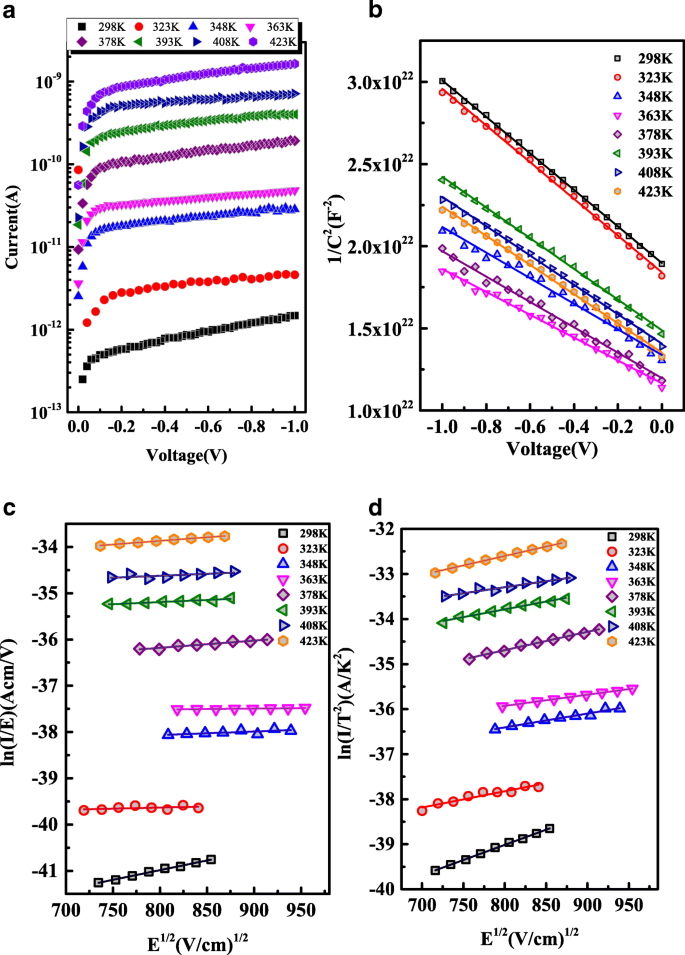
a Características reversas I-V de Mo / β-Ga 2 O 3 Diodos de barreira Schottky em diferentes temperaturas. b Dependência de temperatura de 1 / C 2 características do Mo / β-Ga 2 O 3 Diodos de barreira Schottky. A análise de dependência do campo elétrico de Mo / β-Ga 2 O 3 Contato Schottky com mecanismo diferente. c Mecanismo Poole-Frenkel ( I / E ) versus E 1/2 e d Mecanismo Schottky ln ( eu / T 2 ) versus E 1/2
onde ε s é a permissividade do β-Ga 2 O 3 (~ 10 ε 0 ) e E é o campo elétrico aplicado, calculado por \ (E \ kern0.5em =\ kern0.5em \ sqrt {\ frac {2 {qN} _D} {\ varepsilon_S} \ left (V + {V} _ {bi} - \ frac {k_BT} {q} \ right)} \), N D é a densidade de doadores do β-Ga 2 O 3 e V bi é o potencial embutido. Conforme mostrado na Fig. 5b, N D e V bi pode ser extraído da inclinação e da interceptação da capacitância quadrada inversa (1 / C 2 ) versus o V re plota usando a seguinte expressão
$$ \ frac {1} {C ^ 2} =\ frac {2 \ left ({V} _ {\ mathrm {bi}} - kT / qV \ right)} {q {\ varepsilon} _s {A} ^ 2 {N} _D} $$ (5)
Se a curva de ln ( I / T 2 ) versus E 1/2 é linear, o mecanismo de emissão Schottky é dominante. E se o enredo de ln ( eu / E ) versus E 1/2 for linear, a emissão Poole-Frenkel domina o transporte de corrente reversa. A Figura 5c, d representa os gráficos de ln ( eu / E ) e ln ( eu / T 2 ) versus E 1/2 , respectivamente. Ambos os conjuntos de curvas são lineares, indicando não apenas a emissão de Poole-Frenkel, mas também a emissão de Schottky. Para esclarecer o mecanismo de transporte da portadora dominante, a inclinação das curvas ou o coeficiente de emissão podem ser expressos como [34,35,36].
$$ S =\ frac {q} {nkT} \ sqrt {\ frac {q} {\ pi \ varejpsilon}} $$ (6)
onde n =1 é para a emissão Poole-Frenkel ( S PF ) e n =2 para a emissão Schottky ( S S ) Os valores experimentais de S são denotados como S m-PF e S m-S para a emissão de Poole-Frenkel e Schottky dada pela inclinação das curvas na Fig. 5c, d, respectivamente. As razões do valor experimental para o valor teórico, N PF (= S m-PF / S PF ) e N S (= S m-S / S S ), são mostrados na Fig. 6. Uma vez que os valores de N S estão mais próximos da unidade do que os de N PF , a corrente reversa é dominada pela emissão Schottky.

Gráficos de coeficientes relativos de emissão de Poole-Frenkel N PF (= S m-PF / S PF ) e emissão Schottky N S (= S m-S / S S ) versus temperatura
Conclusões
Nós investigamos as características elétricas dos diodos de barreira Mo / Au Schottky fabricados no (100) β-Ga 2 O 3 filme esfoliado mecanicamente a partir de β-Ga dopado com Sn 2 O 3 substrato. Com base no modelo TE, o extraído ϕ b e n aumenta e diminui com o aumento da temperatura, respectivamente. Assumindo a distribuição gaussiana da altura da barreira não homogênea, a altura média da barreira de 1,55 eV e o desvio padrão de 0,186 eV foram obtidos . Finalmente, de acordo com o ln ( eu / T 2 ) e ln ( eu / E ) versus E 1/2 plotagens, o parâmetro N S da emissão de Schottky é próxima da unidade, ilustrando a emissão de Schottky sendo o mecanismo de transporte dominante da corrente reversa. A tensão de ruptura de 300 V com amostras em Fluorinert é obtida em diodos de barreira Schottky Mo / Au com um campo elétrico médio de 3 MV / cm, indicando o grande potencial de β-Ga 2 O 3 para aplicações de eletrônica de potência.
Abreviações
- I-V:
-
Corrente electrica
- Mo:
-
Molibdênio
- RTA:
-
Recozimento térmico rápido
- SBD:
-
Diodo barreira Schottky
- TE:
-
Emissão termionica
Nanomateriais
- Pesquisa Experimental sobre Estabilidade e Convecção Natural de Nanofluido de TiO2-Água em Compartimentos com Diferentes Ângulos de Rotação
- O efeito do plasma sem equilíbrio de contato nas propriedades estruturais e magnéticas de Mn Х Fe3 - X О4 Spinels
- Estudo experimental sobre as características de fluxo e transferência de calor de nanofluidos de TiO2-água em um tubo espiralado
- Fabricação de filmes finos SrGe2 em substratos Ge (100), (110) e (111)
- Nanomontagens de ácido 5-aminolevulínico-esqualeno para fotodetecção e terapia de tumor:estudos in vitro
- Estudo da Força de Adesão e Transição de Vidro de Filmes de Poliestireno Fino por Microscopia de Força Atômica
- Preparação e Características Termoelétricas de ITO / PtRh:Termopar de Filme Fino PtRh
- Estudos de TEM e STEM nas morfologias transversais de filmes anti-reflexo de SiO2 de banda larga dupla / tripla
- Estudos teóricos sobre fotodiodos de avalanche de InGaAs / InAlAs SAGCM
- Uma simulação teórica das respostas à radiação da superrede de Si, Ge e Si / Ge para irradiação de baixa energia



