Deposição de camada atômica aprimorada com plasma de baixa temperatura de SiO2 usando dióxido de carbono
Resumo
Neste trabalho, relatamos o crescimento bem-sucedido de SiO 2 de alta qualidade filmes por deposição de camada atômica intensificada por plasma de baixa temperatura usando um oxidante que é compatível com materiais sensíveis à umidade / oxigênio. O SiO 2 os filmes foram cultivados a 90 ° C usando CO 2 e Bis (terc-butilamino) silano como precursores do processo. Crescimento, composição química, densidade, propriedades ópticas e tensão residual de SiO 2 filmes foram investigados. SiO 2 filmes com um crescimento saturado por ciclo de ~ 1,15 Å / ciclo mostraram uma densidade de ~ 2,1 g / cm 3 , um índice de refração de ~ 1,46 a um comprimento de onda de 632 nm e uma tensão residual de baixa tração de ~ 30 MPa. Além disso, os filmes mostraram baixos níveis de impureza com concentrações em massa de ~ 2,4 e ~ 0,17 at. % para hidrogênio e nitrogênio, respectivamente, enquanto o teor de carbono foi encontrado abaixo do limite de medição da análise de detecção de recuo elástico de tempo de voo. Estes resultados demonstram que CO 2 é um precursor de oxidação promissor para materiais sensíveis à umidade / oxigênio relacionados a processos de deposição de camada atômica aprimorada por plasma.
Histórico
SiO 2 é um material amplamente utilizado para aplicações como microeletrônica [1, 2], sistemas microeletromecânicos [3, 4], fotovoltaica [5, 6] e óptica [7, 8]. Enquanto SiO 2 filmes finos podem ser cultivados por vários métodos, como oxidação térmica, deposição de vapor químico aprimorada por plasma (PECVD) ou deposição de vapor físico (PVD), deposição de camada atômica (ALD) oferece a vantagem excepcional de combinar o controle preciso da espessura do filme, alta uniformidade , e conformalidade [9,10,11].
Muitos processos ALD, com vários precursores de Si (clorossilanos ou aminossilanos) e oxidantes (H 2 O, H 2 O 2 , ou O 3 ), foram desenvolvidos para o crescimento de SiO 2 . Esses processos geralmente requerem temperaturas relativamente altas (> 150 ° C) [12,13,14,15,16]. Para processos compatíveis com materiais termicamente sensíveis, como materiais orgânicos, biológicos e poliméricos, o ALD catalisado [17,18,19] e deposição de camada atômica intensificada por plasma (PEALD) [9, 20,21,22] têm sido usados como uma solução eficaz com temperaturas de processo abaixo de 100 ° C. No entanto, o comumente usado H 2 O e O 2 Oxidantes à base de água podem levar à degradação do material no caso de materiais sensíveis à umidade / oxigênio. Comparado com H 2 O e O 2 , em baixa temperatura, CO 2 não é quimicamente reativo. Neste caso, usando CO 2 como um oxidante, pode minimizar a degradação de materiais sensíveis à umidade / oxigênio, evitando oxidação desnecessária. Além disso, CO 2 foi relatado por King [23] como um agente oxidante viável para o crescimento de PEALD SiO 2 filmes ao usar SiH 4 como um precursor de Si. No entanto, as temperaturas de crescimento desses processos PEALD, que estavam na faixa de 250–400 ° C, não são compatíveis com materiais sensíveis a altas temperaturas.
Neste trabalho, relatamos o desenvolvimento de um CO 2 processo PEALD baseado em SiO 2 filmes a 90 ° C. A dependência do crescimento do filme nos parâmetros do processo (pulso do precursor / tempo de purga e potência do plasma) é investigada. Também relatamos a composição química, propriedades estruturais e ópticas e análise de tensão residual dos filmes.
Métodos
Preparação do filme
PEALD SiO 2 os filmes foram cultivados em substratos de Si (100) e safira a 90 ° C usando CO 2 (99,5%, Air Products) plasma como fonte de oxigênio e bis (terc-butilamino) silano (BTBAS) (97%, Strem Chemicals) como precursor de Si [22]. Os processos foram realizados em um reator Beneq TFS 200 com um sistema de plasma remoto usando uma fonte operada por rádio frequência (rf) de 13,56 MHz capacitivamente acoplada. O N 2 (99,999%, AGA) foi usado como um transportador e gás de purga com um fluxo através do reator de 600 sccm, enquanto uma mistura de gás de N 2 (200 sccm) e CO 2 (75 sccm) fluiu através do sistema de plasma. As potências de plasma escolhidas neste estudo foram baseadas na estabilidade do sistema de plasma. A temperatura da fonte de BTBAS foi definida em 21 ° C e um N 2 o reforço foi aplicado durante o pulso do precursor. Os detalhes dos parâmetros do processo são mostrados na Tabela 1. Durante os processos PEALD, a pressão do reator era de cerca de 1 hPa.
Caracterização do filme
A espessura do PEALD SiO 2 Os filmes foram determinados com um elipsômetro SENTECH SE400adv usando um laser HeNe em um comprimento de onda de 632,8 nm e em um ângulo de incidência de 70 °. O crescimento por ciclo (GPC) foi calculado usando a espessura de filme obtida dividida pelo número de ciclos ALD. O desvio do GPC foi baseado na não uniformidade da espessura do filme.
A composição química foi medida por espectroscopia de emissão óptica de descarga luminosa (GDOES), análise de detecção de recuo elástico de tempo de voo (TOF-ERDA) e espectroscopia de infravermelho com transformada de Fourier de refletância total atenuada (ATR-FTIR). As medições GDOES foram realizadas em um Horiba GD-Profiler 2. Um ânodo de 4 mm de diâmetro e uma potência rf de 35 W no modo pulsado foram usados. As intensidades elementares foram relatadas como valores integrados ao longo de toda a espessura do filme, conforme descrito na Ref. [22]. Para medições de TOF-ERDA, íons Br de energia de 40 MeV obtidos de um acelerador em tandem de 5MV foram direcionados às amostras medidas. O ângulo de detecção foi de 40 °. As medições de ATR-FTIR foram feitas usando um espectrômetro Thermo Electron Corporation Nicolet 380 ATR-FTIR com um cristal de diamante como elemento de reflexão interno. O procedimento incluiu uma coleta de background do substrato de Si e coleta de dados das amostras. Um −1 de 2 cm resolução acima de 800–4000 cm −1 faixa de número de onda foi usada.
As análises de refletividade de raios X (XRR) foram realizadas com um difratômetro Philips X'Pert Pro usando Cu-K α1 radiação. A densidade do filme foi adquirida a partir dos dados medidos usando um software de adaptação desenvolvido internamente [24]. Uma camada de óxido interfacial entre o substrato de silício e o PEALD SiO 2 o filme foi simulado como parte do modelo de camada de adaptação XRR. Usando um espectrômetro PerkinElmer Lambda 900, espectro de transmitância do PEALD SiO 2 o filme foi gravado na faixa de comprimento de onda de 360–800 nm após o crescimento em substrato de safira. O índice de refração ( n ) e coeficiente de extinção ( k ) foram determinados com ajuste de Cauchy do espectro de transmitância. Para garantir uma boa precisão de ajuste, para esta medição, SiO com 150 nm de espessura 2 os filmes foram cultivados em substratos de safira.
A tensão residual de PEALD SiO com 50 nm de espessura 2 os filmes foram determinados com o método da curvatura do wafer [25] e a equação de Stoney [26]. A curvatura do wafer foi medida antes e depois do crescimento do filme com uma ferramenta TOHO FLX-2320-S. As bolachas foram escaneadas biaxialmente usando um comprimento de varredura de 120 mm. Os resultados medidos foram apresentados com incerteza de medição máxima [25].
Resultados e discussão
Crescimento do filme
A dependência do SiO 2 filme GPC no pulso BTBAS e tempo de purga foi investigado durante a etapa de oxidação com uma potência de plasma fixa de 180 W, um CO 2 tempo de exposição do plasma de 3 s, e um CO 2 tempo de purga do plasma de 2 s. As Figuras 1a eb mostram os valores de GPC em função do pulso BTBAS e do tempo de purga, respectivamente. Para a dependência do tempo de pulso, o tempo de purga do BTBAS foi definido para 3 s, enquanto para a dependência do tempo de purga, o tempo de pulso do BTBAS foi definido para 0,3 s. Como mostrado na Fig. 1a, o menor GPC é obtido com um pulso BTBAS de 0,05 s, enquanto um tempo de pulso de 0,1 s é considerado suficiente para atingir um crescimento autolimitado com um GPC de ~ 1,15 Å / ciclo. Além disso, quando um pulso BTBAS fixo de 0,3 s e um tempo de purga decrescente de 3 a 0,5 s (Fig. 1b) são usados, nenhuma alteração de GPC é observada. Isso indica que o curto tempo de purga aplicado de BTBAS é suficiente para evitar componentes CVD. Observe, entretanto, que a uniformidade da espessura do filme foi melhorada com o aumento do tempo de purga.

GPC de PEALD SiO 2 filmes crescidos em substratos de Si como uma função de BTBAS a tempo de pulso e b tempo de purga. A potência de plasma aplicada foi de 180 W
O SiO 2 o crescimento durante a etapa de oxidação foi investigado usando pulso de BTBAS fixo e tempo de purga de 0,3 e 3 s, respectivamente. As Figuras 2a e b mostram o GPC de PEALD SiO 2 filmes crescidos em wafers de Si como uma função do CO 2 exposição ao plasma e tempo de purga, respectivamente. Durante o estudo dos efeitos do tempo de exposição ao plasma, potências plasmáticas de 50, 180 e 300 W foram aplicadas. Como uma observação geral, o maior valor de GPC de 1,15 Å / ciclo, que pode ser considerado como o GPC saturado a 90 ° C [27], é observado em todas as condições de potência do plasma. Para o processo com um tempo de exposição ao plasma de 1 s, independentemente da potência usada, os valores de GPC abaixo de 1,15 Å / ciclo sugerem um crescimento incompleto do filme. Isso indica que o tempo de exposição do plasma de 1 s não é longo o suficiente para gerar uma quantidade suficiente de radicais O. Esses radicais, que são necessários para uma reação de superfície completa, resultam de CO 2 reações de dissociação do plasma [28]. Para uma potência de plasma de 50 W, o GPC aumenta com um aumento de CO 2 tempo de exposição do plasma até 6 s, após o qual o GPC atinge o valor saturado de 1,15 Å / ciclo. Este valor permanece constante por um tempo de exposição de até 15 s. No entanto, para filmes crescidos com maior potência (180 e 300 W), uma tendência V inversa do GPC é observada para o tempo de exposição do plasma entre 1 e 6 s. De acordo com nossos estágios de crescimento relatados anteriormente de filmes PEALD [27] e o maior GPC obtido de 1,15 Å / ciclo neste trabalho, a saturação de crescimento é alcançada em 180 e 300 W com um tempo de exposição de plasma de 3 s. Para um tempo de exposição de plasma de 6 s, o GPC diminuído é provavelmente uma consequência da densificação do filme, semelhante ao que relatamos anteriormente para PEALD de Al 2 O 3 filmes finos [27]. Observe que essas duas curvas (representando a dependência do GPC em CO 2 tempo de exposição de plasma para 180 e 300 W) se sobrepõem totalmente. A sobreposição observada das curvas GPC sugere que o crescimento do SiO 2 filmes com 180 e 300 W envolvem mecanismos idênticos que podem estar relacionados a uma quantidade comparável de fluxos de íons e radicais gerados por plasma de alta potência [29]. Em comparação com o caso de altas potências, o comportamento de crescimento de SiO 2 filmes finos usando uma potência de plasma de 50 W são diferentes, pois não ocorre nenhuma densificação de filme. Isso é provavelmente devido aos fluxos de íons e radicais relativamente baixos resultantes da baixa potência de 50 W [29].

GPC de PEALD SiO 2 filmes crescidos em substratos de Si como uma função de CO 2 plasma a tempo de exposição com potências de plasma variadas de 50, 180 e 300 W e b tempo de purga com uma potência de plasma de 180 W
O efeito do CO 2 o tempo de purga do plasma no GPC é mostrado na Fig. 2b. Como no caso da dependência de tempo de purga BTBAS, os valores GPC permanecem constantes quando CO 2 o tempo de purga varia entre 0,5 e 3 s. Assim, pode-se concluir que o tempo de purga aplicado de ambos os precursores tem um impacto insignificante no GPC de nosso SiO 2 filmes finos. Isso difere de um processo PEALD relatado anteriormente com SAM.24, um aminosilanos parentes de BTBAS e O 2 plasma [9], onde as etapas de purga com um tempo de purga menor que 2 s tiveram um efeito significativo no crescimento do filme. Aqui, a independência entre nosso tempo de purga de precursor aplicado e o GPC poderia ser atribuída à remoção eficaz de precursores e subprodutos residuais que poderiam se beneficiar parcialmente do projeto da câmara de reação usando o fluxo cruzado. Tal configuração torna o tempo de troca gasosa entre os pulsos do precursor relativamente curto. No entanto, a viscosidade dos precursores não pode ser excluída. Com base nos resultados mostrados na Fig. 2a, usando pulso BTBAS / tempo de purga de 0,3 s / 3 se CO 2 exposição / tempo de purga do plasma de 3 s / 2 s, a maior velocidade de deposição durante o crescimento saturado é de 50 nm / h. Isso implica que aplicando uma alta potência de plasma e usando BTBAS pulso / tempo de purga de 0,1 s / 0,5 s e CO 2 exposição / tempo de purga de plasma de 3 s / 0,5 s, uma velocidade de deposição de até 100 nm / h é alcançável.
Propriedades do filme
A densidade do SiO 2 filmes foi estudado por XRR e os resultados são mostrados na Fig. 3. As amostras medidas foram cultivadas em substratos de Si usando tempo de exposição de plasma variado com uma potência de plasma de 180 W, um tempo de pulso de BTBAS de 0,3 s, um tempo de purga de BTBAS de 3 s, e um CO 2 tempo de purga do plasma de 2 s. As amostras estudadas são rotuladas como “SiO1”, “SiO3” e “SiO6” para um tempo de exposição de plasma de 1, 3 e 6 s, respectivamente. Embora os valores estejam dentro da margem de erro de medição, os valores médios mais baixo e mais alto são mostrados em “SiO1” e “SiO6”, respectivamente, sugerindo que a densidade do filme é ligeiramente aumentada com um aumento do tempo de exposição do plasma. Isso apóia nossa hipótese de densificação do filme durante o processo com uma potência de plasma de 180 W e um tempo de exposição de 6 s. No caso de crescimento saturado, embora nossa densidade de filme de 2,11 g / cm 3 está em um bom acordo com os valores relatados em estudos anteriores para O 2 baseado em PEALD SiO 2 filmes usando reatores ALD comerciais com temperaturas de crescimento variando entre 50 e 300 ° C [9, 21, 30], é inferior ao valor (2,3 g / cm 3 ) relatado por King que demonstrou o PEALD SiO 2 processo a 400 ° C em um reator PECVD modificado [23].

Densidade de SiO 2 filmes crescidos com o tempo de exposição de plasma de 1, 3 e 6 s
A composição química do PEALD SiO 2 foi medido por GDOES. Como as medições não foram calibradas para o perfil de profundidade de composição, ou seja, a taxa de emissão dependente do elemento não foi considerada, apenas as intensidades do mesmo elemento podem ser comparadas entre diferentes amostras e nenhuma comparação entre diferentes elementos é possível. Portanto, neste caso, as medições GDOES fornecem uma informação bastante qualitativa sobre a composição química. Os elementos detectados, Si, O, H, N e C, são mostrados na Fig. 4. Conforme exibido na figura, embora a intensidade de H em "SiO1" seja ligeiramente menor do que nas outras amostras, levando em consideração o erro margens, não foram observados efeitos significativos do tempo de exposição do plasma nos conteúdos de Si, O e H. Esta descoberta é semelhante aos efeitos da energia do plasma relatados em nosso trabalho anterior no PEALD SiO 2 crescido usando BTBAS e O 2 plasma [22]. No caso do conteúdo de N, as intensidades para "SiO1" e "SiO3" são bastante constantes, enquanto uma intensidade mais baixa é medida para "SiO6". Isso sugere que a remoção de impurezas de N é mais eficaz durante a densificação do filme. Observe que, independentemente das condições de crescimento da amostra, todas as amostras medidas mostram a mesma intensidade para o conteúdo de C.

Composição química qualitativa de SiO 2 filmes crescidos com o tempo de exposição de plasma de 1, 3 e 6 s medido por GDOES. A medição tem uma precisão de ± 15% e a comparação elementar das intensidades não é possível neste trabalho (nenhum fator de calibração está disponível)
Uma avaliação adicional da composição química do filme foi realizada usando medições de TOF-ERDA e ATR-FTIR. Levando em consideração que o crescimento saturado é normalmente direcionado em processos ALD, a seguir, focamos nossa investigação em amostras crescidas com uma potência de plasma de 180 W, um tempo de pulso BTBAS de 0,3 s, um tempo de purga BTBAS de 3 s, um CO 2 tempo de exposição do plasma de 3 s, e um CO 2 tempo de purga do plasma de 2 s. O perfil de profundidade TOF-ERDA e a composição do elemento são mostrados na Fig. 5a. Observe que o declive descendente de O mostrado no perfil de profundidade do filme é causado pelo efeito do substrato de Si, que se correlaciona com a resolução de profundidade de TOF-ERDA para nosso SiO 2 / Si estrutura da amostra. Durante as análises de composição do elemento, o efeito do substrato foi levado em consideração. A amostra investigada exibe baixos níveis de impureza com concentrações em massa de ~ 2,4 e ~ 0,17 at. % para hidrogênio e nitrogênio, respectivamente, enquanto a concentração total de C no filme inteiro está abaixo do limite de medição do TOF-ERDA. Com base nas informações do perfil de profundidade, as contagens de carbono são coletadas principalmente da superfície do filme. Portanto, especulamos que o conteúdo de C detectado pelas medições GDOES e mostrado na Fig. 4 pode ser devido à contaminação da amostra durante o armazenamento ou do ambiente de teste. É importante notar que a concentração de H também é maior na superfície do que na massa. Além disso, descobriu-se que os filmes têm uma composição ligeiramente rica em oxigênio com uma razão Si / O de ~ 0,48. Esse resultado é consistente com o relatado por Dingemans et al. para PEALD SiO 2 crescido usando SAM.24 e O 2 plasma em uma faixa de temperatura entre 100 e 300 ° C [9]. Esta composição rica em oxigênio é provavelmente devido à contribuição de espécies –OH residuais deixadas nos filmes.
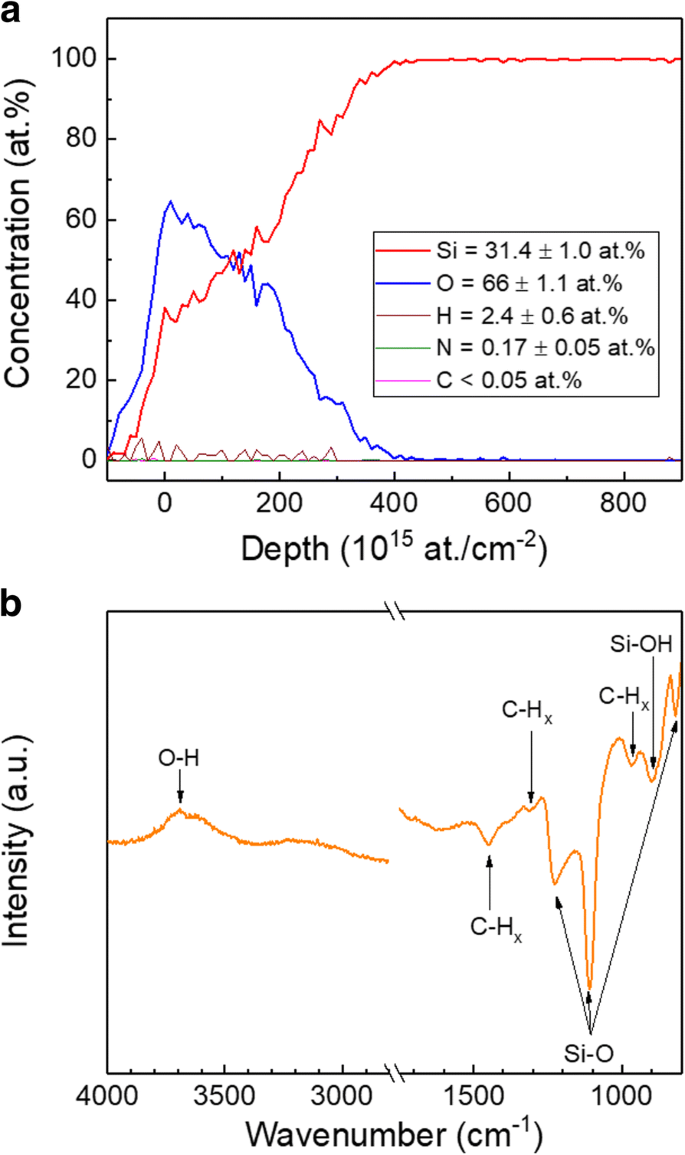
a Perfil de profundidade TOF-ERDA e b Espectro de transmissão ATR-FTIR do SiO 2 filme. A espessura do filme alvo era de 50 nm
A Figura 5b mostra o espectro ATR-FTIR medido na mesma amostra. Os recursos de banda larga, localizados em 3200–3800 cm −1 região, pode ser atribuído ao trecho O-H do Si-OH e água, mas o primeiro é menos provável [14, 31]. Outra banda, que também é típica do trecho Si – OH [31], é visível em ~ 900 cm −1 . A presença de grupos –OH, que é consistente com os resultados TOF-ERDA mostrados acima, implica que reações semelhantes à combustão, que envolvem a combustão de - NH t Bu ligantes e formação de grupos –OH, dominam a etapa de oxidação. Um mecanismo semelhante foi relatado anteriormente para ocorrer durante o crescimento de Al 2 O 3 de trimetilalumínio e O 2 plasma [32] e SiO 2 de SAM.24 e O 2 plasma [9]. Além dos grupos –OH, o alongamento da ligação Si-O-Si é detectado em torno de 1108 e 1226 cm −1 [14, 33] enquanto a dobra da ligação é vista em aproximadamente 820 cm −1 [34, 35]. Observe que, em comparação com os valores da literatura [14, 34, 35], a frequência de alongamento Si-O-Si neste trabalho é relativamente alta. Isso pode ser causado pela mudança do comprimento da ligação Si-O, que pode ser influenciada pela tensão residual do filme. Jutarosaga et al. relataram que quanto maior o estresse compressivo, menor é a frequência de alongamento Si-O-Si [36]. As bandas em ~ 970, 1301 e 1450 cm −1 são atribuídos ao CH 3 balanço, CH 3 deformação simétrica e CH 2 tesoura, respectivamente [14]. O achado de grupos de superfície C-H está de acordo com o resultado do TOF-ERDA e é provavelmente devido à contaminação da superfície.
A partir dos dados da Fig. 5 e com base nos resultados relatados anteriormente na literatura [37], nossas reações de superfície de processo durante o primeiro semiciclo de ALD podem ser consideradas como segue:
$$ \ mathrm {Si} - {\ mathrm {OH}} ^ {\ ast} + {\ mathrm {H}} _ 2 \ mathrm {Si} {\ left [{NH} ^ t Bu \ right]} _ 2 \ para \ mathrm {Si} - \ mathrm {O} - {\ mathrm {SiH}} _ 2 {{\ left [{NH} ^ t Bu \ right]} _ {2-x}} ^ {\ ast} + { xH} _2 {N} ^ t Bu $$ (1)
onde as espécies de superfície são denotadas pelo asterisco (*). Na primeira meia-reação, apenas um ( x =1) ou ambos ( x =2) de - NH t Bu ligantes podem reagir com a superfície –OH grupos formando t -butilamina moléculas.
Os radicais O são as principais espécies ativas geradas durante o CO 2 reações de dissociação do plasma [28] e, conseqüentemente, dominam as reações de oxidação. Portanto, no segundo meio-ciclo, as reações do tipo combustão propostas [9] são:
$$ {\ mathrm {SiH}} _ 2 {{\ left [{NH} ^ t Bu \ right]} _ {2-x}} ^ {\ ast} + \ mathrm {O} \ to \ mathrm {Si} - {\ mathrm {OH}} ^ {\ ast} + {\ mathrm {H}} _ 2 \ mathrm {O} + {\ mathrm {CO}} _ 2+ \ mathrm {N} - \ mathrm {contendo} \ \ mathrm {espécie} $$ (2)
Devido à incerteza dos produtos reais da reação, a reação de superfície proposta não é balanceada propositalmente. Para ser capaz de determinar totalmente essa reação, análises in-situ durante o crescimento do filme, como análises de gás de subproduto, seriam necessárias.
As propriedades ópticas do SiO 2 filme crescido em um substrato de safira foram estudados por espectrometria. A Figura 6a mostra a transmitância medida em função do comprimento de onda junto com o ajuste de Cauchy da curva. A dispersão do índice de refração simulada a partir do espectro de transmitância é mostrada na Fig. 6b. Do encaixe, a um comprimento de onda de 632 nm, um índice de refração de 1,456 e zero k valor foram obtidos. Este valor de índice de refração está de acordo com o que foi relatado anteriormente para PEALD SiO 2 de baixa temperatura [9, 21] e relativamente baixo em comparação com os valores relatados para processos de alta temperatura [23]. De fato, sabe-se que a temperatura de crescimento influencia a concentração de –OH nos filmes crescidos e, portanto, seu índice de refração [38]. Além disso, o zero obtido k valor é consistente com o baixo teor de carbono nos filmes. Uma correlação semelhante entre o k valor e a concentração de C foram relatados anteriormente por Putkonen et al. para SiO 2 filmes finos crescidos por ALD [21].
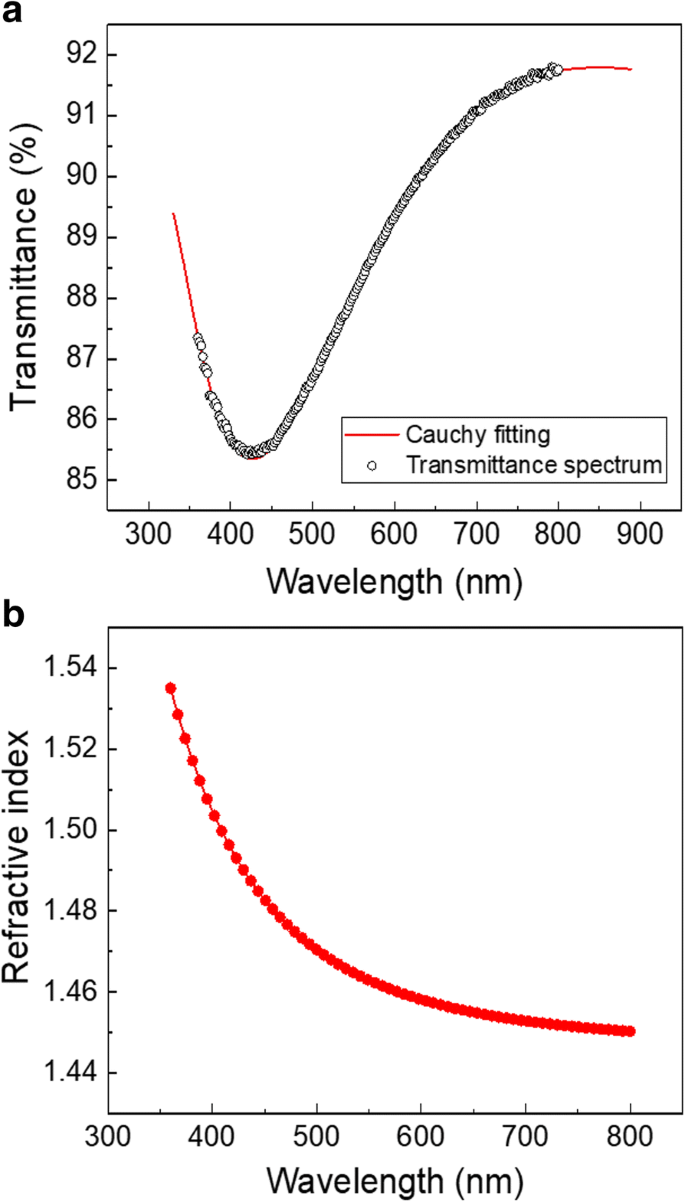
a Espectro de transmitância e ajuste de Cauchy e b dispersões de índice de refração do SiO 2 filme crescido em um substrato de safira com uma potência de plasma de 180 W, um tempo de pulso BTBAS de 0,3 s, um tempo de purga BTBAS de 3 s, um CO 2 tempo de exposição do plasma de 3 s, e um CO 2 tempo de purga do plasma de 2 s. A espessura do filme alvo era 150 nm
O estresse residual dos filmes ALD compreende as contribuições do estresse térmico e do estresse intrínseco. O estresse térmico resulta da diferença na expansão térmica entre o filme e o substrato. O estresse intrínseco é definido como o estresse interno criado durante o crescimento do filme, dependendo dos precursores, temperatura de crescimento e método ALD [30, 39]. A Figura 7 mostra a tensão residual de SiO 2 filmes em função da temperatura de crescimento. O maior valor de tensão, 150 MPa (compressivo) [23], foi obtido a partir da amostra cultivada a 400 ° C; entretanto, uma baixa tensão de tração de 30 ± 10 MPa é obtida a 90 ° C neste trabalho. Putkonen et al. e Shestaeva et al. mostrou uma clara dependência de SiO 2 estresse do filme na temperatura de crescimento [21, 30]:temperaturas mais altas resultam em maior estresse compressivo. A contribuição do estresse térmico é maior em temperaturas mais altas. Eles também relataram valores de tensão residual próximos de "zero" para PEALD SiO 2 de baixa temperatura filmes [21, 30]. Levando em consideração o valor da tensão residual relatado aqui e na literatura, a tensão próxima de “zero” é mais provavelmente uma consequência da tensão intrínseca ao invés do estresse térmico. O estresse intrínseco de PEALD SiO 2 os filmes poderiam ser causados pelo efeito do plasma. No entanto, outros fatores como o fluxo de gás, a pressão do processo ou o precursor usado não podem ser descartados [40].

Estresse residual de SiO 2 filmes em função da temperatura de crescimento. Nossa amostra foi cultivada com uma potência de plasma de 180 W, um tempo de pulso BTBAS de 0,3 s, um tempo de purga BTBAS de 3 s, um CO 2 tempo de exposição do plasma de 3 s, e um CO 2 tempo de purga do plasma de 2 s. As referências incluem Putkonen et al. [21], Shestaeva et al. [30] e King [23]. A espessura do filme alvo de nossa amostra era de 50 nm
Conclusões
Este trabalho demonstra o potencial de CO 2 como um oxidante para o crescimento de PEALD SiO 2 de baixa temperatura em materiais sensíveis à umidade / oxigênio. SiO 2 filmes com baixos níveis de impureza e baixa tensão residual de tração foram cultivados a 90 ° C por PEALD usando CO 2 e BTBAS como precursores. Os filmes mostraram um GPC saturado de ~ 1,15 Å / ciclo junto com uma densidade de ~ 2,1 g / cm 3 . Este estudo também mostra a possibilidade de atingir um crescimento saturado dos filmes com um tempo de ciclo ALD muito curto de cerca de 4 s, o que é consideravelmente desejável para alto rendimento e, portanto, aplicações industriais.
Abreviações
- ALD:
-
Deposição de camada atômica
- ATR-FTIR:
-
Espectroscopia de infravermelho com transformada de Fourier de refletância total atenuada
- BTBAS:
-
Bis (terc-butilamino) silano
- GDOES:
-
Espectroscopia de emissão óptica de descarga brilhante
- GPC:
-
Crescimento por ciclo
- PEALD:
-
Deposição de camada atômica intensificada por plasma
- PECVD:
-
Deposição de vapor químico intensificada por plasma
- PVD:
-
Deposição física de vapor
- rf:
-
Frequência de rádio
- TOF-ERDA:
-
Análise de detecção de recuo elástico de tempo de voo
- XRR:
-
Refletividade de raios-x
Nanomateriais
- Carbono oceânico gerado na escala atômica
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Revelando a estrutura atômica e eletrônica das nanofibras de carbono de copo empilhado
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Deposição em duas etapas de ZnO dopado com Al em p-GaN para formar contatos ôhmicos
- Sensor de dióxido de carbono de estado sólido
- Medindo a espessura da camada usando um microscópio



