Deposição de camada atômica aprimorada por plasma de filmes de cobalto usando Co (EtCp) 2 como um precursor de metal
Resumo
Para tecnologia avançada de interconexão de Cu, os filmes de Co têm sido amplamente investigados para servir como o forro e a substituição da camada de semente por causa de uma melhor molhabilidade ao Cu do que ao Ta. Neste artigo, os filmes de Co são cultivados por deposição de camada atômica intensificada por plasma usando Co (EtCp) 2 como um precursor, e as influências dos parâmetros do processo nas características dos filmes de Co são investigadas de forma elaborada. Os resultados indicam que a janela do processo é 125–225 ° C com uma taxa de crescimento de ~ 0,073 Å / ciclo. Ou seja, a conexão do grupo Et ao ligante Cp pode permitir um crescimento estável do filme a 125 ° C, enquanto a temperatura correspondente deve ser superior a 200 ° C em termos de Co (Cp) 2 e Co (MeCp) 2 . Os filmes depositados contêm elementos N e O além de Co e C. dominantes. Além disso, o prolongamento do NH 3 o tempo de pulso aumenta significativamente a condutividade do filme de Co e uma baixa resistividade de 117 μΩ cm pode ser alcançada com um NH 3 tempo de pulso de 40 s. A rugosidade quadrática média mostra uma variação menor com a temperatura de deposição e mantém um valor baixo de ~ 0,3 nm, indicativo de um filme de Co plano.
Histórico
Considerando o processo de interconexão de Cu convencional em circuitos integrados de alta velocidade em escala ultragrande, uma camada de barreira como TaN é indispensável para prevenir a difusão de átomos de Cu nos dielétricos intercamadas circundantes (ILD) [1]. Além da camada de barreira, uma camada de forro como Ta também é necessária para aumentar a adesão entre a camada de barreira e Cu. Além disso, é difícil para a linha de Cu ser depositada na camada de revestimento por eletrodeposição diretamente devido à fraca nucleação dos átomos de Cu na superfície de Ta. Como consequência, uma camada de semente de Cu é necessária para ser revestida na camada de revestimento antes da eletrodeposição de Cu. Ou seja, uma pilha de camada de semente TaN / Ta / Cu deve ser inserida entre o ILD e a linha Cu. Além disso, esta pilha é revestida no ILD padronizado como trincheiras e vias. Com a redução do tamanho do recurso do dispositivo, o volume disponível para a linha de interconexão de Cu diminui continuamente. A fim de alcançar uma resistência de interconexão de Cu mais baixa, a camada de barreira / forro sem sementes tem sido amplamente investigada [2,3,4,5,6]. Por exemplo, TaN ainda funciona como a camada de barreira e Co substitui Ta como a camada de revestimento. Devido a uma melhor molhabilidade do Co para o Cu do que o do Ta, o Cu pode ser eletrodepositado na superfície de Co diretamente. Tradicionalmente, a camada de barreira / forro é crescida pelo processo de deposição física de vapor. No entanto, a deposição de uma camada de barreira / liner de alta qualidade é um desafio, uma vez que o PVD tem uma taxa de cobertura de etapa pobre em trincheiras e vias de alta razão de aspecto. Em vez disso, filmes ultrafinos, contínuos e de boa cobertura podem ser obtidos pela técnica de deposição de camada atômica (ALD), graças à propriedade de crescimento autolimitante [7].
Em termos de filmes ALD Co, um grande número de precursores de Co, especialmente aqueles baseados no ligante ciclopentadienil (Cp), têm sido amplamente estudados, como bis-ciclopentadienil cobalto (CoCp 2 ) [8,9,10,11,12,13,14], bis (η-metilciclopentadienil) cobalto [Co (MeCp) 2 ] [15], e ciclopentadienil isopropil acetamidinato cobalto [Co (CpAMD)] [16]. O emprego de CoCp 2 permite o crescimento de filmes de Co com baixa resistividade e alta pureza; no entanto, o crescimento estável do filme é limitado a temperaturas acima de 250 ° C. Com a adição do grupo metil ao ligante Cp, um menor crescimento de temperatura pode ser alcançado a 200 ° C, o que é atribuído à maior reatividade de NH 3 radical ao ligante MeCp em comparação com o ligante Cp. Com base no crescimento do filme Co com CoCp 2 e Co (MeCp) 2 como precursores, a janela do processo pode ser movida para temperaturas mais baixas, isto é, <200 ° C se o grupo etil estiver conectado ao ligante Cp.
Neste trabalho, filmes finos de Co foram cultivados por ALD intensificado por plasma (PE-ALD) usando bis (etilciclopentadienil) cobalto [Co (EtCp) 2 ] e NH 3 plasma como precursores. A influência de diferentes parâmetros de processo nas características dos filmes de Co foi investigada de forma elaborada. Como resultado, uma janela de processo de 125–225 ° C foi alcançada com sucesso. Além disso, os filmes de Co exibem uma resistividade mais baixa (~ 130 μΩ cm).
Métodos
Vários filmes finos de Co foram cultivados por PE-ALD em 200 nm SiO 2 filme, que foi depositado em substratos de silício do tipo p por oxidação térmica. Co (EtCp) 2 foi usado como o precursor de metal, que foi armazenado em um recipiente a 70 ° C e transferido para a câmara de deposição com um N 2 gás portador. O NH 3 o plasma foi gerado por um gerador de plasma remoto com potência de 2.800 W, atuando como agente redutor. A taxa de fluxo de N 2 foi mantida a 50 sccm e a pressão de trabalho foi de ~ 1000 Pa durante o crescimento do filme. Para investigar o efeito da temperatura de deposição no crescimento do filme, a temperatura do substrato foi variada de 100 a 270 ° C com uma etapa de 25 ° C. Além disso, para otimizar os parâmetros do processo, os tempos de pulso de Co (EtCp) 2 e NH 3 plasma também foram alterados, respectivamente. Além disso, a fim de investigar o efeito do pós-recozimento no desempenho dos filmes de Co, as amostras depositadas em diferentes temperaturas foram recozidas no gás de formação (N 2 / 4% -H 2 ) a 400 ° C durante 30 min.
A espessura e a densidade do filme foram deduzidas por reflexão de raios-X, e a microestrutura do filme foi determinada por difração de raios-X de incidência rasante (XRD) em um difratômetro (Bruker D8 Discover) com Cu K α radiação. A morfologia da superfície do filme foi observada com microscopia de força atômica (AFM) (Bruker Icon) e microscópio eletrônico de varredura (MEV) (Zeiss SIGAMA HD). A composição elementar e as ligações químicas do filme foram analisadas por espectroscopia de fotoelétrons de raios-X (XPS) (Kratos Axis Ultra DLD). A resistência da folha do filme foi medida por uma sonda de quatro pontos, e a resistividade do filme foi calculada com base na espessura do filme e na resistência da folha.
Resultados e discussão
Otimização dos parâmetros do processo ALD
A Figura 1a mostra a taxa de crescimento do filme de Co em função da temperatura do substrato. Verificou-se que a taxa de crescimento aumenta com o aumento da temperatura do substrato para 125 ° C, e então uma taxa de crescimento relativamente estável de 0,073 ± 0,02 Å / ciclo é obtida entre 125 e 225 ° C. No entanto, quando a temperatura do substrato sobe até 250 ° C ou mais, a taxa de crescimento é aumentada. Portanto, a faixa de temperatura de 125–225 ° C pode ser considerada como uma janela de processo apropriada. Comparado com Co (Cp) 2 e Co (MeCp) 2 , a adição do grupo Et ao ligante Cp permite que a janela do processo seja movida para uma temperatura de deposição mais baixa, indicando uma maior reatividade dos ligantes EtCp com NH 3 plasma. Esse crescimento de baixa temperatura a 125 ° C é benéfico para reduzir o orçamento térmico. Em relação às temperaturas do substrato inferiores a 125 ° C, o crescimento relativamente mais lento do filme deve ser atribuído à falta de energia de ativação adequada para a reação química [7]. Essa alta taxa de crescimento a ≥ 250 ° C está relacionada à decomposição térmica do precursor de metal [17]. Para investigar a influência de Co (EtCp) 2 tempo de pulso na taxa de crescimento do filme depositado, o tempo de pulso de Co (EtCp) 2 aumenta gradualmente de 1 a 4 s com um passo de 1 s enquanto outros parâmetros do processo são fixos. Conforme mostrado na Fig. 1b, a taxa de crescimento aumenta de ~ 0,06 a ~ 0,073 Å / ciclo com o incremento de Co (EtCp) 2 tempo de pulso de 1 a 2 s, e então mantém um valor relativamente estável. Isso indica que a adsorção de superfície de Co (EtCp) 2 atinge uma saturação em um tempo de pulso de 2 s. A Figura 1b também ilustra a influência de NH 3 -tempo de pulso de plasma na taxa de crescimento do filme. A taxa de crescimento aumenta com o prolongamento do NH 3 - tempo de pulso do plasma; entretanto, quando o tempo de pulso do plasma excede 20 s, a taxa de crescimento atinge um valor de saturação de ~ 0,12 Å / ciclo.

Dependência da taxa de crescimento do filme ALD em a temperatura do substrato, b Co (EtCp) 2 e NH 3 tempo de pulso
Caracterização dos Co-filmes depositados
A Figura 2 mostra os espectros de pesquisa XPS dos filmes depositados a 175 ° C. Os filmes depositados consistem em elementos Co, N, O e C. Vale a pena mencionar que para remover completamente a contaminação da superfície, todas as amostras foram atacadas in situ com bombardeio de íons de Ar por 6 min antes da coleta dos espectros de XPS. A Tabela 1 lista as porcentagens elementares do filme depositado a 175 ° C com o tempo de corrosão e os conteúdos de C e O permanecem constantes após 6 min de corrosão, indicando uma remoção completa da contaminação da superfície. A Tabela 2 lista a razão de átomos elementares dos filmes crescidos a 100 e 175 ° C, respectivamente, que são extraídos dos espectros XPS de alta resolução. Conforme a temperatura do substrato aumenta de 100 para 175 ° C, o conteúdo relativo de C diminui de 40 para 32% e a porcentagem elementar de N aumenta de 14 para 18%. Além disso, a porcentagem relativa de O mostra um ligeiro incremento de 5 a 7%. Os maiores conteúdos de C devem ser atribuídos à remoção de parte dos ligantes EtCp [15, 16]. Como não há elemento O nos precursores, os átomos de O nos filmes depositados provavelmente são originados do oxigênio na câmara de reação.
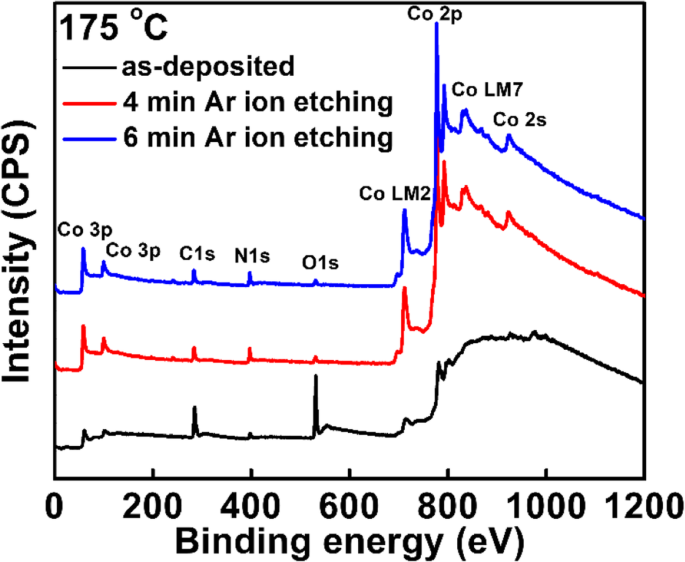
Os espectros de pesquisa dos filmes de Co depositados a 100 ° C com diferentes tempos de corrosão
A Figura 3a mostra os espectros de C 1s de alta resolução dos filmes depositados em diferentes temperaturas. O espectro de C 1s pode ser bem dividido em quatro componentes em 283,2, 284,7, 286,1 ± 0,1 eV e 288,9 eV, que resultam de C-Co [12], CC [12, 18], CN [15, 19] e Obrigações CO [12], respectivamente. Conforme a temperatura aumenta de 100 para 175 ° C, o conteúdo relativo da ligação C-C diminui de 61 para 56%, enquanto os de C-Co, C-N e C-O aumentam em 1%, 2% e 2%, respectivamente. Isso revela que mais ligantes EtCp foram decompostos em uma temperatura mais alta, levando à redução da porcentagem relativa de C no filme. A Figura 3b mostra os espectros de N 1s de alta resolução dos filmes depositados em diferentes temperaturas. Cada espectro N 1s pode ser bem separado em dois componentes usando a função Gaussiana-Lorentziana. O pico localizado em 397,8 eV deve ser associado à ligação N-Co [13], e os picos centrados em 399,2 eV devem corresponder à ligação N-C [20, 21]. Conforme a temperatura do substrato aumenta de 100 para 175 ° C, o conteúdo relativo de N-Co diminui de 72 para 69%. Isso ocorre porque a dessorção de nitrogênio do filme é aumentada em temperaturas mais altas, resultando na formação de menos ligações N-Co. A Figura 3c mostra Co 2p 3/2 de alta resolução Espectros XPS dos filmes de Co depositados em diferentes temperaturas. Em relação à existência das ligações C-Co e N-Co, conforme revelado na Fig. 3a, b, é razoável que o Co 2p 3/2 espectro pode ser separado em três componentes, que estão localizados em 778, 778,9 e 780,86 ± 0,34 eV, respectivamente. O pico na menor energia de ligação deve ser atribuído à ligação Co-Co [12, 22]. Além disso, uma vez que a eletronegatividade de Pauling de C (2,55) é menor do que a de N (3,04), a densidade de carga positiva em Co ligado a N é maior do que em Co ligado a C. Portanto, os picos em 778,9 e 780,86 ± 0,34 eV deve surgir das ligações Co-C e Co-N, respectivamente. Quando a temperatura de deposição é aumentada de 100 para 175 ° C, o conteúdo relativo da ligação Co-N diminui de 48 para 32%, o que é consistente com a evolução da ligação N-Co na Fig. 3b.

a de alta resolução Co 2p 3/2 , b C 1s e c Espectros N 1s XPS dos filmes depositados a 100 ° C e 175 ° C, respectivamente
As propriedades do cristal dos filmes de Co são caracterizadas por TEM, conforme mostrado na Fig. 4. Os filmes de Co depositados a 100 e 250 ° C, respectivamente, são ambos cristalizados. A Figura 5 mostra as imagens AFM dos filmes de Co crescidos em diferentes temperaturas. Conforme a temperatura de deposição aumenta de 100 para 250 ° C, a rugosidade quadrada média (RMS) mostra uma variação menor e mantém um valor baixo de ~ 0,3 nm, indicativo de um filme de Co plano.
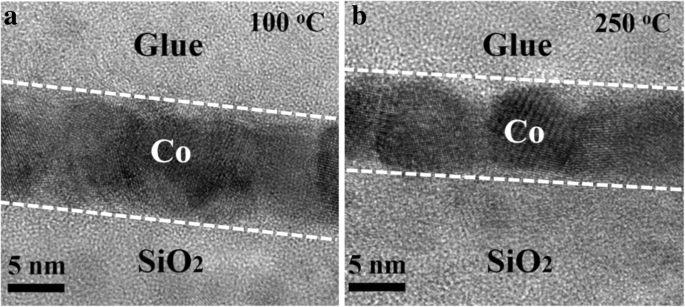
As imagens de seção transversal TEM dos filmes Co (1200 ciclos) depositados em a 100 ° C e b 250 ° C, respectivamente
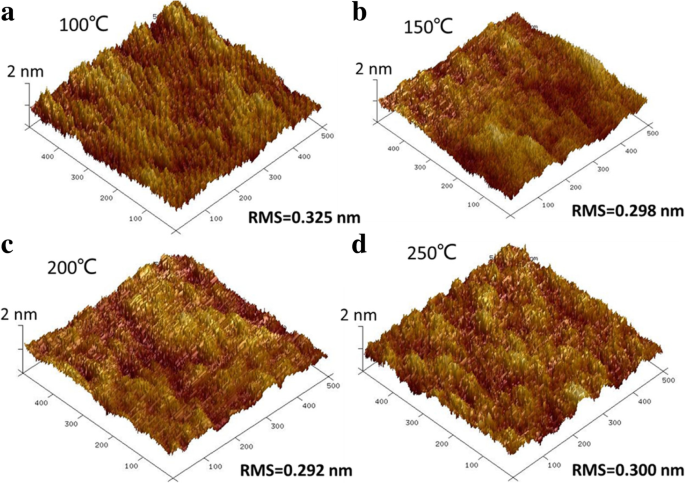
Imagens AFM dos filmes Co (1200 ciclos) depositados com Co (EtCp) 2 tempo de pulso de 2 se NH 3 tempo de pulso de plasma de 10 s em diferentes temperaturas: a 100 ° C; b 150 ° C; c 200 ° C; d 250 ° C
A Figura 6a, b mostra a dependência da resistividade dos filmes de Co na temperatura do substrato e NH 3 tempo de pulso. A resistividade do filme reduz notavelmente de 652 para 130 Ω cm e então se mantém constante com o aumento da temperatura de deposição de 100 para 275 ° C. Os resultados devem ser atribuídos ao aumento do teor relativo de Co metálico no filme. Como o NH 3 o tempo de pulso aumenta de 10 para 40 s, a resistividade dos filmes de Co diminui de 158 para 117 μΩ cm (ver Fig. 6b). A Figura 7 mostra o Co 2p 3/2 Espectros XPS dos filmes Co depositados com diferentes NH 3 tempos de plasma. Como o NH 3 o tempo de plasma é prolongado de 10 a 40 s, a porcentagem relativa das ligações Co-Co aumenta de 31 para 34% e o conteúdo relativo das ligações Co-C diminui de 40 para 31%. Além disso, o teor de carbono diminui em 22% à medida que o NH 3 o tempo de pulso do plasma aumenta de 10 para 40 s. Isso indica o aumento gradativo da remoção dos ligantes de EtCp, contribuindo para a diminuição da resistividade do filme de Co.

A resistividade do filme de Co em função da temperatura de crescimento ( a ) e NH 3 tempo de pulso ( b ), respectivamente
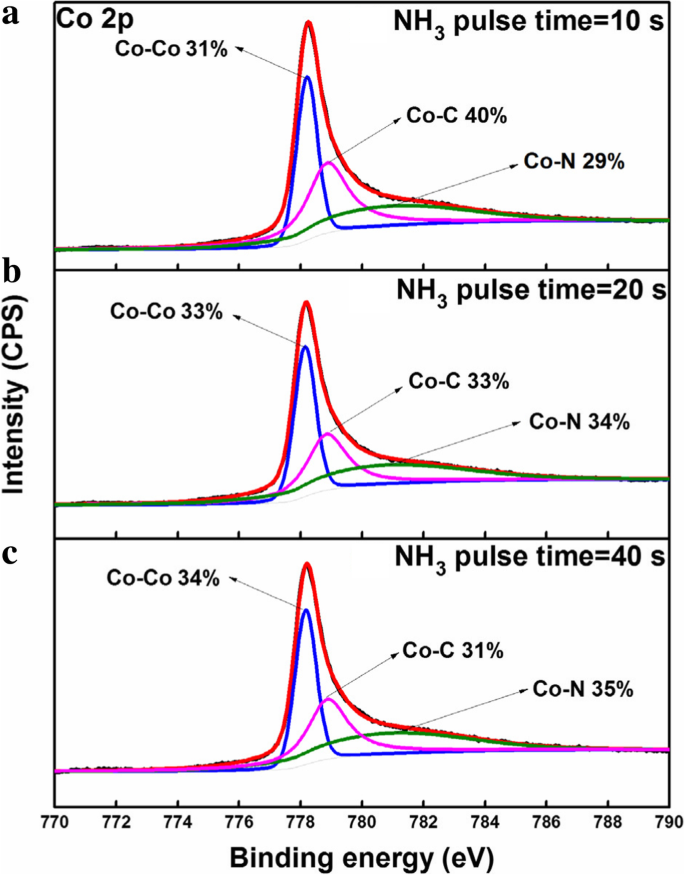
Os espectros XPS dos filmes Co com diferentes NH 3 tempos de plasma: a 10 s; b 20 s; c 40 s
A Tabela 3 mostra a comparação de desempenho dos filmes de Co crescidos por diferentes precursores. Comparado com CoCp 2 e Co (MeCp) 2 , Co (EtCp) 2 permite a deposição da camada atômica de filmes de Co em uma temperatura mais baixa. Além disso, usando o precursor de metal de Co (EtCp) 2 leva a uma taxa de crescimento menor. Teoricamente, o processo ALD é o crescimento de monocamada por monocamada. Na verdade, o efeito de impedimento estérico e a adsorção superficial dos precursores afetam o crescimento do filme. Em termos do efeito de impedimento estérico, isso significa que os ligantes das espécies de precursores de metal adsorvidos quimicamente podem proteger a superfície parcial e evitar que outras espécies de precursores de metal sejam totalmente adsorvidas na superfície do substrato. Desde Co (EtCp) 2 tem um ligante maior em comparação com CoCp 2 e Co (MeCp) 2 , presume-se que um efeito de impedimento estérico significativo ocorrerá durante o processo ALD. Isso pode levar ao crescimento da sub-monocamada, resultando em uma taxa de crescimento menor. Por outro lado, uma vez que uma camada de Co liner deve ser depositada em uma camada de barreira TaN para futuras aplicações práticas, 1200 ciclos de filmes de Co foram cultivados no filme ALD TaN a 125 ° C. A Figura 8 mostra a imagem TEM em seção transversal do filme de Co depositado na superfície TaN. Observa-se que o filme de Co é contínuo e uniforme, revelando um comportamento de crescimento superior. Além disso, verificou-se que a espessura (cerca de 10 nm) do filme de Co depositado no filme ALD TaN é semelhante ao cultivado no SiO 2 superfície.
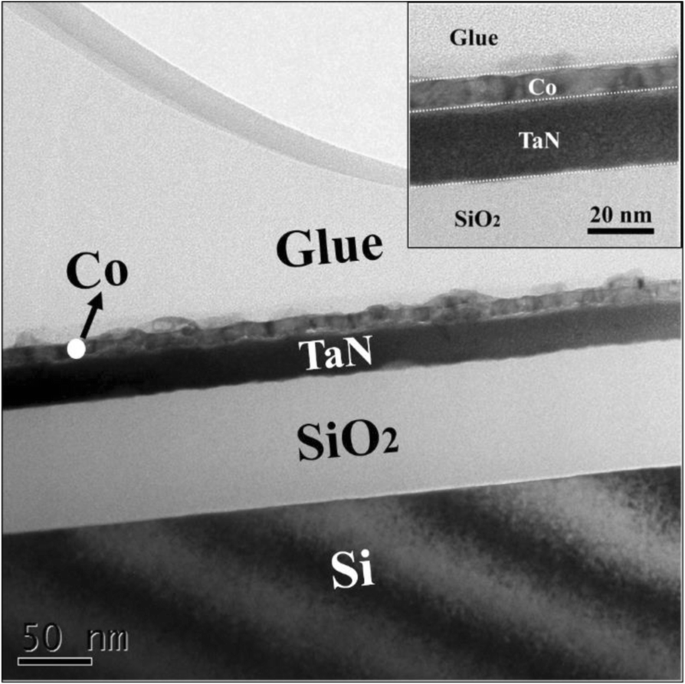
A imagem TEM em seção transversal do filme Co (1200 ciclos) depositado a 125 ° C na superfície ALD TaN e a inserção é uma imagem ampliada
Conclusões
O crescimento do filme fino de Co é devolvido por PE-ALD usando os precursores de Co (EtCp) 2 , e a influência dos parâmetros do processo nas características dos filmes de Co foram investigados. A adição do grupo Et ao ligante Cp permite que a janela do processo seja movida para uma temperatura de deposição inferior de 125 ° C. Além disso, os filmes Co são compostos de elementos Co e C juntamente com alguns elementos N e O. Com o aumento da temperatura de deposição, os ligantes EtCp são removidos mais suficientemente e a porcentagem elementar relativa de C é diminuída. Como consequência, a resistividade dos filmes de Co depositados reduz de 652 para 130 μΩ cm e então permanece um valor estável quando a temperatura do substrato é aumentada de 100 para 275 ° C. Para a temperatura de deposição de 125 ° C, a resistividade diminui gradualmente com o prolongamento de NH 3 tempo de pulso e uma baixa resistividade de 117 μΩ cm podem ser obtidos quando um NH 3 tempo de pulso de 40 s é usado. A rugosidade quadrática média mostra uma variação menor com a temperatura de deposição e mantém um valor baixo de ~ 0,3 nm, indicativo de um filme de Co plano.
Abreviações
- AFM:
-
Força atômica microscópica
- ALD:
-
Deposição de camada atômica
- Co (CpAMD):
-
Ciclopentadienil isopropil acetamidinato cobalto
- Co (EtCp) 2 :
-
Bis (etilciclopentadienil) cobalto
- Co (MeCp) 2 :
-
Bis (η-metilciclopentadienil) cobalto
- CoCp 2 :
-
Bis-ciclopentadienil cobalto
- Cp:
-
Ciclopentadienil
- ILD:
-
Dielétrico Interlayer
- PE:
-
Realçado por plasma
- RMS:
-
Raiz quadrada média
- SEM:
-
Microscópio eletrônico de varredura
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- XRD:
-
Difração de raios X
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- Investigações da sorção de íons de metal pesado usando nanocompósitos de biocarvão modificado com ferro
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Deposição em duas etapas de ZnO dopado com Al em p-GaN para formar contatos ôhmicos
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Medindo a espessura da camada usando um microscópio
- Vantagens de usar ligas



