Influência de Te-Doping em Nanowires VS InAs sem Catalisador
Resumo
Nós relatamos o crescimento de nanofios InAs livres de catalisador dopado com Te por epitaxia de feixe molecular em substratos de silício (111). Mudanças na morfologia do fio, ou seja, uma diminuição no comprimento e um aumento no diâmetro, foram observadas com o aumento do nível de dopagem. A análise da estrutura cristalina com base na microscopia eletrônica de transmissão, bem como na difração de raios-X, revela um aumento da proporção do segmento da blenda de zinco / (wurtzita + blenda de zinco) se Te for fornecido durante o processo de crescimento. Além disso, as medições elétricas de dois pontos mostram que o aumento do Te-doping causa um ganho na condutividade. Duas séries de crescimento comparáveis, diferindo apenas na pressão parcial As em cerca de 1 × 10 −5 Torr, mantendo todos os outros parâmetros constantes, foram analisados para diferentes níveis de Te-doping. A comparação sugere que a estrutura do cristal é fortemente afetada e o ganho de condutividade é mais distinto para fios crescidos em uma pressão parcial de As comparativamente mais alta.
Histórico
Nanofios (NWs) têm atraído atenção notável na última década, pois são considerados um bloco de construção promissor para tecnologias emergentes e futuras. Suas aplicações técnicas são diversas, variando de transistores de efeito de campo e dispositivos ópticos a células solares [1, 2]. A ampla aplicabilidade dos NWs se baseia em suas características marcantes, como alta relação de aspecto, dissipação de potência ultrabaixa e, no caso dos InAs, ausência de barreira Schottky na interface com contatos metálicos [3,4,5] . Este último se deve ao fato do InAs apresentar uma camada superficial de acumulação, possibilitando o contato ôhmico [6]. Do ponto de vista da física, os InAs NWs apresentam propriedades excelentes, ou seja, uma alta mobilidade de elétrons [7], uma baixa massa efetiva [8], um grande fator g [9] e um forte acoplamento spin-órbita Rashba [10, 11]. Devido a isso, eles se tornaram um ingrediente importante na pesquisa relacionada à informação quântica [5, 12,13,14].
InAs NWs são comumente cultivados por meio de um método de crescimento de vapor-líquido-sólido (VLS) usando gotículas de ouro como catalisador. O uso de Au apresenta pelo menos duas desvantagens. Por um lado, incorpora como impurezas não intencionais nos NWs degradando suas propriedades materiais [2, 15, 16], por outro lado, a integração de aplicações importantes já demonstradas como transistores de efeito de campo NW (FET) [17], túnel FETs [18], fotodetectores [19], etc., na tecnologia baseada em silício não é possível. Assim, um crescimento livre de catalisador no modo vapor-sólido (VS) desenvolvido anteriormente foi aplicado nesta comunicação [20]. Uma parte da fase de blenda de zinco cúbico (ZB), que é a fase estável em materiais III-V a granel, a fase de wurtzita hexagonal (WZ) também está presente em nanofios. O politipismo ZB-WZ e outros defeitos como gêmeos rotacionais e falhas de empilhamento são comumente relatados. Fase pura, quase livre de falhas de empilhamento InAs NWs podem ser obtidos por crescimento VLS assistido por Au [21, 22], mas não usando o método VS sem catalisador [23,24,25]. Esses defeitos impactam negativamente o transporte [26, 27] e as propriedades ópticas [28].
Uma forma de neutralizar o transporte de carga diminuído é o uso de dopagem, ou seja, a incorporação de transportadores adicionais. No entanto, os métodos de dopagem bem estabelecidos usados para camadas semicondutoras compostas III-V não podem ser simplesmente transferidos para as estruturas de fio. Os nanofios têm facetas de crescimento axial e radial com orientação de cristal diferente e reconstruções de superfície, resultando em um crescimento altamente anisotrópico que supostamente influencia a incorporação do dopante. A situação é complicada pelos diferentes modos de crescimento, vapor-líquido-sólido (VLS) e VS, das facetas participantes [29, 30] e politipismo de fase cristalina peculiar [31]. Todas essas características específicas resultam em distribuição não homogênea de dopante, tanto axial quanto radialmente [29, 32, 33]. O elemento Si do grupo IV tem sido comumente usado como dopante do tipo n para filmes finos III-V de crescimento de MBE. No entanto, o Si é conhecido por exibir comportamento anfotérico, ou seja, os átomos de Si podem ser incorporados como doadores em sítios de rede catiônica ou aceitadores em sítios de rede ânion, dependendo da orientação do substrato e das condições de crescimento [34, 35]. Este comportamento foi observado também em nanofios sendo correlacionados com as diferentes orientações dos cristais das facetas envolvidas no crescimento, mecanismos de crescimento e temperatura de crescimento [29, 36, 37]. Por outro lado, o elemento Te do grupo VI é um dopante do tipo n muito eficaz em epilayers [38], sem risco de comportamento anfotérico. Além disso, o Te tem algumas outras vantagens:uma energia de ionização mais baixa em comparação com outros dopantes do tipo n comumente usados em sistemas de materiais III-V, o que potencialmente leva à obtenção de níveis mais altos de dopagem [39]; um menor coeficiente de difusão [40] e um efeito de memória mais fraco em comparação com outros elementos do grupo VI, a saber, S e Se, que são importantes para interfaces abruptas [41]. O comportamento dopante exclusivamente do tipo n de Te foi relatado para nanofios de GaAs catalisados por Au [42] e autocatalisados, mostrando o potencial de alta concentração de dopagem rica, mas também o impacto na morfologia do fio e na estrutura cristalina [43, 44] .
Nesta comunicação, investigamos o Te-doping em InAs NWs, fornecendo informações sobre o impacto do doping na morfologia NW e a troca entre a estrutura ZB e WZ dentro do crescimento de VS na presença de Te. Investigações baseadas em microscopia eletrônica de varredura (SEM) revelaram um forte impacto do Te na morfologia NW. Microscopia eletrônica de transmissão de alta resolução (HR-TEM) [45] e medições de difração de raios-X (XRD) serviram para evidenciar uma mudança na razão ZB / (WZ + ZB) e medições elétricas de dois pontos mostraram um aumento na condutividade com elevando o nível de Te-doping.
Métodos / Experimental
InAs NWs foram cultivados no modo VS sem o uso de qualquer catalisador estranho em substratos de Si tipo n (111).
Preparação do substrato
Antes do crescimento, os substratos foram limpos com HF e água DI. Um tratamento consecutivo com peróxido de hidrogênio por 45 s leva à formação de um filme de SiO2 com poucos angstrom de espessura contendo pequenos orifícios, que servem como centros de nucleação para o crescimento NW [20]. Após a oxidação, os substratos foram imediatamente transferidos para o load-lock no qual foram aquecidos a 200 ° C por 45 min. Isso foi seguido por uma etapa de desgaseificação dentro da câmara de preparação, aquecendo as amostras a 400 ° C por mais 45 min.
Crescimento dos Nanofios InAs
Os NWs foram cultivados a uma temperatura de substrato de 475 ° C por 1:20 h em uma câmara de epitaxia de feixe molecular Omicron Pro 100 (MBE). Uma taxa de crescimento de 0,1 μmh −1 foi usado para o crescimento NW. O arsênico foi fornecido por meio de uma célula de cracker As4 e a pressão equivalente do feixe As4 (BEP) foi ajustada para valores de 2,3 × 10 –5 Torr e 3,3 × 10 –5 Torr. A primeira série de amostra (série A) foi cultivada em pressão parcial de As mais alta em comparação com uma segunda série de crescimento (série B) (cf. Tabela 1), mantendo todos os outros parâmetros constantes. O telúrio foi fornecido durante o crescimento usando GaTe estequiométrico. A temperatura de operação da célula de efusão variou entre 401 ° C e 562 ° C com base em calibrações conduzidas em camadas de GaAs dopadas com Te por meio de medições Hall. As temperaturas da célula GaTe 401 ° C, 447 ° C, 500 ° C e 561 ° C correspondem a uma concentração de transportador de cerca de 1 × 10 15 cm −3 , 4 × 10 16 cm −3 , 5 × 10 17 cm −3 e 6 × 10 19 cm −3 respectivamente, em GaAs (100) camadas usadas para calibração.
Processamento do dispositivo
A fim de processar contatos de dois pontos, os NWs foram transferidos mecanicamente em um substrato de Si pré-padronizado que foi coberto com 200 nm de SiO2. Um diagrama esquemático das etapas de contato é fornecido no arquivo adicional 1:Figura S1. Antes da deposição do metal, os fios foram revestidos por rotação por um sistema de três camadas de resistência de 50 K (AR-P639.04), 50 K e 950 K (AR-P679.04) PMMA em que a forma de contato foi definida via litografia de feixe eletrônico. Após o desenvolvimento, a área de contato foi passivada por polissulfeto de amônio 3,5% diluído (H 2 O:(NH4) 2 S 3 , 34:1) a 60 ° C durante 30 min. Os eletrodos, consistindo de titânio de 100 nm e ouro de 40 nm, foram depositados por meio de um evaporador de feixe de elétrons.
A lista completa de amostras investigadas via SEM, TEM, XRD e medições elétricas é apresentada na Tabela 1. Aqui, as letras A, B e C indicam a série de amostras que foram cultivadas cada uma em diferentes pressões parciais de As, mas separadas daquelas em condições de igualdade. Uma temperatura GaTe de 0 ° C corresponde a um obturador de célula fechada.
Resultados e discussão
Morfologia
Imagem SEM foi usada para investigar a influência do Te-doping na morfologia do fio. Os resultados são apresentados na Fig. 1. Cada ponto de dados nos gráficos representa a média de pelo menos 40 fios e a barra de erro seu desvio padrão.

Morfologia de nanofios. Comprimento e diâmetro médios do nanofio em diferentes temperaturas da célula GaTe. a A série A foi cultivada a uma pressão parcial As de cerca de 3,3 × 10 –5 Torr. b A série B foi cultivada a uma pressão parcial As de 2,3 × 10 –5 Torr. As linhas tracejadas são um guia para os olhos. A micrografia SEM mostrada na inserção descreve InAs NWs não dopados cercados por cristalitos formados durante o crescimento. A barra de escala é de 300 nm e 120 nm, respectivamente
A Figura 1a mostra a morfologia da série de fios A crescida a uma pressão parcial As de cerca de 3,3 × 10 −5 Torr. A temperatura da célula GaTe variou de 0 ° C a 561 ° C. Levando em consideração a barra de erro, nenhuma tendência distinta do diâmetro e comprimento NW é observada até a temperatura da célula de 500 ° C. No entanto, a 561 ° C o suprimento de Te é claramente prejudicial, levando a um forte aumento no diâmetro e diminuição no comprimento NW. A série de crescimento B, representada na Fig. 1b, cresceu a uma pressão de As comparativamente mais baixa de 2,3 × 10 −5 Torr. A inserção mostra uma vista lateral SEM exemplar de uma amostra crescida, exibindo InAs NWs e clusters na superfície do substrato. Outras imagens SEM das séries A e B são mostradas no arquivo adicional 1:Figura S2. Aqui, uma faixa de temperatura da célula GaTe de 0 ° C a 462 ° C foi explorada. Observamos uma diminuição no comprimento quando Te é adicionado durante o crescimento para a série B a uma temperatura de célula de 401 ° C. Comparando as medições das séries A e B no mesmo intervalo de temperatura, observa-se que, em particular, a diminuição do comprimento NW é mais distinta em pressões de As comparativamente mais baixas (série B). No entanto, a mesma tendência geral, ou seja, uma diminuição no comprimento NW é observada para ambas as séries e um aumento no diâmetro é observado para a série A.
A dopagem com Si leva de forma semelhante a um diâmetro aumentado e comprimento diminuído para InAs e GaAs, independentemente do método de crescimento (MBE ou epitaxia de fase de vapor metalorgânica (MOVPE)) [46, 47]. A mesma mudança nas dimensões foi observada para Te-dopagem de GaAs livre de catalisador NWs crescidas por MBE [44]. Parece que independente do sistema de material usado, ou seja, materiais IIIV dopados com materiais do grupo IV (InAs / Si, GaAs / Si) ou materiais do grupo VI (GaAs / Te, InAs / Te), a mesma tendência geral em relação à morfologia é observada.
Te exibe um raio covalente bastante grande em relação aos átomos da rede hospedeira e pode, portanto, atuar como surfactante [48, 49]. O comportamento observado pode, portanto, ser originado em uma difusividade diminuída dos átomos In causada pelo Te. Isso, por sua vez, poderia causar o aumento do crescimento radial e uma diminuição do comprimento, pois os In adátomos são impedidos em seu caminho para a ponta NW, onde controlam o crescimento [46]. Comparando a Fig. 1a (série A) e a Fig. 1b (série B), descobrimos que a pressão de As influencia como a morfologia do fio é afetada pela adição de Te. A descoberta sugere que pode ser possível neutralizar o impacto decrescente do Te na dimensão radial e axial do fio InAs aumentando a pressão de As até certo ponto.
Estrutura do cristal
O impacto dos Te-dopantes na estrutura cristalina foi investigado usando TEM e XRD. Adotando a classificação usada por Caroff et al. [49], uma sequência de empilhamento de cristal foi atribuída a um segmento ZB (cf. Fig. 2a) ou WZ (cf. Fig. 2d) se a sequência de empilhamento seguiu exatamente quatro bicamadas de átomos. Isso significa que ... ABCA ... foi contado como um segmento ZB e ... ABAB ... como um segmento WZ. Isso é ilustrado na Fig. 2b, e. Aqui, cada letra representa uma bicamada de átomos. Algumas seções de fio são interrompidas por falhas de empilhamento (SFs) que consistem em uma camada ausente ou em excesso dentro da sequência de cristal, conforme apresentado na Fig. 2c, f. Embora raramente observada, a geminação rotacional também está presente em alguns segmentos (não mostrado aqui).
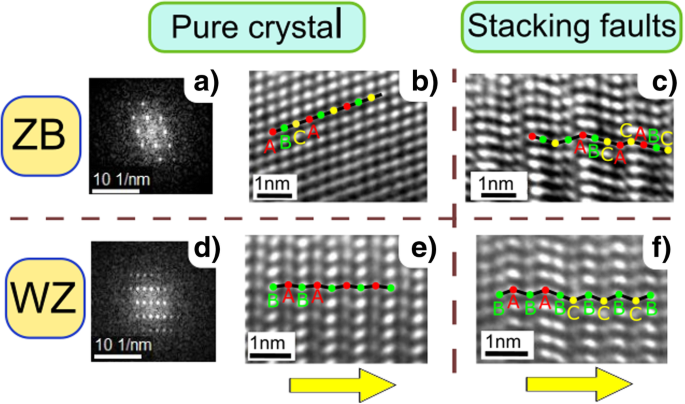
Análise da estrutura cristalina. Imagens HR-TEM de InAs NWs, ilustrando as estruturas cristalinas ZB e WZ com e sem falhas de empilhamento. As setas amarelas indicam a direção de crescimento [111]. Os pontos coloridos e as linhas pretas são orientações para que os olhos reconheçam a característica de empilhamento. a Padrão de difração FFT para ZB sem defeitos. b , c Estrutura ZB. d Padrão de difração FFT para WZ livre de defeitos e e - f Estrutura WZ
As seções de cristal foram identificadas como segmentos ZB ou WZ apenas se uma sequência completa consistindo em quatro bicamadas de átomos foi observada. As seções restantes foram atribuídas a SFs ou gêmeos rotacionais.
A estrutura cristalina em três diferentes níveis de dopagem avaliados de acordo com as características explicadas é ilustrada na Fig. 3. Diferentes áreas WZ e ZB são destacadas. No entanto, para a análise, apenas segmentos individuais foram contados. A fim de quantificar a influência do Te-doping na estrutura cristalina NW, um comprimento total de cerca de 150 nm de segmentos de 10 NWs para cada nível de dopagem foi analisado e calculado (cf. Fig. 3b-d). A razão do segmento ZB / (WZ + ZB) foi determinada contando o número de segmentos ZB e WZ únicos. As amostras B1, B3, C1 e A4 a 0 ° C, 447 ° C e 500 ° C foram analisadas (cf. Fig. 4), respectivamente. Observamos um aumento da razão do segmento ZB / (WZ + ZB) com o aumento da temperatura da célula GaTe. Esta tendência é ilustrada na Fig. 4. Comparando os dois primeiros pontos de dados (0 ° C e 447 ° C), a proporção aumentada é devido a um aumento mais forte nos segmentos ZB em comparação com o aumento dos segmentos WZ do não dopado ao temperatura mais baixa de dopagem (cf. inserção Fig. 4). Ambos os tipos de estrutura são aprimorados e o número de SFs é reduzido. No entanto, a tendência difere para o terceiro ponto. Ao comparar o nível de dopagem mais alto com o mais baixo (500 ° C e 447 ° C), descobrimos que o número de segmentos WZ diminui e o número de segmentos ZB permanece quase constante (cf. inserção da Fig. 4) enquanto o número de SFs aumenta. Isso leva a uma proporção elevada. Ainda assim, a seção ZB é promovida em comparação com o caso não dopado. Finalmente, os resultados mostram que o Te-doping realmente aumenta a razão do segmento ZB / (WZ + ZB). No entanto, permanece ambíguo se a formação de segmentos ZB é estritamente promovida pela incorporação de Te.
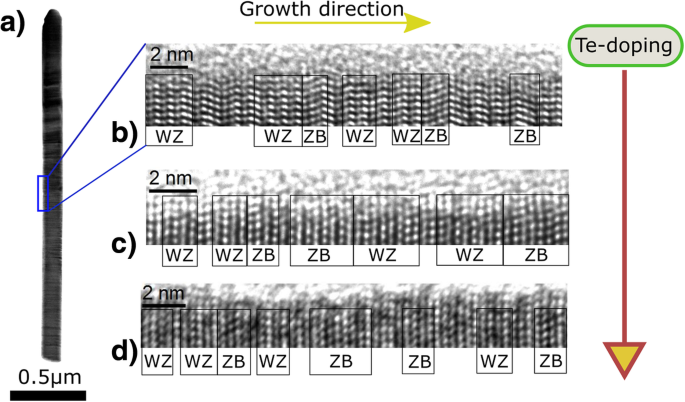
Influência do te-doping na estrutura cristalina. Imagens TEM que representam a estrutura cristalina em NWs de InAs sem dopagem e com dopagem. a Vista lateral de um InAs NW. b - d Imagens HR-TEM da estrutura cristalina InAs NW (imagem girada 90 ° no sentido horário). As áreas WZ e ZB são rotuladas. As seguintes amostras e temperaturas de células GaTe foram escolhidas: b B1 (como 4 -BEP =2,3 × 10 −5 Torr), não dopado, isto é, 0 ° C. c B3 (como 4 -BEP =2,3 × 10 −5 Torr), 447 ° C. d C1 (como 4 -BEP =3,0 × 10 −5 Torr), 500 ° C

Razão entre os segmentos ZB e WZ. Razão entre o número de segmentos ZB e o número total de segmentos identificados como WZ ou ZB na dependência da temperatura da célula GaTe. Para as duas primeiras medições, B1 e B3 foram analisados. A 500 ° C, os resultados dos fios C1 e A4 foram mesclados à medida que cresceram em As-BEP semelhantes. O gráfico de barra na inserção representa o comprimento acumulado de todos os segmentos WZ e ZB presentes no NW na temperatura da célula indicada, respectivamente
A fim de complementar as observações feitas por TEM, medições de XRD foram realizadas. Realizamos varreduras φ com foco nos reflexos cúbico (220) e hexagonal [10,11,12,13,14,15]. Esses reflexos podem ser atribuídos inequivocamente à estrutura ZB e WZ, respectivamente. A medição das respectivas intensidades permitiu extrair o I ZB / ( eu ZB + eu WZ ) relação de intensidade. As varreduras φ representadas na Fig. 5a serviram para determinar as intensidades relativas dos picos ZB e WZ em cada temperatura de dopagem de células GaTe. Para o reflexo ZB, seis picos ocorrem, embora a rede cúbica só deva levar a uma simetria de 3 vezes. Atribuímos esses picos a gêmeos simétricos na estrutura ZB. Os picos simétricos de seis vezes que ocorrem na varredura WZ são característicos da estrutura de cristal hexagonal e correspondem às nossas expectativas. Aqui, a intensidade do sinal de cristalitos de superfície InAs (cf. inserção na Fig. 1) é assumida como sendo duas ordens de magnitude menor do que o sinal NW [50] e pode, portanto, ser desprezada. A relação de intensidade correspondente I ZB / ( eu ZB + eu WZ ) é traçado na Fig. 5b (triângulos coloridos para a série A). Mostra um aumento do I ZB / ( eu ZB + eu WZ ) relação de intensidade com o aumento da temperatura da célula GaTe, tornando-se aparente após 401 ° C para a série A. Este resultado está de acordo com a observação já obtida na análise TEM. Observe que as razões de intensidade fornecidas não representam a proporção ZB / WZ real, mas constituem um resultado qualitativo. Isso se deve ao fato de que diferentes reflexos são de intensidades diferentes, de acordo com o fator de estrutura que não foi levado em consideração explicitamente. No entanto, a comparação entre os pontos de dados permanece válida. A mesma medição sensível ao reflexo foi conduzida para a série B, que cresceu a uma pressão de As mais baixa do que a série A apresentada acima. Os resultados representados na Fig. 5b (pontos pretos) mostram uma tendência semelhante à da série A, ou seja, um aumento na razão de intensidade ZB / (WZ + ZB) em temperaturas de célula mais altas. No entanto, o impacto dos átomos de Te na estrutura cristalina é menos distinto em comparação com as pressões de As mais altas e um aumento claro só é observado a 462 ° C. Embora a série B mostre apenas um aumento da razão de intensidade ZB / (WZ + ZB) no XRD para a temperatura de célula GeTe mais alta de 462 ° C, a série A exibe claramente um aumento na temperatura de célula de 447 ° C e 500 ° C. Essa observação sugere que os átomos de As facilitam a incorporação de átomos de Te, o que por sua vez leva a uma mudança na estrutura cristalina. Assim, verifica-se um impacto mais forte na relação ZB / (WZ + ZB) para as respetivas pressões de As mais elevadas. A diminuição da razão de intensidade a 447 ° C na Fig. 5b pode ser devido aos efeitos de sombreamento, uma vez que a densidade NW para a amostra B3 estava acima da média, embora isso ainda não seja totalmente compreendido.

Análise de raios-X da estrutura da rede. a φ varreduras obtidas por meio de medições de raios-X em InAs NWs A1-A4. b Resultante eu ZB / ( eu WZ + eu ZB ) razão de intensidade vs. temperatura da célula GaTe. Os pontos de dados triangulares são extraídos das medições descritas em ( a ) para as amostras A1 – A4. Os pontos pretos indicam os pontos de dados das amostras B1 – B4
A partir dos resultados de TEM apresentados acima, conclui-se que os NWs que foram cultivados sob o fornecimento de Te mostram um número aumentado de segmentos ZB e WZ e, portanto, menos SFs em comparação com o caso não dopado. Além disso, as medições de XRD indicam que a razão de intensidade ZB / (WZ + ZB) aumenta com o aumento do nível de dopagem de Te (em temperaturas mais altas) que está qualitativamente em linha com as medições de TEM. Em contraste com os elementos comuns usados para dopagem de materiais III-V, como Si (InAs / Si [30], GaAs / Si), C (GaAs / C) ou Be (GaAs / Be), Te afeta claramente a estrutura cristalina do NW. A promoção da formação de ZB observada pode se originar de uma mudança nas energias de superfície, diminuindo a barreira de energia para a nucleação de ZB. Isso foi igualmente observado em nanofios InP dopados com zinco [51], onde o crescimento VLS catalisado por Au foi usado. No entanto, mais pesquisas são necessárias para esclarecer o mecanismo subjacente.
Medições elétricas
A condutividade definida por σ =A · R · L −1 w foi extraído de medições de dois pontos usando contatos Ti / Au. Aqui, A é a seção transversal hexagonal do fio com A =3√3 d 2 NW / 8 onde d NW é o diâmetro máximo, R a resistência e Lw a distância entre os contatos elétricos. L w e d NW foram medidos individualmente para cada fio por meio de imagem SEM. As características I – V exemplares de NWs de InAs dopados e dopados são apresentadas na Fig. 6a – d. Os gráficos mostram o comportamento ôhmico esperado devido à camada superficial de acumulação de InAs [6, 52]. A condutividade na dependência do nível de dopagem foi determinada com base nas medições I – V e na geometria NW. A dependência resultante entre a condutividade e a temperatura da célula GaTe é ilustrada na Fig. 6e. Em cada temperatura, pelo menos 20 NWs foram examinados para a série A. Comparando fios não dopados e dopados, um aumento na condutividade média de cerca de uma ordem de magnitude no nível de dopagem mais alto é observado. A uma temperatura de célula GaTe de 500 ° C, foi determinada uma condutividade média de cerca de 80 S / cm (em comparação com cerca de 8 S / cm para 0 ° C). Embora a propagação da condutividade para níveis mais elevados de dopagem seja bastante distinta, nossa observação mostra que a incorporação de Te de fato tem um forte impacto, levando a um aumento da condutividade em média. A comparação do XRD e a medição da condutividade sugere que abaixo de 401 ° C o impacto do Te na estrutura do cristal e nas propriedades de transporte desempenha apenas um papel menor. A grande variação na condutividade de NWs de InAs mencionada acima foi relatada de forma semelhante na literatura [53]. Nenhuma tendência da condutividade foi observada com relação a uma mudança no diâmetro NW ou espaçamento de contato, como esperado [26]. Assim, excluímos a relação de aspecto diferente como uma fonte de erro. Identificamos três razões principais responsáveis pela forte variação na condutividade:(i) o método de passivação de contato usando polissulfeto de amônio pode levar a uma qualidade de contato heterogênea. (ii) A superfície do fio não é passivada e os estados da superfície podem ser influenciados por uma saturação não homogênea das ligações pendentes nas facetas laterais do fio via água e oxigênio, o que finalmente resulta em oxidação superficial não uniforme. Isso, por sua vez, tem um forte impacto nas características de transporte, levando a grandes erros [54]. Uma forma de prevenir estes estados superficiais heterogêneos é a passivação via deposição in situ de Al 2 O 3 [53, 55]. (iii) A dopagem não homogênea ao longo do NW, como observada para a dopagem com Si [26], também pode causar a grande disseminação de dados, embora tenhamos tentado excluir isso colocando os contatos centralizados para cada fio. Finalmente, variações no comprimento NW (cf. Fig. 1) e densidade podem levar a efeitos de sombreamento, impedindo a incorporação homogênea de Te em toda a amostra. No entanto, investigações mais sistemáticas são necessárias para identificar a origem da grande variância observada. Além disso, as medições de condutividade para NWs da série B crescidas a uma pressão de As comparativamente mais baixa foram conduzidas. Aqui, pelo menos seis fios foram medidos para cada temperatura de célula GaTe. Os resultados representados na Fig. 6e mostram um comportamento semelhante aos discutidos acima para a série A. A condutividade dos InAs NWs é aumentada para temperaturas mais altas da célula GaTe. No entanto, o efeito é menos distinto em comparação com a série A, cultivada em uma pressão de As mais alta. Comparando as condutividades de ambas as séries a 401 ° C e 447 ° C na Fig. 6e, descobrimos que os valores para a série A são cerca de duas vezes maiores que os encontrados para B. Os resultados de XRD apresentados acima (cf. Fig. 5 ) ilustram que a estrutura cristalina na série A é mais fortemente afetada pela incorporação de Te do que na série B. A combinação de ambas as descobertas indica que a condutividade elevada está relacionada à mudança na estrutura cristalina, ou seja, o aumento de ZB / (WZ + ZB) relação de intensidade. É conhecido da literatura que uma modificação na estrutura cristalina InAs NW de WZ dominada para ZB, aumenta a condutividade [50, 53, 56]. Com base em investigações de TEM no InAs 1 - x Sb x NWs, Sourribes et al. relataram um aumento na condutividade de 1,5 para um ganho na fração NW ZB de 20 a 80% [50]. Nossos resultados de TEM (cf. Fig. 4) mostram uma razão ZB / (WZ + ZB) elevada de 32% (NW não dopado) a 43% (NW dopado máximo), enquanto o valor médio de condutividade aumenta cerca de um fator de 10. Isso a comparação sugere que a estrutura cristalina alterada não é a única razão para o aumento da condutividade. Embora a modificação da estrutura cristalina afete o transporte de portadores, o efeito observado é provavelmente devido a uma densidade de portadores aumentada induzida por Te atuando como um doador.
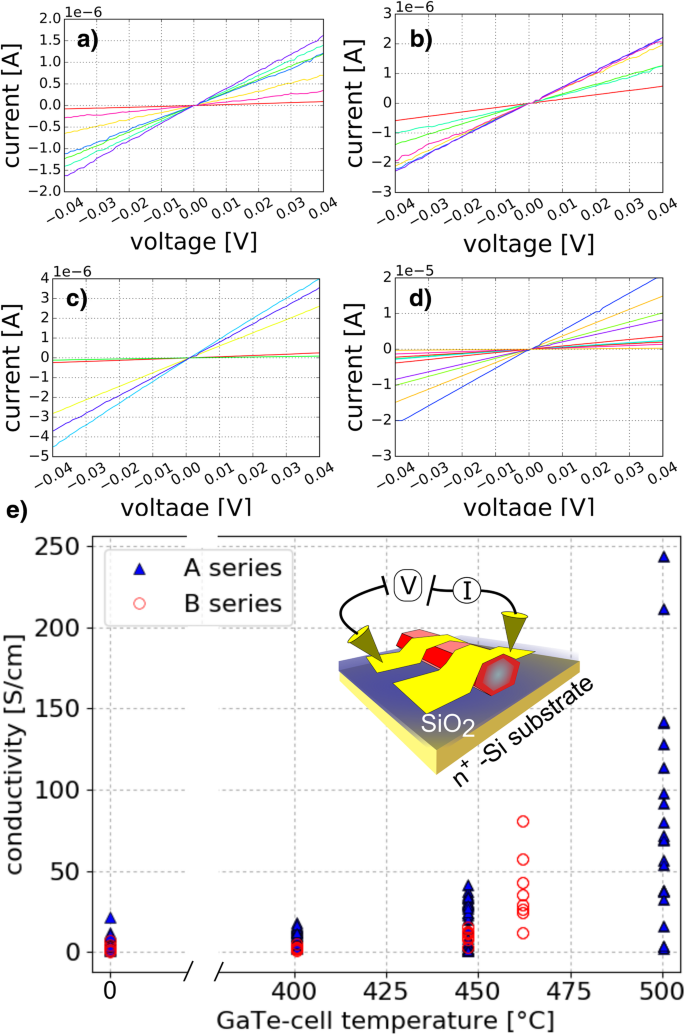
Caracterização elétrica. a - d Medições I – V exemplares de InAs NWs em uma temperatura de célula GaTe de 0 ° C, 401 ° C, 447 ° C e 500 ° C (série A) medidas por meio de contatos de dois pontos. e Valores de condutividade determinados de InAs NWs dopados com Te na dependência da temperatura da célula GaTe para as séries A (alto As-BEP) e B (baixo As-BEP). A inserção mostra um esquema da configuração da medição elétrica
Conclusão
Em resumo, cultivamos InAs NWs sem catalisador dopado com Te em substratos de Si (111) por meio do método de crescimento sólido de vapor. Te foi fornecido por uma célula GaTe permitindo o crescimento de NWs de InAs dopados com Te em diferentes níveis de dopagem, ajustando a temperatura da célula. Duas séries de amostras cultivadas em diferentes As-BEPs foram caracterizadas por SEM, TEM, XRD e medições elétricas. Mostramos que Te muda a morfologia NW levando a uma tendência geral de aumento da taxa de crescimento radial e diminuição da taxa de crescimento axial. O impacto é mais forte em pressões parciais de As comparativamente mais baixas. Medições de TEM e XRD revelaram que a estrutura cristalina NW é afetada pela adição de Te, resultando em um aumento da razão ZB / (WZ + ZB) para ambas as séries de crescimento. A influência na estrutura cristalina NW crescida em As-BEP comparativamente mais alto foi mais intensificada do que observada para NWs crescidos em As-BEP mais baixas. Medições elétricas de dois pontos demonstraram um aumento na condutividade média para fios cultivados sob fornecimento de Te. Isso foi observado para duas séries de crescimento, cultivadas em diferentes pressões de As. A comparação entre as duas séries de amostras mostrou que as propriedades elétricas e cristalinas dos InAs NWs são mais fortemente afetadas pela adição de Te em pressões de As mais altas. O resultado indica que a condutividade média melhorada está fortemente relacionada com a mudança na estrutura do cristal, ou seja, o aumento na razão ZB / (WZ + ZB). Atribuímos as propriedades de transporte aprimoradas tanto ao elemento Te do grupo VI incorporado atuando como um doador, quanto a uma estrutura cristalina alterada. Este trabalho constitui uma importante contribuição no sentido de estender as opções de dopagem NW, que é de grande interesse para neutralizar a degradação das propriedades de transporte pelos FSs.
Abreviações
- Como:
-
Arsênico
- BEP:
-
Pressão equivalente do feixe
- C:
-
Carbono
- GaAs:
-
Arsenieto de gálio
- GaTe:
-
Telureto de gálio
- HR-TEM:
-
Microscopia eletrônica de transmissão de alta resolução
- InAs:
-
Arsenieto de índio
- MBE:
-
Epitaxia de feixe molecular
- MOVPE:
-
Epitaxia de fase de vapor metalorgânica
- NW:
-
Nanowire
- SEM:
-
Microscopia eletrônica de varredura
- SF:
-
Falha de empilhamento
- Si:
-
Silício
- Te:
-
Telúrio
- VS:
-
Vapor-sólido
- WZ:
-
Wurtzite
- XRD:
-
Difração de raios X
- ZB:
-
Blenda de zinco
Nanomateriais
- Sustentando o crescimento da IoT
- Crescimento do CMMS para pequenas empresas
- Cientistas de materiais ensinam nanofios a 'dançar'
- Sobre nanopartículas semicondutoras
- Investigações de Estruturas de Vacância Relacionadas ao Seu Crescimento na Folha h-BN
- Crescimento autocatalisado de nanofios de GaSb verticais em hastes de InAs por deposição de vapor químico orgânico-metálico
- Nanofios de silício amorfo cultivados em filme de óxido de silício por recozimento
- Investigação teórica de nanofios de germânio deformados biaxialmente por tração
- Controlando o crescimento de seleneto de índio de alta uniformidade (In2Se3) Nanofios por meio do processo de recozimento térmico rápido em baixa temperatura
- Influência da rigidez elástica e adesão da superfície no salto de nanopartículas



