Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
Resumo
O HfO 2 / TiO 2 / HfO 2 Dispositivos de memória de acesso aleatório resistivo de estrutura tricamada (RRAM) foram fabricados em substratos de Si revestidos com Pt e TiN com eletrodos de topo de Pt por deposição de camada atômica (ALD). O efeito dos eletrodos de fundo de Pt e TiN nas propriedades de chaveamento resistivo de unidades de estrutura de três camadas foi investigado. Ambos Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / TiN apresentam comportamento de comutação resistiva bipolar típico. Os mecanismos de condução dominantes em estados de baixa e alta resistência (LRS e HRS) de ambas as células de memória são o comportamento ôhmico e a corrente limitada por carga espacial, respectivamente. Verificou-se que os eletrodos de fundo de Pt e TiN têm grande influência na preferência de polaridade de eletroformação, razão de alta e baixa resistência e dispersão das tensões de operação das células de memória de estrutura tricamada. Em comparação com o uso de eletrodos simétricos de Pt superior / inferior, as células RRAM usando eletrodos assimétricos de Pt superior / inferior TiN mostram menor tensão de formação negativa de -3,7 V, distribuição relativamente estreita das tensões de ajuste / redefinição e menor proporção de resistências alta e baixa de 10 2 . A polaridade de eletroformação dependente de eletrodo pode ser interpretada considerando a atividade química dos eletrodos com oxigênio, as reações relacionadas no ânodo e a distribuição não uniforme da concentração de vacância de oxigênio na estrutura de três camadas de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN. Além disso, para Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivos TiN, o eletrodo TiN como reservatório de oxigênio desempenha um papel importante na redução da tensão de formação e na melhoria da uniformidade dos parâmetros de comutação resistiva.
Histórico
A memória de acesso aleatório resistiva (RRAM) tem atraído grande atenção devido ao seu potencial para a substituição da memória flash em memórias não voláteis de próxima geração [1,2,3]. O fenômeno de comutação resistiva (RS) foi amplamente descoberto em óxidos de metais de transição, eletrólitos sólidos e polímeros orgânicos [4,5,6,7]. Dispositivos RRAM baseados em óxidos de metal de transição têm sido amplamente explorados devido à sua composição simples e processamento compatível com a fabricação convencional de óxido metálico complementar semicondutor (CMOS) [8,9,10]. O modelo de filamento de migração de vacância de oxigênio é usado para elucidar o comportamento de comutação [1, 11]. Um princípio microscópico unificado é proposto para quantificar as características de troca unipolar e bipolar de RRAM baseado em óxido de metal de transição, que são correlacionadas com a distribuição de vacâncias localizadas de oxigênio na camada de troca de óxido [12, 13].
No entanto, as células de memória que usam óxidos de metal de transição sofrem de não uniformidade de parâmetros de chaveamento resistivo, como valores de resistência instáveis de estados de baixa e alta resistência (LRS e HRS), conjuntos dispersos e tensões de reset, impedindo as aplicações comerciais. Recentemente, foi demonstrado que os dispositivos RRAM baseados em óxido de estrutura em três camadas melhoram a dispersão dos parâmetros de comutação resistivos. As células com uma estrutura de Al 2 O 3 / HfO 2 / Al 2 O 3 exibiu uma uniformidade fantástica de tensões de ajuste e reset, e excelente resistência de comutação entre o LRS e o HRS [14]. A ligação ou ruptura dos filamentos condutores ocorreu mais facilmente em duas camadas interfaciais entre Al 2 O 3 / IL / HfO 2 / IL / Al 2 O 3 . Enquanto isso, a unidade da estrutura de três camadas de TaO x / TiO 2 / TaO x mostrou bom desempenho em matrizes de um seletor e um resistor, o que foi atribuído ao fato de que a banda de energia do TiO 2 o filme foi simetricamente dobrado na parte superior e inferior TaO x / TiO 2 interfaces e modificadas como uma barreira de óxido crista devido à difusão de alguns átomos de Ta no TiO 2 filme [15].
Além disso, o comportamento RS de um determinado meio de armazenamento de óxido pode ser significativamente afetado pelos materiais do eletrodo [1, 16, 17]. No entanto, os modelos existentes baseados na energia livre de formação do óxido interfacial e nas funções de trabalho do metal são insuficientes para explicar completamente os resultados. Enquanto isso, o trabalho sobre o fenômeno RS dependente de eletrodos da estrutura de três camadas RRAM também está faltando no momento.
A deposição de camada atômica (ALD) é um novo tipo de tecnologia de deposição de filme fino com base em reações sequenciais de quimioabsorção de superfície autolimitada e complementar usando vapor precursor com controle de espessura simples e de precisão, grande uniformidade de área e excelente conformalidade tridimensional, especialmente para deposição de estrutura nano-laminada [18, 19].
Neste trabalho, o HfO 2 / TiO 2 / HfO 2 Dispositivos RRAM de estrutura tricamada foram preparados em Si / SiO 2 Substratos / Ti / Pt e Si / TiN com eletrodos de topo de Pt por ALD. O impacto dos eletrodos inferiores de Pt e TiN nos comportamentos RS de HfO 2 / TiO 2 / HfO 2 dispositivos foi investigado cuidadosamente. A explicação relacionada foi proposta.
Métodos
Neste experimento, usamos dois eletrodos de fundo diferentes, incluindo Si / SiO comercial 2 / Ti / Pt e Si / SiO caseiro 2 /Lata. O TiN condutor foi depositado por deposição da camada atômica intensificada por plasma (PEALD) em nosso laboratório.
ALD foi realizado em um Picosun SUNALE TM comercial Reator avançado R-200 (Picosun, Finlândia). P wafers do tipo Si (100) com resistividade de 1 ~ 10 Ω cm foram usados como substratos iniciais. Após a limpeza RCA convencional das pastilhas de Si sem remover o óxido nativo, TiN de 30 nm de espessura foi depositado em Si como o eletrodo inferior a 400 ° C por PEALD, usando TiCl 4 à temperatura ambiente e NH 3 gás de plasma como os precursores de Ti e N, respectivamente. NH líquido 3 foi selecionado como NH 3 fonte de plasma à temperatura ambiente. A potência do plasma e NH 3 a taxa de fluxo de gás foi de 2500 W e 150 sccm, respectivamente.
Posteriormente, 5 nm HfO 2 / 10 nm TiO 2 / 5 nm HfO 2 estruturas de empilhamento foram depositadas por sua vez em substratos de Si revestidos com Pt e TiN a 250 ° C por ALD térmico usando Hf [N (C 2 H 5 ) CH 3 ] 4 (TEMAH), TiCl 4 , e H 2 O como os precursores Hf, Ti e O, respectivamente, onde um ciclo de óxido consistia em 0,1 s injeção de fonte de metal, 4 s N 2 purgando, 0,1 s H 2 Injeção O e 4 s N 2 purgando. TEMAH foi evaporado a 150 ° C. Pure N 2 (99,999%) foi usado como gás de arraste e gás de purga. Em seguida, eletrodos de topo de Pt de 100 nm de espessura foram pulverizados por DC através de uma máscara de sombra com um diâmetro de 150 μm usando o sistema Q150T.
O crescimento por ciclo (GPC) de HfO puro 2 ou TiO 2 em Si foi determinado por elipsômetro espectroscópico (GES-5, Sopra). A topografia e a rugosidade da superfície dos filmes e eletrodos de fundo foram analisadas por microscopia de força atômica (AFM, Cypher, Asylum Research). Os valores de rugosidade quadrática média (RMS) foram registrados em áreas de 1 μm × 1 μm. A composição e o estado químico das estruturas da pilha foram examinados por espectroscopia de fotoelétrons de raios-X (XPS, Thermo Fisher K-Alpha) com um Al K monocromático α fonte (hν =1486,6 eV) para excitação de fotoelétrons. O efeito de carga foi calibrado definindo o C 1 s fotoemissão a 284,6 eV. O perfil de profundidade XPS de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN foi obtido por ataque de íon Ar. As propriedades elétricas do HfO 2 / TiO 2 / HfO 2 Dispositivos RRAM de estrutura tricamada foram medidos pelo sistema de caracterização de semicondutor Keithely 4200 na estação de sonda (CasCade Summit 12000 B-M). Uma conformidade de corrente de 10 mA foi imposta para proteger as unidades do dispositivo fabricadas de danos de alta corrente durante os processos de ajuste. A tensão de polarização foi aplicada ao eletrodo superior de Pt com os eletrodos inferiores aterrados de Pt ou TiN.
Resultados e discussão
O esquema do dispositivo RRAM de HfO 2 / TiO 2 / HfO 2 A estrutura em três camadas por ALD é ilustrada na Fig. 1. A morfologia da superfície e aspereza dos eletrodos de fundo e a estrutura em três camadas de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN foram examinados. O eletrodo inferior de Pt tem valor RMS menor de 0,39 nm do que TiN derivado de PEALD de 0,87 nm. Portanto, a amostra de HfO 2 / TiO 2 / HfO 2 no Si revestido com Pt também exibe uma superfície relativamente mais lisa com RMS de 0,68 nm do que no Si revestido com TiN com 1,3 nm.
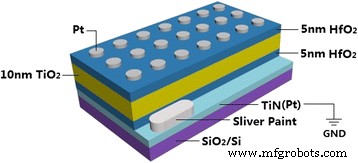
O esquema do dispositivo RRAM de HfO 2 / TiO 2 / HfO 2 estrutura de três camadas por ALD
As curvas DC I-V de Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / TiN dispositivos contendo o processo de eletroformação inicial são plotados na Fig. 2a, b, respectivamente, indicando uma característica de comutação resistiva bipolar típica. Para quase todas as amostras, uma tensão de formação maior é necessária para formar os filamentos condutores antes do teste de comutação. Ao aplicar uma tensão de polarização positiva no eletrodo superior de Pt, o Pt / HfO 2 / TiO 2 / HfO 2 / Pt unidade de dispositivo mostra uma tensão de formação de +7 V na Fig. 2a. Continuando a varredura de tensão, uma tensão de reset de -0,8 V é medida para a célula unitária de LRS a HRS e uma tensão definida de 2,0 V de HRS a LRS. A proporção correspondente de resistências altas e baixas é de cerca de 10 5 . O processo de eletroformação e repouso também pode ser concluído aplicando-se uma tensão negativa de −11 V e uma positiva de +4 V, respectivamente, que são muito maiores do que as tensões de formação positiva e negativa de reset. Além disso, a célula do dispositivo apenas muda de LRS para HRS por vários ciclos após o processo de formação negativa e, em seguida, falha ao redefinir para HRS devido à quebra irreversível (não mostrada aqui). Na Fig. 2b, em comparação com os eletrodos simétricos de Pt superior e inferior, os dispositivos RRAM de estrutura de três camadas com eletrodo inferior de TiN assimétrico e eletrodo superior de Pt mostram uma tensão de formação inferior oposta de cerca de -3,7 V, tensão definida de -1,5 V , redefinir a tensão de +1,5 V e uma proporção relativamente menor de resistências alta e baixa de 10 2 . Ao impor a tensão de eletroformação positiva, o fenômeno RS não pode ser observado no Pt / HfO 2 / TiO 2 / HfO 2 / Célula TiN e o dispositivo são interrompidos permanentemente em +14 V sem a seguinte redefinição eficiente de LRS para HRS em tensão negativa (não mostrado aqui).
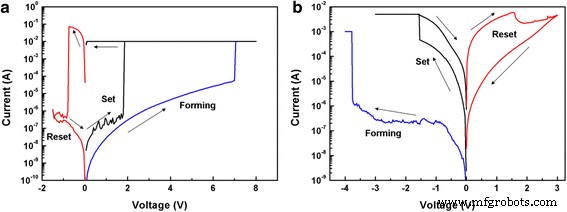
As características típicas de chaveamento resistivo bipolar dos dispositivos RRAM. a Pt / HfO 2 / TiO 2 / HfO 2 / Pt. b Pt / HfO 2 / TiO 2 / HfO 2 /Lata
Os dispositivos RRAM de estrutura de três camadas com eletrodos Pt superior / inferior simétricos e eletrodo inferior TiN / eletrodos superiores Pt assimétricos exibem essa preferência de polaridade de eletroformação diferente. O eletrodo inferior de Pt quimicamente inerte ou TiN relativamente ativo parece desempenhar um papel fundamental. A razão relacionada na polaridade de eletroformação dependente do eletrodo será discutida mais tarde, após considerar os perfis de profundidade XPS das estruturas de três camadas de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN.
Para aplicações de memória de alta densidade, a uniformidade dos parâmetros RS é muito importante. A Figura 3a, b representa os resultados estatísticos da distribuição das tensões de ajuste e redefinição medidas a partir de uma única unidade de dispositivo do Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / TiN para testes de 200 vezes, respectivamente. A Figura 3c, d registra as curvas I – V de 10 unidades de dispositivo selecionadas aleatoriamente do Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / TiN, respectivamente. As unidades de dispositivo RRAM de estrutura tricamada com eletrodos Pt superior e inferior simétricos mostram uma ampla distribuição para definir a tensão de 1,2 a 2,8 V e redefinir a tensão de −0,5 a −1 V (Fig. 3a) e curvas I – V dispersivas (Fig. 3c). Considerando que as unidades do dispositivo com eletrodos assimétricos TiN inferior e Pt superior exibem melhor comportamento RS, como distribuição relativamente concentrada de tensão definida de −0,8 a −1,8 V e tensão de redefinição de 1,3 a 1,8 V e reprodutibilidade estável em curvas I – V (Fig. 3b, d). Simultaneamente, em comparação com aqueles em Si revestido com Pt, diferentes unidades de dispositivo em Si revestido com TiN também apresentam monodispersão aprimorada em parâmetros RS, benéficos para aplicações práticas de RRAM.

Os resultados estatísticos da distribuição das tensões de ajuste e redefinição medidas a partir de uma única unidade de dispositivo para testes de 200 vezes. a Pt / HfO 2 / TiO 2 / HfO 2 / Pt. b Pt / HfO 2 / TiO 2 / HfO 2 /Lata. As curvas I – V de 10 unidades de dispositivo selecionadas aleatoriamente. c Pt / HfO 2 / TiO 2 / HfO 2 / Pt. d Pt / HfO 2 / TiO 2 / HfO 2 /Lata
As propriedades de resistência e retenção das unidades de dispositivo de Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / TiN foram examinados, como visto na Fig. 4a-d, respectivamente. Em Pt / HfO 2 / TiO 2 / HfO 2 / Pt, a tensão de varredura foi aplicada de 0 a 3 V para o set e de 0 a -1,5 V para o reset. Em Pt / HfO 2 / TiO 2 / HfO 2 / TiN, a tensão de varredura foi aplicada de 0 a −2 V para o set e de 0 a 2 V para o reset. Os valores de resistência ON e OFF foram lidos usando 0,2 V à temperatura ambiente. Os testes de retenção foram medidos à temperatura ambiente com a tensão de leitura de 0,2 V. Após 200 ciclos de programação / exclusão, Pt / HfO 2 / TiO 2 / HfO 2 / Pt unidades de dispositivo mostram relação de resistência relativamente estável de estados OFF / ON acima de 10 5 (Fig. 4a); no entanto, a característica de resistência de Pt / HfO 2 / TiO 2 / HfO 2 / As células de memória TiN parecem não ser tão boas quanto as de Pt / HfO 2 / TiO 2 / HfO 2 / Pt (Fig. 4b). Os estados LIGADO e DESLIGADO em dispositivos com eletrodos Pt-TiN não são muito estáveis com relação de resistência menor de estados DESLIGADO / LIGADO de cerca de 10 2 durante o teste de ciclo de comutação, flutuação HRS especialmente significativa do que a de LRS. Com base no modelo físico na Ref. [12], a resistência será melhorada com o aumento da energia de formação da vacância de oxigênio e da interface O 2− montante. Especulamos uma explicação plausível. Em nosso trabalho anterior [14], excelentes propriedades de chaveamento resistivo bipolar de Al derivado de ALD 2 O 3 / HfO 2 / Al 2 O 3 Estruturas de três camadas com eletrodos assimétricos de TiN inferior e superior de Pt foram demonstradas, incluindo melhor resistência de comutação de até 10 3 ciclos com relação de resistência ON / OFF estável. Aqui, adotamos HfO 2 / TiO 2 / HfO 2 configurar em vez de Al 2 O 3 / HfO 2 / Al 2 O 3 . Os íons metálicos em HfO 2 e TiO 2 têm a mesma valência química idêntica de +4, levando a defeitos de interface menos carregados, como vacâncias de oxigênio entre duas camadas interfaciais (ILs) da tricamada HfO 2 / TiO 2 / HfO 2 . Considerando que, os íons metálicos em Al 2 O 3 e HfO 2 têm diferentes valências químicas de Al 3+ e Hf 4+ , produzindo mais defeitos de interface carregada de vacâncias de oxigênio entre dois ILs de Al 2 O 3 / HfO 2 / Al 2 O 3 . Pode-se deduzir que a interface O 2− montante adicionando dois ILs entre Al 2 O 3 / HfO 2 / Al 2 O 3 deve ser maior do que entre HfO 2 / TiO 2 / HfO 2 . Além disso, a energia de formação da vacância de oxigênio na camada de armazenamento de Al 2 O 3 / HfO 2 / Al 2 O 3 também é maior do que o de HfO 2 / TiO 2 / HfO 2 (energia de formação de vacância de oxigênio 7,08 eV (Al 2 O 3 ), 6,53 eV (HfO 2 ) e 4,35 eV (TiO 2 ) [20, 21]). Depois de considerar esses fatores, a célula de memória de Pt / HfO 2 / TiO 2 / HfO 2 / TiN exibe degeneração de resistência, em comparação com Pt / Al 2 O 3 / HfO 2 / Al 2 O 3 /Lata.

As características de resistência e retenção das unidades do dispositivo. a , c Pt / HfO 2 / TiO 2 / HfO 2 / Pt. b , d Pt / HfO 2 / TiO 2 / HfO 2 /Lata.
Para Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / TiN, o nível de resistência dos estados LIGADO e DESLIGADO não tem mudanças evidentes após o tempo de espera cumulativo de 10 4 s à temperatura ambiente na Fig. 4c-d, indicando uma melhor propriedade de retenção de ambas as células de memória ao longo de 10 anos com base no método de extrapolação.
Pt / HfO 2 / TiO 2 / HfO 2 / Os dispositivos TiN têm uma relação de resistência muito menor dos estados OFF / ON do que Pt / HfO 2 / TiO 2 / HfO 2 / Pt, que pode ser atribuído à diferença dos eletrodos inferiores na função de trabalho e condutividade. A função de trabalho dos eletrodos inferiores de Pt e TiN é 5,65 e 4,5 eV, respectivamente; portanto, a barreira da interface entre o TiN e o HfO 2 subjacente é relativamente menor no Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivo TiN. Durante um processo de reinicialização, a energia necessária para o elétron cruzar a barreira também é menor. Então Pt / HfO 2 / TiO 2 / HfO 2 / TiN manifesta valor de resistência inferior no estado DESLIGADO do que Pt / HfO 2 / TiO 2 / HfO 2 / Pt correspondentemente. Durante um processo definido, o dispositivo RRAM muda de HRS para LRS devido à formação dos canais de condução. O eletrodo inferior de Pt tem maior condutividade do que o eletrodo inferior TiN; consequentemente, o valor da resistência no estado ON para Pt / HfO 2 / TiO 2 / HfO 2 / TiN é maior do que para Pt / HfO 2 / TiO 2 / HfO 2 / Pt. Como resultado, Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivos TiN mostram uma relação de resistência menor de estados OFF / ON de 10 2 . No entanto, a taxa de resistência de 10 2 já atendeu ao requisito de aplicativos RRAM.
Para esclarecer o mecanismo condutor durante a comutação resistiva, as curvas I – V típicas são representadas novamente em escala logarítmica dupla. A Figura 5a, b mostra o ajuste linear das curvas I – V para as regiões de varredura de tensão de Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivos TiN. Ambas as células de memória se comportam como mecanismo condutor semelhante. Quando o dispositivo é comutado para o LRS, as curvas de log (I) -log (V) são lineares com inclinação próxima a 1 (0,94 na Fig. 5a, 0,98 na Fig. 5b), indicando que o I – V no LRS é dominado pela lei ôhmica. O modelo de filamento de migração de vacância de oxigênio pode ser usado para explicar o comportamento de comutação. Para o HRS, na região de baixa tensão (valor absoluto <0,11 V), o I – V é dominado pela lei ôhmica com a relação linear de corrente e tensão (inclinação 1,05 na Fig. 5a, 1,09 na Fig. 5b). Na região de tensão mais alta (6,8 V> valor absoluto> 0,11 V na Fig. 5a, 1,85 V> valor absoluto> 0,11 V na Fig. 5b), a inclinação das linhas log (I) -log (V) são em torno de 2 e a corrente é dependente do quadrado aproximado da tensão aplicada (I / V 2 ) Na tensão crítica (valor absoluto 6,8 V na Fig. 5a, 1,85 V na Fig. 5b), um aumento acentuado da corrente repentinamente aparece com uma grande inclinação. Este resultado consiste em três regiões no HRS, obedecendo basicamente à típica injeção de condução limitada de carga espacial controlada por armadilha (SCLC) [11].
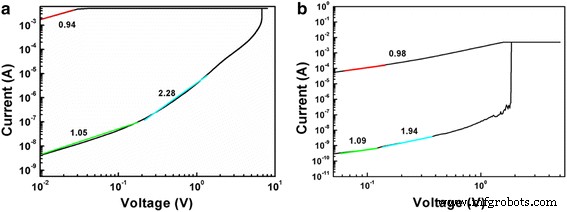
As curvas I – V típicas plotadas em escala logarítmica dupla de a Pt / HfO 2 / TiO 2 / HfO 2 / Pt e b Pt / HfO 2 / TiO 2 / HfO 2 /Lata
A fim de compreender melhor o mecanismo de chaveamento resistivo subjacente do HfO 2 / TiO 2 / HfO 2 no Si revestido com Pt e no Si revestido com TiN, realizamos varreduras estreitas e análises de profundidade XPS em estruturas de três camadas com eletrodos inferior / superior simétricos e assimétricos. Os espectros XPS foram ajustados com funções Gaussian-Lorentzian (G-L) após a subtração de fundo do tipo inteligente.
A Figura 6a-d ilustra os espectros XPS de varredura estreita de Hf 4 f , Ti 2 p , e O 1 s picos em HfO 2 e TiO 2 camadas em Si revestido com TiN. O Hf 4 f e espectros Ti 2p de HfO 2 e TiO 2 as camadas podem ser deconvoluídas em dois picos de grupo. O mais forte Hf 4 f 5/2 e Hf 4 f 2/7 picos em 18,4 e 16,7 eV com uma divisão spin-órbita de 1,7 eV são atribuídos à ligação Hf-O (Hf 4+ ) de HfO 2 (Fig. 6a). Os picos do dupleto spin-órbita mais fracos na energia de ligação mais baixa de 17,6 e 14,8 eV possivelmente resultam do estado de valência química baixa de Hf n + –O ( n <4), indicando a presença de vacâncias de oxigênio em HfO 2 camada. A concentração percentual calculada de Hf n + ( n <4) é cerca de 3,7% em íons Hf. Na Fig. 6b, um dupleto mais forte corresponde a Ti 2 p 3/2 e 2 p 1/2 recursos em 458,8 e 464,5 eV, pertencentes à ligação Ti – O (Ti 4+ ) da TiO 2 . Um dupleto mais fraco localiza-se em 456,1 e 462,0 eV, atribuindo ao Ti 3+ –O vínculo. A concentração percentual calculada de Ti 3+ é cerca de 21% em íons Ti. Isso implica na existência de vacâncias de oxigênio no TiO 2 camada.
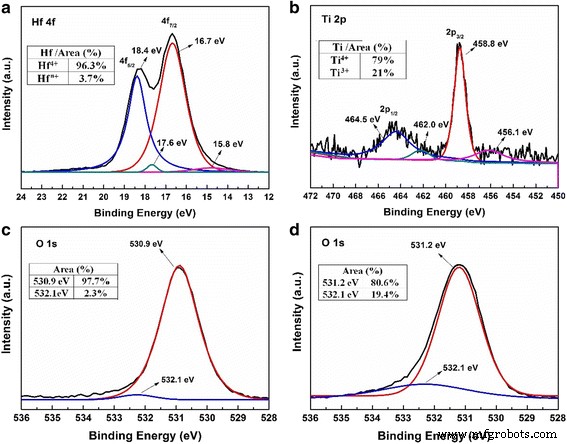
Espectros XPS de varredura estreita da estrutura de três camadas de HfO 2 / TiO 2 / HfO 2 em Si revestido com TiN. a Hf 4f, b Ti 2 p picos de HfO 2 / TiO 2 / HfO 2. O 1 s picos de c HfO 2 e d TiO 2 camadas
O 1 s espectros de HfO 2 e TiO 2 camadas também podem ser deconvoluídas em dois picos, como visto na Fig. 6c, d. As energias de ligação relativamente mais baixas do O 1 s pico em ~ 530,9 e 531,2 eV são atribuídos à ligação Ti-O e Hf-O no TiO 2 e HfO 2 camadas, respectivamente, pertencentes ao oxigênio da rede sem vacâncias de oxigênio. Considerando que a energia ligeiramente superior de 532,1 eV no O 1 s os espectros da Fig. 6c, d são atribuídos aos átomos de oxigênio próximos às vacâncias de oxigênio em HfO 2 e TiO 2 camadas com base nos relatórios da literatura [22,23,24,25]. A concentração relativa de vacância de oxigênio na camada de óxido pode ser avaliada aproximadamente calculando a proporção da área de cada pico [22, 23]. A concentração percentual calculada de vacância de oxigênio em HfO 2 e TiO 2 camadas é cerca de 2,3 e 19,4%, respectivamente, de acordo com os resultados de Hf n + e Ti 3+ .
A Figura 7a, b mostra os perfis de profundidade XPS de HfO 2 / TiO 2 / HfO 2 amostras em Si revestido com Pt e TiN por ataque de íon Ar, respectivamente. A estrutura de três camadas de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN pode ser facilmente reconhecido, embora a difusão interfacial significativa entre HfO 2 / TiO 2 e HfO 2 / TiN foi observado. Normalmente, o modelo de filamento de migração de vacância de oxigênio domina o comportamento RS em dispositivos RRAM baseados em óxidos de metal de transição [11]. No entanto, simplesmente aumentar o conteúdo de vacâncias de oxigênio não é totalmente eficaz. Como controlar efetivamente a distribuição dos filamentos de vacância de oxigênio é uma questão chave para finalmente melhorar a uniformidade RS [20]. Muitos trabalhos têm mostrado que geralmente uma distribuição não uniforme das vacâncias de oxigênio é benéfica para os comportamentos do RS, incluindo a diminuição da tensão de formação, melhorando a estabilidade de comutação e a capacidade de resistência [1, 14, 20, 26,27,28,29]. Uma distribuição não uniforme inicial de vacâncias de oxigênio em uma camada de óxido de armazenamento é frequentemente obtida pelo uso de um eletrodo quimicamente ativo com uma afinidade de oxigênio relativamente alta (por exemplo, Ta, Ti, Al ou TiN) ou pela introdução deliberada de um rico em vacância de oxigênio camada interfacial por engenharia de interface [1, 17, 30].
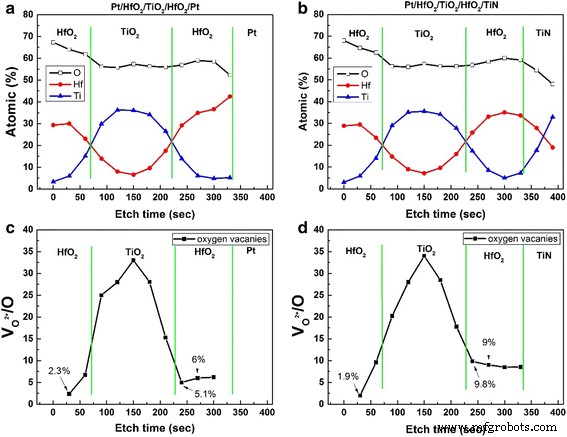
Perfis de profundidade XPS de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN por ataque de íon Ar. a HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt. b HfO 2 / TiO 2 / HfO 2 em Si revestido com TiN. A distribuição de profundidade da concentração de vacância de oxigênio ( V O 2+ / O) determinado a partir de espectros de XPS para HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN. c HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt. d HfO 2 / TiO 2 / HfO 2 em Si revestido com TiN
A Figura 7c, d apresenta as curvas de distribuição da concentração de vacância de oxigênio de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN com base nos perfis XPS de profundidade acima, respectivamente. A concentração de vacância de oxigênio foi avaliada usando o método mencionado acima. Pode-se descobrir que a maior concentração de vacância de oxigênio (~ 34%) aparece no TiO 2 camada intermediária. Outro recurso digno de nota é que o HfO 2 subjacente camada próxima aos eletrodos inferiores de Pt ou TiN tem maior concentração de vacância de oxigênio do que o HfO superior 2 camada (~ 2%). Além disso, a concentração de vacância de oxigênio (~ 9%) do HfO 2 subjacente camada em Si revestido com TiN é obviamente maior do que (~ 6%) em Si revestido com Pt.
A Figura 8 mostra os diagramas esquemáticos de eletroformação e redefinição de Pt / HfO 2 / TiO 2 / HfO 2 / Pt em tensões de polarização positiva e negativa. Para eletrodos superior e inferior de Pt quimicamente inertes, os fenômenos de eletroformação dependente da polaridade de polarização estão relacionados ao O 2 gás liberado da camada de óxido no ânodo como um produto da eletro-redução. Como é conhecido, durante o processo de eletroformação, as vacâncias de oxigênio são criadas por alto campo elétrico e migram para o cátodo, formando filamentos condutores localizados na camada de óxido, ou seja, O O → V O 2+ + O 2− , V O 2+ + 2 e - → V O [12] (Fig. 8b, e). Simultaneamente, O 2− íons derivam em direção ao ânodo, liberando sua carga e evoluindo O 2 gás, ou seja, O 2− → 1/2 O 2 + 2 e - (Fig. 8b, e), que possivelmente causam deformação física da célula e até formação de fissura ou buraco [31]. Ao aplicar a tensão de formação positiva ao eletrodo superior de Pt, postulamos o O 2 gás liberado acima do HfO superior 2 o filme escapa facilmente na borda superior do eletrodo ou através de um pequeno nanopore no eletrodo superior de Pt (Fig. 8b), o que causa uma deformação física fraca. Enquanto isso, considerando a concentração de vacância de oxigênio relativamente mais alta no HfO 2 subjacente (~ 6%) eletrodo inferior de Pt próximo ao HfO superior 2 camada (~ 2,3%) (Fig. 7c), o filamento condutor se forma prontamente, levando a uma tensão de formação positiva menor de +7 V. Com tensão reversa de -0,8 V, a reação reversa leva à ruptura do filamento, e o dispositivo é facilmente comutado de volta ao estado HRS (Fig. 8d).

Diagramas esquemáticos de eletroformação e redefinição da estrutura de três camadas de HfO 2 / TiO 2 / HfO 2 com eletrodos Pt superior e inferior simétricos. a - d Eletroformação em tensão positiva e reset em tensão negativa. e - g Eletroformação em tensão negativa e reset em tensão positiva
Por outro lado, com uma tensão de formação negativa no eletrodo superior, o gás oxigênio se forma sob o HfO 2 subjacente camada e acima de Pt o eletrodo inferior (Fig. 8e). O 2 a liberação torna-se mais difícil, o que impedirá a formação de filamentos condutores. Além disso, porque a concentração de vacância de oxigênio do HfO superior 2 camada (~ 2,3%) é menor do que o HfO 2 subjacente (~ 6%) (Fig. 7c), a tensão de formação negativa mais alta de -11 V é necessária para formar os filamentos. Quando mais O 2 acumula-se a uma certa pressão sob o HfO 2 subjacente , ele possivelmente irrompe da parte mecanicamente mais fraca dos filmes finos, levando ao orifício nos filmes de óxido ou separação entre os filmes de óxido e o eletrodo inferior induzida por quebra da bolha. Embora o dispositivo possa ser redefinido para HRS com polarização aplicada de +4 V (Fig. 8g), a célula de memória é degradada após vários ciclos de comutação. Em nossas amostras, uma parte do eletrodo superior foi explodida após o processo de formação. Cenário de preferência de polaridade de eletroformação semelhante também foi observado em Pt / TiO 2− x / Pt células RRAM bipolares com várias evidências físicas de deformação das junções [31, 32].
Pt / HfO 2 / TiO 2 / HfO 2 Dispositivos / TiN exibem polaridade de eletroformação bastante diferente de Pt / HfO 2 / TiO 2 / HfO 2 / Pt. O LRS causado pela eletroformação pode ser observado tanto na tensão de polarização negativa quanto na positiva; no entanto, o reset efetivo de LRS para HRS pode ser alcançado apenas em tensão de polarização positiva em Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivo TiN. A preferência de eletroformação semelhante com eletrodos assimétricos de Pt e TiN foi observada em algumas literaturas com várias camadas de óxido de armazenamento, como HfO 2 [33, 34], TiO 2 [35], ZrO x / HfO y bicamada [22] e Al 2 O 3 / HfO 2 / Al 2 O 3 tricamada [14]. No entanto, as explicações relacionadas são divergentes ou inexistentes.
Depois de considerar a atividade química do eletrodo TiN com oxigênio [1, 30, 36] e a não distribuição da concentração de vacância de oxigênio na estrutura de três camadas de HfO 2 / TiO 2 / HfO 2 com base nos perfis de profundidade XPS (Fig. 7), um possível mecanismo na preferência de polaridade de eletroformação de Pt / HfO 2 / TiO 2 / HfO 2 / Células TiN são propostas. A Figura 9 mostra os diagramas esquemáticos de eletroformação e redefinição de Pt / HfO 2 / TiO 2 / HfO 2 / TiN em tensões de polarização negativa e positiva. O eletrodo inferior TiN desempenha um papel fundamental na polaridade de eletroformação. Kwak et al. relataram que o eletrodo TiN relativamente ativo absorveria facilmente íons de oxigênio de filmes de óxido para formar TiO x N 1− x (TiON) camada interfacial [36]. A severa difusão de oxigênio do HfO 2 subjacente camada no eletrodo inferior TiN foi confirmada em nossa amostra pelo perfil de profundidade XPS (Fig. 7b). Para Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivo TiN, o eletrodo TiN com alta afinidade de oxigênio [34, 36] produz muitas lacunas de oxigênio no HfO 2 subjacente camada próxima ao eletrodo inferior TiN. A concentração de vacâncias de oxigênio de ~ 9% do HfO 2 subjacente camada é muito maior do que ~ 6% no Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivo Pt.
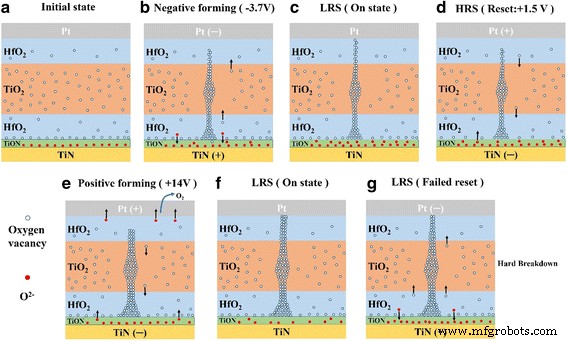
Diagramas esquemáticos de eletroformação e redefinição da estrutura de três camadas de HfO 2 / TiO 2 / HfO 2 com eletrodo superior de Pt assimétrico e eletrodo inferior de TiN. a - d Eletroformação em tensão negativa e reset em tensão positiva. e - g Eletroformação em tensão positiva e reset em tensão negativa
Para eletrodo superior de Pt quimicamente inerte e eletrodo inferior de TiN relativamente ativo, ao aplicar tensão de formação negativa, O 2− íons derivam em direção ao ânodo TiN e são absorvidos para formar TiO x N 1− x camada (Fig. 9b), ou seja, TiN + x O 2 - → TiO x N 1 − x + x 2 e , evitando o O 2 liberação e possível dano às células. O eletrodo TiN pode atuar como um reservatório para íons de oxigênio que flutuam sob uma tensão aplicada [1,36]. Simultaneamente, devido à maior vacância de oxigênio no HfO 2 subjacente camada (~ 9%) e TiO intermediário 2 camada (~ 10–34%) do que o HfO superior 2 camada (~ 1,9%), a migração dos ricos vazios de oxigênio do HfO 2 subjacente camada por meio de TiO 2 camada em direção ao HfO superior 2 , produzindo diretamente filamentos de vacância de oxigênio condutores com uma tensão de formação menor de -3,7 V (Fig. 9b). Ao realizar o processo de reinicialização reversa a +1,5 V, o eletrodo inferior da camada TiN atuando como reservatório de oxigênio fornece íons de oxigênio para reagir com a vacância de oxigênio, ou seja, O 2 - + V O 2 + → O O (oxigênio da rede), que é benéfico para a operação de reinicialização de LRS para HRS com ruptura do filamento condutor (Fig. 9d). Acima de tudo, o efeito do reservatório de oxigênio do eletrodo inferior TiN contribui para a redução da tensão de formação, bem como para uma melhor configuração / redefinição da variação da tensão [1, 29, 36].
Por outro lado, ao impor a tensão de formação positiva no eletrodo superior Pt, as vacâncias de oxigênio migram do HfO superior 2 no HfO subjacente 2 no TiN, se acumulam em sua vizinhança e se desenvolvem em filamentos. Devido à menor concentração de oxigênio no HfO superior 2 (~ 1,9%) do que o HfO 2 subjacente camada (~ 9%) e TiO intermediário 2 camada (~ 10–34%), isso leva a um aumento adicional da concentração de vacância de oxigênio no HfO 2 subjacente e TiO intermediário 2 camada. Ao mesmo tempo, devido à pequena existência de oxigênio em filmes de TiN derivados de PEALD (cerca de 10%), alguns íons de oxigênio em TiN derivam para HfO 2 subjacente camada para formar o oxigênio da rede isolante com a vacância de oxigênio nas proximidades, evitando o crescimento de filamentos condutores (Fig. 9e). Finalmente, quando a tensão de polarização atinge +14 V, os filamentos condutores de engrossamento em óxidos são formados. No entanto, quando uma tensão negativa é aplicada ao dispositivo, o filamento condutor na estrutura de três camadas é muito grande para ser rompido (Fig. 9g). Portanto, o dispositivo não pode mudar para HRS aplicando uma voltagem negativa, indicando que uma falha severa irreversível ocorre em Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivo TiN.
Finalmente, devido ao fato de que o TiO inserido 2 camada armazena mais vacâncias de oxigênio do que HfO 2 camada, a distribuição de vacâncias de oxigênio na estrutura de três camadas não é uniforme, especialmente nas duas camadas interfaciais entre HfO 2 / IL / TiO 2 / IL / HfO 2 , o que pode afetar a posição de crescimento, direção e sobreposição de filamentos condutores. A ligação ou ruptura dos filamentos condutores corresponde ao processo de set de HRS a LRS ou ao processo de reset de LRS a HRS, respectivamente, o que ocorre mais facilmente em duas camadas interfaciais. Além disso, a forma e a posição dos filamentos condutores em HfO 2 e TiO 2 as camadas mudam menos nos processos de configuração e redefinição.
Conclusões
Em resumo, dispositivos RRAM baseados na estrutura de três camadas de Pt / HfO 2 / TiO 2 / HfO 2 / Pt e Pt / HfO 2 / TiO 2 / HfO 2 / TiN foram preparados por ALD. Ambas as células de memória apresentam características de comutação resistiva bipolar típicas e mecanismos de condução dominante ôhmica e SCLC em LRS e HRS, respectivamente. Verificou-se que os eletrodos de fundo de Pt e TiN têm grande influência na preferência de polaridade de eletroformação, na razão de resistências altas e baixas e na dispersão da tensão de operação de células de memória de estrutura tricamada. Em comparação com os eletrodos simétricos de Pt superior / inferior, as células RRAM com eletrodos Pt superior / inferior assimétricos mostram menor tensão de formação negativa de -3,7 V, distribuição relativamente estreita das tensões de operação de ajuste / redefinição e menor proporção de resistências altas e baixas de 10 2 . A polaridade de eletroformação dependente de eletrodo pode ser explicada considerando a atividade química dos eletrodos com oxigênio, as reações relacionadas no ânodo e a distribuição não uniforme da concentração de vacância de oxigênio na estrutura de três camadas de HfO 2 / TiO 2 / HfO 2 em Si revestido com Pt e TiN. Além disso, o eletrodo TiN como reservatório de oxigênio desempenha um papel importante na redução da tensão de formação e melhor dispersão dos parâmetros RS para Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivos TiN. Considerando o efeito de modulação do eletrodo e da estrutura de três camadas no desempenho de chaveamento resistivo, este trabalho fornece uma nova rota de projeto de dispositivo para futuras aplicações RRAM.
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Modelo de retenção de TaO / HfO x e TaO / AlO x RRAM com características de chave auto-retificadora
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Uma SRAM 4T integrada RRAM com carga de comutação resistiva autoinibida por processo lógico CMOS puro
- Efeito da distribuição de nanopartículas de ouro em TiO2 nas características ópticas e elétricas de células solares sensibilizadas por corante
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Um estudo coletivo sobre modelagem e simulação de memória de acesso aleatório resistiva
- Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN



