Deposição de camada atômica de nanofilmes de óxido de índio para transistores de filme fino
Resumo
Deposição de camada atômica (ALD) de In 2 O 3 nanofilmes foram investigados usando ciclopentadienil índio (InCp) e peróxido de hidrogênio (H 2 O 2 ) como precursores. O In 2 O 3 os filmes podem ser depositados preferencialmente em temperaturas relativamente baixas de 160–200 ° C, exibindo uma taxa de crescimento estável de 1,4–1,5 Å / ciclo. A rugosidade da superfície do filme depositado aumenta gradualmente com a temperatura de deposição, o que é atribuído à maior cristalização do filme em uma temperatura de deposição mais alta. À medida que a temperatura de deposição aumenta de 150 para 200 ° C, o gap óptico (E g ) do filme depositado sobe de 3,42 para 3,75 eV. Além disso, com o aumento da temperatura de deposição, a razão atômica de In para O no filme conforme depositado muda gradualmente em direção àquela no In estequiométrico 2 O 3 , e o conteúdo de carbono também é reduzido gradualmente. Para a temperatura de deposição de 200 ° C, o filme depositado exibe uma razão In:O de 1:1,36 e nenhuma incorporação de carbono. Além disso, alto desempenho em 2 O 3 transistores de filme fino com um Al 2 O 3 o dielétrico de porta foi obtido por pós-recozimento no ar a 300 ° C por tempo apropriado, demonstrando uma mobilidade de efeito de campo de 7,8 cm 2 / V⋅s, uma oscilação de sublimiar de 0,32 V / dec e uma relação de corrente liga / desliga de 10 7 . Isso foi atribuído à passivação de vacâncias de oxigênio no canal do dispositivo.
Histórico
Óxido de índio (In 2 O 3 ) é um semicondutor de óxido de metal transparente, que exibe um gap largo de ~ 3,7 eV em temperatura ambiente, uma alta transparência para a luz visível e excelente estabilidade química [1, 2]. Portanto, em 2 O 3 tem sido investigado para várias aplicações, como dispositivos fotovoltaicos, sensores eletroquímicos e monitores de tela plana [3,4,5]. Até agora, várias técnicas de deposição foram desenvolvidas para preparar em 2 O 3 filmes finos, incluindo pulverização catódica [6, 7], sol-gel [8, 9] e deposição química de vapor (CVD) [10, 11]. No entanto, as técnicas de pulverização catódica e sol-gel geralmente sofrem de uma uniformidade pobre em uma grande área, bem como de uma composição elementar inexata; a técnica CVD geralmente requer temperaturas de deposição relativamente altas de> 300 ° C. Essas desvantagens tornam difícil conseguir um uniforme em 2 O 3 filme com espessura precisa e controle de composição em uma baixa temperatura de deposição.
Nos últimos anos, a deposição de camada atômica (ALD) surgiu como uma abordagem promissora que pode render excelente cobertura de etapas, controlabilidade de espessura de escala atômica, boa uniformidade e uma temperatura de deposição relativamente baixa. Consequentemente, o crescimento de In 2 O 3 filmes finos foram explorados por meio de ALD com diferentes precursores, incluindo InCl 3 -H 2 O [12], InCl 3 -H 2 O 2 [13], InCp-O 3 [14], InCp-O 2 -H 2 O [15] e In (CH 3 ) 3 -H 2 O [16]. Em termos de precursores de InCl 3 -H 2 O e InCl 3 -H 2 O 2 , as temperaturas de deposição para In 2 O 3 os filmes devem ser aumentados para ~ 300–500 ° C [13]; enquanto isso, o InCl 3 o recipiente deve ser aquecido a 285 ° C, a fim de obter InCl amplo 3 vapor [15]. Além disso, o subproduto do HCl corrosivo pode danificar o equipamento ALD e gravar o depositado em 2 O 3 filme [17], e a taxa de crescimento de In 2 O 3 é tão baixo quanto 0,25–0,40 Å / ciclo. Embora outros precursores como TMIn-H 2 O e TMIn-H 2 O 2 foram adotados para ALD em 2 O 3 filmes, as temperaturas de deposição ainda são altas (ou seja, 200-450 ° C), apesar das taxas de crescimento relativamente grandes (1,3-2 Å / ciclo) [18].
Neste trabalho, InCp e H 2 O 2 foram propostos como os precursores de ALD em 2 O 3 filmes finos, portanto, o In 2 O 3 filmes finos foram depositados com sucesso em temperaturas mais baixas, exibindo uma taxa de crescimento satisfatória. Adicionalmente, foram caracterizadas as propriedades físicas e químicas dos filmes depositados. Além disso, o In 2 O 3 transistores de filme fino (TFTs) com ALD Al 2 O 3 dielétricos de porta foram fabricados, demonstrando bom desempenho elétrico, como uma mobilidade de efeito de campo de 7,8 cm 2 V −1 s −1 , e uma relação de corrente liga / desliga de 10 7 etc.
Experimental
As bolachas de Si (100) foram limpas usando o processo padrão da Radio Corporation of America, servindo como substratos iniciais. Em 2 O 3 filmes finos foram depositados sobre os substratos de Si (100) pré-limpos usando o equipamento ALD (Wuxi MNT Micro Nanotech Co., LTD, China) a temperaturas relativamente baixas de 150–210 ° C, onde as temperaturas de InCp (Fornano Electronic Technology Co., LTD, China, impureza:99,999%) e H 2 O 2 (Solução aquosa a 30%) precursores foram mantidos a 130 e 50 ° C, respectivamente. O gás nitrogênio foi usado como gás de purga. Para demonstrar a função do ALD em 2 O 3 filme fino, o In 2 O 3 TFTs de canal com base foram fabricados como os seguintes processos. Em primeiro lugar, um Al 2 de 38 nm O 3 o filme dielétrico de porta foi cultivado em um substrato de tipo p pré-limpo (100) (<0,0015 Ω · cm) a 200 ° C por ALD usando trimetilalumínio e H 2 O, e esse substrato de silício de baixa resistividade serviu como porta traseira. Então, um In 2 de 20 nm O 3 camada do canal foi desenvolvida no Al 2 O 3 filme a 160 ° C. Os contatos fonte / dreno de pilhas de Ti / Au (30 nm / 70 nm) foram formados por litografia óptica, evaporação de feixe de elétrons e processo de lift-off. Finalmente, os dispositivos fabricados foram recozidos a 300 ° C ao ar por diferentes tempos.
A cristalinidade, morfologia da superfície, composição elementar, coeficiente de absorção e espessura do In 2 O 3 os filmes foram caracterizados por difração de raios-X (XRD) (Bruker D8 Discover), microscopia de força atômica (AFM) (Bruker Icon), espectroscopia de fotoelétrons de raios-X (XPS) (Kratos Axis Ultra DLD), espectroscopia ultravioleta-visível (UV- VIS) e elipsômetro (Sopra GES-SE, França), respectivamente. As medições elétricas dos dispositivos foram realizadas em analisador de parâmetros semicondutores (B1500A, Agilent Technologies, Japão) com estação de sonda Cascade em ar ambiente à temperatura ambiente.
Resultados e discussão
A Figura 1a mostra a taxa de crescimento do In 2 O 3 filme em função da temperatura do substrato. Verificou-se que uma taxa de crescimento estável de ~ 1,46 Å / ciclo é alcançada na faixa de 160 ~ 200 ° C, revelando uma taxa de crescimento rápida e uma janela de temperatura bem definida para ALD em 2 O 3 filmes. Quando a temperatura do substrato foi reduzida para 150 ° C ou aumentada para 210 ° C, a taxa de crescimento resultante tornou-se maior [19, 20]. O primeiro é atribuído à condensação do InCp no substrato, enquanto o último é devido à decomposição térmica do InCp a uma temperatura mais elevada. Além disso, a evolução do depositado em 2 O 3 a espessura do filme foi avaliada em função dos ciclos ALD, conforme mostrado na Fig. 1b. É claro que o In 2 O 3 a espessura do filme aumenta linearmente com o número de ciclos de deposição, indicando um crescimento bastante uniforme.

a Taxa de crescimento de ALD em 2 O 3 filme no substrato de Si em função da temperatura do substrato, e b dependência do In 2 O 3 espessura do filme no número de ciclos ALD a 160 ° C
Para observar a evolução do In 2 O 3 textura de filme com temperatura de deposição, os padrões de XRD do In 2 O 3 filmes depositados em diferentes temperaturas são apresentados na Fig. 2. Quando a temperatura de deposição não excede 160 ° C, nenhum pico de difração pode ser observado. Isso indica que o depositado em 2 O 3 os filmes em temperaturas mais baixas são amorfos. Quando a temperatura de deposição aumenta até 170 ° C, alguns picos de difração começam a aparecer. Além disso, com a temperatura de deposição aumentando gradualmente para 210 ° C, as intensidades do pico de difração aumentam dramaticamente, tipicamente mostrado pelos picos a 2θ =30,3 ° e 35,4 °. Isso indica que a cristalinidade e o tamanho do grão do como depositado em 2 O 3 o filme é aprimorado gradualmente com o aumento da temperatura de deposição. A Figura 3 mostra as morfologias da superfície do representante em 2 O 3 filmes depositados em diferentes temperaturas. Verificou-se que a superfície do filme se torna cada vez mais áspera com o aumento da temperatura de deposição, isto é, a rugosidade quadrada média (RMS) resultante aumenta de 0,36 para 1,15 nm com o aumento da temperatura de deposição de 160 para 210 ° C. Isso deve estar relacionado à cristalinidade do In 2 O 3 filme. Em termos da temperatura de deposição de 160 ° C, o depositado em 2 O 3 o filme é amorfo e exibe uma superfície muito lisa. Quando a temperatura de deposição atinge 180 ° C, o filme depositado torna-se policristalino. Isso significa que o filme resultante contém muitos grãos cristalinos, e os tamanhos dos grãos tornam-se cada vez maiores com o aumento da temperatura de deposição, conforme revelado na Fig. 2. Isso está de acordo com nossa observação de que os tamanhos dos montículos na superfície do filme aumentar gradualmente com o aumento da temperatura de deposição, resultando em um valor RMS aumentado.
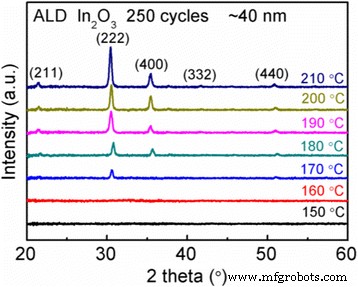
Padrões de difração de raios-X do In 2 O 3 filmes depositados em diferentes temperaturas por 250 ciclos

As imagens AFM do In 2 O 3 filmes depositados em diferentes temperaturas: a 160 ° C, b 180 ° C, c 200 ° C e d 210 ° C. Os ciclos de deposição foram fixados em 250 para cada filme
A Figura 4 mostra os espectros de alta resolução C 1 s, In 3d e O1s XPS do In 2 O 3 filmes depositados em diferentes temperaturas. Em relação aos espectros C 1 s XPS mostrados na Fig. 4a, o filme depositado a 160 ° C apresenta um pico em 289,8 eV, que deve corresponder a C-O [21]. Quando a temperatura de deposição é aumentada para 180 ° C, o pico se torna muito mais fraco. Além disso, em termos de temperatura de deposição de 200 ° C, o pico de C 1 s desaparece. Assim, é indicado que quanto maior a temperatura de deposição, menor será a impureza de C no depositado em 2 O 3 filme. A Figura 4b representa os espectros In 3d XPS do In 2 O 3 filmes, demonstrando claramente picos Gaussianos de um dupleto em 444,7 e 452,3 eV, que estão associados com In 3d 5/2 e em 3d 5/2 níveis básicos para In 2 O 3 [22, 23]. Os espectros de O 1 s XPS são mostrados na Fig. 4c. Verificou-se que o espectro de O 1 s para cada amostra pode ser bem separado em três picos, que estão localizados em 529,8, 531,0 e 532,0 eV, respectivamente. Esses picos correspondem a O 2− íons ligados com metal (O1), vacâncias de oxigênio (O2) e –OH / CO (O3), respectivamente [24, 25]. Conforme a temperatura de deposição aumenta de 160 para 200 ° C, a porcentagem relativa de O1 aumenta de 76 para 92%; e a porcentagem relativa de O2 diminui gradativamente de 16 a 4%. Além disso, o percentual relativo de O3 também apresenta tendência de queda. Esses resultados indicam que uma temperatura de deposição mais alta é benéfica para reduzir a concentração de vacâncias de oxigênio no filme depositado, bem como grupos hidroxila e ligações C-O. Além disso, as composições elementares do In 2 O 3 os filmes depositados em diferentes temperaturas estão listados na Tabela 1. Curiosamente, a razão atômica de In / O no filme depositado diminui em graus com o aumento da temperatura de deposição. No entanto, mesmo para o puro In 2 O 3 filme depositado a 200 ° C, a razão atômica (1:1,36) de In / O é ainda maior do que (1:1,5) do In 2 O 3 . Isso revela que o ALD em 2 O 3 o filme é geralmente rico em lacunas de oxigênio.

Alta resolução a C 1s, b Em 3d e c Espectros XPS de O 1 s de In 2 O 3 filmes depositados a 160, 180 e 200 ° C, respectivamente. Para remover contaminantes da superfície adventícia, todas as amostras foram atacadas com bombardeio de íons de Ar in-situ por 6 min antes da coleta de sinal
A Figura 5a mostra a variação de (αhν) 2 como uma função da energia do fóton para o depositado em 2 O 3 filmes em diferentes temperaturas de deposição. O gap óptico de banda (E g ) do In 2 O 3 filme pode ser determinado pela relação de Tauc:αhν =A (hν-E g ) n [26], onde α é o coeficiente de absorção, A é uma constante, h é a constante de Plank, ν é a frequência e o expoente n caracteriza a natureza da transição da banda. Aqui, n =1/2, indicando que em 2 O 3 é um semicondutor com uma transição diretamente permitida. E g é extraído extrapolando a porção da linha reta para a polarização de energia em α =0. O E extraído g para o In 2 O 3 o filme é mostrado na Fig. 5b. Vê-se que E g aumenta de 3,42 para 3,75 eV com o aumento da temperatura de deposição de 150 para 200 ° C. O aumento E g em temperaturas de deposição mais altas pode resultar da redução de vacâncias de oxigênio e impureza C no filme depositado. Na verdade, outros pesquisadores também relataram que quando existiam muitas vacâncias de oxigênio no ZnO, os estados de impurezas se tornavam mais deslocalizados e sobrepostos à borda da banda de valência, levando ao estreitamento do gap [27]. Além disso, a cristalinidade gradualmente aumentada em função da temperatura de deposição pode influenciar o gap óptico do In 2 O 3 filme. Isso pode ser explicado da seguinte forma. Conforme a temperatura de deposição aumenta, o tamanho do grão do depositado em 2 O 3 o filme aumenta, mostrado na Fig. 2. Isso leva a uma diminuição na densidade dos contornos de grão no filme. Uma vez que os elétrons são facilmente presos nos limites dos grãos, o número de elétrons livres deve aumentar no In 2 O 3 filme com menos limites de grão [28, 29]. Portanto, tal aumento na concentração de elétrons resulta em um gap óptico maior devido ao deslocamento de Burstein-Moss [30].

a Representação gráfica de (αhν) 2 vs energia do fóton para o In 2 O 3 filmes depositados em diferentes temperaturas; b dependência do gap extraído (E g ) de em 2 O 3 na temperatura de deposição
Para demonstrar a função do ALD em 2 O 3 filme atuando como canal do TFT, o In 2 O 3 - TFTs baseados em canal com Al 2 depositado em camada atômica O 3 portões dielétricos foram fabricados. A Figura 6a mostra as características de transferência de In 2 O 3 TFTs. Verificou-se que o dispositivo fabricado não exibe as características de comutação típicas dos transistores de efeito de campo, mas sim um condutor entre a fonte e o dreno. Isso deve ser atribuído à existência de muitas vagas de oxigênio no In 2 O 3 canal porque as lacunas de oxigênio podem fornecer elétrons livres. Portanto, com o objetivo de reduzir a concentração de vacâncias de oxigênio no In 2 O 3 canal, pós-recozimento ao ar foi realizado a 300 ° C. É claro que o In 2 O 3 O TFT exibe um comportamento de comutação típico após o recozimento de 2 horas. Isso indica que o pós-recozimento ao ar pode melhorar significativamente o desempenho do dispositivo. Além disso, conforme o tempo de recozimento aumenta gradualmente para 10 h, a tensão de limiar (V th ) do TFT muda na direção da polarização positiva, e a oscilação sublimiar (SS) melhora pouco a pouco. No entanto, quando o tempo de recozimento aumenta para 11 h, o desempenho do dispositivo começa a degenerar. Observa-se que o hidrogênio pode ser incorporado ao filme durante o processo de fabricação, atuando como uma armadilha de elétrons, formando ligações -OH no canal ou na interface entre o canal e o dielétrico [31]. Essas armadilhas de elétrons talvez resultem na degradação de SS. Após o recozimento ao ar, as ligações OH foram reduzidas pela incorporação de O 2 moléculas [32]. Isso pode levar a uma diminuição na densidade da armadilha, melhorando assim o SS do dispositivo. Em termos de recozimento de 10 h no ar, o In 2 O 3 TFT exibe uma mobilidade de efeito de campo (μ EF ) de 7,8 cm 2 V −1 s −1 , um V th de -3,7 V, um SS de 0,32 V / dec, e uma relação de corrente liga / desliga (I ligado / I desligado ) de 10 7 . As características de saída correspondentes também são apresentadas na Fig. 6b, demonstrando comportamentos claros de compressão e saturação de corrente sob várias tensões de porta positiva. Além disso, as curvas de saída também indicam um n modo de aprimoramento -tipo. Para comparação, a Tabela 2 resume as características do ALD relatado em 2 O 3 filmes e TFTs de diferentes grupos de pesquisa [33,34,35,36,37]. É demonstrado que nosso In 2 O 3 o filme mostra uma taxa de crescimento superior a uma temperatura relativamente baixa e o dispositivo fabricado também exibe um pequeno SS. No entanto, o desempenho geral do dispositivo não é tão perfeito, o que poderia ser melhorado por meio de algumas otimizações de processo e estrutura do dispositivo.
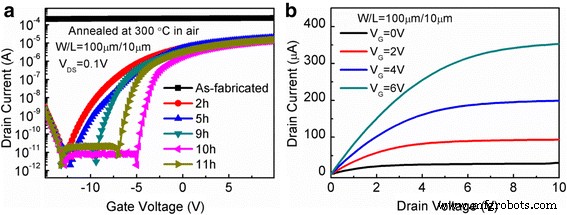
a Transferir características do In 2 O 3 TFTs recozidos a 300 ° C no ar por tempo diferente; b Características de saída do In 2 O 3 TFT recozido a 300 ° C no ar por 10 h
Para entender bem a influência do pós-recozimento ao ar na composição do In 2 O 3 canal, o In 2 O 3 os filmes foram recozidos a 300 ° C por diferentes tempos e, em seguida, analisados por meio de XPS. A Tabela 3 lista as porcentagens elementares de vários filmes recozidos. À medida que o tempo de recozimento aumenta de 2 para 11 h, a razão atômica de In:O diminui de 1:1,22 para 1:1,48, aproximando-se gradualmente de (1:1,5) do In 2 O 3 . Isso confirma ainda que o aumento do tempo de recozimento no ar reduziu efetivamente a densidade de vacâncias de oxigênio no In 2 O 3 filme. Portanto, a melhoria no desempenho do In 2 O 3 A TFT deve ser atribuída principalmente à passivação de vacâncias de oxigênio que podem estar localizadas no canal bulk e / ou na interface entre o canal e o dielétrico [25]. No entanto, o recozimento excessivo degradou o desempenho do dispositivo, conforme revelado pelo recozimento de 11 horas. Isso pode ser atribuído à mudança de cristalização do In 2 O 3 camada de canal, bem como possível oxidação de eletrodos de Ti durante pós-recozimento supérfluo no ar. Assim, um tempo de recozimento apropriado é necessário para alcançar o bom desempenho do In 2 O 3 TFT.
Conclusões
O rápido crescimento ALD do In 2 O 3 filmes foi alcançada em temperaturas relativamente baixas (160–200 ° C) com o InCp e H 2 O 2 precursores, exibindo uma taxa de crescimento uniforme de 1,46 Å / ciclo. Conforme a temperatura de deposição aumentou, a cristalização do filme depositado foi aumentada gradualmente. Enquanto isso, as lacunas de oxigênio e as impurezas de carbono nos filmes depositados também foram reduzidas significativamente. Isso, portanto, levou a um aumento no E g de em 2 O 3 . Além disso, com o ALD em 2 O 3 camada de canal, os TFTs com um ALD Al 2 O 3 dielétricos foram fabricados. Como o tempo pós-recozimento no ar foi alongado, o desempenho elétrico do In 2 O 3 O TFT foi melhorado nitidamente até o recozimento de 10 h. Isso se deve principalmente à passivação das vacâncias de oxigênio localizadas no canal em massa e / ou na interface entre o canal e o dielétrico após o recozimento no ar. Em termos de recozimento de 10 h, o dispositivo exibiu um bom desempenho, como uma mobilidade de efeito de campo de 7,8 cm 2 / V⋅s, uma oscilação de sublimiar de 0,32 V / dec e uma relação de corrente liga / desliga de 10 7 . Em termos de temperatura de deposição de 200 ° C, o filme depositado exibe uma relação In:O de 1:1,36 sem carbono detectável, revelando assim a existência de vacâncias de oxigênio no filme como depositado.
Nanomateriais
- Espaçadores de ar para chips de 10 nm
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Otimização de Filme Fino Altamente Refletivo para Micro-LEDs de Ângulo Total
- Efeito de diferentes ligantes no desempenho eletroquímico do ânodo de óxido de metal para baterias de íon-lítio
- Nanopetais de óxido de níquel mesoporoso (NiO) para detecção ultrassensível de glicose
- Um ânodo de filme Fe2O3 nanocristalino preparado por deposição de laser pulsado para baterias de íon-lítio
- Superfície insensível à polarização Modulador de eletro-absorção de polarização de plasma baseado em óxido de estanho de índio quase zero de épsilon
- Desenvolvimento de biocompósito de quitosana-óxido de polietileno / fibrinogênio para aplicações potenciais de cicatrização de feridas
- O Surfactante Aniônico / Líquidos Iônicos Óxido de Grafeno Reduzido Intercalado para Supercapacitores de Alto Desempenho
- Filme, matriz de antenas de alta frequência para comunicações sem fio



