Um estudo da variabilidade na memória de acesso aleatório resistiva de contato por modelo de vacância estocástica
Resumo
A variabilidade na célula de memória de acesso aleatório resistivo tem sido um dos desafios críticos para o desenvolvimento de matrizes RRAM de alta densidade. Embora as fontes de variabilidade durante a comutação resistiva variem para diferentes filmes de óxido de metal de transição, a geração / recombinação estocástica de vacância de oxigênio é geralmente considerada a causa dominante. Através da análise de dados experimentais, um modelo estocástico que liga as características de chaveamento subsequentes com seus estados iniciais de células RRAM de contato é estabelecido. Combinando um modelo de rede de condução e o mecanismo de tunelamento assistido por armadilha, os impactos da concentração e distribuição de vacâncias intrínsecas de oxigênio no filme dielétrico RRAM são demonstrados com Simulação de Monte Carlo. Os dados de medição em matrizes RRAM de contato concordam bem com as características projetadas pelo modelo com base na presença de vacâncias intrínsecas distribuídas aleatoriamente. Verifica-se uma forte correlação entre as características de formação e os estados iniciais, que vincula comportamentos de formação a vacâncias de oxigênio de pré-formação. Este estudo fornece uma compreensão abrangente das fontes de variabilidade em dispositivos RRAM de contato e um esquema de treinamento de redefinição para reduzir o comportamento da variabilidade nos estados RRAM subsequentes.
Histórico
A memória de acesso aleatório resistiva (RRAM) tem sido considerada uma solução promissora de armazenamento de dados não voláteis, como resultado de suas características desejáveis, como baixa potência, alta velocidade de P / E e compatibilidade superior com o processo lógico CMOS [1,2,3 , 4]. No entanto, ainda existem muitos obstáculos a serem superados para implementar facilmente matrizes de memória RRAM em circuitos CMOS de última geração [5, 6]. Um dos principais desafios em um array RRAM considerável é encontrado na variação existente entre e dentro das células [7,8,9,10]. Muitos modelos e simulações têm sido propostos para descrever o processo estocástico de geração / recombinação de vacância de oxigênio (Vo-) em filme de óxido de metal de transição (TMO) [11,12,13,14]. Kim e Brivio propuseram modelos de rede de disjuntores aleatórios para emular as características elétricas típicas de RRAM unipolar e bipolar, respectivamente [11, 12]. No entanto, os resistores nesses estudos foram todos configurados para serem constantes sem considerar o transporte de elétrons no filme RRAM. Além disso, como os modelos apresentados discutem processos estocásticos de RRAM a partir de um único nível de dispositivo em vez de análise estatística, a variabilidade do comportamento RRAM em uma matriz não é bem abordada e discutida em trabalhos anteriores [11,12,13,14]. Além disso, a presença de defeitos no filme dielétrico durante a fabricação tem sido estudada extensivamente por muitos anos [15, 16], mas seu impacto nas características de chaveamento resistivo em RRAM ainda precisa ser analisado de forma abrangente para que a tecnologia seja aplicada em macros de memória de tamanho considerável. Para investigar o efeito da distribuição intrínseca de Vo- nas características RRAM, uma rede de resistores modelada no mecanismo de tunelamento assistido por armadilha é construída para análise estatística adicional da variação e durante as operações neste estudo [11,12,13,14, 17 ] Além disso, o processo de geração estocástica de Vo- é simulado pelo método de Monte Carlo para estabelecer a correlação entre o RRAM em seus estados iniciais e as seguintes características de formação [18,19,20]. A forte correlação entre o Vo- intrínseco e a tensão de formação é estabelecida verificando o resultado da simulação com dados medidos em matrizes RRAM de contato [21]. Finalmente, diferentes tipos de filamentos condutores (CF) gerados e variação do estado de resistência após as operações de formação como resultado da distribuição de Vo- intrínseca são projetados e investigados de forma abrangente. Além disso, uma solução para aliviar o impacto da variabilidade Voon da pré-formação é proposta e demonstrada neste estudo.
Métodos
Os dados de medição para análise estatística adicional sobre a variabilidade são coletados de matrizes RRAM (CRRAM) de 16 × 16 contato que foram fabricadas por processos lógicos CMOS de 28 nm, onde o processo de fabricação de CRRAM é ilustrado na Fig. 1 [21]. A camada de óxido de proteção do resistor (RPO) e o dielétrico intercamada (ILD) são primeiro depositados após o processo de front-end ser concluído com os transistores formados. Para construir um filme de comutação resistivo funcional, o dimensionamento adequado do orifício de contato, tamanho de contato de 30 nm × 30 nm, é realizado para evitar o curto-circuito do plugue W e da região de difusão n +. Finalmente, a camada de barreira, TiN e o tampão de tungstênio são depositados individualmente. A imagem TEM em seção transversal de CRRAM é mostrada na Fig. 2a. Conforme revelado na imagem, a CRRAM é conectada em série com um transistor de seleção de canal n. Uma estrutura 1T1R é adotada para garantir a seleção adequada em uma matriz e evitar overshoots. A Figura 2b mostra o mapeamento da composição de CRRAM. Sua camada de óxido de metal de transição (TMO), com espessura de 9 nm, composta por TiN / TiON / SiO 2 empilhado é formado entre os eletrodos de tungstênio superior e inferior de silício. Após a fabricação do dispositivo, a análise elétrica e a construção do modelo físico neste estudo são concluídas pelo analisador de parâmetro de semicondutor Aglient 4156C e pela plataforma de software MATLAB, respectivamente.
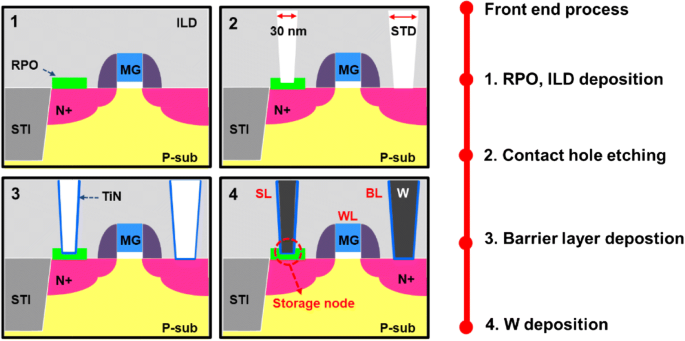
Fluxo de processo do contato RRAM em uma plataforma de processo lógico CMOS de porta de metal high-k de 28 nm. O tamanho de contato menor para CRRAM é projetado para controlar a espessura de corrosão para formar a camada de comutação resistiva funcional
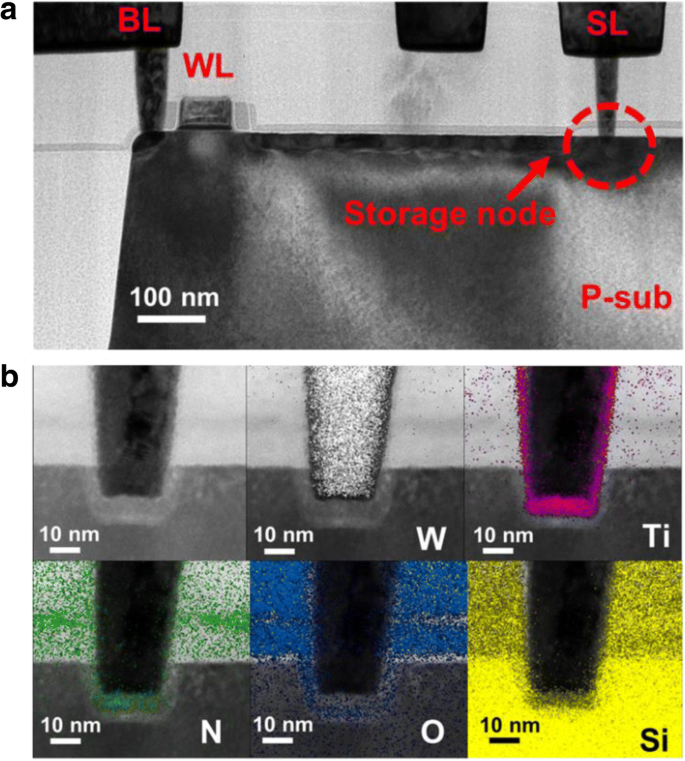
a Imagem TEM em seção transversal da estrutura 1T1R CRRAM. b Mapeamento de composição de CRRAM. O filme de comutação resistiva é composto de TiN / TiON / SiO 2 imprensado entre o plugue de tungstênio superior e o eletrodo de Si inferior
Conforme relatado em um estudo anterior [22], uma ampla distribuição de estados iniciais é encontrada no array CRRAM. Para investigar a origem da variação do estado inicial, as espessuras da camada de TMO com diferentes resistências iniciais são comparadas na Fig. 3 primeiro. Os dados sugerem que não há diferença significativa de espessura entre as duas células, com grande diferença nos níveis de resistência inicial. Muitos estudos têm sido relatados que Vo- são gerados no dielétrico ou filme RRAM durante a fabricação [23,24,25,26], o que implica que a diferença no número e densidade de Vo- é esperada para ser responsável pelas variações iniciais de condutividade.
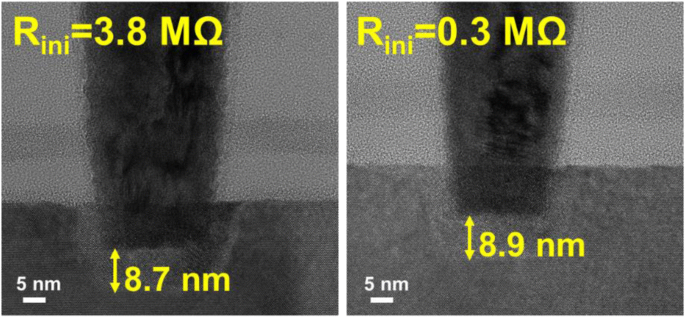
Comparação da espessura da camada de TMO entre duas células CRRAM com grande diferença de resistência inicial. Ambas as células são observadas com espessuras de camada dielétrica de cerca de 9 nm
Resultados e discussão
Modelo de distribuição de vagas intrínsecas
Para emular as interações entre o Vo- intrínseco, um modelo de rede de resistores mostrado na Fig. 4a é estabelecido [11,12,13,14]. As resistências em cada grade são calculadas por meio de um fluxo de simulação delineado na Fig. 4b, enquanto os parâmetros físicos correspondentes usados estão listados na Tabela 1. Com base na imagem TEM de CRRAM, uma estrutura bidimensional com largura de 30 nm e espessura de 10 nm , é definido para descrever a camada TMO, como mostrado na Fig. 5a. A resistência do sítio de óxido, R óxido , e a grade da malha são determinados pela propriedade do material de anatase-TiO 2 , que tem sido usado como um material de chaveamento resistivo em muitos estudos [27,28,29,30]. Por causa de sua estrutura tetragonal, as constantes de rede de anatase-TiO 2 variam com o eixo cristalográfico. Para simplificar, as grades de malha em nosso modelo são todas definidas para 1 nm, introduzindo a constante de rede na direção c de anatase-TiO 2 [31,32,33]. Além disso, as resistências para grades também são determinadas referindo-se à resistividade de anatase-TiO 2 [34, 35]. Conforme mostrado na Fig. 5a, os Vo- distribuídos aleatoriamente são dados dentro da malha 2-D inicialmente. As dependências de temperatura e campo elétrico da corrente de condução da CRRAM estão resumidas na Fig. 6a, b, respectivamente. As principais características da corrente de tunelamento assistido por armadilha (TAT) são mostradas por seu efeito de baixa temperatura e a dependência linear entre ln (J) e 1 / E [17, 36]. Usando o modelo de condução TAT, o perfil potencial dentro do filme TMO precisa ser calculado primeiro para obter ainda mais cada resistência localizada de Vo-. Espera-se que a distribuição de Vo- afete predominantemente a corrente condutora, visto que a distância de tunelamento varia entre as vacâncias de oxigênio. A resistência de Vo-, R ij , é então calculado pela Eq. 1, que considera as probabilidades de presença de Vo no local e adota o modelo TAT, para calcular a probabilidade de tunelamento entre os estados de vacância.
$$ {R} _ {\ mathrm {ij}, N} =\ frac {R _ {\ mathrm {óxido}}} {\ alpha \ {C} _ {\ mathrm {Vo} -} ^ {\ kern0.75em \ beta} \ \ exp \ left (\ frac {\ phi} {d} \ right)} $$ (1)
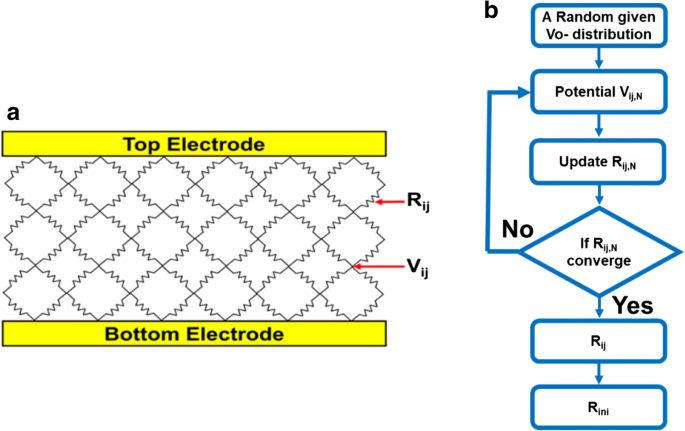
a Esquema do modelo da rede de resistores composta por resistência variável localizada de Vo-. Os nós nesta rede são conectados uns aos outros para simular a interação entre Vo-. b Fluxo de simulação de variabilidade do nível de resistência inicial. A distribuição estocástica de Vo- emergente intrínseco durante a fabricação é considerada pelo método de Monte Carlo

a A distribuição aleatória de Vo- intrínseco é inicialmente dada no filme RRAM. b Distribuição de resistência localizada de Vo- calculada por consideração de tunelamento assistido por armadilha. c R ini distribuição de células frescas coletadas de matrizes CRRAM concorda bem com os dados de simulação, considerando o mecanismo de condução TAT de pré-formação de Vo-
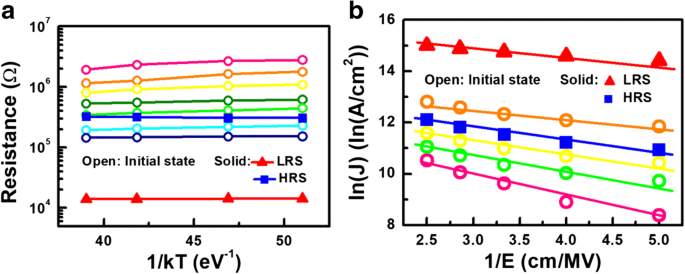
O mecanismo de condução da CRRAM é determinado verificando a dependência da temperatura e b dependência de campo elétrico. O tunelamento assistido por armadilha seguido por CRRAM é considerado por duas características de condução, fraca dependência da temperatura e ajuste linear entre ln (J) e 1 / E
Cada R ij, N é atualizado em cada iteração até que o resultado converta eventualmente. Como o R final ij distribuição é obtida, conforme ilustrado na Fig. 5b, a resistência geral, R ini , de uma célula nova também pode ser projetada subsequentemente, como mostrado na Fig. 5c. Como pode ser visto na Fig. 5c, a variação do R simulado ini distribuição obtida pelo fluxo de simulação proposto considerando a distribuição estocástica e a concentração de Vo- concordam bem com a distribuição do R ini medido em matrizes CRRAM. Portanto, camadas intrínsecas de Vo- in TMO distribuídas aleatoriamente, criando vários caminhos de tunelamento, contribuem para a resistência inicial amplamente difundida encontrada em matrizes CRRAM em pré-formação.
Análise do processo de formação não uniforme
Após modelar as causas atribuídas à variação célula a célula no estado fresco, a operação de formação, inicializando as características de comutação resistiva, é analisada. O fluxo de simulação da operação de conformação no modo de varredura DC é mostrado na Fig. 7 [18,19,20]. Conforme representado na Fig. 8a, uma célula é conectada a um transistor selecionado em série com uma resistência de canal de aproximadamente 5 KΩ na região linear e uma corrente de saturação de cerca de 80 μA. Como resultado da baixa tensão de formação, os mecanismos de condução e tensão do dielétrico em regime de baixo campo elétrico devem ser considerados. Com base no modelo químico-térmico proposto em estudos anteriores, a previsão precisa de falha dielétrica foi demonstrada [37,38,39,40]. Comportamento de decomposição teórica do TiO 2 simulado pelo modelo termoquímico [41] apresentou características semelhantes às observadas no CRRAM. Portanto, a taxa de geração de Vo é obtida com base no modelo químico-térmico aqui [42,43,44]. Conforme sugerido pelo modelo químico térmico, os pontos de grade ao lado de Vo- são definidos como um ponto fraco na vizinhança dos defeitos. A presença de Vo- também induz campo aprimorado localizado, mostrado na Fig. 8b, e acelera o processo de geração de Vo- [45]. Considerando o tempo para o processo de ruptura dielétrica no modelo químico-térmico com uma dependência de campo de exp. (- E), a probabilidade de geração de Vo P ij é calculado pela seguinte equação [42].
$$ {P} _ {\ mathrm {ij}} =\ gamma \ \ exp \ left (\ mathrm {E} \ right) \ \ left \ {\ begin {array} {c} \ kern1.75em \ upgamma =0, \ mathrm {if} \ \ mathrm {site} \ \ mathrm {is} \ \ mathrm {not} \ \ mathrm {fraco} \ \ mathrm {spot} \\ {} \ upgamma =1, \ mathrm {if } \ \ mathrm {site} \ \ mathrm {é} \ \ mathrm {fraco} \ \ mathrm {local} \ end {array} \ right. $$ (2)

Fluxo de simulação de um processo de formação com base no modelo químico-térmico, assumindo o tempo de falha dielétrica com dependência do campo elétrico de exp. (- E)
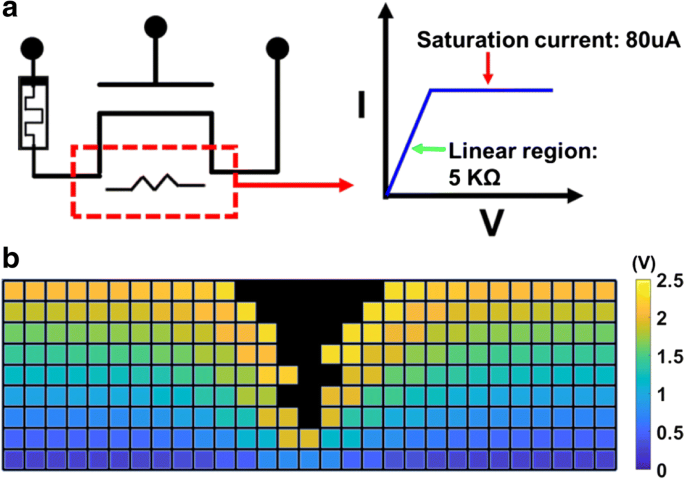
a A operação de conformação é simulada por uma CRRAM conectada em série com um transistor ideal. b A distribuição não uniforme do potencial elétrico, resultante do Vo- pré-existente, induz campo localizado e acelera a geração de novos defeitos
Um nível crítico, P g , e um critério, P ij > P g , são definidos para saber se um novo Vo- é gerado. Um processo de rampa é aplicado para atualizar a nova distribuição de Vo- a cada iteração até que a tensão de formação atinja 2,7 V. Finalmente, com um Vo- intrínseco distribuído aleatoriamente, o nível de baixa resistência R formando após a formação, a operação pode ser obtida. Com base no modelo acima, o R simulado formando distribuição projetou uma ampla variação, como mostrado na Fig. 9a, e o I-V calculado características concordam bem com os dados medidos. Além disso, a correlação entre as características de formação e os estados iniciais também é investigada. Maior concentração e Vo- distribuído localizado aceleram o processo de formação. Portanto, correlação positiva entre a tensão de formação e R ini são encontrados em resultados de simulação e dados medidos, como mostrado na Fig. 9b.
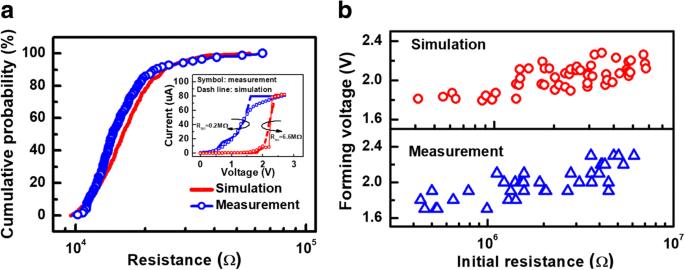
a A distribuição de resistência simulada da operação de conformação concorda bem com o resultado da medição. b Correlações positivas entre a resistência inicial e a tensão de formação são encontradas em dados medidos e simulados devido a mais pontos fracos e maior intensidade do campo elétrico produzido pela pré-formação. Vo-
Além disso, o Vo gerado na operação de formação induz caminho condutor e resulta em uma mudança de CF nas células, onde a evolução do CF durante o processo de formação é ilustrada na Fig. 10. Para células com alto R ini , há menos Vo- intrínseco e menos pontos fracos, como ilustrado na Fig. 10a. Após a operação de conformação, um único caminho condutor é mais provável de ocorrer entre os eletrodos. No entanto, o crescimento de CF em células com muito Vo intrínseco mostrado na Fig. 10b tende a ser mais disseminado; portanto, CF dendrítico são gerados após a formação. A correlação entre diferentes topografias de CF e a distribuição de Vo- em seu estado fresco também é verificada por dados de medição. Vo- e CF na camada TMO são conhecidos por levar a ruído telegráfico aleatório distinto (RTN) durante o processo de captura / remoção de elétrons [46]. Flutuações de resistência ocorrem se o caminho condutor é bloqueado por elétrons aprisionados, e a resistência diminui quando o elétron se desprende. A análise RTN de CRRAM após a formação está resumida na Fig. 11. Flutuação regular de resistência em duas etapas é encontrada em células com alto R ini , quando a captura / retirada de elétrons ocorre em um dispositivo com um CF dominante. Por outro lado, RTN de vários níveis é encontrado em células com baixo R ini que deve obstruir a FC dendrítica com mais de uma via. O resultado estatístico do RTN está resumido na Fig. 12, analisando a medição RTN de mais de 200 células CRRAM. Os dados sugerem que as células com alto R ini tendem a exibir apenas RTN de dois níveis, o que mais provavelmente ocorreu em dispositivos com um FC dominante [46,47,48,49]. A variação da resistência após a operação de formação é organizada na Fig. 13. Os dados sugerem que maiores variações de resistência são encontradas tanto na medição quanto no resultado da simulação nas células com baixo R ini . À medida que os CFs menos confinados empurram o transistor selecionado para entrar na região de saturação mais cedo, uma célula pode não ser formada adequadamente, levando a níveis de resistência de estado de baixa resistência mais amplos.

Progresso do CF na célula com a alta resistência inicial e b baixa resistência inicial. A maior concentração intrínseca de Vo- na camada TMO resulta na geração de Vo- aleatoriamente em pontos fracos. Esses Vo- também se conectam entre si para formar caminhos dendríticos

As topografias de CF na célula com a alta resistência inicial e b resistência inicial baixa são analisadas por seus dados RTN correspondentes. A ocorrência de flutuação de resistência múltipla em células com baixa resistência inicial e mais Vo- intrínseca verifica a existência de CFs dendríticos na camada TMO

A correlação entre o nível de resistência inicial e o nível de RTN nas células CRAM é resumida. Espera-se que ocorra maior probabilidade de flutuação de resistência de dois níveis para células com um caminho condutor dominante, que se correlacionou fortemente com células de alto R ini
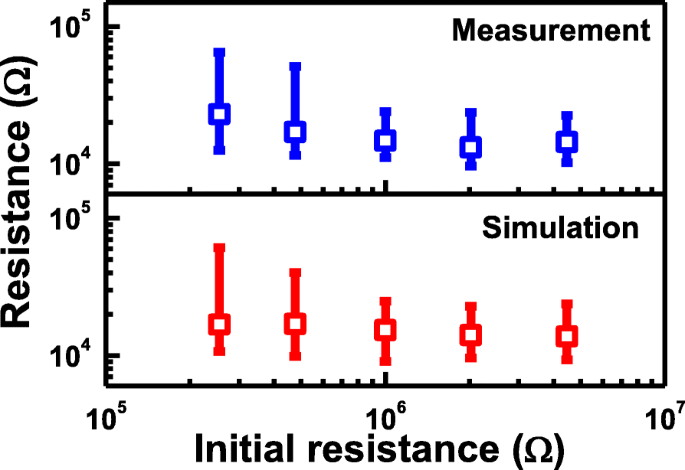
A análise da variação do nível de resistência após a operação de conformação é examinada por meio de simulação e medição. Maior variação induzida pela geração de CF dendrítico é encontrada em células com baixa resistência inicial
Para aliviar a variabilidade de formação causada por Vo- intrínseco na camada TMO, uma operação de treinamento de redefinição, que varre SL para 1,4 V sob uma tensão WL fixa de 2 V, é proposta para ser aplicada às cegas em células de memória inteiras no arranjo CRRAM antes da formação. Espera-se que esta operação aniquile defeitos pré-existentes existentes nas células com baixo R ini e para garantir um melhor crescimento de CF confinado durante o processo de formação subsequente. Devido à baixa voltagem aplicada, não há mudança nas células com alto R ini após o processo de treinamento. Com uma operação de treinamento de redefinição de cobertor, a resistência das células com baixo R ini , aumenta sem perturbar as células com alto R ini , como mostrado na Fig. 14. Subsequentemente, podem ser obtidas características de formação mais uniformes.

Uma operação de treinamento de reset geral é proposta para ser aplicada na matriz CRRAM. Resistência em células com baixo R ini é aumentada pela aniquilação de defeitos intrínsecos, mas células com alto R ini não é perturbado
Conclusões
Um modelo de rede de resistores considerando o efeito de campo local e a condução de tunelamento assistida por armadilha entre Vo- foi estabelecido com sucesso. Por simulação de Monte Carlo, a variabilidade celular em sua resistência inicial, bem como no processo de formação é investigada. A variação nos novos estados de CRRAM pode ser explicada com sucesso por uma distribuição dada aleatoriamente de Vo- intrínseco. A distribuição de resistência projetada após a formação também concorda bem com o resultado da medição ao adotar o modelo químico térmico. O crescimento do CF durante a formação é discutido e relacionado com a variabilidade observada neste processo. Finalmente, uma operação de reset de treinamento é proposta para aliviar ainda mais a variabilidade de formação causada por Vo- intrínseco na camada TMO. Uma forte correlação entre os estados iniciais e as características de formação fornece diretrizes para novas operações adaptativas para o desenvolvimento futuro de tecnologias RRAM.
Abreviações
- CF:
-
Filamento condutor
- CRRAM:
-
Memória de acesso aleatório resistiva de contato
- C Vo- :
-
Vo- concentração
- d:
-
Distância de túnel
- E:
-
Campo elétrico
- ILD:
-
Dielétrico Interlayer
- N :
-
Tempo de iteração
- P g :
-
Probabilidade de troca de limite
- P ij :
-
Probabilidade de geração de Vo
- R formando :
-
Resistência após a operação de conformação
- R ij :
-
Resistência localizada de Vo- site
- R ini :
-
Estado de resistência inicial
- R óxido :
-
Resistência localizada do local do óxido
- RPO:
-
Óxido de proteção do resistor
- RRAM:
-
Memória de acesso aleatório resistiva
- RTN:
-
Ruído telegráfico aleatório
- TAT:
-
Tunelamento assistido por armadilha
- TMO:
-
Óxido de metal de transição
- V f :
-
Tensão de formação
- V ij :
-
Potencial
- Vo-:
-
Vaga de oxigênio
- α :
-
Parâmetro de ajuste
- β :
-
Parâmetro de ajuste
- γ :
-
Parâmetro de ajuste
- ϕ :
-
Diferença de potencial elétrico
Nanomateriais
- ESTUDO DE CASO:O jeito Honda
- Yantracraft e o Templo Dourado
- Modelo de retenção de TaO / HfO x e TaO / AlO x RRAM com características de chave auto-retificadora
- O estudo de um novo sistema micelar em forma de verme aprimorado por nanopartículas
- Uma SRAM 4T integrada RRAM com carga de comutação resistiva autoinibida por processo lógico CMOS puro
- Estudo de primeiros princípios sobre a estabilidade e imagem STM de Borophene
- O efeito do plasma sem equilíbrio de contato nas propriedades estruturais e magnéticas de Mn Х Fe3 - X О4 Spinels
- Estudo sobre a memória de comutação de resistência multinível e fotovoltagem dependente do estado da memória em junções Pt / Nd:SrTiO3
- Um estudo coletivo sobre modelagem e simulação de memória de acesso aleatório resistiva
- Uma metodologia de duas etapas para estudar a influência da agregação / aglomeração de nanopartículas no módulo de Young de nanocompósitos poliméricos



