Alteração das propriedades ópticas de pontos quânticos InAs tampados por GaAsSb por meio de camadas intermediárias de InAlAs
Resumo
Neste trabalho, investigamos as propriedades ópticas de pontos quânticos InAs (QDs) cobertos com composto In 0,15 Al 0,85 As / GaAs 0,85 Sb 0,15 camadas redutoras de tensão (SRLs) por meio de difração de raios X de alta resolução (HRXRD) e espectroscopia de fotoluminescência (PL) a 77 K. Thin In 0,15 Al 0,85 Como camadas com espessura t =20 Å, 40 Å e 60 Å foram inseridos entre os QDs e um GaAs de 60 Å de espessura 0,85 Sb 0,15 camada. As emissões do tipo II observadas para GaAs 0,85 Sb 0,15 InAs QDs limitados foram suprimidos pela inserção do In 0,15 Al 0,85 Como camada intermediária. Além disso, o comprimento de onda de emissão foi alterado para t =20 Å e redshifted para t ≥ 40 Å resultante do aumento do potencial de confinamento e aumento da deformação, respectivamente. A separação de energia do estado fundamental e do estado excitado é aumentada atingindo 106 meV para t =60 Å em comparação com 64 meV para os QDs limitados apenas com GaAsSb SRL. Além disso, o uso do In 0,15 Al 0,85 À medida que as camadas estreitam significativamente a largura de linha espectral QD de 52 para 35 meV para as amostras com 40 e 60 Å de espessura In 0,15 Al 0,85 Como camadas intermediárias.
Histórico
Nas últimas décadas, os pontos quânticos auto-organizados (QDs) sintetizados usando a técnica de Stranski-Krastanov têm atraído muita atenção. Suas propriedades ópticas e eletrônicas têm sido investigadas intensamente devido às suas potenciais aplicações em dispositivos optoeletrônicos [1]. O sistema QD InAs / GaAs amplamente investigado tem sido empregado em uma variedade de dispositivos optoeletrônicos como material ativo. Durante o crescimento dessas nanoestruturas, uma mudança significativa no tamanho e na forma dos QDs ocorre durante o processo de cobertura. Este processo é bastante complexo e envolve mistura, segregação ou difusão intensificada por deformação [2]. O uso de uma camada de cobertura de GaAs puro limita a emissão de QD a menos de 1300 nm. Para aliviar este problema, camadas redutoras de deformação feitas de (Ga, In) (As, Sb, N) foram usadas [2,3,4,5,6,7]. Em particular, o GaAsSb ternário recebeu atenção especial, pois seu alinhamento de banda resultante pode ser adaptado para ser do tipo I ou tipo II, alterando o conteúdo de Sb [8, 9] e por sua capacidade de estender o comprimento de onda de emissão além da banda C [10]. No entanto, a diferença de energia entre o estado fundamental e excitado é limitada a 60-75 meV quando GaAsSb é usado como uma camada redutora de deformação (SRL) [11]. Esta separação de energia não impede que os portadores escapem termicamente dos QDs. Para aplicações que requerem uma longa vida útil do portador, a inserção de uma barreira fina entre os InAs QDs e GaAsSb será benéfica, pois aumentará a separação de portadores entre os QDs e o poço quântico GaAsSb (QW). Como exemplo, as camadas intermediárias de GaAs têm sido usadas resultando em um aumento da eficiência energética da célula solar em um fator de 23% [12]. O uso de camadas de InAlAs pode ser interessante para projetar o tipo de recombinação radiativa. Para a transição do tipo II, a inserção de InAlAs aumentará o tempo de vida do portador [13] e a separação de energia entre o estado fundamental e o primeiro estado excitado [14,15,16]. Além disso, espera-se que a inserção de uma camada InAlAs entre InAs QDs e GaAsSb diminua a segregação e suprima a mistura de átomos de In e Ga entre os InAs QDs e GaAsSb SRL e reduza ainda mais a deformação QD [17]. Os SRLs compostos InAlAs / InGaAs têm sido usados para limitar os QDs de InAs, resultando em emissão de comprimento de onda longo e uma separação de energia favorável entre o estado fundamental e excitado de até 104 meV [16, 18].
Neste artigo, relatamos a primeira investigação do efeito do uso de um In 0.15 Al 0,85 Como intercamada nas propriedades ópticas de InAs / GaAs 0,85 Sb 0,15 QDs por meio de espectroscopia de fotoluminescência (PL). Em particular, a variação do comprimento de onda de emissão, o tipo de emissão óptica, a largura de linha espectral e a separação de energia entre o estado fundamental e o primeiro estado excitado foram estudados em detalhes.
Métodos
As amostras investigadas no presente estudo foram cultivadas em substratos de GaAs tipo p de 2 ″ epi-ready (001) em um sistema Veeco Gen20A Molecular Beam Epitaxy. Os crackers valvulados foram usados para gerar As 2 e Sb 2 dímeros. Seguindo o crescimento de uma camada tampão de GaAs a 590 ° C, a temperatura do substrato foi então diminuída para ~ 485 ° C para crescer um nominalmente 2,5-ML-espessura InAs QDs. Após uma breve pausa em As 2 fluxo, um composto em 0,15 Al 0,85 As / GaAsSb SRL foi depositado imediatamente seguido pelo crescimento de um GaAs de 5 nm de espessura na mesma temperatura após o qual a temperatura de crescimento foi aumentada para 570 ° C para crescer uma camada de barreira de 38 nm de GaAs. A espessura de GaAsSb foi fixada em 60 Å enquanto a espessura de In 0,15 Al 0,85 Como variou de 20 a 60 Å. O GaAsSb SRL de 60 Å de espessura foi realizado usando um As 2 / Sb 2 razão de fluxo dando um teor de Sb de 15% conforme determinado por medições de difração de raios-X em uma amostra de referência. Uma taxa fixa de crescimento de Ga de 0,5 ML / s foi usada para todas as camadas. Quatro amostras denotadas como A, B, C e D foram cultivadas para as quais In 0,15 Al 0,85 Como espessura t foi definido como 0 Å, 20 Å, 40 Å e 60 Å, respectivamente. Com base no procedimento usado por Krijn [19] e usando os parâmetros em [20], a posição relativa das bandas de condução e valência foram estimadas e um esquema das estruturas crescidas com seu diagrama de bandas correspondente está representado na Fig. 1.
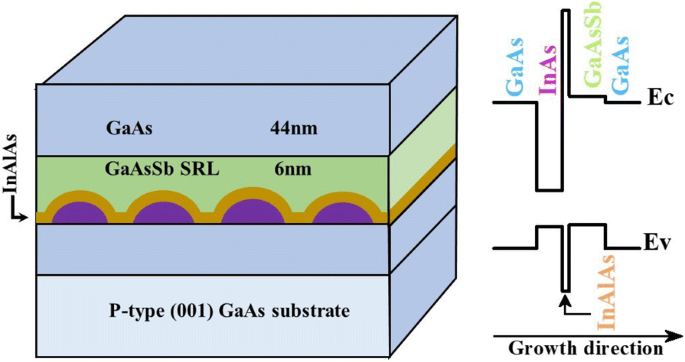
Esquema das estruturas crescidas e diagrama de banda de energia correspondente de InAs QDs cobertos com um composto em 0,15 Al 0,85 Como /GaAs0,85 Sb 0,15 . O In 0,15 Al 0,85 Como espessura t =0 Å, 20 Å, 40 Å e 60 Å para as amostras A, B, C e D, respectivamente
A qualidade do cristal das amostras foi caracterizada por difração de raios X de alta resolução (HRXRD) usando um difratômetro de raios X Panalytical. As propriedades ópticas das amostras crescidas foram avaliadas por meio de espectroscopia PL a 77 K usando um módulo PL conectado a um instrumento Infravermelho com Transformada Fourier Vertex 80 (Bruker Optics GmbH) e usando um detector InGaAs de alto ganho resfriado termeletricamente [21]. As amostras foram excitadas com uma fonte de laser de estado sólido CW 532 nm.
Resultados e discussão
A qualidade do cristal das amostras cultivadas foi caracterizada por HRXRD usando varreduras de curvas oscilantes, registrando o padrão de difração de 004 planos atômicos. A Figura 2a mostra os padrões de difração obtidos para as amostras A, B, C e D correspondentes à espessura de InAlAs de 0, 20, 40 e 60 Å, respectivamente. Picos de satélite claros resultantes do InAs / InAlAs / GaAsSb são observados mostrando a boa qualidade dos cristais das amostras cultivadas. As curvas de balanço de raios-X simuladas estão incluídas na Fig. 2a ao lado dos dados experimentais. O conteúdo médio de Sb obtido na amostra de referência A é de 13% e a espessura de GaAsSb é de 66 Å. Esses valores foram usados nas amostras B, C e D para encontrar o conteúdo de In e a espessura da camada intermediária de InAlAs. A simulação mostrou que o conteúdo médio de In é de 13,5% e a espessura da camada intermediária de InAlAs é de 22 Å, 44 Å e 65 Å nas amostras B, C e D, respectivamente, que estão próximas das espessuras nominais.

a Alta resolução ω / 2 θ verifica as amostras A, B, C e D. b Espectro PL da amostra A obtido a 77 K e 100 mW de excitação. c PL dependente de energia da amostra A a 77 K. d O pico de energia correspondente para as duas primeiras transições ópticas versus P ex 1/3 a 77 K
As propriedades ópticas da amostra de referência A foram investigadas primeiro a 77 K usando a técnica PL dependente da potência. A Figura 2b mostra o espectro PL para uma potência de excitação de 100 mW. O espectro PL pode ser ajustado por três picos Gaussianos centralizados em 1004 meV, 1068 meV e 1113 meV, que podem ser identificados como as transições ópticas fundamental e excitada. A largura total na metade do máximo (FWHM) dos estados fundamental e primeiro excitado são 52 e 58 meV, respectivamente. A fim de compreender a origem das duas primeiras transições ópticas observadas, a potência de excitação foi variada de 1 a 100 mW e os espectros de PL correspondentes foram adquiridos conforme representado na Fig. 2c. Para cada potência de excitação, a energia dos primeiros dois picos foi extraída usando ajuste de função multi-Gaussiana e plotada como uma função da raiz cúbica da potência de excitação, conforme mostrado na Fig. 2d. A energia da transição fundamental diminui com a redução da potência de excitação consistente com uma transição do tipo II, indicando que a emissão é resultado da recombinação dos elétrons localizados no estado fundamental do elétron no QD (E0 QD ) e orifícios localizados no GaAsSb QW (H0 QW ) Para o alinhamento de bandas InAs / GaAsSb tipo II, a localização de elétrons e buracos nos QDs e GaAsSb SRL, respectivamente, induz um efeito de curvatura de banda resultante do campo elétrico, que é predominantemente ao longo da direção de crescimento [22]. Espera-se que a energia de transição do tipo II aumente proporcionalmente com a terceira raiz da potência de excitação, conforme demonstrado por Jin et al. [22]. Da mesma forma, a energia da transição do primeiro estado excitado diminui com a redução da potência de excitação, e esta transição é mais provavelmente o resultado da recombinação dos elétrons no primeiro estado excitado do elétron no QD (E1 QD ) e buracos dentro do GaAsSb QW (H0 QW ), pois a densidade de estados no GaAsSb QW é muito maior do que a densidade de estados nos QDs. As primeiras duas transições ópticas são ilustradas na Fig. 3a. Notamos também que a separação de energia entre o estado fundamental e o primeiro estado excitado ΔE permanece quase constante em 64 meV com potência de excitação decrescente, e esta é uma evidência de que o campo elétrico resultante da acumulação de carga é perpendicular à direção de crescimento [22], ou seja, os buracos no GaAsSb estão localizados acima dos QDs. Uma emissão do tipo II é esperada na amostra A, pois o conteúdo de Sb no GaAsSb, que é de 13%, está próximo da composição onde ocorre uma transição do tipo I para o tipo II [23, 24]. Para o conteúdo de Sb considerado, um pequeno deslocamento de banda de valência entre os QDs e o GaAsSb QW deve existir, favorecendo a localização de buracos no GaAsSb QW e, posteriormente, as emissões do tipo II [25, 26].
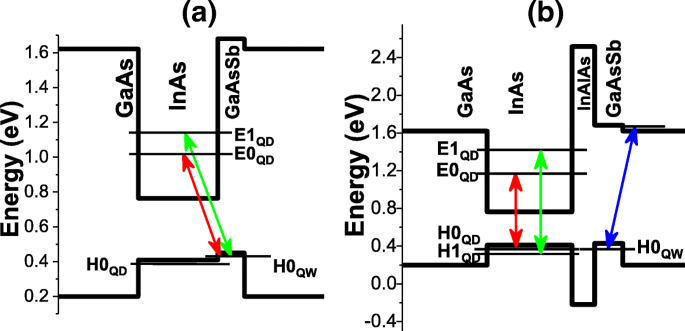
Perfis de banda da amostra A ( a ) e as amostras B, C e D ( b ) com seus canais de recombinação correspondentes
A Figura 4a mostra a emissão de PL correspondente às amostras com In 0,15 diferente Al 0,85 Como espessura com potência de excitação variando de 1 a 100 mW. Três picos principais podem ser identificados para todas as amostras contendo um In 0,15 Al 0,85 Como camada intermediária. Notamos uma alteração das posições dos picos de energia dos diferentes canais radiativos em relação à amostra de referência A. A uma potência de excitação de 100 mW, a energia da transição fundamental, FWHM e a separação de energia ΔE foram extraídas e comparadas com a amostra A. Os valores extraídos são relatados na Fig. 4b.

a PL dependente de energia do InAs / In 0,15 Al 0,85 As / GaAsSb QDs a 77 K. b A energia de pico correspondente, FWHM e ΔE versus espessura InAlAs e c a variação da energia de pico dos canais de transição óptica em função da raiz cúbica da potência de excitação para as amostras B, C e D
A transição do estado fundamental da amostra A ocorre em 1004 meV com um FWHM de 52 meV e uma separação de energia ΔE de 64 meV. Inserindo 20 Å de In 0,15 Al 0,85 As (amostra B) induz uma mudança no blues da transição do estado fundamental em 52 meV. O blueshift é consistente com o que foi observado quando um composto InAlAs / InGaAs foi usado para QDs cultivados quase na mesma temperatura de crescimento [27]. O blueshift de energia de transição do estado fundamental dos InAs QDs na amostra B resulta do potencial de confinamento aumentado [15]. À medida que a barreira para elétrons e lacunas aumenta, a separação do nível de energia de elétrons e lacunas deve aumentar, levando ao blueshift de emissão observado. É bem conhecido que o capeamento de InAs com GaAs resulta em uma redução da altura QD como consequência da segregação de In e da mistura de In-Ga [28]. A introdução de Sb na camada de capeamento de GaAs reduz a decomposição de QD ao inibir a mistura de In-Ga impulsionada por deformação [29]. Espera-se que a inserção da camada intermediária de InAlAs suprima ainda mais a segregação de In e a mistura de In-Ga resultante da inatividade dos adátomos de Al. Na verdade, Jun et al. [17] mostraram por meio do STEM que o uso de uma camada de combinação InAlAs / InGaAs como uma camada de cobertura suprime fortemente a segregação e a mistura de In-Ga ao longo da direção de crescimento durante o processo de cobertura dos QDs de InAs, levando ao aumento altura das nanoestruturas e uma maior concentração de In em InAs QDs após o capeamento. Considerando a baixa temperatura de crescimento dos QDs, ou seja, 485 ° C, espera-se que a segregação de índio e a mistura de interface entre os QDs e a camada intermediária de InAlAs sejam insignificantes como resultado da inatividade dos adátomos de Al.
O FWHM e o ΔE são reduzidos e aumentados para 39 meV e 92 meV, respectivamente. Aumentando ainda mais a espessura de In 0,15 Al 0,85 Quanto a 40 Å e 60 Å (amostras C e D, respectivamente) causa um desvio para o vermelho do comprimento de onda de emissão. Este redshift é provavelmente causado pela modificação da deformação em InAs QDs conforme a espessura total do composto InAlAs / GaAsSb SRL aumenta com o aumento da espessura de InAlAs [30]. Isso pode alterar as dimensões estruturais dos QDs e, portanto, modificar os níveis de energia dos elétrons e lacunas. Parece que para as amostras C e D (40 Å e 60 Å, respectivamente), o efeito de deformação domina o efeito do potencial de confinamento. O menor FWHM de 35 meV e a maior separação de energia ΔE de 35 meV e 106 meV foram obtidos, respectivamente, para a amostra D. O grande ΔE é causado pelo uso de uma camada mais espessa de InAlAs e possivelmente uma altura QD aumentada [31, 32]. A separação de energia é comparável àquela obtida quando um composto InAlAs / InGaAs SRL é usado (104 meV) [16, 33]. A redução do FWHM pode ser entendida em termos de uma redução da mistura entre In 0,15 Al 0,85 As e QDs e, portanto, uma preservação da distribuição de QD. Os parâmetros extraídos estão resumidos na Tabela 1.
A intensidade de PL das amostras B e C foi aumentada em relação à amostra A; no entanto, uma forte redução da intensidade de PL foi observada para a amostra D, ou seja, uma redução por um fator de 5 em comparação com a amostra C. A intensidade de PL reduzida resulta da redução da injeção de transportador da camada de GaAsSb para os QDs. Na verdade, durante a iluminação, numerosos portadores são fotogerados e a inserção do In 0,15 Al 0,85 Como a intercamada cria uma barreira para os portadores e pode limitar sua injeção nos QDs. Os transportadores podem transferir para os QDs através de um processo de tunelamento, e a intensidade PL é maior para as amostras com diluente In 0,15 Al 0,85 Como barreiras [34]. A amostra D mostrou a menor intensidade de PL como o tunelamento através de 60 Å In 0,15 Al 0,85 Como é bastante reduzido, e isso é evidenciado pelo aumento da emissão de PL do GaAsSb QW como mostrado na Fig. 4a. A redução do processo de tunelamento torna favorável e potencializa a recombinação radiativa de elétrons e lacunas no GaAsSb QW.
A principal observação do PL dependente de potência em 77 K para as amostras B, C e D mostradas na Fig. 4a são as posições de energia fixa dos primeiros dois picos com o aumento da potência de excitação em oposição ao que foi observado na amostra A. é uma característica de uma emissão tipo I onde os elétrons e buracos estão localizados dentro dos QDs. Os primeiros dois picos de emissão resultam da recombinação de elétrons e lacunas nos estados fundamental e primeiro excitado nos QDs (E0 QD -H0 QD e E1 QD -H1 QD ) Acreditamos que o terceiro pico se origina de uma emissão do tipo II resultante da recombinação de elétrons dentro de GaAs e lacunas localizadas em GaAsSb QW. Na verdade, a energia correspondente a esta transição aumenta com o aumento da potência de excitação, conforme mostrado na Fig. 4a e na Fig. 4c, característica de uma transição do tipo II. Além disso, vemos que sua intensidade aumenta com o aumento de In 0,15 Al 0,85 Como espessura da camada. Isso está de acordo com a redução da intensidade do PL da transição fundamental como um In 0,15 mais espesso Al 0,85 As camadas reduzem o tunelamento de portadores de GaAsSb para os QDs e favorece a emissão do tipo II obtida a partir da recombinação de elétrons e buracos localizados em GaAs e GaAsSb, respectivamente. Um esquema dos canais de recombinação para as amostras B, C e D está representado na Fig. 3b. A supressão da emissão do tipo II pode ser entendida como segue. A inserção de um 20-Å em 0,15 Al 0,85 À medida que a camada aumenta a separação da portadora entre os QDs e GaAsSb QW e, como resultado, a sobreposição da função de onda do elétron e do buraco diminui. Além disso, o fato de que o conteúdo Sb no conteúdo GaAsSb é próximo ao crossover tipo I-tipo II, o In 0,15 Al 0,85 Como intercamada trará o nível confinado no QW (H0 QW ) abaixo do primeiro nível quantizado nos QDs (H0 QD ) como mostrado na Fig. 3b e, portanto, os furos capturados no QW podem criar um túnel através da camada InAlAs, tornando menos provável a emissão do tipo II. Para um mais espesso em 0,15 Al 0,85 Como intercamada (40 Å e 60 Å), o tunelamento é ainda mais reduzido, mas a sobreposição de função de onda de elétron e buraco é substancialmente reduzida, favorecendo a recombinação de elétrons em GaAs com buracos em GaAsSb [13]. A transição óptica de InAs / GaAsSb QDs pode ser adaptada para o tipo de aplicação que requer vida curta ou longa. Em nosso estudo, consideramos um conteúdo de Sb de 13% em GaAsSb, que está próximo da transição do tipo I para o tipo II. A inserção de uma camada intermediária de InAlAs suprimiu a emissão do tipo II e aumentou a separação de energia entre o estado fundamental e o primeiro estado excitado, o que é desejável para aplicações que requerem um curto tempo de vida do portador. O presente estudo também pode ser adaptado para aplicações que requerem uma longa vida útil do portador. Na verdade, a combinação do uso de um conteúdo mais alto de Sb na camada de GaAsSb e a inserção de uma camada intermediária de InAlAs deve manter a emissão do tipo II para camadas intermediárias de InAlAs finas enquanto aumenta significativamente a vida útil do portador. Ao mesmo tempo, o aumento da separação de energia entre o estado fundamental e o primeiro estado excitado reduzirá o escape térmico do portador.
Conclusão
InAs QDs limitados com composto In 0,15 Al 0,85 As / GaAs 0,85 Sb 0,15 SRLs com variação de 0,15 Al 0,85 Conforme as espessuras foram aumentadas e caracterizadas. Nossa análise mostra que a inserção de um In 0,15 Al 0,85 Como a camada suprime a emissão observada tipo II obtida de InAs / GaAs 0,85 Sb 0,15 QDs. Além disso, o comprimento de onda de emissão é desviado para o azul para t =20 Å e redshifted para t ≥ 40 Å resultante do aumento do potencial de confinamento e aumento da deformação, respectivamente. Uma grande separação de energia ΔE de 106 meV foi obtida para a amostra com 60 Å de espessura In 0,15 Al 0,85 Como camada intermediária. Além disso, a introdução do In 0,15 Al 0,85 Como interlayer reduz significativamente o FWHM de 52 meV atingindo um mínimo de 35 meV.
Abreviações
- FWHM:
-
Largura total pela metade no máximo
- HRXRD:
-
Difração de raios-x de alta resolução
- PL:
-
Fotoluminescência
- QDs:
-
Pontos quânticos
- QW:
-
Bem quântico
- SRLs:
-
Camadas redutoras de tensão
Nanomateriais
- O rearranjo atômico de poços quânticos múltiplos baseados em GaN em gás misto H2 / NH3 para melhorar propriedades estruturais e ópticas
- N, N-Dimetilformamida regulando a fluorescência de pontos quânticos MXene para a determinação sensível de Fe3 +
- Detectando Exciton Espacialmente Localizada em Superredes de Pontos Quânticos Auto-Organizados InAs / InGaAs:Uma Forma de Melhorar a Eficiência Fotovoltaica
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Síntese verde de pontos quânticos InP / ZnS Core / Shell para aplicação em diodos emissores de luz livres de metais pesados
- Síntese de pontos quânticos de sulfeto de antimônio solúvel em água e suas propriedades fotoelétricas
- Síntese sonoquímica fácil de uma etapa e propriedades fotocatalíticas de compostos de pontos quânticos de grafeno / Ag3PO4
- Eliminação do tamanho bimodal em pontos quânticos InAs / GaAs para preparação de lasers de pontos quânticos de 1,3 μm
- Fotocondutividade entre bandas de pontos quânticos InAs / InGaAs metamórficos na janela de 1,3-1,55 μm
- Material e propriedades ópticas de pontos quânticos de carbono fluorescente fabricados a partir de suco de limão via reação hidrotérmica



