Pontos quânticos de índio de tamanho uniforme cultivados na superfície de uma camada epitaxial InGaN por um processo de resfriamento de duas etapas
Resumo
Um novo método para crescer pontos quânticos de índio (Em QDs) na superfície de uma camada InGaN epitaxial por MOCVD é proposto. Pontos quânticos In de tamanho uniforme foram encontrados para se formar na superfície de uma camada InGaN quando um processo de resfriamento de duas etapas é realizado. Através da análise, descobrimos que a formação de In QDs na superfície é devido à reação entre a camada rica em In da superfície e o gás portador H 2 no período de temperatura mais baixa no processo de resfriamento de duas etapas. Ao mesmo tempo, como a densidade de In QDs é intimamente dependente da camada rica em In da superfície, isso nos fornece uma maneira de estudar a propriedade da superfície da camada InGaN diretamente.
Introdução
Nos últimos anos, os materiais à base de (Al, In, Ga) N têm atraído muita atenção devido à sua aplicação bem-sucedida em um dispositivo emissor de luz (LED) e diodo laser (LD) [1,2,3,4, 5]. O InGaN possui alta absorção, ampla cobertura espectral e dureza de radiação, sendo sempre utilizado como material ativo para a fabricação de dispositivos optoeletrônicos. No entanto, é um grande desafio cultivar materiais InGaN de alta qualidade, devido a uma série de problemas. Por exemplo, a grande diferença na constante de rede entre InN e GaN resulta em uma lacuna de miscibilidade de fase sólida [6, 7]. A pressão de vapor relativamente alta do InN em comparação com o GaN leva a uma baixa incorporação de índio na liga InGaN [8]. Além disso, uma grande diferença nas entalpias de formação para InN e GaN causa uma forte segregação da superfície do índio na frente de crescimento [9]. Por outro lado, no processo de crescimento da camada InGaN, sempre existe uma camada rica em In na superfície devido ao efeito de tração, que afetará a qualidade da camada subsequente do poço quântico múltiplo InGaN / GaN (MQW) por introdução de átomos de índio no crescimento subsequente da camada de GaN [10]. Para obter o alto desempenho dos dispositivos optoeletrônicos baseados em InGaN, temos que superar todos esses obstáculos. Durante a pesquisa, o crescimento de uma única camada InGaN é sempre usado para otimizar o parâmetro de crescimento de InGaN / GaN MQW. Neste artigo, ocasionalmente encontramos pontos quânticos de tamanho uniforme na superfície da camada InGaN única ao fazer um processo de resfriamento de duas etapas que substitui o processo de resfriamento regular de uma etapa após o crescimento da camada InGaN única. Por meio da análise, descobrimos que a formação de In QDs está relacionada à camada In-rich existente na superfície da camada InGaN, e que nos fornece uma forma de estudar diretamente a camada In-rich da superfície.
Experimento
As amostras utilizadas neste estudo foram camadas únicas de InGaN cultivadas em substrato de safira plano C por um AIXTRON 6 × 2 em deposição química metalorgânica de reator de chuveiro de acoplamento próximo (MOCVD) em um N 2 atmosfera. Trimetilgálio (TMGa), trimetilíndio (TMIn) e amônia (NH 3 ) são usados como precursores de fonte Ga, In e N, respectivamente. As camadas InGaN únicas com uma espessura abaixo de 60 nm e o conteúdo de In de menos de 15% foram cultivadas em uma camada GaN de dopagem não intencional de 2 μm de espessura após uma camada tampão de GaN de 25 nm crescida em um substrato de safira. O esquema da estrutura é mostrado na Fig. 1. H 2 e N 2 são usados como gás portador em diferentes períodos do processo de crescimento. Convencionalmente, o N 2 é usado como gás de arraste no processo de crescimento da camada InGaN porque H 2 tem um efeito corrosivo na camada InGaN que irá diminuir em grande parte a eficiência da incorporação [11, 12]. No entanto, H 2 como gás de arraste, pode melhorar muito a mobilidade superficial dos átomos e reduzir a concentração de impurezas. Portanto, H 2 é preferido para uso como um gás transportador durante o crescimento da camada de GaN para melhorar a qualidade do cristal. Geralmente, quando o crescimento da camada InGaN é concluído, a temperatura foi diretamente diminuída para a temperatura ambiente em uma atmosfera de nitrogênio. Aqui, chamamos esse processo de “resfriamento em uma etapa”. Neste artigo, um processo denominado de resfriamento em duas etapas foi realizado após o crescimento da camada InGaN, no qual a temperatura foi reduzida para 400 ° C em uma atmosfera de nitrogênio no primeiro período de resfriamento e, posteriormente, é reduzida para a temperatura ambiente em um H 2 atmosfera. Difração de raios-X de alta resolução (XRD), microscopia de força atômica (AFM), microscópio eletrônico de varredura (SEM) e espectrômetro de dispersão de energia (EDS) são usados para caracterizar as amostras InGaN.
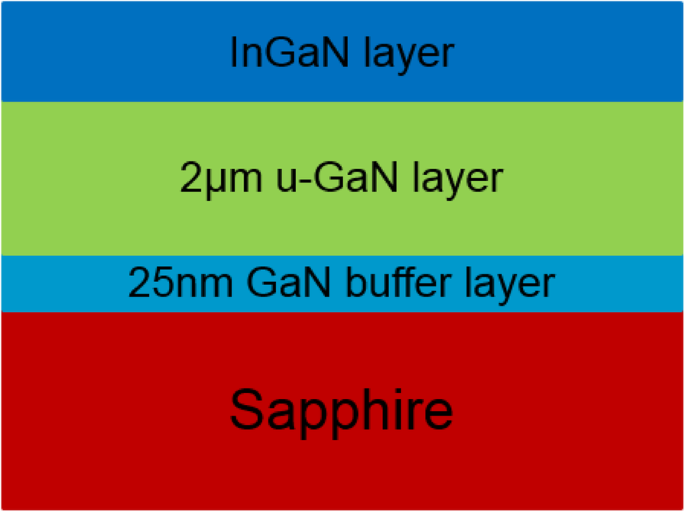
O esquema da estrutura da única camada InGaN crescida em um modelo GaN usando um substrato de safira
Resultado e discussão
Uma topografia de superfície anormal da camada InGaN foi encontrada quando cultivada em uma única camada InGaN no modelo GaN com um processo de resfriamento de duas etapas. A morfologia da superfície AFM das amostras InGaN com resfriamento de uma etapa e resfriamento de duas etapas é mostrada respectivamente na Fig. 2a e b. A Figura 2a mostra uma morfologia de superfície típica da epilayer InGaN, a partir da qual podemos descobrir que a camada InGaN tem um fluxo de crescimento 2D claro. Ao mesmo tempo, existem muitas ilhas 3D na superfície da amostra que são atribuídas a se relacionarem com as linhas de deslocamento do parafuso na camada de GaN. Também pode ser visto que há um ponto escuro no topo de cada ilha 3D que foi provado ser o v-pit formado ao longo do deslocamento do parafuso [13, 14]. Diferentemente da Fig. 2a, exceto a superfície de fluxo em degrau e as ilhas 3D, há também muitos pontos quânticos de tamanho uniforme (os pequenos pontos brancos na imagem) na Fig. 2b. Combinado com a inserção da Fig. 2b no canto superior esquerdo, que é um diagrama 3D da superfície, podemos obter o tamanho médio desses pontos quânticos de cerca de 100 nm × 100 nm, a altura média é de cerca de 20 nm, e a densidade é cerca de 1,6 × 10 8 cm −2 . Observa-se que a principal diferença entre essas duas formas diferentes de resfriamento de amostra é que H 2 é usado como gás portador em vez de N 2 no segundo período de resfriamento do processo de resfriamento de duas etapas. Portanto, a formação de pontos quânticos na superfície da camada InGaN está relacionada ao gás portador H 2 no processo de resfriamento de baixa temperatura.
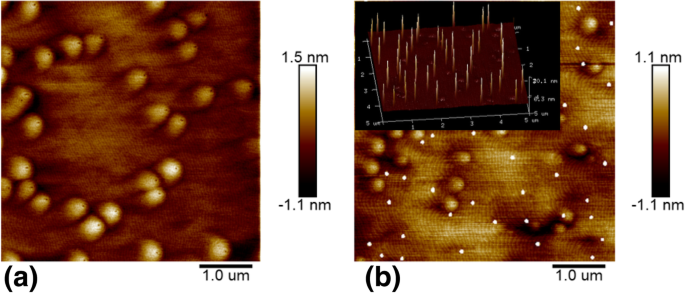
Topografia de superfície AFM de a Amostra InGaN com resfriamento de uma etapa e b Amostra InGaN com processo de resfriamento de duas etapas, onde a inserção é um diagrama 3D da superfície
Para entender como isso acontece quando o processo de resfriamento de duas etapas é obtido em amostras InGaN, fazemos um experimento de resfriamento de duas etapas no GaN em vez de InGaN. Esta camada de GaN foi cultivada na mesma condição com as amostras de camada única InGaN estudadas neste trabalho, isto é, a uma temperatura de crescimento relativamente mais baixa de 740 ° C e N 2 é usado como gás portador. A topografia de superfície AFM da camada de GaN após um processo de resfriamento de duas etapas é mostrado na Fig. 3a. Podemos descobrir que não há quaisquer pontos quânticos na superfície e a superfície é igual a amostras de camada de GaN crescidas com MOCVD de resfriamento de uma etapa, conforme amplamente relatado [15]. Além disso, verificamos o que acontecerá quando o processo de resfriamento de duas etapas for usado para uma amostra da camada InGaN com um conteúdo de In muito baixo, no qual o conteúdo de In é de apenas 1%. A Fig. 3b mostra a morfologia da superfície AFM desta amostra InGaN com baixo teor de In após um processo de resfriamento de duas etapas. Verificou-se que a densidade dos pontos quânticos tem uma diminuição muito grande em comparação com a amostra InGaN com alto conteúdo de In mencionado acima, em que o conteúdo de In é de cerca de 13%. Esses resultados significam que a formação de pontos quânticos na superfície da camada InGaN no processo de resfriamento de duas etapas está correlacionada ao átomo In, e esses pontos quânticos podem estar em um estado de In, que é formado devido à reação entre o InGaN camada e gás portador H 2 no processo de segundo resfriamento.
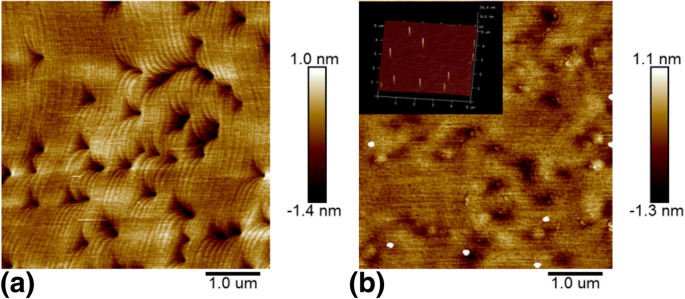
Topografia de superfície de AFM de amostras com resfriamento em duas etapas. a Camada de GaN. b Camada InGaN com conteúdo In 1%
Estudos anteriores mostraram que existem três estados diferentes de átomos In no processo de crescimento da camada InGaN [16, 17]. O primeiro são os átomos In na rede cristalina da liga InGaN, que é a parte principal e o produto alvo do crescimento da camada InGaN; o segundo é a liga InN que sempre aparece na superfície da camada InGaN; e o terceiro é a gota In, que pode aparecer em alguma condição especial de crescimento. Diferentes estados do átomo In podem ser distinguidos por espectros de XRD, pois eles têm diferentes picos de difração no modo de varredura ω / 2θ. Para determinar a qual estado esses pontos pertencem, a medição de XRD foi feita para as amostras InGaN com processos de resfriamento de uma ou duas etapas. A Figura 4 mostra os espectros XRD ω / 2θ típicos para amostras com resfriamento de duas etapas (linha vermelha) e resfriamento de uma etapa (linha azul). Três picos característicos foram encontrados para as amostras com resfriamento de duas etapas, enquanto há apenas dois picos característicos para as amostras com resfriamento de uma etapa. Portanto, o pico característico extra para as amostras com resfriamento em duas etapas pode representar os pontos quânticos que se formam na superfície. Os dois picos característicos que comumente existem nessas amostras estão localizados em torno de 33,5 ° e 34,5 °. Eles pertencem ao cristal InGaN e GaN, respectivamente. Enquanto o pico característico extra localizado em 2θ =32,8 ° foi verificado para vir da gota de entrada [16, 17]. Portanto, podemos concluir que os pontos quânticos que observamos na superfície InGaN com o processo de resfriamento em duas etapas é a gota de In. Para confirmar esta conclusão, a medição SEM foi realizada nas amostras com um processo de resfriamento em duas etapas, o resultado é mostrado na Fig. 5a, a partir da qual também podemos encontrar os pontos existentes na superfície. Para identificar esses pontos, EDS foi tomado no mesmo lugar, a Fig. 5b-d mostra a distribuição de átomos de superfície para In, Ga e N, respectivamente, a partir da qual podemos obter que os átomos de Ga e N estão uniformemente distribuídos em a superfície, enquanto a concentração de átomos de In nos pontos é muito maior do que ao seu redor, o que representa que esses pontos são ricos em In. Assim, combinado com a análise acima, podemos concluir que o gás portador H 2 pode reagir com a camada InGaN na temperatura baixa e formar gotículas de In na superfície.
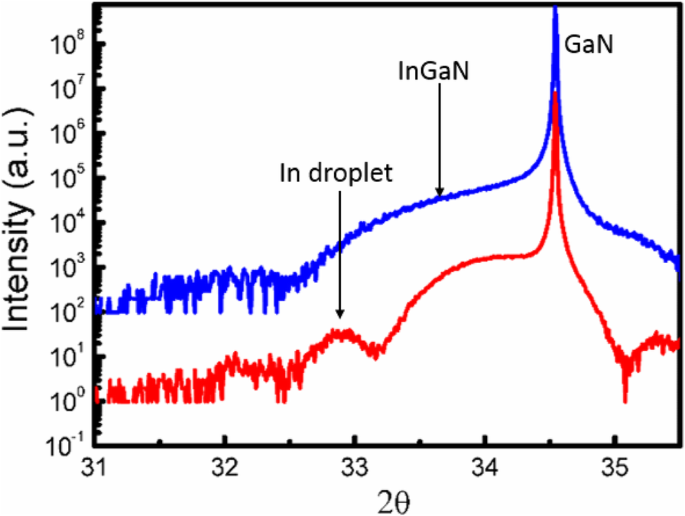
Os espectros de XRD para amostra com resfriamento de duas etapas (linha vermelha) e resfriamento de uma etapa (linha azul)
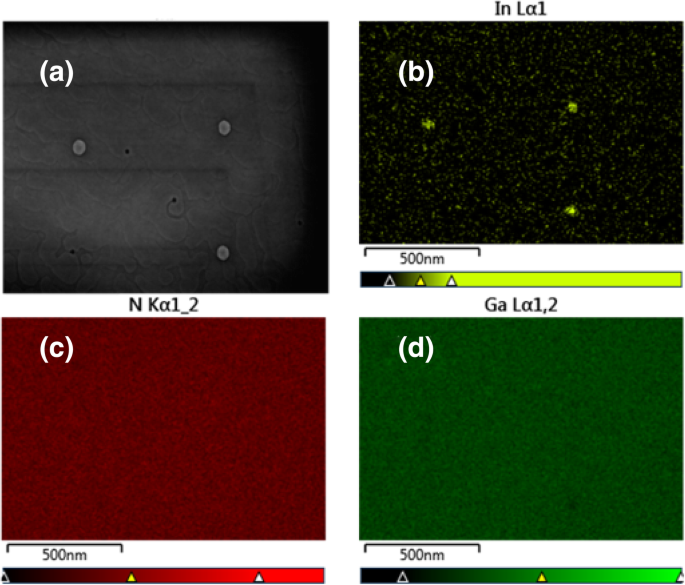
a A fotografia de superfície SEM para a amostra com um processo de resfriamento de duas etapas, b - d é o resultado da análise do elemento EDS para o átomo In, N e Ga, respectivamente
Foi relatado que muitas vezes há uma camada rica em In formada na superfície da camada epitaxial InGaN devido ao efeito de tração da superfície [10]. Em nosso experimento, as amostras foram resfriadas diretamente até a temperatura ambiente após o crescimento de uma única camada de InGaN, o que significa que a camada de superfície rica em In ainda existe na superfície no processo de resfriamento. Portanto, há duas possibilidades de origem do átomo In para os In QDs que observamos:a camada InGaN e a camada de superfície rica em In, respectivamente. Para saber qual é a origem do átomo In dos pontos quânticos In e como ocorre a reação, novos experimentos foram realizados. É conhecido que um processo de recozimento pode limpar a camada rica em In [18]. Portanto, consideramos um processo de recozimento térmico para as amostras InGaN antes do processo de resfriamento de duas etapas. O tempo do processo de recozimento térmico é definido como 60 s, e a temperatura é cerca de 800 ° C, que é 60 ° C mais alta do que a temperatura de crescimento da camada InGaN. A topografia AFM da amostra InGaN com um processo de recozimento antes do processo de resfriamento de duas etapas é mostrada na Fig. 6, obviamente não há pontos quânticos na superfície. Porém, em comparação com a Fig. 2a, uma grande mudança na topografia da superfície pode ser encontrada, a superfície torna-se mais rugosa. A falta de pontos quânticos In na superfície mostra que a camada InGaN não se formaria em QDs com H 2 no segundo processo de resfriamento, como o recozimento térmico pode apenas limpar a camada rica em In. Portanto, a formação do ponto quântico In na superfície da camada InGaN no processo de resfriamento de duas etapas é devido à reação entre a camada superficial rica em In e o gás portador H 2 na faixa de baixa temperatura.
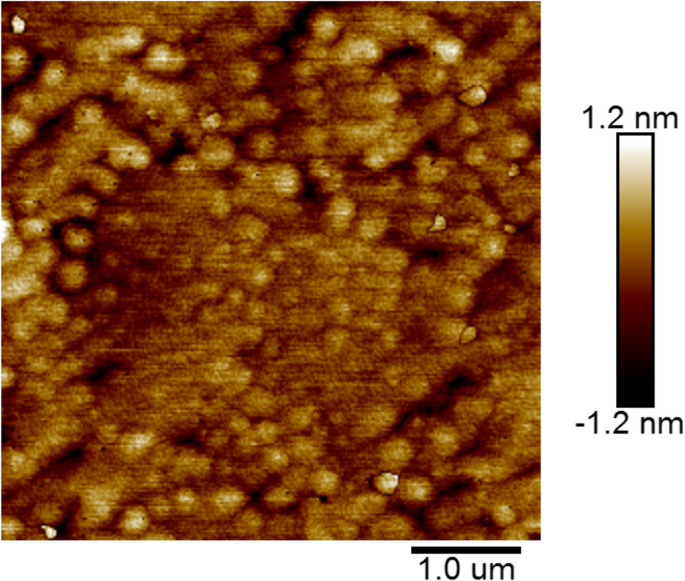
A topografia de superfície AFM da camada InGaN com um recozimento térmico antes do resfriamento de duas etapas.
O efeito corrosivo de H 2 sobre o crescimento da camada InGaN foi amplamente relatado. Sabe-se que H 2 pode impedir que os átomos de In incorporem na rede [19, 20], e essa é a principal razão pela qual convencionalmente apenas N 2 é usado como gás de arraste no crescimento de MOCVD das camadas de InGaN. O efeito corrosivo de H 2 na camada InGaN pode ser visto como um processo reverso do crescimento da camada InGaN, que pode ser expresso pela seguinte reação química:
$$ {3 \ mathrm {H}} _ 2 + 2 \ mathrm {In} \ mathrm {N} \ a 2 \ mathrm {In} + {2 \ mathrm {NH}} _ 3 $$
A formação de pontos quânticos In no processo de resfriamento de duas etapas pode ser vista como um tipo de efeito corrosivo, mas existem algumas diferenças entre alta temperatura (para crescer InGaN com H 2 ) e baixa temperatura (para resfriar InGaN e formar em QDs com H 2 ) Em alta temperatura, o átomo de In formado pelo efeito corrosivo na superfície tem energia suficiente para escapar pela camada limite da superfície, diminuindo assim a eficiência de incorporação de In. No entanto, em baixa temperatura (abaixo de 400 ° C), nossos resultados revelam que H 2 tem um efeito corrosivo apenas na camada de superfície altamente contida em InGaN, uma vez que esta camada é mais instável do que a camada InGaN. Por outro lado, como a temperatura está abaixo de 400 ° C, os átomos de In que se formam na superfície podem escapar muito menos através dos limites da superfície em tempo hábil, então eles migrarão na superfície da amostra e então formarão gotas de In na superfície.
Em nosso estudo, como a formação de In QDs está relacionada à camada de alto In contido na superfície do InGaN, eles podem fornecer diretamente algumas informações sobre a camada rica em In da superfície do InGaN. As amostras da camada InGaN com diferentes conteúdos e espessuras de In são usadas para fazer experimentos de tratamento de resfriamento em duas etapas. A Figura 7 mostra a topografia da superfície das camadas InGaN com diferentes conteúdos e espessuras de In. O conteúdo de In é 7,65%, 8,45% e 9,6%, respectivamente, para as amostras A, B e C, e a espessura da camada InGaN para essas três amostras é quase a mesma (cerca de 13,4 nm). A partir das morfologias de superfície AFM das amostras A, B e C, podemos descobrir que a densidade de In QDs aumenta com o conteúdo de In na camada InGaN. E a densidade de QDs é cerca de 2,4 × 10 7 cm −3 , 4,8 × 10 7 cm −3 e 9,2 × 10 7 cm −3 respectivamente para as amostras A, B e C, enquanto o tamanho dos QDs para essas amostras é quase o mesmo. Por outro lado, a amostra D tem o mesmo conteúdo de In da amostra A (7,65%), enquanto a espessura da camada é de cerca de 41 nm. Compare a superfície para duas amostras de A e D, é claro que a densidade dos pontos quânticos In aumenta quando a espessura da camada InGaN aumenta. De nossa análise mencionada acima, aprendemos que a formação desses pontos quânticos In é causada pela reação de H 2 com a camada de superfície rica em baixa temperatura. Assim, a tendência de mudança da densidade de In QDs pode refletir o estado da camada de superfície rica em In, ou seja, os átomos de In instáveis existentes na camada de superfície rica em In, eles aumentam junto com o aumento do conteúdo de In e espessura do InGaN camada. Este resultado é consistente com estudos teóricos anteriores que mostraram que o conteúdo de In da camada de superfície rica em In está relacionado com o conteúdo de In e a espessura das camadas de InGaN [21]. Isso também prova que o mecanismo de formação dos pontos quânticos In está de fato relacionado à superfície da camada rica em In.
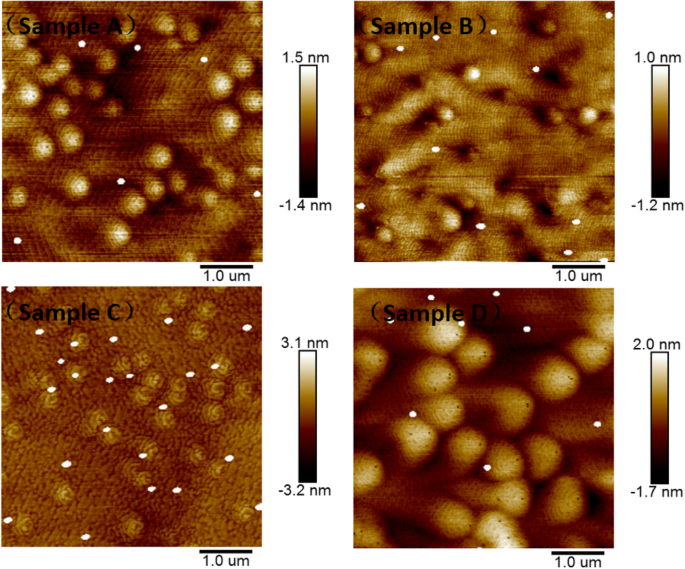
A topografia de superfície AFM das camadas InGaN a , b , c , e d com conteúdo e espessura diferentes (ver texto)
Conclusão
Neste artigo, apresentamos um novo método para obter In QDs de tamanho uniforme na superfície de uma camada InGaN. Encontramos forma de In QDs de tamanho uniforme na superfície de uma camada InGaN ao fazer um processo de resfriamento de duas etapas sobre ela. Por meio de uma análise detalhada, descobrimos que a formação de pontos quânticos In na superfície é devido à reação entre a camada rica em In da superfície e o gás portador H 2 a uma temperatura baixa. Ao mesmo tempo, nossos experimentos revelam que H 2 só tem um efeito corrosivo na camada de superfície rica em In quando a temperatura é inferior a 400 ° C, e este processo corrosivo formará In QDs na superfície. Por outro lado, como a formação de In QDs está intimamente relacionada à camada In-rich na superfície, tal processo pode nos fornecer uma maneira de estudar diretamente a propriedade dessa camada.
Método
O objetivo deste artigo é apresentar um novo método para obter tamanhos uniformes em QDs na superfície da camada InGaN. As amostras utilizadas neste estudo foram cultivadas por um AIXTRON 6 × 2 em deposição química metalorgânica de reator de chuveiro de acoplamento próximo (MOCVD). Difração de raios-X de alta resolução (XRD), microscopia de força atômica (AFM), microscópio eletrônico de varredura (SEM) e espectrômetro de dispersão de energia (EDS) são usados para caracterizar as amostras InGaN. Todos os participantes deste estudo são cientistas da Universidade da Academia Chinesa de Ciências da China.
Disponibilidade de dados e materiais
Os conjuntos de dados usados e / ou analisados durante o estudo atual estão disponíveis junto ao autor correspondente, mediante solicitação razoável.
Abreviações
- AFM:
-
Força atômica microscópica
- EDS:
-
Espectrômetro dispersivo de energia
- GaN:
-
Nitreto de gálio
- Em QDs:
-
Pontos quânticos de índio
- InGaN:
-
Nitreto de gálio e índio
- InN:
-
Nitreto de índio
- LD:
-
Diodo laser
- LED:
-
Dispositivo emissor de luz
- MOCVD:
-
Deposição química metalorgânica
- MQW:
-
Poço quântico múltiplo
- NH 3 :
-
Amônia
- QDs:
-
Pontos quânticos
- SEM:
-
Microscópio eletrônico de varredura
- TMGa:
-
Trimetilgálio
- TMIn:
-
Trimetilíndio
- XRD:
-
Difração de raios X
Nanomateriais
- N, N-Dimetilformamida regulando a fluorescência de pontos quânticos MXene para a determinação sensível de Fe3 +
- O Projeto da Camada de Emissão para Multiplicadores de Elétrons
- Pontos quânticos de bismuto em poços quânticos de GaAsBi / AlAs recozidos
- Nanofios de silício amorfo cultivados em filme de óxido de silício por recozimento
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Defeitos na superfície do nanofósforo MgAl2O4 dopado com Ti
- Controlando o crescimento de seleneto de índio de alta uniformidade (In2Se3) Nanofios por meio do processo de recozimento térmico rápido em baixa temperatura
- Fabricação e caracterização de Nano-Clips de ZnO pelo processo mediado por poliol
- Fotocondutividade entre bandas de pontos quânticos InAs / InGaAs metamórficos na janela de 1,3-1,55 μm
- Fatores-chave que afetam os resultados do processo de retificação de superfície



