Placa de microcanais de alta sensibilidade e longa vida processada por deposição de camada atômica
Resumo
Como um componente chave do dispositivo multiplicador de elétrons, uma placa de microcanais (MCP) pode ser aplicada em muitos campos científicos. Óxido de alumínio puro (Al 2 O 3 ) como camada de emissão secundária de elétrons (SEE) foram depositados nos poros de MCP via deposição de camada atômica (ALD) para superar problemas como alta corrente escura e baixa vida útil que muitas vezes ocorrem no MCP tradicional. Neste artigo, investigamos sistematicamente a morfologia, distribuição de elementos e estrutura de amostras por microscopia eletrônica de varredura (MEV) e espectroscopia de dispersão de energia (EDS), respectivamente. Corrente de saída de diferentes espessuras de Al 2 O 3 foi estudado e uma espessura ótima foi encontrada. Testes experimentais mostram que o ganho médio do ALD-MCP foi quase cinco vezes melhor do que o do MCP tradicional, e o ALD-MCP apresentou melhor sensibilidade e maior tempo de vida.
Introdução
A placa de microcanais (MCP) é um multiplicador de elétrons compacto de alto ganho [1,2,3]. É um componente chave em MCP-PMT, dispositivos de visão noturna, microscopia eletrônica, câmera de enquadramento de raios-X e assim por diante [4,5,6,7]. Ele tem sido usado em uma ampla gama de aplicações de detecção de partículas e fótons, como íons, elétrons, nêutrons, raios-X e raios UV [8,9,10,11]. A placa de microcanais é uma matriz bidimensional fina composta por vários milhões de poros de vidro condutores ultrafinos de 4 a 25 μm de diâmetro e 0,2 a 1,2 mm de comprimento. O MPC tem três características principais de estrutura - ângulo de polarização, proporção do comprimento do canal para o diâmetro do canal e proporção da área aberta (proporção da área aberta total para toda a área efetiva). Em geral, o ângulo de polarização varia de 5 a 15 °. A proporção do comprimento do canal para o diâmetro do canal é de cerca de 20:1 a 100:1, e a proporção da área aberta de cerca de 60 a 80%. O MCP tradicional é feito de vidro de silicato de chumbo e fabricado por desenho, empilhamento, fusão, corte, gravação e redução de hidrogênio. Após o processamento químico de redução de hidrogênio, a camada condutora e a camada de emissão secundária de elétrons (SEE) são geradas no poro. Quando um elétron ou radiação entra em um canal, elétrons secundários são emitidos da camada SEE e esses elétrons são acelerados por um campo elétrico desenvolvido por uma voltagem V D aplicado na camada condutora. Finalmente, mais elétrons secundários foram produzidos dessa maneira e a amplificação de elétrons foi realizada. Embora o MCP tradicional tenha sido amplamente utilizado em muitos campos, existem várias desvantagens [12]. Em primeiro lugar, a corrosão química de alto ruído aumenta o Ra na superfície interna do poro, o fator de ruído aumenta e o S / N reduz quando os fotoelétrons são multiplicados. Em segundo lugar, o cozimento a vácuo e a depuração de elétrons resultam na variação do elemento de superfície do MCP e reduzem a carga extraída e o ganho do MCP. Em terceiro lugar, a resistência elétrica e as propriedades de emissão de elétrons secundários não podem ser ajustadas independentemente. Como as causas das desvantagens são diferentes e o processo de produção do MCP tradicional é complexo, é difícil superar todas as desvantagens ao mesmo tempo ajustando os parâmetros do processo.
À medida que a tecnologia de deposição de camada atômica (ALD) é aplicada em cada vez mais áreas de pesquisa [13,14,15,16,17], alguns pesquisadores propuseram a camada condutora depositada e a camada SEE dentro dos canais para otimizar o desempenho do MCP tradicional [18, 19,20,21,22,23]. ALD é uma técnica de deposição de filme fino em que um filme é cultivado em um substrato, expondo sua superfície a espécies gasosas alternativas. ALD é considerado como um método de deposição com grande potencial para a produção de filmes conformados muito finos com controle da espessura e composição dos filmes possível em nível atômico [24, 25].
Existem muitas vantagens em aplicar a tecnologia ALD no pós-processamento do MCP. Dióxido de silício (SiO 2 ) é o principal material de emissão de elétrons secundários no MCP tradicional [26] e tem um baixo rendimento de elétrons secundários (SEY). Se depositássemos um material SEE alto na parede do canal, o ganho de MCP poderia ser melhorado. Por causa do processo de corrosão, as superfícies do canal interno do MCP tradicional mantêm uma rugosidade superficial mais alta e têm muitos orifícios em nanoescala. Os orifícios em nanoescala adsorvem gases e outros poluentes difíceis de limpar. Quando acelerados, os elétrons atingem os absorventes, que são ionizados e acelerados pelo campo elétrico. Os íons acelerados ionizam cada vez mais absorventes e consomem elétrons extras do MCP. Devido ao tempo de vida do MCP decidido pela quantidade total de carga elétrica, a existência de absorventes leva a um tempo de vida mais curto. Nesse ínterim, o processo de lavagem elétrica é necessário para garantir um alto vácuo. Mais absorventes precisam de mais tempo de lavagem elétrica e custam mais carga elétrica, reduzindo ainda mais a vida útil do MCP. Se depositássemos material SEE com vários nanômetros de altura na superfície do canal interno, partes dos buracos em nanoescala poderiam ser preenchidos para melhorar a rugosidade da superfície e, então, ter uma vida útil mais longa.
Neste artigo, Al 2 O 3 como SEE o material foi preparado pela técnica ALD nos poros do MCP com 15 mm de comprimento de lado. A morfologia, distribuição de elementos, estrutura do filme fino de óxido depositado de ALD e desempenho de ALD-MCP foram sistematicamente investigados.
Métodos experimentais e de cálculo
O esquema da configuração do experimento é mostrado na Fig. 1. O sistema consiste em cátodo de ouro, MCP e ânodo PCB e é colocado em uma câmara de vácuo evacuada até 2 × 10 −4 Pa. As tensões para todos os eletrodos são fornecidas por uma fonte de alimentação multicanal de alta tensão e são alimentadas na câmara de vácuo por canais de alimentação de alta tensão. Há um picoamperímetro entre o ânodo do PCB e o solo para medir a corrente de saída do MCP. Uma lâmpada de mercúrio atenuado atua como fonte de luz ultravioleta quando medimos a corrente de saída do MCP. A lâmpada de mercúrio sem atenuação serve como fonte de luz ultravioleta quando aceleramos o teste de vida da placa de microcanais.
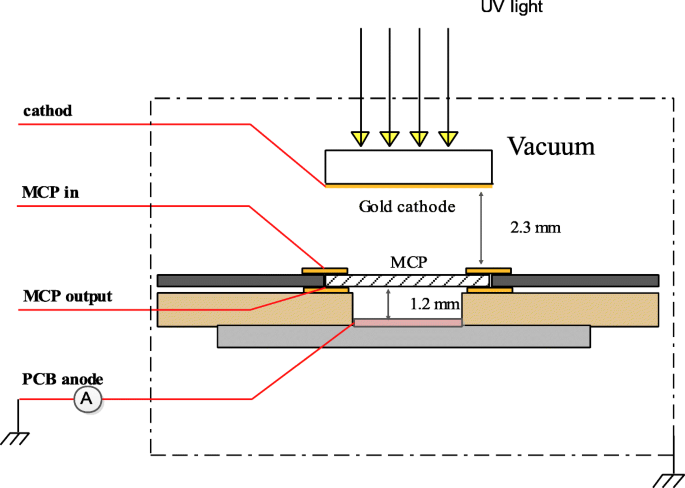
O esquema da configuração do experimento
Um sistema comercial de deposição de camada atômica de parede quente foi usado para preparar filmes finos de nano-óxido na superfície do canal interno MCP (como mostrado na Fig. 2) e silício. As amostras depositadas em silício são usadas para medir o rendimento da emissão secundária. Os substratos de silício polido foram limpos ultrassonicamente em acetona / etanol / ácido fluorídrico / água DI e, em seguida, colocados em uma câmara ALD aguardando a deposição. Os MCPs nus (espessura =1,2 mm, tamanho de poro =24 μm, razão de aspecto =40, ângulo de polarização =10 °) foram aquecidos a 200 ° C por 1 h para crescer filmes finos de nano-óxido. De acordo com o artigo [27, 28], é mais difícil controlar a espessura e a composição dos materiais no MCP do que no substrato plano. Duas abordagens foram adotadas para fazer a espessura e a composição, tanto quanto possível, serem uniformemente distribuídas nos poros do MCP. Um deles é a extensão de precursores para cada ciclo ALD (amostra F). O outro está usando um modelo de fluxo interrompido (amostra G), em que o pulso de precursores entra e se difunde na câmara de parede quente por vários segundos, então bombeado para fora e purgado pelo gás portador.
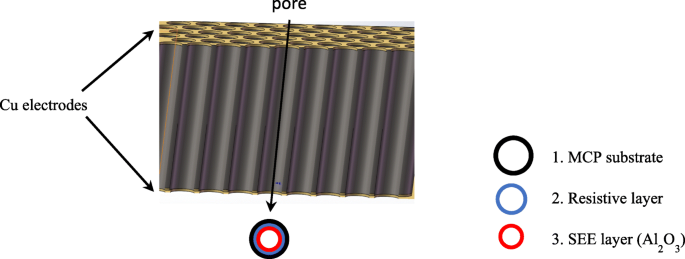
Diagrama esquemático da estrutura de ALD-MCP
Para a deposição da segunda camada de emissão de elétrons, Al 2 O 3 foi realizada usando TMA e água desionizada como Al e precursor de oxidante, respectivamente. O nitrogênio de pureza ultra-alta foi usado como transportador e gás de purga. O Al 2 O 3 ALD foi realizado usando TMA e H 2 separados Exposição O com sequência TMA / N 2 / H 2 O / N 2 (0,05 / 10 / 0,05 / 10s). O MCP quadrado com 15 mm de comprimento de lado revestido de aproximadamente 4 nm (amostra B), 6 nm (amostra C), 8 nm (amostras D e H), 10 nm (amostra E) e 60 nm Al 2 O 3 (amostra F). A amostra G foi realizada usando TMA e H 2 separados Exposição O com sequência TMA / Stop / N 2 / H 2 O / Stop / N 2 (0,05 / 3/20 / 0,05 / 3 / 20s) por 600 períodos. Um MCP circular (50 mm de diâmetro) foi dividido em duas partes; uma parte foi descoberta e a outra parte foi coberta por duas peças de pastilha de silício semicircular, para obter um MCP que é metade com processo ALD e metade não processado. Os detalhes dos parâmetros experimentais estão listados na Tabela 1. As superfícies das amostras de MCP foram examinadas por microscopia eletrônica de varredura (MEV). A composição elementar do filme foi medida pelo método transversal transversal SEM (EDS). Após a funcionalização do ALD, a camada de cobre com 200 nm como eletrodos foi preparada em ambos os lados do MCP por sistema de evaporação para caracterização elétrica do MCP e teste de vida.
Resultados e discussão
Conforme mostrado na Fig. 1, o princípio do teste de ganho MCP é mostrado abaixo. O fóton ultravioleta chega ao cátodo de ouro e foi convertido em fotoelétron pelo efeito fotoelétrico. O fotoelétron é acelerado pela voltagem entre o cátodo e o MCPin e obtém a energia do elétron primário. Em seguida, o fotoelétron com energia do elétron primário amplificado por MCP e nuvens de elétrons de saída para o ânodo do PCB. Por fim, os elétrons fluem para o solo e a corrente de saída foi medida pelo picoamperímetro. A corrente de saída do MCP é ordenada por tensões de polarização entre diferentes eletrodos. A fim de determinar as tensões para cada eletrodo, a amostra A foi montada e a tensão entre MCPin e MCPout foi ajustada para um valor fixo; em seguida, altere as tensões do cátodo e do ânodo para obter um valor ideal.
A corrente de saída do MCP como função da energia do fotoelétron (a energia do elétron primário antes de entrar no MCPin) é mostrada na Fig. 3 quando a configuração da tensão de polarização para MCP é 1400 V. A corrente de saída do MCP aumenta aproximadamente linearmente conforme a energia do fotoelétron é menor que 400 V e entra em um platô com energia maior que 400 eV. Isso pode ser atribuído ao fato de que o SEY do dióxido de silício é particularmente baixo na energia elétrica incidente mais baixa e, uma vez que o SEY está próximo do máximo, a corrente de saída torna-se estável.

Tensão de polarização entre cátodo e MCPin em função da corrente de saída do MCP
A Figura 4 mostra a curva SEY de Al 2 O 3 e SiO 2 . Na figura, o SEY de Al 2 O 3 está aumentando com a tensão e obtém o maior valor de 3,6 a 400 V, e essa tendência corresponde aproximadamente à Fig. 3. No Al 2 O 3 Curva SEY, o valor SEY fica maior que 400 eV. Mas, conforme mostrado na Fig. 3, a corrente de saída ainda está aumentando quando a tensão de polarização está acima de 400 V. Isso pode ser explicado pela razão de área aberta do MCP. O MCP que usamos tem uma proporção de área aberta de cerca de 60%; isso significa que quando os fotoelétrons chegam ao MCPin, 40% deles não podem entrar nos canais e seriam refletidos pela superfície superior do MCP. Quando a tensão entre o cátodo e o MCPin aumenta, o campo elétrico acelera novamente os 40% dos elétrons e entra no canal novamente.
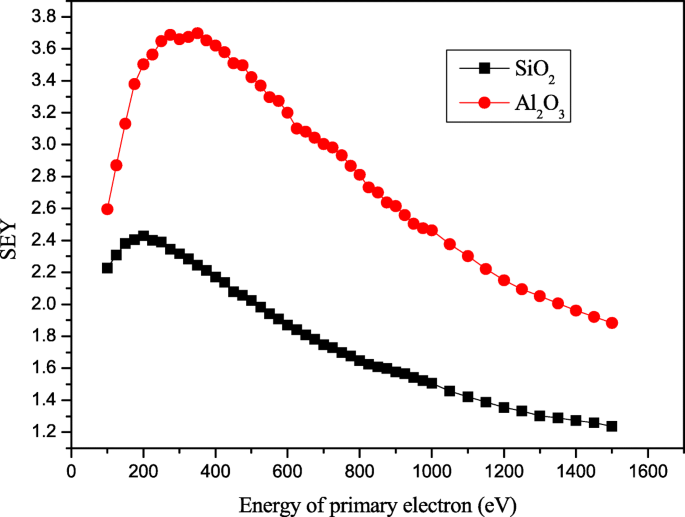
Rendimento de elétrons secundários (SEY) de SiO2 ALD Al2O3
Por causa da uniformidade da camada SEE pode afetar a uniformidade do detector de imagem MCP, então a uniformidade da camada SEE é um fator chave para a caracterização ALD-MCP. A Figura 5 mostra os espectros e a composição elementar de amostras de seção transversal de MCP processadas pela extensão do modelo de precursor e do modelo de parada de fluxo. A distribuição de Al é caracterizada por EDS em cinco locais ao longo da superfície interna dos poros. A fim de reduzir o erro de medida de EDS, os dados de distribuição do elemento foram medidos por duas amostras mais espessas, amostra F e amostra G, que depositou Al 60 nm 2 O 3 . Na Fig. 5a, b, a composição elementar de MCPs revestidos e não revestidos foi medida para excluir a influência do substrato na distribuição de Al. A quantidade de Al é inferior a 1% no substrato e muito pequena para afetar os resultados finais do experimento. A distribuição de todas as amostras depositadas pelo modelo de fluxo interrompido e modelo de precursor de extensão é mostrada na Fig. 5c. O conteúdo de Al em diferentes locais significa que os elementos são mais uniformemente distribuídos na superfície interna dos poros, cuja amostra é depositada pela extensão do modelo de precursores. Isso também implica que a técnica ALD é capaz de depositar uma película fina de nano-óxido homogêneo em substratos com estrutura complexa. A distribuição dos elementos da amostra depositada pelo modelo de stop flow mostra um uniforme ruim. As superfícies superior e inferior do MCP têm uma baixa porcentagem atômica, enquanto o meio do canal tem uma alta porcentagem atômica. Isso provavelmente se deve ao fato de os precursores na superfície serem fáceis de limpar e obter uma camada de deposição atômica. No meio do canal, os precursores eram difíceis de limpar e obter uma deposição de vapor em vez de uma deposição atômica.

Espectro e composição elementar de amostras MCP de seção transversal. a Espectros e composição elementar de ALD MCP. b Espectros e composição elementar de MCP não revestido. c Distribuição de todas as amostras depositadas por modelo de stop flow e modelo de precursor de extensão.
A espessura com MEV pode ser a melhor opção para confirmar a uniformidade. Portanto, a espessura das camadas SEE depositadas na superfície interna dos poros do MCP foi medida por SEM e está resumida na Fig. 6. A espessura de cinco pontos diferentes ao longo de um poro, como mostrado na Fig. 6a, foi medida diretamente por SEM. As curvas de espessura dos diferentes modelos de deposição são mostradas na Fig. 6c, que basicamente coincide com a distribuição de Al como na Fig. 5c.
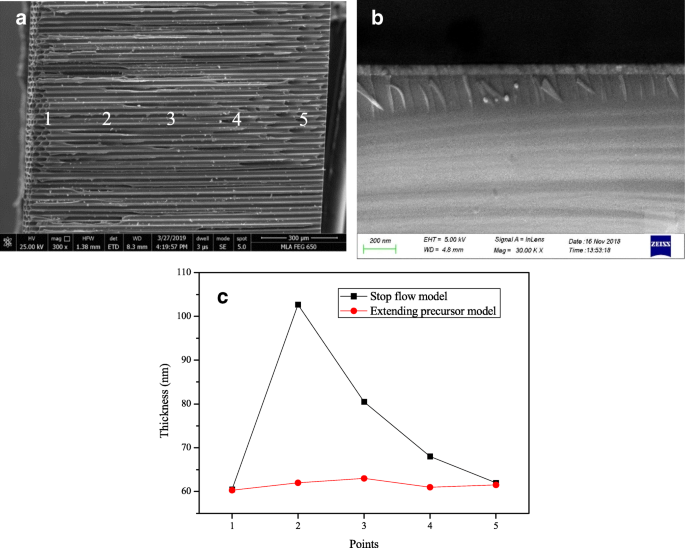
Imagens SEM em corte transversal do MCP. a Imagens de SEM em corte transversal de amostras ALD-MCP. b Imagens de SEM em corte transversal da camada de Al2O3 na superfície do canal interno. c Espessura da camada SEE em diferentes locais medidos com SEM
Depois que os eletrodos de cobre foram preparados em ambos os lados do MCP, a caracterização elétrica medida por um sistema é mostrada na Fig. 1. A Figura 7 mostra a corrente de saída e a imagem do MCP tradicional e ALD-MCP revestido. A Figura 7a mostra a corrente de saída em função das diferentes espessuras de Al 2 O 3 . Na Fig. 7b, à medida que a espessura do filme aumenta de 6 para 10 nm, a corrente de saída do subtrato revestido MCP não revestido aumenta significativamente primeiro e depois se mantém estável. Os ALD-MCPs com Al de 8 nm e 10 nm Al 2 O 3 o revestimento obteve mais de cinco vezes a corrente de saída do que o MCP convencional. Isso significa que Al 2 de 8 nm de espessura O 3 é ideal para a aplicação MCP. Isso é causado pelo ALD-MCP que tem um material SEY mais alto que podemos ver na Fig. 3. Como mostrado em (a), quando revestido 4 nm na superfície do canal interno do MCP, a corrente de saída é menor do que o não revestido MCP. Isso provavelmente porque não há material contínuo e muitos defeitos existem quando a espessura de Al 2 O 3 está abaixo de 4 nm. A recombinação de elétrons ocorre em defeitos para reduzir o número de elétrons secundários e levar a uma corrente de saída mais baixa do que o MCP não revestido.
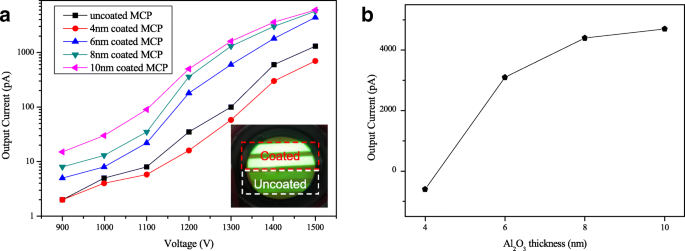
Saída de corrente e imagem de MCP tradicional e ALD-MCP revestido. a Corrente de saída de diferentes espessuras revestidas de Al2O3 em MCP e fotografia de uma tela de fósforo iluminada por Al2O3 de 8 nm semi-revestido e metade não revestido. b Corrente de saída de MCP não revestido de subtração revestido em função da espessura de Al2O3
Depois de depositarmos Al 2 de 8 nm O 3 na metade da amostra H, há quatro tiras de cobre depositadas na amostra H e uma tela de fósforo em vez do ânodo PCB para coletar os elétrons de saída. Conforme mostrado na Fig. 7b, o MCP semi-revestido tem uma imagem mais brilhante do que o MCP não revestido. Isso é consistente com a caracterização elétrica.
A amostra A e a amostra D foram continuamente iluminadas com uma lâmpada ultravioleta de mercúrio para um teste vitalício. Para acelerar o teste de vida, foi usada lâmpada ultravioleta de mercúrio de alta potência sem atenuação. Os MCPs foram operados com grandes correntes de saída e permanecem em um nível de saturação por vários dias. Conforme mostrado na Tabela 2, a corrente escura e a corrente de saída em um baixo nível de iluminação foram medidas antes e depois do teste de vida. Antes do teste, a corrente escura do MCP tradicional era de 1,0 pA e o ALD-MCP era de 1,2 pA. A corrente escura mais alta do ALD-MCP era apenas porque os substratos dos MCPs eram MCPs tradicionais e o ALD-MCP era revestido por um material de alto SEY. Após o teste vitalício, a corrente escura do ALD-MCP tem um desempenho melhor, enquanto eles mostraram um desempenho semelhante antes do teste vitalício. De acordo com a Tabela 2, a corrente de saída do MCP tradicional caiu cerca de 50% após a iluminação de alta potência, enquanto o ALD-MCP mostra um melhor comportamento e a corrente de saída mantida em torno de 6nA.
Conclusões
A morfologia, composição e estrutura de filmes finos de nano-óxido Al 2 O 3 preparados via deposição de camada atômica foram investigados. As uniformidades de espessura no canal depositado pelo modelo de precursor de extensão e modelo de fluxo interrompido foram medidas. O conteúdo de Al e a espessura do filme em diferentes locais ao longo dos canais significam que o precursor de extensão pode obter uma melhor uniformidade para um MCP com tamanho de poro de 24 μm e razão de aspecto de 40. Avaliamos um sistema de teste de MCP e observamos que as tensões de polarização entre o cátodo e a superfície superior do MCP pode afetar a corrente de saída. As propriedades elétricas e medidas de vida foram estudadas. Os resultados das medições elétricas mostraram que quando a espessura do filme aumenta de 6 para 10 nm, a corrente de saída aumenta e a velocidade diminui. E ALD-MCPs que são revestidos com mais de 8 nm Al 2 O 3 tem cerca de cinco vezes a corrente de saída do que os MCPs tradicionais e tem um melhor desempenho durante toda a vida.
Abreviações
- ALD:
-
Deposição de camada atômica
- ALD-MCP:
-
Placa de microcanal processada por deposição de camada atômica
- EDS:
-
Espectroscopia de dispersão de energia
- MCP:
-
Placa de microcanal
- Camada VER:
-
Camada de emissão de elétrons secundária (SEE)
- SEM:
-
Microscopia eletrônica de varredura
- SEY:
-
Rendimento de elétrons secundários
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Revelando a estrutura atômica e eletrônica das nanofibras de carbono de copo empilhado
- O Projeto da Camada de Emissão para Multiplicadores de Elétrons
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Eletrodeposição de SnO2 em FTO e sua aplicação em células solares de perovskita de heterojunção planar como uma camada de transporte de elétrons
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Tratamento UV de camadas de transporte de elétrons de SnO2 processado em baixa temperatura para células solares de perovskita planar



